電荷移動ベースのバリア変調下でのMoS2非対称ガスセンサーのキャリア輸送特性
要約
二次元材料は、その独特の性質から、ここ数年、次世代の電気センシングデバイスとして大きな注目を集めています。ここでは、MoS 2 のキャリア輸送特性を報告します。 周囲およびガス暴露条件下でのショットキーダイオード。 MoS 2 電界効果トランジスタ(FET)は、PtおよびAl電極を使用して製造されました。 Ptの仕事関数はMoS 2、の仕事関数よりも高い 一方、AlのそれはMoS 2 のそれよりも低いです 。 MoS 2 Al接点を備えたデバイスは、ショットキー障壁の高さ(SBH)が低いため、Pt接点を備えたデバイスよりもはるかに高い電流を示しました。 MoS 2 の電気的特性とガス応答 AlおよびPt接点を備えたショットキーダイオードは電気的に測定され、密度汎関数理論計算によってシミュレートされました。理論的に計算されたダイオードのSBH(ガス吸収下)は、NO x 分子はダイオードと強い相互作用を持ち、負の電荷移動を引き起こしました。ただし、NH 3 の場合は逆の傾向が見られました。 分子。また、MoS 2 のガス検知性能に対する金属接点の影響を調査しました。 実験的および理論的の両方のFET。
背景
近年、グラフェンの発見後、ファンデルワールス(vdW)力で垂直に積み重ねられた層を持つ2次元(2D)ナノ材料が、その独特の性質から大きな注目を集めています[1,2,3,4 、5]。炭素の層状六角形構造であるグラフェンは、高いキャリア移動度[6、7]、機械的強度[8]、柔軟性[9、10]などの独自の特性を備えており、ナノ電子デバイスの新しい道を切り開いています。最近、MoS 2 などの遷移金属ジカルコゲナイド(TMD) およびWSe 2 、グラフェンと比較してバンドギャップが大きいためにも研究されています[11、12、13、14、15]。単層MoS 2、 厚さ6.5Åの最も広く知られている2D層状TMDです。最大200cm 2 の高い可動性を示します V -1 s -1 [16]およびオン/オフ比が〜10 8 を超える [17]。さらに、MoS 2 は、バルクで1.2 eV [18]の間接バンドギャップを持ち、バンドギャップがゼロのグラフェンとは異なり、単層で1.8 eV [19]の直接バンドギャップを持つ半導体です。グラフェンのこのゼロバンドギャップは、ナノ電子デバイスへの応用を制限します。
MoS 2 を開発するために シリコンベースのデバイスと同等の性能を備えたトランジスタ、格子状態の品質、製造、接触金属とMoS 2 間の接触抵抗などの多くの制限 克服する必要があります。この文脈でのこれまでの研究の多くは、MoS 2 の界面での電気的相互作用の改善に焦点を合わせてきました。 と金属電極。これは、接触に関連する特性には、電位差、アニーリング条件、および面積が含まれるためです。ただし、これらの研究のほとんどは対称接合を想定しており、実験的分析と理論的分析の両方を含んでいませんでした。さらに、MoS 2 のキャリア挙動を分析することは困難です。 そのバンド構造変調のみを観察することにより、ガス曝露条件下で。この基本的なバンド構造では変調を決定するための特定の値を提供できないため、このシミュレーション結果を適用するには制限があります。さらに、ショットキー障壁の高さ(SBH)は、MoS 2 の電気的応答を決定するための重要な要素であると考えられていますが ガス吸収下のトランジスタでは、以前の研究では理論的にも実験的にもSBHの影響を分析していませんでした。
この研究では、MoS 2 を作成しました 非対称電極AlおよびPtを備えたFETは、ガス曝露条件下でショットキー障壁を通過するキャリア輸送を観察します。まず、ケルビンプローブフォース顕微鏡(KPFM)を使用して表面電位を測定することにより、デバイスの仕事関数の違いを幾何学的にマッピングしました。 MoS 2 を設計するには ショットキーダイオード、MoS 2 の接触効果 /金属界面は、理論的(密度汎関数理論(DFT)計算)と実験的(対称および非対称MoS 2 の電気的測定)の両方で周囲条件下で分析されました。 FET)。ダイオードの電気的応答は、ガス暴露条件下で測定されました。次に、この電気的応答を、変調を数値的に理解することを可能にする理論的に計算されたSBH変化値と比較しました。この研究の結果は、ガス分子とMoS 2 の相互作用への洞察を提供します。 / MoS 2 の金属接触インターフェース ベースのガス検知装置。
メソッド
MoSの作成 2 デバイス
MoS 2 を作成しました 簡単な機械的転送方法を使用したショットキーデバイス。 MoS 2 の数層のフレーク SPIサプライから購入したバルク結晶から剥離されました。ポリジメチルシロキサン(PDMS)(“ Sylgard 184”、ダウコーニング)、MoS 2 高濃度にドープされたSi / SiO 2 に転写されました 基板。 PtおよびAl電極(厚さ100 nm)をサンプルフィルムに蒸着し、電界放出型走査電子顕微鏡(FE-SEM)(JSM-7001F、JEOL Ltd.)を使用した電子ビームリソグラフィーによってパターン化しました。 MoS 2 のパフォーマンス デバイスは、室温でソース/ドレインおよびソース/ゲート電圧変調(Keithley 2400ソースメーター)を測定することによって評価されました。
表面電位測定
デバイスの表面電位は、25°Cおよび1バールの周囲空気条件で、PtIrコーティングされたシリコンプローブチップ(SCM-PIT、Veeco)を使用して、静電力顕微鏡(Nanoscope IV、Veeco)のインターリーブモードで測定されました。チップの最初のスキャンでは、デバイスの表面トポロジーを調べました。その後の2回目のスキャンを実行して、デバイスの表面とチップの間の静電力を測定しました。
DFT計算
MoS 2 の\(\ sqrt {3} \ times \ sqrt {3} \)スーパーセル 3つのMo原子と6つのS原子で準備されました(図3a)。画像の相互作用を防ぐために、15Åの真空間隔が定義されました。格子定数は3.184Åと計算され、実験値(3.160Å)とよく一致しています。金属と単分子層MoS 2 の間の界面を構築するために、6層のAlまたはPt金属原子((111)自由表面)を備えた基板を製造しました。 。 AlおよびPt基板の格子定数は、それぞれ4.070および3.973Åと計算されました。各構造の形状最適化後、単層MoS 2 基板上に堆積され、構成が再び最適化されました。 MoS 2 間の格子不整合 MoS 2 の単分子層が観察されたため、金属基板が観察されました。 ジオメトリの最適化中に引き伸ばされます。単分子層MoS 2 の構造 ガス分子(NO 2 を含む) およびNH 3 )も、\(\ sqrt {3} \ times \ sqrt {3} \)スーパーセルを使用して構築および最適化されました。
DFT計算は、VASP(Vienna ab initioシミュレーションパッケージ)[20,21,22,23]を使用して実行されました。 GGA(一般化勾配近似)–PAW(Projector Augmented-wave)法の交換補正機能に対するPBE(Perdew-Burke-Ernzerhof)がvdW補正とともに使用されました[24、25、26、27]。基底関数系のカットオフエネルギーは、すべての計算で500eVに拡張されました。自己無撞着とバンド構造の計算では、電子エネルギーの収束と原子間力の基準を10 -5 に設定しました。 それぞれeVと0.02eV /Å。ブリュアンゾーンサンプリングのKポイントは8×8×1でした(ガンマ(Γ)ポイントを中心に)。ガス分子とMoS 2 間のvdW相互作用を測定するため 、GrimmeのDFT-D2法が使用されました[28]。
結果と考察
MoS 2 を用意しました 2種類の電極(AlとPt)を備え、原子間力顕微鏡(AFM)を使用してそれらの形態と厚さを特性評価したデバイス(図1a)。図1bは、MoS 2 の高さを示しています。 断面線に沿ったレイヤー(図1aの赤い線で示されています)。 MoS 2 の厚さ サンプルは4nmでした。 MoS 2 での仕事関数の違いを示すため 対称電極と非対称電極を備えたデバイスでは、KPFMを使用してMoS 2 間の接触電位差を測定しました。 とプローブチップ。プローブチップとサンプルが十分に接近すると、それらの間の仕事関数の違いのために静電力が加えられました。 2つの材料の静電力と仕事関数の関係は次のとおりです。
$$ {F} _ {\ mathrm {electrostatic}} =\ frac {q _ {\ mathrm {s}} {q} _ {\ mathrm {t}}} {4 {\ pi \ varepsilon} _0 {z} ^ 2} + \ frac {1} {2} \ frac {dC} {dz} {\ left({V} _ {\ mathrm {applied}}-{V} _ {\ mathrm {contact}} \ right)} ^ 2 $$ここで、 dC / dz はサンプルとチップ間の微分容量 q s は表面電荷であり、 q t チップの料金です。 V 連絡先 表面電位値によって特徴付けることができます[29]。表面電位値を使用して、仕事関数を次のように計算しました
$$ {V} _ {\ mathrm {contact}} ={\ Phi} _m-{\ chi} _s- \ varDelta {E} _ {fm}-\ varDelta \ Phi $$ここで、Φ m はプローブチップの仕事関数χです。 s は電子親和力、ΔE fn は伝導帯の最低レベルからのフェルミ準位の位置であり、Δ Φは修正されたバンドベンディングです。
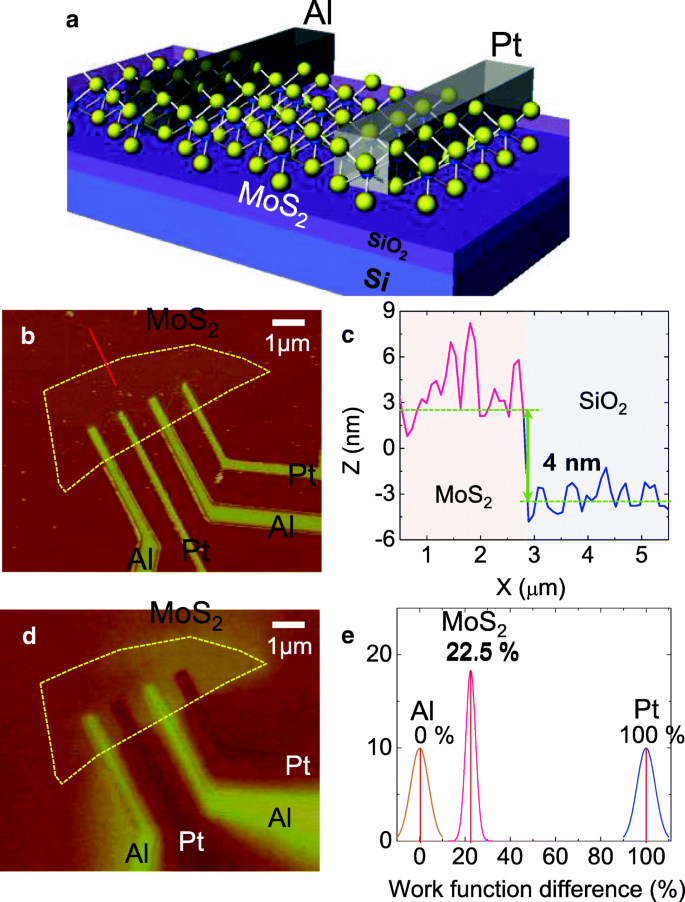
a MoS 2 の概略図 AlおよびPt接点を備えたショットキーダイオード。 b MoS 2 のAFM画像 非対称金属電極(Al / Pt)を備えたショットキーダイオードデバイス。 c MoS 2 の厚さを測定するためのデバイスの断面分析 層。 d 同じデバイスの表面電位画像。 e MoS 2 の相対表面電位の正規分布 、Al、およびPt
デバイスの表面電位マッピングを図1cに示します。 PtIrコーティングされたSiチップの仕事関数値(4.85 eV)を追加して、電極とチャネル部分の仕事関数を取得しました[30]。次に、正規化プロセスの後に、MoS 2 のパーセンテージ値を配置しました。 図1dに示すように、PtとAlの間。 AlとMoS 2 の表面電位の違い は22.5%であり、PtとMoSの表面電位の間の電位よりも小さかった 2 (100%)。 Ptとは異なり、AlはMoS 2 と同等の仕事関数を持っています。 。これは、Alの表面電位がMoS 2 の表面電位に匹敵するためです。 。以来、MoS 2 とAlは同様の仕事関数を持ち、オーミック接触を形成できます。 MoS 2 およびPtは、表面電位が大きいため、ショットキー接触を示します。ガス検知メカニズムを理解するには、ガス吸収下で電位変調が発生するかどうかを確認するために、さらに調査を行う必要があります。
デバイスの非対称接合特性を比較するために、ゲート電圧範囲-15〜15VでのAlおよびPt接点を備えたデバイスの電流-電圧特性をそれぞれ図2a、cに示します。 MoS 2 Al接点を備えたデバイスは、Pt接点を備えたデバイスよりもはるかに高い線形ドレイン電流を示しました。 Al接点の電流はPt接点の電流の1000倍以上でした。これは、仕事関数の低い金属接点を備えたデバイスのSBHが低いことを示しています。 MoS 2 に対する金属接点の影響をさらに調査するには /デバイスの金属インターフェース、さまざまな順方向バイアス電圧(0.1、5、および10 V)での伝達特性を測定しました(図2b、d)。どちらの場合(AlおよびPt接触)でも、MoS 2 の伝達曲線 は、n型半導体の特性を示しました。つまり、正のゲート電圧での電流レベルは、負のゲート電圧での電流レベルよりも高かった[31]。ソース-ドレインバイアスが0.1Vの場合、Al接点のあるデバイスのみがオンオフ傾向を示しました。バイアスを5Vに上げると、Al接点とPt接点のオンオフ比は約10 6 になりました。 および10 3 、 それぞれ。バイアス電圧が10Vに近づくと、Al接点のあるデバイスのオフ機能が無効になり、Pt接点のオンオフ比が増加しました。これは、特定の電流範囲で望ましい性能を備えたガス検知デバイスを実現するには、適切な金属接点を使用することが不可欠であることを示唆しています。デバイスのしきい値電圧を決定するために、\(\ sqrt {I_ {DS}} \)対ゲート電圧曲線がそれらの伝達曲線に追加されました(図2b、d)。これは、\(\ sqrt {I_ {DS}}-{V} _g \)線の変動を平滑化することでしきい値電圧を測定しやすくなるためです。 Al電極を備えたデバイスの\(\ sqrt {I_ {DS}}-{V} _g \)ラインによって誘導されたしきい値電圧は約-70 Vでしたが、Pt電極を備えたデバイスのしきい値電圧は約-30 V(図2a、c)。 Al接点のあるデバイスのしきい値電圧は、Pt接点のあるデバイスのしきい値電圧よりもはるかに低かった。これは、Al / MoS 2 のショットキー高さが低いことに起因する可能性があります。 Pt / MoS 2 のインターフェースと比較したインターフェース インターフェース。さらに、Al接点を備えたデバイスのしきい値電圧は、ソース-ドレイン電圧によって強く変調されました。一方、Ptがドレイン-ソース間電圧と接触しているデバイスのしきい値電圧には、大きな変化は見られませんでした。

a 出力曲線と b MoS 2 の伝達曲線 Al-Al対称電極を備えたデバイス。 c 出力曲線と d Pt-Pt対称電極を備えた同じデバイスの伝達曲線
金属/ MoS 2 の電気的状態を理論的に分析する インターフェイス、DFT計算は、MoS 2 を使用して実行されました。 -on-Al構成(図3a、b)。表1に、格子の不一致と距離 h を示します。 MoS 2 の間 と金属基板。この研究で得られた値は、以前に報告された値と一致していました[32]。 MoS 2 のバンド構造 Al基板とPt基板をそれぞれ図3c、dに示します。仕事関数とSBHの値を表1にまとめています。仕事関数とSBHの値を表1にまとめています。MoS 2 の仕事関数 Pt基板(5.755 eV)を使用した場合、以前の結果(5.265 eV)とよく一致します[32]。 Al基板を使用したデバイスのSBHの値は、Pt基板を使用したデバイスのSBHの値より72%低かった。 SBHの違いの理由は、AlとPtの仕事関数の違いに起因します。 Alの仕事関数はPtの仕事関数より64%低い。 [33]したがって、Al / Pt非対称接触システムはダイオードとして機能することができます。

a 、 b MoS 2 の3Dモデル DFT計算で使用されたAlおよびPt基板上。 c 、 d これらのモデルのバンド構造。緑の線は、真空準位の仕事関数としてゼロをとることによって設定されたフェルミエネルギーを示します。青いダッシュは、単分子層MoS 2 のエネルギーバンドに対応します。 。伝導帯サイトの緑色の線の値と青色の破線の最小値の差はSBHです[38]
Al / Pt非対称システムの性能をさらに調べるために、MoS 2 上にAl / Pt非対称金属電極を作製しました。 ショットキーデバイス。図4aは、MoS 2 の電流-電圧特性を示しています。 Al-Al、Pt-Pt、Al-Pt、およびPt-Al接点を備えたデバイス(ソースとドレインの順序として)。 Al-AlおよびPt-Ptデバイスの対称曲線とは異なり、非対称ダイオードはMoS 2 の方向に整流特性を示しました。 / Al連絡先。デバイスの性能に対する電荷移動の影響を調査するために、ゲートバイアスの関数としてのドレイン電流を観察しました(図4b)。ソース-ドレイン電圧に対応する伝達曲線も得られました(図4c)。図4cは、ソース-ドレイン電圧の増加に伴い、しきい値電圧が40から-40Vにシフトしたことを示しています。対称的にAlに接触したデバイスの場合にも同様の傾向が観察されました。これは、Al / MoS 2 接触側は、Pt / MoS 2 よりもデバイスのキャリア輸送に影響を及ぼしました。 接触側。
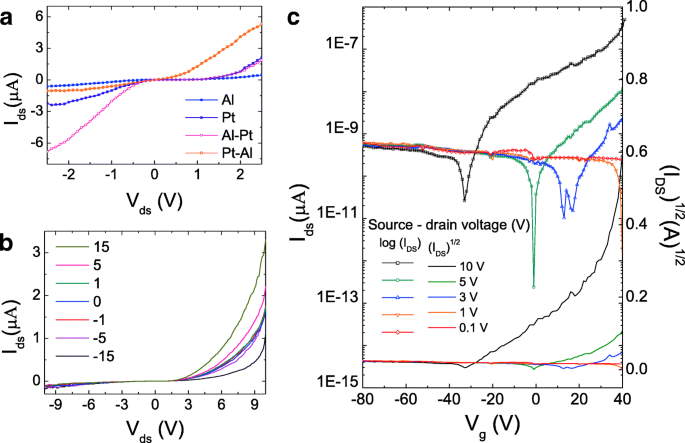
a I-V DS MoS 2 の曲線 対称電極(Al-Al、Pt-Pt)と非対称電極(Al-Pt)を備えたデバイス。 b 伝達曲線と c 非対称デバイスの出力曲線
MoS 2 のリアルタイムガス応答 ショットキーダイオードを測定して、電荷移動を伴うショットキーバリア変調を観察しました。ダイオードのガス感度は、次の式を使用して計算されました。
$$ \ frac {\ Delta R _ {\ mathrm {air}}} =\ frac {R _ {\ mathrm {gas}}-{R} _ {\ mathrm {air}}} {R _ {\ mathrm {空気}}} $$ここで R 空気 および R ガス MoS 2 の抵抗を表します それぞれ周囲およびガス曝露条件下でのショットキーダイオード。図5は、MoS 2 のガス検知能力(時間の経過に伴う抵抗の変化)を示しています。 NO x 用のショットキーデバイス およびNH 3 3 Vのソース-ドレインバイアスが適用された分子(10、20、および30 ppm)。NO x 以降 は強力な電子受容体であり、したがってpドーピング材料であり、MoS 2 の界面での負電荷注入により、ガス曝露の増加に伴ってデバイスの抵抗が増加しました。 [34]。 MoS 2 のpドーピング ショットキー障壁が増加し、MoS 2 での接触抵抗が増加しました。 / metalインターフェース。信号応答のガス吸収依存性も観察された。デバイスの感度は、ガス濃度の増加とともに増加し、その電荷移動の増加を示しています。一方、デバイスの抵抗は、NH 3 にさらされると減少しました。 (図5c)。これは、NH 3 が原因です。 電子をMoS 2 に寄付します したがって、ショットキー障壁が減少します[35]。 NH 3 の測定されたガス感度 NO x よりもはるかに低かった 、NH 3 の存在下での電荷移動を示します NO x の存在下よりも低かった [36]。さらに、各ステップでの電流変動後、ガス濃度のわずかな依存性も観察されました。 NH 3 の増加に伴い 濃度、デバイスの抵抗が減少しました。これは、MoS 2 が原因です。 / Alインターフェースは、より高いNH 3 でより低いSBH値を示しました 濃度。これらの結果を理論的に確認するために、MoS 2 のSBHを計算しました。 さまざまな種類のガス分子と接触していた/ Alインターフェース(図5d)。カンら。 MoS 2 のショットキーバリア理論について以前に説明しました /金属接触と3種類のモデルを使用して接触側を通るキャリア輸送を説明しました[37]。この論文で説明されているバンド図によると、ショットキーバリア変調は電極とチャネルの境界で発生します。そこで、ガス吸収によるショットキーバリア変調の観測を容易にするために、ショットキーバリアを均一に分布させた複合構造を設計しました。ただし、モデルはすべての状況に適用されるわけではありません。タイプ3は、MoS 2 の直接接触した界面にショットキー障壁が形成されていないことを示しました。 強力な金属化効果のために金属。 MoS 2 との密着性が強い金属 TiやMoのようにタイプ3に分類されます。金属/ MoS 2 のさまざまな接触効果を調査する モデル構造を設計するには、複合的な慎重な検討に従う必要があります(追加ファイル1:図S1およびS2)。バリアの高さを計算するためにAl側のみが選択されました。これは、Pt電極を備えたバリアが、順方向バイアス下でのキャリア輸送を妨げなかったためです。 NO 2 およびNH 3 MoS 2 のショットキー障壁の変調のために選択されました / Alインターフェース。このショットキーバリアは、元の状態で観察されたものと比較されました(表1)。 NO 2 の理論的に計算されたバリアの高さ およびNH 3 それぞれ0.16と0.13eVでした。この結果は、NO 2 およびNH 3 異なる方向への誘導電荷移動。ショットキー障壁は、NO 2 の影響をより受けました。 NH 3 よりも 。これらの結果は実験結果と一致していた。結果は、MoS 2 ショットキーダイオードは、次世代のガス検知デバイスで使用される可能性が非常に高いです。

a MoS 2 の概略図 シミュレーションに使用されたガス分子。 b 、 c MoS 2 の抵抗変化 NO x のショットキーダイオード およびNH 3 それぞれ露出。 d MoS 2 の理論的に計算されたSBH /周囲およびガス暴露条件下での金属界面(NO、NO 2 、およびNH 3 )
結論
この研究では、MoS 2 の特性に対する接触材料の影響を調査しました。 周囲およびガス暴露条件下での非対称FET。 KPFMの結果は、Ptが最も高い仕事関数を持ち、MoS 2 がそれに続くことを示しました。 とアル。 DFTの結果は、MoS 2 のSBHを予測しました。 / metalインターフェースは、仕事関数の高い金属の方が高かった。これは、この研究で製造された対称(Al-AlおよびPt-Pt)および非対称(Al-Pt)FETで得られた実験結果と一致しています。 NO x の吸収 その結果、ガス応答が強くなり、デバイスの抵抗率が増加しました。 NH 3 の場合、反対の傾向が観察されました。 。これらの結果は、理論的に計算されたSBH値と一致していました。この研究では、MoS 2 を開発するために適切な金属接点を選択することの重要性を強調しています。 望ましい性能のガスセンサー。
略語
- AFM:
-
原子間力顕微鏡
- DFT:
-
密度汎関数理論
- FET:
-
電界効果トランジスタ
- KPFM:
-
ケルビンプローブフォース顕微鏡
- SBH:
-
ショットキーバリアの高さ
- TMD:
-
遷移金属ジカルコゲナイド
- V ds :
-
ソース-ドレイン電圧
- vdW:
-
ファンデルワールス
ナノマテリアル
- 電気触媒水素発生のための制御された厚さのMoS2
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- 水素センサーの特性に及ぼすPd / SnO2ナノ材料形成の条件の影響
- 電気触媒作用のためのグラフェンナノシート上のMoS2ナノフレークの温度依存性結晶化
- MoS2 / GaAsヘテロ接合における大きな横方向光起電力効果
- 多層MoS2フォトトランジスタのバイアス依存光応答性
- 紫外線支援酸化銅ナノワイヤー水素ガスセンサー
- 個々のNiCo2O4ナノワイヤの温度依存性電気輸送特性
- リチウムイオン電池用のバインダーフリー電極としての三次元MoS2 /グラフェンエアロゲル
- ウェアラブルセンサーがガス漏れを検出
- ウェアラブル、伸縮性ガスセンサー



