c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性
要約
異なるAlN厚さのn-GaN上にAlNを堆積させた原子層の界面および電気的特性を調べた。静電容量-電圧( C – V )特性として、厚さ7.4 nmのAlNを含むサンプルは、最高の界面密度と酸化物トラップ密度を示しました。 AlNの厚さが0.7nmの場合、X線光電子分光法(XPS)スペクトルは、明確なAlNピークがなく、Al–O結合に関連する主要なピークを示しました。 GaN表面近くに残っている酸素原子の量は、AlNが厚いほど減少することがわかりました。ただし、多くの酸素原子がAlN層全体に存在し、酸素関連の欠陥を提供し、最終的に界面状態密度を増加させました。熱電子放出(TE)モデルによるバリアの不均一性は、厚さ7.4 nmのAlNのサンプルの順方向バイアス電流を説明するのに適切でしたが、厚さ0.7nmのAlNのサンプルには適切ではありませんでした。厚さ0.7nmと7.4nmのAlNの両方のサンプルの逆リーク電流は、プール-フレンケル放出よりもファウラー-ノルドハイム(FN)を使用してより適切に説明されました。
背景
バンドギャップが大きく、電子飽和速度が高く、破壊電界が大きいため、III族窒化物材料は、青色発光ダイオード(LED)、レーザーダイオード(LD)、UV検出器などのオプトエレクトロニクスデバイスだけでなく、高電子移動度トランジスタ(HEMT)やパワーデバイスなどの電子デバイス[1,2,3,4]。高性能のGaNベースのデバイスを実現するには、最小の界面状態密度を持つ金属/ GaN界面が必要です。これは、電子トラップとして機能するか、フェルミ準位を固定することによって金属の仕事関数に従って障壁の高さを調整する制限として機能します[5、6]。他のGaNベースのデバイス改善技術の場合、無極性 m のGaNナノカラムの合体過成長など、いくつかの方法があります。 -平面GaN、ナノインプリントGaNテンプレート、および半極性面GaNナノロッドも実証されています[7、8、9、10、11]。 III族窒化物化合物半導体の中で、窒化アルミニウム(AlN)は、その高いバンドギャップ(〜6.2 eV)、高い熱伝導率、高い電気抵抗、および低い膨張により、UV検出器、短波長エミッター、および検出器に適用できます。高温で[12、13]。さらに、AlNは、原子層堆積(ALD)(〜300°C)によって、相補型金属酸化膜半導体(CMOS)互換プロセスで堆積できます。これは大きな利点です。多結晶およびアモルファスのALD成長AlN膜は、マイクロエレクトロニクスデバイスの誘電体層として使用できます[14]。 AlN成長技術の進歩にもかかわらず、ALD成長AlNは、大量の酸素関連不純物を含む非化学量論的特性を示しています[15]。 AlNの酸素原子の量は、AlNの電気的および光学的特性に大きく影響する可能性があります[16]。
高- k Al 2 などの誘電性酸化物 O 3 およびHfO 2 AlGaN / GaN高電子移動度トランジスタ(HEMT)のパッシベーション層として採用されています[17、18]。しかし、Al 2 でのGa–O結合の形成 O 3 /(Al)GaN界面は、高密度の深い(そして遅い)界面状態を生成することが知られています[19]。低界面状態の代替パッシベーション材料として、AlNは、GaNとの格子不整合が小さいため、GaNベースのデバイスで検討されてきました[20、21]。さらに、非常に薄い酸化物層を挿入することによる金属/半導体(MS)接点のバリア高さなどの電気的特性の変調が、GaNで報告されています[22、23]。 Pt / HfO 2 でのバリア高さの増加 厚さ5nmのHfO 2 を備えた/ GaN金属絶縁体半導体(MIS)ダイオード 層が報告された[22]。 Fe / GaN界面に3nmのMgO層を挿入すると、実効バリア高さが0.4eVに低下することがわかりました[23]。しかし、今でも、GaN上でALDで成長させたAlNとの工学的接触特性について報告している論文の数は限られています。この作業では、さまざまな厚さのALDによってn-GaN上にAlN層を堆積し、AlN / n-GaN界面の特性を調査しました。
メソッド
材料とデバイスの製造
水素化物気相エピタキシー(HVPE)-成長、ドープなし、 c -平面(0001)バルクGaN(厚さ300μm、キャリア濃度5×10 14 cm -3 、貫通転位密度1.5×10 7 cm −2 )この作業では、Lumilogから購入したものを使用しました。ウェーハを細かく切断した後、HCl:H 2 での洗浄プロセスの後、それらの一部をALDチャンバーにロードしました。 O(1:1)ソリューション。次に、温度を350°Cまで上げてAlN層を堆積させました。 AlN薄膜は、トリメチルアルミニウム(TMA)とNH 3 を使用した熱ALDシステム(メーカー:韓国のCN-1、モデル:Atomic Classic)によって堆積されました。 前駆体として。 ALDサイクルの数を変えることにより、3つの異なる厚いAlN層(0.7、1.5、および7.4 nm)を準備しました。 AlNフィルムの厚さは、FS-1多波長エリプソメーター(メーカー:米国のFilm Sense、モデル:FS-1)を使用して測定しました。フィルムの電気的特性を調べるために、MISダイオードをPtショットキー電極(直径500μm、厚さ50 nm)とAlバックコンタクト(厚さ100 nm)で製造しました。参考までに、Pt / n-GaNショットキーダイオード(つまり、AlN層なし)も製造されました。
特性評価
温度依存の電流-電圧( I – V – T )測定は、温度コントローラーに接続されたホットチャックにサンプルを置いた後、HP 4155B半導体パラメーターアナライザーを使用して実行されました。静電容量-電圧( C – V )測定は、HP 4284ALCRメータを使用して実行されました。 X線光電子分光法(XPS)の測定は、単色のAl Καを使用して実行されました。 AlN / GaN界面での形成メカニズムを観察するためのX線源。
結果と考察
図1a–cは、AlN層周辺の断面走査透過電子顕微鏡(STEM)画像を示しています。 AlN層の推定厚さは、エリプソメーターの値と同様でした。典型的な半対数電流密度-電圧( J – V )曲線を図2aに示します。 AlNを含まないサンプル(つまり、参照サンプル)と比較して、電流値は、0.7 nmの厚さのAlNを含むサンプルで増加し、1.5nmおよび7.4nmの厚さのAlNを含むサンプルで減少しました。熱電子放出(TE)モデル[24]を使用して、ショットキーダイオードの順方向バイアス電流輸送を分析し、バリアの高さと理想係数の両方を取得しました。バリアの高さは、0、0.7、1.5、および7.4 nmのサンプルで0.77(±0.03)、0.61(±0.01)、0.83(±0.05)、および1.00(±0.08)eVと計算されました。それぞれ厚いAlN。理想係数は、0、0.7、1.5、および7.4 nmの厚さのサンプルで、1.63(±0.18)、4.19(±0.16)、1.83(±0.33)、および1.57(±0.03)であることがわかりました。それぞれAlN。厚さ0.7nmのAlNを使用すると、バリアの高さが減少し、理想係数が増加しました。より厚いAlN層では、理想係数は同様でしたが、バリアの高さは参照サンプルと比較して増加しました。図2cでは、AlNの厚さが増加するにつれて、バリアの高さが最初に減少し、次に、厚いAlN層によって誘発されるトンネリング抵抗のために増加することが分かる。これは、約0.7nmがAlNの厚さに関するバリア高さのターニングポイントであることを示しています。
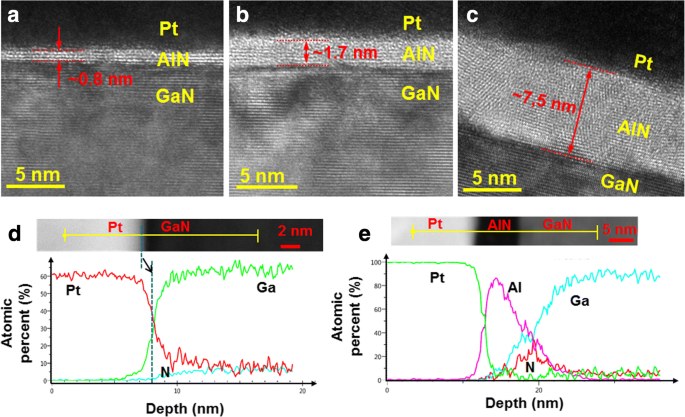
a を使用した断面走査透過電子顕微鏡(STEM)画像 0.7-、 b 1.5-、および c 7.4nmの厚さのAlN。 d 、 e エネルギー分散型X線分光法(EDS)ラインスキャンから得られた原子パーセント対深度プロファイルは、それぞれ0nmと7.4nmの厚さのAlNを使用したサンプルです

a 典型的な半対数電流-電圧( I – V )特性。 b バリアの高さと理想係数のプロット。 c AlNの厚さの関数としてのバリアの高さと理想係数
図3は、 C を示しています。 – V さまざまな周波数で測定された曲線。 AlNの厚さが0および0.7nmの場合、静電容量値の反転が10kHz未満で観察されました。少数キャリア(正孔)の生成率が低いため、通常、GaNのようなワイドバンドギャップ材料では、反転の代わりに深い空乏化が観察されます[25、26]。図3c、dに示すように、このような反転は、より厚いAlN層では観察されませんでした。ここで、Au / GaN接合では、低周波数で反転が観察されなかったことに注意する必要があります。ディープレベルトランジェントスペクトロスコピー(DLTS)を使用して、Auret等。 Pt / n-GaNショットキー接合で観察された電子ビーム誘起欠陥[27]。ここでは、エネルギー分散型X線分光法(EDS)の測定を行い、厚さ0nmと7.4nmのAlNを含むサンプルの深さプロファイルをそれぞれ図1d、eに示します。図1dから明らかなように、Pt原子はGaN層に拡散しましたが、Pt原子のGaN層への拡散はAlN層のために効果的に抑制されました。したがって、GaN表面近くのPt堆積によって誘発された欠陥が低周波数で反転容量を生成し、これらの欠陥の形成が比較的厚いAlN層(> 1.5 nm)で抑制されたことを示唆することができます。
>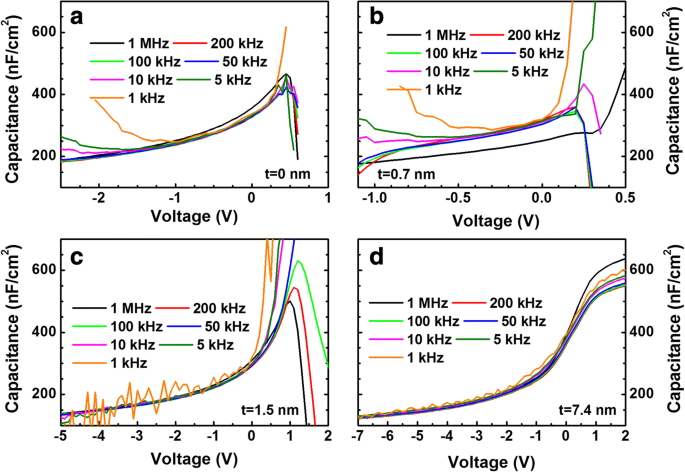
静電容量-電圧( C – V ) a のサンプルについてさまざまな周波数で測定されたデータ 0-、 b 0.7-、 c 1.5-、および d 厚さ7.4nmのAlN
厚さ7.4のAlNのサンプルを除いて、他のすべてのサンプルは C に異常なピークを示しました。 – V ギャップ内の深いトラップの分布、直列抵抗、および界面状態に関連するバイアス電圧の増加に伴う曲線[28、29]。蓄積領域での周波数分散は、界面での不均一な層の形成に関連しています。このような層の静電容量は酸化物の静電容量と直列に作用し、蓄積の分散を引き起こします[30]。枯渇の分散は、適用された周波数に応答するインターフェース状態の存在によるものです。インターフェース状態の時定数が小信号の周波数に匹敵する場合、インターフェース状態は総静電容量に寄与し、周波数が低下するとしきい値静電容量が増加します[31]。
図4は、コンダクタンス-電圧( G )を示しています。 / ω – V )さまざまな周波数で測定された曲線。十分に高い順方向および逆方向のバイアスの下で、活性化された欠陥は、低周波数でより効果的に隣接する界面状態と通信し、したがってコンダクタンスを増加させる可能性があります。およそ-1から0Vの範囲で、すべてのサンプルは周波数の増加とともにコンダクタンスの増加を示しました。この振る舞いは、7.4nmの厚さのAlNを含むサンプルでより顕著になりました。周波数の増加に伴うコンダクタンスの増加は、空乏領域での再結合電流を促進する再結合中心と、高周波で発生する充電および放電電流またはホッピング伝導プロセスを提供する界面状態に関連していました[32]。したがって、結果は、さまざまな時定数を持つ界面状態がすべてのサンプルに存在し、そのような欠陥の存在は、7.4nmの厚さのAlNを持つサンプルで最も重要であることを示しています。
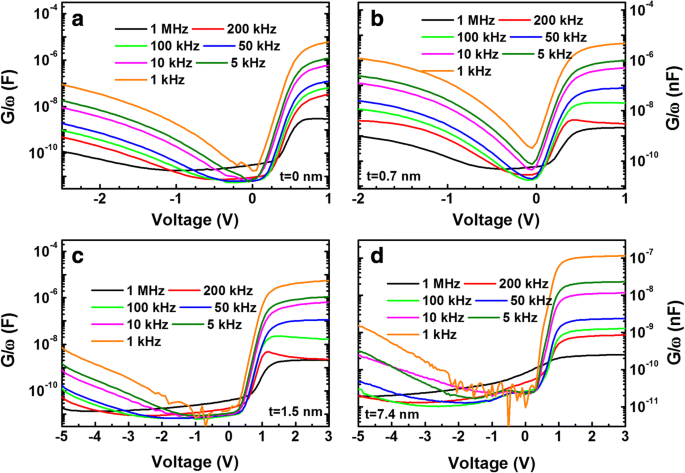
コンダクタンス-電圧( G / ω – V ) a のサンプルについてさまざまな周波数で測定されたデータ 0-、 b 0.7-、 c 1.5-、および d 厚さ7.4nmのAlN
図5aに示すように、界面状態密度の推定値( D それ )は、実験的な C–V にターマン法を適用して作成されました。 1MHzで測定された曲線[33]。得られた D それ 対 E C – E t (インターフェース状態の位置)を図5bに示します。ここでは、 C–V は分析していません。 サンプルに漏れがあり、正確な酸化物静電容量( C )があるため、厚さ0.7nmのAlNを使用したサンプルからの曲線 OX )うまく定義されていませんでした。 7.4 nmの厚さのAlNを含むサンプルは、特に E の場合に、最も高い界面状態密度を示しました。 C – E t > 0.4eV。さらに、平均界面および酸化物トラップ密度( Q T )GaNバンドギャップに沿って( E g ) C を分析して計算しました – V フラットバンド電圧シフト(Δ V )を使用したヒステリシスプロット FB )方程式 Q を介して T =( C OX Δ V FB )/ qE g [34]。小さなフラットバンド電圧シフトと小さなヒステリシスウィンドウは、トラップ密度が低いことを示しています。図4bの挿入図は C を示しています – V ヒステリシスプロット。トラップされた電荷密度は4.2×10 9 と計算されました。 、9.3×10 9 、および3.6×10 11 cm −2 eV -1 それぞれ0、1.5、および7.4nmの厚さのAlNを含むサンプルの場合。ヒステリシスは、AlN / GaNの界面トラップとAlN層の境界(またはバルク)トラップに起因する可能性があります。ターマン法と同様に、厚さ7.4 nmのAlN層は、最高の界面と酸化物トラップ密度を示しました。したがって、このサンプルでは、AlN層の境界トラップと界面トラップが C のシフトに大きく寄与していることを示唆することができます。 – V プロット。
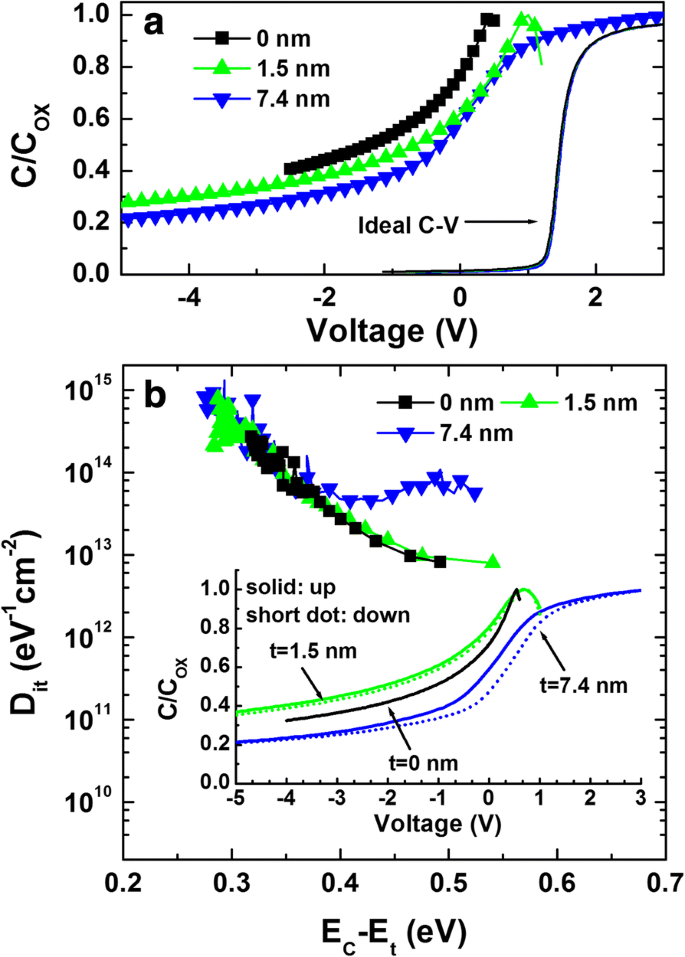
a 実験的な静電容量と電圧の比較( C – V )1 MHzおよび理想的なC– V で測定されたデータ データと b 界面状態密度( D それ )0、1.5、および7.4nmの厚さのAlN層を持つサンプルにターマン法を適用して決定された分布。 b の挿入図 C を示しています – V 1MHzで測定されたヒステリシスプロット
AlN / GaN界面での化学組成は、0.7nmと7.4nmの厚さのAlNを含む2つのサンプルのXPS測定を使用して調査されました。ここでは、AlNの厚さが厚すぎてAlN / InP界面付近の正確な情報を取得できないため、7.4nmの厚さのAlNを使用してサンプルに対してスパッタエッチング処理を実行しました。ベアGaNも参照として表面スキャンされました。図6aは、厚さ7.4nmのAlNを含むサンプルから得られた各元素のXPS深度プロファイルを示しています。 AlN層へのGa原子の拡散がはっきりと見られた。かなり大量の酸素原子がAlN層全体に存在することがわかりました。ただし、O原子とAl原子の両方がAlN / GaN界面の近くでは十分に観察されませんでした。 AlN / GaN界面と比較して、AlN表面近くの酸素量が多いことは、そのかなりの部分が、ALD堆積プロセス自体ではなく、大気酸化に起因することを示しています。次に、1つのエッチング深さ(残りのAlNの厚さは約1.5〜2.0 nm)でスキャンされた狭いXPSスペクトルを選択し、他のサンプルのデータと比較しました。図6bは、Ga 2 p を示しています。 3/2 コアレベルのスペクトル。裸のGaNと0.7nmの厚さのAlNを含むサンプルの両方で、〜1118.0 eVと〜1119.2 eVのピークは、GaNとGa 2 に関連付けられています。 O 3 、それぞれ[35、36]。 7.4 nmの厚さのAlNを含むサンプルの〜1117.4 eVのピークは、GaがAlNに結合しているためです[37]。ただし、Ga 2 からのものである可能性を排除することはできません。 Oピーク(〜1117.3eV)[38]。

a 厚さ7.4nmのAlNを含むサンプルから得られた各元素のXPS深度プロファイル。 b のXPSコアレベルスペクトル Ga 3 p 3/2、 c O 1 s 、および d Al 2 p 厚さ0、1.5、および7.4nmのAlNを含むサンプルの場合
図6cに示すように、〜530.2および〜531.9 eVのピークは、化学吸着されたOおよびGa 2 に起因します。 O 3 、それぞれ[39]。さらに、〜532.8eVのピークはAl–OHに関連しています[40]。ただし、選択した深さで7.4 nmの厚さのAlNを含むサンプルでは、特異なピークは観察されませんでした。同様に、より深いエッチング深さでピークは観察されなかった(示されていない)。 AlNの厚さが薄い場合(0.7 nm)、化学吸着された酸素原子は除去されましたが、Al原子はOHと結合していました。 AlNの厚さを増やすと、GaN表面領域の近くに酸素原子がほとんど存在せず、クリーンアップ効果を示しています。ただし、酸化物電荷を提供するために、大きくなりすぎたAlN領域に大量の酸素原子が存在していました。 O 1 s Ga原子の量が無視できるエッチング深さ(図6aのAlN表面から約0〜3 nm)でのコアレベルのスペクトルは、Al 2に関連する〜531.8eVで支配的なピークを示すことがわかりました。 O 3 [41]。これは、AlN層の一部がAl 2 で構成されていることを意味します。 O 3 。図6dに示すように、AlNに関連するピークは、0.7nmの厚さのAlNを含むサンプルではよく観察されません。むしろ、AlO x に関連して、〜74.1および〜75.6eVに2つのピークが観察されます。 それぞれAl–OH [42]。 AlO x などのこれらのAl–O結合関連のピーク また、Al–OHは欠陥として機能する可能性があります。厚さ7.4nmのAlNを含むサンプルの〜73.6 eVのピークは、AlNに関連しています[43]。
厚さ0.7nmおよび7.4nmのAlNを含むサンプルの電流輸送特性は、温度依存の電流-電圧( I )を使用してさらに調査されました。 – V – T )測定。図7に示すように、0.7 nmの厚さのサンプルでは、順方向バイアス電流と逆方向バイアス電流の両方が同程度に増加しました。ただし、厚さ7.4 nmのAlNを使用したサンプルの場合、逆方向のリーク電流は順方向の電流よりも温度に依存していました。逆バイアス下では、温度が高くなると、深いレベルからAlN価電子帯への正孔の熱放射が発生し、電子の別の供給が導入される可能性があります[44]。不均一バリアモデル[24]によると、温度依存の有効バリア高さ(φ B )は、ゼロバイアスの平均バリア高さ(\({\ overline {\ varphi}} _ B \))と標準偏差(σ)に関連しています。 0 )as \({\ varphi} _B ={\ overline {\ varphi}} _ B-q {\ sigma_0} ^ 2/2 kT \)。 σ 0 値は、0.7nmと7.4nmの厚さのAlNを含むサンプルでそれぞれ0.147Vと0.204Vとして得られました。これらの値を使用して、ln( I の修正されたリチャードソンプロット 0 / T 2 )− q 2 σ 0 2 / 2 k 2 T 2 vs. 1 / kT 図8aに示すように得られた。縦座標の切片は、 A のリチャードソン定数を生成しました ** 397.3および27.1A cm −2 として K −2 それぞれ0.7nmと7.4nmの厚さのAlNを含むサンプルの場合。厚さ7.4nmのAlNを含むサンプルの値は、理論値の26.4 A cm -2 と同様です。 K −2 n-GaNの場合、TEモデルとのバリアの不均一性が電流輸送を説明できることを示しています。ただし、AlNの厚さが0.7 nmのサンプルでは、理論値に比べて値が高すぎるため、バリアの不均一性を含めてもTEモデルでは電流輸送を説明できないことを示しています。図8bは、 nkT の値を示しています。 kT の関数として 。傾きが1.15の直線は、TEモデルを使用した厚さ7.4nmのAlNのサンプルの実験データとよく一致します。ただし、AlNの厚さが0.7 nmのサンプルの場合、傾きは5.11であることがわかりました。単一性からのこのような大きな逸脱は、界面状態、絶縁体層、およびトンネル電流から生じる可能性があります。
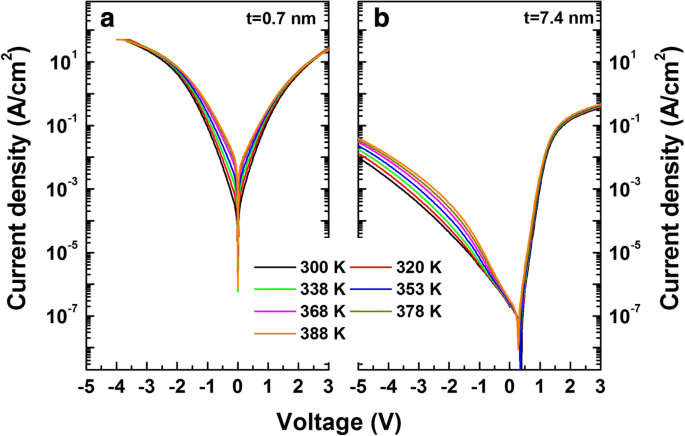
温度依存の電流密度-電圧( J – V ) a のサンプルの特性 0.7-および b 厚さ7.4nmのAlN
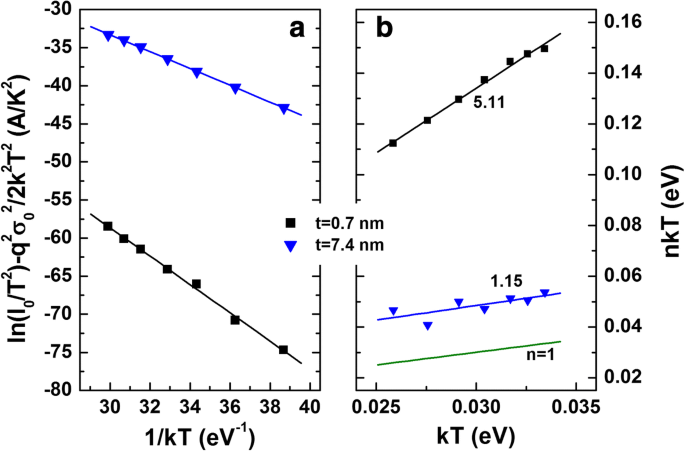
a 修正されたリチャードソンプロットと b nkT 対 kT 実験データへの線形フィットでプロットします。 b で 、傾きが1の線( n =1)も参照として含まれています
逆リーク電流密度は、[45]によって与えられたFowler-Nordheim(FN)トンネリングモデルを使用して分析されました。
$$ J =\ alpha {E} ^ 2 \ exp \ left(-\ beta / E \ right)$$(1)ここでα =1.54×10 −6 / m ∗ Φ B およびβ =6.83×10 −7 ( m ∗ ) 1/2 (Φ B ) 3/2 ; m * ( m * =0.30(AlNの場合[46])は、絶縁体の有効電子質量であり、Φ B トンネル障壁の高さです。図9a、bは、バイアス電圧がそれぞれ-0.9Vおよび-3Vより高い場合に、厚さ0.7nmおよび7.4nmのAlNのサンプルでFN発光が観察されたことを示しています。 7.4 nmの厚さのAlNを使用したサンプルの電圧が高いのは、AlNが厚いほどトンネル電圧を高くする必要があるためです。図9に示されている勾配から、各温度のトンネル障壁の高さが決定されました。これは、図9bの挿入図に示されています。室温で、0.7nmと7.4nmの厚さのAlNを含むサンプルのバリア高さは、それぞれ約1.67eVと0.78eVと計算されました。これらの値は、AlN / GaN界面で報告されている2.58eVの伝導バンドオフセットよりも低くなっています[47]。 AlN / GaN界面付近の界面品質が悪いと、そのような低い値が生成される可能性があります。 7.4 nmの厚さのAlNを含むサンプルのバリア高さが低いことは、AlN / GaN界面付近の高い界面と酸化物トラップ密度、およびAlN層の酸素関連の欠陥にも関連している可能性があります。その結果、トラップ支援トンネリングがより簡単に発生し、逆リーク電流が増加しました。
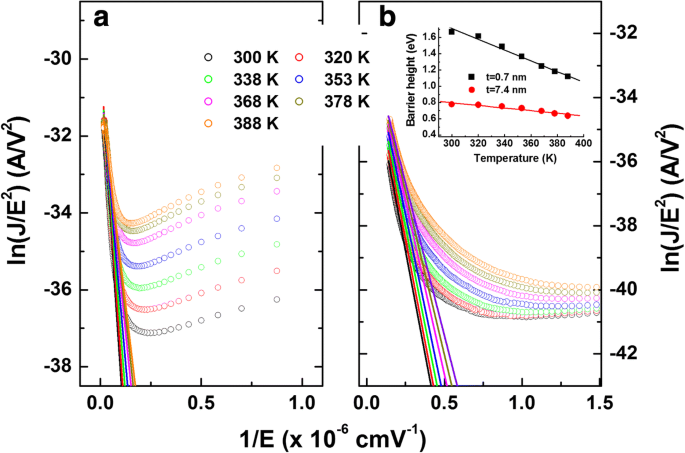
ln( J のFowler–Nordheim(FN)トンネリングプロット / E 2 )vs。1/ E a のサンプルの実験データに線形フィットします。 0.7-および b 7.4nmの厚さのAlN。 b の挿入図 計算されたバリアの高さを温度の関数として表示します
プール-フレンケル(PF)放出モデルは、[48]で与えられる逆リーク電流にも適用されました。
$$ \ ln \ left(J / E \ right)=m(T){E} ^ {1/2} + b(T)\ Big)$$(2)と
$$ m(T)=\ frac {q} {kT} \ sqrt {\ frac {q} {{\ pi \ varepsilon} _0 {\ varepsilon} _ {\ mathrm {AlN}}}}、b(T) =-\ frac {q {\ varphi} _t} {kT} + \ ln C $$(3)ここで、 ϕ t はトラップ状態からの電子放出障壁の高さ、ε AlN は、高周波(ε)でのゲート絶縁体の比誘電率です。 AlN 4.77 [49])、ε 0 は自由空間の誘電率であり、 C 定数です。線形係数 m の温度依存性をチェックすることにより、PFエミッションフィッティングの妥当性を検証しました。 ( T )PFプロットの線形近似から得られたln( J / E ) E の関数として 1/2 [50]、これは図10に示されています。 m から ( T )これらのプロット(図10aの挿入図)への線形フィッティングから得られた値、ε AlN 厚さ0.7nmと7.4nmのAlNを含むサンプルでは、それぞれ64.9と959.0であることがわかりました。得られた値は、理論値4.77と比較して高すぎます。これは、PF放出が両方のサンプルの電流輸送を正しく説明できないことを示しています。したがって、FNトンネリングは逆リーク電流のより適切な輸送メカニズムです。
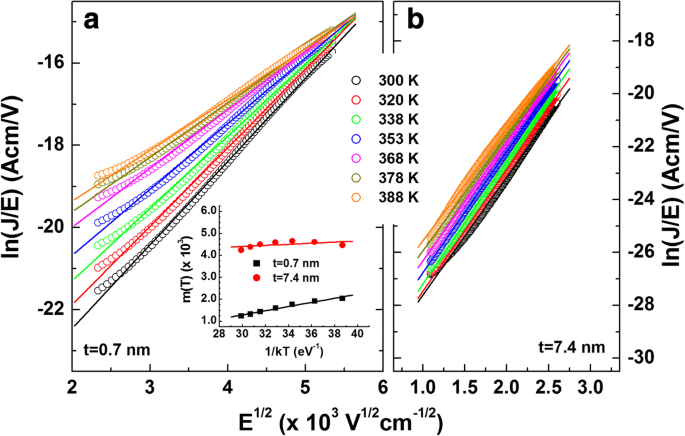
ln( J のプール-フレンケル(PF)放出プロット / E )対 E 1/2 / a のサンプルの実験データに線形フィットします。 0.7-および b 7.4nmの厚さのAlN。 a の挿入図 計算された m を表示します ( T )値と温度
式が(1)は温度依存性を含まず、得られたバリア高さは温度の上昇とともに減少しました。傾きは、0.7nmと7.4nmの厚さのAlNを含むサンプルで、それぞれ-6.67 meV / Kと-1.62meV / Kとして得られました。 SiO2 / 4H-SiC構造では、FNトンネリングが-7.6 meV / Kの傾きを持つ温度依存性を持っていることが報告されています[51]。 Pt電極から放出された電子は、フェルミ-ディラック分布[52]に従ったため、トンネル効果による逆リーク電流も温度とともに増加する可能性があります。この場合、AlN層が薄いほど、温度による上昇が大きくなります。
一方、高電界での電流輸送メカニズムは、FNトンネリングだけでは説明できないことが報告されています[53、54]。基板の酸化物とフェルミ準位の電荷の変化、およびSiO 2 での電子エネルギー分布も含まれます。 / SiCインターフェースと温度、SiO 2 の逆リーク電流 / 4H-SiCは十分に説明されていませんでした[53]。界面電子トラップからのトラップされた電子の熱的に活性化されたPF放出が漏れ電流の増加に大きく寄与することが提案された[54]。したがって、ALDプロセス中のAlNのこのような欠陥を減らすことは、特に高温動作中のAlN / GaNベースのデバイス性能において非常に重要です。
図2cのバリア高さ対AlN厚さのプロットからわかるように、Li etal。 Y 2 との金属/ n-Ge接触で同様の挙動が観察されました O 3 レイヤー[55]。彼らは、バリアの高さの減少は、不安定なGeO x の抑制に起因すると考えました。 Ge表面のダングリングボンドの成長と不動態化。 Karpov etal。挿入されたSi 3 N 4 Ni / n-GaN接点に層を形成し、バリアの高さがSi 3 で0.78から0.27–0.30eVに減少することを発見しました。 N 4 層。結果は、Si 3 での双極子形成によって説明されました。 N 4 / GaNインターフェース[56]。さらに、鄭ら。接触抵抗とAl 2 の比較を調査しました O 3 Al / n-SiC構造の厚さであり、1.98nmの厚さで界面双極子が形成され始めたことを発見しました[57]。この厚さを超えると、接触抵抗は最初に双極子効果のために減少し、次にトンネル抵抗の増加のために増加しました。図6のXPSデータによると、AlN層の形成は0.7nmの厚さのAlNのサンプルでは不明です。したがって、0.7 nmの厚さのAlNによるバリアの高さの減少は、界面双極子の形成ではなく、不動態化効果による可能性が高くなります。
誘導結合プラズマ(ICP)エッチングなどのドライエッチングプロセスは、紫外線で強化されたウェット化学エッチングが実証されているにもかかわらず[59]、GaNの化学的安定性のためにGaNベースのデバイスで広く使用されています[59]。ただし、ドライエッチングプロセスは、GaN表面に損傷を引き起こし、リーク電流を増加させ、整流動作を低下させる可能性があります。反応性イオンエッチング(RIE)後の熱アニーリングとKOH溶液を使用したエッチング後処理は、GaNの表面損傷を効果的に除去することがわかりました[60]。これまでの結果を踏まえると、エッチングされたGaN表面の損傷を低減するためにAlN蒸着(1 nm以上)を適用できることを提案します。これにより、界面品質と整流特性がさらに向上することが期待されます。
結論
異なるAlN厚さのn-GaN上に原子層堆積AlNの界面および電気的特性を調査しました。静電容量-電圧( C – V )特性として、厚さ7.4 nmのAlNを含むサンプルは、最高の界面と酸化物トラップ密度を示しました。 X線光電子分光法(XPS)測定によると、0.7 nmの厚さのAlNを含むサンプルは、Al–O結合に関連する支配的なピークを示し、AlNに関連する明確なピークはありませんでした。 GaN表面近くに残っている酸素原子は、7.4nmの厚さのAlNを含むサンプルではごくわずかであることがわかりました。一方、AlN層全体に多くの酸素原子が存在することがわかり、AlN層に酸素関連の欠陥が生じました。逆リーク電流の分析により、0.7nmおよび7.4nmの厚さのAlNを使用したサンプルの電流輸送を説明するには、Poole-Frenkel(PF)放出よりもFowler-Nordheim(FN)放出の方が適切であることが明らかになりました。
略語
- ALD:
-
原子層堆積
- AlN:
-
窒化アルミニウム
- C – V :
-
静電容量–電圧
- FN:
-
ファウラー–ノルドハイム
- J – V :
-
電流密度-電圧
- PF:
-
プール–フレンケル
- TE:
-
熱電子放出
- XPS:
-
X線光電子分光法
ナノマテリアル
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- ナノ粒子の毒性の物理的および化学的性質への依存性
- ポリマーナノコンポジットの界面/相間特性および引張強度に及ぼすナノ粒子のサイズおよび凝集/凝集の影響



