自己組織化ZnOナノワイヤネットワークチャネルの容易な製造とそのゲート制御UV検出
要約
組み立てられた酸化亜鉛ナノワイヤー(ZnO NW)ネットワーク電界効果トランジスタ(FET)に基づいて、ゲート制御可能なUVセンサーのアレイを製造する簡単な方法を示します。これは、非極性領域を避けて極性領域で分子表面プログラムパターン化と選択的NWアセンブリの両方を組み合わせ、続いてNW間の安定した接触を確保するために300°Cで熱処理することによって実現されました。 ZnO NWネットワークFETデバイスは、オンオフ比が10 5 の典型的なn型特性を示しました。 、相互コンダクタンスは約47 nS、移動度は約0.175 cm 2 V − 1 s − 1 。さらに、デバイスは、印加されたゲート電圧によって制御できるUV光に対して光応答挙動を示しました。光応答性は、チャネル電圧 V に直線的に比例することがわかりました。 ds 、 V で最大の光応答性を示します ds =7V。
背景
一次元ナノ材料は、比表面積が大きく、配向が均一な結晶構造であり、高いデバイス性能と簡単なデバイス製造を可能にする有向電荷輸送経路により、他のフィルムタイプまたはかさばる材料に比べてさまざまな利点があることがよく知られています[1 、2]。特に、その独自の寸法により、半導体ナノワイヤ(NW)は、エネルギー変換、メモリ、光学デバイス、センサーなどのさまざまなアプリケーションで利用されてきました[3,4,5,6,7,8,9]。その中で、酸化亜鉛(ZnO)NWは、3.37 eVの大きな直接バンドギャップと、室温で60meVの高い厳密な結合エネルギーを備えた優れた半導体特性を示しています[10]。また、ZnOは環境に優しく、自然に豊富で、製造コストが低いことが知られています[11]。したがって、ZnOは、発光ダイオード[12、13]、レーザーダイオード[14]、太陽電池[15、16、17、18]、光検出器[19、20、21、22]などのさまざまな分野に適用されてきました。 、23]、透明電界効果トランジスタ[24、25、26]、ジェネレータ[27、28]、および化学センサー[29、30]。一方、ZnO NWに基づくUVセンサーが実証されていますが[31、32、33]、デバイスの製造は困難でした。 ZnO NWネットワークデバイスを製造するこれらの方法は、一般に、電極堆積されたZnO NWコーティング膜と、それに続くチャネルを規定するためのエッチングプロセスを含む。この方法では、ZnOチャネル幅の調整などの物理的寸法を制御することは困難です。これらの問題を克服するために、事前にパターン化された層上でのZnO NWの水熱成長の方法が研究されてきたが、追加のエッチングおよび/または水熱成長プロセスが必要である。レーザー誘起選択的成長[34、35]や局所ヒーターを使用したZnO NWの熱水成長[36]など、現在提案されているZnOナノワイヤーのパターニング方法には、高コストで高温のプロセスが含まれます。垂直方向に成長したZnOナノワイヤアレイネットワークを使用して、デバイスのプロパティを制御できる整列したナノワイヤアレイネットワークを使用する場合もありますが[37]、これもCVDなどの真空装置を必要とするために多大な労力を必要とし、大面積で低コストの生産。マイクロコンタクトプリンティング[38]またはインクジェット印刷[39]に基づく低コスト生産を伴ういくつかの低温プロセスが提案されましたが、NW密度および対応するデバイス特性の制御は依然として課題として残っています。
この作業では、分子パターン基板上の自己組織化と熱処理を使用して、ZnO NWネットワーク電界効果トランジスタ(FET)に基づくゲート制御UVセンサーのアレイを製造するための再現性が高く簡単な方法を示します。 ZnO NWネットワークチャネルのデバイス歩留まりは90%で、平均抵抗値は数百kΩです。後熱処理は、残留有機溶剤を除去し、北西部間の電気的接触を強化する効果があると考えられています。 ZnO NWベースのFETデバイスは、オンオフ比が10 5 のn型特性を示しました。 、相互コンダクタンスは約47 nS、移動度は約0.175 cm 2 V -1 s -1 。物理的特性は、分子パターン、溶液中のNW密度、引っ張り速度などのNWアセンブリ条件を変更することで制御できます。最後に、印加されたゲート電圧によって制御可能な光応答性と応答時間を備えたZnOUVセンサーのアレイを実現することに成功しました。 n型FETに印加される負のゲート電圧は、ZnONWチャネルの空乏化による初期電流を最小限に抑えました。実際、UV光に対する最大の光応答性は-55 V未満のゲート電圧で見られ、光応答性はチャネル電圧 V に比例することがわかりました。 ds 、 V で最大の光応答性を示します ds =7V。さらに、負のゲート電圧により、UV露光後のデバイスの回復が容易になりました。 ZnO NWネットワークデバイスに関する以前の報告が報告されているが[34、35]、当社のZnO NWデバイスは、化学的またはプラズマエッチングプロセスを使用せずに制御可能なチャネル幅および厚さを有するZnO NW構造を有することに留意されたい。この穏やかなプロセスとZnO再結晶温度(〜400°C)未満の熱処理を組み合わせることで、高いオンオフ比と光応答性を備えたゲート制御UVセンサーの大規模で簡単な製造が実現しました。私たちのプロセスとデバイスのパフォーマンスにより、ZnONWベースのアプリケーションの商用化プロセスが促進されることを期待しています。
メソッド
ZnONWネットワークFETの製造
長さ2〜3 µm、直径200nmのZnONWは、米国のSigma-Aldrich、Inc。から購入しました。 NWは、3秒間の超音波処理により、ジクロロベンゼン(DCB)に1 wt%の濃度で分散されました。分子パターン化された基板を準備するために、フォトレジスト(AZ 5214E)は、典型的なフォトリソグラフィー法によって、SiO2(500μm厚のpドープSiウェーハ上の300 nm厚のSiO2)基板上にパターン化されました。次に、基板を1:500 v に浸しました。 / v ヘキサン中のオクタデシルトリクロロシラン(OTS)約3分[40]。このプロセス中に、OTS分子の単分子層が露出したSiO 2 の表面に自己組織化されました。 非極性OTS領域を作成する領域。 OTS処理後、基板をアセトンに2分間浸して、フォトレジストで保護された領域を除去し、極性SiO 2 を露光しました。 ZnONWが組み立てられる領域。自己組織化OTS単分子層は、非極性領域となるメチル末端を持っています。一方、SiO2表面は、そのヒドロキシル基(OH)からの極性領域として機能します。 ZnO NWアセンブリの場合、基板をNW溶液に浸し、0.5〜10 mm min -1 の範囲で制御された引っ張り速度で引っ張りました。 。 ZnO NW溶液は、NWの凝集と沈殿を防ぐために、100rpmでのプルプロセス中に磁気バーで攪拌されました。基板が引っ張られると、蒸発は空気-サスペンション-基板界面の近くで最も速く進行し、極性SiO 2 へのZnONWの選択的吸着をもたらしました。 非極性OTS領域を避けながら、ファンデルワールス力による領域。基板上にZnONWを組み立てた後、電極(Ti / Al、10/300 nm)を熱蒸着、続いてリフトオフプロセスで蒸着しました。
熱処理プロセス
熱処理は、炉内のAr周囲で1Torrの圧力で実行されました。残りの溶媒を蒸発させるために、温度を3分間で110°Cに上げ、10分間一定に保ちました。次に、温度を3分間で300°Cに上げ、10分間一定に保って、北西間のインターフェースを改善し、北西間の潜在的な障壁と接触抵抗を減らしました[41]。その後、サンプルを1時間かけて室温まで冷却し、炉から取り出しました。
ZnONWネットワークFETの電気的および光応答特性の測定
I–V特性やゲート特性などの電気的特性は、半導体パラメータアナライザを備えたプローブステーション(4200A-SCS、米国ケースレー)を使用して測定しました。ソース-ドレイン電圧を0Vから7Vまでスキャンしました。ゲート電圧を-60Vから+60 Vまで掃引しました。ゲートに依存するI-V特性から、相互コンダクタンスと移動度の値を計算しました[42、43]。 。 NWチャネルの抵抗に対する周囲の影響を回避するために、測定中、温度と相対湿度はそれぞれ23±1°Cと35±1%で一定に保たれました。 UV光応答測定の場合、ソース-ドレイン電圧 V ds UV光源は、励起波長365 nm、出力密度350 µW cm -2 のハンドヘルドUVランプ(Spectroline ENF-260C / FE、米国)でした。 。
結果と考察
図1は、パーコレーションZnONWネットワークチャネルの準備とその後の熱処理を説明する概略図を示しています。まず、OTSパターンの基板をZnO NW懸濁液(ジクロロベンゼン中1 wt%)に浸し、自家製の引っ張りシステムを使用して、0.5 mm min -1 のさまざまな引っ張り速度でZnONW懸濁液から引っ張りました。 〜10 mm min -1 (追加ファイル1:図S1)。引っ張りプロセス中に、ZnONWを含む液体メニスカスがOTSパターンの基板に対して引きずられました。露出したSiO 2 上でのみ組み立てられたZnONW チャネル領域。図2aの挿入図に示すように、合計100台のデバイスが、当社の製造方法を使用して4インチウェーハ上に製造されました。図2aは、パーコレーションするZnO NWネットワークチャネルの光学画像を示しています。挿入図は、FETデバイスアレイを示しています。 ZnONWの平均直径は200nm、NWの長さは2〜3 µm、チャネルの長さと幅はそれぞれ6 µmと20 µmでした。 ZnO NWアセンブリの後、ソース-ドレイン電極は、従来のフォトリソグラフィー技術、金属(10 nm Ti、300 nm Al)の熱蒸着、およびリフトオフプロセスによって作成されました。

ZnONWネットワークFETの製造手順の概略図。プルプロセスを使用した分子パターン基板上のZnONWのアセンブリ
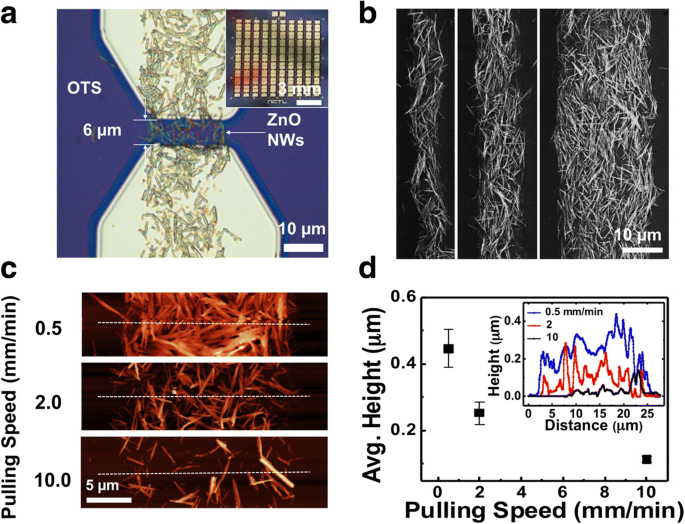
ZnONWネットワークFETデバイスのチャネル形成と厚さ制御。 a 長さ6μmのNWネットワークチャネルとAl電極の拡大光学画像。挿入図は、マイクロパターン化されたチャネルを備えた10×10アレイデバイスの光学顕微鏡写真です。 b 走査型電子顕微鏡(SEM)画像は、5、10、および20μmのさまざまな線幅の線パターンへのZnONWの選択的アセンブリを示しています。 c ZnONWsネットワークのAFM画像。 d 0.5〜10 mm min -1 のさまざまな引っ張り速度での高さと引っ張り速度の平均分布 。挿入図は、0.5、2、10 mm min -1 のさまざまな引っ張り速度でのAFM高さプロファイルを示しています。
図2bに示すように、SiO 2 を変更することにより、5、10、および20μmのさまざまな線幅のZnONWパターンを取得することができました。 領域パターンサイズ。周囲のOTS領域は、OTS分子のメチル末端のために無極性です。 NWは、極性SiO 2 にのみ吸着されると考えられています。 ファンデルワールス相互作用による領域[40]。 ZnO NWの選択的アセンブリは、エネルギー分散型X線分光法(EDS)でも確認されました(追加ファイル1:図S2を参照)。ここでは、Zn信号はZnONWのある領域に限定されていました。
厚さや密度などの浸透するZnONWネットワークチャネルの物理的特性は、NWアセンブリ中にNWソリューションからの基板の引っ張り速度を調整することによって制御されました。図2cは、0.5、2、および10 mm min -1 のさまざまな引張速度で組み立てられたZnONWネットワークのAFM(原子間力顕微鏡)画像を示しています。 。平均高さプロファイルと引っ張り速度を図2dに示します。 NW密度は1.21NWμm -2 でした。 引っ張り速度0.5mm min -1 、および0.09NWμm −2 10mm分で -1 。引っ張り速度を下げることにより、NWチャネルの厚さが増加しました。 NWチャネルの高さは、通常、最も遅い速度0.5 mm min -1 で、単一のNW平均直径200 nmの約1.5〜2倍でした。 (図2d、挿入図)。引っ張り速度10mm min -1 、ネットワーク接続がパーコレーション制限に達し、それを超えるとネットワークは接続を示しませんでした。 ZnO NWネットワークデバイスを製造する現在の方法は、一般に、電極堆積ZnO NWコーティングされたフィルムと、それに続くチャネルを定義するためのある種のエッチングプロセスを含む[38、39]。この方法では、ZnOチャネル幅の調整などの物理的寸法を制御することは困難です。これらの問題を克服するために、事前にパターン化された層上でのZnO NWの水熱成長を使用する方法が研究されていますが[44、45]、追加のエッチングプロセスおよび/または時間とコストを要する水熱成長プロセスも必要です。対照的に、私たちの方法では、事前にOTS分子でチャネルをパターン化し、プルシステムを介してNWを組み立てることで、チャネルの幅と長さを簡単に制御できます。
電気的特性は、引っ張り速度を調整することによっても制御できます。図3は、熱処理前の電気的特性を示しています。図3aは、さまざまな引っ張り速度でのI–V特性の変化を示しています。引っ張り速度を2から0.5mm min -1 に下げたとき 、初期電流は1Vで5から50nAに増加しました。これは、おそらく、チャネル内のNW密度の増加に伴うネットワーク接続の増加によるものです。 2 mm min -1 で製造されたZnONW FETの典型的なゲート依存I–V特性曲線 引っ張り速度を図3b、cに示します。図3bは、さまざまなゲート電圧 V でのI–V特性を示しています。 g 値(-20Vステップで-60Vから60Vまで)。 私 ds - V g 図3cのゲート特性は、典型的なn型特性を示しており、オンオフ比が3pAのオフ電流から556nAに5桁増加し、引張速度が0.5から2mmに増加するとオフ電流が減少します。 min -1 (追加ファイル1:図S3を参照)。膜密度の減少に伴うこのオンオフ比の増加は、NWチャネルを薄くするにつれてチャネルがバックゲートからの電界の影響をより受けていることに注目することで説明できます[46]。また、引っ張り速度は、デバイスの歩留まりと2プローブの抵抗度数分布に影響します(追加ファイル1:図S4)。抵抗は、28.2±4MΩの平均値を示し、0.5 mm min -1 で〜92%の歩留まりを示します。 。ただし、分布は877±280MΩにシフトし、2 mm min -1 で約78%の収率になります。 引っ張る速度。ここで、歩留まりは、機器のノイズを超える測定可能な抵抗値を持つデバイスの数の割合として定義されます。
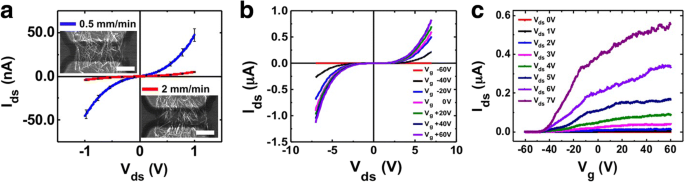
引っ張り速度の制御によるZnONWネットワークの接続性と電気的特性。 a 引っ張り速度0.5および2mm min -1 のZnONWsネットワークFETの電気的特性 。 0.5および2mm min -1 のさまざまな引張速度で製造されたデバイスの一般的な電流-電圧特性 。ネットワークチャネルは、-1〜1 Vのショットキー接触を示しました。挿入図は、0.5(左上)および2(右下)mm min -1 でのネットワークチャネルのSEM画像です。 。どちらの場合も、スケールバーは10μmです。 b さまざまなバックゲート電圧の電流-電圧特性。 V g 20Vステップで-60Vから60Vの範囲でした。 c 私 ds vs V g さまざまな V で製造されたZnONWネットワークチャネルの関係 ds 。 V ds 1 Vステップで0〜7Vの範囲
ここで、FETのゲート特性はクリーンな飽和領域を持っていません。以前の報告によると、おそらく複雑なNWネットワークパス、大きな表面積、およびNW接合部での粒界によるキャリア散乱の増加が原因で、ZnONWネットワークはクリーンな飽和レジームを示しませんでした[47]。私たちのZnONWネットワークは、ソースとドレインの間にいくつかのパスを形成します。また、最大約0.4μmの厚さのZnO NWネットワークチャネル(図2d)。ナノワイヤの厚さが不均一であると、各ナノワイヤのゲートまでの距離が異なり、変調の程度がわずかに異なります。したがって、FETの特性には、単一のナノワイヤFETのようなクリーンな飽和領域がありません。
製造されたままのデバイスの電気的特性は、電気的特性の均一性を改善し、NW間の接触抵抗をさらに下げるために、その後の熱処理プロセスによって強化することができます[41]。熱処理は、100 sccmのArガスを流しながら、300°Cで10分間の低圧条件で実行されました(追加ファイル1:図S5を参照)。図4は、2 mm min -1 で製造されたサンプルの電気的特性の変化を示しています。 引っ張る速度。熱処理後、1Vバイアスでの電流は600nAから6.5μAに増加しました(図4a)。図4bの抵抗度数分布は、平均抵抗が877±280MΩから207±37kΩに約3桁低下していることを示しています。また、おそらくNW間の電気的接触が強化されたため、デバイスの歩留まりは78%から90%に増加しました。熱処理によるNW接続強化の利点を活用することに焦点を当てました。このため、ZnOが再結晶する400°Cを超えて温度を上げることはありませんでした。このような再結晶は、UV照射中のZnO表面での酸素の脱離および吸着特性に影響を与えることが報告されています[41]。そのため、熱処理によりNW間の接続性を改善するために、300°Cまで熱処理を行い、NW間の界面を改善しました。これにより、電気的安定性と特性が向上しました。プロセス温度がHMTAの融点(290°C)よりも高いため、熱処理プロセスによって水分やヘキサメチレンテトラミン(HMTA)などの吸着分子が除去される可能性があると考えています。これにより、NW間の接合が改善され、水分などのNWのパフォーマンスを低下させる他の吸着分子が除去されるため、NWFETのパフォーマンスが向上しました。

熱処理後のZnONWネットワークの電気的特性。 a 引張速度2mm min -1 のアニーリング前後の典型的な電流-電圧特性 。ネットワークチャネルはSchottkyの接触動作を示しました。 (挿入図)アニーリング前のI–V特性、拡大。 b 2 mm min -1 の速度で引っ張られたZnONWネットワークの抵抗度数分布 。平均抵抗は約3オーダー減少しました。 ( c )さまざまなバックゲート電圧でのI–V特性。 V g 20Vステップで-60Vから60Vの範囲でした。 d I の電気的性質 ds vs V g 熱処理後。 e I の比較 / 私 オフ 異なる V での比率 g 熱処理前後の値( V g ステップ=5 V)。 f 熱処理による相互コンダクタンスの改善
典型的な I ds - V ds および私 ds - V g ZnO NW FETの特性曲線を図4c、dに示します。図4eは、 I ds - V g 特性曲線は熱処理前後で類似しており、最大 I on / I オフ 比率は〜2×10 5 。これは、熱処理によってNW間の接続が改善されて抵抗が低下するだけであり、固有の電気的特性に変化が生じないことを示しています。図4fは、相互コンダクタンス dI の改善を示しています。 ds / dV g 熱処理後。これは、ZnONWデバイスの電子移動度の向上に起因する可能性があります。最大相互コンダクタンス( g m =dI ds / dV g )は、 I の最大勾配から抽出されました。 ds - V g V ds の7Vでの特性と最大オンオフ比 。 (追加ファイル1:図S6)。計算された最大相互コンダクタンスは、 V で〜47nSでした g =−30V。式μを使用しました = g m ・ L /( W ・ C d ・ V ds )推定移動度計算[48]。移動度は0.175cm 2 と計算されました V -1 s -1 。これは、以前に報告された0.018 cm 2 の値に相当します。 V -1 s -1 ZnONWsデバイスアレイの使用[49]。
最後に、ZnOネットワークFETのUV光応答とゲート電圧への依存性を観察しました。図5aは、さまざまなゲート電圧(-20Vステップで-60Vから60Vまで)でのUV照明によるI-V特性を示しています。 私 ds -V g 図5bのUV照明下の特性は、オンオフ比の低下を示しています。 UV光は、光励起キャリアを生成することにより、n型FETデバイスのオフ電流を増加させる効果がありました。図5cは、UVライトのオンとオフの状態で測定された電流の違いを示しています。 UV光応答性( I <サブ>ライト / I 暗い :暗電流に対する光電流の比率)は、印加されるゲート電圧によって異なり、8.6×10 5 の最大比率値を示します。 V g で − 55V以下。図5cの挿入図は、 I を示しています。 ds - V g V ds の場合のUV照明がある場合とない場合の特性 =7 V( V ds -私 ds 特性は、追加ファイル1:図S7に示されています。図5dは、 I 間の線形関係を示しています <サブ>ライト / I 暗い およびオンオフ電流比( I on / I オフ )。 私 on / I オフ 増加は、UV光応答性の改善につながります。現在の値 V の増加による改善を示すため ds 、図5dのデータを、電流(挿入図)に応じたオンオフ値としてプロットします。次に、 V g =− 60Vおよび V ds =7 V条件は、 I が最適な条件でした。 <サブ>ライト / I 暗い UV照射前後で比較すると比率が最大でした。

ZnO NWFETのUV検知特性。 a さまざまなバックゲート電圧でのUV照明下でのI–V特性。 V g 20Vステップで-60Vから60Vの範囲でした。 b I ds の電気的特性 vs V g UV照明下。 c 私 lignt / 私 暗い ゲート電圧の変化として。最大 I lignt / 私 暗い V 付近で取得されました g〜− 55 V.挿入図、 I ds - V g UV照射下および暗所での特性。 d フォト/ダーク電流比( I )間の線形関係 lignt / 私 暗い )および初期オンオフ電流比( I on / 私 オフ )ZnO NWFETの。挿入図は最初の I を示しています on / 私 オフ さまざまな V の比率 ds 。最大の I on / 私 オフ 比率は V でした ds =7V。 e 空気中のUV照射がある場合とない場合のZnONWネットワークFET光検出器の光応答。挿入図は、UVライトがオフになった後の指数関数的減衰特性を示しています。 f UV光のオンとオフを切り替えることによって記録されたZnONWネットワークチャネルデバイスの時間分解光応答
私 ds -V g UV光下での特性は、トランジスタが半導体状態(図4c)から導電(蓄積)状態(図5b)に変化したことを示しました。この変化は、UV光下で光励起キャリア濃度を縮退レベルまで増加させることが期待できます[50]。 私 <サブ>ライト / 私 暗い 私たちのデバイスの比率は約2×10 4 でした 、10および6、それぞれ-60 V、0 V、および60 Vのゲート電圧で(図5e)。これは、UV光応答性がゲート電圧によって調整できることを示しています。 V として g 減少し、光応答性が増加しました。
他の研究からのZnONWネットワークベースの光検出器の光応答性能を比較しました。たとえば、CVDで成長させたZnOナノワイヤアレイは、UV光応答性( I )を示しました。 <サブ>ライト / 私 暗い )〜10 4 [33、51]。私たちの場合、2×10 4 の同様の光検出器の応答性を達成できました。 高温および/または高真空プロセスを使用せずに。インクジェット印刷[47]や垂直に整列したナノワイヤー[52]などの方法を使用した他の研究では、10 3 の光応答性レベルが示されました。 〜10 4 、これは私たちの調査と同等かわずかに低いです(追加ファイル1:図S8を参照)。さらに、私たちの研究では、ゲート制御可能な特性が示されています。これは、光の状態に応じてデバイスの感度を調整するのに有利です。
ZnO NWのUV応答は、酸素の脱着と吸着に起因する空乏領域の変調によって説明できます[53]。紫外線は、ZnONW表面に吸着した酸素イオンを脱離させます。酸素の脱着により、有効なチャネルの厚さが増加し、NWを流れる電流が増加します。さらに、UV光による酸素脱着による脱着領域の減少は、NW間の接合バリアの高さを低下させ、電流の流れをより効率的にドリフトさせます[54、55]。私たちのデバイスはn型半導体の振る舞いを示したため、暗電流は大きな負の V で最小化されました。 g 。したがって、大きな負のゲート電圧での光応答性が最大化されました(追加ファイル1:図S9を参照)。
また、ゲート電圧は、UV光をオフにしたときの初期状態への回復時間に影響を与えます。 V の落下(減衰)時間 g =− 60Vと+60 Vはそれぞれ52秒と141秒で、3倍の差を示しています(挿入図、図5e)。電流が10%から90%に増加(立ち上がり時間)または減少(立ち下がり時間)する時間は、回復時間として定義されます。ゲートバイアスによる電界は、UV光によって脱離された酸素分子の吸収過程における電子と正孔の再結合の可能性に影響を与えます[56、57]。これは、デバイスの初期状態に戻る時間に関係します。そのため、電界によっては回復時間が遅れたり短くなったりする場合があります。図5fは、 V を適用した場合の反復的な光応答を示しています。 g =− 60V。これは、UV光のオンとオフを切り替えることによって記録されたZnONWネットワークチャネルデバイスの時間分解光応答を示しています。反復的なUV応答では、光応答性の低下が発生しないことを確認しました。
結論
ZnO NWFETを使用したゲート制御UVセンサーのアレイの効果的な製造方法を示しました。当社のZnONWデバイスは、化学的またはプラズマエッチングプロセスを使用せずにチャネル幅と厚さを制御できるZnO NW構造を備えています。この穏やかなプロセスと、ZnO再結晶温度(〜400°C)未満の熱処理を組み合わせることで、ゲートの大規模で簡単な製造が可能になりました。高いオンオフ比と光応答性を備え、デバイスの歩留まりが90%の制御されたUVセンサー。製造されたZnONWsネットワークUVセンサーは、オンオフ比10 5 のn型ゲート特性を示します。 、相互コンダクタンスは約47 nS、移動度は約0.175 cm 2 V -1 s -1 。これらの電気的特性は、引っ張り速度などの引っ張り方法のプロセスパラメータによって調整できます。電気的性質は、熱処理方法でさらに向上させることができます。デバイスはUV光に対して高い感度を示し、光応答性と応答時間はゲート電圧によって制御できます。私たちのプロセスとデバイスのパフォーマンスにより、ZnONWベースのアプリケーションの商用化プロセスが促進されることを期待しています。
略語
- AFM:
-
原子間力顕微鏡
- DCB:
-
ジクロロベンゼン
- EDS:
-
エネルギー分散型X線分光法
- FET:
-
電界効果トランジスタ
- HMTA:
-
ヘキサメチレンテトラミン
- NW:
-
ナノワイヤー
- OTS:
-
オクタデシルトリクロロシラン
- SEM:
-
走査型電子顕微鏡
- ZnO:
-
酸化亜鉛
ナノマテリアル
- 基本的な侵入検知システム
- Team Chemistry and Industrie 4.0
- 小さなセレンナノ結晶とナノロッドの容易な合成と光学的性質
- 溶液由来のZnOを使用したテンプレートプロセスによるナノシェルベースの3D周期構造の製造
- 圧力センサーおよび調整可能な感度を備えたガスセンサーとしての多層多孔質ポリアニリン複合材料の容易な製造
- Au @ TiO2卵黄シェルナノ構造の調製とメチレンブルーの分解および検出へのその応用
- ZnOナノ結晶の合成と逆ポリマー太陽電池への応用
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- ポリオール媒介プロセスによるZnOナノクリップの製造と特性評価
- CA / TPUヘリカルナノファイバーの製造とそのメカニズム分析
- ウォータージェット切断とその機械加工および製造における多くの用途



