原子層に堆積したZnO /β-Ga2O3(\(\ overline {2} 01 \))ヘテロ接合でのエネルギーバンドの調査
要約
ZnO /β-Ga 2 のエネルギーバンドアラインメント O 3 (\(\ overline {2} 01 \))ヘテロ接合は、X線光電子分光法(XPS)によって特徴づけられました。 ZnO膜は、様々な温度での原子層堆積を使用することによって成長させられた。タイプIのバンドアラインメントがすべてのZnO /β-Ga 2 で確認されました O 3 ヘテロ接合。伝導(価電子帯)バンドオフセットは1.26(0.20)eVから1.47(0.01)eVまで変化し、成長温度は150から250°Cに上昇しました。温度による伝導バンドオフセットの増加は、主にZnO膜のZn格子間原子によってもたらされます。一方、アクセプター型複合欠陥V zn + OHは価電子帯オフセットの減少を説明する可能性があります。これらの発見は、ZnO /β-Ga 2 の設計と物理的分析を容易にします。 O 3 関連する電子機器。
はじめに
酸化ガリウム(Ga 2 O 3 )は、その独自の特性により、次世代パワーエレクトロニクスデバイス向けの有望な超広帯域半導体材料として広く研究されてきました[1]。さまざまな多形(α、β、γ、δ、およびε)の中で、単斜晶系β-Ga 2 O 3 最も熱安定性があります[2]。さらに、β-Ga 2 O 3 室温バンドギャップは4.5〜4.9 eVで、化学的安定性に優れています[3]。特に、β-Ga 2 O 3 バルク電子移動度が約100cm 2 と高い / V・s、SiC(3.18 MV / cm)またはGaN(3 MV / cm)よりもはるかに高い8 MV / cmの絶縁破壊電界[4]であり、キャリア濃度はSnとSiをドープすることで簡単に変調できます[4]。 5、6]。したがって、β-Ga 2 O 3 ソーラーブラインド光検出器[7]や金属酸化物半導体電界効果トランジスタ(MOSFET)[8]などのベースのデバイスが報告されています。ただし、β-Ga 2 にはまだ制限があります O 3 金属とβ-Ga 2 間のオーミック接触が悪いなどのベースのデバイス O 3 [9]。近年、金属とGa 2 の間に高電子濃度の金属酸化物半導体中間層、すなわち中間半導体層(ISL)を挿入しています。 O 3 、インターフェースでのエネルギー障壁の変調[10,11,12]のため、効果的な解像度であることが示されています。
酸化亜鉛(ZnO)は、励起子の結合エネルギーが60 meVと大きく、電子濃度が> 10 19 と高いため、注目を集めています。 cm -3 、および1.89eVの強力な凝集エネルギー。 [13、14]さらに、ZnOとGa 2 の間の格子不整合 O 3 5%以内です[15]。水熱法[16、17]や化学蒸着(CVD)など、さまざまな堆積技術がZnO膜を調製するために開発されてきました。 [18]しかし、水熱法は複雑なプロセスを必要とし、成長速度は静かに遅く、CVDは一般に900°Cを超える静かな高い成長温度を必要とします。これらの欠点により、デバイスへの適用が困難になります。最近、原子層堆積(ALD)が有望な技術として登場しました。これは、優れたステップカバレッジ、原子スケールの厚さの制御性、優れた均一性、および比較的低い堆積温度を示します。その結果、ワイドバンドギャップ半導体上に原子層が堆積したZnOは、界面の乱れを低減し、キャリア輸送プロセスで重要な役割を果たすエネルギーバンドの整列を調べるためのより制御可能なサンプルを生成できます[19]。これまで、Ga 2 間のバンドアラインメント O 3 ZnOとGa 2 の理論的なバンド配列についてはいくつかの報告がありますが、原子層に堆積したZnOは実験によって研究されていません。 O 3 。 [20]したがって、原子層に堆積したZnO /β-Ga 2 のエネルギーバンド配列を理解する O 3 ヘテロ接合は、将来の関連デバイスの設計と物理的分析にとって非常に望ましいものです。この研究では、β-Ga 2 上の原子層堆積ZnOのエネルギーバンドアラインメント O 3 X線光電子分光法(XPS)によって特徴づけられました。さらに、バンドアラインメントに対するZnOの成長温度の影響も取り上げられました。
メソッド
β-Ga 2 O 3 (\(\ overline {2} 01 \))Snドーピング濃度が〜3×10 18 の基板 / cm 3 6×6mm 2 のサイズの小さな断片にさいの目に切った 。さいの目に切ったサンプルをアセトン、イソプロパノールで10分ごとに超音波洗浄して交互に洗浄し、続いて脱イオン水ですすいで残留有機溶媒を除去しました。その後、Ga 2 O 3 基質をALDリアクター(Wuxi MNT Micro Nanotech co。、LTD、China)に移しました。 ZnO膜の成長速度は約1.6Å/サイクルでした。 40nmと5nmの両方のZnO膜は、洗浄されたβ-Ga 2 上で成長しました。 O 3 Znを使用(C 2 H 5 ) 2 (DEZ)およびH 2 それぞれ150、200、および250°Cの各温度でのO。作製したZnO膜の厚さをエリプソメーター(SopraGES-5E)で測定した。 ZnO(40 nm)/β-Ga 2 O 3 バルク標準として使用され、ZnO(5 nm)/β-Ga 2 O 3 バンドアラインメントを決定するために使用され、その間、ベアバルクβ-Ga 2 O 3 対照サンプルとして使用した。価電子帯最大(VBM)、Ga 2p、およびZn 2pスペクトルを測定するために、0.05 eVのステップでXPS(AXIS Ultra DLD、島津製作所)測定を実行しました。表面の酸化と汚染の干渉を避けるために、すべてのサンプルは、XPS測定の前に2kVの電圧で3分間Arイオンによってエッチングされました。すべてのXPSスペクトルは、充電効果を補償するために284.8eVのC1sピークによって較正されていることに注意してください。バンドギャップを特定するために、Ga 2 の光透過率スペクトル O 3 およびZnOは、紫外可視(UV-VIS)分光法(Lambda 750、PerkinElmer、USA)によって測定されました。
結果と考察
図1は、(α hv のバリエーションを示しています。 ) 1 / n バルクβ-Ga 2 の光子エネルギーの関数として O 3 成長したままのZnO膜は200°Cで堆積しました。光バンドギャップ( E g )ZnO膜とβ-Ga 2 O 3 Taucの関係[21]によって決定できます:(α hv ) 1 / n = A ( hv − E g )、ここで、αは吸収係数、Aは定数、 hv 入射光子エネルギー、 E g は光エネルギーのバンドギャップ、 n 直接バンドギャップの場合は1/2、間接バンドギャップの場合は2です。ここでは、ZnOとβ-Ga 2 の両方 O 3 n の値を作る典型的な直接バンドギャップがある は1/2です。続いて、 E g α=0でのエネルギーバイアスに直線部分を外挿することで抽出できます。したがって、抽出された E g ZnOとβ-Ga 2 O 3 報告されているものとよく一致して、それぞれ3.20eVと4.65eVです。 [22、23]

(α hv のプロット ) 2 対 hv a の場合 石英ガラス上に成長させたZnO膜 b β-Ga 2 O 3 基板。挿入図は、ZnOとβ-Ga 2 の光透過スペクトルを示しています。 O 3 、それぞれ
価電子帯オフセット(VBO)は、次の式を使用したクラウトの方法で決定できます[24]
$$ \ Delta {E} _V =\ left({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3}-{E} _ {VBM} ^ {Ga_2 {O} _3} \ right)-\ left({E} _ {Zn \ 2p} ^ {Zn O}-{E} _ {VBM} ^ {Zn O} \ right)-\ left({E} _ {Ga \ 2p} ^ {Ga_2 {O } _3}-{E} _ {Zn \ 2p} ^ {Zn O} \ right)、$$(1)ここで、\({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3}-{E} _ {VBM} ^ {Ga_2 {O} _3} \)\(\ Big({E} _ {Zn \ 2p} ^ {Zn O}-{E} _ {VBM} ^ {Zn O} \))は、Ga 2p(Zn 2p)コアレベル(CL)とバルクβ-GaのVBM間のエネルギー差を表します 2 O 3 (ZnO)、および\({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3}-{E} _ {Zn \ 2p} ^ {Zn O} \)は、Ga2pとZn2pコアレベル。図2は、ZnO(40 nm)/β-Ga 2 のZn2pを含むすべてのCLスペクトルを示しています。 O 3 およびZnO(5 nm)/β-Ga 2 O 3 、バルクGa 2 のGa2p O 3 およびZnO(5 nm)/β-Ga 2 O 3 、およびバルクGa 2 からの価電子帯スペクトル O 3 およびZnO(40 nm)/β-Ga 2 O 3 。図2aは、ZnO(40 nm)/β-Ga 2 上のZn2pのCLスペクトルを示しています。 O 3 は、均一な結合状態を示す静かな対称であり、1021.09eVにあるピークはZn-O結合に対応します[25]。 VBMは、線形外挿法を使用して決定できます[26]。 ZnOのVBMは2.11eVにあります。図2bでは、1117.78 eVにあるピークは、Ga-O結合[27]とGa 2 のVBMに対応しています。 O 3 上記の方法により、2.74eVと推定されます。 ZnO(5 nm)/β-Ga 2 中のZn2pおよびGa2pのCL O 3 図2cに示します。式によると。 (1)、ZnO / Ga 2 の界面のVBO O 3 0.06eVと決定されます。
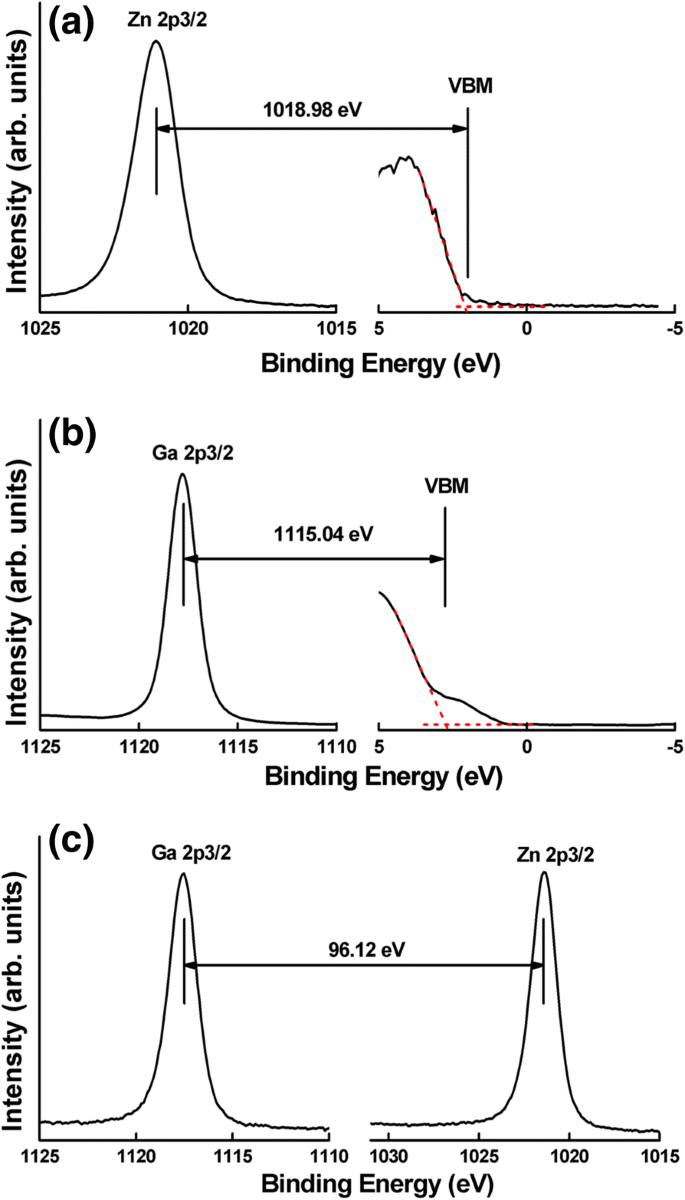
a のコアレベルと価電子帯の最大値(VBM)の高分解能XPSスペクトル 40 nm ZnO /β-Ga 2 からのZn2pコアレベルスペクトルとVBM O 3 、 b 裸のβ-Ga 2 からのGa2pコアレベルスペクトルとVBM O 3 、および c 5 nm ZnO /β-Ga 2 の高分解能XPSスペクトルから得られたGa2pおよびZn2pのコアレベルスペクトル O 3
計算された E に基づく g および ∆E V 、ZnO / Ga 2 での伝導バンドオフセット(CBO) O 3 インターフェイスは、次の式から簡単に推測できます。
$$ \ Delta {E} _C ={E} _g ^ {Ga_2 {O} _3}-{E} _g ^ {ZnO}-\ Delta {E} _V、$$(2)ここで、\({E} _g ^ {Ga_2 {O} _3} \)と\({E} _g ^ {ZnO} \)は、β-Ga 2 のエネルギーバンドギャップです。 O 3 それぞれ、ZnO。 ZnO /β-Ga 2 の詳細なエネルギーバンド図 O 3 界面はタイプIのバンド配列を持ち、ZnOの伝導帯と価電子帯の両方のエッジがβ-Ga 2 のバンドギャップ内にあります。 O 3 。

ZnO(200°C)/β-Ga 2 の概略バンドアライメント図 O 3 ヘテロ接合
ZnOとβ-Ga 2 の間のバンド配列に対する成長温度の影響をさらに調べるため O 3 、ZnO膜も150および250°Cで成長します。 150〜250°Cの温度でALDによって調製されたZnO膜は、多結晶性を持っていることに注意してください。図4は、さまざまな温度で成長させたZnO膜の高分解能O 1sXPSスペクトルを示しています。各O1sスペクトルは、ガウス-ローレンツ関数を使用して3つの成分に十分に分離できます。 530.0(O1)、531.6(O2)、および532.4(O3)eVを中心とするピークは、それぞれZn-Oバンド、酸素空孔、および-OH基に対応します[28、29]。異なる成分の相対パーセンテージも、図4で分解されたピーク面積に従って計算されます。これは、前駆体の分解とZn格子間原子の増加により、酸素空孔の相対含有量が10.7%から15.0%に増加することを示しています。ただし、この温度範囲では、DEZ前駆体と表面の–OH基の間の反応がより完全になるため、–OHの対応物は5.1%から1.9%に減少します[30]。

a で成長したZnO膜の高解像度O1のXPSスペクトル 150°C、 b 200°C、および c それぞれ250°C
図5は、ZnO /β-Ga 2 のバンドオフセットを示しています。 O 3 成長温度の関数としてのヘテロ接合。 CBOは1.26から1.47eVに増加し、成長温度は150から250°Cまで変化します。ネイティブドナーの欠陥には、Znの逆位、酸素空孔、およびZn格子間原子が含まれます。しかし、逆位原子の形成エネルギーは非常に高いため、その濃度は非常に低くなります。 CBMは主にZn原子の4s軌道によって支配されるため、Zn格子間原子は、酸素空孔よりも伝導帯最小値(CBM)に大きな影響を及ぼします。 [31]結果として、0.21 eVのCBOの増加は、主にZn格子間原子によってもたらされる可能性があります。一方、VBOは0.20から0.01 eVに低下し、成長温度は150から250°Cに上昇します。本来のアクセプター欠陥には、Oアンチポジション、Zn空孔、および酸素格子間原子[32]が含まれ、それらの形成エネルギーは高く、その数はごくわずかですらあります。さらに、最もネイティブなアクセプターレベルはZnOバンドギャップの奥深くにあるため、VBMにはほとんど影響しません[33]。ただし、V zn + OHは、低い形成エネルギー[34] V zn のデュオとして提示されるのに適しています。 + OHは、OH結合に属する電子で発生する可能性があります。格子水素H + イオンは補償中心として機能し、V Zn と結合できます。 転位と積層欠陥コアの周りに、p型導電性のアクセプター型複合欠陥を保証します[35]。 ZnO膜中のより多くの残留–OH基は、より低い成長温度、つまり150°Cで得られます[36]。 VBM付近のアクセプターレベルは温度とともに低下し、 E の効果的な下方シフトにつながります V ZnOの、したがってΔE V 低くなります。したがって、低温で堆積されたZnOは、金属とGa 2 の間の界面での障壁の高さを減らすために、より効率的になる可能性があります。 O 3 。

原子層に堆積したZnO /β-Ga 2 の伝導帯と価電子帯のオフセット O 3 異なる温度で製造されたヘテロ接合
結論
要約すると、原子層に堆積したZnO /β-Ga 2 でのエネルギーバンドの整列 O 3 (\(\ overline {2} 01 \))はXPSによって特徴づけられました。 ZnO /β-Ga 2 で形成されたタイプIバンドアラインメント O 3 インターフェース。伝導帯オフセットは1.26から1.47eVに増加し、価電子帯オフセットは温度が150から250°Cに上昇するにつれて0.20から0.01eVに減少しました。これらの観察結果は、低温で堆積されたZnOが、ZnO /β-Ga 2 での電子障壁の高さを低減するための有望なISLであることが好ましいことを示唆しています。 O 3 インターフェイス。
略語
- ALD:
-
原子層堆積
- CBM:
-
伝導帯の最小値
- CBO:
-
伝導バンドオフセット。
- CVD:
-
化学蒸着
- DEZ:
-
Zn(C 2 H 5 ) 2
- Ga 2 O 3 :
-
酸化ガリウム
- GaN:
-
窒化ガリウム
- ISL:
-
中間半導体層
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- OH:
-
ヒドロキシル
- SiC:
-
炭化ケイ素
- UV-VIS:
-
紫外可視分光法
- VBM:
-
価電子帯の最大値
- VBO:
-
ヴァランスバンドオフセット
- XPS:
-
X線分光法
- ZnO:
-
酸化亜鉛
ナノマテリアル



