自立型GaN基板上のMg注入およびMgドープGaN層の欠陥の比較分析
要約
非効率的なMg誘起p型ドーピングは、ソリッドステート照明および電力アプリケーション向けのGaNベースの電子デバイスの開発における主要な障害であり続けています。この研究は、Mgの取り込みがイオン注入とエピタキシャルドーピングの2つのアプローチを介して実行される自立型GaN基板上のGaN層の欠陥の比較構造分析を報告します。走査型透過電子顕微鏡は、Mgを注入したサンプルにのみピラミッド型および線状の欠陥の存在を明らかにしましたが、Mgをドープしたサンプルはこれらの欠陥の存在を示さず、欠陥の性質は組み込み方法に依存することを示唆しています。二次イオン質量分析から、Mg濃度とこれらの欠陥の位置およびタイプとの間に直接的な対応が観察されます。私たちの調査によると、これらのピラミッド型および線状の欠陥はMgに富む種であり、それらの形成により自由正孔密度が低下する可能性があります。これは、p-GaNベースの材料およびデバイスにとって依然として大きな懸念事項です。自立型GaN基板は、pn接合ベースの垂直デバイスを実現するためのプラットフォームを提供するため、このような基板上のGaN層でのさまざまなMg取り込みプロセスに起因する欠陥の比較構造調査により、Mg自己補償メカニズムの理解に向けた洞察が得られる可能性があります。 GaNベースのデバイス技術の進歩のためにMgドーピングおよび/または注入プロセスを最適化する。
はじめに
過去30年間で、GaNは世界中で最も研究されている化合物半導体の1つとして浮上してきました。これは主に、ソリッドステート照明アプリケーションだけでなく、高出力、高周波、および高温動作でのその途方もない可能性によるものです[1,2,3,4,5,6,7,8]。 GaNおよび関連するヘテロ構造に基づくデバイスをこのようなアプリケーションや操作にうまく採用するには、制御可能なn型およびp型のドーピングが重要な要件です。この側面では、GaNエピ層または単結晶でのn型ドーピングの達成と制御は、学界と産業界のボトルネックであるp型の対応物と比較して大幅に最適化されています。これまで、Mgは、大量のMg濃度(約10 19 )を必要とする高い活性化エネルギーにもかかわらず、最も効率的なp型ドーパントであることが証明されています。 cm -3 以上)10 18 に近い妥当なフリーホール濃度を達成するために組み込む必要があります cm -3 。 10 19 を超えるMg原子濃度の増加 cm -3 自由正孔濃度の低下につながります[9、10、11]。この現象は主に、N個の空孔[12,13,14]、Mg関連の点欠陥[10、15]、またはフェルミ準位を下げて自由正孔を飽和させるMg空孔関連の荷電および/または中性錯体の生成に起因します。濃度[16、17]。 2.9 eVにピークを生じさせるフォトルミネッセンス測定に基づいて、深いドナー欠陥複合体Mg-V N また、自己補償メカニズムの主な理由の1つであると考えられていました。 [17、18、19]。したがって、GaNへのMgの取り込みを理解するために多くの重要な研究が試みられたにもかかわらず、この問題は依然として不明であり、さらなる分析を行う必要があります。
原子スケールの顕微鏡研究を使用した欠陥分析に関する以前の報告のほとんどは、有機金属化学蒸着(MOCVD)または分子線エピタキシー(MBE)を使用してサファイア上に成長させたMgドープGaN層に基づいています。私たちの知る限り、Mgをドープした自立型GaN基板の欠陥分析に関する報告はほとんどなく、Mgがイオン注入によって組み込まれている自立型GaN基板の透過型電子顕微鏡ベースの欠陥分析に関する報告はありません。自立型GaN基板は、転位密度のレベルが低下し、効率的な垂直デバイスに応用できるため、外来基板上にMOCVD / MBE成長したGaN層に比べていくつかの利点があることが今では広く受け入れられています。イオン注入を介してそのような基板で十分なp型ドーパント活性を達成することは、GaNベースの固体照明および高出力デバイスの商業化および開発のために調査される必要があります。これらすべての問題を主な目的として、ドーピングとイオン注入によってMgの取り込みが達成されるGaN自立層のMgが取り込まれた欠陥の詳細な構造解析を実施しました。
実験方法
私たちの研究では、水素化物気相エピタキシーを使用して成長させた自立型n-GaN基板を使用しています。その後、エピタキシャル層はこれらの基板上にMOCVDによって成長します。 Mgの取り込みは、イオン注入とエピタキシャルドーピングの2つのアプローチで実行されます。前者の場合、MgはアンドープGaN層上に保護層を堆積せずに厚さ4μmのアンドープGaNエピタキシャル層に注入され、後者の場合、厚さ1μmのMgドープGaNは4μm上にエピタキシャル成長します。 -厚くドープされていないGaN層を連続的に。信頼できる比較のために、Mgの取り込みレベルは4×10 19 と同じに保たれています。 cm -3 両方の場合において。 Mgの注入は500°Cで実行され、続いてドーパントの活性化のために1350°Cでアニーリングされます。注入エネルギーは、15、30、55、95、および180 keVと見なされ、それぞれの投与量は3.0×10 13 です。 、5.5×10 15 、1.1×10 14 、1.9×10 14 、および8×10 14 cm −2 、深さ200nmのボックスプロファイルを取得します。ホール測定は、MgをドープしたGaNサンプルとMgを注入したGaNサンプルの両方の電気的特性を評価するために実行されます。 MgをドープしたGaNサンプルの場合、正孔濃度と移動度は3.4×10 17 であることがわかります。 cm -3 および9.5cm 2 / V-s。一方、Mgを注入したサンプルの電気的特性は、抵抗性が高いため適切に評価できませんでした。深さの関数としてのMgの分布は、二次イオン質量分析(SIMS)を使用して調査され、走査型透過電子顕微鏡(STEM)分析は、Mgによって誘発された欠陥の構造調査に使用されます。このために、STEMおよび電子エネルギー分散型X線分光法(EDS)は、200および80kVで動作するJEOLJEM-ARM200Fによって実行されました。これらの研究では、TEM試料は、Gaビームを使用した集束イオンビームミリングと、それに続く液体窒素冷却低エネルギーArイオンミリングによって準備されました。
結果と考察
Mgを注入したGaN層の欠陥分析
図1(a)は、Mgを注入したGaNの明視野(BF)-STEM画像を示し、(b)は対応するSIMSプロファイルを示しています。図1(a)に示す矢印は、正の[0001]方向を表しており、画像は[11 \(\ overline {2} \)0]ゾーン軸に沿って表示されます。欠陥は深さの関数として均一に分布していないことがわかります。実際、Mgの濃度と欠陥の間には直接的な相関関係が見られます。欠陥のほとんどは、Mg濃度が10 19 を超える表面から約150nmに蓄積されます。 cm -3 SIMS測定から観察されたように。 GaNへのMg注入による欠陥とその可視化をよりよく理解するために、[11 \(\ overline {2} \)0]軸からc軸を中心にサンプルを10°傾けることにより、オフゾーン軸条件でイメージングを実行します。 。この条件は、完全結晶のために回折コントラストを弱め、欠陥のコントラストを高め、周囲の環境と比較して欠陥をよりよく視覚化できるようにします。このオフゾーン軸条件下で採取したMg注入GaNサンプルのBF-STEM画像を図1(c)に示します。ここでは、表面から約200nmの深さでいくつかの線欠陥が見られます。対応するMgSIMSプロファイルは、線形スケールで(d)に示され、これらの線欠陥の存在とMg濃度の間に直接的な対応が観察されます。これらの欠陥は、Mg濃度が約10 19 の狭い領域にあることがわかります。 cm -3 範囲。
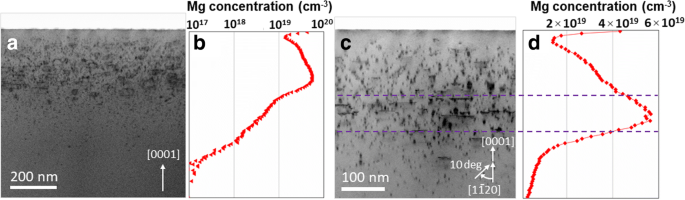
a [11 \(\ overline {2} \)0]軸と b に沿って得られたMg注入GaNサンプルの断面明視野STEM画像 SIMSを使用して得られたMgの対応する深さプロファイル。欠陥とそれらのMg濃度との関係をよりよく視覚化するために、 c に示すようにオフゾーン軸条件下でイメージングが実行されます。 。 c に対応するMgプロファイル d に表示されます 線形スケールで、Mg濃度が最も高い狭い領域で線欠陥が観察される
さらに、高倍率のBF-STEMイメージングは、図2(a)に示すように、オフゾーン軸条件で実行されます。(b)は、(a)の選択された領域を高倍率で示しています。 (b)に示すように、A、B、C、Dの4種類の構造が観察されます。 「A」とラベル付けされた欠陥はピラミッド型ですが、「B」は線状の欠陥として表示されます。

a 欠陥のコントラストを強化するためにオフゾーン軸条件で得られたMg注入GaNサンプルの断面明視野STEM画像。 ( a のマークされた領域の拡大図 )は( b )A、B、C、およびDとラベル付けされた4つの異なる種類の欠陥が観察されます。 ( b でAとラベル付けされたピラミッド型ドメインの高解像度TEM画像 )は( c に表示されます )右下に概略図があります。ピラミッド型ドメインの歪んだ格子は、( c )を絞ることによって表されます。 )( d に示すように )。 1つの典型的なCまたはDタイプの欠陥の高分解能TEM画像を( e )に示します。 )( f )、欠陥の周りのひずみ場のコントラストを示しています
これらの欠陥の構造観察は、Mg補償メカニズムを理解する観点から重要であり、原稿の次のセクションでは、主にタイプ「A」および「B」の欠陥の構造分析に専念します。 「A」として示されている構造は、正の[0001]方向が頭に向いているピラミッド型の欠陥であり、[0001]平面上のベースと、[11 \(\ overline {2} \)3]平面上の6つの壁が次のように傾斜しています。図2(c)のそのような欠陥の1つの高解像度TEM画像。このようなピラミッド型ドメインの概略図も図2(c)に示されています。図2(c)は、(d)に示すように、[0001]方向に垂直に絞られています。ここでは、周囲のGaNマトリックスと比較して、ピラミッド型ドメインで格子が歪んでいるように見えます。これは、これらのピラミッド型ドメインの内側と外側のGaとNの副格子間の変位を示しています。 。これは、Venneguesらの発見と一致しています。 [20]同様のタイプのピラミッド型ドメインが観察されます。同様のピラミッド形状の欠陥は、MgをドープしたGaN膜で以前に観察され、それらの存在は通常、Mgの導入によるGaN原子構造の変化によって説明されます[19、20、21、22、23、24]。 Liliental-Weber etal。 [25、26]は、そのようなピラミッド型の欠陥は、これらのピラミッドの頭の近くに存在するMgに富むクラスターに起因することを提案しました。ウルツ鉱相のGaN構造は、通常、Ga原子で満たされたN個の副格子四面体サイトの半分を持つN面の六角形の積み重ねによって記述されます。 Vennegues etal。 [27]彼らの調査に基づいて、GaNに高レベルのMgを導入すると、GaがMgに置換され、Mg 3 が形成されることが提案されました。 N 2 、Mg-N化合物はアンチビックスバイト構造を持っていると報告されています。 Mg 3 のアンチビックスバイト構造 N 2 4つのサイトのうち3つを占めるMgによるN個の副格子四面体サイトの充填に対応します。 Venneguesらによって提案されたモデルによると。 [27]、ピラミッド型ドメインは、Mg 3 の単分子層によって分離された反対の極性の2つのGaN結晶と見なすことができます。 N 2 。これは、ハンセンらの調査によってさらに裏付けられています。 [28]これらのピラミッド型ドメインはMg 3 であると提案されました N 2 インクルージョン。 Vennegues etal。 [27]およびLerouxetal。 [23]はまた、ナノメートルサイズのこのようなピラミッド型ドメインの形成には、10 19 の中程度のMgの取り込みが必要であることも報告しています。 cm -3 範囲。これは、ピラミッド型の欠陥が10歳未満から中期に観察されるという我々の発見と一致しています 19 cm -3 STEM画像(図1(c))と対応するSIMSプロファイル(図1(d))の相関関係から見たMg濃度。したがって、本研究の図2(b)で構造「A」とラベル付けされたピラミッド型の形状欠陥は、Mgに富むピラミッド型ドメインであると考えられ、それらの形成は、p-GaN層のMg補償メカニズムに直接関連している可能性があります。図2(b)に示す他のタイプの欠陥は、タイプ「C」および「D」の欠陥であり、これらは本質的に類似した構造であり、寸法が異なります。 [11 \(\ overline {2} \)0]軸から見たときに[0001]方向に沿って伸びているように見えるコントラストは、ひずみに起因する可能性があります。これをさらに明確にするために、そのような類似の欠陥の1つの高分解能TEM画像を図2(e)に示します。(f)は、[0001]方向に垂直に絞り出された同じ画像を示しています。 [0001]方向に沿った歪んだ格子は、この方向に沿った異なるひずみ場のために異なる格子定数を示唆しています。 MgはGaに比べてサイズが小さいため、Gaサイトに組み込まれると、格子に歪みが生じ、これらの欠陥の周囲にこのコントラストが生じる可能性があります。
図2(b)で「B」とラベル付けされた別のタイプの欠陥は、[11 \(\ overline {2} \)0]軸から見た場合、[0001]方向に垂直な線欠陥であるように見えます。このようなタイプの欠陥は、Mg濃度が高い狭い領域に蓄積されているように見えることに注意することが重要です(図1(c)および(d)に示すBF-STEM画像とMg SIMSプロファイルの対応から観察)。それらの形成がMgの過剰取り込みに関連していることを示唆している。別の観察は、これらの線欠陥の縁にピラミッド状ドメインが存在することであり、これは、これらのドメインの蓄積がそれらの形成をもたらす可能性があることを示している。ただし、それがピラミッド型と線状の欠陥のランダムな重なりである可能性があることを除外するべきではなく、この方向でさらに調査する必要があります。これらのタイプの欠陥を示すBF-STEM画像を図3(a)に示します。これらの欠陥をよりよく理解するために、サンプルを[0001]方向に垂直な軸を中心に約10°傾け、得られたBF-STEM画像を図3(b)に示します。このサンプルの傾斜により、1〜100方向に沿って回折スポットが強く励起され、欠陥を取り巻く方向のひずみ場からのコントラストが向上します。このひずみ場のコントラストから、線として現れた欠陥(図2(a)および(b)を参照)は、実際には、[0001]方向により深い数nm離れた一対の線で構成されています。

a 切り詰められたピラミッドまたは台形の形状のように見えるタイプBの欠陥を分析するためのMg注入バルクGaNサンプルの断面明視野STEM画像。 b c に垂直な軸を中心にサンプルを10°傾けて撮影した画像を表します -これらの欠陥のエッジで異なるコントラストが観察される軸
これらの欠陥は、Mg濃度が10 19 よりも高い狭い領域に現れるため、Mgが存在する可能性があります。 cm -3 STEM画像(図1(c))とMg SIMSプロファイル(図1(d))の対応から観察されます。 Mgを含むこれらのタイプの欠陥のこの信念を検証するために、EDSプローブの直径が0.2 nm未満の走査型透過電子顕微鏡-エネルギー分散型分光法(STEM-EDS)測定を、「欠陥から離れた」領域と2つの異なる領域で実行しました。図4(a)に示すように、それぞれポイント1および2としてラベル付けされた「欠陥時」。 Mgピークが予想される1.19keVから1.35keVのエネルギー範囲でのポイント1と2の比較EDSスペクトルを図4(b)にプロットし、挿入図に完全なEDSスペクトルを示します。欠陥(ポイント2)でMgの存在がはっきりと見られます。これをさらに正当化するために、同様のMgを注入したGaNサンプルに対してSTEM-EDSマッピングを実行しました。図4(c)は、Mgを注入したGaNサンプルのSTEM画像を示し、下向きの矢印はこれらの線の欠陥を示しています。対応するMgのEDSマップを図4(d)に示します。これらの欠陥にはMgの存在がはっきりと見られます。したがって、これらの欠陥にはMgが含まれており、Mg濃度が10 19 を超えると形成されます。 cm -3 Mg補償のもう1つの原因である可能性があります。

a 個々のタイプ「B」の欠陥を示すMg注入GaNサンプルの断面STEM画像。ポイント1と2は、EDS測定が実行される領域を表し、結果のEDSスペクトルは b に示されています。 。 1.19〜1.40keVのエネルギー範囲のEDSスペクトルが b にプロットされています。 挿入図は、GaおよびNピークを含む完全なEDSスペクトルを示しています。 c および d これらのタイプの欠陥にMgが存在することを示す同様のMg注入バルクサンプルの現在のSTEM画像と対応するMgマップ
MgをドープしたGaN層の欠陥分析
次に、厚さ1μmのMgドープGaN層を厚さ4μmのアンドープGaNエピタキシャル層上にエピタキシャル成長させたGaNサンプルの構造調査を実施しました。もう一度言及する価値があるのは、Mgのレベルが同じ、つまり4×10 19 に保たれていることです。 cm -3 Mg取り込みの2つのアプローチ(エピタキシャルドープとイオン注入)の有意義な比較のために。図5(a)は、[11 \(\ overline {2} \)0]に沿って見た、自立型GaN基板上にエピタキシャル成長させたMgドープGaNのBF-STEM画像を示しています。一方、(b)は、GaNの深さの関数としてのMgプロファイルを示しています。 SIMSを使用して取得。 Mg濃度は約4×10 19 でほぼ一定のままであることに注意してください。 cm -3 図5(a)の視野内(最大700 nm)は、Mg濃度がGaNの深さの関数であることがわかったMg注入GaNの以前のケースとは異なります(図1(a)〜(d)を参照)。 ))。
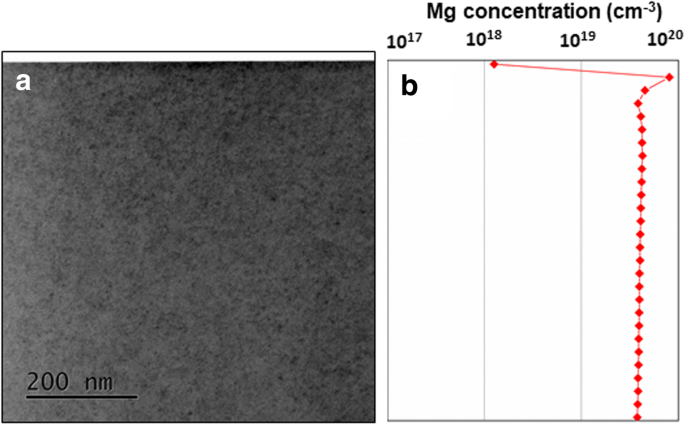
a [112̅0]軸と b に沿って得られたMgドープバルクGaNサンプルの断面明視野STEM画像 SIMSを使用して得られたMgの対応する深さプロファイル。ドット状の欠陥がサンプル全体に均一に分布していることがわかります
MgをドープしたGaNサンプルの欠陥分析を実行するには、サンプルを c の周りに10°傾けて、オフゾーン軸条件でSTEMイメージングを行います。 -[11 \(\ overline {2} \)0]軸からの軸が実行されます。図6(a)および(b)は、BF-STEMおよびDF-STEM画像を表しており、約5nmのサイズのドット状の欠陥がサンプル全体に均一に分布していることが観察されます。ここで、SIMSプロファイルから観察されるように、この場合、Mgプロファイルも均一に見えることに注意してください(図5(b)を参照)。 GaNサンプル全体でのMgとこれらの欠陥の均一な分布は、これらの欠陥とMgの取り込みとの間に直接的な相関関係があることを示唆しています。約5nmのこれらの点状の欠陥は、Mgの析出物である可能性があります(そして、それによって積層欠陥が誘発される可能性があります)。サイズが小さいため、Mgの沈殿自体をEDS測定で直接確認することはできませんでした(GaとMgのピークは互いに非常に接近しているため、小さな濃度差のマッピングは非常に困難です)。
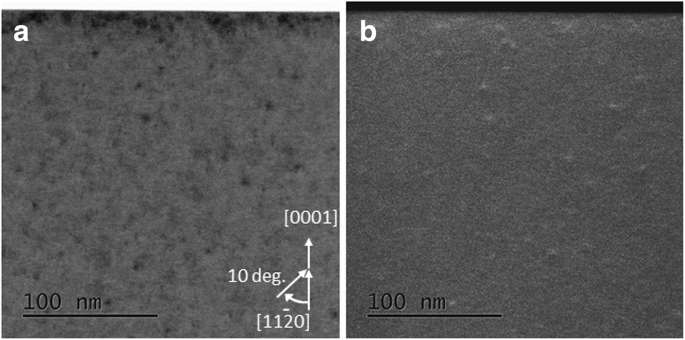
断面 a STEM-BFおよび b 欠陥のコントラストを強化するためにオフゾーン軸条件で得られたMgドープバルクGaNサンプルのSTEM-ADF画像
この観察結果は、Mg濃度が最大であった表面から200nmに欠陥が蓄積していることがわかったMg注入サンプルの以前のケースとは完全に異なります。さらに、Mgを注入したサンプルとは異なり、MgをドープしたGaNサンプルでは、ピラミッド型および2線状の欠陥(図2(b)でAおよびBとラベル付けされている)は観察されませんでした。興味深いことに、ピラミッド型および線状の欠陥は、Mgがイオン注入以外の手法で組み込まれているGaNサンプルでも報告されています。たとえば、Khromov etal。 [29]は、MOCVDによって成長させたMgドープGaNサンプルにピラミッド型欠陥が存在することを報告しました。しかし、彼らは、Mg濃度が約〜5×10 19 である高濃度にドープされたGaNサンプルでのみそのような欠陥を観察しました。 cm -3 。ただし、Mgが〜2×10 18 のサンプルでは cm -3 、これらのピラミッド型ドメインは観察されませんでした。 Vennegues etal。 [27]は、MOCVDで成長させたMgドープGaNサンプルでこのようなピラミッド型ドメインを観察しました。Mg濃度は10 19 の半ばにあります。 cm -3 範囲。彼らは、Mg濃度が10 19 未満のサンプルではそのような欠陥を観察しませんでした。 cm -3 。私たちの仕事では、同様のレベルのMg〜4×10 19 cm -3 これらの欠陥の存在を分析するために、イオン注入とエピタキシャルドーピングを介して組み込まれています。これらの欠陥は、Mgをドープしたサンプルではなく、Mgを注入したサンプルでのみ観察されます。これは、Mgの分布もそれらの存在を説明するために考慮する必要があることを示唆しています。 SIMS測定から、Mgを注入したサンプルではMgが不均一に分布していることがわかり(図1(b)および(d))、MgをドープしたサンプルではMgが均一に分布していました(図5(b))。さらに、Mgを注入したサンプルでは、これらの欠陥は、周囲のマトリックスと比較して、Mg濃度が高い狭いウィンドウにのみ存在することがわかりました。したがって、これらの欠陥の形成は、組み込まれたMgのレベルおよびMgの分布と関連しており、Mgが10 19 の範囲にある領域で形成される可能性があります。 cm -3 。 Mgを注入したサンプルのMgプロファイルが不均一になると、欠陥の分布が不均一になるようです。ただし、不均一に分布した欠陥が不均一なMg分布を引き起こしたり、Mg注入プロファイルがそのような欠陥の存在に依存したりする可能性を否定するべきではありません。したがって、この方向でさらに調査する必要があります。 Mgを組み込んだGaNの欠陥の比較分析は、欠陥の性質とタイプが取り込み方法に依存していることを示唆しています。
結論
要約すると、自立型GaN基板上のMg注入およびMgドープエピ層の欠陥の走査型透過電子顕微鏡ベースの構造調査により、欠陥の性質はMgの取り込み方法に強く依存することが明らかになりました。 Mgを注入したGaNは、[0001]方向を指すピラミッド型ドメインと、[0001]方向に数ナノメートル深い特徴を持つ2線欠陥の存在を示しました。ピラミッド型ドメインはMg 3 であると考えられています N 2 エネルギー分散型分光法から観察されるように、線欠陥もMgを持っていることがわかります。これらの線欠陥は、表面から約200 nmの深さで、Mg濃度が約10 19 の狭い領域にあることがわかります。 cm -3 これは、それらの形成が注入されたMg濃度のレベルに関連していることを示唆しています。 Mg注入時のGaNにおけるこれらの欠陥の形成は、非効率的なp型ドーピングにつながるMg自己補償メカニズムに大きく寄与すると予想されます。それどころか、MgをドープしたGaNサンプルは、サンプル全体に均一に分布していることがわかっているドット状の欠陥の存在のみを示しました。欠陥の性質とタイプに対するMgの取り込み方法とその濃度の依存性を強調する現在の研究は、効率的なデバイス動作のためにGaNベースの材料で高いp型導電性を達成するために組み込むMgの適切な量を選択するのに役立つかもしれません。
略語
- ADF:
-
環状暗視野
- BF:
-
明視野
- EDS:
-
エネルギー分散型分光法
- MBE:
-
分子線エピタキシー
- MOCVD:
-
有機金属化学蒸着
- SIMS:
-
二次イオン質量分析
- STEM:
-
走査型透過電子顕微鏡法
ナノマテリアル
- 回路とネットリストの例
- メッシュ電流法と解析
- 5GおよびGaN:LDMOSからGaNへの移行
- 5GおよびGaN:将来のイノベーション
- ポリマーナノ構造上のU2OS細胞におけるアクチンと接着斑組織の分析
- サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
- 表面の湿潤性と湿度を制御することによる絶縁基板へのエレクトロスピニング
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 水性電解質中の対称スーパーキャパシタとしてのカーボンナノファイバーと活性炭の研究:比較研究
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- 天然および合成ナノ材料の電気化学的、生物医学的、および熱的特性の比較研究



