アルゴン注入エッジ終端を備えた高電圧β-Ga2O3ショットキーダイオード
要約
エッジ終端されたAu / Ni /β-Ga 2 O 3 ショットキーバリアダイオードは、アルゴン注入を使用して、アノード接点の周辺に高抵抗層を形成することによって製造されました。 50keVの注入エネルギーと5×10 14 の線量で cm −2 および1×10 16 cm −2 、逆方向降伏電圧が209から252および451 V(最大550 V)に増加し、バリガの性能指数(V BR 2 / R on )も25.7から30.2および61.6 MW cm -2 に増加します 、それぞれ約17.5%と140%の拡張。 2Dシミュレーションによると、接合コーナーの電界はアルゴン注入後に平滑化され、最大破壊電界の位置5.05 MV / cmは、界面のアノードコーナーから注入直後のオーバーラップコーナーに変化します。領域。前方特性の温度依存性も調査されました。
背景
Ga 2 などの超ワイドバンドギャップ半導体材料を使用した高出力デバイスの開発 O 3 、AlN、ダイヤモンドなどが近年加速しています。 β-Ga 2 のバンドギャップ O 3 は4.8〜4.9 eVと大きく、β-Ga 2 の破壊電界 O 3 推定値は8MV / cmで、4H-SiCやGaNの約3倍です。バリガの性能指数3400は、4H-SiCの性能指数の少なくとも10倍、GaNの性能指数の4倍です[1]。さらに、大型単結晶と低コストのβ-Ga 2 O 3 基板は、フローティングゾーン(FZ)[2]やエッジ定義のフィルムフィード成長(EFG)[3、4]などの溶融成長法で製造できます。電子密度は10 16 の広い範囲で制御できます。 〜10 19 cm -3 Sn、Si、またはGeをドープすることによって[5,6,7]。これらの優れた特性により、β-Ga 2 O 3 高絶縁破壊電圧ショットキーバリアダイオード(SBD)や金属酸化膜半導体電界効果トランジスタ(MOSFET)などの低損失、高電圧スイッチング、および高電力アプリケーションに最適です[8,9,10,11,12] 。ショットキーバリアダイオードは、p-n接合ダイオードと比較して、スイッチング速度が速く、順方向電圧降下が小さいという利点があります。これにより、電力損失を減らし、電源の効率を向上させることができます。
β-Ga 2 では、1016 V、2300 V、1600Vの大きな絶縁破壊電圧が得られていますが O 3 エッジ終端のないショットキーバリアダイオードは、すべて理想値の約34%、8%、および10%です[10、13、14]。電界混雑効果を緩和し、β-Ga 2 の電位を完全に実現する O 3 、適切なエッジ終端を設計する必要があります。フィールドプレート、フローティングメタルリング、トレンチMOS構造、埋め込みガードリング、ジャンクションターミネーションエクステンション(JTE)など、デバイスのブレークダウン電圧を上げるためのエッジターミネーション技術がいくつかあります[12、15、16、17]。ただし、埋め込まれたガードリングとJTE構造は、Ga 2 には適用されません。 O 3 p型ドーピングの欠如によるショットキーダイオード。 H.松波とBJバリガは、アルゴン注入を使用してアノードのエッジに高抵抗率のアモルファス層を形成し、電界の混雑を低減するエッジ終端構造を提案しました[18、19、20、21、22]。マルチフォトリソグラフィーやディープトレンチエッチングステップを必要としないシンプルな技術であり、整流接点周辺の電界分布を滑らかにするためにSiCおよびGaN整流器で広く使用されています[15、23、24]。
この論文では、垂直エッジで終端されたβ-Ga 2 O 3 ショットキーダイオードは、ショットキー接点のエッジにアルゴンを注入して製造されました。静電容量-電圧(C-V)および温度依存電流密度-電圧(J-V)特性は、Keithley 4200半導体特性評価システムを使用して記録され、電界分布も分析されました。
メソッド/実験
厚さ10μmのドリフト層は、高品質のSnドープ(100)配向のβ-Ga 2 から得られました。 O 3 機械的剥離によるバルク基板。 β-Ga 2 O 3 バルクは、4Nの純粋なGa 2 を使用したEFG技術によって成長しました O 3 出発原料としての粉末。図1a、bに示すように、優れた結晶品質と滑らかな表面は、高解像度X線回折(HRXRD)および原子間力顕微鏡(AFM)測定によって確認されました。半値全幅(FWHM)と二乗平均平方根(RMS)は、それぞれ37.4秒角と0.203nmと推定されました。図1cは、β-Ga 2 の分布を示しています。 O 3 4点プローブ測定による厚さ10μmの基板シート抵抗。 (1.3±0.04)×10 17 のキャリア濃度を使用 cm -3 シート抵抗が(563±18.5)Ω/□の場合、電子移動度は85.3〜95.2 cm 2 と計算されます。 /Vsbyμ n =1 /(R シート × n × q × t )、ここでμ n、 R シート、 n 、 q 、および t 電子移動度、シート抵抗、電子濃度、電子電荷、およびβ-Ga 2 の厚さです。 O 3 報告された結果と同様の基質[25]。エネルギー50keV、線量2.5×10 14 のアルゴンイオン注入 cm −2 、および950°Cで60分間のN 2 での高温アニーリング 雰囲気は最初に裏面で実行され、続いてTi / Au(20 nm / 100 nm)オーミック金属スタックの電子ビーム蒸着と600°Cで60秒間のN 2 > アンビエント。次に、厚さ2μmのフォトレジストを、50keVのエネルギーと5×10 14 の線量で室温でアルゴン注入用のマスクとして使用しました。 cm −2 (サンプルB)および1×10 16 cm −2 (サンプルC)、それぞれ。注入による損傷を修復し、逆バイアス下での漏れ電流を低減するために、注入されたサンプルは、N 2 の下で400°Cで60秒間の急速熱アニーリングにかけられました。 アンビエント[13、26]。最後に、直径100 µmの円形ショットキーアノード電極を、標準のフォトリソグラフィーパターン、Ni / Au(30 nm / 200 nm)スタックの蒸着、およびリフトオフによって前面に作製しました。アルゴン注入なしの参照デバイスも製造されました(サンプルA)。図2aは、製造されたGa 2 の断面TEMを示しています。 O 3 アルゴン注入エッジ終端を備えたショットキーダイオード。ほぼ表面のアモルファスβ-Ga 2 O 3 層は注入領域に作成されました。終了したβ-Ga 2 の実際の写真 O 3 ショットキーダイオードを図2bに示します。図2cは、順方向電流-電圧( I )の測定セットアップを表しています。 - V )β-Ga 2 の特性 O 3 SBD、測定電圧の範囲は0〜3 Vで、ステップは10mVです。図2dは、逆電流-電圧( I )の測定セットアップを示しています。 - V )β-Ga 2 の特性 O 3 ブレークダウン電圧を取得するためのショットキー整流器。測定電圧の範囲は0〜-500 Vで、ステップは-1Vです。

a XRDロッキングカーブと b β-Ga 2 のAFM画像 O 3 (100)β-Ga 2 から機械的に剥離したドリフト層 O 3 基板 c 測定されたシート抵抗10mm×10mmβ-Ga 2 O 3 基板
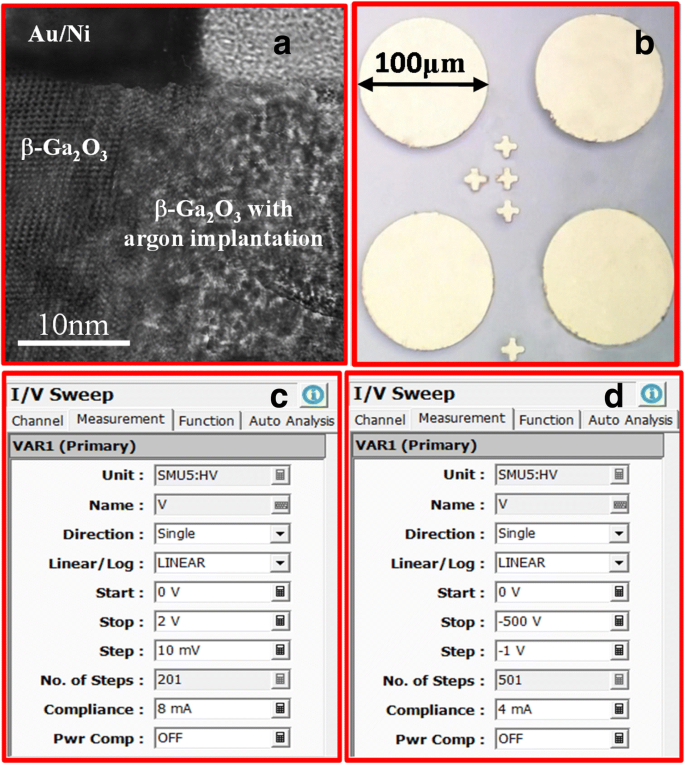
a サンプルCと b のTEM画像 終了したβ-Ga 2 の写真 O 3 ショットキーダイオード c 順方向電流と d の測定セットアップ β-Ga 2 の逆電流-電圧(I-V)特性 O 3 絶縁破壊電圧を取得するためのSBD
結果と考察
図3は、実験的な1 / C を示しています。 2 対 V 室温での3つのSBDサンプルの特性。有効キャリア濃度 N d - N a β-Ga 2 の O 3 ドリフト層とビルトインポテンシャル( eV bi )は(1.3±0.04)×10 17 になるように抽出されます cm -3 および(1.30±0.08)eV、それぞれ。次の式によると、ショットキー障壁の高さφ b_CV は(1.32±0.08)eVと計算されます。
$$ \ frac {1} {C ^ 2} =\ frac {2} {q \ varepsilon {A} ^ 2 \ left({N} _d- {N} _ {\ mathrm {a}} \ right)} \ left({V} _ {bi} -V \ right)$$(1)$$ e {\ varphi} _b ={eV} _ {bi} + \ left({E} _c- {E} _f \右)-e \ Delta \ varphi $$(2)$$ {E} _c- {E} _f =kT \ ln \ left(\ frac {N_c} {N_d- {N} _a} \ right)$$( 3)$$ e \ Delta \ varphi ={\ left \ {\ frac {e} {4 \ pi \ varepsilon} {\ left [\ frac {2 {eV} _ {bi} \ left({N} _d- {N} _a \ right)} {\ varepsilon} \ right]} ^ {1/2} \ right \}} ^ {1/2} $$(4)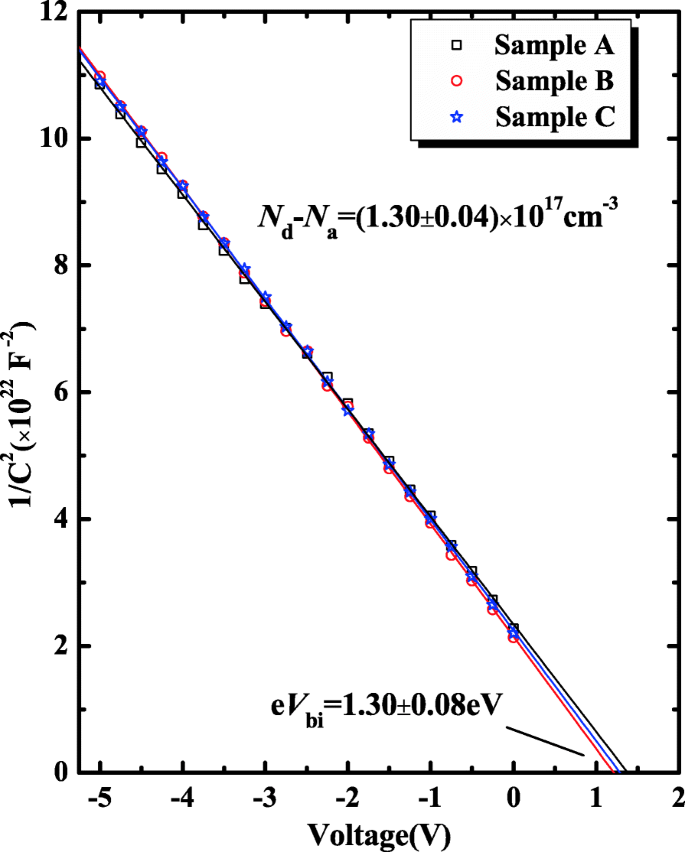
1 / C 2 - V 3つのβ-Ga 2 のプロット O 3 SBDサンプル
ここで A 、 q 、およびε ショットキー接触面積、電子電荷、およびβ-Ga 2 の誘電率です。 O 3 。 E c 、 E f 、eΔφ 、 k 、 T 、および N c は、伝導帯の最小値、フェルミ準位、イメージ力によって引き起こされるポテンシャル障壁の低下、ボルツマン定数、K単位の絶対温度、伝導帯の有効状態密度です。
図4aは、順方向電流密度-電圧( J - V )β-Ga 2 の特性 O 3 SBD。順方向バイアスでは、アルゴン注入は電気的特性に大きな影響を与えません。しきい値電圧は、 I の3つのサンプルについて、0.91 V、0.92 V、および0.95Vと決定されます。 on / 私 オフ 比率はすべて10 9 より大きい 室温で線形領域をフィッティングすることにより、特定のオン抵抗( R on )は1.7、2.1、3.3mΩcm 2 、および2 Vでの順方向電流密度は857、699、および621 A / cm 2 図4aの挿入図に示すように、それぞれ3つのサンプルについて。電流密度はより高く、比オン抵抗はドリフト層のより高い導電率とキャリア密度について報告された値よりも低いか、それに匹敵します[12、13、26、27、28、29、30]。
>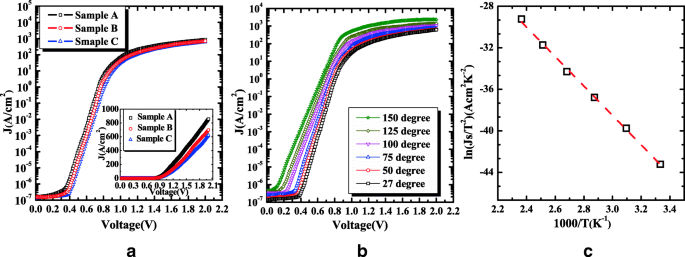
a フォワード J - V 終端および未終端のβ-Ga 2 の特性 O 3 室温および b 温度依存のフォワード J - V 300〜423KのサンプルCの特性。 c リチャードソンのln( J のプロット s / T 2 )vs 1000 / T サンプルCの
前方特性の温度依存性に対するアルゴン注入の影響を調査するために、前方 J - V サンプルCの測定は、図4bに示すように、300〜423Kで行われます。理想的な要素 n ショットキー障壁の高さφ b_JV 室温で1.06および1.22eVと決定され、φよりも低くなります。 b_CV 熱電子放出(TE)モデル[31、32]によると、(1.32±0.08)eVの。温度が上がると、 n 1.06から1.02に減少し、バリア高さはわずかに減少しますが、温度範囲全体で1.21±0.01 eVでほぼ一定です。これは、温度上昇に伴う理想的なショットキーダイオードのバリア高さの減少とは対照的ですが、製造されたβ-Gaで観察されています。 2 O 3 SBD [26]。方程式ln( J s / T 2 )=ln(A *)-q ϕ b / kT 、バリアの高さ ϕ b 実効リチャードソン定数A *は、1.22eVおよび48.5A / cm 2 であると決定されます。 K 2 勾配と y からのサンプルCの場合 -図4cに示すように、プロットの線形領域の軸切片。さらに、3つのサンプルで抽出された数十のデバイスのA *値は、24〜58 A / cm 2 です。 K 2 、以前の実験結果と理論値と一致して、24〜58 A / cm 2 K 2 、有効電子質量 m * =0.23–0.34 m 0 β-Ga 2 の O 3 [33,34,35,36,37]。
図5aは、逆の J を示しています。 - V サンプルの特性。アルゴン注入後、絶縁破壊電圧は209Vから252Vおよび451Vに上昇し、バリガの性能指数(V BR 2 / R on )3つのサンプルの場合、約25.7、30.2、および61.6 MW cm -2 、 それぞれ。注入中に、いくつかの欠陥が導入され、リーク電流の大幅で望ましくない増加につながる可能性があります。これは、SiCおよびGaNショットキーダイオードデバイスでも報告されています[18、19、20]。熱アニーリングはアルゴン注入後に実施されましたが、サンプルBとCのリーク電流はまだわずかに大きいため、順方向および逆方向の電気的特性に関するアニーリング後の温度と持続時間の調査の詳細については、次の論文で説明します。

a 逆の J - V β-Ga 2 の特徴 O 3 室温でのサンプル。 b および c β-Ga 2 の絶縁破壊電圧の分布 O 3 アルゴン注入の有無によるSBD
図5b、cは、β-Ga 2 の絶縁破壊電圧の分布を示しています。 O 3 アルゴン注入の有無によるショットキー整流器。これらのデバイスの理想的な平面並列降伏電圧は、5.1〜5.3 MV / cmの臨界電界を使用して553〜598 Vと決定されます[11、39]。アルゴン注入なしの絶縁破壊電圧は約110〜310 Vで、理想値の約50%です。ただし、アルゴン注入量が5×10 14 の場合 cm −2 、ブレークダウン電圧は150〜350 Vに上昇しますが、1×10 16 のドーズ量では、リファレンスデバイスよりもそれほど大きくはありません。 cm −2 、絶縁破壊電圧が理想値に近づいています。この作業では、550Vの最大絶縁破壊電圧を得ることができます。さらに、絶縁破壊電圧での電界分布をシミュレートしました。簡単にするために、TRIMシミュレーションによって決定された50 nmの注入深さで単一のミッドギャップアクセプターレベルが追加され、図6に示すように、不完全なイオン化モデルも考慮されました[38]。明らかに、高抵抗層は効果的に平滑化されます。接合部のコーナーで電界を出力し、参照サンプルと比較してブレークダウン電圧を大幅に向上させます。報告された結果[11、39]と同様に、絶縁破壊電圧での最大電界はすべて約5.05 MV / cmですが、位置は、次のように、界面のアノードコーナーから注入領域のすぐ下のオーバーラップコーナーに変化します。図6d、e。
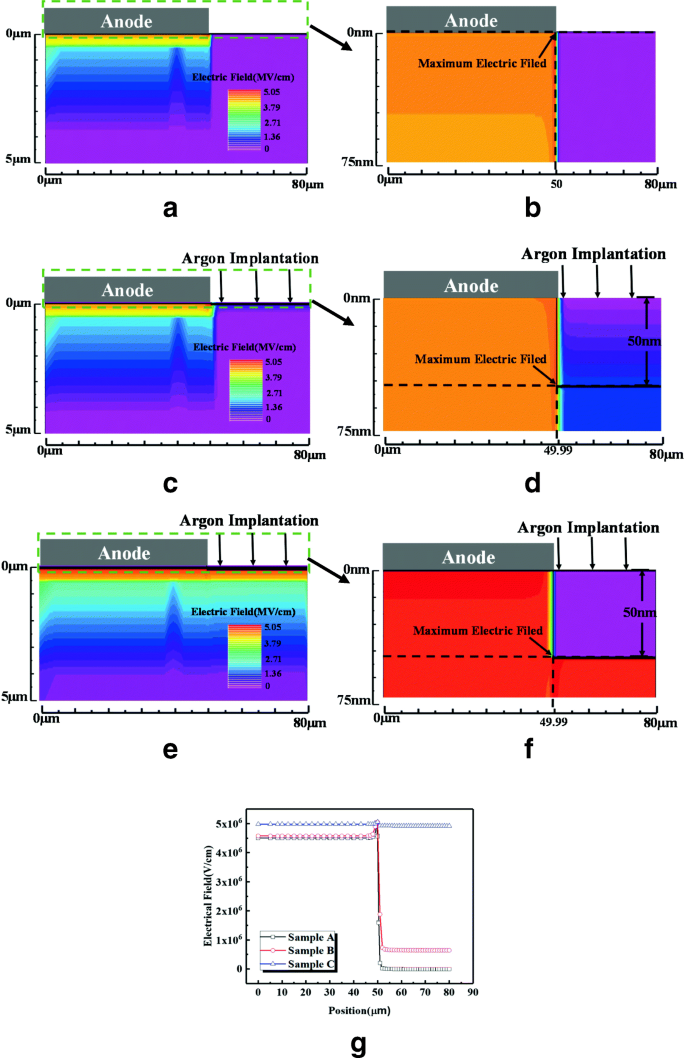
サンプルA〜Cの絶縁破壊電圧での電界分布のシミュレーション( a 、 c 、 e )、破線のボックス内の選択された領域の拡大画像( b 、 d 、 f 、 g )、シミュレートされた電界と( b の破線に沿った位置) 、 d 、 f )3つのサンプルの場合、Au / Ni /β-Ga 2 O 3 サンプルAのインターフェース、サンプルBとCのインターフェースよりそれぞれ50nm下。最大フィールドは5.05MV / cm
結論
垂直Au / Ni /β-Ga 2 O 3 アルゴン注入によって形成されたエッジ終端を備えたショットキーバリアダイオードは、β-Ga 2 上に製造されました。 O 3 高品質(100)配向のβ-Ga 2 から機械的に剥離したドリフト層 O 3 バルク基板。制御装置と比較して、特定のオン抵抗( R on )1.7から2.1および3.3mΩcm 2 に増加 絶縁破壊電圧は、5×10 14 の注入線量で209から252、451Vに増加します。 cm −2 および1×10 16 cm −2 、それぞれ、より大きな逆リーク電流で。絶縁破壊電圧での最大電界は約5.05MV / cmで、SiCやGaNよりもはるかに大きくなっています。
略語
- AFM:
-
原子間力顕微鏡
- EFG:
-
エッジで定義されたフィルムフィードの成長
- FWHM:
-
半値全幅
- FZ:
-
フローティングゾーン
- HRXRD:
-
高解像度X線回折
- JTE:
-
ジャンクションターミネーションエクステンション
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- RMS:
-
二乗平均平方根
- SBD:
-
ショットキーバリアダイオード
- TE:
-
熱電子放出
ナノマテリアル
- STは、STM32ニューラルネットワーク開発者ツールボックスを使用して、AIをエッジおよびノード組み込みデバイスに駆動します
- ept:0.8mmピッチの高速SMTエッジカードコネクタ
- Future Electronics:音質が改善されたCUIのMEMSマイク
- アドバンテックは、NVIDIAを使用してクラウドからエッジへの高速コンピューティングを実現します
- ADLINK:EdgeAISolutionsとNVIDIAEGXプラットフォームを使用してAIをエッジからクラウドにデプロイする
- ADLINKがEdgeIoT Smart PalletExperienceでより速くより正確なロジスティクスを発表
- シスコは、エンタープライズとインダストリアルのエッジを新しいルーターと結び付けています
- エッジ分析によるインダストリー4.0のアップグレード
- エッジコンピューティングの進歩、IICがOpenFogに参加
- コロナウイルスと戦うために採用されたアドバンテックのエッジコンピューターを搭載したスマート5Gパトロールロボット
- エッジでAI推論を開始する方法



