フォトルミネッセンスによって研究されたInGaN / GaN量子井戸における2種類の局在化状態間のキャリア再分布
要約
InGaN / GaN多重量子井戸(MQW)は、各InGaN井戸層に追加で成長させたキャップ層の厚さを除いて、有機金属化学蒸着(MOCVD)によって同じ条件で準備されます。薄いキャップ層サンプルのフォトルミネッセンス(PL)強度は、厚いキャップ層サンプルのフォトルミネッセンス(PL)強度よりもはるかに強力です。興味深いことに、厚いキャップ層のサンプルには、高い励起パワーの下で2つのフォトルミネッセンスピークがあり、PLピークのエネルギー-温度曲線は、励起パワーの増加に伴い、逆V字型から通常のS字型への異常な遷移を示しています。一方、それは、より低い励起電力の下でのそれよりもより高い励起電力の下での厚いキャップ層サンプルのより劣った熱安定性を示す。このような非典型的な現象は、厚いキャップ層サンプル中のインジウム組成の不均一な分布によって引き起こされる、2種類の局在状態間のキャリアの再分布に起因します。さらに、深い局在状態の発光はより良い熱安定性を有し、浅い局在状態の発光は不十分な熱安定性を有する。実際、このようなより深刻な不均一なインジウム分布は、低温GaNキャップ層の成長時間が長くなることによるInGaN / GaNMQW領域のその後のエピタキシャル成長の劣化によって引き起こされる可能性があります。
はじめに
InGaN / GaN多重量子井戸(MQW)構造は、発光ダイオード(LED)およびレーザーダイオード(LD)で広く使用されているため、大きな注目を集めています[1,2,3,4,5,6]。 InGaN / GaN MQWの自発分極と圧電分極によって引き起こされる高い貫通転位密度と波動関数の減少は重なりますが、それらの輝度効率は依然として驚くほど高いです[7,8,9,10]。主な理由の1つは、インジウム含有量の変動による潜在的な最小値での励起子の局在化が、InGaN / GaN量子井戸での量子ドットのような状態の形成につながることです[11]。ただし、ローカリゼーション状態が発光メカニズムでどのように果たす役割はあいまいなままです。いくつかの研究では、InGaN組成の変動が放射およびオージェ再結合に及ぼす影響が報告されています[12、13、14]。ジョーンズが使用した原子的タイトバインディングの理論的シミュレーションでは、局在化によって放射再結合率とオージェ再結合率の両方が増加するが、オージェ再結合率は放射再結合率よりも1桁高くなることがわかりました[15]。実験的に、キャリアの局在化は、オージェ再結合プロセスにおけるk選択規則の緩和につながり、したがって、高光励起下での極性InGaN / GaNQWにおけるオージェ再結合プロセスを強力に強化します[16]。発光ピークエネルギーの温度依存性のS字型の振る舞いは、キャリアの局在化の指紋であることはよく知られています。ローカライズされた状態アンサンブル(LSE)モデルなどの多くのモデルが、キャリアのローカリゼーションと熱再分配の動作を説明するために提案されており、温度による発光ピークエネルギーの変化は、さまざまな励起レベルでの固有のキャリア再分配プロセスによって影響を受ける可能性があることを示しています[17、 18,19,20,21]。一般に、レーザーダイオードのような製造されたデバイスは、常により高い注入キャリア密度で動作します[22]。この場合、局在化状態のフォトルミネッセンススペクトルは、局在化状態の均一性に関連する異なる励起レベルで独特の挙動を示す可能性があります。したがって、InGaNデバイスに対する合金の変動の影響を理解するには、さらなる研究が必要です。
この作業では、各InGaNウェル層上に追加で成長するGaNキャップ層の厚さが異なる2つの典型的なサンプルを、有機金属化学蒸着システム(MOCVD)によって準備します。 MQWの特性は、高分解能X線回折(HRXRD)、温度依存フォトルミネッセンス(TDPL)、および電力依存フォトルミネッセンス(PDPL)測定によって詳細に特徴付けられます。厚いキャップ層のサンプルは、高い光励起パワーの下で、より高いエネルギー側で異常なピークを示すことがわかります。これは、2つの異なる種類のローカライズされた状態の共存を意味します。一方、PL強度は、励起パワーが高くなるにつれて、低温でより速く減衰します。したがって、深い局在状態のフォトルミネッセンスは熱安定性が高く、浅い局在状態のフォトルミネッセンスは熱安定性が低いと推測できます。
メソッド
資料
密結合シャワーヘッドリアクター内のAIXTRON3×2によってc面サファイア基板上に成長させた異なるキャップ層の厚さのInGaN / GaNMQWサンプルを研究します。トリメチルガリウム(TMGa)、トリメチルインジウム(TMIn)、およびアンモニア(NH 3 )は、それぞれGa、In、およびNソース前駆体としてエピタキシャル成長に使用されました。ここで、H 2 およびN 2 それぞれ、GaNおよびInGaN成長のキャリアガスでした。 MQWは、2周期のInGaN / GaNQWで構成されています。各ウェル層の成長中、TMInの流速は一定に保たれました。次に、GaNキャップ層を同じ温度、つまり710°Cで成長させました。その後、温度を830°Cまで上昇させ、数秒間そのままにしてから、バリア層を830°Cで成長させました。サンプルAとBはどちらも、GaNキャップ層の成長時間を除いて同じ条件下で成長します。つまり、サンプルAでは30秒、サンプルBでは200秒です。2つのInGaN / GaNMQWの構造と成長パラメータの概略図AとBを図1に示します。
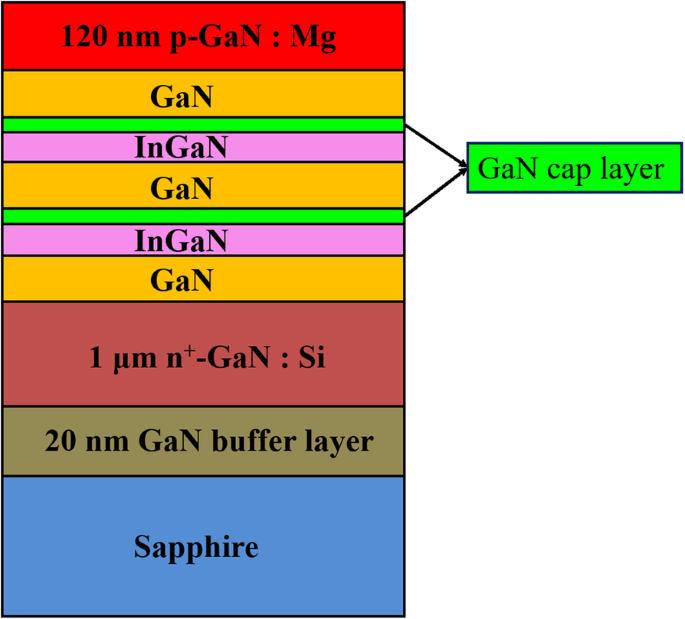
2つのMQWのエピ層構造の断面概略図
特性評価
2つのInGaN / GaN MQWの平均インジウム含有量、周期の厚さ、および材料品質を決定するために、高分解能X線回折(HRXRD)測定が、動作するCu-Ka放射線(λ=1.54Å)を使用したRigaku UltimaIVで実行されます。 40kVおよび30mAで。温度依存フォトルミネッセンス(TDPL)および励起パワー依存PL(PDPL)の測定では、スポットサイズが0.5 mm 2 の励起光源として405nmレーザーを使用しました。 、および励起電力は0.01〜50mWで変化しました。サンプルはクローズドサイクルのHeクライオスタットに取り付けられ、温度は10〜300Kに制御されました。
結果と考察
2つのサンプルAとBの構造特性を調査するために、図2aに示すように、ω-2θ対称(0002)スキャンが実行されました。基板のピークはGaN(002)面に由来し、衛星のピークはMQWに由来します。 4次までの衛星ピークは、2つのサンプルすべてではっきりと観察でき、良好な層周期性を示しています。さらに、表1に示すように、測定された曲線をフィッティングすることにより、平均インジウム組成と周期的厚さを取得できます。キャップ層の厚さが増加すると、GaNバリアの厚さとInGaNの厚さとインジウム組成がわかります。ウェル層はわずかに増加します。実際、キャップ層の成長速度は0.006 nm / sと小さく、成長温度は710 Kと低いため、バリアの厚さの変化は比較的小さくなります。ただし、追加のGaNキャップ層の成長は、バリア層の厚さだけでなく、後で詳しく説明するように、InGaNウェル層内のIn原子の拡散、蒸発、および再分布にも影響を与える可能性があることに注意してください。

オメガ-2シータスキャンと両方のサンプルの逆格子空間マッピングは、HRXRDによって実行されます。 a サンプルAおよびBのGaN(0002)平面上のHRXRDオメガ-2シータ曲線。 b サンプルAのGaN(10–15)回折の逆格子空間マッピング(RSM)
一方、GaNQB層とInGaNQW層のひずみ状態を調べるために、GaN(10–15)面の近くで逆格子空間マッピング(RSM)が実行されます。サンプルAの結果を図2bに示します(BのRSMの図は似ていますが、ここには示されていません)。サンプルAの場合、MQWとGaNピークのサテライトピークが同じ垂直線上によく整列していることがわかります。これは、両方のサンプルのMQWが緩和なしで完全に歪んでいることを示しています[23]。
図3は、10Kでの2つのサンプルのPDPL測定値を示しています。2つのサンプルがまったく異なる動作を示すことは興味深いことです。サンプルAの場合、低エネルギー側に小さなピークがあります(ピーク A 1 )ドミナントピークの A 2 。ピーク A 1 メインピーク A から92meV離れたフォノンレプリカです。 2 。 B のフォノンレプリカ 2 サンプルBにも表示され、ピーク B と呼ばれます。 1 。一方、図3bでは、主要な発光ピークが1つしかないことがわかります B 2 励起電力が5mW未満の場合。ただし、励起電力が10 mWを超えると、別のピーク B 3 B の高エネルギー側に異常が現れる 2 、およびピーク B 3 ピーク B ではなく、徐々に主要な発光ピークになります 2 励起パワーがさらに増加したとき。ここでは、光励起キャリアの大部分が最初に最初のタイプの電子状態(たとえば、ローカルのインリッチクラスターによって作成された局所状態)にトラップされ、次に放射的に再結合して、発光ピーク Aを生成すると想定できます。 2 および B 2 。 [24]。
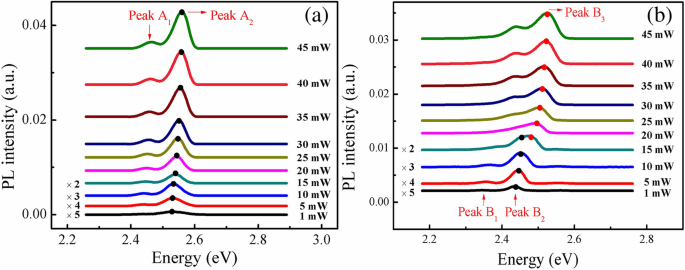
サンプルAのPLスペクトル( a )およびB( b )10 Kの温度で測定された、いくつかの異なる励起パワーで
異常なピークの振る舞いを調べるには B 3 さらに、サンプルBについて、図4に示すさまざまな励起パワーでTDPL測定を実行しました。ここで、図4aとbは、それぞれ5mWと40mWの励起パワーで得られたPLスペクトルです。図4bの発光スペクトルの2つのピーク現象は、200 K未満の温度ではっきりと見られ、300 Kに向かってぼやけていることに注意してください。発光スペクトルの動作を要約すると、低エネルギー発光ピークから高エネルギー放出ピークは、狭い範囲の励起パワーで発生し、「スイッチング」特性を備えています。狭い遷移領域の外側では、単一の低エネルギー( B 2 )または高エネルギー( B 3 )発光ピークは、それぞれ低励起パワーと高励起パワーで支配的です。
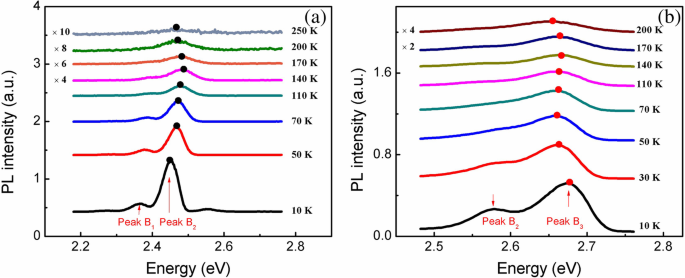
5 mW( a )の励起パワーで測定された、10〜300Kの温度範囲でのサンプルBのPLスペクトル )および40 mW( b )
さらに、両方のサンプルの温度による支配的な放出ピークエネルギーの変化を詳しく調べると、ユニークなものを見つけることができます。図5aに示すように、サンプルAの励起電力が5から40 mWに増加すると、温度の上昇に伴うPLピークエネルギーの変化(以下のET曲線と呼ばれます)は、通常とは異なる「逆V字型」曲線を示します。 「S」字型。逆V字型は、ピークエネルギーの全体的な青方偏移を除いて、励起パワーの増加に伴ってほとんど変化しません。逆の「V」字型の温度依存性は、発光中心でのキャリア充填効果と温度上昇に伴うバンドギャップ収縮効果の共同作用として説明されます[25、26]。一方、図5bに示すように、5 mW未満の励起パワーでのサンプルBのE-T曲線は、逆V字型を示しています。この状況はサンプルAと同様です。ただし、励起電力が徐々に40 mWに増加すると、最初の赤方偏移がより低い温度範囲で現れ、E-T曲線は規則的なS字型になります。明らかに、この現象は、励起パワーが十分に大きい場合、局在化効果が完全に消失し、ピークエネルギーの温度挙動がVarshniの法則に厳密に従うという予想と矛盾します[27]。

サンプルAの温度の関数としてのPL発光ピークエネルギー( a )およびB( b )異なる励起パワーの下で。実線は、LSEモデルを使用した理論的なフィッティング曲線です。点は実験データです
したがって、局在状態の発光の観測された異常な励起光パワー依存性を定量的に説明するために、LSE発光モデルを使用してE-T曲線を適合させました。これはQ.Liらによって提案されました。このモデルはすべての温度範囲で使用でき、「S」字型のE-T曲線だけでなく、「V」字型または逆「V」字型にも適合します。さらに、LSEモデルは高温でEliseev et al。のバンドテールモデルに還元できることも証明されました[24、25]。このモデルでは、温度の関数としてのピークエネルギーは[18,19,20,21]:
として記述できます。 $$ E(T)=\ left({E} _0- \ frac {\ alpha {T} ^ 2} {\ theta + T} \ right)-{xk} _BT $$(1)ここで、θ は特定の材料のデバイ温度であり、 a Varshniパラメータ k です。 B はボルツマン定数であり、 x 次の超越方程式[18,19,20,21]によって数値的に解くことができます:
$$ {xe} ^ x =\ left [{\ left(\ frac {\ sigma} {k_BT} \ right)} ^ 2-x \ right] \ left(\ frac {\ tau_r} {\ tau_ {tr} } \ right){e} ^ {\ left({E} _0- {E} _a / {k} _BT \ right)} $$(2)ここで、σ ローカライズされた状態の分布の標準偏差です。つまり、ガウス型の状態密度分布の幅を意味します。 τ r およびτ tr 局在キャリアの放射再結合と脱出寿命を表し、したがってτ r / τ tr 非放射的に再結合するキャリアの部分を意味します。 E 0 は局所化された中心の中心エネルギーであり、 E a は「マーキング」レベルを示します。このレベルを下回ると、すべてのローカライズされた状態が0 Kのキャリアによって占有されます。これは、フェルミディラック分布の擬フェルミ準位と同じです。 E であることは明らかです 0 および E a 一緒に発光局在中心の起源に関連しています[17]。
両方のサンプルで取得されたフィッティングパラメータを表2に示します。サンプルAの場合、中心エネルギー E 0 および E a 5から40mWにそれぞれ19meVと18meVに変更されます。 E 0 - E a およびσ ほとんど変更されていません。励起パワーが大きくなると、ますます多くのキャリアが励起されるからです。まず、InGaNウェルの強力な圧電場が光生成キャリアによって遮蔽され、中心エネルギーの増加につながります E 0 。第二に、充填効果に応じて、ますます多くのキャリアがより高い電子状態を占めるようになり、その結果、局在化したキャリアの擬フェルミ準位が増加します E a 。したがって、 E 0 - E a は、偏光遮蔽効果とキャリア充填効果の共同作用を表しており、サンプルAのピーク位置の全体的な青方偏移が観察されます。サンプルAとは異なり、サンプルBの場合は5〜40 mWで、 E が大幅に増加します。 0 および E a 、それぞれ73meVと57meV。 E 0 - E a 16 meV増加、τ r / τ tr 数桁変化し、σ 少し減少します。このような変化は非常に大きいため、5mWと40mWの異なる励起パワーで発光中心の原点が異なると想定する必要があります。
<図>したがって、サンプルBの場合、インジウム組成の不均一な分布により、ウェル層に2つの異なるエネルギー深度で分布する、つまり、インジウム組成が高い(深い局在状態)と低い、2種類の局在状態があることが示唆されます。インジウム組成(浅い局在状態)。さらに、サンプルBの上記の現象を説明するために、2種類の局在状態間のキャリア再分布の考えられるメカニズムを示す概略図を図6にプロットします。10K、5mWなどのより低い励起パワーで図6aでは、光励起されたキャリアの大部分が最初に最初のタイプの電子状態(深い局在状態)にトラップされるため、低いエネルギーピークが支配的ですが、図6bに示すように40 mWでは、ますます光生成されますキャリアはより高いエネルギーレベルを占め、次に、より高いエネルギー状態密度を持つ浅い局所状態も満たされるため、励起電力の増加に伴い、より高いエネルギーピークが徐々に支配的になります。したがって、 E 0 および E a 大幅に増加し、τ r / τ tr ローカライズされた状態からのキャリアの脱出能力を意味する数桁増加します。図6cに示すように、温度が5mWで30Kに上昇すると、一定量の熱エネルギーを持つ光生成キャリアは、主に、より深い局所状態を埋めるために使用され、E-T曲線の最初のブルーシフトが発生します。ただし、図6dでは、40 mWになると、浅い局所状態は深い局所状態よりも容量が大きいという仮定に基づいて、光生成されたキャリアの大部分は浅い局所状態にとどまり、転送できるようになります。キャリアを結合する強力な能力を持っている深い局所化された状態に。したがって、E-T曲線は赤方偏移します。言い換えれば、ET曲線の外観の異常な変化は、サンプルBのInGaNウェル層の不均一なインジウム分布による複数の種類の局在状態に関係しています。このような組成の変動は、主に原子スケール[28]。

異なる励起パワーでのPLピークエネルギー対T曲線の異常な変動の考えられるメカニズムを示す概略図。より低いT(10 K)でのキャリア分布を( a )に示します。 )および( b ) P の場合 =それぞれ5mWと40mW。より高いT(30 K)でのキャリア分布を( c )に示します。 )および( d ) P の場合 =それぞれ5および40mW
さらに、サンプルBの高励起パワーの下での高エネルギー発光ピークの出現も、PL積分強度の異常な変動につながります。図7には、5mWと20mWの励起パワーで測定されたサンプルAとBの積分強度対温度曲線がそれぞれプロットされています。まず、サンプルBの熱消光はサンプルAの熱消光よりも明らかに速いことに注意してください。一般に、InGaN MQWの発光熱消光は、アレニウスの式で説明できる非放射再結合プロセスによって支配されます。したがって、迅速な熱消光は、サンプルBの熱安定性が低いことを意味します。さらに、励起パワーが十分に高い場合、非放射再結合中心は容易に飽和するため、比較的低温での非放射再結合中心の影響はそれほど重要ではありません。過剰なキャリアによる[27]。これは、サンプルAの励起パワーの増加に伴うPL積分強度と1 / T曲線の変化が遅いことを完全に説明できます。ただし、サンプルBの場合、5mWの励起パワーで正規化された積分強度がさらに高いことは非常に興味深いことです。温度が125K未満の場合は20mW未満の場合よりも高く、125 Kを超える場合は逆になります。前述のように、深い局在状態に由来する1つの低いエネルギー放出ピークのみが支配的であると想定されます。 5 mWで、浅い局所状態に由来する別のより高いものが20mWで支配的になります。したがって、深く局在化した発光中心は、浅い発光中心よりも優れた発光効率を有すると結論付けられる。これは、局所化された状態に関連する以前の研究結果とよく一致しています[28]。したがって、サンプルBでは20mWで励起された2種類の局在状態があることもある程度証明できます。
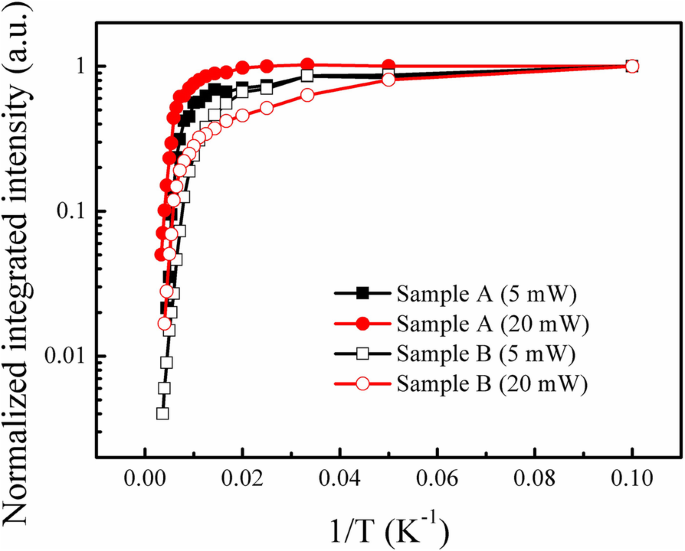
5mWおよび20mWの励起パワーで測定された、10〜300Kの温度範囲で両方のサンプルのPLスペクトルから抽出された積分強度
これらすべての分析に基づいて、ピーク B 3 サンプルBのインジウム組成の不均一な分布に関連する電位の低い局在状態に由来します。これは、より高い発光エネルギーピークの実験結果とよく一致します B 3 そして、より高い励起パワーの下での低温でのサンプルBのIQEの減少。実際、QWの成長過程では、引っ張り効果を考慮すると、インジウム原子はInGaN QW層の上部に蓄積し、インジウム浮遊層と呼ばれる余分な層を形成する傾向があります[29]。低温でのより厚いGaNキャップ層の成長は、これらのインジウム浮遊原子の蒸発に有害です。その結果、In原子はQW成長後にGaNキャップ層とバリア層に組み込まれる可能性があります[30]。当然、この振る舞いはウェル層の厚さの増加をもたらし、したがってQCSEが強化されます。アクティブQWのより高いひずみとより強い圧電場は、より局所的な緩和を誘発し、したがって、より深い局所的な電位とより高い障壁を誘発します。その間、より多くの転位と欠陥が、その後のGaNバリア層の成長に導入されます。一般に、転位の近くには大きな引張応力があり、インジウム原子は転位の近くに蓄積して不均一に分布する傾向があります。 [31、32]したがって、InGaNウェル層の成長では、転位密度の増加に関連して、インジウムが豊富な領域とインジウムが少ない領域が多くなります。これは、キャッピング層の厚さが増すにつれて、インジウムの変動の規模が大きくなることを意味します。私たちの実験では、2種類の局在状態がより厚いキャップ層を持つサンプルBに導入され、より高い励起パワーの下でより高い発光エネルギーのPLピークが活性化されることを示しています。一方、光生成キャリアが深い局在状態にとどまると、欠陥をふるいにかけることができるため、熱安定性が向上します。一方、光生成キャリアが浅い局在状態にとどまると、欠陥に関連する非放射再結合によって捕捉されます。バリアの高さが比較的低い。
結論
要約すると、InGaNウェル層上に追加で成長させた異なる厚さのGaNキャップ層を備えたInGaN / GaN多重量子井戸(MQW)サンプルは、有機金属化学蒸着システム(MOCVD)によって準備されます。それらの構造的および光学的特性は、HRXRD、TDPL、およびPDPL測定によって調査され、分析されます。 PDPLの結果は、厚いキャップ層で成長したサンプルBについてのみ、より高い励起パワーで追加の高発光エネルギーピークが励起されることを示しています。一方、サンプルBのさまざまな励起パワーで測定されたTDPLの結果は、励起パワーが増加すると、支配的なPLピークのE-T曲線が逆V字型から通常のS字型に変化することを示しています。さらに、高い励起パワーでのサンプルBの熱安定性が低いことがわかりました。これらの異常な現象は、比較的不均一なインジウム分布によって引き起こされるサンプルBの2種類の局所的な状態があることを意味します。これらの結論により、緑色のInGaN / GaN量子井戸のフォトルミネッセンスメカニズムと、InGaN / GaNレーザーダイオードの製造に役立つ可能性のある高励起レベルでの不均一性の影響についてさらに理解することができます。
略語
- HRXRD:
-
高解像度X線回折
- LD:
-
レーザーダイオード
- LED:
-
発光ダイオード
- LSE:
-
ローカライズされた状態のアンサンブル
- MOCVD:
-
有機金属化学蒸着システム
- MQW:
-
マルチ量子井戸
- NH 3 :
-
アンモニア
- PDPL:
-
パワー依存フォトルミネッセンス
- RSM:
-
逆格子空間マッピング
- TDPL:
-
温度依存のフォトルミネッセンス
- TMGa:
-
トリメチルガリウム
- TMIn:
-
トリメチルインジウム
ナノマテリアル
- 構造的および光学的性質を改善するためのH2 / NH3混合ガス中のGaNベースの多重量子井戸の原子転位
- 電子増倍管の発光層の設計
- 半極性InxGa1-xN / GaN多重量子井戸を備えた紫外線GaNベースのフォトニック準結晶ナノピラミッド構造からの多色発光
- 自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
- アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解



