オゾンとプラズマポスト酸化によって形成されたGeOxパッシベーションを備えたGepMOSFET
要約
GeO x を使用したGepMOSFETの電気的性能に関する比較研究 オゾン後酸化(OPO)とプラズマ後酸化(PPO)によって形成されたパッシベーション層が実行されます。 PPOとOPOはAl 2 で実行されました O 3 / n-Ge(001)基板とそれに続く5 nm HfO 2 ALDチャンバーにその場で堆積されたゲート誘電体。誘電体/ Ge界面層の品質は、X線光電子分光法と透過型電子顕微鏡法によって特徴づけられました。 PPO処理により、正のしきい値電圧( V TH )シフトと下の I オン / 私 オフ 比率。これは、インターフェイスの品質が低いことを意味します。 OPOを備えたGepMOSFETは、より高い I を示します オン / 私 オフ PPOデバイスと比較して、比率(最大4桁)、サブスレッショルドスイングの改善、およびキャリア移動度特性の向上。より厚いAl 2 O 3 OPOプロセスのブロック層は、Geトランジスタの移動度を高めます。 2つの異なる酸化方法を比較することにより、結果は、OPOが界面層の品質を向上させる効果的な方法であり、GepMOSFETの有効な移動度の向上に貢献していることを示しています。
背景
従来の相補型金属酸化膜半導体(CMOS)デバイスが物理的限界に近づいているため、チャネル材料としてシリコン(Si)を使用する高速半導体デバイスのパフォーマンス向上を実現することは困難です。基板またはチャネル材料を移動度の高い他の材料と交換することは必須のオプションです。ゲルマニウム(Ge)は、Siよりもキャリア移動度が高いため、有望な代替チャネル材料と見なされています。 MOSFETは通常、高い実効移動度を達成するために高品質の酸化物/半導体インターフェースを必要とします。ただし、かなり長い歴史の中で、Ge MOSFETは高い界面状態密度( D )に悩まされていました。 それ )GeO 2 の熱安定性が低いことが原因 ダングリングボンド[1]。このように、Geインターフェースのパッシベーションについて多くの研究が行われてきました。
高品質のGe /誘電体界面層を実現するためのいくつかのアプローチが報告されています。たとえば、誘電エピタキシーの前にGe基板上に複数のSi単分子層を均一に堆積させることによるSiパッシベーションや、GeO 2 を形成することによる自己パッシベーションなどです。 わざと[2、3]。高品質のGeO 2 を形成するために 層、 D を減らすために多くの酸化プロセスがあります それ 高圧酸化[4]、オゾン酸化[5]、H 2 などの熱安定性を向上させます Oプラズマ[6]、および酸化後の電子サイクロトロン共鳴(ECR)プラズマ[7]。
近年、Al 2 による後酸化により高性能GeMOSFETを実現できることが多く報告されています。 O 3 / Geインターフェース。 2014年、Ge CMOSインバーターは、GeO x を備えたGe-on-insulator(GeOI)基板上に実現されました。 1 nmAl 2 後の純酸素環境での急速熱アニーリングにより成長 O 3 Geに堆積した[8]。参考文献で。 [7]、GeO x を備えたGepMOSFETおよびnMOSFET 不動態化は、酸化後の酸素プラズマとGeO x の温度依存性を使用して製造されました。 厚さと電気的性能についても議論されました。オゾンは酸素よりも反応性が高いため、オゾンによるGeの熱酸化は低温で行うことができます[5]。 GeO x に対する温度の影響 Ge表面でオゾンによって成長した厚さが実証されました。 GeO x を備えたGepMOSFET オゾン後酸化によって生成された不動態化も報告されました[9]。
この作業では、GeO x を備えたGepMOSFET 不動態化は、Al 2 のオゾン後酸化(OPO)と酸素プラズマ後酸化(PPO)を使用して製造されます。 O 3 / n-Geインターフェース。 GepMOSFETとOPOおよびPPOの電気的性能の比較研究が行われます。パッシベーションを除くすべてのプロセスは、同じになるように正確に制御されます。後酸化は、Al 2 の後に実行されました。 O 3 酸化後がHfO 2 の後にあった[9]とは異なるブロック層の堆積 沈着。 クーロンの移動度低下メカニズム 粗さ散乱を調べます。 Al 2 の厚さの影響 O 3 デバイスパフォーマンスのブロックレイヤーについても説明します。全体として、OPOが将来のGeMOSFET製造のための有望なパッシベーション技術であることを示しています。
メソッド
GepMOSFETは4インチで製造されました。抵抗率が0.14〜0.183Ωcmのn-Ge(001)ウェーハ。 3つの異なるパッシベーションプロセスが実行され、主要なプロセスステップが図1aに示されています。ウェーハは、希釈HF(1:50)と脱イオン水で数サイクル洗浄して自然酸化物を除去し、すぐにプラズマ化学気相堆積PEALD(Picosun R200 Advanced)チャンバーに移しました。次に、薄いAl 2 O 3 フィルム(〜1 nm)を300°Cでトリメチルアルミニウム(TMA)と脱イオン水(H 2 O)それぞれAlおよびOの前駆体として。 Al 2 O 3 / GeO 2 層が薄すぎて正確な酸素原子比を得ることができないため、これら2つの層をAlO x としてマークしました。 / GeO x 。 PPOは、Litmasリモートプラズマソースを使用して60秒間実行されました。 50%O 3 でのOPO処理には、入力酸素流量が750 sccmのオゾン発生器(IN USA ACシリーズオゾン発生器)を使用しました。 / O 2 アンビエント。真空を破ることなく、60サイクルのHfO 2 次に、AlO x の上部に堆積しました / GeO x テトラキスジメチルアミノハフニウム(TDMAHf)とH 2 を使用して300°CでPPOまたはOPO処理した後 それぞれHfとOの前駆体としてのO。次に、100 nmのTaNが、ゲート金属として反応性スパッタリングによって堆積されました。ゲートのパターニングとエッチングの後、自己整合BF 2+ 20keVのエネルギーと1×10 15 の線量でソース/ドレイン(S / D)領域に注入 cm − 2 行われた。 20 nmのNiS / D金属が堆積され、リフトオフプロセスによってパターン化されました。最後に、ドーパントの活性化とS / Dオーミック接触のために450°Cで30秒間の急速熱アニーリングを行いました。製造されたGepMOSFETの概略図と顕微鏡画像をそれぞれ図1bとcに示します。
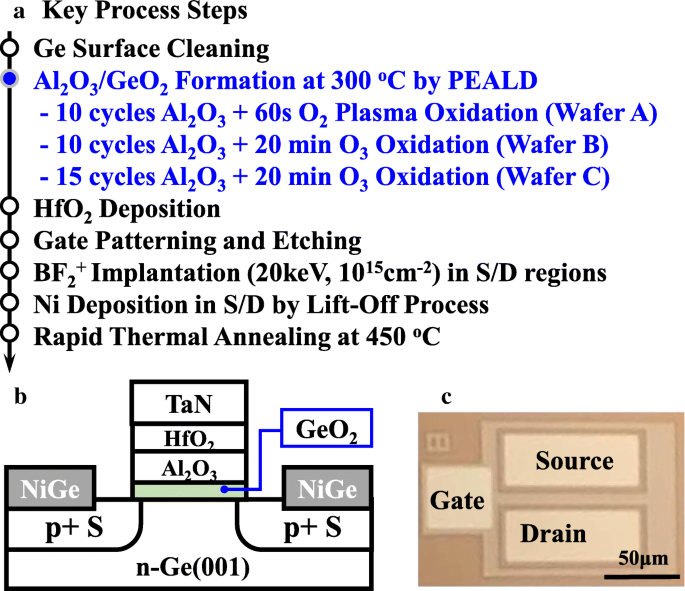
a GeO 2 を使用してGepMOSFETを製造するための主要なプロセスフロー 3つの異なるパッシベーション方法による表面パッシベーション。 b 回路図と c 作製したGeトランジスタの顕微鏡画像
TaN / HfO 2 の断面 / AlO x / GeO x / Geゲートスタックは、透過型電子顕微鏡(TEM)を使用して描かれ、GeO x に対する酸素プラズマまたはオゾンの影響を比較しました。 形成。図2aおよびbは、TaN / HfO 2 の断面TEM画像を示しています。 / AlO x / GeO x / GeゲートスタックとそれぞれPPOおよびOPO。アモルファスHfO 2 の厚さ 両方のデバイスの層は6nmです。 60年代のPPO処理を施したウェーハAには、明確なAlO x があります。 / GeO x HfO 2 間のレイヤー およびGe基板。このAlO x / GeO x 20分のOPOによって形成されたウェーハBの層には、乱雑なマージンがあります。 GeO x の厚さ レイヤーは[10]のデータに準拠しています。
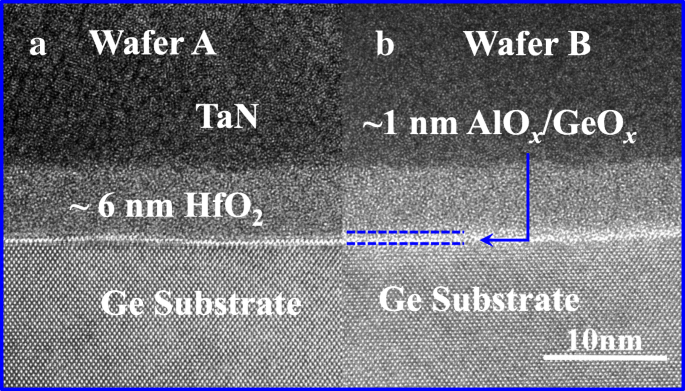
AlO x を使用したhigh-k /メタルゲートスタックの断面TEM画像 / GeO x a によって製造された界面層(IL) OPOと b n-Ge(001)チャネルのPPO
結果と考察
高周波ゲート-ソース間容量-電圧(CV)と組み合わせた出力および伝達特性は、Keithley4200-SCSによって測定されました。図3は、AlO x の3つの異なる形成条件でのGepMOSFETの転送および出力特性の比較を示しています。 / GeO x パッシベーション層。さまざまなウェーハ上のすべてのデバイスのゲート長は( L G )3μmの。ウェーハA上のデバイスは、より高い飽和ドレイン電流( I DS )他の2枚のウェーハと比較。しかし、OPOを備えたウェーハBおよびCは、はるかに低いオフ状態電流を示します( I オフ )PPOを使用したウェーハAと比較。また、OPOを備えたウェーハBおよびCはエンハンスメントモードで動作し、ウェーハAはデプレッションモードで動作したことがわかります。 PPO処理後も、 D が高いため、n-Ge表面は依然としてp型のままであると推測されます。 それ [11]で議論されている値。より厚いAl 2 を備えたウェーハC O 3 ブロック層は正の V を示します TH ウェーハBと比較してシフトし、 D それ ウェーハBよりも。図3bに示す出力特性から、低いゲート電圧( V GS )、ウェーハAの I は低くなります DS サブスレッショルドスイング(SS)がそれほど急ではないため、ウェーハBおよびC上で発生します。 V のとき GS 増加します、 I DS ウェーハAの割合は、他の2つのデバイスと比較して高くなっています。したがって、図3と図2のTEM画像から、AlO x の拡散がわかります。 / GeO x レイヤーが I を抑制する可能性があります オフ 、したがって、パッシベーション効果が向上します。
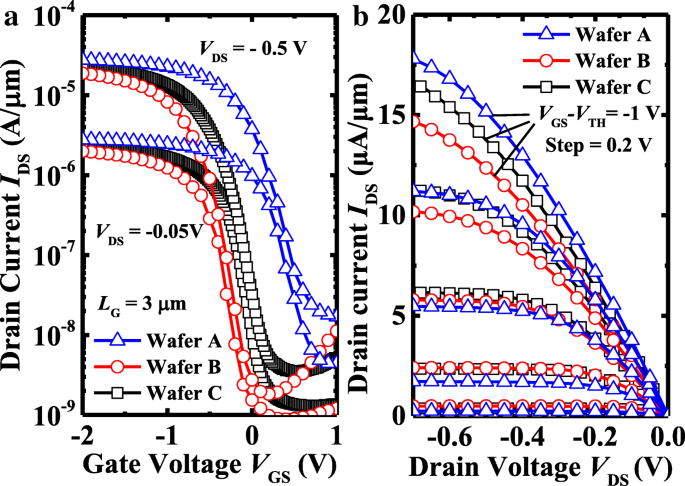
a 私 DS –V GS および b 私 DS –V DS Al 2 を備えたGepMOSFETの特性 O 3 / GeO 2 PPO(ウェーハA)とOPO(ウェーハBとC)によって製造されたパッシベーション層
図4は、 I の統計結果をまとめたものです。 オン / 私 オフ 異なるウェーハ上のデバイスの比率とサブスレッショルドスイング。 OPOを備えたGepMOSFETは、より高い I を示します オン / 私 オフ 比率(〜4桁)とPPOデバイスと比較して著しく改善されたSSは、誘電体/チャネルインターフェースの品質が高いことを示しています。ウェーハBと比較すると、ウェーハCはより高いオン状態電流( I )を示します。 オン )しかし、より低い I オン / 私 オフ 比率。
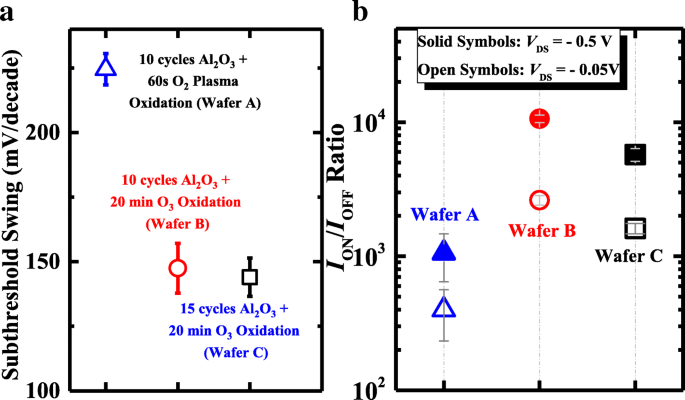
a の統計プロット SSと b 私 オン / I オフ パッシベーション条件が異なるGepMOSFETの比率
さまざまな酸化後の方法の界面層の品質をさらに表すために、ウェーハA、B、およびC(HfO 2 のないダミーサンプル およびゲート金属)は、X線光電子分光法(XPS)によってテストされました。 XPS測定は、HfO 2 を使用せずにPPOまたはOPO処理を行った後、3つの酸化後ダミーサンプルで実行されました。 堆積およびTaNスパッタリング。 GeO x の化学量論 Al 2 で O 3 / GeO / Geサンプルは、単色の軟AlKα(1486.6 eV)X線源を使用して調査されました。 Ge 3 d ピークとピーク微分分析を図5に示します。Ge3 d 5/2 3つのサンプルのピークは29.7eVで統一され、Ge 3 d の化学シフトが発生します。 3/2 、Ge 1+ 、Ge 2+ 、Ge 3+ 、およびGe 4+ Ge 3 d へ 5/2 それぞれ0.6、0.8、1.8、2.75、3.4eVに設定されています[12]。図5bで、ウェーハAは、60年代のPPOの後、GeO x の主なGe原子価を示しています。 Ge 1+ です およびGe 3+ 。同様のGeバランス状態分布がウェーハCとGe 3+ で観察されます。 コンポーネントがわずかに増加します。図5bで、ウェーハBは、より薄い(10サイクル)Al 2 を備えたOPOデバイスを示しています。 O 3 Ge 1+ をさらに酸化します Ge 2+ に 、Ge 3+ 、およびGe 4+ 、Ge 1+ 大幅に削減されます。
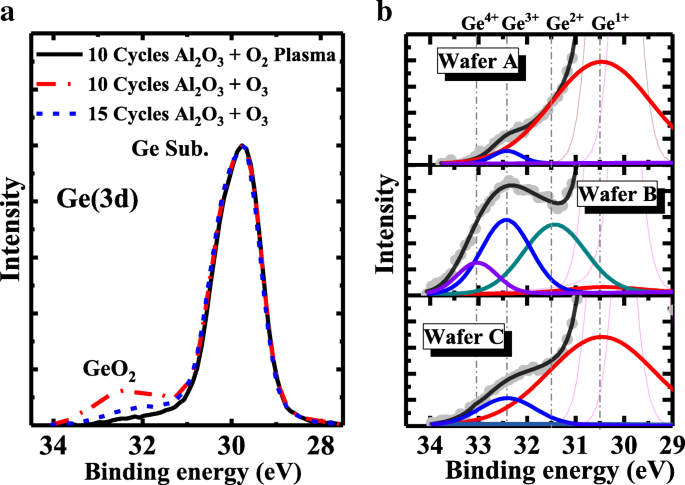
a Ge 3 d Al 2 のXPSスペクトル O 3 / GeO x / Geはさまざまな条件で形成されます。 b Ge 3 d のピークフィッティング GeO 2 からのXPSスペクトル 3つのサンプルのレイヤー
ゲートからソースへのCV特性を図6に示します。1MHzのCV曲線から、 D それ ミッドギャップ付近はターマンによって推定されます 方法[13]であり、同等の酸化物の厚さ(EOT)値も表1に示すように評価されます。20分のOPO(ウェーハBおよびC)は、PPO(ウェーハA)と比較して高いEOTをもたらします。ウェーハCは、Al 2 が厚いため、ウェーハBよりも高いEOTを示します。 O 3 ブロッキング層として。 GeO x の厚さが報告されています O 3 の裸のGe表面 周囲は数分で飽和に達し、飽和の厚さは酸化時間ではなく温度によって支配されます[10]。したがって、この論文では、GeO x の厚さ オゾンによる酸化後は数分後に飽和し、残りの酸化時間はアニーリング専用です。
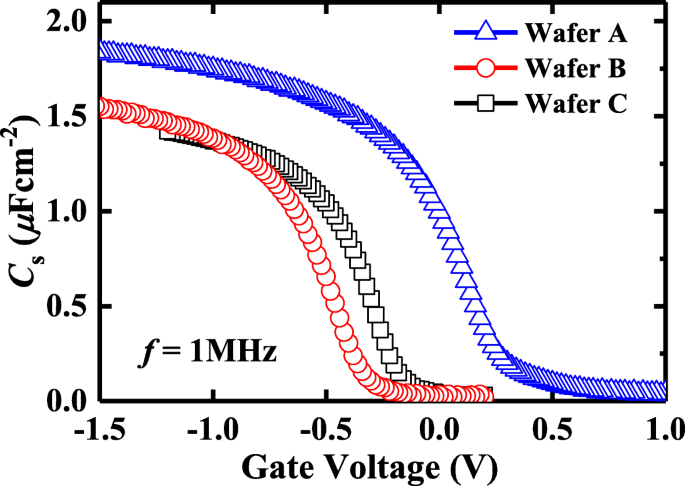
ゲート-ソース間容量対 V GS PPO(ウェーハA)およびOPO(ウェーハBおよびC)によって不動態化されたGepMOSFETの特性
図7は、総抵抗( R )をまとめたものです。 T )対 L G この作品の各デバイスの。ここで、 R T V として定義されます DS / 私 DS V で DS =0.05Vおよび V GS − V TH =1 V.ソース/ドレイン(S / D)直列抵抗( R SD )およびチャネル抵抗( R CH )は、 R の線形フィッティングの切片と傾きから抽出できます。 T – L G 図7に示すような線。抽出された R SD および R CH 結果は表1にまとめられています。図7は、PPOを備えたGepMOSFETがより低い R を示すことを示しています。 SD および R CH これは、図6に示す静電容量の結果と一致しています。
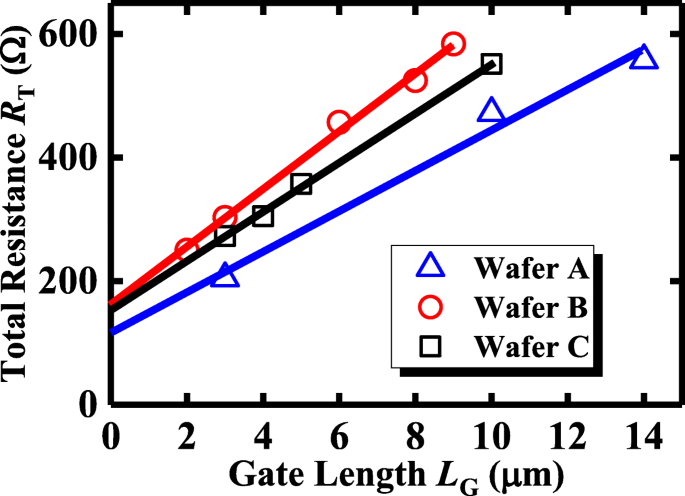
総抵抗( R T )対ゲート長( L G )GepMOSFETの
実効正孔移動度μ eff 全抵抗勾配ベースのアプローチに基づいて抽出されました。図8では、μを比較しています。 eff 他の報告されているGepMOSFETとのPPOおよびOPO処理による当社のGepMOSFETの比較[9、14]。 Q inv デバイスチャネルの反転電荷密度です。 OPOを備えたGepMOSFETは、より高いピークμを示します eff PPOを備えたデバイスと比較して。より厚いAl 2 を備えたウェーハC O 3 ブロック層のピークホール移動度は283cm 2 と高くなっています。 Al 2 が薄いウェーハBと比較した/ V O 3 。 PPOを備えたウェーハAは、より低い高電界ホールμを示します。 eff 粗さの散乱が少ないため、OPOを備えたデバイスを使用します。しかし、低電界では、PPOを備えたウェーハA上のトランジスタはより低いμを達成します eff クーロン散乱が高いため、OPOデバイスよりも優れています[15]。オゾンパッシベーションによって製造されたGepMOSFETに関する研究はわずかしか報告されていません。ここでは、デバイスとOPOで処理された報告されたGe pMOSFET [9、14]との主要なデバイス性能の比較を行い、その結果を表2に示します。この作業のウェーハCは、高い性能を達成していると結論付けられます。 -フィールドμ eff 強化以上の I オン / 私 オフ OPOで処理された報告されたデバイスと比較して。その上、 Q で inv 5×10 12 cm − 2 、ウェーハCは2.37倍高いμを示します eff Siユニバーサルモビリティと比較して。 私 オン ウェーハCのは参考文献のそれよりわずかに低い。 [9]これはEOTが大きいためです。
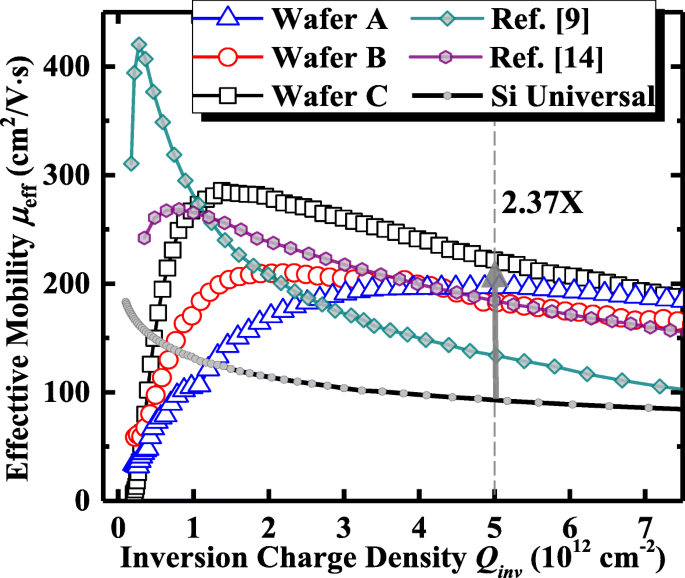
μ eff 対 Q inv 不動態化条件の異なるGepMOSFETの特性。 15サイクルのAl 2 を備えたGeトランジスタ O 3 +20分O 3 酸化(ウェーハC)はピークμを示します eff 283 cm 2 /対。 μに対するS / D抵抗の影響 eff 抽出は、全抵抗スロープベースの有効チャネル移動度抽出方法によって削除されました[16]
結論
Ge pMOSFETは、GeO x で実現されます Al 2 のOPOまたはPPO処理によって形成されるパッシベーション O 3 / n-PEALDのGe。 OPOデバイスは、より優れた転送および出力特性を示し、 I が高くなります。 オン / 私 オフ 比率、改善されたサブスレッショルドスイング、およびより高いピークμ eff PPOデバイスと比較して。 15サイクルのOPOプロセスの場合、より厚いAl 2 O 3 層はより高いEOT値と改善されたμにつながります eff 10サイクルの場合と比較したデバイスで。この作業のすべての結果は、OPOが高品質のGe /誘電体インターフェースを実現するための効果的なパッシベーション方法であり、したがって将来のGeMOSFET製造の有望な候補パッシベーション技術になり得ることを示しています。
略語
- Al 2 O 3 :
-
酸化アルミニウム
- ALD:
-
原子層堆積
- BF 2 + :
-
フッ化ホウ素イオン
- EOT:
-
等価酸化物の厚さ
- Ge:
-
ゲルマニウム
- GeO x :
-
酸化ゲルマニウム
- HF:
-
フッ化水素酸
- HfO 2 :
-
二酸化ハフニウム
- TEM:
-
透過型電子顕微鏡
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- OPO:
-
酸化後のオゾン
- PPO:
-
プラズマ後酸化
- Q inv :
-
反転電荷密度
- SS:
-
サブスレッショルドスイング
- XPS:
-
X線光電子分光法
- μ eff :
-
効果的な正孔移動度
ナノマテリアル
- RaspberryPiとPythonを使用したロボットの構築
- 粘り強さと忍耐力でリードする
- Portentaおよび熱電対センサー(MAX6675を使用)
- C++ クラスとオブジェクトと例
- 高度な農薬活性を備えたスマートナノマテリアルおよびナノコンポジット
- 金コーティングとプラズマ処理によるポリエーテルエーテルケトンの表面化学の調整
- アルゴンプラズマ処理によるZnOの挿入による金属とn-Ge間の接触抵抗の低減
- アモルファスSiパッシベーションを備えた高移動度GepMOSFET:表面配向の影響
- 2段階のポストアニーリングを備えた原子層堆積酸化アルミニウムによる強化されたSiパッシベーションとPERC太陽電池効率
- プラズマ切断とは何ですか?プラズマ切断はどのように機能しますか?
- Node-RED と Docker の使用開始



