マルチ量子井戸が埋め込まれたトップダウンで製造されたAlGaNナノロッドアレイの光学性能
要約
深紫外線AlGaNベースのナノロッド(NR)アレイは、完全に構造化されたLEDウェーハから、ナノインプリントリソグラフィーとトップダウンドライエッチング技術によって製造されました。高度に秩序化された周期的な構造特性および形態は、走査型電子顕微鏡法および透過型電子顕微鏡法によって確認された。平面サンプルと比較して、カソードルミネッセンス測定により、NRサンプルは約277 nmでの多重量子井戸からの発光に対して1.92倍の光抽出効率(LEE)の向上と12.2倍の内部量子効率(IQE)の向上を示したことが明らかになりました。 LEEの強化は、空気とエピ層の間の十分に製造されたナノ構造の界面に起因する可能性があります。さらに、量子閉じ込めシュタルク効果の減少は、IQEの大幅な向上を説明しました。
はじめに
過去10年間で、AlGaNベースのUV LEDは、水の浄化、滅菌、生化学的検出などの有望なアプリケーションのために広く注目されてきました。 [1,2,3]。従来の水銀UVランプと比較して、AlGaNベースのUV LEDは堅牢でコンパクト、そして環境にやさしく、ウォーミングアップステップなしでオンにすることができます。ただし、AlGaN多重量子井戸(MQW)には強力な圧電場が存在するため、電子と正孔が空間的に分離され、量子閉じ込めシュタルク効果(QCSE)と呼ばれ、内部量子効率(IQE)が劇的に低下します[4]。 。もう1つの問題は、光抽出効率(LEE)[5]が低いことです。これは、エピレイヤーの界面での内部全反射だけでなく、支配的な横磁気(TM)偏光[6]によっても引き起こされます。以前の調査では、エネルギーバンドエンジニアリングがQCSEを削減し、IQEを改善する効果的な方法であることが示唆されていました[7]。一方、フォトニック結晶[8、9]、パターン化基板[10、11]、分布ブラッグ反射鏡[12]、表面プラズモン[13、14、15、16]などの構造を組み込むなどのインターフェースエンジニアリングは、深紫外線LEDのLEEを向上させることができます。ただし、これらの方法の組み合わせは比較的困難です。
AlGaNベースの深紫外線ナノ構造LEDの製造は、QCSEと低LEEの問題を同時に克服するための代替方法となります。一般に、ナノ構造のLEDは、ナノメートルスケールのマスクとトップダウンのドライエッチング技術によって製造されました。マスクは、ニッケル(Ni)や金などのアニールされた金属ナノ粒子[17、18]、ナノスフェアリソグラフィー[19、20、21]、電子ビームリソグラフィー(EBL)[22]、および集束イオンビームミリング[23]によって調製されました。 。一方、InGaNベースのナノワイヤLEDを得るために、いくつかの選択領域エピタキシー法が開発されています[24、25]。ただし、各方法には、高価で制御できない形態、不均一、マイクロエレクトロニクスプロセスとの互換性がない、時間がかかるなど、固有の欠点があります。これらの欠点を克服するために、我々はソフトUV硬化ナノインプリントリソグラフィー(NIL)技術を開発し、非常に広い領域で、高い均一性と低い欠陥密度で制御可能なマスクを作成しました[26、27]。
この作業では、平面AlGaN LEDウェーハから埋め込まれたMQWを備えたAlGaNナノロッド(NR)アレイの準備に成功しました。平面(PLA)サンプルと比較して、1.92倍のLEE強化と12.2倍の相対IQE強化が実証されています。カソードルミネッセンス(CL)、走査型電子顕微鏡(SEM)、および透過型電子顕微鏡(TEM)の測定により、LEEの向上は、空気とエピ層の間の界面品質の向上に起因する可能性があることが示唆されました。ラマン測定は、MQWのひずみが0.42%から0.13%に減少することを示しました。これは、IQEの強化に有益です。
メソッド
AlGaN LEDウェーハは、2インチの有機金属化学蒸着(MOCVD)によって成長しました。 c PLAサンプルとして定義される平面サファイア基板。エピタキシーは、900 nmのドープされていないAlNバッファー、400 nmの傾斜Al組成AlGaN層、1.4μmの厚さのSiドープn-Al 0.5 で構成されていました。 Ga 0.5 N、およびAl 0.35 の5つの期間 Ga 0.65 N / Al 0.45 Ga 0.55 ウェルとバリアの厚さがそれぞれ3nmと10nmのNMQWと、それに続く100 nmMgドープp-GaNコンタクト層。
AlGaN NRアレイを得るために、ソフトUV硬化NILと成長後エッチングアプローチが採用されています[26、27、28]。図1a–hに示すように、NILプロセスは、厚さ200 nmの二酸化ケイ素(SiO 2 )の堆積から始まりました。 )プラズマ化学気相成長法(PECVD)を使用する(図1b)。次に、厚さ300nmのSU8フォトレジストの層と厚さ80nmのUV硬化性レジストの層をエピ層に直接スピンコーティングし(図1c)、UV硬化性レジストにポストソフトUV硬化NILを使用しました。 (図1d)。 UVレジスト残留物を除去し、ナノパターンをSU8フォトレジスト層に複製するには、酸素(O 2 )プラズマを利用して、反応性イオンエッチング(RIE)手順でSU8フォトレジストをエッチングしました(図1e)。その後、物理蒸着(PVD)により厚さ30 nmのNi層を堆積し、リフトオフプロセスを経て、SiO 2 の表面に周期的なNiアイランドを形成しました。 ハードマスクとして機能するレイヤー(図1f)。準備したNiハードマスクを使用して、パターンをSiO 2 に転写しました。 別のRIEプロセスによるレイヤー(図1g)。続いて、これらのSiO 2 ナノロッドアレイは、誘導結合プラズマ(ICP)エッチングプロセスを介してAlGaNLEDウェーハをエッチングするための2番目のマスクとして使用されました。最後に、これらのSiO 2 図1hに示すように、ナノロッドアレイマスクをHF溶液で除去し、AlGaNNRアレイを取得しました。このNILテクノロジーによるナノ構造の収率は2インチウェーハで98%以上であり、これはEBL法に匹敵しますが、NILテクノロジーははるかに安価です。詳細は以前のレポート[27]に記載されています。ドライエッチング中にナノロッドの側壁に表面状態を生成することは避けられません。これは、非放射線再結合中心として機能し、AlGaNMQWの発光を抑制する可能性があります。したがって、すべてのNRサンプルは、表面状態を除去するために、KOHと90°Cの水浴中の希酸溶液を使用して化学処理されています。
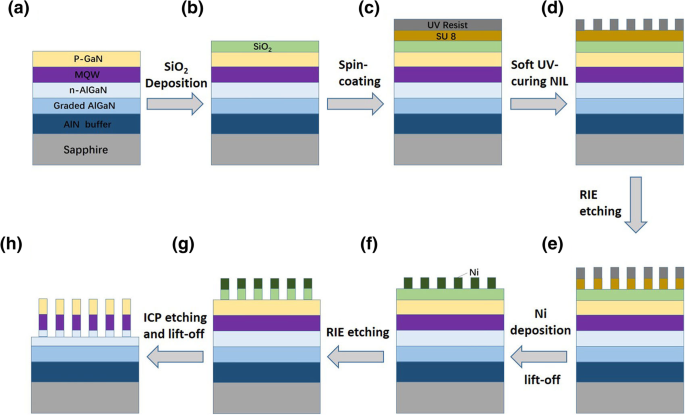
MQWが埋め込まれたAlGaNNRアレイの製造の概略図。 a オリジナルのAlGaNベースの深紫外線LEDウェーハ。 b SiO 2 沈着。 c SU8フォトレジストとUV硬化レジストのスピンコーティングプロセス。 d ソフトUV硬化NILプロセス。 e SU8フォトレジストのRIEプロセス。 f アセトン中でのNiの堆積とリフトオフプロセス。 g NiパターンをSiO 2 に転送します RIEによるレイヤー。 h SiO 2 からの転写パターン ICPによるAlGaNベースのLEDウェーハへの変換
製造されたAlGaNNRアレイの形態は、ZEISSSIGMA高分解能電界放出SEMシステムで特性評価されました。 TEM画像は、200kVで動作する電子ビームを備えたFEITitan 80-300TEMシステムによって収集されました。 CLスペクトルは、10kVおよび922pAで動作する電子ビームを備えた電子ビームファイバープローブシステムによって収集されました。ラマン散乱のスペクトルは、励起源として514 nmのレーザーを使用することにより、後方散乱構成の共焦点ラマン分光イメージングシステム(WITec alpha 300RA)で取得されました。ラマン測定は、520.7 cm -1 の光学フォノンモードを備えた標準的な単結晶シリコンサンプルによって較正されました。 。
結果と考察
図2a、a、bの挿入図は、均一性が高く、側壁が滑らかな、製造されたAlGaNNRアレイの典型的な上面図のタイトル付き断面SEM画像を示しています。 NRが高度に順序付けられた六角形の配列になっていることがわかります。 NRの直径、周期、長さは、それぞれ約350 nm、730 nm、1300nmです。図2cおよびdに示すように、NRに埋め込まれたMQWは、NRの製造後にはっきりと観察できます。井戸と障壁はそれぞれ暗い領域と明るい領域として表示され、インターフェースは依然として読みやすく、平坦で、急勾配です。

上面図( a )、タイトル(aの挿入図)、および断面( b )AlGaNNRアレイのSEM画像。 c 、 d それぞれ単一のNRおよびAlGaNMQWのTEM画像
図3aとbは、それぞれNRサンプルの室温(RT; 300 K)と低温(LT; 10 K)のCLスペクトルを示しています。図3cとdは、それぞれPLAサンプルのRTスペクトルとLTCLスペクトルを示しています。実線と破線は実験的で適合した曲線(ガウス)です。ガウスフィッティングは、すべてのスペクトルが2つの発光ピークで構成されていることを示しています。 PLAまたはNRサンプルに関係なく、LTで測定されたCL発光強度は、RTで測定されたものと比較して大幅な向上を示します。これは、LTでの弱い熱活性化エネルギーに起因する可能性があります。したがって、キャリアは非放射再結合が可能な欠陥に移行できません。つまり、キャリアは放射線再結合のみを実行し、IQEは約100%と見なすことができます。エピタキシャル層の構造を考慮すると、短波長(ピーク1)と長波長(ピーク2)のピークは、それぞれn型層とMQWの発光に起因します。ガウス分割ピークから得られた詳細なパラメータを表1に示します。NRサンプルの場合、n型層からの発光の積分強度は約2.89 [ I 1 (NR300K)/ I 1 (PLA300K)]および2.78 [ I 1 (NR10K)/ I 1 (PLA10K)] RTおよびLTでのPLAサンプルのそれぞれの倍。ただし、RTでは、NRサンプルのMQWからの放射の積分強度は約5.81 [ I 2 (NR300K)/ I 2 (PLA300K)] PLAサンプルの2倍ですが、比率はわずか0.48 [ I 2 (NR10K)/ I 2 (PLA10K)] LTで。

a 、 b 電子ビーム(10 kV、992 pA)によって励起された、それぞれ300Kおよび10KでのNRサンプルのCLスペクトル。 c 、 d 電子ビーム(10 kV、992 pA)によって励起された、それぞれ300および10KでのPLAサンプルのCLスペクトル。実線と破線は、実験とガウスフィッティング曲線に対応しています
PLAサンプルと比較すると、図4aに示すように、NRサンプルの側壁は空気にさらされているため、空気とエピレイヤーの間の総界面面積が大幅に増加します。したがって、LEEは、n型レイヤーとMQWエミッションの両方に対して拡張できます。 n型層発光のLEE増強は、約2.8 [ I 1 (NR)/ I 1 (PLA)]。さらに、図2aから得られた幾何学的構造によれば、PLAサンプルのMQW面積はNRサンプルの約4倍です。 PLAサンプルとNRサンプルの両方のIQEを10Kで1と仮定すると、相対的な光抽出の向上は約1.9 [4× I 2 (NR10K)/ I 2 (PLA10K)]。明らかに、n型層発光のLEE増強は、MQW発光のそれよりも高い。
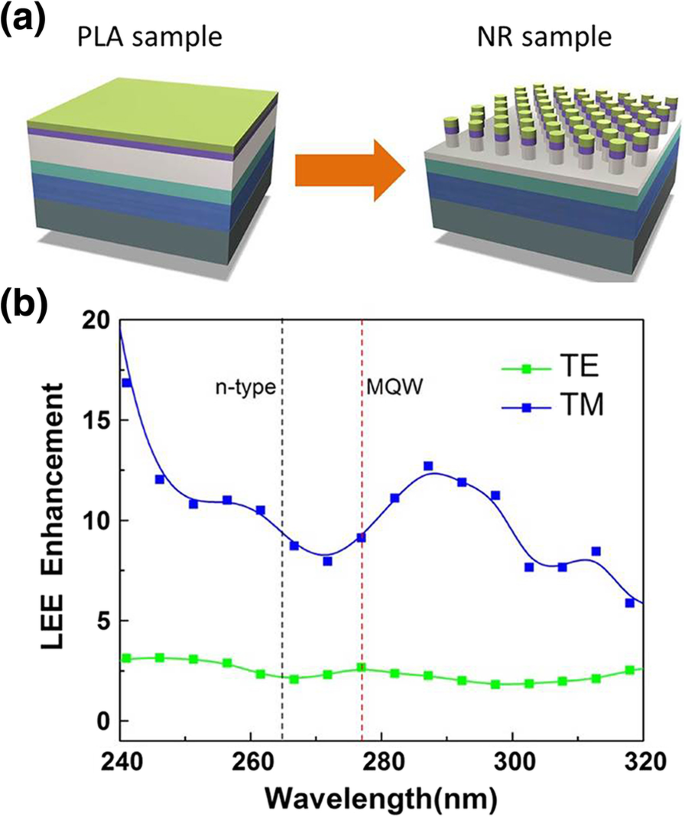
a PLAおよびNRサンプルの構造図。 b FDTDシミュレーションによって計算されたTEおよびTM偏光状態でのPLAサンプルと比較したNRサンプルのLEEエンハンスメント。黒と赤の破線は、それぞれn型AlGaN層とAlGaNMQWの発光波長に対応しています
有限差分時間領域(FDTD)シミュレーションを実行して、AlGaNNRアレイのLEE拡張を明確にしました。 NRアレイの直径、周期、長さは、図4aに示すように、製造されたNRアレイと一致するように、それぞれ350 nm、730 nm、1300nmに設定されています。その他のシミュレーションパラメータは、以前のレポート[29]と同様です。モニターによって収集されたフィールドは、電力P 0 を統合するために使用されました 上面から脱出し、ダイポールのソースパワーはP S として定義されます。 、したがって、LEEはη = P 0 / P S 。また、抽出エンハンスメントは E で計算できます。 n =η r / η p 、ここでη p 、η r は、それぞれPLAサンプルとNRサンプルのLEEです。図4bは、横電気(TE)およびTM偏光状態でのPLAサンプルと比較したNRアレイの光抽出の強化を示しています。約265nmでのn型層発光の場合、LEE増強比はTEおよびTM偏光状態でそれぞれ約2.4および9.2であることがわかります。以前の調査では、圧縮成長したAlGaN MQWの場合でも、240nmという短い波長で強いTE偏光の発光が観察されることが示されていました[30]。したがって、TE状態とTM状態の混合のLEEエンハンスメントが約2.8であることは合理的です。ただし、LEEの増強率は、約277nmでのTEおよびTM偏光状態でそれぞれ約2.6および9.1です。実験データから計算されたMQW放出のLEE増強比は、約1.9であり、TEとTMの両方の偏光状態のシミュレートされたLEE増強比よりも小さくなっています。これは、図2aに示す実験的に製造されたNRアレイの部分的に不規則な形状、またはNILプロセスによって引き起こされた損傷層の再吸収に起因する可能性があります。
一方、QCSEを減らすと、MQWエミッションのNRサンプルのIQEを向上させることができます。 300 Kでのn型層発光のIQEは、約1.96%と見積もることができます[ I 1 (PLA300K)/ I 1 (PLA10K)]および2.03%[ I 1 (NR300K)/ I 1 (NR10K)] PLAおよびNRサンプルの場合。 QCSEはn型層に存在しないため、これらは互いに非常に接近しています。ただし、300 KでのMQW放出のIQEは約1.32%です[ I 2 (PLA300K)/ I 2 (PLA10K)]および16.1%[ I 2 (NR300K)/ I 2 (NR10K)] PLAおよびNRサンプルの場合。したがって、PLAサンプルと比較したNRサンプルのMQW放出のIQEの増強率は12.2です。相対IQEのこの大幅な向上は、NRサンプルのQCSEの低下に起因するはずです。青/緑LEDのいくつかの同様の研究[27、31]によると、NR製造による大きなひずみ緩和はQCSE効果を減少させます。 QCSEが減少すると、電子と正孔の波動関数の重なりが増加し、IQEが増加します。
NRサンプルのひずみ緩和を確認するためにラマン測定を行った。図5は、PLAおよびNRサンプルのラマンスペクトルを示しています。 E 2 (高)フォノンモードは通常、エピタキシャル層の応力状態を特徴づけるために利用されます。特に、3つの E 2 (高)フォノンモードは、PLAサンプルとNRサンプルの両方のラマンスペクトルに示され、GaN接触層、n型層、およびAlNバッファ層に対応します。明らかに、PLAおよびNRサンプルのピークシフトは、ストレスのない E と比較して異なります。 2 (高)フォノンモード。PLAサンプルがNRサンプルに製造された後に応力状態が変化したことを示します。通常、エピタキシャル層の面内応力は次の式で表されます[29]:
$$ {\ omega} _ {{\ mathrm {E}} _ 2 \ left(\ mathrm {high} \ right)}-{\ omega} _0 =C \ sigma、$$(1)ここで、Cはストレスシフト率(− 3.4 cm -1 )です。 / GPa、− 3.1 cm −1 / GPa、および− 3.25 cm -1 GaN、AlN、およびAl 0.5 の場合は/ GPa Ga 0.5 それぞれN)[29]。 \({\ omega} _ {{\ mathrm {E}} _ 2 \ left(\ mathrm {high} \ right)} \)およびω 0 E のラマンシフトです 2 私たちの研究における対応するエピタキシャル層とストレスのない材料のそれぞれの(高)モード。 ω 0 GaNとAl 0.5 の値 Ga 0.5 Nは567.0および586.0cm -1 であると報告されています それぞれRTで[32]。エピタキシャル層のひずみは[33]:
として表すことができます。 $$ {\ sigma} _ {\ mathrm {xx}} =\ left [{C} _ {11} + {C} _ {12} -2 \ frac {C_ {13} ^ 2} {C_ {33} } \ right] {\ varepsilon} _ {\ mathrm {xx}}、$$(2)ここで、σ xx は面内応力です。 ε xx は面内ひずみであり、 C ij は、以前のレポート[34]で与えられたGaNとAlNの弾性定数です。つまり、比例係数はGaNでは478.5 GPa、Al 0.5 では474.5GPaです。 Ga 0.5 N。
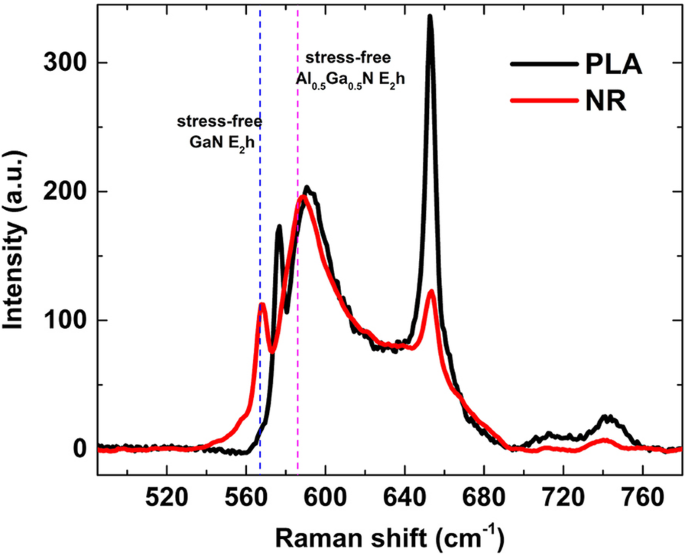
RTで514レーザーによって刺激されたPLAおよびNRサンプルのラマンスペクトル。黒と赤の曲線は、それぞれPLAとNRのサンプルを表しています。青とピンクの破線は E に対応します 2 ストレスのないGaNとAl 0.5 のhピーク Ga 0.5 それぞれN
式を使用します。 (1、2)、ラマンシフト、応力、およびひずみを表2に示します。特に、ひずみはGaN接触層で大幅に減少します。異なるAl含有量のエピ層のひずみと応力の線形補間を単純に考慮することにより、35%のAl含有量のMQWの応力/ひずみは、PLAとNRで1.99 GPa / 0.42%および0.59 GPa / 0.13%として取得できます。それぞれサンプル。したがって、NRサンプルのMQWs層では69%のひずみが緩和されています。
<図>以前の調査[35]によると、分極場 E w 量子井戸では次のように表すことができます
$$ {E} _ {\ mathrm {w}} =\ frac {l _ {\ mathrm {b}} \ left({P} _ {\ mathrm {b}}-{P} _ {\ mathrm {w} } \ right)} {l _ {\ mathrm {w}} {\ upvarepsilon} _ {\ mathrm {b}} + {l} _ {\ mathrm {b}} {\ upvarepsilon} _ {\ mathrm {w}} }、$$(3)ここで l w 、 l b 、 P w 、 P b 、およびε b 、ε w は、それぞれウェルとバリアの幅、全分極、誘電率です。したがって、圧電分極だけでなく、自発分極も考慮に入れる必要があります。圧電分極は、\({P} _ {\ mathrm {pz}} =2 \ left({e} _ {31}-{e} _ {33} \ frac {C_ {13}} {C_ { 33}} \ right){\ varepsilon} _ {\ mathrm {xx}} \)[36]、ここで e 31 、 e 33 、 C 31 、および C 33 は、GaNとAlNの関連パラメータ[37、38]、ひずみεからの線形補間によって得られます。 xx 線形補間法を使用してラマンスペクトルによって計算されます。自発分極は、GaNとAlNの自発分極からの線形補間によって得られます[37、39]。したがって、ウェルの誘電率と、GaN εの誘電率から線形補間によって得られたバリアを使用することによって GaN =8.9およびAlN ε AlN =8.5 [40]、分極場は式(1)で計算できます。 (3)。表3に、PLAおよびNRサンプルの量子井戸における自発分極、圧電分極、全分極、および分極場を示します。 NR製造後に分極場が減少していることがはっきりとわかります。
<図>結論
要約すると、MQWが埋め込まれた非常に均一なAlGaN NRアレイは、NILおよびトップダウンエッチング技術によって正常に製造されています。 n型層(高エネルギー)とMQW(低エネルギー)からの発光に対応する2つのピークが、300Kと10KでのNRサンプルとPLAサンプルの両方のCL測定によって観察されます。n型層の発光の場合、2倍を超えるLEEの向上が観察されていますが、IQEはNRの製造ではほとんど向上していません。 MQW放出の場合、LEE増強率は約1.9と推定でき、12.2倍のIQE増強が達成されます。ラマンスペクトルは、ひずみがNR製造によって0.42%から0.13%に減少することを示し、QCSEが減少したという強力な証拠を示しています。私たちの結果は、結晶品質が高くないサンプルの場合、QCSEによって引き起こされる電子と正孔の間の空間的分離がIQE低減の重要な要因になることを示しています。
略語
- CL:
-
カソードルミネッセンス
- EBL:
-
電子ビームリソグラフィー
- FDTD:
-
有限差分時間領域
- ICP:
-
誘導結合プラズマ
- LEE:
-
光抽出効率
- LT:
-
低温
- MOCVD:
-
有機金属化学蒸着
- MQW:
-
マルチ量子井戸
- Ni:
-
ニッケル
- NIL:
-
ナノインプリントリソグラフィー
- NR:
-
ナノロッド
- PECVD:
-
プラズマ化学気相成長法
- PLA:
-
平面
- PVD:
-
物理蒸着
- QCSE:
-
量子限定シュタルク効果
- RIE:
-
反応性イオンエッチング
- RT:
-
室温
- SEM:
-
走査型電子顕微鏡
- TE:
-
横電気
- TEM:
-
透過型電子顕微鏡
- TM:
-
横磁気
- UV:
-
紫外線
ナノマテリアル
- 組み込みファームウェアのヒント:信号波形やその他のファイルデータを使用してCでアレイを初期化する方法
- NiCo2S4 @ NiMoO4コアシェルヘテロ構造ナノチューブアレイは、バインダーフリー電極としてNiフォーム上に成長し、高容量で高い電気化学的性能を示しました
- スリーステートエレクトロクロミックデバイスのディップコーティングプロセスエンジニアリングと性能最適化
- 金属支援化学エッチングによって製造されたAuキャップGaAsナノピラーアレイ
- 光触媒性能が向上した新規Bi4Ti3O12 / Ag3PO4ヘテロ接合光触媒
- TiO2ナノチューブアレイ:ソフトハードテンプレートで製造され、電界放出性能の粒子サイズ依存性
- タルボットキャビティと統合されたテーパー量子カスケードレーザーアレイ
- 構造用カラーマイクロファイバーを使用した光スイッチングパターンの製造
- 微調整可能な光学特性を備えた2次元ルドルスデンポッパーペロブスカイト量子ドットの容易な合成
- 効果的な光吸収が強化されたピン接合ナノコーンアレイ太陽電池の光起電力性能
- 表面構造が変更された高性能有機ナノ構造シリコンハイブリッド太陽電池



