AlGaNベースの深紫外線発光ダイオードのn-AlGaN層のドーピングタイプを局所的に変調することによる電流拡散の改善
要約
このレポートでは、 n のドーピングタイプをローカルで調整します -AlGaNベースの深紫外線発光ダイオード(DUV LED)用のn-AlGaN / p-AlGaN / n-AlGaN(NPN-AlGaN)構造の電流拡散層を提案することによるAlGaN層。薄いp-AlGaN層をn-AlGaN電子供給層に挿入した後、 n に伝導帯バリアを生成できます。 DUVLED用のp型正孔供給層の横方向電流分布の変調を可能にする-型電子供給層。さらに、我々の研究によれば、Mgドーピング濃度、厚さ、p-AlGaN挿入層のAlN組成、およびNPN-AlGaN接合数は、電流拡散効果に大きな影響を与えることがわかっています。適切に設計されたNPN-AlGaN電流拡散層は、DUV LEDの光出力パワー、外部量子効率(EQE)、およびウォールプラグ効率(WPE)を向上させることができます。
はじめに
消毒、浄水、医療、高密度光記録[1,2,3,4,5,6,7,8]などのさまざまな用途のために、高効率のAlGaN-の開発に多大な努力が払われてきました。ベースの深紫外線発光ダイオード(DUV LED)。現段階では、AlリッチAlGaN膜の結晶品質を改善するために目覚ましい進歩が達成されています。たとえば、グラフェン支援準ファンデルワールスエピタキシーによるナノパターンサファイア基板上でのAlN膜の成長は、ひずみを大幅に解放し、低減することができます。転位密度[9]は、80%の内部量子効率(IQE)を示します[10]。このようなIQEは、キャリア注入を伴わない低温フォトルミネッセンス法を使用して測定されることは注目に値します。ただし、DUV LEDは、電流の流れとキャリアの輸送に関連する電気的バイアスによって動作します[11、12、13]。電流の流れに関するもう1つの非常に重要な側面は、電流の混雑効果です。これは、デバイスが非常に高い電流レベルでバイアスされている場合に簡単に発生します[14]。 DUV LEDは、AlN成分が多いp-AlGaN層でのMgドーピング効率が非常に低く[15、16]、導電率が低くなります。さらに、DUV LEDは、電流の横方向注入方式を特徴とするフリップチップ構造を採用しています。したがって、InGaN / GaNベースのUV、青、および緑のLEDと比較して、AlGaNベースのDUV LEDは、現在の混雑効果によってより困難になります[17]。 p-接触電極またはメサエッジのいずれかで電流混雑効果が発生すると、多重量子井戸(MQW)のエレクトロルミネッセンス強度が不均一になり、接合部温度が上昇します[18]。結果として、DUVLEDの横方向の電流拡散を促進することは確かに重要です。その目的のために、提案されたナローマルチストリップp型電極は、均一に分散された電流拡散を可能にし、したがって、ウォールプラグ効率(WPE)を60%増加させます[19]。さらに、ITO / ZGO(ZnGaO)電流拡散層は、電流をよりよく拡散し、外部量子効率(EQE)を向上させることができますが、ZGO / p-GaN界面での界面抵抗率の増加により、DUVLEDのWPEの向上が低下します[20]。 。
したがって、現段階では、DUV LEDの電流拡散を促進するために、p側に研究の注意が向けられています。この作業では、他のアプローチとは異なり、n-AlGaN電子サプライヤ層を設計することにより、DUVLEDのp型正孔サプライヤ層の電流分布を改善できることを提案および証明します。エネルギー障壁は、電子供給層のドーピングタイプを変調することによって伝導帯に生成されます。つまり、n-AlGaN / p-AlGaN / n-AlGaN(NPN-AlGaN)構造が提案され、パラメトリックに研究されます。我々の結果は、NPN-AlGaN接合を使用することにより、正孔の横方向の分布を均一化できることを示しています。これにより、DUV LEDの光出力、外部量子効率、およびウォールプラグ効率が向上します。私たちの設計のもう1つの利点は、エピタキシャル成長の観点から、n型電子供給層に電流拡散層を設けることで、エピ成長者が成長条件をより自由に最適化できることです。
調査方法と物理モデル
NPN-AlGaN DUVLED構造を図1aに模式的に示します。調査した各DUVLEDには、厚さ4μmのn-Al 0.60 があります。 Ga 0.40 N / p-Al x Ga 1- x N / n-Al 0.60 Ga 0.40 N層、およびn-Al 0.60 のSiドーピング濃度 Ga 0.40 N領域は5×10 18 cm -3 。次に、5組のAl 0.45 Ga 0.55 N / Al 0.56 Ga 0.44 N個の多重量子井戸(MQW)活性層が設計されており、量子井戸と量子障壁の厚さはそれぞれ3nmと12nmです。 MQWは、厚さ18nmのMgドープp-Al 0.60 でキャップされています。 Ga 0.40 n層がp-EBLとして機能し、その後、厚さ50nmのMgドープp-Al 0.40 Ga 0.60 N層と50nmの厚さのMgドープp-GaN層が続きます。 p-EBLとホールサプライヤ層のホール濃度は3×10 17 に設定されています。 cm -3 。 350×350μm 2 の長方形のメサを使用してデバイスの形状を設計します 。図1bは、2つのNPN-AlGaN接合(つまり、NPNPN-AlGaN構造)がDUV LED構造に採用されている場合の伝導帯プロファイルの概略を示しており、枯渇したp-Al に存在するエネルギー障壁を見ることができます。 x Ga 1- x N地域。エネルギー障壁は、p型ホールサプライヤ層の水平方向の電流分布を調整できます。逆バイアスされたn-AlGaN / p-AlGaN接合を流れる電流を保証するには、NPN-AlGaN接合がリーチスルーブレークダウンモードになるように、p-AGaN挿入層を完全に空にすることが非常に重要です。 [21]。詳細な分析と議論は、その後に提示されます。参照DUVLEDは、厚さ4μmのSiドープn-Al 0.60 を除いて、NPN-AlGaN DUVLEDと同じです。 Ga 0.40 N層は電子供給層として利用されています。
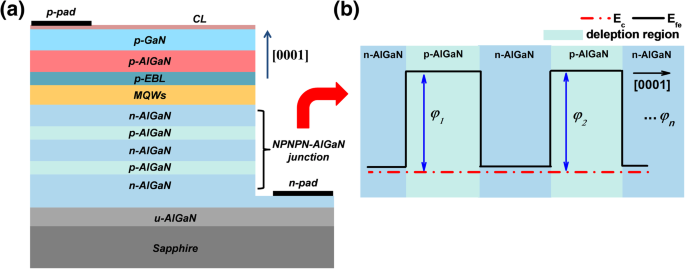
a NPN-AlGaNLEDの概略構造。 b 2つのNPN-AlGaN接合を有するNPNPN-AlGaN構造の概略伝導帯プロファイル。各NPN-AlGaN接合のバリア高さをφと定義します。 1 、φ 2 、およびφ n 、および n はNPN-AlGaN接合の数です
NPN-AlGaN接合によって可能になる改善された電流拡散効果の物理的メカニズムをよりよく理解するために、横方向電流注入方式のDUVLEDの等価回路を図2aに示します。電流がp型ホールサプライヤ層からn-AlGaN領域に垂直方向と横方向の両方に沿って流れることがわかります。 n-AlGaN電子供給層の電気抵抗が電流拡散層(CL)の電気抵抗よりも小さい場合、電流はp型オーミック接触下の領域( I > 1 > 私 2 > 私 3 >…> 私 n [14]。 DUV LED構造にNPN-AlGaN接合を組み込むことで、破壊的な電流混雑効果を抑えることができます。次に、図2bのNPN-AlGaN DUV LEDの電流流路をさらに単純化して、全電流を垂直部分( I )に分割できるようにします。 1 )と水平部分( I 2 )ポイント A から B を指す 。したがって、2点間の合計電圧は、電流拡散層、p-GaN層、p-AlGaN層、MQW、NPN-AlGaN接合、およびn-AlGaN層によって共有されます。 I の現在のパスに基づく 1 および私 2 、式1と2はそれぞれ得られ、前の2つの式を解くことによって式(1)が得られます。次に、3が導出されます:
$$ {I} _1 {R} _ {\ mathrm {CL}-\ mathrm {V}} + {I} _1 {R} _X + {I} _1 \ bullet N \ bullet {R} _ {npn} + { I} _1 \ left({R} _ {n- \ mathrm {V}} + {R} _ {nL} \ right)={U} _ {\ mathrm {AB}}、$$(1)$$ {I} _2 \ left({R} _ {\ mathrm {CL}-\ mathrm {L}} + {R} _ {\ mathrm {CL}-\ mathrm {V}} \ right)+ {I} _2 {R} _X + {I} _2 \ bullet N \ bullet {R} _ {npn} + {I} _2 {R} _ {n- \ mathrm {V}} ={U} _ {\ mathrm {AB}} 、$$(2)$$ \ frac {I_1} {I_2} =1 + \ frac {R _ {\ mathrm {CL}-\ mathrm {L}}-{R} _ {n- \ mathrm {L}} } {R _ {\ mathrm {CL}-\ mathrm {V}} + {R} _X + {R} _n + N \ bullet {R} _ {npn}} $$(3)<図> <画像> <ソースtype ="image / webp" srcset ="// media.springernature.com / lw685 / springer-static / image / art%3A10.1186%2Fs11671-019-3078-8 / MediaObjects / 11671_2019_3078_Fig2_HTML.png?as =webp">>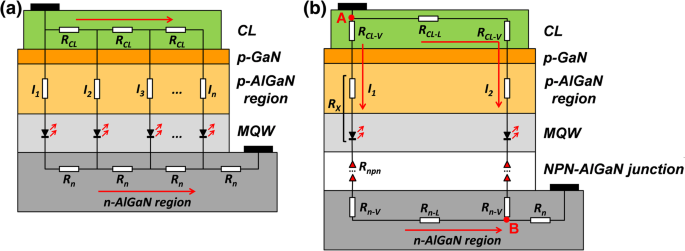
a 横方向電流注入方式の等価回路を備えたDUVLED( I 1 > 私 2 > 私 3 >……> 私 n )。 b NPN-AlGaN構造のDUVLEDは、等価回路と電流経路を簡略化しました I 1 および私 2 展示されています
ここで R CL-V および R CL-L は、それぞれ電流拡散層の垂直抵抗と水平抵抗です。 R n − V および R n − L n-AlGaN層の垂直抵抗と水平抵抗をそれぞれ示します。 R n R の合計です n − V および R n − L (つまり、 R n = R n − V + R n − L )現在のパスの場合 I 1 ; p型正孔注入領域とMQW領域の抵抗の合計は R で表されます。 x ; R npn 各NPN-AlGaN接合のバリア高さによって引き起こされる界面抵抗です。 N は、NPN-AlGaN接合の総数、およびポイント A 間の合計電圧降下を意味します。 および B U によって記述されます AB 。研究対象のすべてのデバイスで、200nmの厚さの電流拡散層が4μmの厚さのn-AlGaN電子供給層よりもはるかに薄いことは言及する価値があります。したがって、電気抵抗がn-AlGaN層よりもはるかに大きいCL、すなわち R が得られます。 CL-L − R n − L ≫0。 I の比率は明らかです。 1 / 私 2 N を作成することで削減できます × R npn 値の増加。 したがって、dUV LED構造用のn型電子供給層のNPN-AlGaN接合を使用することにより、p型正孔供給層の電流拡散効果を改善することができます。一方では、 N × R npn N を増やすことで、価値を高めることができます。 。一方、 R の値 npn は、AlN成分、厚さ、およびp-AlGaN挿入層のMgドーピング濃度の影響を受けます。したがって、詳細な分析は以降の議論で行われます。
Crosslight APSYSシミュレーターは、デバイスの物理特性を調査するために使用されます。使用するモデルは、青色、UVA、およびDUV窒化物ベースのLEDに関する以前の出版物[22、23、24]によると信頼性があります。私たちの物理モデルでは、AlGaN / AlGaNヘテロ接合のエネルギーバンドオフセット比は50:50に設定されています[25]。 Auger再結合係数、Shockley-Read-Hall(SRH)再結合寿命、および光抽出効率は、1.0×10 -30 に設定されています。 cm 6 / s [26]、10 ns [27]、および〜8%[28]、それぞれDUVLEDの場合。格子不整合界面での分極誘起界面電荷は、分極レベルを40%と仮定して考慮されます[29]。
結果と考察
DUVLEDの電流拡散効果に対するNPN-AlGaN構造の影響
LED A(つまり、NPN-AlGaN接合のない参照DUV LED)とLED B(つまり、NPN-AlGaN接合のあるDUV LED)は、電流の均質化におけるNPN-AlGaN構造の影響を調べるために最初に調査されました。 p型ホールサプライヤ層。各NPN-AlGaN接合には、20nmの厚さのp-Al 0.60 があります。 Ga 0.40 Mgドーピング濃度が1×10 18 のN挿入層 cm -3 。図3aは、電流密度が170 A / cm 2 の場合のエネルギーバンドプロファイルを示しています。 LED Bの場合。伝導帯の2つのエネルギー障壁がNPN-AlGaN接合部に形成され、エネルギー障壁の形成は、挿入されたp-Al 0.60 の枯渇効果によく起因します。 Ga 0.40 N層。 LED Bで生成されたバリアは、 R の界面抵抗を誘発します npn NPN-AlGaN接合領域で、 I の減少に役立ちます 1 / 私 2 式で述べたように。 3、より多くの穴が現在のパスに沿って流れるように I 2 。次に、電流密度が170 A / cm 2 の場合の、LED AおよびBの最後の量子井戸(LQW)の水平正孔濃度を計算して表示します。 、図3bに示すように。 LED Bは、LED Aと比較して、より良い横方向の電流拡散を得ることがはっきりとわかります。したがって、n型電子供給層のNPN-AlGaNが、p型正孔供給層の電流拡散効果を促進することを証明します。 DUVLED。

a LED Bのエネルギーバンドプロファイル。伝導帯、電子と正孔の擬フェルミ準位、価電子帯を E と定義します。 c 、 E fe 、 E fh 、および E v 、 それぞれ。 b 電流密度が170A / cm 2 の場合の、LEDAおよびBのLQWの水平正孔濃度
横方向の正孔濃度を示すことに加えて、図4aのLEDAおよびBのMQWの正孔濃度レベルも示しています。電流拡散効果が改善されたため、LEDAの場合と比較してLEDBの正孔濃度が向上していることがわかります。MQWの正孔濃度レベルの向上は、LED Bの放射再結合に有利に働きます(を参照)。図4b)。
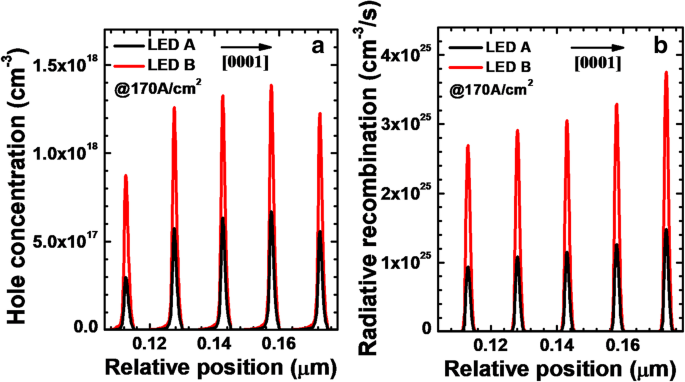
a 正孔濃度レベルと b LEDAおよびBのそれぞれのMQWにおける放射再結合プロファイル。電流密度が170A / cm 2 の場合、メサの右端から120μm離れた位置でデータを収集します。
NPN-AlGaN接合の影響は、図5に示すように、LED AおよびBの計算された光および電気性能によっても正当化されます。図5aは、両方のLEDの注入電流の関数としてのEQEおよび光パワー密度を示しています。 AとB。NPN-AlGaN接合によって改善された電流拡散効果と正孔注入効率のおかげで、LEDBはLEDAよりも高いEQEと光パワー密度の両方を持っていることがわかります。たとえば、電流密度が170 A / cm
2
の場合、LED Bの光パワー密度の向上は約1.67%です。 図5aによると。図5bの調査は、NPN-AlGaN接合を備えたLED Bの順方向電圧が、LED Aの順方向電圧と比較してわずかに増加していることを示しています。この現象は、NPN-AlGaNによって引き起こされる空乏領域のエネルギー障壁に起因すると考えられます。ジャンクション。幸い、LED Bの高い順方向電圧は、ウォールプラグ効率(WPE)に悪影響を与えることはなく、注入電流密度が〜56 A / cm
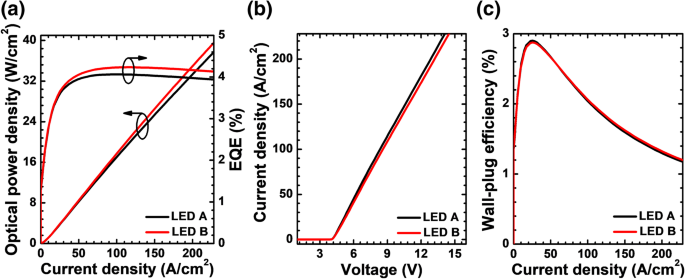
a 注入電流の観点から見たEQEと光パワー密度 b 電流-電圧特性、および c LEDAおよびBの注入電流の関数としてのWPE
p-AlGaN層のAlN組成が電流拡散効果に及ぼす影響
このセクションでは、NPN-AlGaN接合のAlN組成が、DUVLEDの光学的および電気的特性に与える影響を調べます。このメカニズムを明確に説明するために、5つのDUV LED、つまりLED C i を使用します。 ( i =1、2、3、4、および5)異なるNPN-Al x Ga 1- x p-Al x のAlN組成のNジャンクション Ga 1- x N個の挿入層はそれぞれ0.60、0.63、0.66、0.69、0.72です。 p-Al x のドーピング濃度と厚さ Ga 1- x N層は1.8×10 18 cm -3 それぞれ20nm。 2つのNPN-AlGaNジャンクション、つまりNPNPN-AlGaNジャンクションは、調査対象のすべてのデバイスに使用されます。次に、各NPN-Al x の伝導帯バリアの高さを計算します。 Ga 1- x LED用のN接合C i ( i =1、2、3、4、および5)表1に示すように、p-Al x Ga 1- x N挿入層が増加します。伝導バリアの高さが高いと、 R の値になります。 npn I の比率が増加し、減少します 1 / 私 2 式で述べたように、同時にトリガーされます。 3.その点を証明するために、電流密度が170 A / cm 2 の場合、調査したすべてのデバイスの最後の量子井戸の横方向の正孔分布 計算され、図6aに示されています。 LED C1の場合、穴の分布はNPN-Al 0.60 の後に変調できます。 Ga 0.40 N構造を採用しており、p-AlGaN挿入層のAlN成分が0.63まで増加すると、電流拡散効果がさらに向上することは明らかです。
<図>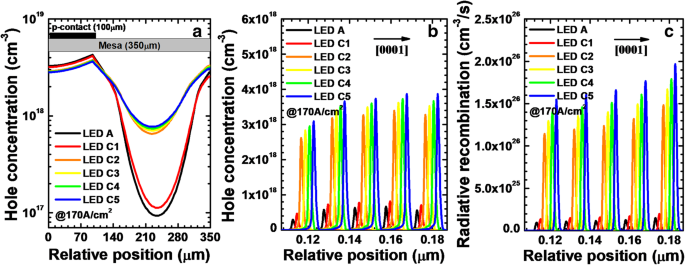
a LQWの水平正孔濃度、 b 正孔濃度レベル、および c LEDAおよびD i のMQWにおける放射再結合プロファイル ( i =1、2、3、4、および5)電流密度が170 A / cm 2 の場合 。 b の曲線を意図的にシフトします および c 識別を容易にするために2nmずつ
LEDAおよびC i のMQWでシミュレートされた正孔濃度レベルと放射再結合プロファイルを示します。 ( i =1、2、3、4、および5)電流密度が170 A / cm 2 の場合、図6bおよびc 、 それぞれ。正孔濃度レベルと放射再結合プロファイルは、メサの右端から120μm離れた場所で収集されます。識別を容易にするために、調査したDUV LEDの正孔濃度レベルと放射再結合プロファイルをそれぞれ2nmずつ空間的にシフトします。 MQWの最低の正孔濃度はLEDAではっきりと観察され、したがって、最低の放射再結合も図6cに示されています。 MQWの正孔濃度と放射再結合は、NPN-AlGaN接合の採用により増加し、p-AlGaN挿入層のAlN組成の増加に伴ってさらに増加する可能性があります。
注入電流密度の関数としての光パワー密度とEQEがさらに計算され、図7aで調査したLEDについて示されています。図に示すように、NPN-AlGaN接合を採用すると、EQEと光パワー密度が増加します。さらに、p-AlGaN挿入層のAlN組成が増加するにつれて、EQEと光パワー密度をさらに高めることができます。これは、図6aに示すように、MQWのより均一な横方向の穴の分布に寄与します。 LEDAおよびC i の電流-電圧特性 ( i =1、2、3、4、および5)を図7bに示します。 LED C1の順方向電圧は、LED Aと比較してわずかな増加を示し、LEDC5は最大の順方向電圧を示します。挿入図は、電流密度が170 A / cm 2 の場合のすべての調査対象LEDの順方向電圧を示しています。 。 LED Aと比較すると、LED C2、C3、およびC4の順方向電圧が低下することは注目に値します。NPN-AlGaN接合はDUV LEDの垂直抵抗を増加させますが、水平方向に沿ったより均一なキャリア集中により水平導電率が向上します。したがって、順方向電圧が低下します。これは、電流拡散層が適切に設計されている限り、強化された電流拡散効果がDUVLEDの順方向動作電圧を低減するのに役立つ可能性があることを示しています[30]。ただし、私たちの設計ではバリアを誘導することで電流経路を変調するため、バリアの高さが高すぎると、LEDC5などの電気コンダクタンスが犠牲になる可能性があります[21]。
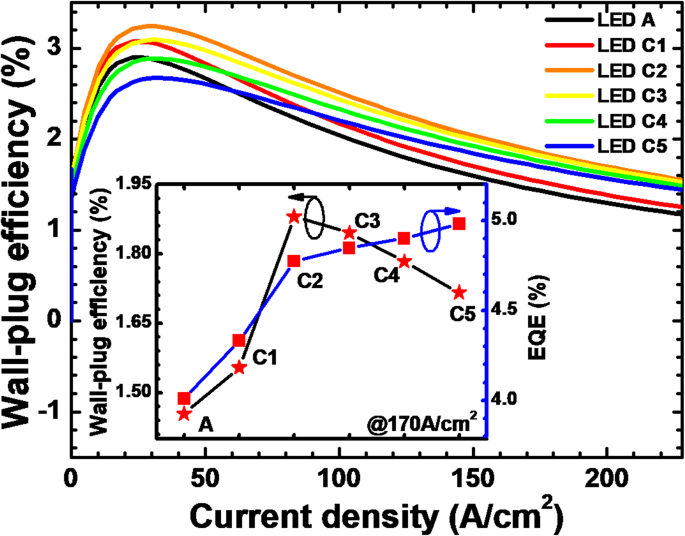
a 注入電流と b に関するEQEと光パワー密度 LEDAおよびC i の電流-電圧特性 ( i =1、2、3、4、および5)。挿入図:LEDAおよびC i の順方向電圧 ( i =1、2、3、4、および5)電流密度が170 A / cm 2 の場合
調査したすべてのデバイスの注入電流密度の関数としてのWPEを図8に示します。LEDAと比較すると、NPN-AlGaN接合が採用されるとLEDC1のWPEが増加します。 LED用WPEC i ( i =2、3、4、および5)は、NPN-AlGaN接合部のp-AlGaN層のAlN組成が増加すると、さらに改善できます。ただし、LED C2は、LED C i の中で光パワー密度が比較的低いにもかかわらず、順方向動作電圧が最も低いため、最も高いWPEを示します。 ( i =2、3、4、および5)。さらに、注入電流密度170 A / cm 2 でのWPEとEQEを示します。 挿入図の調査対象のすべてのデバイス。高い注入電流密度では、電流の密集効果が深刻であることはよく知られています。 LED C5のNPN-AlGaN接合は、電流を均一化するのに最適です。ただし、順方向動作電圧が大幅に上昇すると、WPEは十分ではありません。したがって、EQEとWPEの両方の機能を強化する前に、NPN-AlGaN接合のp-AlGaN挿入層のAlN成分の値を完全に最適化する必要があります。
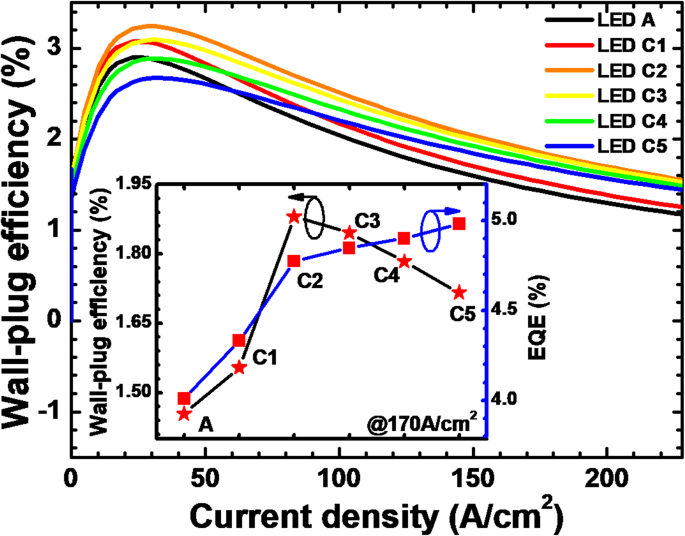
WPEとLEDAおよびC i の注入電流との関係 ( i =1、2、3、4、および5)。挿入図:電流密度が170 A / cm 2 の場合の、さまざまなAlN成分を含むp-AlGaN層で構造化された調査対象LEDのEQEおよびWPE
p-AlGaN層のMgドーピング濃度が電流拡散効果に及ぼす影響
NPN-AlGaN接合の空乏領域の幅は、p-AlGaN挿入層のMgドーピング濃度を変えることで管理でき、それに応じて伝導帯バリアの高さも変わります。したがって、 R の値 npn NPN-AlGaN接合の空乏領域が広くなり、 I の値が大きくなると、増加する可能性があります。 1 / 私 2 減少します。つまり、DUVLEDの電流拡散効果を改善できます。この点をよりよく解明するために、NPN-AlGaN接合のp-AlGaN挿入層に異なるMgドーピング濃度の5つのDUV LEDを設計し、調査しました。 p-AlGaN層のMgドーピング濃度を3×10 17 に設定しました。 、7.5×10 17 、1.7×10 18 、2×10 18 、および3×10 18 cm -3 LED用D i ( i =1、2、3、4、および5)、それぞれ。 p-AlGaN挿入層の厚さとAlN組成は、それぞれ20nmと0.61です。 2つのNPN-AlGaN接合を採用しています。表2に示すように、p-AlGaN層のMgドーピング濃度が高くなると、伝導帯障壁の高さが高くなります。次に、電流密度が170 A / cm 2 の場合の、最後の量子井戸の正孔濃度を計算して表示します。 図9aに示すように、LED Aの横方向の正孔分布と比較して、DUV LEDにNPN-AlGaN接合を導入すると、横方向の正孔分布がより均一になることは明らかです。さらに、NPN-AlGaN接合のp-AlGaN層のMgドーピング濃度が高くなると、さらに均質な正孔分布を得ることができます。
<図>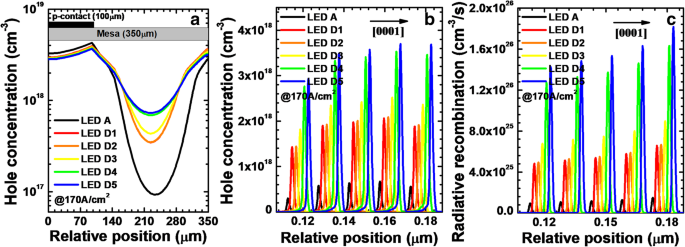
a LQWの水平正孔濃度、 b 正孔濃度レベル、および c LEDAおよびD i のMQWにおける放射再結合プロファイル ( i =1、2、3、4、および5)電流密度が170 A / cm 2 の場合 。 b の曲線を意図的にシフトします および c 識別を容易にするために2nmずつ
次に、電流密度が170 A / cm 2 の場合に、MQWで計算された正孔濃度レベルと放射再結合プロファイルが図9bおよびcのすべての調査対象LEDについて示されます。 、それぞれ、データが収集される場所は、右メサエッジから120μm離れています。予想通り、LED D i ( i =1、2、3、4、および5)は、LED Aと比較してMQWの正孔濃度レベルと放射再結合プロファイルが高く、p-AlGaN層のMgドーピング濃度の増加に伴って正孔濃度と放射再結合が増加します。 NPN-AlGaN接合を備えたLED用。 LED D i のMQWの正孔濃度の上昇に寄与します ( i =1、2、3、4、および5)強化された電流拡散効果。
電流混雑効果の減少とMQWの正孔濃度の上昇により、LED D i ( i =1、2、3、4、および5)は、それに応じて、促進されたEQEと光パワー密度を示します(図10aを参照)。 LEDAおよびD i の電流-電圧特性 ( i =1、2、3、4、および5)を図10bに示します。どうやら、LEDの順方向動作電圧D i ( i =1、2、3、4、および5)p-AlGaN挿入層のMgドーピング濃度の増加とともに増加します。その中で、LED D5が最大のターンオン電圧を示し、これは、p-AlGaN層の非常に高いレベルのMgドーピング濃度によって引き起こされる寄生ダイオードに起因します。図10bの挿入図によると、注入電流密度が170 A / cm 2 の場合、LEDD5は調査したすべてのLEDの中で最大の順方向動作電圧を示すこともわかります。 。
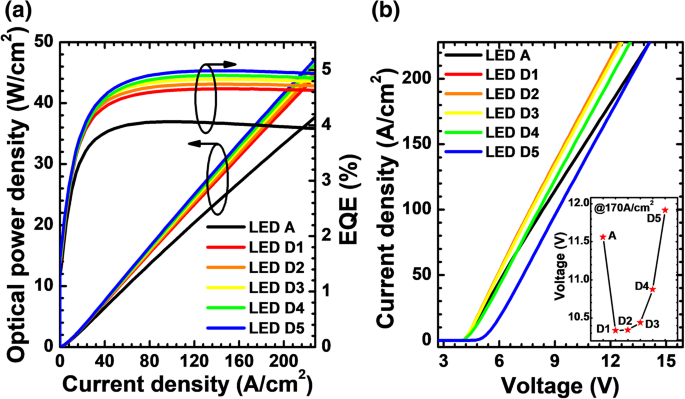
a 注入電流と b に関するEQEと光パワー密度 LEDAおよびD i の電流-電圧特性 ( i =1、2、3、4、および5)。挿入図:LEDAおよびD i の順方向電圧 ( i =1、2、3、4、および5)電流密度が170 A / cm 2 の場合
より包括的な分析のために、図11に示すように、調査したすべてのLEDの注入電流密度の関数としてWPEを計算します。LEDのWPE D i ( i =1、2、3、および4)は、LED Aの場合よりも高くなります。LEDD5のWPEは、注入電流密度が43 A / cm 2 より大きい場合にのみ、LEDAのWPEを超えます。 。 43 A / cm 2 未満の電流密度でのLEDD5の低いWPE これは、前述のように、NPN-AlGaN接合での追加の順方向電圧消費によるものです。挿入図から、EQEはp-AlGaN層のMgドーピング濃度の増加とともに上昇傾向を示していることがわかります。ただし、p-AlGaN層のMgドーピング濃度がさらに高くなると、WPEは低下します。したがって、電流拡散効果と順方向電圧は、p-AlGaN挿入層のMgドーピングレベルに非常に敏感であると結論付けます。
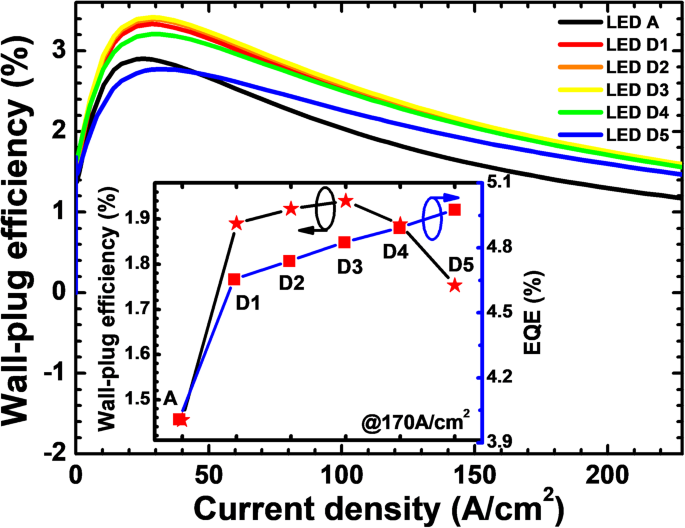
WPEとLEDAおよびD i の注入電流との関係 ( i =1、2、3、4、および5)。挿入図:電流密度が170 A / cm 2 の場合、さまざまなドーピング濃度のp-AlGaN層で構造化された調査対象LEDのEQEおよびWPE
電流拡散効果に対するp-AlGaN層の厚さの影響
このセクションでは、NPN-AlGaN接合部のp-AlGaN挿入層の厚さがLEDの性能に与える影響を調査します。まず、2つのNPN-AlGaN接合(すなわち、NPNPN-AlGaN接合)がすべての研究対象のDUV LEDに適用され、NPN-AlGaN接合のp-AlGaN層のAlN組成とドーピング濃度は0.61と1.5です。 ×10 18 cm -3 、 それぞれ。次に、LED T i のp-AlGaN層に18、20、24、28、および32nmのさまざまな厚さを設定しました。 ( i =1、2、3、4、および5)、それぞれ。 The calculated conduction band barrier heights for each NPN-AlGaN junction are presented in Table 3. It can be seen that the conduction band barrier height increases when the p-AlGaN layer in the NPN-AlGaN junction becomes thick, which enables the reduction of I 1 /I 2 and correspondingly the improved current spreading.
<図>We calculate and show the horizontal hole concentration in the LQW for LEDs A and Ti (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 in Fig. 12a. Clearly, the hole distribution becomes more homogeneous when the NPN-AlGaN junction is introduced in the DUV LED structure, and it becomes more uniform if the thickness for the p-AlGaN layer in the NPN-AlGaN junction gets larger. The reduced current crowding effect is ascribed to the higher conduction band barrier height in the depletion region caused by the thickened p-AlGaN layer in the NPN-AlGaN junction. Figure 12b and c exhibit the hole concentration levels and radiative recombination profiles, respectively, for LEDs A and Ti (i =1, 2, 3, 4, and 5) at the injection current density of 170 A/cm 2 。 The hole concentration levels and radiative recombination profiles are collected at the location of 120 μm away from the right-hand edge of the mesa. We can see that, when compared to that of LED A in the MQWs, LEDs Ti (i =1, 2, 3, 4, and 5) show the higher hole concentration levels and thus higher radiative recombination profiles. Once the thickness of the p-AlGaN layer is increased, further enhanced hole concentration and radiative recombination in the MQWs can be obtained.
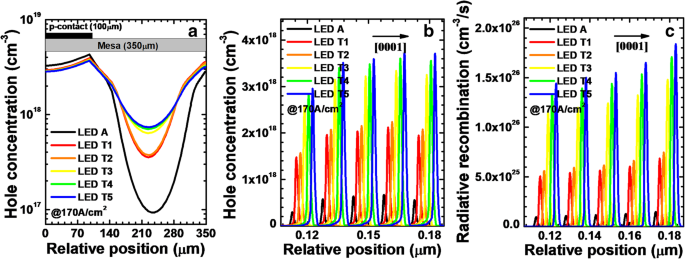
a Horizontal hole concentration in the LQW, b hole concentration levels, and c radiative recombination profiles in the MQWs for LEDs A and Ti (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 。 We purposely shift the curves for b および c by 2 nm for easier identification
The observed optical power density and EQE for all studied LEDs in Fig. 13a agree well with the results shown in Fig. 12c, such that the increasing thickness for the p-AlGaN layer in the NPN-AlGaN junction can improve the optical power density and EQE. Moreover, we calculate and show the current-voltage characteristics for LEDs A and Ti (i =1, 2, 3, 4, and 5) in Fig. 13b. It shows that the forward operating voltages for LEDs Ti (i =1, 2, 3, and 4) exhibit a significant reduction when compared to that for LED A at the injection current density larger than 102 A/cm 2 , which is due to the significantly improved current spreading effect after adopting the NPN-Al0.61 Ga0.39 N junction as mentioned previously. However, a too thick p-AlGaN layer can cause an increase in the turn-on voltage owing to the parasitic N-AlGaN/P-AlGaN diode, e.g., LED T5 has the highest forward operating voltage among all the investigated LEDs when the current density is 170 A/cm 2 , which is also shown in the inset figure of Fig. 13b.
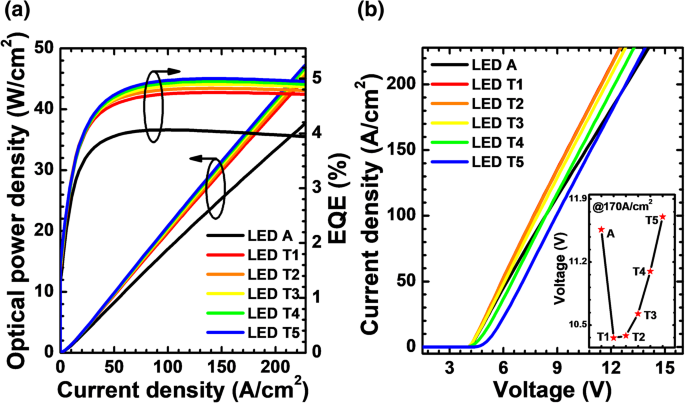
a EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ti (i =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ti (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
To this end, it is particularly important to further discuss the impact of higher forward operating voltage on DUV LED performance. Therefore, we calculate the WPE for all investigate devices and show the results in Fig. 14. We can see that the WPE for all LEDs with NPN-AlGaN junction exhibits distinct enhancement when compared to that for LED A. The presented WPEs in the inset figure also indicate that the NPN-AlGaN-structured DUV LED can save more electrical power than LED A. It is worth mentioning that the thickness for the p-AlGaN layer cannot be improved blindly, such that only when the thickness is properly set, then fully maximized WPE can be obtained.
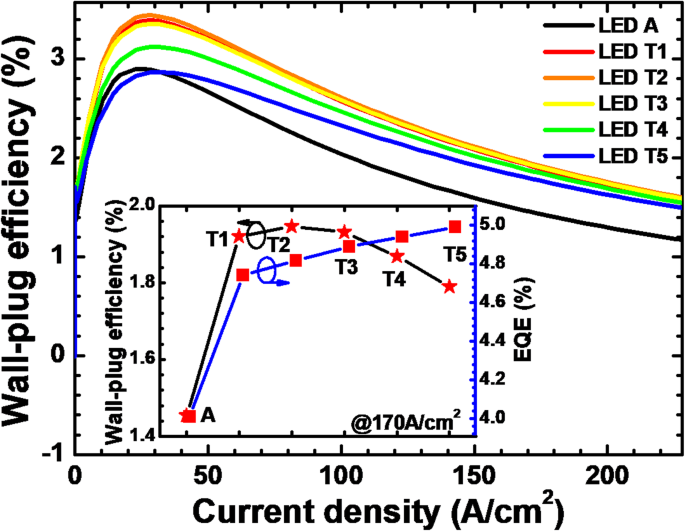
Relationship between WPE and the injection current for LEDs A and Ti (i =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with a p-AlGaN layer with various thicknesses when the current density is 170 A/cm 2
Effect of the NPN-AlGaN Junction Number on the Current Spreading Effect
Finally, we investigate the influence of the NPN-AlGaN junction number on the current spreading effect. The p-Al0.61 Ga0.39 N layer is adopted in the NPN-AlGaN junction for the proposed DUV LEDs in this section, for which the Mg doping concentration and thickness are 1.5 × 10 18 cm -3 and 20 nm, respectively. LEDs Ni (i =1, 2, 3, 4, and 5) have 1, 2, 3, 4, and 5 NPN-AlGaN junctions, respectively. As presented in Table 4, the conduction barrier heights of all NPN-AlGaN junctions are almost the same for LEDs Ni (i =1, 2, 3, 4, and 5). However, the total conduction barrier height for NPN-Al0.61 Ga0.39 N junctions in each investigated DUV LED surely increases when more NPN-Al0.61 Ga0.39 N junctions are utilized. Thus, the value of N × R npn can be enhanced, which helps to better spread the current horizontally, i.e., the increased value of I 2 in Eq. 3 is favored. The enhanced current spreading effect can be observed in Fig. 15a. The hole concentration in the LQW can become more uniform if the NPN-AlGaN junction number becomes more.
<図>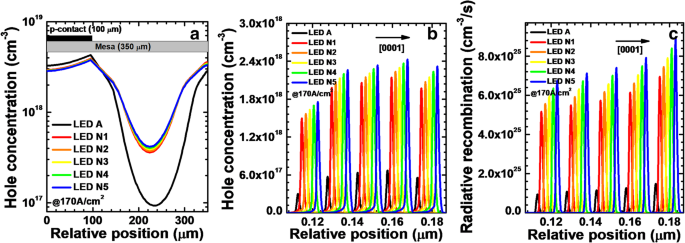
a Horizontal hole concentration in the LQW, b hole concentration, and c radiative recombination profiles in the MQWs for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 。 We purposely shift the curves for b および c by 2 nm for easier identification
Then, the hole concentration levels and radiative recombination profiles in the MQWs for LEDs Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 are exhibited in Fig. 15b and c, respectively. We collect the hole concentration levels and radiative recombination profiles at the location of 120 μm away from the right-hand mesa edge. The hole concentration and radiative recombination are improved by using the NPN-Al0.61 Ga0.39 N junction, and further improvement can be obtained when more NPN-AlGaN junctions are included. Ascribed to the enhanced hole concentration in the MQWs, the optical power density and EQE for the DUV LEDs with NPN-AlGaN junction also shows a significant improvement. The current-voltage characteristics for all studied devices are shown in Fig. 16b, which illustrates that the forward operating voltages for LEDs Ni (i =1, 2, 3, 4, and 5) are lower than that for LED A, and this indicates that the current spreading effect can help to reduce the forward voltage once the Mg doping concentration, thickness, and AlN composition for the p-AlGaN layer are appropriately applied to the NPN-AlGaN junction. The turn-on voltage for all LEDs with NPN-AlGaN junction is almost the same as that for LED A, which illustrates the negligible impact of the reversely biased N-AlGaN/P-AlGaN parasitic junction if the Mg doping concentration in the p-AlGaN layer is properly set, i.e., the p-AlGaN layer has to be completely depleted before the device is biased.
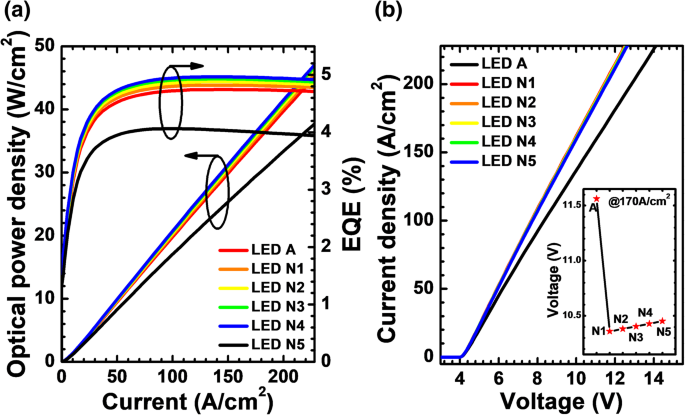
a EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ni (i =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
Last but not the least, the WPEs have also been demonstrated for LEDs Ni (i =1, 2, 3, 4, and 5) in Fig. 17. The WPEs of all DUV LEDs with NPN-Al0.61 Ga0.39 N junction have been promoted owing to the reduced forward operating voltage. In the inset figure, we show the EQE and WPE for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 。 Although the EQE and WPE for LEDs Ni (i =1, 2, 3, 4, and 5) increase with the increasing of the NPN-AlGaN junction number, clearly, we can see that the magnitude of the increase is gradually decreasing, which indicates that the NPN-AlGaN junction number also shall be set to a proper number, and we firmly believe that the device will consume more electrical power if too many NPN-AlGaN junctions are adopted in DUV LEDs.
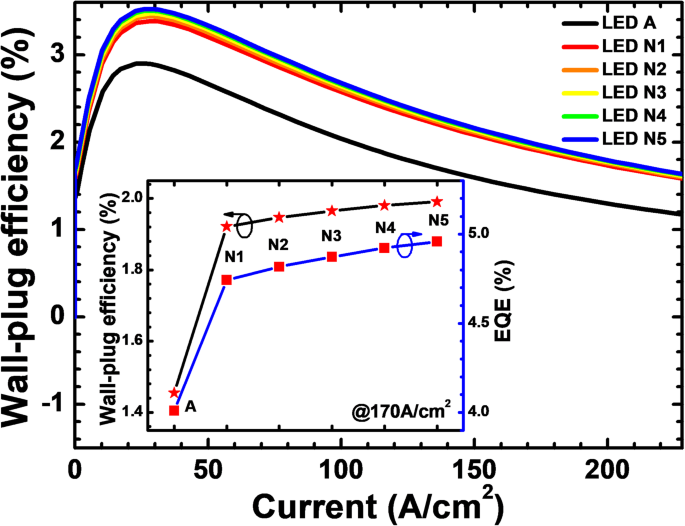
Relationship between WPE and the injection current for LEDs A and Ni (i =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with various NPN-AlGaN number when the current density is 170 A/cm 2
結論
To conclude, we have suggested embedding the NPN-AlGaN junction in the n-type electron supplier layer for DUV LEDs. After comprehensive and systematic discussions, we find that the NPN-AlGaN junction can reduce the current crowding effect in the p-type hole supplier layer and improve the hole injection for DUV LEDs. The NPN-AlGaN junction can tune the conductivity for the n-type electron supplier layer so that the current path in the p-type hole supplier layer can be manipulated. For further explorations, we have investigated the impact of different parameters for NPN-AlGaN junctions on the current spreading effect, the EQE, and the WPE. We find that the current can be further homogenized if the AlN composition, the Mg doping concentration, the thickness of the p-AlGaN insertion layer, and the NPN-AlGaN junction number are increased properly. Although the EQE can be promoted by using the proposed NPN-AlGaN junctions, the WPE is not always monotonically improving, which arises from the additional voltage drop at the barriers within the NPN-AlGaN junctions. Hence, more attention shall be made when designing NPN-AlGaN current spreading layers for DUV LEDs. However, we firmly believe that our results have provided an alternative design strategy to reduce the current crowding effect for DUV LEDs. Meanwhile, we also have introduced additional device physics and hence are very useful for the community.
データと資料の可用性
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
略語
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE:
-
External quantum efficiency
- ITO:
-
Indium tin oxide
- LQW:
-
Last quantum well
- MQW:
-
Multiple quantum wells
- NPN-AlGaN:
-
n-AlGaN/p-AlGaN/n-AlGaN
- IQE:
-
Internal quantum efficiency
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Wall-plug efficiency
- ZGO:
-
Zinc gallate
ナノマテリアル
- ファスナー用の4つの主要なスロット付きドライブタイプ
- AIコンピューティングのためのニューロモルフィックチップの主張
- 電子増倍管の発光層の設計
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- ペロブスカイト太陽電池用のTiO2コンパクト層を製造するための最適なチタン前駆体
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- PEDOT:PSSを正孔輸送層として処理する高極性アルコール溶媒を使用した高輝度ペロブスカイト発光ダイオード
- AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
- 異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響
- 高効率白色発光ダイオードのための環境に優しいペロブスカイトの統合
- 深紫外線フリップチップ発光ダイオードの光抽出効果に及ぼすメッシュp型接触構造の影響



