サブスレッショルドスイング動作を備えたZrOx負容量電界効果トランジスタ
要約
ここでは、ZrO x を報告します ±1V V 未満の45.06mV / decadeサブスレッショルドスイング(SS)を備えたベースの負の静電容量(NC)FET GS 範囲。これにより、将来の電圧スケーラブルなNCFETアプリケーションで新しい機会を実現できます。 Ge / ZrO x の強誘電体のような振る舞い / TaNコンデンサは、酸素空孔双極子に由来することが提案されています。アモルファスHfO 2 のNC効果 およびZrO x フィルムデバイスは、ゲートリークの突然の低下、負性微分抵抗(NDR)現象、 I の強化によって証明できます。 DSおよびサブ60サブスレッショルドスイング。 5 nm ZrO x ベースのNCFETは、時計回りに0.24 Vのヒステリシスを実現し、60 mV / decade SS未満、12% I ZrO x のないコントロールデバイスと比較したDSの機能強化 。 Al 2 の抑制されたNC効果 O 3 / HfO 2 NCFETとZrO x の比較 NCFETは、Al 2 での負の界面双極子による、前方掃引における酸素空孔双極子の部分的なスイッチングに関連しています。 O 3 / HfO 2 インターフェイス。
背景
相補型金属酸化膜半導体(CMOS)デバイスが絶えず縮小するにつれて、集積回路(IC)技術は「ムーア以上の時代」の時代に入りました。 IC産業と技術の原動力は、トランジスタの小型化ではなく、消費電力の削減になります[1、2]。ただし、MOSFETのボルツマン専制政治である60 mV / decade SSを超えると、エネルギー/電力効率が制限されます[3]。近年、衝突電離MOSFET、トンネルFET、NCFETなど、提案されている多くの新しいデバイスには、60 mV / decade未満のしきい値スイングを実現する機能があります[4、5、6、7]。構造が単純で、SSが急峻で、駆動電流が改善されているため、強誘電体(FE)膜を備えたNCFETは、これらの新しいデバイスの中で魅力的な代替品と見なされています[8、9、10]。報告されているNCFETの実験には、主にPbZrTiO 3 が含まれます。 (PZT)、P(VDF-TrFE)およびHfZrO x (HZO)[11,12,13,14,15,16,17]。しかし、多結晶強誘電体材料の粒界に沿った高いプロセス温度と望ましくないゲートリーク電流により、最先端の技術ノードの開発が制限されています[18、19、20、21、22、23、24、25 、26]。最近、アモルファスAl 2 の強誘電性 O 3 およびZrO x 電圧変調された酸素空孔双極子によって可能になるフィルムが調査された[27、28、29]。結晶性の対応物と比較して、アモルファス強誘電体様フィルムは、プロセス温度および漏れ電流の低減において大きな利点を有する。したがって、不揮発性メモリおよびアナログシナプスアプリケーション用のアモルファスゲート絶縁体を備えたFeFETに関する大量の研究があります[27、30、31、32、33、34]。ただし、1トランジスタZrO x の体系的な調査 ベースのNCFETは実行されていません。
この作業では、5 nm ZrO x を備えたGeNCFET 強誘電体誘電体層と5nm Al 2 O 3 / HfO 2 強誘電体誘電体層がそれぞれ提案されている。 ZrO x で60mV / decade未満の急勾配を実験的に観察しました (5 nm)NCFET。これはZrO x のNC効果に起因する可能性があります。 強誘電体層。そして、偏光を分析しました P 印加電圧の関数として V Ge / ZrO x の場合 / TaNコンデンサ。 Ge / ZrO x の強誘電体のような振る舞い / TaNコンデンサは、電圧によって誘発される酸素空孔双極子によって誘発されます。さらに、改善された I DS そして私の突然の低下 G Al 2 で O 3 / HfO 2 NCFETとZrO x NC効果へのNCFET。また、Al 2 でNDR現象を観察しました。 O 3 / HfO 2 NCFETとZrO x NCFET。さらに、Al 2 での界面双極子によるNC効果の減少の物理的メカニズムをさらに分析しました。 O 3 / HfO 2 NCFET。 ZrO x 60 mV未満/ディケードの急勾配、改善されたドレイン電圧、および低い動作電圧を備えたNCFETは、「ムーア以上の時代」の低消費電力のNCFETの設計に適しています。
メソッド
ZrO x を使用するNCFETの主要なプロセスステップ およびAl 2 O 3 / HfO 2 製造を図1aに示します。 Al 2 を含むさまざまなゲート誘電体絶縁体 O 3 /アモルファスHfO 2 (5 nm)フィルムとアモルファスZrO x (4.2 nm)膜は、300°Cで原子層堆積(ALD)によってn-Ge(001)基板上に成長しました。 TMA、TDMAHf、TDMAZr、およびH 2 O蒸気は、それぞれAl、Hf、Zr、Oの前駆体として使用されました。 HfとZrの前駆体のパルス時間とパージ時間は、それぞれ1.6秒と8秒です。 Alの前駆体のパルス時間とパージ時間はそれぞれ0.2秒と8秒です。次に、TaNトップゲート電極をHfO 2 に蒸着しました。 またはZrO x 反応性スパッタリングによる表面。ソース/ドレイン(S / D)領域は、リソグラフィーパターニングとドライエッチングによって定義されました。その後、ホウ素(B + )およびニッケル(Ni)がソース/ドレイン(S / D)領域に堆積しました。最後に、350°Cで30秒間、10 8 でラピッドサーマルアニーリング(RTA)を行います。 Pa窒素アンビエントを実施した。図1b、dは、製造されたAl 2 の概略図を示しています。 O 3 / HfO 2 NCFETとZrO x NCFET。図1cの高分解能透過型電子顕微鏡(HRTEM)画像は、アモルファスHfO 2 を示しています。 (5 nm)Al 2 を使用したGe(001)上のフィルム O 3 界面層。図1eのHRTEM画像は、アモルファスZrO x を示しています。 Ge(001)上の(4.2 nm)フィルム。 ZrO x のC–V曲線 NCFETとTaN / ZrO x のX線光電子スペクトル(XPS) (4.2 nm)/ Geコンデンサは追加ファイル1で測定されました:図S1。
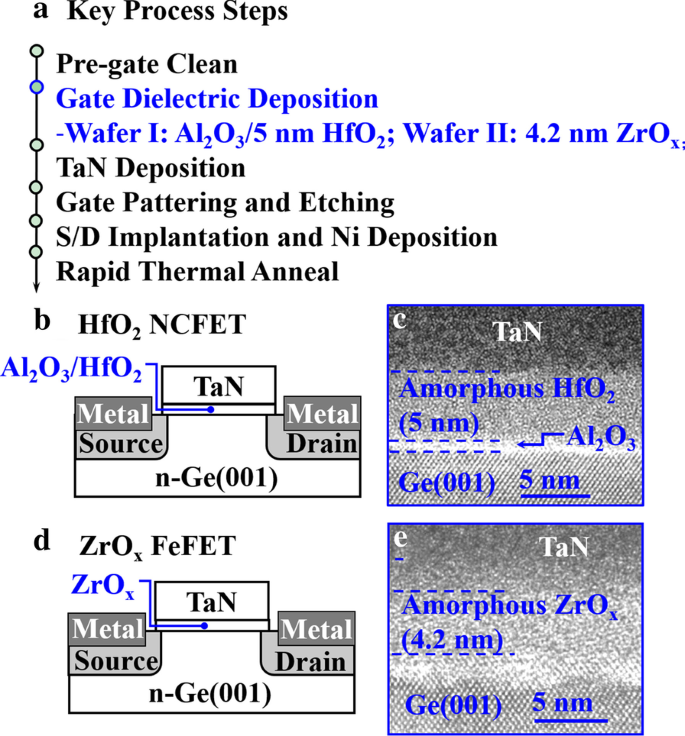
a Al 2 を製造するための主要なプロセスステップ O 3 / 5 nm HfO 2 NCFETおよび4.2nm ZrO x NCFET。 b 回路図と c 作製したZrO x のHRTEM画像 NCFET。 d 回路図と e 作製したAl 2 のHRTEM画像 O 3 / HfO 2 NCFET
結果と考察
図2aは、測定された分極曲線 P v.s. を示しています。 印加電圧 V Ge / ZrO x の特性 3.3kHzの/ TaNコンデンサ。ゲートの長さ( L G )コンデンサの8μmです。残留分極 P r Ge / ZrO x の / TaNコンデンサは、 V のより広い掃引範囲で強化できます。 。アモルファスZrO x の強誘電体のような挙動 図2aのフィルムは、電圧駆動の酸素空孔双極子に由来することが提案されています[35]。図2bは、測定された P–V を示しています。 Ge / ZrO x の曲線 200〜10kHzのさまざまな周波数での/ TaNコンデンサ。アモルファスZrO x の強誘電体のような挙動を見ることができます フィルムはすべての周波数で安定しています。ただし、 P r アモルファスZrO x フィルムは周波数の増加とともに減少します。この現象は、高い測定周波数での不完全な双極子スイッチングによって説明できます[36、37]。測定周波数が高くなるにつれて、アモルファスZrO x の電界の方向が変化する時間 フィルムが減少します。したがって、酸素空孔の板間層の切り替えの一部が不完全であり、 P が減少します。 r 。

測定された P 対 V 4.2 nm ZrO x の特性 a のコンデンサ V のさまざまな掃引範囲 および b さまざまな測定周波数
図3aは、測定された I を示しています。 DS – V GS 強誘電性Al 2 の曲線 O 3 / HfO 2 V でのNCFET DS − 0.05 Vおよび−0.5V。 L G デバイスの数は3μmです。 0.14 V( V のヒステリシスループ DS =− 0.05 V、 I ds =1nA /μm)および0.08 V( V DS =− 0.5 V、 I ds =1nA /μm)がそれぞれ示されています。時計回りのヒステリシスループは、酸素空孔の移動とそれに伴う負電荷に起因します。酸素空孔双極子はGe / Al 2 に蓄積(枯渇)します O 3 正(負)の V の下のインターフェース GS 。したがって、しきい値電圧( V TH )ゲート電圧の順方向(逆方向)スイープの下で増加(減少)します。図3bに示すように、Al 2 の出力特性 O 3 / HfO 2 NCFETと制御FETを比較します。 Al 2 の飽和電流 O 3 / HfO 2 NCFETは26μA/μmを超え、| V での制御FETと比較して23%の上昇です。 GS – V TH | =| V DS | =0.8V。電流の増強は、反転電荷強度( Q )の増加によって引き起こされます。 inv )逆分極電場および表面電位の増幅[38、39]。現在の強化に加えて、得られた明らかなNDRは、アモルファスHfO 2 のNC効果を証明しています。 映画。 NDR効果は、 V としてのドレインからチャネルへの結合による酸素空孔双極子の不完全なスイッチングによって引き起こされます。 DS 増加します[40、41]。図3cは、測定されたゲートリーク I を比較しています。 G – V GS 5 nm Al 2 の曲線 O 3 / HfO 2 V でのNCFET DS − 0.05 Vおよび−0.5Vの。 I の突然の低下 G 逆掃引中のみ、アモルファスHfO 2 の電圧が低下したことを示します。 フィルムと表面電位の増幅[42]。前方掃引中にNC効果がないのは、アモルファスHfO 2 の酸素空孔双極子の部分的なスイッチングが原因です。 フィルム[43]。 Al 2 間で酸素原子を含む異なる能力 O 3 およびHfO 2 層は、Al 2 で酸素の再分配と負の界面双極子につながります O 3 / HfO 2 インターフェイス[44、45]。負の界面双極子が存在するため、アモルファスHfO 2 は困難です。 前方掃引で完全な偏光スイッチング(NC効果)を実現するフィルム(追加ファイル1)。
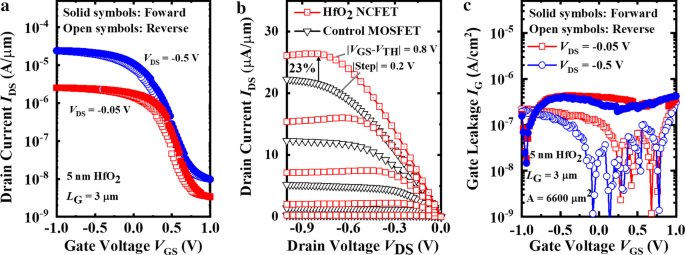
a 測定された I DS – V GS 5 nm HfO 2 の曲線 V の場合のNCFET DS =− 0.5Vおよび V DS =−0.05V。 b 測定された I DS – V DS HfO 2 の曲線 NCFETと制御MOSFET。 c 測定された I G – V GS 5 nm HfO 2 の曲線 V の場合のNCFET DS =− 0.5Vおよび V DS =− 0.05 V
図4aは、強誘電体ZrO x の測定された伝達曲線を示しています。 V でのNCFET DS − 0.05 Vおよび−0.5V。 L G 2つのデバイスのうち4μmです。 0.24 V( V )の時計回りのヒステリシスループ DS =− 0.05 V、 I ds =1nA /μm)および0.14 V( V DS =− 0.5 V、 I DS =1nA /μm)がそれぞれ示されています。図4bに示すように、ZrO x の出力特性 NCFETと制御FETを比較します。 ZrO x の飽和電流 NCFETは30μA/μmを超え、| V での制御FETと比較して12%の上昇があります。 GS – V TH | =| V DS | =1V。改善された電流増強とより明白なNDRは、アモルファスZrO x の増強されたNC効果を示しています。 フィルム(5 nm)と5 nm HfO 2 のコントラスト 映画。図4cは、測定されたゲートリーク I を比較しています。 G – V GS 5 nm ZrO x の曲線 V でのNCFET DS − 0.05 Vおよび−0.5V。突然の I と比較 G Al 2 の滴 O 3 / HfO 2 図3cの逆掃引中のみNCFET、 I の突然の低下 G 図4cの順方向と逆方向の両方のスイープでも、アモルファスZrO x でNC効果が向上していることがわかります。 映画。
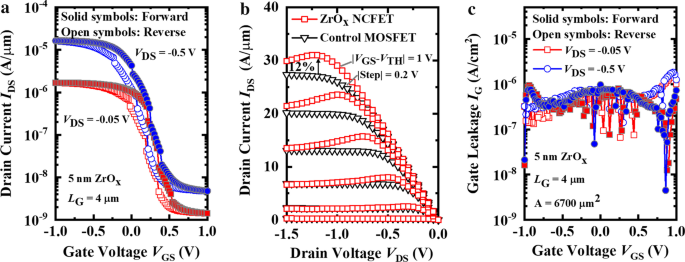
a 測定された I DS – V GS 5 nm ZrO x の曲線 V の場合のNCFET DS =− 0.5Vおよび V DS =−0.05V。 b 測定された I DS – V DS ZrO x の曲線 明らかなNDR現象を示すNCFETと制御MOSFET。 c 測定された I G – V GS 5 nm ZrO x の曲線 V の場合のNCFET DS =− 0.5Vおよび V DS =− 0.05 V
図5a、bは、 I の関数としての点SSを示しています。 DS Al 2 の場合 O 3 / HfO 2 およびZrO x V でのNCFET DS -0.05 Vおよび-0.5Vの値。図5bに示すように、 V の順方向または逆方向の掃引中に、サブ60 mV / decadeサブスレッショルドスイング(SS)を実現できます。 GS V で DS of- 0.05Vおよび-0.5V。 V の場合 DS is- 0.05 V、45.1 mV / decのポイントフォワードSSと55.2mV / decのポイントリバースSSが達成されました。 V の場合 DS is− 0.5 V、51.16 mV / decのポイントフォワードSSと46.52mV / decのポイントリバースSSが達成されました。 Al 2 の掃気効果の能力が異なるため O 3 / HfO 2 およびZrO x 層では、部分的な双極子の切り替えはAl 2 で発生します O 3 / HfO 2 NCFET。したがって、サブ60 mV / decade SSでのより明白なNC効果は、5 nm ZrO x で達成されます。 NCFET。
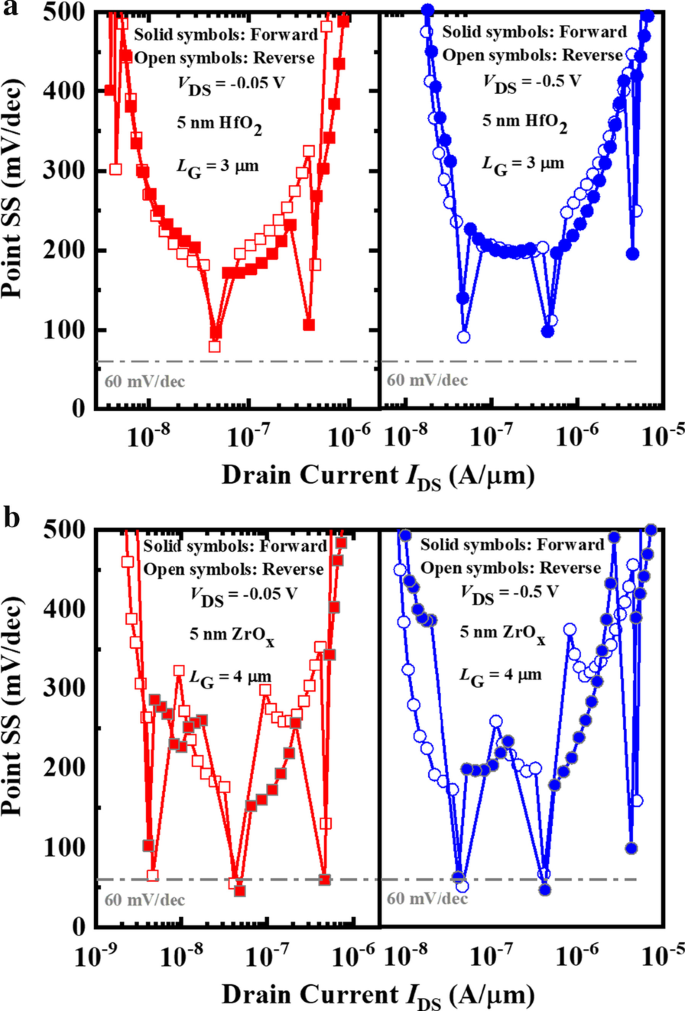
I の関数としてのポイントSS DS a の場合 Al 2 O 3 / 5 nm HfO 2 NCFETと b 5 nm ZrO x NCFET
結論
強誘電性NCZrO x のデモンストレーションを報告します 60 mV / 10年未満のSS、1 Vの低動作電圧、60mV未満のヒステリシスを備えたpFET。アモルファスZrO x の影響 強誘電挙動に関するフィルムは、酸素空孔双極子によって説明されます。改善された I DS とNDR現象はAl 2 でも得られます O 3 / HfO 2 NCFETとZrO x 制御装置と比較したNCFET。 Al 2 の抑制されたNC効果 O 3 / HfO 2 NCFETは、Al 2 での界面双極子による部分的な双極子の切り替えに起因する可能性があります。 O 3 / HfO 2 インターフェース。 ZrO x 60 mV未満/ディケードの急勾配、改善されたドレイン電圧、および低い動作電圧を備えたNCFETは、将来の低消費電力NCFET設計への新しい道を開きます。
データと資料の可用性
この記事の結論を裏付けるデータセットは、記事に含まれています。
略語
- TaN:
-
窒化タンタル
- ZrO x :
-
二酸化ジルコニウム
- TDMAZr:
-
テトラキス(ジメチルアミド)ジルコニウム
- P r :
-
残留分極
- E c :
-
強制電界
- MOSFET:
-
金属-酸化物-半導体電界効果トランジスタ
- Ge:
-
ゲルマニウム
- ALD:
-
原子層堆積
- B + :
-
ホウ素イオン
- Al 2 O 3 :
-
酸化アルミニウム
- HRTEM:
-
高分解能透過型電子顕微鏡
- Ni:
-
ニッケル
- RTA:
-
リペイドサーマルアニーリング
- I DS :
-
電流を排出する
- V GS :
-
ゲート電圧
- V TH :
-
しきい値電圧
- NCFET:
-
負の静電容量電界効果トランジスタ
ナノマテリアル
- スイッチとしての接合型電界効果トランジスタ(JFET)
- 材料:表面特性が改善され、充填挙動が最適化されたEPPフォーム
- 低抵抗Auオーミックコンタクトを備えた多層SnSeナノフレーク電界効果トランジスタ
- 熱DCプラズマプロセスによって調製されたSi-SiC複合ナノ粒子を用いたスパークプラズマ焼結SiCの焼結挙動
- 高度に圧縮耐性のあるスーパーキャパシタ電極としての超弾性と高静電容量を備えたグラフェン/ポリアニリンエアロゲル
- HfO2欠陥制御層を備えた単層カーボンナノチューブが支配的なミクロンワイドストライプパターンベースの強誘電体電界効果トランジスタ
- T型ゲートデュアルソーストンネル電界効果トランジスタのアナログ/ RF性能
- グラフェンベースのナノスケール真空チャネルトランジスタ
- 強化されたデュアルゲートと部分的なP埋め込み層を備えた超低比オン抵抗横方向二重拡散金属酸化物半導体トランジスタ
- 高いオン/オフ比と極性切り替え可能な光伝導性を備えたSnSe2電界効果トランジスタ
- フットプリントが小さく高性能な旋削能力



