Ga2O3MOSFETのチャネル最高温度の解析モデル
要約
この研究では、Ga 2 のチャネル最高温度を推定するための正確な解析モデルを提案しました。 O 3 ネイティブまたは高熱伝導率基板を備えたMOSFET。 Ga 2 の熱伝導率 O 3 異方性であり、温度の上昇とともに大幅に減少します。これは、Ga 2 の熱的挙動にとって重要です。 O 3 MOSFETであるため、モデルで考慮されます。数値シミュレーションはCOMSOLMultiphysicsを介して実行され、デバイスの幾何学的パラメーターと周囲温度を変化させることにより、チャネルの最大温度の電力密度への依存性を調査します。これは、分析モデルとの良好な一致を示し、このモデルの有効性を提供します。新しいモデルは、Ga 2 の効果的な熱管理に役立ちます。 O 3 MOSFET。
背景
酸化ガリウム(Ga 2 O 3 )ベースの金属-酸化物-半導体電界効果トランジスタ(MOSFET)は、Ga 2 の2つの主要な利点の恩恵を受けている、次世代のパワーエレクトロニクスの優れた候補です。 O 3 :非常に高いバンドギャップ(〜4.8 eV)と低コストで製造された高品質のバルク結晶[1]。電流密度[2]、絶縁破壊電圧[3]、性能指数[4]など、あらゆる面で電気的特性を改善するために多大な努力が払われてきました。パワーエレクトロニクスデバイスの前例のない可能性が実験的に確認されたため[5、6、7、8、9]、Ga 2 の性能と信頼性を調査することが今や最も重要です。 O 3 自己発熱効果、したがってチャネルの最高温度( T )の問題などのMOSFET max )、熱伝導率が比較的低いため(κ 、0.11〜0.27 Wcm -1 K -1 室温で)[1]。
近年、 T を推定するためのさまざまな方法 max Ga 2 の O 3 MOSFETは理論的および実験的に提案されています[10、11、12、13]。一般に、数値シミュレーションは T を定量的に推定できます。 max 特定のデバイスの。ただし、これには時間がかかります[14]。一方、 T の抽出 max 実験を通して常に過小評価されています[15]。したがって、 T を適切にモデル化するには、分析モデルを作成する必要があります。 max Ga 2 で O 3 MOSFET。時間効率と定性的評価で十分な精度を提供できます[14]。
本論文では、 T の分析モデルを提案する。 max Ga 2 の場合 O 3 κの依存性を考慮したキルヒホッフ変換を採用したMOSFET Ga 2 の温度と結晶学的方向に関する研究 O 3 。提案されたモデルはGa 2 に適用できます O 3 ネイティブまたは高熱伝導率基板を備えたMOSFET。分析モデルの妥当性と精度は、COMSOLMultiphysicsを介した数値シミュレーションとの比較によって系統的に検証されます。
メソッドとモデル開発
T の分析モデル max Ga 2 で O 3 MOSFETは、図1に示す構造に基づいて提案されています。構造の主要なパラメータを表1に示します。実際、ジュール熱はGa 2 O 3 MOSFET [13]。モデルを単純化するために、ゲートからの加熱効果は均一であり[12]、その厚さが無視できるため、ゲート酸化物を完全に貫通できると仮定します。 Ga 2 の下にあるさまざまな基板材料 O 3 このモデルでは、バルクGa 2 などのチャネルが考慮されます。 O 3 高いκ ボードの実現可能性と互換性を目指した材料。したがって、デバイスは2層の問題と見なされます。基板は理想的なヒートシンクと接触するため、底面は等温であり、その温度は周囲温度( T )と等しくなります。 amb 、デフォルトでは300 K)。断熱境界条件は、構造の他の表面に課されました。これらの境界条件は、[14、16]
として要約できます。 <図>
Ga 2 の概略図 O 3 MOSFET
ここで P 、 T およびκ y Ga 2 の[010]方向の消費密度、温度、熱伝導率を示します。 O 3 、 それぞれ。 P の単位が このペーパーではW / mmです。
κ Ga 2 の値 O 3 材料の熱特性の重要なパラメータの1つである、は、モデルの精度だけでなく、加熱効果の拡散にも重要な役割を果たします。つまり、κを注意深く説明します その深刻な異方性と温度依存性のために、値が必要です[17]。一般的に、κの依存性 Ga 2 の O 3 温度について( T )2つの異なる結晶方位([001]と[010])に沿って、
によって与えられます。 $$ {\ kappa} _ {\ left [001 \ right]} \ left(T \ right)=0.137 \ times {\ left(\ frac {T} {300} \ right)} ^ {-1.12}、$ $(4)$$ {\ kappa} _ {\ left [010 \ right]} \ left(T \ right)=0.234 \ times {\ left(\ frac {T} {300} \ right)} ^ {- 1.27}。$$(5)T の比較研究 max 異なる P 一定で現実的なκを考慮して、COMSOLMultiphysicsによって実行されました 、 それぞれ。 P で 1 W / mm、 T max それぞれ533Kと622Kの値が取得されます(図には示されていません)。したがって、 T の影響を考慮する必要があります。 κの結晶学的方向 Ga 2 の O 3 モデル内。
温度の振る舞いは、熱伝導方程式によって支配されます。 Ga 2 の定常状態での熱伝導方程式 O 3 ドメインは
$$ \ frac {\ partial} {\ partial x} \ left({\ kappa} _ {x} \ left(T \ right)\ frac {\ partial T} {\ partial x} \ right)+ \ frac { \ partial} {\ partial y} \ left({\ kappa} _ {y} \ left(T \ right)\ frac {\ partial T} {\ partial y} \ right)=0、$$(6)ここでκ x Ga 2 の[001]方向の熱伝導率を示します O 3 。非線形熱伝導方程式は、キルヒホッフの変換を使用して解くことができます。ただし、異方性が高いκのため、キルヒホッフ変換の適用が制限される場合があります。 Ga 2 で O 3 、厳密に言えば、等方性のκを持つ材料に対してのみ有効です。 [14]。上記の制限を考えると、κを考慮すべきではありません。 x およびκ y 2つの独立変数になります。図2は、熱抵抗の関係、つまり1 / κを示しています。 、および T 大きな T 上の[001]と[010]の方向 それぞれ範囲。 1 / κ y 1 /(cκで置き換えることができます x )および c 1.64に等しくなるように選択されます。したがって、式。 (6)は次の方程式に変換できます:

熱抵抗率と T の関係 [001]と[010]の方向について。緑の記号と赤の線は、それぞれ実際の値と適合値を示します。青い線は1 / κの仮説を表しています y ≈1/(cκ x )、ここで c =1.64
κの前述の近似に基づく x およびκ y 、キルヒホッフの変換は制限なしで使用できます。また、κの逆数もわかります。 Tに比例すると予想されます。 したがって、計算の複雑さを軽減するために、1 / κの式 x 1 / κとして簡略化できます x = aT + b 、図2に示すように。 a を使用する理由 、 b および c 次の方程式を書くのに便利です。
キルヒホッフの変換と変数分離の方法を適用することにより、 T の表現 max として導出することができます
$$ \ begin {aligned} T _ {{max}} =&\\&\、\ left({T _ {{amb}} + \ frac {b} {a}} \ right)exp \ left({\ frac {{aP \ left({t _ {{ch}} + t _ {{sub}}} \ right)}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ right)-\ frac {b} {a}、\\ \ end {aligned} $$(8)ここで
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ frac {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}}。$$(9)S は収束無限級数であり、実際の値の代わりに、簡単に取得できる近似値を計算に使用します。
Ga 2 の場合 O 3 κが高いMOSFET 基板では、キルヒホッフの変換を理論的に直接適用することはできません。実際、変換が有効であるためには、境界条件は等温(一定の T )である必要があります。 表面)、または固定熱流束密度を持っています。ただし、κが異なるため Ga 2 の O 3 および基板材料の場合、これらの境界条件は両方ともGa 2 では完全には満たされていません。 O 3 /基板インターフェース。 κを考えると Ga 2 の O 3 高いκよりもはるかに低い 基板、仮説、Ga 2 間の等温界面 O 3 そして基板が導入されます。この仮説は、 T という表現を導き出すのに役立ちます。 max その有効性は後で検証されます。この場合、熱抵抗( R TH )高いκ 基質、 T 間の差の比率 int および T amb および PW 、つまり R TH =( T int — T amb )/( PW )、 R として計算できます TH = LW /(κt sub )、ここで W は基板の幅です[19]。したがって、Ga 2 の温度の表現 O 3 /基板インターフェース( T int )は
$$ {T} _ {int} =\ frac {P {t} _ {sub}} {{\ kappa} _ {sub} L} + {T} _ {amb}、$$(10)ここでκ sub は不均一基板の熱伝導率であり、一定であると想定されています。さらに、Ga 2 間の熱境界抵抗に注意する必要があります。 O 3 異種基板はモデルに含まれていません。したがって、式の助けを借りて。 (8)、 T の表現 max Ga 2 の場合 O 3 異種基板を備えたMOSFETは次のように導出できます
$$ \ begin {aligned} T _ {{max}} =&\\&\; \ left({T _ {{int}} + \ frac {b} {a}} \ right)exp \ left({\ frac {{aPt _ {{ch}}}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ right)-\ frac {b} {a}、\\ \ end {aligned} $$(11)ここで
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ frac {{t} _ {ch }} {\ sqrt {c} L}}。$$(12)結果と考察
T の分析モデルの妥当性 max Ga 2 で O 3 このセクションでは、ネイティブ基板と熱伝導率の高い対応する基板の両方を考慮して、MOSFETを体系的に検証しました。モデルの妥当性をテストする最良の方法は、実験データに対してです。ただし、 t など、いくつかの重要な幾何学的パラメータは実験文献では見つかりませんでした。 sub および L 参考文献で。 [12]。したがって、最も正確な手段の1つである有限要素シミュレーションを使用して、モデルを検証します。図3は、 T の依存関係を示しています max 電力密度について P GA 2 について、COMSOLMultiphysicsと分析モデルの両方から取得 O 3 ネイティブ基板を備えたMOSFET。デバイスの長さ L など、さまざまなキーパラメータが考慮されます 、基板の厚さ t sub 、および周囲温度 T amb 。図3aに示すように、 T max 電力密度が高くなると自然に増加し、 L が小さいほど増加率が高くなります。 。これは、 L が大きいデバイスに起因します。 活性領域からの熱放散を可能にするため、全体の温度は L が小さい場合よりも低くなります。 同じ P [11]。つまり、その R TH 、曲線の傾きは、後者の傾きよりも小さくなっています。 さらに、κ Ga 2 の O 3 全体の温度が上がると減少し、その R TH また、 L が小さい場合よりもゆっくりと増加します。 したがって、これは図3a [19]で明らかです。同様に、 T の依存関係の調査 max t sub 図3bに示すように、実行されました。 T の傾向が観察されます max P に関して 図3aと同じです。基板が薄いほど、常に T の上昇が緩和されます。 max 拡大された電力密度を超えると、基板が薄いほど全体的な温度が低くなり、 R が小さくなることが理解できます。 TH 図3aの分析と同様に、その増加率。図3cは、 T の影響を比較しています amb T max P として 増加します。 2つの曲線の差がゆっくりと増加することは明らかです。これは、図3a、bの曲線とは異なります。通常、 R TH デバイスの幾何学的パラメータとκが支配的です 材料の価値。ただし、この場合、構造が固定されていることを考慮すると、 R の増加 TH κの減少によってのみ誘発されます Ga 2 の O 3 。一方、 T を考慮した提案モデルでは、高いレベルの一致が見られます。 -κの方向依存関係 Ga 2 の O 3 、モデルのスケーラブルな性質を確認します。平均して、提案されたモデルとシミュレーションの違いは<1 Kです。観察された全体的な優れた一致は、提案されたモデルが非常に効果的で正確であることを示唆しています。

T の依存関係 max a デバイスの長さ L 、 b 基板層の厚さ t sub 、および c 周囲温度 T amb 異なるパワーで P 。記号と線は、それぞれ提案されたモデルとシミュレーションの結果を示しています
同様に、図4に示すように、Ga 2 についても同様の比較が繰り返されます。 O 3 高κ上のMOSFET 基板、SiC。ここでは、 L の手順を説明します および T amb 選択したものは図3のものよりも大きく、さまざまなチャネルの厚さ t ch t の代わりに考慮されます sub この場合。それ以外の場合、 T の2つの曲線の差 max P に関して SiC基板の効率的な放熱能力により、各図で区別できなくなります。 κ SiCの(3.7 Wcm -1 K -1 )appliedは、COMSOLMultiphysicsソフトウェアのデフォルトパラメータです。高いκに感謝します SiCの場合、すべての図から、 T の増加がはっきりとわかります。 max P のようにほぼ線形です 増加します。これは、 R に対する温度の影響を意味します。 TH デバイスのはごくわずかです。私たちのモデルはこの線形関係をうまく記述できることを指摘しておく必要があります。ただし、 T max 現在のモデルで計算されたものはシミュレーションで予測されたものよりも低く、この違いは消費電力の増加とともにより明白になります。このメカニズムを示すために、シミュレートされた T int パワーを上げて抽出され、計算された T と比較されます int 式によって。 (10)図5にプロットされているように、ジュール熱は P としてデバイスの中央により集中することがわかります。 増加します。 0.5Kと4KのΔ T があります P の場合、この場所でのモデルとシミュレーションの間 =0.25と1W / mm。これが、モデルが T を正確に予測できない理由です。 max 。したがって、 T のより合理的な仮説 int 将来、より高い精度を得るために必要です。それにもかかわらず、 T max モデルでは、1 W / mmの消費電力密度でも、シミュレーションよりもわずか<4K低いと予測されています。つまり、均一な T の仮説が int は事実と矛盾していますが、私たちのモデルは T の推定値を提供できます max 十分な精度で。
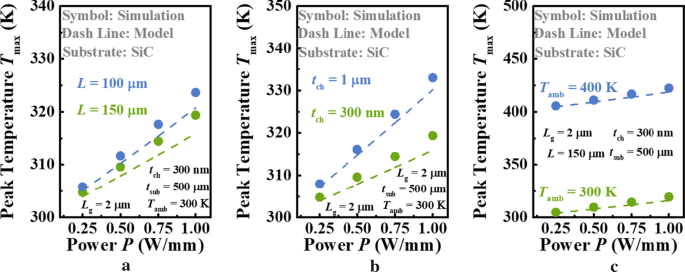
T の依存関係 max Ga 2 の O 3 a 上にSiC基板を備えたMOSFET デバイスの長さ L 、 b Ga 2 の厚さ O 3 レイヤー t ch 、および c 周囲温度 T amb 異なるパワーで P 。記号と線は、それぞれ提案されたモデルとシミュレーションの結果を示しています
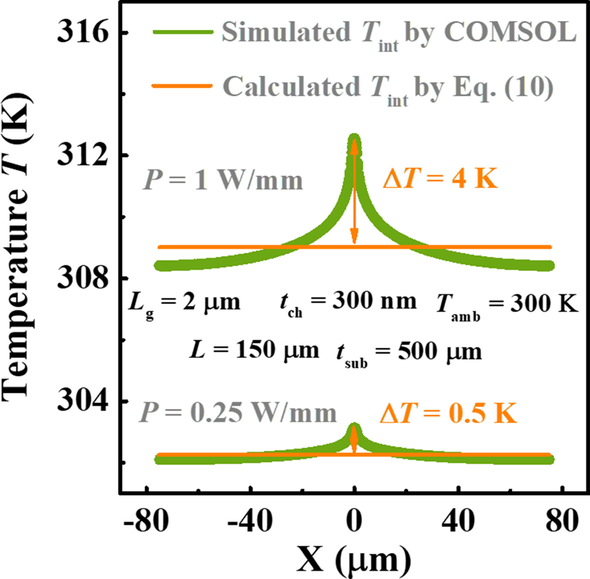
T の比較 int シミュレーションと式の間で計算されます。 (10)異なる P
結論
T を推定するための正確な分析モデル max Ga 2 の O 3 熱伝導率に依存する温度と方向を含むMOSFETが提示されます。デバイスの形状と材料パラメータに基づく簡単な式が導き出されました。さまざまな消費電力を変化させることにより、モデルとCOMSOLMultiphysics数値シミュレーションの間で優れた一致が得られました。 T の提案モデル max 効果的な熱管理パワーデバイス、特にGa 2 にとって非常に重要です。 O 3 MOSFET。
データと資料の可用性
この記事の結論を裏付けるデータセットは、記事に含まれています。
略語
- Ga 2 O 3 :
-
酸化ガリウム
- MOSFET:
-
金属-酸化物-半導体電界効果トランジスタ
- AlGaN:
-
アルミニウムガリウムナイトライド
- GaN:
-
窒化ガリウム
- SiC:
-
炭化ケイ素
ナノマテリアル



