高性能陽極加硫-前処理ゲートP + –π–M–N + InAs / GaSb超格子長波長赤外線検出器
要約
InAs / GaSb超格子赤外線検出器は、多大な努力を払って開発されました。ただし、その性能、特に長波長赤外線検出器(LWIR)は、電気的性能と光量子効率(QE)によって制限されます。アクティブ領域を強制的に p -適切なドーピングによるタイプは、QEを大幅に向上させることができ、ゲーティング技術を使用して電気的性能を大幅に向上させることができます。ただし、飽和バイアス電圧が高すぎます。飽和バイアス電圧を下げることは、ゲート電圧制御デバイスの将来のアプリケーションに幅広い展望を持っています。この論文では、ゲート付きP + について報告します。 – π –M–N + InAs / GaSb超格子長波長赤外線検出器は、200nmのSiO 2 を使用して、-10Vで最小飽和バイアスが減少したさまざまなπ領域ドーピングレベルを示します。 シンプルで効果的な陽極加硫前処理後の層。飽和ゲートバイアス電圧は、200nmのSiO 2 と同じ厚さで報告された-40Vよりもはるかに低くなっています。 パッシベーション層と同様の構造。光学的および電気的特性は、デバイスの電気的および光学的性能が過度のドーピング濃度によって弱められることを示しています。 77 Kでは、デバイスの50%カットオフ波長は約8 µm、100%カットオフ波長は10 µm、最大量子効率は62.4%、最大応答性は5 µmで2.26 A / W、最大デバイスのRAは1259.4Ωcm 2 。さらに、ゲート電極のないBe 780°Cドープ検出器の比検出率は、5.6×10 10 のピークを示します。 cm Hz 1/2 / W、5 µm、70 mvの逆バイアス電圧。これは、Be820°Cをドープした検出器の3倍以上です。さらに、ピーク比検出率をさらに1.3×10 11 に上げることができます。 cm Hz 1/2 ゲート電極で-10Vのバイアスを持つ10mvの予備バイアス電圧で5µmで/ W。
はじめに
タイプIIひずみ層超格子(T2SL)は、Sai-Halasz et al。以来、現在の研究の焦点になりつつあります。 [1]はその概念を提案しました。 T2SLのバンド構造と歪みを注意深く設計することにより、高性能の赤外線検出器を生成できます[2]。 T2SLのよく研究されているメンバーであるInAs / GaSb超格子は、赤外線検出器で幅広い展望を示す優れた材料システムです[3]。 InAs / GaSb超格子赤外線検出器は、多大な努力を払って開発されました。ただし、特に長波長赤外線検出器(LWIR)の性能は、電気的性能と光量子効率(QE)によって制限されます[4]。 LWIR検出器の対応する周囲温度(地上ベース)は約300 Kであり、これは9.6 µm(LWIR大気透過ウィンドウの中心)のピーク波長に対応し、幅広い用途があります[5]。ガス検知、暗視、赤外線早期警報、赤外線リモートセンシング、赤外線誘導など、軍事用途だけでなく、人々の生活にも幅広く利用されています。高性能の長波赤外線検出器を製造することは非常に意味があり、やりがいがあります。
検出器の構造設計とプロセス準備は、LWIR検出器の性能に大きな影響を与えます。活性領域の厚さを増やすことは、QEを改善するための最も直接的で効果的な方法であるように思われました。ただし、厚さが増すにつれてトラップ中心が増えるため、検出器の電気的特性が低下します。 LWIRおよび超長波長赤外線検出器(VLWIR)では、InAs層はGaSb層よりも厚くなる傾向があります。したがって、材料は n です。 -タイプ(少数キャリアは穴です)。アクティブ領域を強制的に p -適切なドーピングによるタイプは、デバイスの領域サイズを変更することなく、QEを大幅に向上させることができます[6]。ただし、ドーピング濃度が高くなればなるほど、デバイスの性能は向上します。特に、デバイスの電気的[7]および光学的性能は、過度のドーピング濃度によって弱まる可能性があります。
πのドーピング濃度を変更することに加えて 最近、デバイスの性能を向上させるために、ゲーティング技術が中波長赤外線検出器(MWIR)およびLWIR検出器[8]に適用されています。ただし、非常に高いゲートバイアス電圧が必要です。ゲートバイアスは次の式で表すことができます。 (1)。
$$ \ sigma =\ varepsilon \ varepsilon_ {0} V / d、$$(1)ここで、\(\ varepsilon \)は誘電体層の比誘電率を表し、\(\ varepsilon_ {0} \)は真空の誘電率 V を表します。 飽和ゲートバイアス電圧 d を指します は誘電体層の厚さであり、σ インターフェースの電荷密度を表します。ゲートバイアスは、多大な努力を払って式に基づいて弱められました。 Y 2 などのhigh-k誘電体を使用する手段 O 3 [9]層の厚さを不動態化または減少させる[10]は効果的です。しかし、電荷密度を下げる研究はほとんどありません。この論文では、飽和バイアスを大幅に低減するために、最初に陽極酸化が実行されます。 NaS 2 の混合物 ・5H 2 加硫液にはOとエチレングリコールを使用しています。陽極硬化プロセス中、デバイスの表面の硫黄原子とダングリングボンドの組み合わせにより、デバイスの表面の導電性チャネルが閉じられ[11]、デバイスの表面再結合が減少し、デバイスの表面電荷密度が弱まります。端末。次に、デバイスの表面に高密度で均一な元素硫黄の層が得られます。次に、元素硫黄層の表面を200nmのSiO 2 の層で覆います。 。ゲート電極はSiO 2 上に配置されます 層。界面の電荷密度が低下すると、飽和ゲートバイアス電圧が低下します。
この研究では、陽極加硫で前処理したLWIR P + – π –M–N + 検出器は、ドーピングが異なるInAs / GaSbT2SLに基づく低飽和ゲートバイアス電圧下で製造されていますπ 地域。結果は、ドーピング濃度が高くないほど、デバイスの性能が向上することを示しています。具体的には、デバイスの電気的および光学的性能は、過度のドーピング濃度によって弱められます。さらに、陽極加硫前処理は、同じ厚さの200 nm SiO 2 で報告されたものよりもはるかに低い、-10Vでのゲートバイアスを大幅に低減できます。 同様の構造の約40Vのパッシベーション層。
メソッド
材料と構造
材料は、2インチの n 上のソリッドソースGEN20MBEシステムによって生成されます。 -タイプGaSb(001)基板。この作業では、高性能LWIR検出器はP + に基づいています – π –M–N + 構造。デバイス、高解像度X線回折(HRXRD)パターン、および原子間力顕微鏡(AFM)の概略図を図1および2に示します。図1は、構造が1300nmの厚さのP + で構成されていることを示しています。 GaSbバッファー、続いて500nmの厚さの8-MLInAs / 12-ML GaSb(Be:約1×10 18 cm -3 )P + 領域、2000nmのわずかにPドープされた12-MLInAs(Be:780°C800°C820°C)/ 7-ML GaSb π 領域、500nmのドープされていない18-MLInAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb M領域、500nmの厚さの18-MLInAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb(Si:約1×10 18 cm -3 )N + 領域、および30 nm N + InAsキャップレイヤー。また、構造とのシミュレーションバンドの位置合わせも示しています。 P + のパフォーマンスを考慮すると – π –M–N + LWIR検出器は、πのドーピングによって大きく影響されます。 地域では、Beドーピング温度が780〜820°Cの異なる3つのサンプルを準備します。
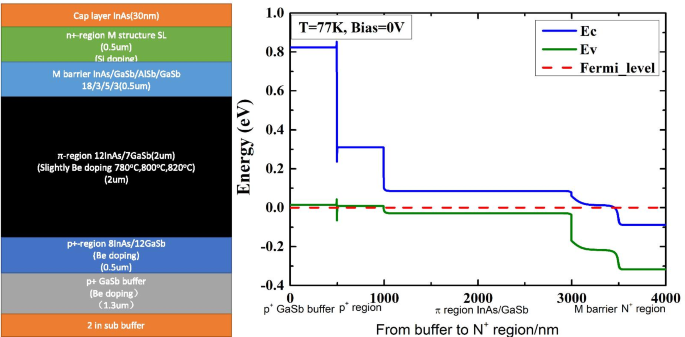
異なるπ領域ドーピングレベルの材料のエピタキシャル構造とバンドアラインメント

異なるπ領域ドーピングレベルのサンプルのHRXRDロッキングカーブ
p の超格子周期は59.3Å、58.4Å、89.5Åです。 -連絡先、 p -アクティブ領域、およびそれぞれ60秒角、0秒角、0秒角の格子不整合を持つM構造層を図2に示します。各領域のSLの最大値の半分の全幅は32です。アーク秒、25アーク秒、および12アーク秒。これは、材料が界面で高品質であることを示しています。
図3は、原子ステップが10×10 µmの領域で1.87Åの粗さの二乗平均平方根(RMS)で表示されることを示しています。
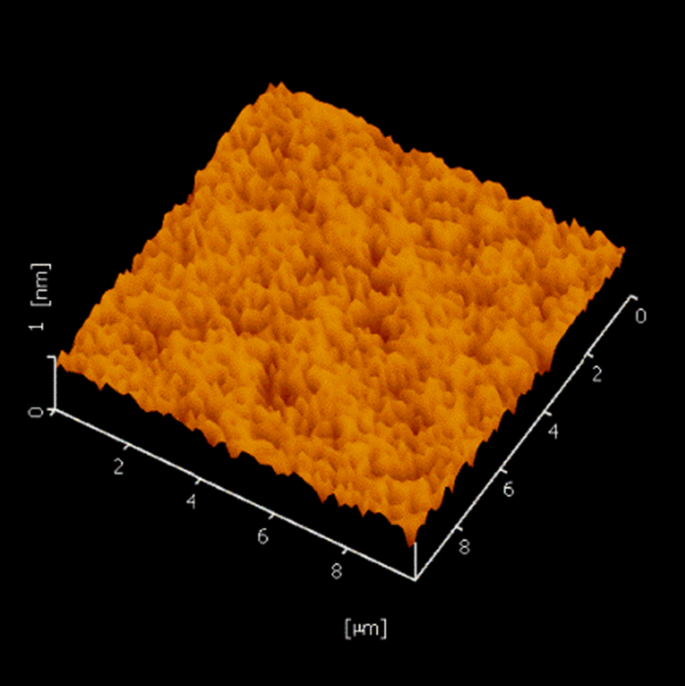
10×10µm 2 のAFM サンプルの面積
デバイスの構造と製造
このプロセスは、参考文献[12]のプロセスと同様です。まず、ウェーハをSiO 2 で覆います。 ハークマスクとして。次に、対応する標準的なリソグラフィーステップが採用されます。次に、誘導結合プラズマ(ICP)システムによってハードマスクを開きます。次に、CH 4 を備えた誘導結合プラズマ(ICP)システムを使用してメサを取得します。 / Cl 2 / Ar混合物。具体的には、ウェーハは最上層からP + までエッチングされます。 [12]に連絡してください。その後、残りのSiO 2 レイヤーが削除されます。次に、ウェーハの片面を硫化ナトリウムとエチレングリコールの混合溶液に浸し、ウェーハに定電流を流してしきい値電圧を設定します。膜の表面に硫黄原子層が形成され、抵抗が変化します。ウェーハの電圧は、しきい値電圧に達するまで徐々に上昇し、その後、加硫が完了します。次に、元素硫黄層を200nmのSiO 2 の層で覆います。 。さらに、フォトリソグラフィーを再度実行して、SiO 2 の層を通してウィンドウを開きます。 上部および下部の金属電極の金属接触領域としての元素硫黄。さらに、2つの電極形状で設計された別のフォトリソグラフィーが実行されます。 1つの電極形状はゲート付きダイオード(GD)用で、もう1つはゲートなしダイオード(UGD)用です。 Ti(50 nm)/ Pt(50 nm)/ Au(300 nm)は、金属電極用に蒸着された電子ビームによって蒸着されます。最後に、上部、下部、およびゲート電極は、金属リフトオフによって取得されます。
図4にGDの構造を示します。ご存知のように、材料エッチングの傾斜角は、ICP電力、RF電力、ガス流量、およびチャンバー圧力を変更することで調整できます。この研究では、側壁の実際の傾斜角度は80度から85度の間であり、側壁への堆積ゲートの接触を容易にします。ゲート電極は、SiO 2 の側壁に配置されます。 レイヤー。
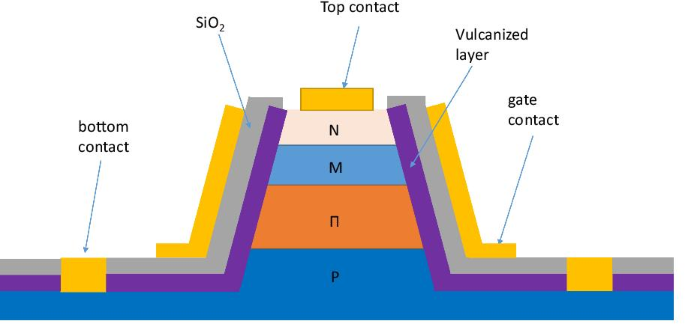
GDのデバイス構造図
図5は、ハーフダイオードが3つのダイ(780°C、800°C、および820°CのBeドーピング)でGDになるように堆積されていることを示しています。次に、ゲート付きダイオード(GD)とゲートなしダイオード(UGD)の両方を取得できます。最終的に、サンプルA(780°CGD)、サンプルB(780°CUGD)、サンプルC(800°CGD)、サンプルD(800°CUGD)、サンプルE(820°CGD)、およびサンプルF (820°CUGD)を取得できます。

光学顕微鏡下でのデバイスの写真
結果と考察
赤外線検出器では、特定の検出器( D *)は通常、検出器の性能を特徴づけるために使用されます。これは、式(1)で計算されます。 (2)。
$$ D ^ {*} =\ frac {Ri} {{\ sqrt {2qJ + 4 \ frac {kT} {{RA}}}}} $$(2)ここで、 q 電荷の量を示します。 K ボルツマン定数を指します。 T ケルビン温度です。 Riは、赤外線検出器の応答性を指します。 J は、特定のバイアス下でのデバイスの暗電流密度です。および RA 抵抗値とダイ面積の積を指します。 J およびRAは、デバイスの電気的性能を特徴づけます。そして、Riは次の式でQEに変換できます:
$$ QE =\ frac {hC} {{q \ lambda}} Ri $$(3)ここで、\(h \)はプランク定数、\({} C \)は光速、 q は電荷の量を示し、\({} \ lambda \)は特定の波長であり、QEとRiはデバイスの光学性能を特徴づけます。図6は、さまざまなπを使用したサンプルの光学特性を示しています。 77 Kでの領域ドーピングレベル。すべてのサンプルは、77 Kで同様の50%カットオフ波長8 µmと10 µmの100%カットオフ波長を持っています。ただし、デバイスのQEと応答性は、ドーピングタイプを次のように変更することで向上できます。 p -πのタイプ 地域では、温度が高くなればなるほど、QEと応答性は高くなりません。ただし、ドーピング濃度の増加に伴い、QEと応答性は大幅に低下します。タイプIIひずみ層超格子(T2SL)の場合、成長中のドーピング温度はドーピング濃度にとって重要です。温度が高いほど、ドーピング濃度は高くなります。 780°CのQEは最大値の62.4%に達し、820°CのQEの1.5倍になります。これは、ドーピング濃度の増加に伴って導入される不純物が多すぎて、過剰なキャリア寿命/拡散長が減少し、QEと応答性が低下するためです[6]。さらに、それらは図6aの分光学的赤方偏移を引き起こします。図6aおよびbは、780°Cが光学特性評価に最適な材料のドーピング温度であり、5 µmでのピーク応答性が2.26 A / W、ピークQEが62.4%であることを示しています。
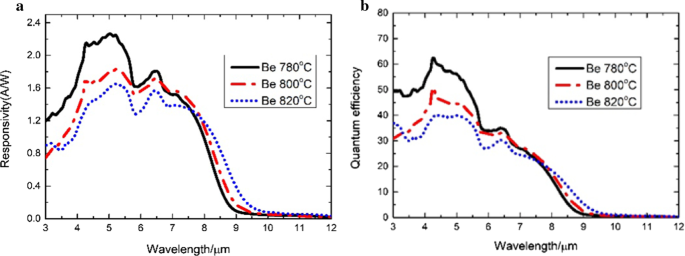
77Kでの異なるπ領域ドーピングレベルのサンプルの光学特性
図7は、さまざまなπを使用したUGDサンプルの電気的特性を示しています。 77 Kでの領域ドーピングレベル。デバイスの電気的性能は、さまざまなπの影響を大きく受けます。 領域ドーピング濃度[7]。 π領域のドーピングレベルが高くなると、特定のバイアスでの抵抗値とダイ面積(RA)の積が小さくなり、それに応じて暗電流密度が大きくなります。参考文献[6]と同様に、RAはほぼ0 Vで最大に達し、逆バイアスが増加するにつれてソフトブレークダウンが発生します。これは、デバイスにトンネリング暗電流モードがあることを示しています。 RAの最大値1259.4Ωcm 2 に到達します -200 mvで780°CをドープしたBeは、820°CをドープしたBeの約40倍です。図7bは、-0.1〜0 Vの範囲で負のバイアスの暗電流密度が類似しており、780°CでドープされたBeの暗電流密度が他の密度に比べて少し小さいことを示しています。暗電流は4.9×10 -3 A / cm 2 − 70mvで780°Cでドープされたデバイスの場合
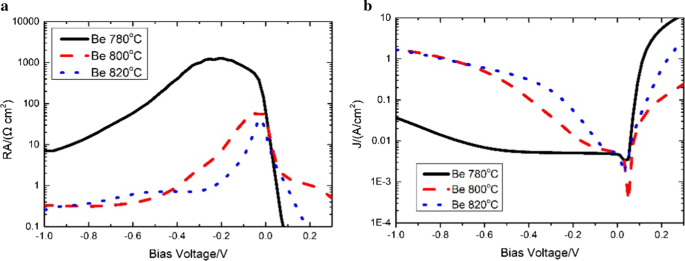
πが異なるUGDサンプルの電気的特性 77Kでの領域ドーピングレベル
対応する D *特定のRi、 J を使用して計算できます 、および77 Kでのさまざまなバイアス電圧下でのRA値。図8は、さまざまなπを使用したUGDサンプルの検出率を示しています。 地域。 − 30 mvでは、ピーク検出率は5.6×10 10 です。 cm Hz 1/2 / W、5 µm、780°Cでドープ、3.8×10 10 cm Hz 1/2 / W、820°Cでドープされています。 780°CでドープされたBeのピーク検出率は、820°CでドープされたBeの1.5倍です。したがって、適切なドーピング濃度は非常に重要です。ただし、ドーピング濃度が高すぎると、デバイスのパフォーマンスが低下します。

πを使用したUGDサンプルの77Kでの比検出率間の相関 領域のドーピングレベルと波長
図9は、77 Kで760°CをドープしたGDサンプルの電気的特性を示しています。通常のゲート電圧制御デバイスとは異なり、この研究では最初に陽極加硫前処理を実行して、飽和ゲートバイアス電圧を大幅に低減します。さらに、NaS 2 の混合物 ・5H 2 加硫液にはOとエチレングリコールを使用しています。陽極加硫不動態化法は、デバイスの表面に高密度で均一な元素硫黄の層を形成するために採用されています。電気化学反応中、硫黄原子はデバイス表面のダングリングボンドと結合し、表面のダングリングボンドによって生成された電子チャネルを閉じ、デバイスの表面の電子正孔再結合メカニズムを分離します[11]。次に、元素硫黄層の表面を200 nm SiO 2 の保護層で覆います。 、およびゲート電極は、SiO 2 の側壁に配置されます。 層。以前の研究で報告されているように、飽和バイアスとデバイスの誘電体層の厚さの間の相関はほぼ線形です。図9は、単純で効果的な加硫前処理により、デバイスの飽和バイアスを約-10Vで低減できることを示しています。他の研究でのこの減少した値は約40Vであり、同じ厚さのSiO 2 を持つ同様の構造のデバイスでは4倍大きくなります。 レイヤー[10]。その上、RAは最大25Ωcm 2 に達します 約− 10 Vで負のバイアス電圧を印加すると下降傾向が大幅に遅くなります。ゲート電極に− 10 Vのバイアス電圧を印加すると、RAは10Ωcm 2 > − 0.3 Vで、これはバイアス電圧が印加されていない場合の40倍です。さらに、-0.6 Vのバイアス電圧がない場合よりも約2桁低くなります。図9bは、暗電流が最小値の2×10 –4 に達することを示しています。 A / cm 2 0 Vに近く、-0.3 Vで1桁減少します。ご存知のように、バイアス電圧が正の場合、IV曲線は0Vのゲートバイアスで変化しません。さらに、バイアス電圧が0から-10 Vに増加すると、デバイスのRAが大幅に増加します。その間、デバイスの暗電流はそれに応じて減少します。バイアス電圧が−10から− 20 Vまで変化すると、デバイスのRAはわずかに減少し、それに応じてデバイスの暗電流が増加します。上部電極と下部電極間の予備バイアスが高い場合(たとえば、-1 V)、暗電流はゲートバイアスとともに減少し、その後、-12Vをわずかに超えて増加します。これは主にゲートバイアス特性のためです。さらなる導入を図10に示します。低い逆バイアス(たとえば、− 0.1 V)の場合、ゲートバイアスが増加するにつれて暗電流が増加するように見えます。これは、-1 Vの場合とは完全に異なります。異なる逆バイアスの場合、次のように考えられます。主な漏れメカニズムが異なります。リザーブバイアスが低い場合、ゲートバイアスが高いと、電子とホットエレクトロンの表面散乱に影響を与えるため、悪影響があります。また、逆バイアスが高い場合は、表面リーク電流が減少するため、リークが減少します。ですから違います。

780°CのGDサンプルの電気的特性異なるゲートバイアス電圧と上部電極と下部電極のバイアス電圧をドープする
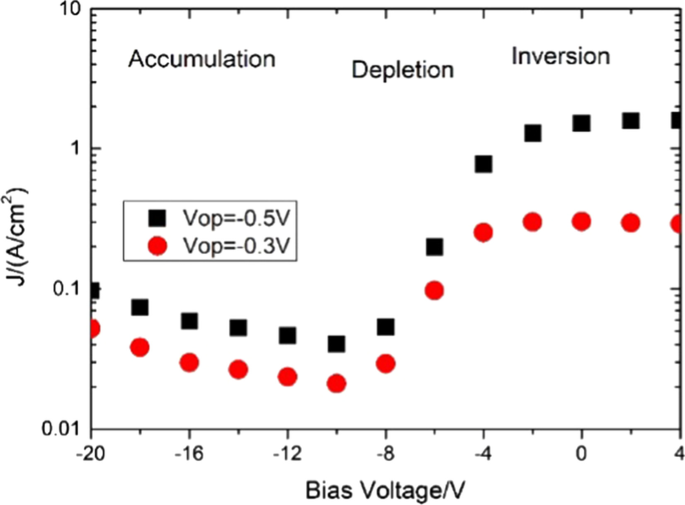
逆暗電流密度と780°CのGDサンプルのゲートバイアスとの相関関係異なるダイオード動作バイアスでドープされている
図10に示すように、上部電極と下部電極の間の予備バイアスが高い場合(たとえば、-1 V)、暗電流はゲートバイアスとともに減少し、その後、-12Vをわずかに超えて増加します。 77Kでバイアス電圧が変化するとデバイスが3段階で存在することがわかります[10]。参考文献[13]によると、P + およびN + P + の領域 –π–M–N + 構造デバイスは高濃度にドープされており、M領域はπと比較して有効質量が大きいラガーバンド領域です。 およびP + 領域;したがって、ゲートバイアスはπにはるかに大きな影響を及ぼします。 他と比較した地域[13]。 Chen [10]と同様の方法を使用して、ゲート電極に印加される高い負のバイアス電圧(− 20〜− 10 V)のプロセス中の3つの段階が分析されます。結果は、メサ側壁が平坦な状態または蓄積下にあり[8]、加硫界面のためにゲートバイアスとともに暗電流密度がわずかに増加することを示しています。加硫界面の密度がわずかに不均一である疑いがあり、密度が不十分な場合はわずかに崩壊します。負のバイアス電圧(− 10〜− 2 V)を印加すると、メサ側壁が空乏化し、暗電流がスムーズに増加します。さらに、-2 Vのバイアス電圧が正のゲートバイアスに印加されると、電界誘起空乏幅が最大になり、反転層が形成されます。したがって、暗電流密度は一定に保たれます。参考文献[14]によると、-0.5 Vでの表面生成-再結合(G-R)電流が-0.3Vでの電流よりも大きい理由が説明されています。
図11は、ゲートバイアスが− 10 Vの場合、 D * 780°CのGDサンプルの場合、Beがドープされると、1.3×10 11 のピーク検出率に達します。 cm Hz 1/2 / W 5 µmで、これは780°Cのバイアス電圧なしでドープされた場合の2倍以上、720°Cでバイアス電圧なしの場合の3倍以上77Kでドープされた。これは、適切な負のバイアスを適用することを示します。デバイスのパフォーマンスを大幅に向上させることができます。
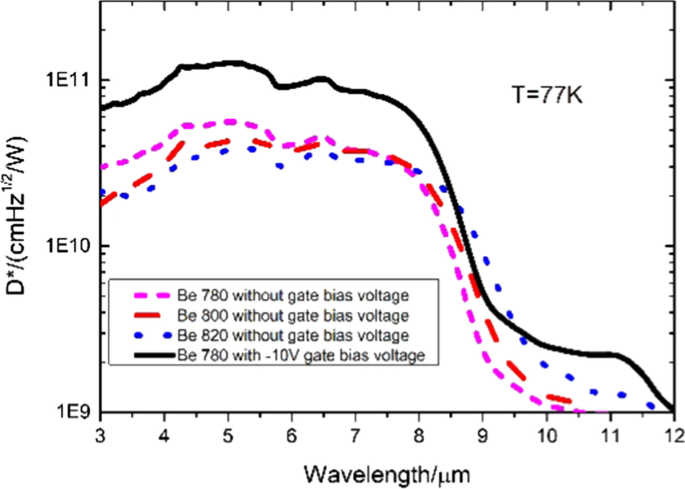
780°CのBeをドープしたGDサンプルと、異なるπ領域のドーピングレベルと77Kでの波長を使用したUGDサンプルの検出率の相関関係
結論
2017ノースウェスタン大学は、InAs / InAs 1- x に基づく長波長赤外線(LWIR)nBn光検出器を報告しました Sb x タイプII超格子。このデバイスは、77Kで約10µmのカットオフ波長を示し、ピーク応答性は2.65 A / Wで、量子効率は43%、RAは664Ωcm 2 に相当します。 暗電流密度は8×10 5 A / cm 2 、77Kで80mVのバイアス電圧未満。光検出器は4.72×10 11 の比検出率を示しました cm Hz 1/2 / W [5]。このデバイスのピーク応答性は1.3×10 11 です。 cm Hz 1/2 nBnデバイスに匹敵する-10Vのゲートバイアス電圧で5µmおよび0Vで/ W。ただし、弱点は、デバイスのパフォーマンスに影響を与えるデバイスのRAの均一性です。
結論として、アクティブ領域を p に強制します -πでのドーピングによるタイプ 領域は、LWIR InAs / GaSb超格子P + のパフォーマンスを効果的に向上させることができます。 – π –M–N + 検出器[6]。ただし、ドーピング濃度が高くなればなるほど、デバイスの性能は向上します。特に、デバイスの電気的および光学的性能は、過度のドーピング濃度によって低下する可能性があります。 77 Kでの光学的特性は、780°CでドープされたBeで4.26 µmで最大62.4%、5 µmで最大2.26 A / WのQEが得られることを示しています。電気的特性は、RAの最大値が1259.4Ωcm 2 であることを示しています。 780°CでドープされたBeが得られます。比検出率は最大5.6×10 10 に達します cm Hz 1/2 / W、5 µm、780°Cでドープ。さらに、デバイスの飽和バイアスは、単純で効果的な陽極加硫前処理によって劇的に低減できます。加硫前処理は、ゲートバイアス電圧を下げる可能性を示します。電気的特性は、飽和バイアスがわずか-10 Vであることを示していますが、他の研究では、同じ厚さのSiO 2 の同様の構造で加硫前処理を行わないと40Vになります。 層。さらに、ゲート電極に適切な負のバイアスをかけることにより、デバイスの性能を大幅に向上させることができます。最大1.3×10 11 cm Hz 1/2 / Wは、77Kで780°Cをドープした-10Vゲートバイアス電圧で5µmおよび0 Vに到達します。実験装置および実験条件によって制限されるため、SiO 2 を選択します。 誘電体層であるが、フォローアップでは、さらなる実験のためにHi–K媒体を使用すると考えられる。理論的には、ゲートバイアス電圧をさらに下げることができます。
データと資料の可用性
著者は、物質移動合意書の過度の資格なしに、資料とデータが読者にすぐに利用可能であることを宣言します。この調査中に生成または分析されたすべてのデータは、この記事に含まれています。
略語
- LWIR:
-
長波長赤外線検出器
- QE:
-
量子効率
- T2SL:
-
タイプIIひずみ層超格子
- VLWIR:
-
非常に長波長の赤外線検出器
- MWIR:
-
中波長赤外線検出器
- HRXRD:
-
高解像度X線回折
- AFM:
-
原子間力顕微鏡
- ICP:
-
誘導結合プラズマ
- GD:
-
ゲート付きダイオード
- UGD:
-
ゲートなしダイオード
- D *:
-
特定の検出力
- RA:
-
抵抗値とダイ面積の積
- Ri:
-
赤外線検出器の応答性
- G–R:
-
生成-再結合
ナノマテリアル
- 専門家インタビュー:3D印刷用の高性能ポリマーの進化に関するOxford PerformanceMaterialsのScottDeFelice
- 高性能可視光駆動光触媒としてのヘテロ構造WS2 / Bi2MoO6の容易な合成
- 有機金属化学蒸着によるInAsステム上での垂直GaSbナノワイヤの自己触媒成長
- 陽極TaOxナノチューブアレイの生体適合性の向上
- NドープZnO / g-C3N4ナノコンポジットの可視光駆動光触媒性能
- 中空構造LiNb3O8光触媒の調製と光触媒性能
- 光触媒性能が向上した新規Bi4Ti3O12 / Ag3PO4ヘテロ接合光触媒
- グリセロール燃料電池の電気酸化用の新しい陽極PdAu / VGCNF触媒の性能の向上
- SnO2-TiO2ナノメイスアレイに基づく高性能セルフパワーUV検出器
- 高性能スーパーキャパシタ用の2次元VO2メソポーラスマイクロアレイ
- X線検出器の性能の自動評価



