垂直電場によるML-GaSの電子的および光学的異方性特性の変調
要約
第一原理計算を用いて、GaS単分子層の電場依存光学特性と電子的挙動を調べます。 E // cからE⊥c異方性への双極子遷移の逆転は、約5 V / nmの臨界外部電場で見られます。分解された投影バンドの寄与は、外部電場の下でGaS中間層に非対称の電子構造を示します。これは、吸収優先度の変化を説明しています。部分電荷と電荷密度の差の空間分布は、GaS MLの著しく反転した光学異方性が、外部電場から発生する追加の結晶場と密接に関連していることを示しています。これらの結果は、実験研究への道を開き、単層GaSベースの2次元電子および光電子デバイスのアプリケーションに新しい展望を提供します。
背景
典型的な2次元(2D)材料として、グラフェンはかなりユニークで並外れた特性を持っており[1]、トランジスタや電気化学電極としての優れた性能を可能にします[2]。それにもかかわらず、ナノ電子デバイスで使用する場合、固有のバンドギャップ[3]がないため、従来の発光デバイスでのアプリケーションは本質的に制限されます。表面の機能化と外部の電界またはひずみ場がある場合でも、非常に小さなバンドギャップを実現できます[4、5、6、7]。この文脈では、特定の特性と用途に新しい機会を提供する可能性のある他の2D材料の検索は、基本的な関心と技術的重要性の両方です。
最近、安定したクラスの2D金属ジカルコゲナイド(MD)材料であるGaX(X =S、Se)が、そのエキゾチックな物理的および化学的特性のために大きな注目を集めており、太陽エネルギー変換やオプトエレクトロニクスなどの分野での応用に大きな期待が寄せられています。 [8,9,10,11]。層GaXは、X-Ga-Ga-XのシーケンスでD 3h と共有結合した4原子平面によって構成されます。 対称。高度なアプリケーションでは、外部制御パラメータによって意図的に変調できる、調整可能で可逆的な電子特性を備えた材料が必要になることがよくあります。ひずみ工学は、GaS単分子層(ML)およびその他の2D材料の電子的挙動および電子エネルギー低損失スペクトルを調整するための有望なルートの1つとして特定されています[12]。別の方法として、印加された電界または光は、広範囲にわたって電子特性を変更するための新しい方法を提供します[13、14]。たとえば、二層グラフェンの平面に垂直な強い電場は、大きなバンドギャップを引き起こす可能性があり[15、16]、バンドギャップは、2つ以上の層を持つBNに対しても変調できます[17]。ただし、2D GaSMLの電子構造に対する外部電界の影響はまだ不明です。さらに、GaS MLに存在する固有の大きな負の結晶場は、E⊥cの吸収係数が約10 3 であるという光学異方性をもたらします。 cm -1 、E // cの場合よりも30分の1になります[18]。光学材料の場合、発光偏光は、伝導帯の下部と価電子帯の上部の間で発生する、バンド端付近の遷移と密接に関連しています。外部電界を使用することにより、GaS MLのバンド構造、したがって光学特性を便利に変調して、デバイスアプリケーションの複数の要求を満たすことができます。
この問題に対処するために、GaSMLでの光学的および電子的異方性の変調に関する理論的予測を実行します。 E⊥c方向とE // c方向の両方の光吸収スペクトルは、さまざまな外部電界の下で計算されます。双極子遷移の外部電場への依存性を説明するために、バンド構造と軌道の寄与が分析されます。部分電荷と電荷密度の差の空間分布がさらにシミュレートされ、垂直外部電場によって誘導される層間結合と非対称電子構造が示され、GaSMLの光学的および電子的異方性の変調の物理的メカニズムが明らかになります。現在の結果は、2DGaS材料に基づく調整可能な電子および光電子デバイスに関する理論的ガイダンスを提供するのに有益です。
メソッド
密度汎関数理論(DFT)計算は、Vienna Ab-initio Simulation Package(VASP)コード[19]を使用して、プロジェクター拡張波擬ポテンシャル法[20]を使用して実行します。交換および相関効果は、Perdew–Burke–Ernzerhof(PBE)一般化勾配近似(GGA)によって処理されます[21]。 Heyd-Scuseria-Ernzerhof(HSE)混成汎関数は、バンドギャップの定量的推定を提供するために使用されます[22]。 S-Ga-Ga-Sの順で4つの原子層からなるGaSのスラブモデルを採用し、z方向に沿った15Åの真空層を採用してスラブ間の相互作用を排除しています。ブリュアンゾーンは、Monkhorst–Pack法[23]に従ってサンプリングされます。 27×27×1 k 単層GaSを緩和するためにポイントメッシュが使用され、波動関数を平面波ベースに拡張するために450eVのカットオフエネルギーが使用されます。エネルギーの収束は10 -5 として選択されます 2つのステップ間のeVと、各原子に作用する最大のHellmann-Feyman力は、イオン緩和時に0.01eV /Å未満です。ガウススミアリングは、各波動関数の部分占有率の設定方法に対処するために使用され、スミアリングの幅は0.1eVです。方向バンド間遷移による誘電関数の虚数部は、フェルミの黄金律[24]を使用して取得されます。計算中、スピン軌道相互作用(SOC)の分割は、電子的および光学的特性への影響が小さいため、無視されます。
結果と考察
GaS MLの完全に緩和された幾何学的構成を図1a、bに示します。単分子層の厚さは4.66Åと計算されますが、平面投影は、グラフェンと同様の理想的な六角形のハニカム構造を示します。格子定数 a は3.64Åであり、層間相互作用がないため、バルク材料よりもわずかに大きくなります[25]。 S–GaとGa–Gaの結合長はそれぞれ2.37Åと2.48Åであり、最近傍のS原子間のS–Ga–S角度は約100.34°であり、これは以前の研究と完全に一致しています[12]。便宜上、上部と下部の中間層原子にはY (1) というラベルが付けられています。 (Y =Ga、S)およびY (2) (Y =Ga、S)、それぞれ。

a トップと b GaSMLの原子配置の側面図。 ビッググリーン および小さな黄色い球 それぞれGa原子とS原子を表し、上部と下部の中間層原子にはY (1) というラベルが付けられています。 (Y =Ga、S)およびY (2) 、それぞれ
GaS MLの光学特性を変調する目的で、さまざまな外部電場での光吸収スペクトルが計算されます。印加電界の方向は+ z方向に沿っています。図2に示すように、異常光(TM光; E )の吸収挙動 // c )および通常のライト(TEライト; E ⊥ c )はまったく異なり、GaSMLの光学異方性を示しています。 TM光とTE光の吸収端は、それぞれ赤と緑の破線で示されています。外部電界がない場合、TM光とTE光の吸収端のエネルギー差は約0.55 eVです(図2aを参照)。外部電界が印加されると、両方の吸収端がより低いエネルギーにシフトし、吸収端のエネルギー差が減少します。 E からの双極子遷移の逆転 // c E へ ⊥ c 異方性は、約5 V / nmの臨界外部電界で発生します。電界がさらに8V / nmに増加すると、TE光の吸収端はTM光の吸収端よりもさらに低くなることに注意してください。これらの結果は、GaSMLの光学異方性が垂直外部電場によって変調できることを示しています。
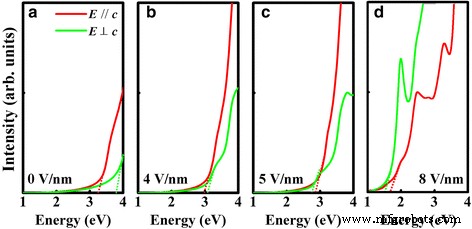
GaS ML a の計算された光吸収スペクトル 外部電界なしで b – d それぞれ4、5、および8 V / nmの外部電界を使用します。吸収端にはラベルが付いています。 赤 および緑色の線 それぞれTMライトとTEライトを表します
GaS MLの光学異方性に対する外部電場の影響を理解するために、外部電場の違いがある場合とない場合のバンド構造をシミュレートします。図3aに示すように、GaS MLの伝導帯の最小値(CBM)はΓ点にあり、価電子帯の最大値(VBM)はΓと K の間の位置にあります。 ポイント、間接バンドギャップを示します。 DFTとハイブリッド法で計算されたバンドギャップはそれぞれ2.35と3.46eVであり、これは以前の結果と一致しています[12、26]。興味深いことに、外部電界Eが存在する場合、図3b–dに示すように、Eが臨界値(約5 V / nm)を超えると、VBMはΓ点に切り替わりますが、CBMは依然としてΓに位置します。点。これは、外部電界下でのGaSMLの間接から直接へのバンドギャップ遷移を示しています。さらに、図3eに示すように、エネルギーギャップは外部電界の増加とともに単調に減少します。バンドギャップの修正は、 h に関する以前の研究で観察されたよく知られたシュタルク効果から生じます。 -BN [27]およびMoS 2 [28]。外部電界が印加されると、2つの中間層の間に電位差があり(図1bを参照)、これは U として説明できます。 =− dE * e 、ここで d は層間距離であり、 E * 遮蔽された電界です。外部電界は、下部中間層の電位を上昇させ、上部中間層の電位を低下させます。その結果、VBMが上昇し、エネルギーバンドギャップがさらに減少します。より強い外部電場は、2つの中間層の間のより大きな差につながり、したがって、より大きなバンド分割とより小さなバンドギャップにつながります。

GaSMLのバンド構造 a 外部電界なしで b – d それぞれ4、5、および8 V / nmの外部電界を使用します。 破線 ゼロに設定されているフェルミ準位を示します。 e GaSMLの外部電場によるエネルギーギャップの変化
GaS MLの光学異方性の進展メカニズムを明らかにするために、図4に示すように、電界がある場合とない場合の分解された投影バンド構造をさらに計算します。電界のない元のGaS MLの場合、CBMとVBMは次のようになります。主にハイブリッド化された s によって提供されます および p z Ga原子の状態と p z それぞれS原子の状態ですが、VBMの下にある次の4つの価電子帯は、主に面内の p で構成されています。 x + p y S原子の統計。 8 V / nmの外部電界が印加されると、上部と下部のGa-S層がバンド構造に非対称的に寄与します。 CBMは主に両方の によって占められています および p z 上部Ga (1) の軌道成分 S (1) レイヤーですが、 p のみ z 下部Ga (2) の状態 S (2) 層。伝導帯の層間結合状態と比較して、価電子帯の面内状態は、垂直方向の外部電場に対してさらに敏感です。 p x + p y 上部Ga (1) の状態 S (1) およびより低いGa (2) S (2) 層はそれぞれ別々の低いエネルギーと高いエネルギーを持っており、Γ点でのエネルギー差は約3.05eVです。これは、外部電場がGaS中間層に非対称電子構造を誘導することを示しています。隆起した p x + p y 下部Ga (1) の状態 S (1) レイヤーが p を超えています z S原子の状態が最上位の価電子帯になり、ΓとKの間の元の点からΓ点へのVBMの置換につながります。このVBMの変化により、 E からの双極子遷移が進化します。 // c E へ ⊥ c E の吸収という上記の予測を説明する好み ⊥ c 垂直外部電界とともに徐々に増加し、 E の電界を超えます。 // c 約5V / nmの臨界外部電界で。

GaSMLの分解された投影バンド構造。上部のパネルはs( a )、p x + p y ( b )、およびp z ( c )外部電場のない軌道;真ん中と最後のパネルは、s( d 、 g )、 p x + p y ( e 、 h )、および p z ( f 、 i )それぞれ8 V / nmの外部電場を持つGaSの上部と下部の中間層からの軌道
GaS MLのCBMおよびVBMでの部分電荷の空間分布は、それぞれ図5a、bに示すように、8 V / nmの外部電界がある場合とない場合でさらに計算されます。両方のケースのCBMには s があります 球形のS原子の周りにしっかりと局在しているタイプの状態文字。より低い電界(0〜5 V / nm)では、VBMは p からのみです。 z z方向に平行なダンベル形状として分布する状態。外部電界が臨界値以上に増加すると、VBMは p の混合物から導出されます。 x および p y コンポーネント、z方向に垂直な別のダンベル形状を示します。 VBの順序に基づいて、パリティ選択ルールが機能します。 xy でのバンド間遷移 偏光は、同じパリティを持つ状態に対してのみ許可されますが、z偏光下の状態は、反対のパリティを持つ状態に対して一意に許可されます。したがって、0〜5 V / nmの外部電界では、GaSの最も低い遷移CBM-VBMは、TM偏光( E )でのみ使用できます。 // c )、外部電界が5 V / nmより大きいため、最も低い遷移CBM-VBMは、TE偏光( E )で利用できるように調整されます。 ⊥ c ) それだけ。この現象は、垂直電界下での電子的および光学的異方性の変調を示します。反対の光学異方性の起源は、図5c、dにプロットされた電荷密度の違いによって証明されるように、電場によって誘発された追加の結晶場にまでさかのぼることができます。外部電界がない場合、電子はGa–SおよびGa–Ga結合領域に蓄積し、それぞれイオン結合と共有結合を形成することが観察されます。外部電場を印加すると、S原子の周りに蓄積する電子が増える傾向にありますが、上部と下部のGa原子の間に分布する電子はますます少なくなります。これは、外部電場がGaSの上部と下部の中間層間の相互作用を減らし、各中間層内のS原子とGa原子間の相互作用を強化することを意味します。その結果、電子輸送チャネルは、図5dの8 V / nmのように5V / nmの電界の上に作成されます。上記の分析は、GaS MLの著しく反転した光学異方性が、印加された外部電場に起因する追加の非対称結晶場と密接に関連していることを示しています。
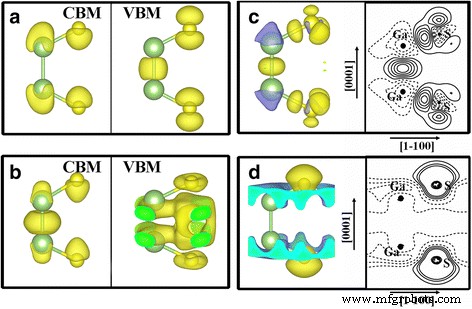
( a なしのGaSMLのCBMおよびVBMの部分状態密度 )およびwith( b )それぞれ8V / nmの外部電界。 ( c なしのGaSMLの(1-100)平面に沿った空間電荷密度差と垂直断面 )およびwith( d )それぞれ8V / nmの外部電界。正の密度と負の密度(等高線)は、それぞれ黄色で示されます。 (実線 )および青 (破線 )色、等高線間隔は0.005eÅ -3
結論
要約すると、第一原理DFTシミュレーションに基づいて、GaSMLの電界依存光学特性と電子的挙動を調査します。両方の E の吸光スペクトル ⊥ c および E // c 方向は、さまざまな外部電界の下で計算されます。 E からの双極子遷移の逆転 // c E へ ⊥ c 異方性は、約5 V / nmの臨界外部電界で見られます。バンド構造の計算は、外部垂直電界の増加に伴い、GaSMLのバンドギャップが減少し、間接バンドギャップから直接バンドギャップに移行することを示しています。分解された投影バンドの寄与は、外部電場の下でGaS中間層に非対称の電子構造を示し、これが吸収優先度の変化を説明しています。部分電荷と電荷密度の差の空間分布は、GaS MLの著しく反転した光学異方性が、外部電場から発生した追加の結晶場と密接に関連していることを示唆しています。これらの結果は、外部電場によるGaS MLの電子構造と光学特性の変調を明らかにするだけでなく、2D電子および光電子デバイスでの将来のアプリケーションへの参照も提供します。
ナノマテリアル
- 電界と静電容量
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 小さなセレンナノ結晶とナノロッドの容易な合成と光学的性質
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- フェムト秒レーザー誘起硫黄ハイパードープシリコンN + / Pフォトダイオードの光学的および電子的特性
- 分子線エピタキシー法を用いたGeBi膜の作製と光学的性質
- Ag n V(n =1–12)クラスターの構造的、電子的、および磁気的特性の調査
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- 自動車 PCB の特性と設計上の考慮事項
- 電子と電気の違いは?



