電場を利用したシリコンナノワイヤアレイの高速で方向制御された形成
要約
低コストで用途の広い方法である金属支援化学エッチング(MaCE)は、シリコンナノワイヤー(SiNW)を準備するための有望な手法と考えられていましたが、Si内に注入された穴を適切に制御できないと、エッチング速度が低下し、不要な側壁が生じる可能性があります。エッチング、および構造の均一性を低下させます。ここで、この研究では、バイアス変調されたMaCEプロセスが実行され、大面積の均一性を備えた典型的なバイアスのないMaCEの4倍以上の大きさのエッチング速度を示しました。電界媒介正孔整流が反応性イオンからの遅延拡散の効果を圧倒し、したがって分散エッチングのダイナミクスが指向性エッチング挙動に移行することが見出された。さらに、エッチングの向きも外部バイアスで操作できます。その結果、電気分極を変化させることでエッチング方向を傾斜フィーチャに切り替え、従来の垂直配向フィーチャよりも優れた反射防止特性を備えた特殊な傾斜/垂直NWアレイを作成したことが実証されました。
はじめに
低次元シリコン(Si)ナノ構造は、電界効果トランジスタ、バイオセンサー、太陽電池などの機能デバイスやアプリケーションの構成要素として機能する可能性のある、顕著な電子的、機械的、および光電子的特性を示しました[4 、5、6、7、8、9]。 Siナノ構造の規則的なアレイを形成するために、金属支援化学エッチングは、平面基板[10、11]、粉末[12、13]、およびピラミッド構造上にSiナノワイヤー(SiNW)アレイを形成することさえ可能にする一般的な戦略と見なされてきました。 [14]。エッチングプロセスでは、金属触媒を横切って下のSiに向かって正孔が注入され、続いて酸化されたSiの溶解が継続的に発生し、その結果、長いエッチング細孔が生じました。ただし、生成された正孔は、基板面に対して常に垂直に移動するのではなく、Siマトリックス内で拡散する可能性があります。それは通常、一次エッチングサイトの近くに多数のSiナノポアの形成を引き起こし、制御できないエッチングプロファイルを残しました[15]。この機能は、溶液の粘度が高い場合に特に顕著であることがわかりました。
Si内に注入された正孔を適切に制御できないと、Siナノ構造の実用化が妨げられる可能性があります。
この厳しい問題を克服するために、外部分野の採用は有望であるように思われました。 Liyi Li et al。は、電気バイアス減衰MaCEを使用することで、高アスペクト比(> 10:1)の通常のホールまたはストリップアレイを実現できることを実証しましたが、フィーチャの寸法はマイクロスケールでした[16]。この研究に触発されて、この研究では、MaCEプロセス中にバイアスを適用することによってSiNWアレイを製造する可能性を探求しようとしました。電界に依存するエッチング速度を理解するために、正と負の両方のバイアスを調査しました。エッチング速度に加えて、バイアス方向を調整することにより、傾斜/垂直特徴の形のデュアルセグメントSiNWが実現されるエッチング配向を変調できることがわかりました。電界の存在下での基礎となるエッチングメカニズムとエッチング速度論が調査され、独自の傾斜/垂直SiNWアレイの優れた反射防止特性が実験分析とシミュレーション分析の両方で提示されました。
メソッド
基板の準備
525μmの厚さの単結晶(100)、片面研磨Si基板を出発材料として使用した。 Si基板は、イソプロピルアルコール、アセトン、および脱イオン水で数サイクル超音波洗浄した後、SC-1溶液(NH 4 の1部)でさらに洗浄しました。 ああ、H 2 の一部 O 2 、および5部の脱イオン水)を30分間使用して表面を洗浄し、親水性の表面を生成しました。
ナノスフィアリソグラフィー
高度に秩序化された整列したナノ構造を製造するために、ナノスフェアリソグラフィー(NSL)が実施された。基本的に、直径300 nmのポリスチレンナノスフェア(PS)は、ペトリ皿の空気/水界面の六角形の最密充填フィーチャにゆっくりと分散および組み立てられてから、Si基板に直接転写されます。大規模で均一なPSのサイズ収縮は、200mTorrのプロセス圧力下で100Wの電力の酸素プラズマを使用することによって達成されました。エッチング時間は120秒に設定され、酸素の流れは12sccmに維持されました。続いて、7.0×10 -6 の真空条件下で、0.3Å/ sの速度で電子ビーム蒸発器を使用して30nmの銀膜を堆積させた。 トル。その後、トルエン中で2時間超音波処理することにより、残りのPSを完全に除去しました。その結果、Si基板上にパターン化された銀メッシュが形成されました。
Siナノワイヤーの製造
洗浄したままのSi基板を上面と背面の電極として銅テープで貼り付け、電界を印加するための電源に接続しました。印加電圧は40Vから40Vの範囲内で調整されました。HF(49%)、H 2 O 2 (30%)、およびそれぞれ4Mと0.28Mの濃度の脱イオン水[17、18、19、20]。エッチングプロセスを行った後、残留Ag層を濃縮HNO 3 で除去しました。 (65%)
特性
形成されたままのナノワイヤの形態は、電界放出走査型電子顕微鏡(SEM、LEO 1530)によって特徴づけられました。接触角分析は、Theta Lite(TL101)を使用して取得しました。 SiNWの発光挙動は、発光ダイオードランプ(出力電力:780 mW)を備えたフォトルミネッセンス(PL)システムによって特徴づけられ、光源の波長は365nmでした。 UV / Vis反射スペクトルは、UV-vis-NIR分光光度計(Varian、Cary 5000、オーストラリア)によって記録されました。光反射率は、有限差分時間領域(FDTD)を使用してシミュレートされ、照明方向に沿って完全に一致する境界が選択されました。
結果と考察
AgをロードしたSi基板に採用された典型的なMaCEとバイアスアシストMaCEの比較を図1aに示しました。 H 2 O 2 酸化剤は、既存のAg触媒によって支援されてSiに向かって拡散する正孔を提供しました。それにもかかわらず、図1aに示すように、AgNPの不均一なファセットがSiと接触しているため、正孔の注入は常に一方向に進むとは限りませんでした。これらの特徴は、NW形成のためのSiの方向性溶解に寄与することができなかったが、代わりに分布し、多孔質構造の形成に容易につながる可能性がある正孔の損失を明確に引き起こしました。対照的に、基板面に対して垂直に配置された順方向バイアス(+ 10V)を使用すると、エッチング速度が劇的に変化する可能性があります。フィールドに適用されたMaCEの相関設計は、追加ファイル1:図S1に概略的に示されています。実際、関与する分極電位は、典型的なMaCEプロセス(220 nm / min)(図1c)と比較して強化されたエッチング速度(260 nm / min)(図1c)に応答する印加電界の配向に沿って拡散するすべての穴を強制しました。 1b)。したがって、MaCEプロセス内で適用される正のバイアスの変化は、追加のファイル1:図S2に示されているように、エッチング速度の変化をもたらす可能性があります。
a 典型的なMaCE(上の図)とバイアス支援MaCE(下の図)を示す概略図。 b によって作成されたSiNWの断面SEM画像 典型的なMaCEと c バイアスアシストMaCE(+ 10V)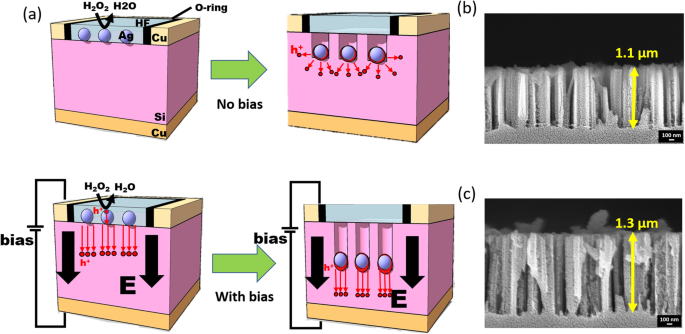
一方、このようなフィールド支援効果は、MaCEプロセスが負のバイアスを受けている間も有効でした。図2aは、正孔注入経路に対する正孔拡散の反対の整流を示しています。これは、Ag微細電極内の正孔を拘束することによってSiの効果的な溶解を阻害し、エッチング速度の低下(180 nm / min)を引き起こしました。さらに、MaCE反応のエッチング速度に適用されるバイアスの全範囲が図2bに示されています。これは、関与するバイアスの分極に関するエッチング速度の遷移を示した。負のバイアスは明確にエッチング速度の低下を引き起こしましたが、+ 10 Vでの正のバイアスは、ホール整流効果によって方向性のあるSiの効果的なエッチングを促進し、エッチング速度の漸進的な増加を反映しました。バイアスが大きくなると、正孔の整流に加えて、Siの方向性エッチングに関与する新たに生成された正孔が導入される可能性があり、これは陽極酸化効果と相関していました[21、22]。このような効果は主にエッチング速度を制御し、したがって、典型的なバイアスのないMaCEの4倍以上の大きさのエッチング速度を劇的に向上させた。したがって、ホールの整流と陽極酸化の複合効果がSiで発生し、エッチングの速度論と相関する動作を調整できると結論付けることができます。
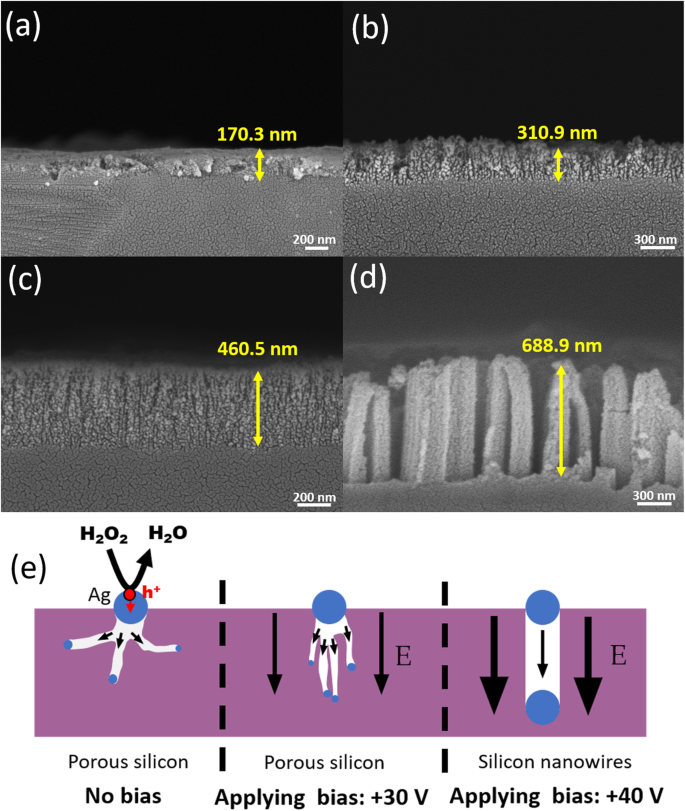
a − 10Vの印加電界でバイアス支援MaCEから得られたSiNWの断面SEM画像。 b SiNWの形成のための印加電圧と対応するエッチング速度の関係
MaCE反応におけるバイアス変調の動力学をさらに明らかにするために、比較的高粘度の溶液を利用しました。これは、90%のIPA溶媒にエッチング試薬を混合することによって達成されました。拡散係数と粘度の関係は次のように表すことができます[23]、
$$ \ mathrm {D} =\ mathrm {AT} / {\ upeta} ^ {\ mathrm {p}} $$(1)D は拡散係数、 A は経験的定数、 T 温度、ηは溶媒の粘度、pは粘度指数です。したがって、IPA溶媒の粘度は25 ° で2.1mPasです。 Cは、水の2.3倍以上です(粘度=0.9 mPa s)。したがって、両方のH 2 のイオン拡散係数を期待できます。 O 2 IPA媒体中のF-イオンは、水条件の場合よりもはるかに低かった。図3aに示すように、バイアスを使用しない場合、5分間のエッチングで厚さ170.3nmの薄い多孔質構造が作成されました。これは、関与するIPA溶媒が、ランダムな方向に穴を広げることを目的とした大きな粘度を持っているため、一次元構造ではなく多孔質の特徴が形成されたという事実によってもたらされました。 Siの垂直エッチングを開始するための電荷の蓄積を容易にするために、図3b–dに示すように、さまざまな正のバイアスが導入されました。 + 20Vおよび+30 Vを含む低い関与バイアスでは、多孔質構造の膜厚が明らかに増加し、34.0 nm / min(0 V)、62.2 nm / min(+ 20 V)92.1 nm / min(+ 30V)に向けて。
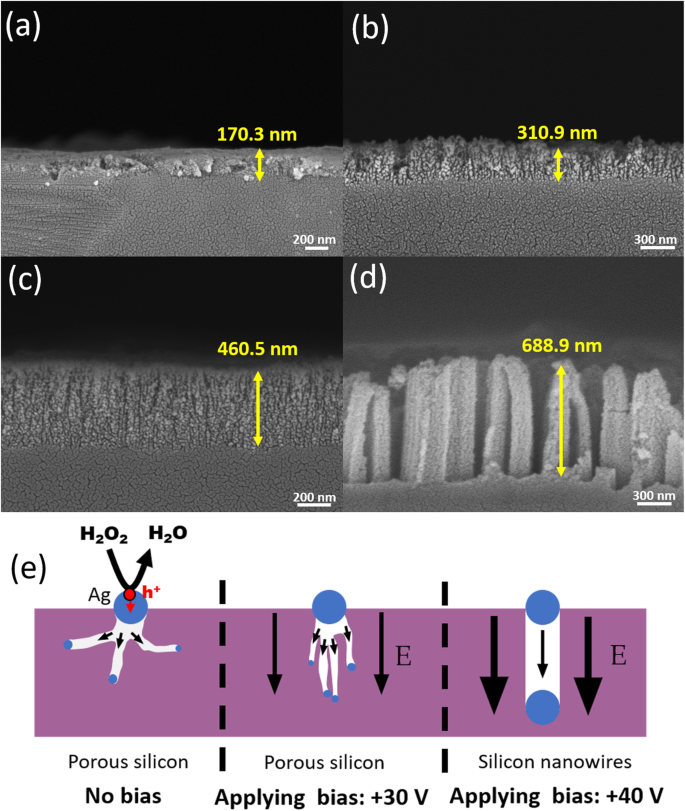
a から得られたSiナノ構造の断面SEM画像 バイアスのないMacE、 b + 20 VのMaCE、 c + 30 V、および d のMaCE + 40VのMaCE。 e さまざまなバイアス条件下でのナノ構造形成の概略図
これらの結果は、本質的にエッチング速度を支配するバイアスの影響を検証しました。ここでは、分離された穴のほとんどがAg触媒のサイトのすぐ下に収集および蓄積され、より深いエッチング形態が開始されると想定されました。印加バイアスを+ 40Vに上げると、電界を介した正孔整流が反応性イオンの拡散遅延への影響を圧倒することが判明したため、ランダムおよび分散エッチングのダイナミクスが指向性エッチング動作に移行しました。図3dに示すように、垂直に整列したSiNWアレイが実現され、これら4つの精巣条件の中で最大137.8 nm / minの最高のエッチング速度を示しました。適用されたバイアスに関する明確な形成メカニズムは、図3eから理解することができます。バイアスが導入されていない場合、正孔の等方性拡散経路が薄い多孔質膜の形成につながることを示した。対照的に、比較的異方性の正孔輸送は、適度なバイアスの関与の下で見られ、生成された細孔は最終的にバイアス配向に沿って移動し、複数の細孔の特徴を確立した。高バイアス条件では、注入された正孔は触媒/ Si界面に蓄積し、分極場に続いて相乗的にSiに移動し、垂直方向にエッチングされたプロファイルを作成します。
さらに、準備されたSiテクスチャの表面湿潤性を調べ、図4に示すように、すべてのサンプルを異なる位置で6回測定しました。測定された接触角は、ナノ構造の粗さと相関していることが報告されています。以下に示す式に[24、25]、
$$ \ mathrm {cos} \ uptheta ={\ mathrm {Rfcos} \ uptheta} _ {\ mathrm {e}}-\ mathrm {R} \ left(1- \ mathrm {f} \ right)$$(2 )。ここでθ およびθ e は、それぞれ粗いSi表面と平坦なSi表面の接触角、および R 粗さ係数を表します。さらに、 f 空気/水面の面積分率です。 4つの異なるサンプルからの平均接触角は109.8 0 であることがわかりました。 ±10.8 0 バイアスなしのエッチングの場合、108.4 0 ±9.2 0 + 20 Vのバイアス、105.4 0 ±7.6 0 + 30Vのバイアスと103.6 0 ±1.6 0 図4に示すように、+ 40Vのバイアスで+ 40Vの使用から測定された接触角での偏差が大幅に減少したのは、エッチングされた表面の比較的均一なトポグラフィに起因する可能性があります。エッチング速度を向上させるだけでなく、実際のアプリケーションに不可欠なサウンドエッチングの均一性をさらに維持することができました。
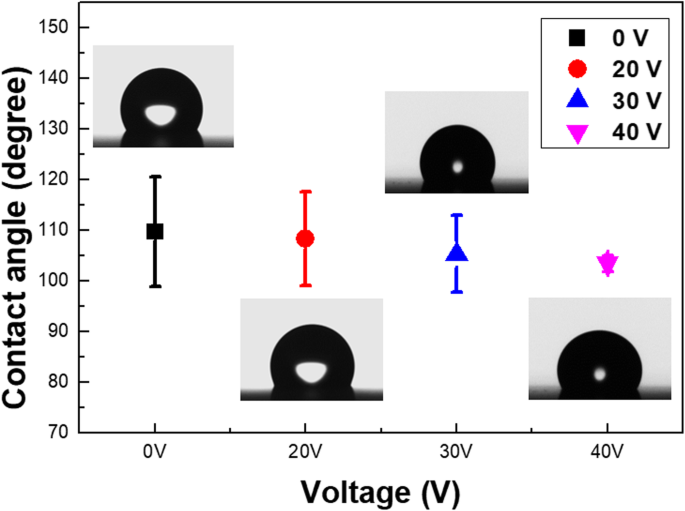
Si表面の接触角測定結果
図5aに示すように、エッチング速度の変調に加えて、エッチング方向も外部バイアスで操作できます。このテストでは、MaCEとナノスフェアリソグラフィーの組み合わせを実施して、自己組織化ポリスチレンナノスフェアを介してAgパターンを定義しました[26]。図5bに示すように、MaCEプロセス中に基板面に対して垂直方向のバイアスを適用することにより、バイアス方向に沿った方向性エッチングが作成され、垂直方向に調整されたSiNWアレイが形成されました。エッチング方向を垂直フィーチャから傾斜プロファイルに切り替えることは、60 ° での電気分極を変化させることによって実現されました。 面内方向に関して。バイアスは変調されましたが、全体として、図5cに示すように、2セグメントの傾斜/垂直SiNWアレイが形成されました。
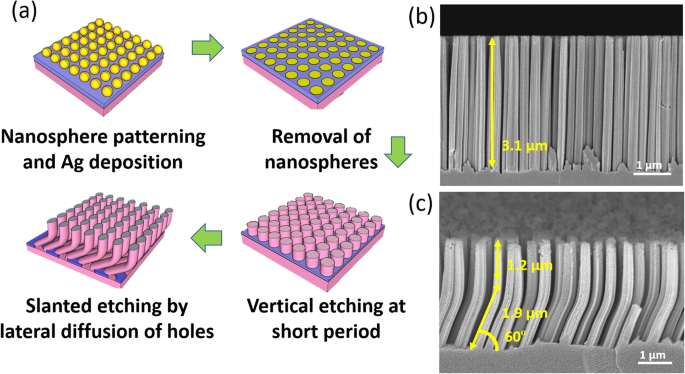
a 傾斜/垂直SiNWアレイを形成するためのプロセスフローの概略図。 b の断面SEM画像 垂直SiNWおよび c 傾斜/垂直SiNW
エッチング条件でのエッチャント濃度の拡散律速局所変化によってNW配向を変化させる一般的な方法とは異なり[27、28]、ここでは酸化剤とエッチャントの両方の濃度が一定のままであり、したがってエッチング方向の変化が主に寄与しました。外部バイアスから。これにより、3次元処理能力の実現が実現する可能性があります。最後に、図6に示すように、垂直および2セグメントベースのSiNWアレイの両方から可視反射率を調べました。測定された反射率の結果は、平均反射率が2.8%の傾斜/垂直SiNWアレイが比較的低い光を持っていることを明確に確認しました。可視帯域をカバーする唯一の垂直SiNWアレイ(平均反射率=5.4%)よりも反射能力。実験的調査をさらに確認するために、図6に示すように、シミュレーションされた反射結果も比較されました。シミュレーションされた結果は測定結果とよく一致し、傾斜/垂直ナノ構造の優れた反射防止特性を示していることがわかりました。
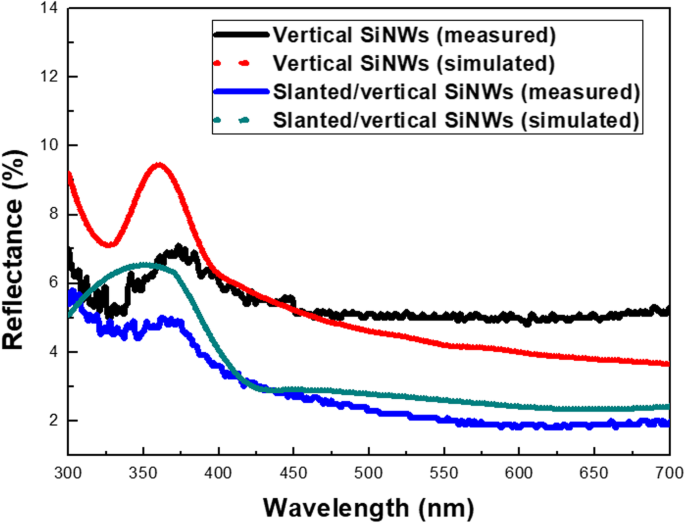
それぞれ垂直および傾斜/垂直SiNWアレイの反射の測定結果とシミュレーション結果
結論
改善されたエッチング速度を有する配向制御されたSiNWアレイを形成するための電場支援MaCE法が提示された。根本的なメカニズムは、エッチングの形態と速度論を調整できる穴の整流と陽極酸化の複合効果によって解明されました。さらに、表面の湿潤性を調べたところ、バイアスが+ 40Vのときに大面積の均一性が得られたことがわかりました。印加電界の分極を操作することにより、エッチング方向の垂直フィーチャから傾斜プロファイルへの遷移が実現されました。傾斜/垂直機能の形をしたこのような2セグメントSiNWは、大幅に改善された反射防止特性を備えており、オプトエレクトロニクスデバイス、フォトニック結晶、およびその他の多機能アプリケーションに役立つ可能性があります。
データと資料の可用性
この記事の結論を裏付けるデータセットは、記事に含まれています。
略語
- FDTD:
-
有限差分時間領域
- MaCE:
-
金属支援化学エッチング
- NSL:
-
ナノスフェアリソグラフィー
- PL:
-
フォトルミネッセンス
- PS:
-
ポリスチレンナノスフェア
- SEM:
-
走査型電子顕微鏡
- SiNW:
-
シリコンナノワイヤー
ナノマテリアル



