窒化処理を施したHfO2ベースのRRAMの伝導メカニズムと耐久性の向上
要約
尿素/アンモニア錯体窒素源を使用した窒化処理技術により、HfO 2 の抵抗スイッチング特性が向上しました。 ベースの抵抗変化型メモリ(RRAM)。窒化処理により、高性能で信頼性の高いデバイスが生成され、優れた耐久性(10 9 以上)が実現しました。 サイクル)および自己コンプライアンス効果。したがって、HfO 2 の窒素原子による欠陥不動態化により、電流伝導メカニズムが変化しました。 薄膜。高抵抗状態(HRS)で、HfO 2 のPoole-FrenkelからのSchottky放出に移行しました。 ベースのRRAM。低抵抗状態(LRS)では、電流伝導メカニズムは、窒化処理後の空間電荷制限電流(SCLC)でした。これは、窒素原子がHf–N–Ox空孔クラスター(V o )を形成することを示唆しています。 + )スイッチング層を通過する電子の移動を制限します。
背景
最近では、絶縁層を2つの電極で挟んだ抵抗変化型メモリ(RRAM)が、シンプルな構造、低消費電力、高速動作などの優れた特性から、次世代不揮発性メモリの有望な候補として広く研究されています。 (<300 ps)、および非破壊読み出し[1–9]。ほとんどのRRAMデバイスは、不揮発性メモリよりも優れた多くの特性を備えていますが、RRAMの高い動作電流とパフォーマンスの低下は、ポータブル電子製品のアプリケーションの観点から、不揮発性メモリの主要な問題です。
Pt / HfO 2 / TiN構造は、抵抗スイッチング動作を誘発する伝導経路を供給することができます[10–19]。ただし、アモルファスHfO 2 の欠陥 漏れ経路の数が増え、消費電力とジュール熱の低下につながります。この作業では、HfO 2 の抵抗スイッチング層 電気的スイッチング特性を強化するための窒化処理として、尿素/アンモニア複合窒素源を含む溶液で処理しました。
メソッド
パターン化されたTiN / Ti / SiO 2 / Si基板は、標準的な堆積およびエッチングプロセスで製造され、その後、ビアホールを形成できます(図1aの挿入図)。次に、23nmの厚さのHfO 2 薄膜は、純粋なHfO 2 を使用したRFマグネトロンスパッタリングによって、基板上のビアホールに堆積されました。 目標。スパッタリングパワーは、RFパワー150 Wに固定され、アルゴン周囲温度(Ar =30 sccm)で、室温で4mtorrの使用圧力で実行されました。 HfO 2 / TiN半製品を反応チャンバーに入れ、尿素/アンモニア錯体窒素源を使用して溶液に浸し、窒化処理を行いました。窒化処理中、溶液はシステムのステンレス鋼チャンバー内で30分間160°Cに加熱されました。次に、厚さ110 nmのPt上部電極を、DCマグネトロンスパッタリングによってHfO 2 に蒸着しました。 Pt / HfO 2 で電気デバイスを形成する薄膜 / TiNサンドイッチ構造。最後に、すべての電気的特性がAgilentB1500半導体パラメータアナライザによって測定されました。電気測定中、上部電極(Pt)を接地しながら、DCおよびパルス掃引バイアスを下部電極(TiN)に適用しました。さらに、フーリエ変換赤外分光法(FTIR)は、中赤外領域でBruker VERTEX70v分光計によって測定されました。

a HfO 2 の形成電流曲線 ベースのRRAMデバイス。 b HfO 2 の窒化処理の初期と後の5mAコンプライアンス電流でのDC掃引サイクルの比較 ベースのRRAM。 c HfO 2 の外部電流コンプライアンスなしのDC掃引サイクル 窒化処理後の装置。 d HfO 2 の保持時間 窒化処理後のコンプライアンス電流がある場合とない場合の85°CでのベースのRRAMデバイス
結果と考察
図1aに示すように、10μAのコンプライアンス電流でDCバイアスを使用してすべてのRRAMデバイスをアクティブ化するには、電鋳プロセスが必要です。成形プロセス後、HfO 2 の電流-電圧(I-V)特性 ベースのRRAMは、初期と窒化処理後に比較されました。 LRSでは、未処理のHfO 2 と比較して電流が明らかに減少しました。 図1bに示すように、薄膜。現在の減少は、NH 3 によって不動態化された欠陥に起因する可能性があります。 処理液中の分子。図1bの挿入図のように、硝化処理後のHRS分布ははるかに安定していることがわかりました。抵抗状態は、DC動作での100回の掃引サイクル中に0.1 Vの読み取り電圧で抽出されます(図1bの挿入図)。窒化処理後、抵抗のオン/オフ比はわずかに減少しました。興味深いことに、これらのHfO 2 では、自己コンプライアンス抵抗スイッチング特性が観察されました。 図1cに示すように、治療後のベースのRRAMデバイス。 10 3 を超えた後 スイープサイクルでは、ハードブレークダウンのないデバイスの再現可能な自己保護特性が観察されました。保持時間は85°Cで評価され、10 4 後も安定しています。 ■HRSとLRSの両方。
デバイスのパフォーマンスをさらに評価するために、HfO 2 の耐久性テスト 図2に示すように、初期および窒化処理後にベースのRRAMを実行しました。未処理のデバイスでは10 6 図2aに示すように、スイープサイクルでは、HRS / LRS比が100:1から5:1に大幅に低下します。ただし、窒化処理後は10 9 スイープサイクルでは、図2bに示すように、デバイスは安定したHRS / LRS比を示しました。これらの結果は、ニトロ化プロセスがHfO 2 を強化したことを示しています。 優れたスイッチング機能と信頼性で動作するベースのRRAM。これらの結果をさらに調査するために、FTIR分析を使用してHfO 2 の化学的変化を観察しました。 図3に示すように、薄膜。1589および1311 cm -1 に鋭いピークがあります。 窒化処理後に出現し、N–O結合の対称および非対称の伸縮振動ピークに対応します[20]。さらに、1471 cm -1 でのN–H結合のピーク強度 [21]尿素/アンモニア複合窒素源によるニトロ化プロセスにより増加しました(図3の挿入図)。したがって、窒化処理後の窒素含有化合物の形成を推測することができます。
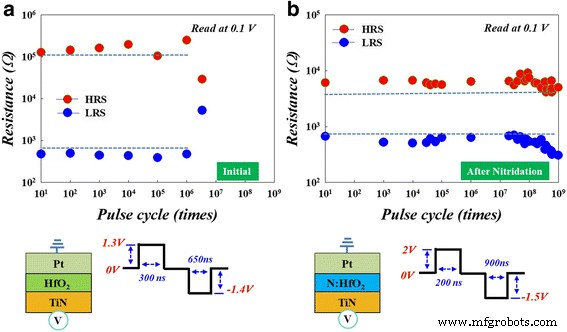
HfO 2 の耐久時間の比較 ベースのRRAM: a 初期および b 窒化処理後。下の図は、対応するデバイス構造と耐久パルス条件です

HfO 2 のFTIRスペクトルの比較 初期と硝化処理後の薄膜
抵抗スイッチングメカニズムを明らかにするために、HfO 2 の電流伝導メカニズムを分析しました。 図4aおよびdに示すように、窒化処理を行った場合と行わなかった場合の薄膜。未処理のHfO 2 の場合 薄膜では、電子は欠陥を介して移動し、電流伝導メカニズムは、ln(I / V)と印加電圧の平方根(V 1)の間の線形関係に従ってプール-フレンケル伝導によって支配されました。 / 2 )図4b [22]に示すようにHRSで。
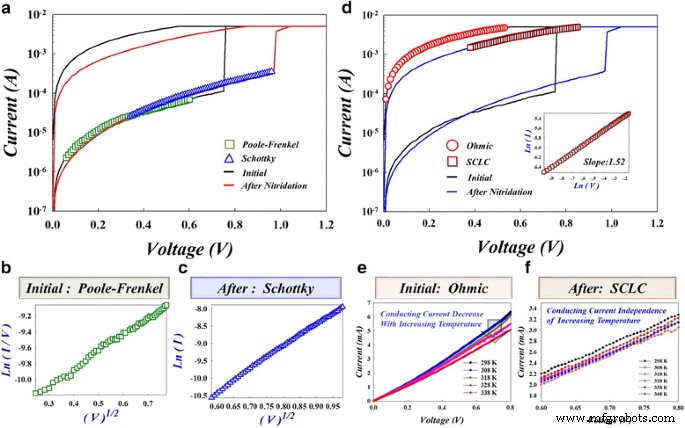
a HfO 2 のI-V曲線からのHRSの電流伝導メカニズムの分析 初期と後の窒化処理の間のベースのRRAM。 b HfO 2 におけるHRSのプール-フレンケル電流伝導メカニズム ベースのRRAM。 c HfO 2 におけるHRSのショットキー放出電流伝導メカニズム 窒化処理後のベースのRRAM。 d HfO 2 での窒化処理後にオーム伝導からSCLCに変化するLRSの電流伝導メカニズムの分析 ベースのRRAM;挿入図は、SCLC電流フィッティングの結果を示しています。 e HfO 2 におけるLRSのオーム伝導メカニズム 温度との電流の負の相関に特徴的なベースのRRAM。 f HfO 2 におけるLRSのSCLCメカニズム 窒化処理後の温度に依存しないベースのRRAM
対照的に、HfO 2 ベースのRRAMは、ln(I / T 2 間の線形関係に従ってショットキー放出メカニズムを示しました。 )および印加電圧の平方根(V 1/2 )図4c [23、24]に示すように、HRSの。これは、窒化処理後に結合が窒素原子によって不動態化されるため、欠陥とダングリングボンドが減少するためです。さらに、HfO 2 のLRSでの処理がある場合とない場合の電流伝導メカニズムも分析しました。 ベースのRRAM。 LRSでは、未処理のHfO 2 のキャリア輸送メカニズム 図4eに示すように、ベースのRRAMは、温度の上昇とともに電流が減少するオーム伝導によって支配されていました。窒化処理後、電流伝導メカニズムは、1.52の傾きを持つ空間電荷制限電流(SCLC)に移行します。 I-V曲線は温度に対して相対的ではなく、ln(I)と印加電圧V 2 の2乗の間に線形関係があります。 図4f [25]に示すように、LRSで。
電流伝導メカニズムの特性を説明するモデルを提案しました。これを図5に示します。したがって、NおよびO原子とHf原子に関連する2つのオフセット双極子(つまり、シーケンスO–Hf–O)があります。 N原子をHfO 2 にドープした後、O–Hf–N–O)に置き換えられます。 薄膜。窒素電子の負性は酸素よりも低いため、Hf–N結合の双極子はHf–O結合よりも低く、誘電率の低い領域が作成されます。 SETプロセス中に正のバイアスが適用されると、誘電率が低いために一連のHf–N–Ox空孔が形成され、空孔クラスター(Vo + )が形成されます。 )。導電性パスは通常、Hf–N–Ox空孔クラスター(Vo + )とともに形成されます。 )図5bに示すように、窒素原子がクラスターの周囲の酸素イオンを捕捉するため。これらの絶縁性Hf–N–Ox空孔クラスターの存在(Vo + )結果として、電流が減少し、HfO 2 に見られる自己コンプライアンス効果が得られます。 ベースのRRAM。

HfO 2 の設定プロセスによる酸素イオンの移動の概略図 a 用のベースのRRAM 初期および b Hf–N–Ox空孔クラスター(V o )を形成する窒化処理後 + )
結論
要約すると、自己コンプライアンス抵抗スイッチング特性がPt / HfO 2 で観察されました。 窒化処理後の/ TiNRRAMデバイス。耐久時間は10 9 に達しました サイクルと10 4 を超える保持時間 sは85°Cで達成されました。窒素原子の電子陰性は酸素原子に比べて小さいため、Hf–N結合の双極子はHf–O結合の双極子よりも小さく、誘電率領域が低くなります。 SETプロセス中、Hf–N–Ox空孔クラスター(Vo + )導電経路を形成します。絶縁性のHf–N–Ox空孔クラスター(Vo + )デバイスをハードブレークダウンから保護し、自己コンプライアンスプロパティを実行します。
略語
- FTIR:
-
フーリエ変換赤外分光法
- HRS:
-
高抵抗状態
- LRS:
-
低抵抗状態
- RRAM:
-
抵抗変化型メモリ
- SCLC:
-
空間電荷制限電流
ナノマテリアル
- バターとマーガリン
- 専門家へのインタビュー:pencerw.comおよびnTopologyのSpencer Wright
- Markforgedで牽引力を獲得:3Dプリントホイールのオーバーモールドと鋳造
- 材料:表面特性が改善され、充填挙動が最適化されたEPPフォーム
- 高度な農薬活性を備えたスマートナノマテリアルおよびナノコンポジット
- 自己整流スイッチ特性を備えたTaO / HfOxおよびTaO / AlO xRRAMの保持モデル
- 非常に効果的な標的膵臓腫瘍治療のための、血液循環が延長され、生体適合性が改善されたレスベラトロール負荷アルブミンナノ粒子
- PEG化リポソームを介したブファリンの改善された抗腫瘍効果および薬物動態
- クルクミンの処理効果を持つPEGコーティングされたCoFe2O4ナノ粒子の毒性
- アルゴンプラズマ処理によるZnOの挿入による金属とn-Ge間の接触抵抗の低減
- 廃水処理におけるナノ材料とナノテクノロジーの役割:計量書誌学的分析



