BaTiO3 / Nb:SrTiO3エピタキシャルヘテロ接合における強誘電場効果による非対称抵抗スイッチング効果
要約
非対称抵抗スイッチングプロセスがBaTiO 3 で観察されました / Nb:SrTiO 3 エピタキシャルヘテロ接合。高抵抗状態から低抵抗状態へのSETスイッチング時間は、+ 8Vバイアスで10nsの範囲にあり、低抵抗状態から高抵抗状態へのRESETスイッチング時間は10の範囲にあります。 5 − 8Vバイアス下のns。 BaTiO 3 での電子と酸素空孔によって制御される強誘電分極スクリーニング / Nb:SrTiO 3 このスイッチング時間の違いを理解するために、ヘテロインターフェースが提案されています。速いSETと遅いRESET遷移を備えたこのスイッチは、いくつかの特別な地域で潜在的なアプリケーションを持つ可能性があります。
背景
分極反転は、化学的変化を引き起こさず、本質的に速い現象である純粋な電子メカニズムに基づいているため、強誘電性抵抗スイッチング効果は多くの研究関心を集めています[1、2]。強誘電性抵抗スイッチング効果は、2つの金属または半導体電極に挟まれた強誘電性ヘテロ接合で観察されています[3,4,5]。強誘電体/半導体ヘテロ接合では、多くの興味深い挙動が観察されています。たとえば、BaTiO 3 では、大幅に強化されたトンネリング電気抵抗が観察されます。 (BTO)/(001)Nb:SrTiO 3 (NSTO)[4、5]およびMoS 2 / BaTiO 3 / SrRuO 3 [6]バリアの高さと幅の両方が強誘電性電界効果によって変調できるため、ヘテロ接合。 BaTiO 3 には、バイポーラ抵抗スイッチングと負性差動抵抗の共存が見られます。 /(111)Nb:SrTiO 3 ヘテロ接合[7]。光学的に制御された電気抵抗と電気的に制御された光起電力がSm 0.1 で観察されました。 Bi 0.9 FeO 3 /(001)Nb:SrTiO 3 ヘテロ接合[8]。 BiFeO 3 で強誘電分極変調バンドベンディングが観察されました /(100)NbSrTiO 3 走査型トンネル顕微鏡および分光法によるヘテロインターフェース[9]。 BaTiO 3 では、整流効果からバイポーラ抵抗スイッチング効果への遷移が観察されました。 / ZnOヘテロ接合[10]。
ここでは、BaTiO 3 の非対称抵抗スイッチング効果を観察します。 / Nb:SrTiO 3 まだ報告されていないショットキージャンクション。さらに、この非対称抵抗スイッチング効果を理解するために強誘電体電界効果を提案します。具体的には、高抵抗状態から低抵抗状態へのSET遷移は+ 8Vバイアス下で10nsであり、低抵抗状態から高抵抗状態へのRESET遷移は10 5 > − 8 V未満のns。これは、BaTiO 3 での電子と酸素空孔による強誘電分極スクリーニングによって理解できます。 / Nb:SrTiO 3 インターフェース。速いSETと遅いRESET遷移を備えたこのスイッチは、いくつかの特別な地域で潜在的なアプリケーションを持つ可能性があります。
メソッド
市販の(100)0.7 wt%NSTO基板は、エタノール、アセトン、および脱イオン水で15分以内に連続して洗浄され、堆積前に空気が吹き付けられました。 BTOフィルムは、KrFエキシマレーザー(248 nm、パルス幅25 ns、COMPexPro201、コヒーレント)を使用し、エネルギー300 mJ、周波数5 Hz、ベース真空でパルスレーザー堆積(PLD)によってNSTO基板上に成長させました。 2×10 −4 Pa。成長中、基板温度は700°Cに保たれ、ターゲットと基板の距離は6.5cmでした。酸素分圧は1Paで、成長時間は15分でした。成長後、サンプルを1 Paの酸素分圧下で10分間保持した後、真空環境内で温度を10°C /分で室温まで下げました。 BTO薄膜の厚さは約100nmです。 Au上部電極(0.04 mm 2 )は、DCマグネトロンスパッタリングによってシャドウマスクを介してBTO薄膜上にスパッタリングされ、下部電極はNSTO基板上にインジウム(In)プレスされました。ケースレー2400ソースメーターを使用して輸送測定を実施しました。電圧パルスは、任意波形発生器(Agilent 33250A)によって供給され、パルス幅は10nsから1sの範囲でした。原子間力顕微鏡(AFM)、ピエゾ応答力顕微鏡(PFM)、および走査型ケルビンプローブ顕微鏡(SKPM)の結果を実行して、オックスフォードAR機器によるBTOフィルム表面の形態、強誘電性、および静電ポテンシャルを特徴付けました。 PFM面外位相、PFM面外振幅、電流、およびSKPM画像は、2×2μm 2 <の領域を書き込んだ後、同じ領域に0.5Vのバイアスされた導電性チップで記録されました。 / sup> − 8 V、次に中央の1.25×1.25μm 2 + 8 Vの正方形。すべての測定で、下部電極を接地し、上部電極または先端に電圧を印加しました。すべての測定は室温で行われました。
結果と考察
図1a〜dは、振幅と幅が異なるパルスを印加した後、-0.5〜0.5Vの小さなバイアスで測定されたAu / BTO / NSTO / Inシステムの電流-電圧曲線を示しています。図1a、bは、さまざまな振幅の100msの幅のパルス、図1c、dは、それぞれさまざまな幅の+8および-8Vの振幅のパルスの後に測定されます。図1e–hは、高抵抗状態(HRS)(図1e、g)または低抵抗状態(LRS)(図1e、g)(図1e、g)から始まるさまざまな振幅と幅の電圧パルスの印加後に-0.3Vで記録された接合抵抗を示しています。図1f、h)。ここで、パネルeとfのパルス幅は100ミリ秒で、パネルeとfの異なる曲線は、正または負の最大電圧を変化させた、異なる連続測定に対応しています。図1aの挿入図は、デバイス構造の概略図を示しています。 Au / BTO / NSTOの抵抗スイッチングは、小さいバイアスでの電流-電圧曲線と、書き込みパルスの振幅の関数としての抵抗ループによって示されます。図1a、b、e、fに示すように、8Vまで。明らかに、正のパルスはデバイスを低抵抗状態に設定できますが、負のパルスはデバイスを高抵抗状態に戻します。興味深いことに、オン状態とオフ状態の間の切り替えはどちらも段階的であり、HRSまたはLRSから開始するかどうかに関係なく、マルチステート抵抗スイッチングデバイスに役立ちます。 HRSとLRSの間のこれらの段階的な移行は、BTO / La 0.67 でも観察されました。 Sr 0.33 MnO 3 強誘電性トンネル接合[2]。低(3×10 4 )間のヒステリシスサイクル Ω)および高-(3×10 6 Ω)抵抗状態が観察され、書き込み電圧が+8と-8Vの間で掃引されると100の大きなOFF / ON比が得られます(図1e、f、黒い曲線)。図1e、fのマイナーループは、サイクリングプロトコルに応じて、HRSとLRSの間で最終的な抵抗状態を微調整できることを示しています。同様に、振幅が-8〜8 V、幅が10 ns〜1 sの書き込みパルスをデバイスに適用し、続いて、書き込みパルス幅の関数としてIV曲線と接合抵抗を記録しました。図1c、d、g、h。明らかに、HRSとLRSの切り替えは、正(負)の電圧パルス幅が十分に長く、振幅が十分に大きい場合にのみ発生します。 SETプロセスとRESETプロセスの両方で、絶対パルス電圧振幅が増加するにつれて、パルス持続時間は短くなります。具体的には、HRSからLRSへのスイッチング時間は非常に速く、図1gに示すように、4Vを超える10nsのパルスで接合抵抗を飽和させるのに十分です。対照的に、HRSへの完全な切り替えは、図1hに示すように、ミリ秒のタイムスケールで比較的長いRESETパルスによってのみ達成されます。 memristiveデバイスのアプリケーションの場合、図1e–hは、パルス電圧の振幅または持続時間をプログラミングすることでマルチレベル動作を実現できることも示しています。
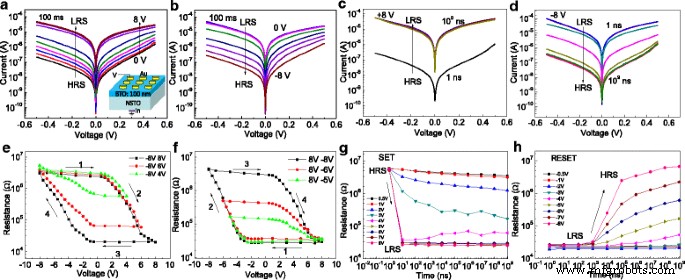
さまざまな振幅( a )で幅100 msのパルスを印加した後の、-0.5〜0.5Vの小さなバイアスでのAu / BTO / NSTO / Inシステムの電流-電圧曲線 、 b )。 + 8 V( c )のパルスを印加した後の、小さなバイアスでのAu / BTO / NSTO / Inシステムの電流-電圧曲線 )および− 8 V( d )さまざまなパルス幅で。 HRS( e )から始まるさまざまな振幅と幅の電圧パルスを印加した後、-0.3Vで記録されたAu / BTO / NSTO / Inシステムの接合抵抗 、 g )またはLRS( f 、 h )、ここで e のパルス幅 および f 100ミリ秒で、 e のさまざまな曲線 および f 正または負の最大電圧を変化させて、異なる連続測定に対応します。 a の挿入図 にデバイス構造の概略図を示します
図2aのトポグラフィー画像は、BTOフィルムの表面が原子的に平坦であることを示しています。これにより、上部電極と下部電極の間の短絡が防止されます[11]。図2bに示すピエゾ応答力顕微鏡(PFM)の面外ヒステリシスループは、BTOフィルムの強誘電性を示しています。図2bに示すように、局所的な強制電圧は約+ 3.1および-3.1 Vであり、振幅ループの最小値で示されます。図2c–fは、2の領域を書き込んだ後、図2aの同じ領域に記録されたBTO表面に書き込まれた強誘電体ドメインのPFM面外位相、PFM面外振幅、電流、およびSKPM画像を示しています。 ×2μm 2 + 8 V、次に中央の1.25×1.25μm 2 バイアスされた導電性チップを使用して、− 8Vの正方形。 BTOが− 8 V(+ 8 V)で分極されている場合、強誘電分極が半導体基板から離れる方向を向いている中央(外側)ドメインで、より小さな(より大きな)電流が観察されます。これは、強誘電性ヘテロ接合における分極依存抵抗スイッチング効果を実証するための重要な証拠として使用されてきました[4]。さらに、HRSとLRSの両方の伝導が非常に均一であるため、伝導性フィラメントが形成されていないことがわかります。 SKPMの原理により、チップとサンプル間の接触電位差の2次元分布をナノメートル範囲の分解能で測定します。熱平衡状態で測定を行うと、接触電位差をサンプルの仕事関数に変換できます。これは、サンプルにバイアスをかけたときの電位です。したがって、正(負)のチップバイアスは、負(正)イオンおよび/または分極電荷を表面に引き付け、表面電位をより低く(より高く)します[12]。この予測は、図2fの観察結果と一致しており、分極電荷の変動が主な影響であることを確認しています。したがって、BTO / NSTOヘテロ接合の抵抗スイッチングは、強誘電分極反転によって理解できます。これは、以前のレポート[13]でも説明されています。ただし、SETとRESETの両方の動作速度は、純粋な強誘電分極反転[2]の場合、10 nsのオーダーである必要があります。これは、図に示すように、SETとRESETの速度の4次の違いの観察結果とは逆です。 1g、h。次に、SETとRESETの動作速度の違いをどのように理解するかという質問がありますか?
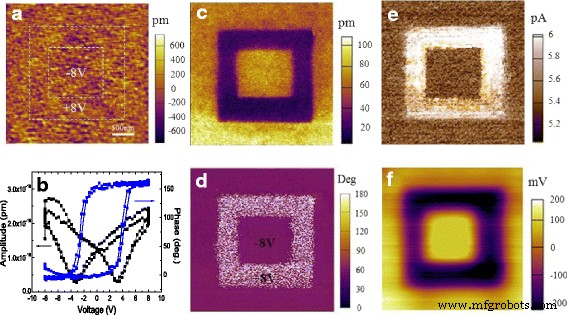
a NSTO基板上のBTOフィルムの表面形態。 b ローカルPFM面外ヒステリシスループ:青、位相信号。黒、振幅信号。 c PFM面外位相、 d PFMの面外振幅、 e 現在、および f 同じ領域で記録されたSKPM画像( a )2×2μm 2 の領域を書き込んだ後 − 8 V、次に中央の1.25×1.25μm 2 バイアスされた導電性チップを使用して、+ 8Vの正方形。 a の画像のスケールバーは500nmです および c – f 。 c のラベル – e 面外電流、PFM位相、PFM振幅の値にそれぞれ対応します
スイッチング時間の明らかな非対称性は、Al / W:AlO x でも観察されています。 / WO y / W [14]、La 2/3 Sr 1/3 MnO 3 / Pb(Zr 0.2 Ti 0.8 )O 3 / La 2/3 Sr 1/3 MnO 3 [15]、およびPt / LaAlO 3 / SrTiO 3 [16]デバイス。ウーらW:AlO x で非対称レドックス反応を提案 / WO y 二分子膜デバイスであり、スイッチング時間の差は、AlO x の異なるギブズの自由エネルギーに起因すると考えられます。 およびWO y レイヤー[14]。ただし、現在のBTO / NSTOヘテロ接合では、NSTOは高濃度にドープされた半導体であるため、電圧はBTOフィルムにのみ印加できます。したがって、本研究では非対称レドックス反応を除外することができます。秦ら。およびWuetal。スイッチング時間の非対称性は、LSMO / Pb(Zr 0.2 )全体で酸素空孔の移動を促進する異なる内部電場に起因すると考えられます。 Ti 0.8 )O 3 およびLaAlO 3 / SrTiO 3 インターフェイス[15、16]。界面を横切る酸素空孔のこのモデルによれば、酸素空孔は正のバイアスの下でBTOからNSTOに移動し、BTOの酸素空孔濃度の減少により、BTOの抵抗は増加しますが、NSTOの抵抗は変化しません。すでに高濃度のNbドナーが含まれているためです。したがって、システム全体の抵抗は正のバイアスの下で増加します。これは、図1の観察結果とは逆です。さらに、イオンプロセスは電子プロセスよりもはるかに遅いと考えられるため、純粋なイオンプロセスでは図2gに示すように、10nsの高速SETプロセス。したがって、分極反転の物理的プロセスまたはドリフトした酸素空孔の化学的プロセスだけを考慮するだけでは、非対称抵抗スイッチング速度を理解することは困難です。実際、Au / NSTO [17]およびZnO / NSTOショットキー接合[18]でも非対称スイッチング速度が観察されています。非対称ショットキー障壁は、非対称抵抗スイッチング速度にもつながる可能性があります。ただし、PFMとSKPMの結果に基づくと、本研究におけるBTO / NSTOヘテロ接合の抵抗スイッチングは、強誘電体電界効果によって引き起こされることが観察されています。したがって、この非対称的な振る舞いを理解するために、BTO / NSTOインターフェースを横切る酸素空孔の移動と組み合わせた強誘電分極反転のモデルを提案します。
図3は、低抵抗状態と高抵抗状態のAu / BTO / NSTO構造の概略図(図3a、b)と対応する位置エネルギープロファイル(図3c、d)を示しています。 BTOでは、赤い矢印は分極方向を示し、「プラス」と「マイナス」の記号はそれぞれ正と負の強誘電体結合電荷を表します。 「丸で囲んだプラス」の記号は、イオン化された酸素空孔を表します。青い矢印は、BTO / NSTOインターフェースを横切ってドリフトする酸素空孔の方向を示しています。簡単にするために、Au / BTO界面の強誘電性結合電荷を完全にスクリーニングできると仮定します。したがって、Au / BTO界面の障壁の高さは固定されており、分極の反転によって変化することはありません。 BTO / NSTOインターフェースのバリアの高さは、分極が下部(上部)の電極インターフェースを指すように小さく(大きく)なり、正(負)のバイアスの下で低(高)抵抗状態になります。 Au / BTOの上部電極界面では、正と負の両方の強誘電性結合電荷が、正と負の両方のバイアスの下で、それぞれ電子と正孔によって完全に遮蔽されます。したがって、スクリーニング速度は常に数百ピコ秒と同じくらい速くなる可能性があります[19]。 SET速度とRESET速度の両方が同じ時間スケールである必要があるため、Au / BTOの上部電極インターフェースは非対称抵抗スイッチング速度を考慮できません。ただし、BTO / NSTOの下部電極界面の場合、正および強誘電性の結合電荷は、正および負のバイアスの下で、それぞれ電子および酸素空孔によってスクリーニングできます。実際、酸素空孔は、BTO / NSTOインターフェースを横切って、BTOからNSTO(NSTOからBTO)に移動し、上部電極に正(負)のバイアスがかかると、NSTOに向かう(離れる)分極点になります。強誘電分極が上から下の電極に向けられている場合、下の電極界面で正の強誘電結合電荷をスクリーニングするために電子が必要です。したがって、電子の移動速度のみが抵抗スイッチングプロセスのSET速度に影響を与えます。強誘電分極が下部電極から上部電極に向けられている場合、下部電極界面での負の強誘電結合電荷をスクリーニングするために酸素空孔が必要です。したがって、酸素空孔の移動速度は、抵抗スイッチングプロセスのリセット速度を制限します。酸素空孔の移動には電子よりもはるかに長い時間がかかるため、電子によって制限されるSET速度は、酸素空孔によって制限されるRESET速度よりもはるかに速くなります。これは私たちの観察と一致しています。さらに、電子スクリーニングと酸素空孔スクリーニングの間の移行は、BiFeO 3 でも観察されています。 / La 0.7 Sr 0.3 MnO 3 インターフェイス[20]は、現在の作業で提案されている非対称抵抗スイッチングのメカニズムをさらに確認します。

概略図( a 、 b )および対応する位置エネルギープロファイル( c 、 d )低抵抗状態と高抵抗状態のAu / BTO / NSTO構造の。 BTOでは、赤い矢印は分極方向を示し、「プラス」と「マイナス」の記号はそれぞれ正と負の強誘電体結合電荷を表します。 「丸で囲んだプラス」の記号は、イオン化された酸素空孔を表します。青い矢印は、BTO / NSTOインターフェースを横切ってドリフトする酸素空孔の方向を示しています
結論
結論として、非対称抵抗スイッチング時間は、BTO / NSTOヘテロ接合で観察されます。 RESET動作に必要なパルス幅は、SETプロセスよりも4桁長くなります。 BTO / NSTO界面で電子と酸素空孔によって遮蔽された正と負の強誘電性結合電荷は、それぞれ正と負のバイアスで重要な役割を果たします。電子スクリーニングのプロセスは、酸素空孔のプロセスよりもはるかに高速であるため、正のバイアスによって誘発されるSET遷移(HRSからLRS)は、負のバイアスによって誘発されるRESET遷移(LRSからHRS)よりもはるかに高速です。さらに、このスイッチは高速のSET遷移と低速のRESET遷移を示し、一部の特殊な領域でアプリケーションが使用される可能性があります。
略語
- BTO:
-
BaTiO 3
- HRS:
-
高抵抗状態
- LRS:
-
低抵抗状態
- NSTO:
-
Nb:SrTiO 3
- PFM:
-
ピエゾレスポンスフォース顕微鏡
- SKPM:
-
ケルビンプローブ顕微鏡のスキャン
ナノマテリアル
- デジタル(ON / OFF)ホール効果デバイス:スイッチとラッチ
- ナノ結晶合金
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- コンプライアンスフリーのZrO2 / ZrO2 − x / ZrO2抵抗変化型メモリと制御可能な界面マルチステートスイッチング動作
- 超微細チタニア核形成に対する硫酸陰イオンの効果
- 純粋なCMOSロジックプロセスによる自己抑制抵抗スイッチング負荷を備えたRRAM統合4TSRAM
- リチウムイオン電池用の金属酸化物アノードの電気化学的性能に及ぼす異なるバインダーの影響
- La0.67Sr0.33MnO3 / BaTiO3超格子の軌道秩序化によって引き起こされるキュリー温度の上昇
- 不揮発性メモリのスイッチング特性に及ぼす二分子膜CeO2-x / ZnOおよびZnO / CeO2-xヘテロ構造と電鋳極性の影響
- InP / ZnS量子ドット膜の光学特性に及ぼすポストサーマルアニーリングの影響
- エレクトロスピニングされたPUナノファイバーの機械的性質に及ぼす温度の影響



