InGaAs / InAlAs単一光子アバランシェフォトダイオードの理論的分析
要約
InGaAs / InAlAsアバランシェフォトダイオード(APD)と単一光子APD(SPAD)の理論的分析と2次元シミュレーションが報告されています。 InGaAs / InAlAsAPDとSPADの電界分布とトンネル効果を研究します。 InGaAs / InAlAs SPADがガイガーモードで動作している場合、電界は吸収層で線形に増加し、増倍層での線形関係から外れます。増倍層のトンネリングしきい値電界を考慮すると、増倍層の厚さは300nmより大きくする必要があります。さらに、SPADは大きなバイアス電圧の下で動作して、電荷層のドーピング濃度が高い吸収層でのトンネリングを回避できます。
背景
0.53 Ga 0.47 As / In 0.52 Al 0.48 As(以下、InGaAs / InAlAsと呼びます)およびInGaAs / InPアバランシェフォトダイオード(APD)は、短波赤外線検出用の最も重要な光検出器です。近年、量子鍵配送の研究が急速に進んでおり、現在、InGaAs / InAlAsおよびInGaAs / InP APDは、単一光子APD(SPAD)として単一光子のカウントとタイミングを実現できます[1]。光電子増倍管など、SWIR波長範囲の他の単一光子検出器と比較して、InGaAs単一光子アバランシェダイオードには、高性能、高信頼性、低バイアス、小型、優れた時間分解能、および操作の容易さという独特の利点があります。 2、3]。したがって、InGaAs / InAlAsおよびInGaAs / InP APDはかなりの注目を集めています[4、5]。線形モードで動作するAPDと比較して、SPADとしてガイガーモードで動作するAPDには、ブレークダウン電圧を超える逆バイアスが適用されます[6]。 SPADは増倍層で高いゲインを達成し、単一光子は巨視的な電流パルスをトリガーできます。これにより、単一光子の検出器への到達を正確に検出できます[7]。したがって、SPADは1550nmの波長で単一光子を検出できます[8]。一方、吸収波長は吸収層の材料によって制御することができます[9]。
InAlAsベースのSPADと比較して、InPベースのSPADの理論的およびシミュレーション研究はより包括的です[2、10、11、12]。ただし、InAlAsベースのAPDは、APDとSPADの両方でパフォーマンスを向上させることができるため、InPベースのAPDの代わりに使用されることが増えています[13]。 InAlAsの電子(α)と正孔(β)のイオン化係数比はInPのイオン化係数比よりも大きいため、InAlAsベースのAPDでは過剰雑音指数が低くゲイン帯域幅積が高くなります[14]。 InAlAsのバンドギャップを大きくすると、SPADのブレークダウン特性が向上し、ダークカウント率(DCR)が低下する可能性があります[15]。 InAlAsベースのAPDは電子移動度が高く、InPベースのAPDよりも応答時間が速くなります[16]。さらに、InAlAs APDのイオン化係数比は、InPベースのAPDの温度変化に対する感度が低くなります[17]。その結果、InGaAs / InAlAs APDは、ブレークダウン特性、DCR、過剰ノイズ、ゲイン帯域幅、応答時間、および温度特性の点で高いパフォーマンスを実現できます。
InGaAs / InAlAs APDに関する研究は、主に単一光子検出効率(SPDE)の向上と、SPADのDCRの低下に焦点を当てています。 Karve etal。 130 Kで16%のSPDEを持つ最初のInGaAs / InAlAsSAPDを実証しました[18]。中田ほかSPADの温度性能を改善し、213 Kで10%のSPDEを達成しました[19]。趙ら160 Kで11.5%のSPDEを備えた自己消光および自己回復InGaAs / InAlAsSPADを設計しました。同時に、3.3 MHzのDCRが観測されています[20]。 Meng etal。 260 Kで21%のSPDEを達成するメサ構造InGaAs / InAlAsSPADを設計しました[21]。次に、同様の構造で厚い吸収および増倍層を適用しました。これにより、210 KでSPDEが26%に向上し、DCRが1×10 8 に減少します。 Hz [22]。ただし、これらの研究では、InGaAs / InAlAsSPADのDCRはInGaAs / InP SPADと比較して高すぎます(最近のInP SPADでは、DCRは一般的に<10 4 Hz)[23]。 InGaAs / InAlAs SPADの高いDCRは、過バイアス電圧での高電界によって引き起こされるトンネリング電流に起因します[21、22、24]。したがって、トンネリング関連のメカニズムを減らすことは、InGaAs / InAlAs SPADにとって重要であり、これらのメカニズムはSAPDの電界分布に関連しています。文献から[1。 9]、トンネリングしきい値電界は2.0×10 5 です。 吸収層(InGaAs)のV / cmおよび6.8×10 5 増倍層のV / cm(InAlAs)。したがって、適切な電界分布は、電荷層と増倍層の厚さによって決定されるInAlAsSPADにとって重要です。 InAlAs APDの電荷層を考慮して、Kleinow等。この層のドーピング濃度の影響を研究し、ドーピング濃度がInGaAs / InAlAs APDの性能にとってより重要であることを発見しました[25、26]。 Chen etal。理論的な分析とシミュレーションによって、パンチスルー電圧とブレークダウン電圧に対する電荷層と増倍層の影響を研究しました[27]。これらの研究は、線形モデルの下でのInAlAsAPDの性能に焦点を合わせています。ただし、ガイガーモードでは、InAlAsSPADの性能はまだ完全には理解されていません。
この論文では、理論的分析とシミュレーションを使用して、InGaAs / InAlAsSPADのトンネル効果と電界分布を研究します。ガイガーモードでのトンネルしきい値電界を考慮して、SPADの設計基準はトンネル効果を回避するように最適化されています。
メソッド
数値シミュレーションは、TCAD [28]を使用して、前面照射されたSAGCM InGaAs / InAlAsAPDに対して実行されます。シミュレーションに使用した物理モデルは次のとおりです。 Selberherr衝突電離モデルは、InAlAsでのアバランシェ増倍をシミュレートします。電界分布と拡散電流は、ポアソン方程式とキャリア連続方程式を含むドリフト拡散モデルによって記述されます。トンネル電流には、バンド間およびトラップ支援トンネルモデルが使用されます。シミュレーションでは、フェルミ-ディラックキャリア統計、オージェ再結合、キャリア濃度依存性、ショックリー-リード-ホール再結合、低磁場移動度、速度飽和、衝突電離、レイトレーシング法などの他の基本モデルが使用されます。シミュレーション用の前面照射型APDエピタキシャル構造の概略断面図を図1に示します。
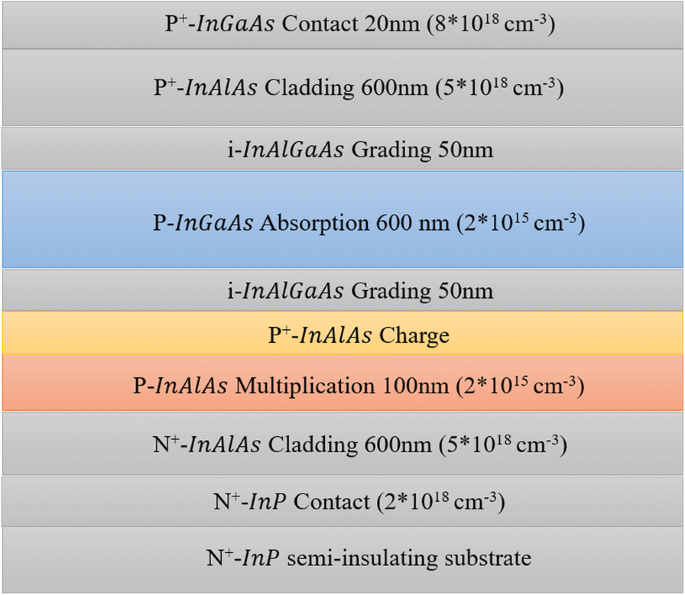
前面から照らされたSAGCMAPDの概略断面図。上部に照らされたSAGCMINGaAs / InAlAsAPDの概略断面図を示します。これには、構造、材料、ドーピング、および厚さが含まれます。下から上に向かって、これらの層は、基板、接触層、クラッド層、増倍層、電荷層、グレーディング層、吸収層、グレーディング層、クラッド層、および接触層と順番に命名されます。
下から上に、層は、基板、接触層、クラッド層、増倍層、電荷層、グレーディング層、吸収層、グレーディング層、クラッド層、および接触層と順番に命名される。吸収層に誘導された光生成キャリアは増倍層にドリフトし、そこでアバランシェ降伏を引き起こします。吸収の電界は、電荷層制御を使用して調整され、増倍層でのみ高電界を維持します。電荷層と吸収層の間のInAlGaAsグレーディング層は、InGaAs-InAlAsヘテロ接合での電子の堆積を回避します。シミュレーションのデバイス構造は、参考文献の実験構造に似ています。 [21]。
SAGCM APDの電界分布は、ポアソン方程式、PN空乏層モデル、および境界条件方程式を使用して解くことができます[29]。ポアソン方程式は次のように与えられます
$$ \ frac {d \ xi} {d x} =\ frac {\ rho} {\ varepsilon} =\ frac {q \ ast N} {\ varepsilon}。 $$(1)境界条件方程式は次のように与えられます
$$ Vbias + Vbi =-{\ int} _0 ^ w \ xi \ left(x、\ mathrm {w} \ right)dx。 $$(2)これらの方程式では、ρ ドーパントイオン q に等しい × N 空乏層では、ε は材料の誘電率 V バイアス APDのバイアス電圧 V bi は組み込みのポテンシャルであり、 w 空乏層の厚さです。空乏層の境界がデバイスの接触層に到達したときの電界分布とバイアス電圧の数学的関係は、式(1)を使用して導き出すことができます。 (1)と(2)。
トンネリング電流は、バンド間およびトラップ支援トンネリングで構成されます。バンド間トンネル電流は、材料内の電界に依存し、高電界での暗電流の主要な成分になります[24、30]。バンド間トンネルの生成率は[31]として与えられます。
$$ {G} _ {\ mathrm {btb}} ={\ left(\ frac {2 {m} ^ {\ ast}} {E_g} \ right)} ^ {1/2} \ frac {q ^ 2E } {{\ left(2 \ pi \ right)} ^ 3 \ mathrm {\ hslash}} \ exp \ left(\ frac {-\ pi} {4q \ mathrm {\ hslash} E} {\ left(2 { m} ^ {\ ast} \ ast {E} _g ^ 3 \ right)} ^ {\ raisebox {1ex} {$ 1 $} \!\ left / \!\ raisebox {-1ex} {$ 2 $} \ right。 } \ right)$$(3)上記の式では、 E g は、InGaAs(0.75 eV)またはInAlAs(1.46 eV)のエネルギーバンドギャップ、 m * (0.04 m に等しい e InGaAsおよび0.07 m e InAlAs)は有効な換算質量であり、 E 最大電界です。 G btb 電界に依存します E およびエネルギーバンドギャップ E g 、 w トンネル トンネリングプロセスの有効な厚さであると想定され、 A デバイスの領域と見なされます。したがって、バンド間トンネルのトンネル電流は[13]として与えられます。
$$ {I} _ {\ mathrm {tunnel}} / A ={G} _ {\ mathrm {btb}} \ ast q \ ast {w} _ {\ mathrm {tunnel}} $$(4)I の計算結果 トンネル / A ( w トンネル =1μm)を図2に示します。 I トンネル 2.0×10 5 で有意になります InGaAsのV / cmおよび6.9×10 5 それぞれInAlAsのV / cm。これらの計算値は、トンネリングしきい値電界(2.0×10 5 )とよく一致することがわかります。 V / cm、InGaAs)および(6.8×10 5 参考文献のV / cm、InAlAs)。トンネル電流は、高磁場でのSPADの性能に十分な影響を与える可能性があります。したがって、フィールドは、SPADのInGaAsとInAlAsの両方でトンネリングしきい値より低くなるように調整する必要があります。表1に、シミュレーションで使用されたパラメータを示します。
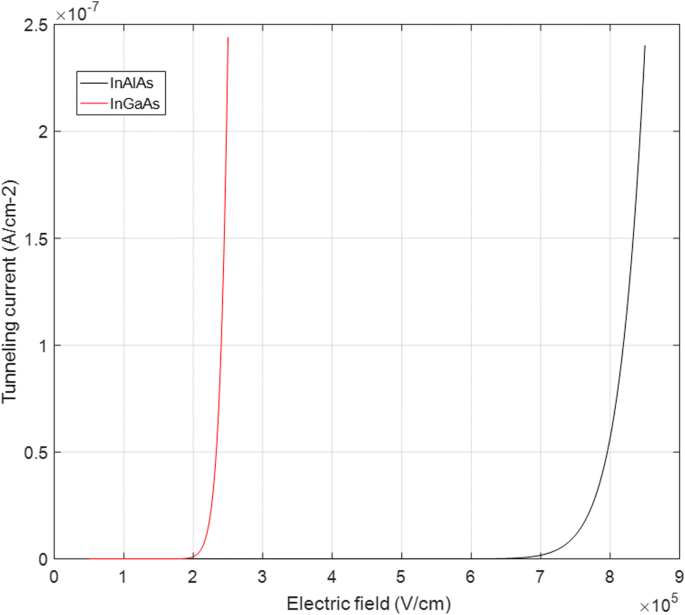
I との関係 トンネル / A InGaAsとInAlAsの電界。 I の計算結果を表示します トンネル / A 。 私 トンネル 2.0×10 5 で有意になります InGaAsのV / cmおよび6.9×10 5 それぞれInAlAsのV / cm
結果と考察
このセクションでは、理論的分析と結論をシミュレーションによって研究しました。まず、ガイガーモードでの電界分布をセクションAで検討しました。次に、ガイガーモードでのトンネルしきい値電界を考慮して、SPADの設計基準を最適化し、セクションBでのトンネル効果を回避します。参考文献[22]の構造は、シミュレーションモデルのテストに使用されました。このシミュレーションでは、参考文献[28]と同じシミュレーションエンジンを使用し、電流-電圧曲線とゲイン対電圧曲線を図3に示しました。パンチスルー電圧とブレークダウン電圧で突然増加します。
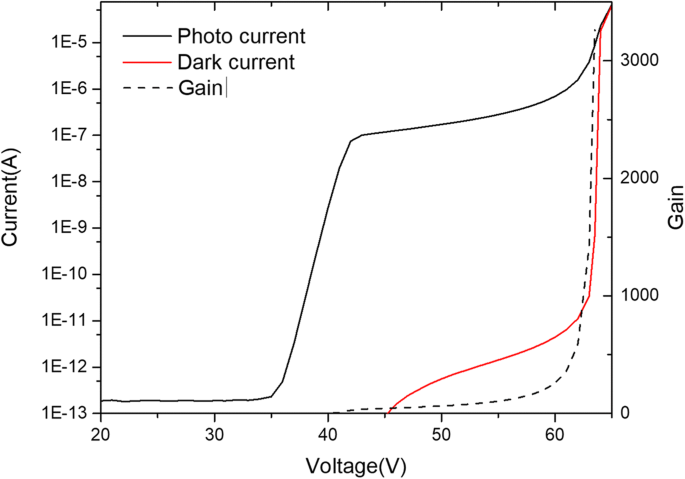
InGaAs / InAlAsAPDのゲイン対電圧に伴う電流-電圧曲線。図のように、いくつかの典型的なデバイス構造のゲイン対電圧曲線とともにi-v曲線を示します
ガイガーモードでの電界分布
デバイスの性能は電界分布に大きく影響されることがわかりました。高利得と小暗電流を維持するには、増倍層と吸収層の電界を適切に制御することが重要です。参考文献から。 [32]、InGaAs / InAlAs APDの適切な電界分布は、これらの規則に準拠する必要があります。保証V pt (パンチスルー電圧)
図4と図5は、それぞれガイガーモードでの増倍層と吸収層でシミュレートされた界磁電圧特性を示しています。シミュレーションでブレークダウン電圧1〜6 Vを超える逆バイアスがSPADに適用されるため、ガイガーモードで動作するAPD。電荷層の厚さ( W 料金 )は50 nmで、増倍層の厚さ( W 掛け算 )はそれぞれ100、200、300nmです。
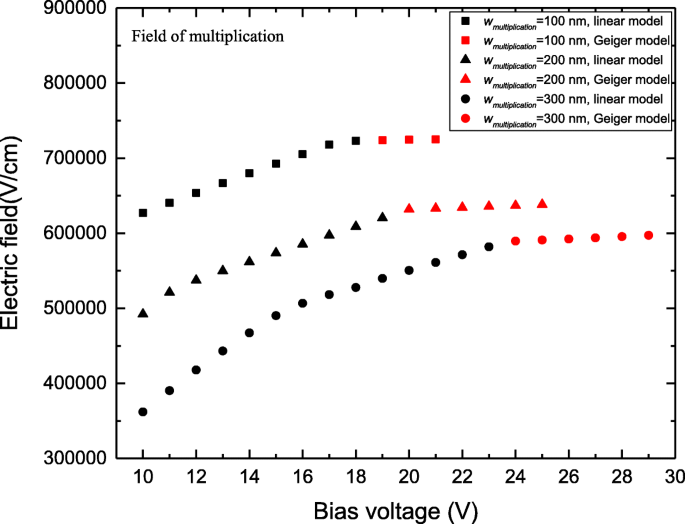
シミュレーションの結果、ガイガーモードでの乗算で電界が発生します。 W の値 掛け算 は100nm(黒い四角)、200 nm(黒い三角形)、300 nm(黒い円)です。図3は、ガイガーモードでの増倍層のシミュレーションされた界磁電圧特性を示しています。電荷層の厚さは50nmで、増倍層の厚さはそれぞれ100、200、300nmです
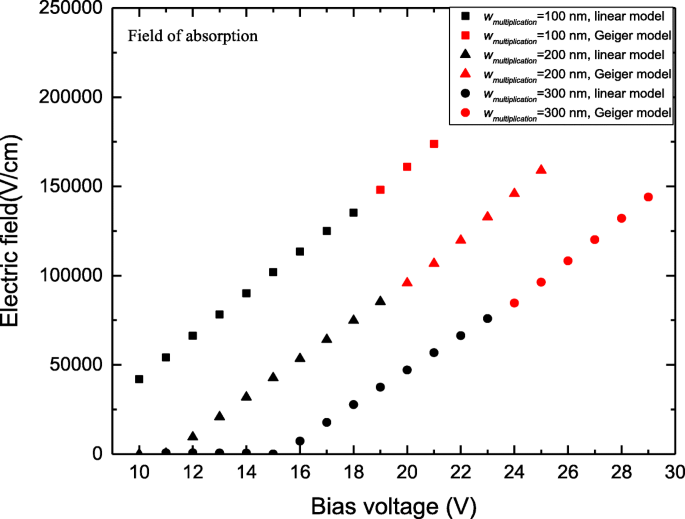
シミュレーションの結果、ガイガーモードでの吸収における電界が発生します。 W の値 掛け算 は100nm(黒い四角)、200 nm(黒い三角形)、300 nm(黒い円)です。図4は、ガイガーモードでの吸収層のシミュレーションされたフィールド電圧特性を示しています。電荷層の厚さは50nmで、増倍層の厚さはそれぞれ100、200、300nmです。
InGaAs / InAlAs SPADが線形モデル(APD)で動作する場合、吸収層と増倍層の電界は、バイアス電圧の増加に伴って線形に増加します。ただし、ガイガーモードではバイアス電圧が絶縁破壊電圧を超えるため、吸収層の電界は以前と同様に直線的に増加しますが、増倍層のアバランシェ電界の増加は遅くなります。線形モードで動作するInGaAs / InAlAs APDと比較して、InGaAs / InAlAs SPADは、より高いアバランシェ場を持つ増倍層で高いゲインを達成し、単一の光子が巨視的な電流パルスをトリガーできます。同時に、ガイガーモードでの吸収場は線形モデルでの吸収場よりも大きくなります。トンネル電流は高磁場の暗電流の主要な成分になり、単一の光子は、線形モードよりもはるかに大きいアバランシェゲインで巨視的な電流パルスをトリガーできます。
SPADの設計上の考慮事項
SAPDは飽和モードで動作することがわかっています。高利得と小暗電流を維持するには、増倍層と吸収層の電界制御が重要です。吸収場がトンネリング閾値電場よりも小さい場合、増倍層で高いアバランシェ電場を維持し、トンネリング電流を回避することができます。したがって、各層の濃度と厚さは、SPAD用に適切に設計する必要があります。
図2は、増倍層と吸収層の電界がトンネル効果のしきい値電界を超えているため、SPADがトンネル効果を大きくする可能性があることを示しています。したがって、電界は、InGaAs吸収とInAlAs増倍の両方でトンネリングしきい値より低くなるように調整する必要があります。理論的分析は、増倍のなだれ電場が N の積によって減少することを示しています 料金 および w 料金 [28]。したがって、電荷層は吸収の場を制御することができます。ただし、増倍層のなだれ電場は w によって決定されます。 掛け算 。図6は、デバイスがアバランシェブレークダウンを受けたときの、さまざまな増倍厚(100〜500 nm)でシミュレートされたフィールド電圧特性を示しています。増倍層と吸収層のバックグラウンドドーピングは2×10 15 です。 cm -3 、分子線エピタキシー(MBE)の固有濃度です。シミュレーション結果は、増倍層の厚さが増すにつれて、増倍層のなだれ電場が減少することを示している。したがって、厚い増倍層は、増倍における低アバランシェ電場を介したトンネル効果の可能性を回避することができます。

W が異なる増倍層の電界 掛け算 。図5は、デバイスがアバランシェ降伏を受けたときのさまざまな増倍厚(100〜500 nm)のシミュレーションされた界磁電圧特性を示しています
ガイガーモードでトンネリングしきい値を超える増倍時のアバランシェ電場を回避するには、増倍の厚さを> 300 nmにする必要があります。これは、アバランシェ電場が6×10 5 未満です。 V / cmであり、図4の絶縁破壊電圧を超えています。したがって、厚い増倍層は、ガイガーモードでのSPADのトンネル効果を回避できます。これが、乗算が厚いSPADのDCRが低い理由です。
セクションAで述べたように、吸収層の電界はガイガーモードで直線的に増加します。バイアス電圧の増加は、吸収層の電界に大きく影響します。これにより、電界が2.0×10 5 を超える確率が高くなります。 V / cm。図7は、電荷層( w )のさまざまなドーピング濃度についてシミュレートされた電界分布を示しています。 料金 =50 nm)。ドーピング濃度が高いと、吸収層の電界が低くなり、ガイガーモードでは5Vの絶縁破壊電圧を超えることさえあります。ただし、より低いドーピング濃度では、トンネリングしきい値電界がすぐに達成されます。その結果、電荷層のドーピング濃度が低くなると、トンネリング効果が早期に開始されます。ガイガーモードで十分な動作バイアス電圧を取得するには、 N 料金 SPADの数が N よりも大きい 料金 APDの。低い N と比較して 料金 SPADの場合、 N が高くなります 料金 のSPADは、大きなバイアス電圧の下で動作して、トンネル効果を回避し、増倍層で高いゲインを実現できます。
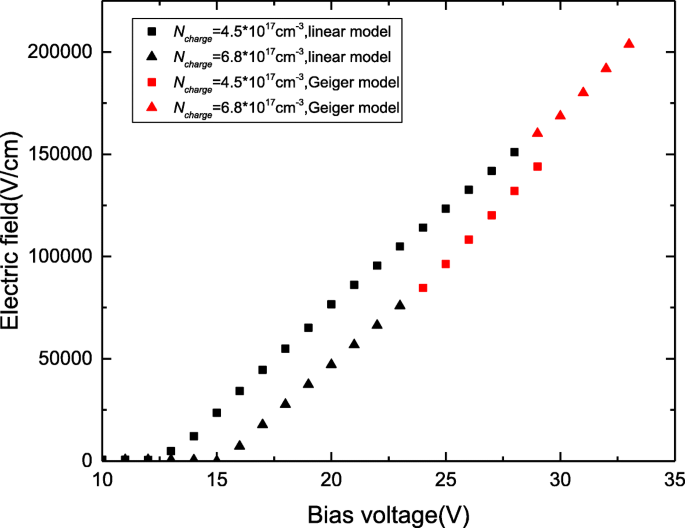
N が異なる吸収層のフィールド 料金 。 N の値 料金 は4.5 * 10 17 cm − 3 (黒い四角)、6.8 * 10 17 cm -3 (黒い三角形)。図6は、電荷層( W )のさまざまなドーピング濃度に対する吸収の電界分布を示しています。 料金 =50 nm)
結論
理論的解析とシミュレーションにより、InGaAs / InAlAsAPDとSPADの電界分布とトンネル効果を研究します。 InGaAs / InAlAs SPADがガイガーモードで動作している場合、吸収層の電界は直線的に増加し、その直線関係から外れます。増倍層のトンネリングしきい値電界を考慮すると、増倍層の厚さは300nmより大きくする必要があります。さらに、SPADは大きなバイアス電圧の下で動作して、電荷層のドーピング濃度が高い吸収層でのトンネリングを回避できます。
略語
- 2D:
-
二次元
- APD:
-
アバランシェフォトダイオード
- DCR:
-
ダークカウント率
- SAGCMAPD:
-
個別の吸収、グレーディング、充電、および増倍アバランシェフォトダイオード
- SPAD:
-
単一光子アバランシェフォトダイオード
- SPDE:
-
単一光子検出効率
ナノマテリアル
- 分析オプション
- ポリマーナノ構造上のU2OS細胞におけるアクチンと接着斑組織の分析
- サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
- マイクロピラーのInAs二重層量子ドットに基づく1.3μmの明るい単一光子源
- 二軸引張ひずみゲルマニウムナノワイヤの理論的研究
- グラフェン集積シリコンマイクロリング共振器のラマンマッピング分析
- CA / TPUヘリカルナノファイバーの製造とそのメカニズム分析
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- InGaAs / InAlAsSAGCMアバランシェフォトダイオードに関する理論的研究
- 低エネルギー照射に対するSi、Ge、およびSi / Ge超格子の放射応答の理論的シミュレーション
- 収差補正HAADF-STEMによるエピタキシャルGaAsBi中のBi分布の分析



