マイクロ波アニーリングによる原子層堆積Al2O3 / ZrO2 / Al2O3MIMコンデンサの誘電増強
要約
RF、DRAM、およびアナログ/ミックスドシグナル集積回路の分野に適用される金属-絶縁体-金属(MIM)コンデンサの場合、デバイスの機能サイズの縮小に伴い、高い静電容量密度が不可欠です。この作業では、マイクロ波アニーリング技術を調査して、Al 2 の誘電特性を向上させます。 O 3 / ZrO 2 / Al 2 O 3 ベースのMIMコンデンサ。結果は、ZrO 2 の誘電率を示しています。 1400 Wで5分間のマイクロ波アニーリングで41.9(〜40%強化)に増加します。基板温度は400°C未満であり、これはラインプロセスのバックエンドと互換性があります。漏れ電流密度は1.23×10 -8 です。 および1.36×10 -8 A / cm 2 堆積したままのサンプルと1400Wのサンプルの場合、それぞれ漏れ特性が低下していないことを示しています。伝導メカニズムは、フィールド支援トンネリングとして確認されています。
背景
金属-絶縁体-金属(MIM)コンデンサは、無線周波数(RF)、ダイナミックランダムアクセスメモリ(DRAM)、およびアナログ/ミックスドシグナル集積回路の分野で広く使用されています。デバイスの特徴サイズの縮小に伴い、これまで以上に高い静電容量密度を得ることが望ましい。たとえば、静電容量密度は10 fF /μm 2 より大きくする必要があります。 国際半導体技術ロードマップ(ITRS)の2020ノードによると[1]。その結果、HfO 2 などの多数のhigh-κ材料が調査されました。 [2,3,4,5,6]、ZrO 2 [7,8,9,10,11,12,13,14]、Ta 2 O 5 [15,16,17,18]、およびTiO 2 [19、20、21、22、23、24]。これらのhigh-κ材料の中で、ZrO 2 誘電率(κ)は16〜25(単斜晶相)で、バンドギャップは5.8eVです。ただし、ZrO 2 のκ値 立方晶相と正方晶相に結晶化すると、それぞれ36.8と46.6に増強できます[25]。したがって、静電容量密度をさらに高めることができます。マイクロ波アニーリング(MWA)技術は、従来の熱処理技術と比較してプロセス温度が低いため、シリコンのドーパント活性化[26,27,28]およびケイ化物形成[29,30]について非常に研究されてきました。さらに、Shih etal。 [31]は、TiN / Al / TiN / HfO 2 の電気的特性に対するMWAの影響を調査しました。 / SiMOSコンデンサ。等価酸化物の厚さ、界面状態密度、リーク電流密度などのいくつかの重要なパラメータがすべて改善されました。
この作業では、TaN / Al 2 の電気的特性に対するMWAの影響 O 3 / ZrO 2 / Al 2 O 3 / TaN(TaN / A / Z / A / TaN)MIMコンデンサを調査します。 MWAを使用すると、ZrO 2 の誘電率 が著しく向上し、漏れ電流密度がわずかに増加します。さらに、根底にある伝導メカニズムも研究されています。
メソッド
まず、厚さ500nmのSiO 2 膜はPECVDによってSi基板上に成長し、続いてTaN(20 nm)/ Ta(100 nm)膜が堆積され、TaNはN 2 にTaターゲットをスパッタリングすることによって成長しました。 / Arプラズマ。続いて、TaN / Ta膜でコーティングされたSiウェーハをALDチャンバーに移し、Al 2 のナノスタックを作成しました。 O 3 (2 nm)/ ZrO 2 (20 nm)/ Al 2 O 3 (2 nm)は250°Cで堆積されました。 Al 2 O 3 およびZrO 2 フィルムはAlから成長しました(CH 3 ) 3 / H 2 Oと[(CH 3 ) 2 N] 4 Zr / H 2 それぞれO。非常に薄いAl 2 O 3 下部のTaN電極とZrO 2 の間の層 層は、ALDおよび堆積後のアニーリング中の界面層の形成を抑制するために挿入されました。その後、サンプルをマイクロ波アニーリングにかけた。 MWAは、5.8GHzのDSGI八角形チャンバーで実行されました。アニーリング中、サンプルは、電磁場が最も均一であるチャンバーの中央に配置されました。サンプルのその場温度は、サンプルの裏側に面したRaytekXRシリーズ赤外線高温計によって監視されました。電力は、5分の固定アニーリング時間で700Wから1400Wまで変化しました。最後に、100 nmの厚さのTaN上部電極が、反応性スパッタ、リソグラフィ、および反応性イオンエッチングによって順番に形成されました。
ALD膜厚はエリプソメーター(SOPRA GES 5E)で測定し、透過型電子顕微鏡(TEM)で確認しました。静電容量-電圧( C-V )は、50 mV AC振幅の高精度インピーダンスアナライザー(Agilent 4294A)によって測定されました。電流-電圧( I-V )測定は、ダークボックス内で半導体デバイスアナライザ(Agilent B1500)を使用して実行されました。バイアスは上部電極に適用されました。
結果と考察
A / Z / AベースのMIMコンデンサとMWAチャンバーの概略構造をそれぞれ図1aとbに示します。図1cは、1400Wで5分間MWAを受けたA / Z / AベースのMIMコンデンサの断面TEM画像を示しています。 ZrO 2 層は完全に結晶化されており、積み重ねられた層を明確に区別できます。挿入図を参照してください。図2aは、さまざまなアニーリングパワーでの静電容量密度の累積確率プロットを示しています。結果は、MIMコンデンサの静電容量密度が7.34、8.87、8.96、および9.06 fF /μm 2 であることを示しています。 それぞれ、50%の累積確率で0、700、1050、および1400Wに対して。したがって、マイクロ波の影響下で静電容量密度が増加します。 MWAを備えたA / Z / AスタックMIMコンデンサの静電容量密度の分布が非常に狭いことは、アニーリングの均一性が非常に良好であることを示しています。図2aの挿入図は、すべてのサンプルの典型的なCV曲線を示しています。 Al 2 の効果を除く O 3 (κ≈8)、ZrO 2 の誘電率 フィルムは、図2bに示されているように、0、700、1050、および1400 Wに対してそれぞれ28.3、40.1、41、および41.9として抽出されます。 1400 Wのマイクロ波電力に関して、ZrO 2 の誘電率 堆積したままのサンプルと比較して、膜は40%増加します。 ZrO 2 の誘電率の大幅な向上 図1cに示すように、マイクロ波アニーリング中の高度な結晶化に起因する可能性があります。上記のように、ZrO 2 の誘電率 立方晶相と正方晶相に結晶化すると、それぞれ36.8と46.6に増強できます[25]。したがって、誘電率向上のメカニズムをさらに調査するために、XRD測定を実行しました。図2bの挿入図に示されているように、1400 WでのMWA処理後、約30.7°にピークが存在し、ZrO 2 に正方晶相(111)が出現したことを示しています。 [32、33]。この正方晶相の存在は、誘電率を28.3から40以上に高める原因となります。

a Al 2 の概略構造 O 3 / ZrO 2 / Al 2 O 3 ベースのMIMコンデンサ。 b MWAチャンバーの概略構造。 c Al 2 のTEM写真 O 3 / ZrO 2 / Al 2 O 3 1400Wで5分間のMWAを備えたベースのMIMコンデンサ

a さまざまなサンプルの静電容量密度の累積確率プロット。挿入図は、バイアスに対する静電容量密度を示しています。 b ZrO 2 の誘電率の累積確率プロット さまざまなサンプルの場合。挿入図は、堆積したままのサンプルと1400WのサンプルのXRDパターンを示しています
MIMコンデンサは集積回路のバックエンドオブライン(BEOL)で製造されるため、プロセス温度は400°C未満である必要があります[34]。図3に示すように、MWAの温度曲線は、基板の最高温度が700、1050、および1400 Wでそれぞれ260、350、および400°Cであることを示しています。したがって、MWAはプロセス温度の観点からCMOSプロセスと互換性があります。さらに、前作[13]では、Al 2 O 3 (2 nm)/ ZrO 2 (20 nm)ベースのMIMコンデンサは、N 2 で420°Cで10分間の急速熱アニーリング(RTA)を受けました。 / H 2 ZrO 2 の周囲および結果として生じる誘電率 RTAの場合、アニーリング時間は420°Cで10分間一定に保たれたため、MWAと比較してサーマルバジェットがはるかに大きくなりました。 MWA [35、36]の場合、双極子分極が分子レベルでのエネルギー移動の最も重要なメカニズムであると考えられています。接触している材料の誘電特性が異なる場合、マイクロ波は誘電損失の高い材料と選択的に結合します。対照的に、従来のRTAは、熱を最も効率的に伝導性の高い材料に伝達します。
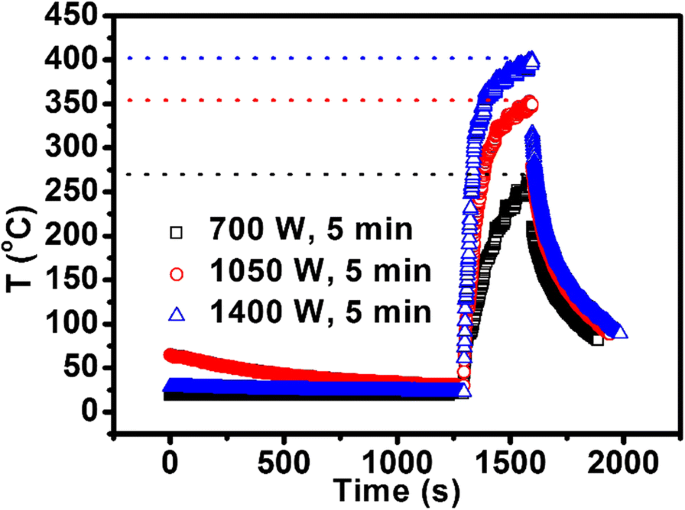
マイクロ波アニーリング中のさまざまなサンプルの基板温度の曲線
漏れ電流は、MIMコンデンサのもう1つの重要なパラメータです。図4aに示すように、明らかな転換点があり、異なる電子伝導メカニズムを示しているため、リーク電流曲線はすべてのサンプルで2つのセクションに分割できます。 MWA処理を施したサンプルは、堆積したままのサンプルに比べて、転換点に対応する電圧が小さくなっています。表1に、すべてのサンプルの±4Vでの漏れ電流密度を示します。たとえば、4 Vを例にとると、漏れ電流密度は1.06×10 -7 から増加します。 〜1.92×10 -5 A / cm 2 つまり、マイクロ波電力が0から1400 Wに増加すると、2次の振幅が増強されます。ZrO 2 の結晶化が高いためです。 フィルムでは、多数の粒界が現れて漏れ経路として機能するため、高電界下での電子伝導が促進されます。ただし、2 Vの動作電圧を考慮すると、リーク電流密度は1.23×10 -8 です。 および1.36×10 -8 A / cm 2 堆積したままのサンプルと1400Wのサンプルの場合。明らかに、マイクロ波アニーリングは低電界下での漏れ性能にほとんど影響を与えません。さらに、絶縁破壊電圧は I から抽出されました - V テストして図4bにプロットします。堆積したままのサンプルの場合、絶縁破壊電圧は50%の累積確率で約9.8Vです。 MWAを適用すると、絶縁破壊電圧は〜9 Vに低下します。この絶縁破壊電圧の低下は、ZrO 2 の変化に関連している可能性があります。 微細構造。
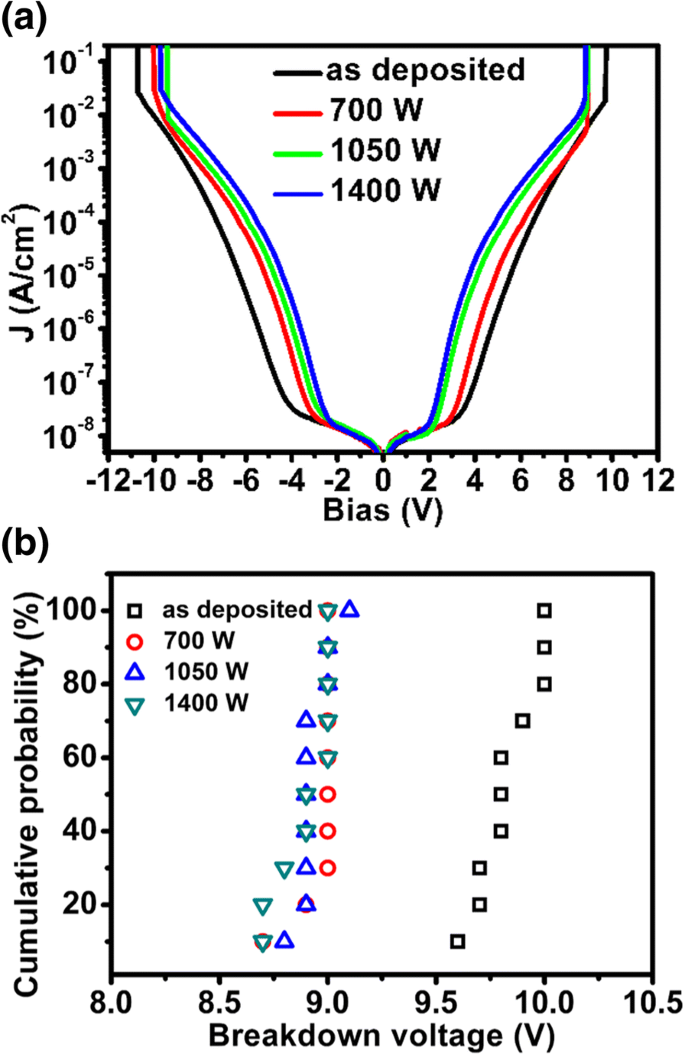
a 漏れ電流密度のプロット( J )vsバイアスと b さまざまなサンプルの絶縁破壊電圧の累積確率プロット
リーク電流に対するMWAの影響をさらに理解するために、MIMコンデンサの伝導メカニズムを調査します。 Al 2 に関する以前の調査に基づく O 3 (2 nm)/ ZrO 2 (20 nm)ベースのMIMコンデンサ[13、14]、高電界での支配的な伝導メカニズムは、電界支援トンネリング(FAT)として確認されました。トラップ関連のトンネリングであるFATの場合、電子は最初に絶縁体のトラップによって捕捉され、次に絶縁体の伝導帯に直接トンネリングします[37]。現在の作業では、Al 2 O 3 およびZrO 2 A / Z / AベースのMIMコンデンサの膜は同じ条件で堆積されたため、リーク電流はおそらくFATによっても支配的です。 FATモデルは次の式で表すことができます。 (1)[37]
$$ J ={AE} ^ 2 \ exp \ left(-\ frac {8 \ pi \ sqrt {2 {m} ^ {\ ast} q {\ varphi} _t ^ 3}} {3 hE} \ right) $$(1)ここで A は定数、 E は電界、 q は電荷、 m *は有効電子質量(約0.25 m )を表します 0 、ここで m 0 は自由電子質量)、 k はボルツマン定数、φです。 t はトラップを伝導帯から分離するエネルギー障壁であり、 h プランク定数です。
積層誘電体に関しては、誘電率と厚さが異なるため、各層に印加される電界は互いに異なります。したがって、スタック全体の平均電界を使用すると、伝導メカニズムについて説明する際に重大なエラーが発生します。結果として、ZrO 2 を横切る電界 レイヤーは正確に抽出する必要があります。 ZrO 2 全体の電界 3.125×10 7 です × V スタック 、2.5×10 7 × V スタック 、2.47×10 7 × V スタック 、および2.44×10 7 × V スタック ガウスの法則とキルヒホッフの電圧の法則[38、39]に従って、それぞれ、堆積されたままのサンプル、700 W、1050 W、および1400 Wのサンプルの場合:
$$ \ left \ {\ begin {array} {c} {k} _A {E} _A ={\ kappa} _Z {E} _Z \\ {} {d} _A {E} _A + {d} _Z {E } _Z ={V} _ {stack} \ end {array} \ right。 $$(2)ここで k A およびκ Z Al 2 の誘電率を表します O 3 およびZrO 2 、 それぞれ; E A および E Z Al 2 を横切る電界を示します O 3 およびZrO 2 、 それぞれ; d A および d Z Al 2 の厚さに等しい O 3 およびZrO 2 、 それぞれ;および V スタック スタックに印加される電圧です。したがって、Ln( J / E Z 2 )対1 / E Z は図5に任意にプロットされており、電子下部注入(図5aを参照)または電子上部注入(図5bを参照)の下で、各サンプルの高電界領域で直線フィッティングが達成されました。これは、FATメカニズムが高電界で支配的であることを意味します。抽出されたφ t は、電子ボトムインジェクション下の堆積したままのサンプル、700 W、1050 W、および1400 Wのサンプルでそれぞれ0.73、0.51、0.38、および0.35eVです。電子のトップインジェクションに関しては、対応するφ t はそれぞれ0.82、0.53、0.47、0.43eVです。したがって、いくつかの浅いトラップはMWAによって誘発されます。浅いトラップは、伝導帯の近くに追加の電子状態を導入する可能性のある粒界欠陥から生じると報告されています[40]。さらに、低磁場での伝導メカニズムは、トラップ支援トンネリング(TAT)である可能性が最も高いです。
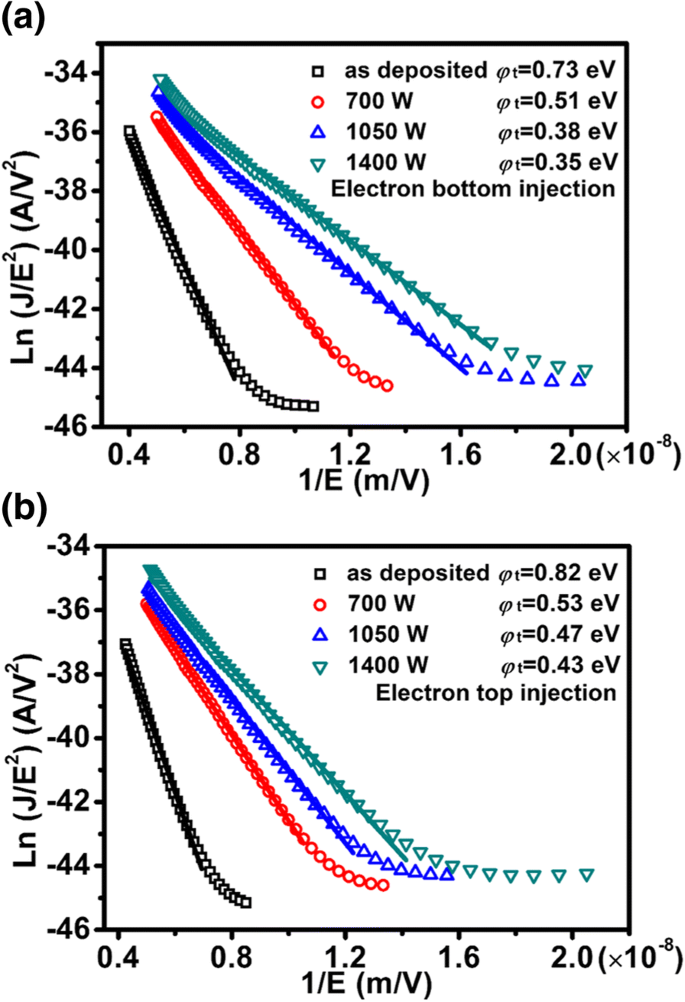
Lnのプロット( J / E 2 )vs 1 / E さまざまなサンプル用。 a 電子ボトムインジェクションと b 電子トップインジェクション
結論
原子層堆積Al 2 O 3 / ZrO 2 / Al 2 O 3 ナノスタックは、MIMコンデンサの絶縁体として使用されます。 1400 Wで5分間のMWAの効果により、静電容量密度は9.06 fF /μm 2 に増加します。 、静電容量の約23.4%が向上しました。 Al 2 の影響を切り離す O 3 、誘電率は1400 Wサンプルで41.9と推定されます(誘電率の約40%が増加)。このような誘電率の向上は、ZrO 2 の高い結晶化に起因します。 映画。さらに、基板温度が400°C未満であるため、MWAはBEOLプロセスと互換性があります。このより低い基板温度は、MWAの材料の選択的加熱に起因する可能性があります。 2 Vの動作電圧に関して、漏れ電流密度は1.23×10 -8 です。 および1.36×10 -8 A / cm 2 堆積したままのサンプルと1400Wのサンプルの場合。高電界における支配的な伝導メカニズムは、FATプロセスとして確認されています。低電界での漏れ電流は、TATによって決定される可能性があります。上記の事実に基づいて、マイクロ波アニーリングは、MIMコンデンサの誘電性能を向上させるためにCMOSプロセスで使用される有望な技術です。
略語
- A / Z / A:
-
Al 2 O 3 / ZrO 2 / Al 2 O 3
- ALD:
-
原子層堆積
- BEOL:
-
行のバックエンド
- C-V :
-
静電容量-電圧
- DRAM:
-
ダイナミックランダムアクセスメモリ
- FAT:
-
フィールド支援トンネリング
- ITRS:
-
半導体の国際技術ロードマップ
- I-V :
-
電流-電圧
- MIM:
-
金属-絶縁体-金属
- MWA:
-
マイクロ波アニーリング
- PECVD:
-
プラズマ化学気相成長法
- RF:
-
無線周波数
- RTA:
-
ラピッドサーマルアニーリング
- TAT:
-
トラップ支援トンネリング
- TEM:
-
透過型電子顕微鏡
ナノマテリアル
- AVXは、高性能マイクロ波およびRFアプリケーション向けの新しい超小型薄膜伝送線路コンデンサをリリースします
- 液体中の2D原子結晶上の原子のイメージング
- 原子スケールで画像化された海洋炭素
- コンプライアンスフリーのZrO2 / ZrO2 − x / ZrO2抵抗変化型メモリと制御可能な界面マルチステートスイッチング動作
- フェニルトリメトキシシランで修飾されたアルミナナノ粒子をベースにしたAl2O3:SiOCナノコンポジットの形成と発光特性
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 誘電体ナノプリズムに基づくプラズモンセンサー
- 単一のCdSSeナノベルトに基づく波長制御光検出器
- InP / ZnS量子ドット膜の光学特性に及ぼすポストサーマルアニーリングの影響
- インメモリアプリケーションを計算するための低動作電圧の原子層堆積HfAlOxベースのRRAM
- Al2O3ナノ流体の熱拡散率に対する変調レーザー照射の光熱効果



