ゲルマニウム負容量電界効果トランジスタ:Hf1-xZrxO2のZr組成の影響
要約
Hf 1- x のさまざまなZr組成を持つゲルマニウム(Ge)負容量電界効果トランジスタ(NCFET) Zr x O 2 ( x =0.33、0.48、および0.67)が作成され、特性評価されます。各Zr組成について、NCFETは、NC効果によって引き起こされるサブスレッショルドスイング(SS)のいくつかのポイントで突然の低下を示します。駆動電流 I DS アニーリング温度の上昇とともに増加します。これは、ソース/ドレイン抵抗の減少とキャリア移動度の向上によるものです。急勾配のSSポイントは、NC効果によって誘導されることを証明する、複数のDCスイープ測定を通じて再現性と安定性があります。ゲート電圧の値 V GS 急勾配のSSに対応する一貫性があり、時計回りに I DS - V GS 複数のDCスイープによって維持されます。固定アニーリング温度で、Hf 0.52 のNCデバイス Zr 0.48 O 2 より高い I を達成します DS しかし、他の組成物と比較してヒステリシスが大きくなっています。 Hf 0.67 のNCFET Zr 0.33 O 2 ヒステリシスのない曲線と高い I で優れた性能を得ることができます DS 。
背景
ゲートスタックに強誘電体膜が挿入された強誘電体負容量電界効果トランジスタ(NCFET)は、従来の金属のサブスレッショルドスイング(SS)の基本的な制限を克服できるため、低電力散逸アプリケーションの有望な候補です。酸化物-半導体電界効果トランジスタ(MOSFET)[1]。 NCFETの負の静電容量(NC)現象は、シリコン(Si)[2、3]、ゲルマニウム(Ge)[4]、ゲルマニウム-スズ(GeSn)[5]、III–Vなどのさまざまなチャネル材料で広く研究されています。 [6]、および2Dマテリアル[7]。また、NC特性は、BiFeO 3 などのさまざまな強誘電体を備えたNCFETで実証されています。 [8]、PbZrTiO 3 (PZT)[9]、PVDF [10]、およびHf 1- x Zr x O 2 [11]。他の強誘電体と比較して、Hf 1- x Zr x O 2 CMOS統合と互換性があるという利点があります。実験的研究により、NCFETの電気的性能は、Hf 1- x の厚さと面積を変えることで最適化できることが示されています。 Zr x O 2 、MOS容量( C )間のマッチングに影響します MOS )および強誘電体コンデンサ( C FE )[12、13]。 Hf 1- x のZr組成が予想されます Zr x O 2 また、Hf 1- x の強誘電特性を決定するため、NCFETの性能にも大きな影響を与えます。 Zr x O 2 。ただし、NCFETの電気的特性に対するZr組成の影響に関する詳細な研究はまだ不足しています。
この論文では、GeNCFETの性能に及ぼすアニーリング温度とZr組成の影響を包括的に研究します。
メソッド
Hf 1- x で異なるZr組成を持つGepチャネルNCFETを製造するための主要なプロセスステップ Zr x O 2 図1(a)に示します。プレゲート洗浄後、n-Ge(001)基板を原子層堆積(ALD)チャンバーにロードしました。薄いAl 2 O 3 (25サイクル)フィルムが堆積され、続いてO 3 不動態化。次に、Hf 1- x Zr x O 2 フィルム(x =0.33、0.48、0.67)は、[(CH 3 ) 2 N] 4 Hf(TDMAHf)、[(CH 3 ) 2 N] 4 Zr(TDMAZr)およびH 2 それぞれHf、Zr、およびO前駆体としてのO。その後、反応性スパッタリングを使用してTaN金属ゲートを堆積させた。ゲートのパターニングとエッチングの後、ホウ素イオン(B + )は、20keVのエネルギーと1×10 15 の線量でソース/ドレイン(S / D)領域に注入されました。 cm −2 。非自己整合S / D金属は、リフトオフプロセスによって形成されました。最後に、急速熱アニーリング(RTA)を、ドーパントの活性化、S / Dメタライゼーション、およびHf 1- x の結晶化のためにさまざまな温度で実行しました。 Zr x O 2 映画。 Al 2 を使用したGe制御pMOSFET O 3 / HfO 2 スタックも作成されました。

( a )Hf 1 -x で異なるZr組成を持つGeNCFETを製造するための主要なプロセスステップ Zr x O 2 強誘電体。 ( b )製造されたNCトランジスタの概略図。 ( c )7 nmH 0.52 を示すNCデバイスのゲートスタックのTEM画像 Zr 0.48 O 2 層と2nmAl 2 O 3 レイヤー
図1(b)は、製造されたNCFETの概略図を示しています。図1(c)の高分解能透過型電子顕微鏡(HRTEM)画像は、Hf 0.52 のデバイスのGeチャネル上のゲートスタックを示しています。 Zr 0.48 O 2 強誘電体。 Al 2 の厚さ O 3 およびHf 0.52 Zr 0.48 O 2 層はそれぞれ2nmと7nmです。
Hf 1- x の化学量論を確認する Zr x O 2 、X線光電子分光法(XPS)測定を行った。図2(a)と(b)は、Hf 4f を示しています。 およびZr 3d それぞれ、Hf 0.67 の光電子コアレベルスペクトル Zr 0.33 O 2 、Hf 0.52 Zr 0.48 O 2 、およびHf 0.33 Zr 0.67 O 2 映画。材料組成は、ピークの面積比と対応する感度係数に基づいて計算されました。 Zr 3d の2つのピーク 5/2 およびZr 3d 3/2 スピン軌道分裂は2.4eVで、これはRefsで構成されています。 [14、15]。 Hf 1- x のZr組成の増分 Zr x O 2 、Zr 3d 、およびHf 4f ピークは低エネルギー方向にシフトします。

( a )Hf 4f および( b )Zr 3d Hf 1- x のコアレベルスペクトル Zr x O 2 異なるZr組成のサンプル
Hf 1- x の強誘電特性 Zr x O 2 映画( x =0.33、0.48、および0.66)は、分極 P によって特徴付けられました。 対駆動電圧 V ヒステリシスループ測定。 P - V ループは元のデバイスで記録されました。図3は、 P の曲線を示しています。 対 V TaN / Hf 1- x の場合 Zr x O 2 (10 nm)/一連の駆動電圧のTaNサンプル。アニーリング後の温度が500°Cから550°Cに上昇すると、 P - V Hf 1- x の曲線 Zr x O 2 サブループ状態で飽和する傾向があります。 Zr組成が増加すると、膜の残留分極が明らかに改善され、ゼロバイアスでのヒステリシスループの薄化が観察されます。これは、現象論的には、重ね合わせた反強誘電性のような特性として最もよく説明できます[16、17]。
>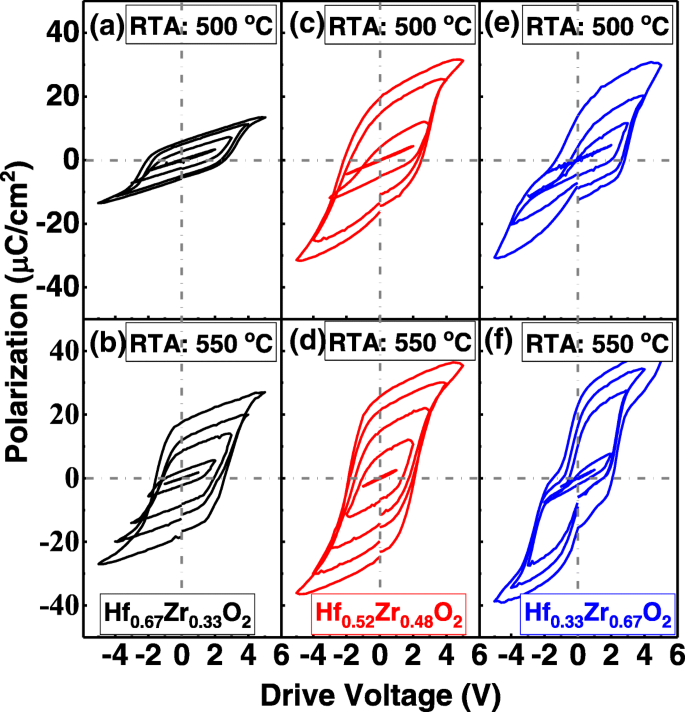
Hf 1-x の測定されたP-V曲線 500および550 o でアニールされた異なるZr組成のZrxO2フィルム C。( a )および( b )はHf 0.67 です Zr 0.33 O 2 500および550でアニールされたフィルム o それぞれC。 ( c )および( d )はHf 0.52 です Zr 0.48 O 2 500および550でアニールされたフィルム o それぞれC。 ( e )および( f )はHf 0.33 です Zr 0.67 O 2 500および550でアニールされたフィルム o それぞれC。アニーリング後の温度が500から550に上昇すると o C、Hf 1-x のP-V曲線 Zr x O 2 サブループ状態で飽和する傾向があります。 Zr組成が増加すると、強誘電性から反強誘電性のような挙動への進化が観察されます
結果と考察
図4(a)は、Hf 0.52 のGeNCFETの測定された伝達特性を示しています。 Zr 0.48 O 2 異なるアニーリング温度の強誘電体とAl 2 の制御デバイス O 3 / HfO 2 スタック誘電体。制御装置は500°Cでアニールされました。すべてのデバイスのゲート長は L G 2μmの。順方向および逆方向のスイープは、それぞれ白抜きの記号と実線の記号で示されます。 NCFETは、制御デバイスと比較してはるかに高い駆動電流を持っています。アニーリング温度が450°Cから550°Cに上昇すると、しきい値電圧 V TH NCデバイスの数が正の V にシフトします GS 方向。 NCFETは小さなヒステリシスを示しますが、RTA温度の上昇に伴って無視できるようになります。トラップ効果もヒステリシスにつながりますが、それは反時計回りの I を生成します DS - V GS 強誘電体スイッチングによって引き起こされる結果とは反対のループ[18]。ポイントSS対私 DS 図4(b)の曲線は、NCトランジスタがSSのいくつかのポイントで急激な低下を示し、 I の急激な変化に対応していることを示しています。 DS NC効果によって誘発される[19]。 NCFETは、制御装置と比較して改善されたSS特性を達成することが観察されます。デバイスの突然の降下点は、さまざまなアニーリング温度で一貫していることがわかりました。測定された I DS - V DS Hf 0.52 のNCFETの曲線 Zr 0.48 O 2 さまざまな温度でアニールされた強誘電体を図4(c)に示します。 私 DS - V DS NCトランジスタの曲線は明らかなNDR現象を示しており、これはNCトランジスタの典型的な特性です[20、21、22、23]。図4(d)は、 I のプロットです。 DS のGeNCFETとHf 0.52 Zr 0.48 O 2 V でそれぞれ450、500、550°Cでアニールされた強誘電体層 DS =− 0.05 Vおよび− 0.5 V、および| V GS − V TH | =1.0V。ここでは、 V TH V として定義されます GS I で DS の10 -7 A /μm。 私 DS RTA温度の上昇とともに増加します。これは、ソース/ドレイン抵抗の低下と、より高いアニーリング温度でのキャリア移動度の向上によるものです。
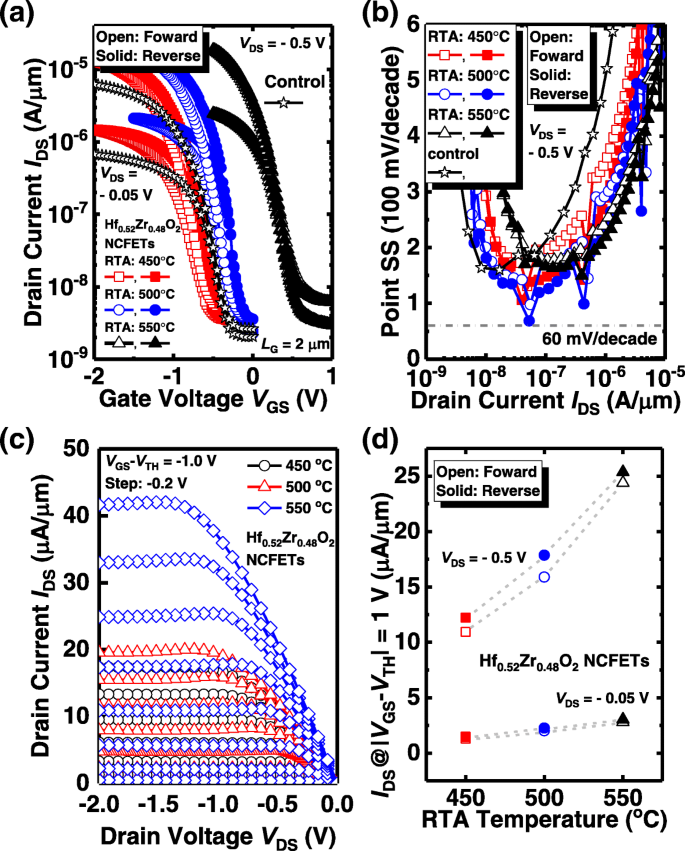
( a )測定された I DS - V GS Hf 0.52 のNCFETの曲線 Zr 0.48 O 2 強誘電性および制御装置。 ( b )ポイントSSと I DS 制御MOSFETと比較してNCFETのSSが急勾配であることを示す曲線。 ( c )私 DS - V DS 典型的なNDR現象を示すNCFETの曲線。 ( d ) I の比較 DS 1Vのゲートオーバードライブでさまざまな温度でアニールされたNCFETの場合
Hf 0.52 に加えて Zr 0.48 O 2 強誘電体トランジスタでは、Hf 0.33 を使用したGeNCトランジスタの電気的特性も調査します。 Zr 0.67 O 2 強誘電体。図5(a)は、 I を示しています。 DS - V GS Hf 0.33 のデバイスの特性 Zr 0.67 O 2 V での異なるアニーリング温度で DS =− 0.05 Vおよび−0.5V。Hf 0.52 と比較 Zr 0.48 O 2 NCトランジスタでは、さらに小さなヒステリシスが得られます。 Hf 0.52 に似ています Zr 0.48 O 2 NCトランジスタ、アニーリング温度が450から550°Cに上昇すると、 V TH V での順方向掃引で、デバイスの電圧が− 0.63Vから0.51Vに増加します。 DS =− 0.05 V. I の関数としてのポイントSS DS Hf 0.33 の特性 Zr 0.67 O 2 強誘電性NCFETを図5(b)に示します。さらに、450°Cおよび500°Cのアニーリング温度のデバイスでは、550°Cのアニーリングトランジスタと比較して、SSの急激な低下がより顕著になります。異なるアニーリング温度での急激な降下点は、同じゲート電圧で発生します。図5(c)は、順方向と逆方向の I を示しています DS Hf 0.33 の Zr 0.67 O 2 V のNCFET DS =− 0.05 Vおよび− 0.5 V、および| V GS – V TH | =1.0 V.順方向または逆方向のスイープのいずれの場合でも、 I DS アニーリング温度とともに増加します。これは、Hf 0.52 の特性と一致しています。 Zr 0.48 O 2 デバイス。
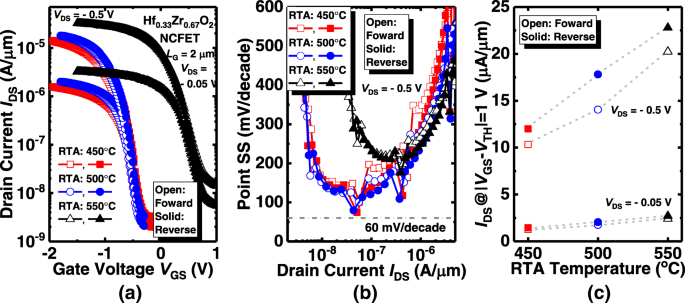
( a )Hf 0.33 の測定された伝達特性 Zr 0.67 O 2 NC Ge pFETは450〜550°Cでアニーリングされました。 ( b ) I の関数としてのポイントSS DS Hf 0.33 の場合 Zr 0.67 O 2 デバイス。 ( c )私 DS 1Vのゲートオーバードライブでアニーリング温度が異なる強誘電体NCトランジスタの場合
また、Zr組成が小さいGeNCFETの電気的性能についても調査します。 Hf 0.67 の伝達特性 Zr 0.33 O 2 さまざまなアニーリング温度でアニーリングされたNCFETを図6(a)に示します。ヒステリシス現象は見られません。 Hf 0.33 との比較 Zr 0.67 O 2 およびHf 0.52 Zr 0.48 O 2 デバイス、 V TH アニーリング温度の変化によって引き起こされるシフトは、Hf 0.67 ではそれほど顕著ではありません。 Zr 0.33 O 2 NCFET。ポイントSS対私 DS 図6(b)の曲線は、Hf 0.67 Zr 0.33 O 2 NCトランジスタは V でNCトランジスタのSSのいくつかの点で急激な低下を示します DS =− 0.05 V.図6(c)は、 I を示しています。 DS Hf 0.67 の Zr 0.33 O 2 V で450°C、500°C、および550°CでアニールされたGeNCFET DS =− 0.05 Vおよび− 0.5 V、および| V GS – V TH | =1.0 V.同様に、 I DS RTAの温度が上がると向上します。
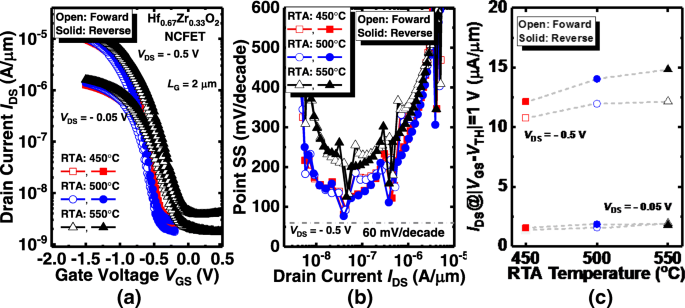
( a )測定された I DS - V GS Hf 0.67 の Zr 0.33 O 2 450°C、500°C、および550°CでアニーリングされたNC GepFET。 ( b )ポイントSSとI DS デバイスの特性。 ( c )私 DS 1Vのゲートオーバードライブでアニーリング温度が異なる強誘電体NCトランジスタの場合
Hf 0.52 の強誘電体層によって引き起こされるNC効果の安定性 Zr 0.48 O 2 NCFETは、複数のDCスイープ測定によって検証されました。測定された I DS - V GS DCスイープの100サイクルにわたる曲線を図7(a)に示します。 V の値がわかります GS 急勾配のSSに対応する一貫性があります。さらに、時計回りの I-V ループは、複数のDCスイープによって維持されます。急勾配のSSポイントは、複数のDCスイープを通じて再現可能で安定しており、NC効果によって誘導されることをさらに証明しています。図7(b)は、スイープサイクル数全体での最適なポイントSSと駆動電流を示しています。図7(c)は、DC掃引サイクル数の関数としてのヒステリシス特性を示しています。安定した I-V 〜82mVのヒステリシスウィンドウが見られます。
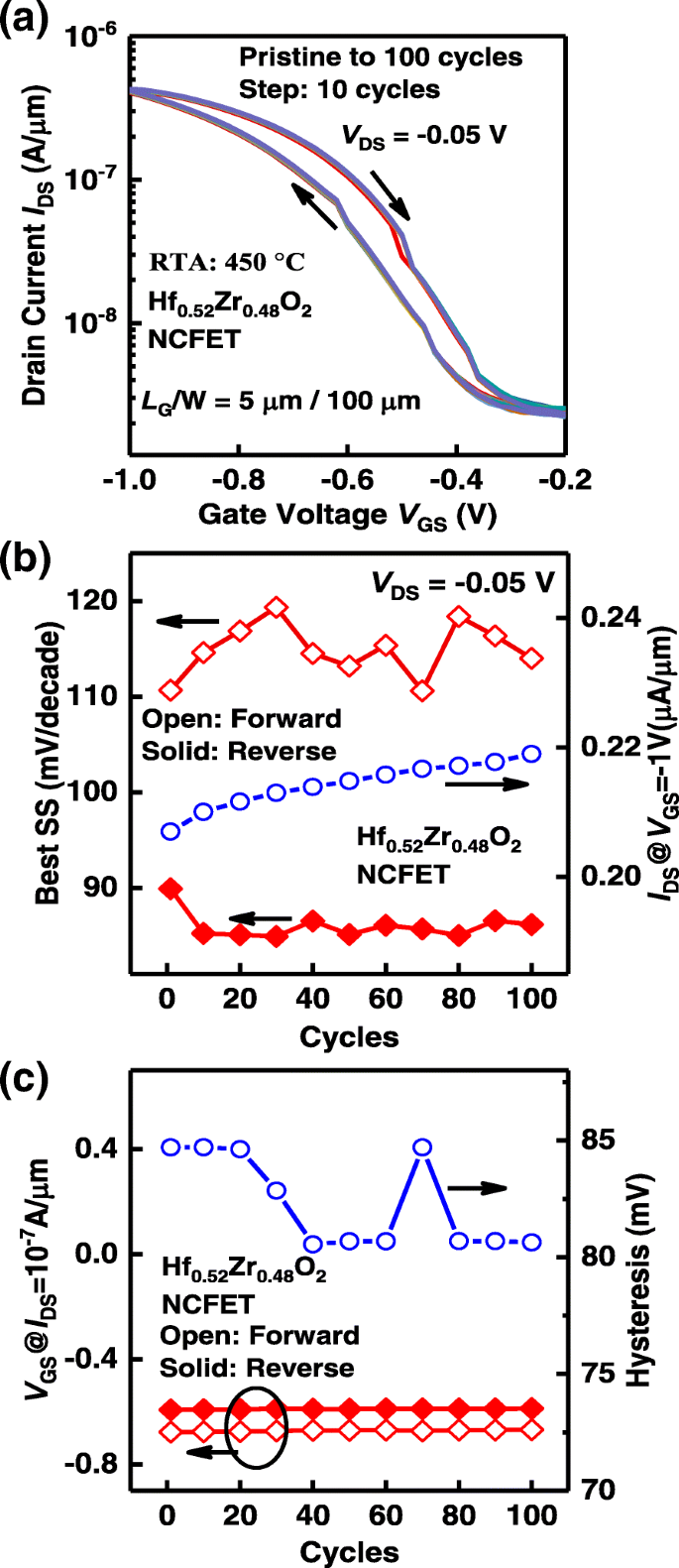
( a )測定された I DS - V GS Hf 0.52 の曲線 Zr 0.48 O 2 DCスイープの100サイクルにわたるNCGepFET。 ( b )ベストポイントSSと I DS 対サイクル数。 ( c )DC掃引サイクル数の関数としてのヒステリシス特性
Hf 1- x の異なるZr組成を持つGeNCFETのヒステリシスと駆動電流特性を要約します。 Zr x O 2 図8に示します。図8(a)に示すように、 x のデバイスのヒステリシス値は70、148、および106mVです。 = V で、それぞれ0.33、0.48、0.67 DS – 0.5 Vの。組成が0.33から0.48に増加すると、NCデバイスのヒステリシスが大幅に増加します。 Zr組成がさらに増加すると、ヒステリシスは急速に減少します。 私 DS 450°CでアニールされたNCFETの数は、 V で図8(b)にプロットされています。 DS =− 0 。 5Vおよび V GS − V TH =− 1 。 0 V.オープンとソリッドは、それぞれ順方向と逆方向のスイープを表します。 Hf 0.52 のNCデバイス Zr 0.48 O 2 最高の I を達成 DS 、しかしそのヒステリシスは深刻です。 Hf 0.67 のNCFET Zr 0.33 O 2 ヒステリシスのない曲線と高い I で優れた性能を得ることができます DS 。 Zr組成が増加すると、強誘電体コンデンサ C fe (=0.3849 * P r /( E c * t fe )[24]) P の増加とともに増加します r 、そしてその間、MOS容量( C MOS )HZOフィルムの誘電率が高くなるため、同様に上昇します。 私 DS ヒステリシスは| C によって決定されます fe |および C MOS トランジスタの。 Zr組成が0.33から0.48に増加すると、| C が増加します。 fe | C よりも遅いと推測されます MOS 、ヒステリシスの拡大につながります。それにもかかわらず、より大きな C MOS より高い I を生成します DS 。 Zr組成がさらに増加すると、| C が増加します。 fe | C よりも高速です MOS 、| C を提供する可能性があります fe | ≥ C MOS 、NCFETのヒステリシスを低減します。
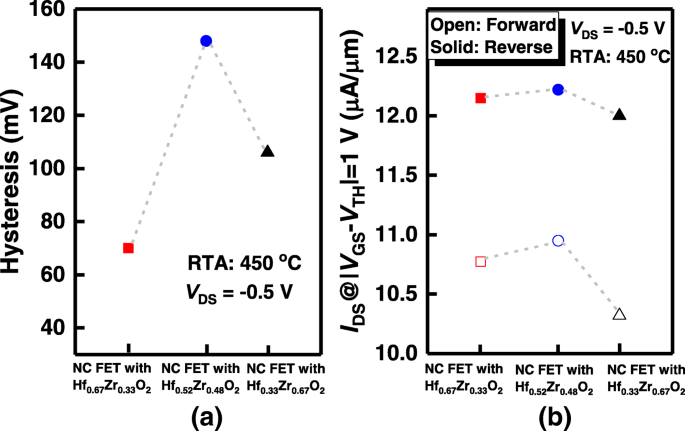
( a の統計プロット )ヒステリシスと( b )私 DS GeNCFETとHf 1- x の比較 Zr x O 2 ( x =0.33、0.48、および0.67)
結論
Hf 1 -x におけるアニーリング温度とZr組成の影響 Zr x O 2 GeNCFETの電気的性能に関する研究が実験的に行われています。 Hf 1- x の化学量論と強誘電特性 Zr x O 2 XPSおよび P-V によって確認されました それぞれ測定。 NCFETは、急勾配のポイントSSと改善された I を示します DS NC効果により、制御装置と比較して。 V TH および私 DS Hf 1 -x の Zr x O 2 NCFETはアニーリング温度の影響を大きく受けます。複数のDC掃引測定は、強誘電体層によって誘発されるNC効果の安定性がNCFETで達成されることを示しています。 Hf 0.67 Zr 0.33 O 2 NCFETは、Zr組成の高いデバイスよりもヒステリシスのない特性を簡単に実現できます。
略語
- Al 2 O 3 :
-
酸化アルミニウム
- ALD:
-
原子層堆積
- BF 2 + :
-
フッ化ホウ素イオン
- DC:
-
直流
- Ge:
-
ゲルマニウム
- GeO x :
-
酸化ゲルマニウム
- HF:
-
フッ化水素酸
- HfO 2 :
-
二酸化ハフニウム
- HRTEM:
-
高分解能透過型電子顕微鏡
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- NC:
-
負の静電容量
- Ni:
-
ニッケル
- SS:
-
サブスレッショルドスイング
- TaN:
-
窒化タンタル
- TDMAHf:
-
テトラキス(ジメチルアミド)ハフニウム
- TDMAZr:
-
テトラキス(ジメチルアミド)ジルコニウム
ナノマテリアル



