SiNxパッシベーション層にフッ素イオンを注入した高絶縁破壊電圧と低動的ON抵抗AlGaN / GaN HEMT
要約
この研究では、高い絶縁破壊電圧(BV)と低い動的ON抵抗( R )を提案し、実験的に実証しました。 ON、D )厚いSiN x にフッ素イオンを注入することによるAlGaN / GaN高電子移動度トランジスタ(HEMT) ゲート電極とドレイン電極の間のパッシベーション層。薄いAlGaNバリア層へのフッ素イオン注入の代わりに、厚いパッシベーション層へのフッ素イオン注入の場合、ピーク位置と空孔分布は二次元電子ガス(2DEG)チャネルから遠く離れており、直接を効果的に抑制します。電流(DC)静的およびパルス動的特性の低下。不動態化層のフッ素イオンも空乏領域を拡張し、ゲートとドレイン間の平均電界(電界)強度を増加させ、BVを向上させます。提案されたHEMTのBVは、同じ寸法パラメータを持つ従来のAlGaN / GaN HEMT(Conv。HEMT)の680Vから803Vに増加します。測定された R ON、D 提案されたHEMTのは、100 Vの高いドレイン静止バイアスで23%しか増加しませんが、 R ON、D 薄いAlGaNバリア層にフッ素イオンを注入したHEMTの比率は98%増加します。
背景
ここ数十年で、GaN、金属酸化物、2D材料などの新しい半導体材料は、その優れた材料とデバイスの特性により、エネルギー変換と貯蔵効率をさらに高めるために広く研究されてきました[1,2,3,4、 5,6,7,8]。中でも、GaNベースのAlGaN / GaN高電子移動度トランジスタ(HEMT)は、臨界破壊電界が高く、電子移動度が高いため、高出力、高周波、低損失のアプリケーションに適しています[9、10、11、12、13 、14]。絶縁破壊電圧(BV)は最も重要な設計目標の1つであり、報告された値はまだ理論上の限界をはるかに下回っています[15、16]。したがって、特にデバイスサイズを大きくすることを犠牲にしてではなく、BVをさらに改善することが非常に重要です。フィールドプレート[17、18、19]、フッ素イオン注入[20、21、22]、埋め込みゲートエッジ終端[23、24]など、BVを改善するためのいくつかの終端技術が提案されています。薄いAlGaNバリア層(FBL)に注入されたフッ素イオン[22]は、追加の寄生容量を誘発することなく、単純な製造プロセスを備えています。ただし、フッ素プロファイルと空孔分布のピーク位置は2次元電子ガス(2DEG)チャネルの近くにあるため、必然的に静的および動的な特性が大幅に低下します。
この作業では、高い絶縁破壊電圧と低い動的ON抵抗( R ON、D )SiN x にフッ素イオン注入を施したAlGaN / GaN HEMT パッシベーション層(FPL HEMT)を実験的に調べます。薄いAlGaNバリア層へのフッ素イオン注入の場合とは異なり、厚いパッシベーション層へのフッ素イオン注入は、フッ素のピーク位置と空孔分布を2DEGチャネルから遠くに保つことができるため、静的および動的な特性劣化を効果的に抑制できます。 。終端技術としてのパッシベーション層のフッ素イオンは、表面電界(E-field)分布を最適化するためにも使用され、BVの向上を実現します。結論として、FPLHEMTは優れた静的特性と動的特性を示します。
作成方法
図1は、FPL HEMT、FBL HEMT、およびConvの3次元概略図です。それぞれHEMT。すべてのデバイスはゲート長 L を備えています G 2.5μm、ゲート-ソース間距離 L GS 1.5μm、ゲート-ドレイン距離 L GD 10μmの。 FPLHEMTの製造に使用されるエピタキシャルAlGaN / GaNヘテロ構造は、有機金属化学蒸着(MOCVD)によって6インチ(111)シリコン基板上に成長しました。エピタキシャル層は、2 nm GaNキャップ、23 nm Al 0.25 で構成されています。 Ga 0.75 Nバリア、1 nm AlN中間層、150 nm GaNチャネル、および3.5μmGaNバッファ。 2DEGのホール効果測定密度と移動度は9.5×10
12
でした。 cm
−2
および1500cm
2
それぞれ/ Vs。提案されたFPLHEMTは、高電力Cl 2 によって実装されたメサ分離から始まりました。 / BCl 3 ベースの誘導結合プラズマ(ICP)エッチング。次に、厚さ40 nmの低圧化学蒸着(LPCVD)SiN x 層は、NH 3 を使用して780°C / 300mTorrで堆積されました。 280sccmのフローとSiH 2 Cl 2 70 sccmの流量、3.7 nm / minの堆積速度をもたらします。屈折率はエリプソメーターで1.978と測定され、SiN x のN / Si比は 1.31 [25]です。 LPCVD SiN x の結晶化度 はアモルファスであり、高分解能透過型電子顕微鏡(HR-TEM)顕微鏡写真で確認できます(図1aの挿入図を参照)。 SF 6 でソースとドレインのコンタクトウィンドウを開いた後 プラズマドライエッチングでは、Ti / Al / Ni / Au(20/150/45/55 nm)オーミックコンタクトが堆積され、N 2 中で890°Cで30秒間アニールされました。 アンビエント。線形伝送線路法により、1Ωmmの接触抵抗と400Ω/平方のシート抵抗を抽出しました。次に、ゲート金属電極は、Ni / Au(50 nm / 150 nm)堆積およびリフトオフプロセスによって形成されます。次に、AZ5214フォトレジストでフッ素イオン注入窓(窓の長さ=3μm)を形成し、SENNV-GSD-HEイオン注入装置で10keVのエネルギーで1×10
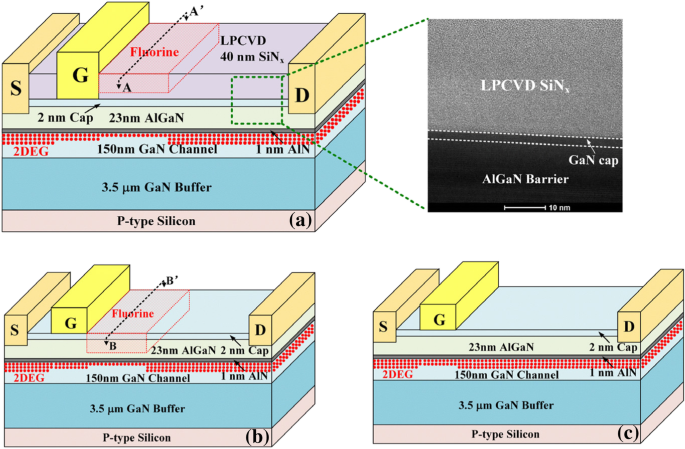
a の3次元概略図 FPL HEMT(挿入図:LPCVD SiN x のHR-TEM顕微鏡写真 )、 b FBL HEMT、および c コンバージョンHEMT
結果と考察
図2は、フッ素イオン濃度の測定された二次イオン質量分析(SIMS)プロファイルと、カットラインに沿ったTRIMによるシミュレートされた空孔濃度を示しています。(a) A-A ' FPL HEMTおよび(b) B-B ' それぞれFBLHEMTの同じエネルギーと量のフッ素イオン注入で、表面から測定されたピーク位置とフッ素プロファイルの最大濃度は、2つの構造でほぼ同じです。薄いAlGaNバリア層へのフッ素イオン注入の場合、フッ素によって誘発された空孔は2DEGチャネル領域にまで及びます。材料ごとに結合エネルギーが異なるため、空孔濃度の分布は各界面で不連続になります[27]。ただし、厚いSiN x へのフッ素イオン注入の場合 パッシベーション層、空孔分布はSiN x 内にあります パッシベーション層であり、2DEGチャネルから遠く離れています。イオン注入によって誘発された空孔は2DEGチャネルをトラップし、空孔分布が2DEGに近い場合は2DEGを簡単にトラップできます[28]。結論として、厚いSiN x へのフッ素イオン注入 パッシベーション層は、2DEGチャネルへのイオン注入の影響を大幅に低減し、静的および動的な特性劣化を効果的に抑制することができます。

切断線に沿ったTRIMによるフッ素イオン濃度の測定されたSIMSプロファイルとシミュレートされた空孔濃度。 a A-A '。 b B-B '
図3は、測定された I-V を示しています。 伝達特性と直流(DC)出力特性。コンバージョンと比較してHEMT、FPLHEMTとFBLHEMTの両方が I の減少を示しています DS 静的ON抵抗の増加( R オン )、フッ素イオンがドリフト領域で2DEGの補助的な枯渇を引き起こし、2DEG密度を低下させるためです[29]。さらに、イオン注入によって2DEGの移動度も低下します。 FPLおよびFBLHEMTの2DEG移動度を測定したホール効果は228cm 2 です。 / Vsおよび203cm 2 それぞれ、イオン注入後の/Vs。同じ線量のフッ素イオンにより、出力特性と R オン FPLHEMTとFBLHEMTの比率は、低いドレイン電圧( V など)でほぼ同じです。 DS <3 V)。ただし、 V の場合 DS > 3 V、FBL HEMTで飽和ドレイン電流の崩壊が発生します。これは、フッ素の空孔プロファイルが2DEGチャネル領域にまで及ぶため、ドレイン電圧が臨界よりも大きい場合に、フッ素によって誘発されるこれらの深いレベルの空孔によって2DEGが簡単にトラップされる可能性があるためです。ドレイン電圧(例: V DS > 3 V)[30]、それによりドレイン電流が減少します。 FPL HEMTの空孔分布は2DEGチャネルから遠く離れているため、飽和ドレイン電流の崩壊を効果的に抑制します。

測定された a I-V 伝達特性、および b 3つのHEMTのDC出力特性
図4は、測定された I-V を示しています。 ブロッキング状態での特性とシミュレートされた表面電界分布。 FPL / FBL / ConvのBV。 HEMTはそれぞれ803/746 / 680Vです。 BVは、ドレイン電流でのドレイン-ソース間電圧( I )として定義されます。 DS ) V で1μA/ mm GS =− 4 V.終端技術としてのゲートとドレイン間のフッ素イオンは、ゲートエッジの電界ピークを低減し、イオン注入領域の終わりに新しい電界ピークを引き起こします。したがって、FPLHEMTとFBL HEMTは、Convよりも均一な表面電界分布と高いBVを実現します。 HEMT。 FPL HEMTと比較して、FBL HEMTは、フッ素イオンプロファイルが2DEGチャネルに近いため、電界変調効果が強化されています。ただし、FBL HEMTの場合、イオン注入は必然的にAlGaNバリアに追加の損傷を引き起こし[31、32]、ゲートバリア層-2DEG の連続的なゲートリーク電流経路につながります。;したがって、FBLHMETのBVはFPLHEMTのBVよりもわずかに小さくなります。

a 測定されたオフ状態の I-V ゲート電圧が-4Vの特性で、基板をフロート状態に保ちます。 b V でシミュレートされた表面電界分布 DS =150 V
パルス I DS - V DS 動的ON抵抗( R )の動作を特徴づけるために、低速スイッチングでの測定[33]が実行されました。 ON、D )製造されたAlGaN / GaNHEMTの。図5aは、パルス I 中の応力電圧の印加を示す概略図です。 DS - V DS 測定。パルス I-V 測定では、各 I-V の前に、GaNHEMTのゲート電極とドレイン電極に短い電圧パルスを印加しました。 デバイスがオフ状態にあることを確認するための測定。パルス幅は3ms、周期は5msです。図5b–dは、( V GS0 、 V DS0 )(0 V、0 V)および(0 V、100 V)の。コンバージョンの動的ON抵抗がわずかに低下(12.3%)していることがわかります。 HEMT、フッ素イオン注入プロセスがないため。 FBL HEMTと比較して、FPLHEMTは動的ON抵抗の劣化が少ないです。パッシベーション層のおかげで、空孔分布は2DEGチャネルから遠く離れており、パッシベーション層内に配置されているため、FPLHEMTでの電荷トラップが抑制されます。図6は、 R の比率値をまとめたものです。 ON、D / R オン ( V の下の3つのHEMTの場合 GS0 、 V DS0 )20 Vのステップで(0 V、0 V)および(0 V、100 V)から。FBLHEMTの場合、測定された R ON、D ( V での静的なものの98%ですでに増加しています GS0 、 V DS0 )(0 V、0 V)と(0 V、100 V)の、 R ON、D FPL HEMTの値は、100 Vの高いドレイン静止バイアスで23%しか増加しません。
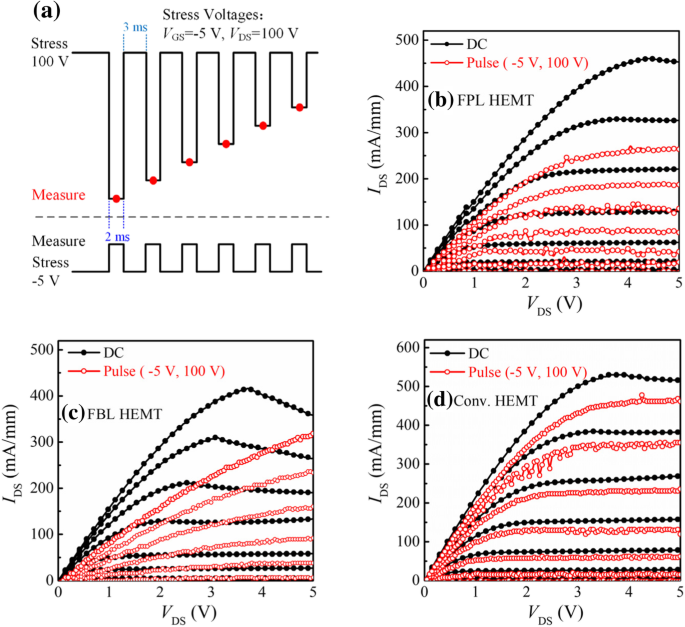
a パルス I 中の応力電圧の印加を示す概略図 DS - V DS 測定。パルス I DS - V DS b で作製したAlGaN / GaNHEMTの特性 FPL HEMT、 c FBL HEMT、および d コンバージョンHEMT( V GS =− 4〜0 V;ステップ:0.5 V)
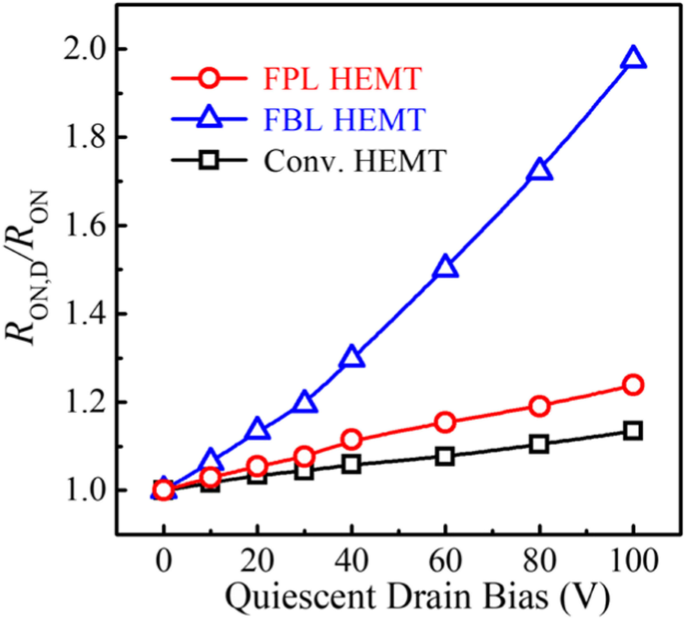
R の比率 ON、D / R オン 異なる静止ドレインバイアスポイントで製造されたHEMTの場合。パルス幅と周期はそれぞれ3msと5msです
結論
結論として、我々は、高い絶縁破壊電圧と低い動的ON抵抗を備えた新しいAlGaN / GaNHEMTを提案しました。厚いSiN x へのフッ素イオン注入が特徴です。 パッシベーション層。パッシベーション層へのフッ素イオン注入は、電気的特性の劣化を効果的に抑制することができます。動的ON抵抗は、オフ状態 V 後の静的ON抵抗のわずか1.23倍です。 DS FBL HEMTの1.98倍であるのに対し、100Vの応力。さらに、パッシベーション層のフッ素イオンもEファイルの分布を変調し、空乏領域を広げます。したがって、提案されたHEMTのBVは、従来のAlGaN / GaNHEMTの680Vから803Vに増加します。
データと資料の可用性
この調査中に生成または分析されたすべてのデータは、この公開された記事に含まれています。
略語
- 2DEG:
-
二次元電子ガス
- HEMT:
-
高電子移動度トランジスタ
- ICP:
-
誘導結合プラズマ
- LPCVD:
-
低圧化学蒸着
- MOCVD:
-
有機金属化学蒸着
- SIMS:
-
二次イオン質量分析
- TEM:
-
透過型電子顕微鏡
ナノマテリアル
- 故障メンテナンスとは何ですか、そしてそれをどのように扱うか
- AlGaN / GaNHEMTの表面電位と2DEGに及ぼす表面状態とアルミニウムモル分率の影響
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- RGOと3次元グラフェンネットワークが高性能でTIMを共同修正
- 高度に圧縮耐性のあるスーパーキャパシタ電極としての超弾性と高静電容量を備えたグラフェン/ポリアニリンエアロゲル
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性
- インメモリアプリケーションを計算するための低動作電圧の原子層堆積HfAlOxベースのRRAM
- 強化されたデュアルゲートと部分的なP埋め込み層を備えた超低比オン抵抗横方向二重拡散金属酸化物半導体トランジスタ
- 高PSRRのナノスケール低電力抵抗なし電圧リファレンス
- ハイブリッドトレンチカソードを備えた高精度AlGaN / GaN逆ブロッキングCRD(RB-CRD)
- PCB材料と高電圧用の設計



