触媒を含まないVSInAsナノワイヤに対するTeドーピングの影響
要約
シリコン(111)基板上での分子線エピタキシーによるTeドープ触媒フリーInAsナノワイヤの成長について報告します。ドーピングレベルの上昇に伴い、ワイヤの形態の変化、すなわち長さの減少と直径の増加が観察されています。透過型電子顕微鏡法とX線回折に基づく結晶構造解析により、成長プロセス中にTeが提供された場合、閃亜鉛鉱/(ウルツ鉱+閃亜鉛鉱)セグメント比の向上が明らかになります。さらに、電気的2点測定は、Teドーピングの増加が導電率の増加を引き起こすことを示しています。 As-partial圧力のみが約1×10 -5 異なる2つの同等の成長シリーズ 他のすべてのパラメータを一定に保ちながら、TorrをさまざまなTeドーピングレベルについて分析しました。彼らの比較は、結晶構造が強く影響を受け、比較的高いAs分圧で成長したワイヤの導電率ゲインがより明確であることを示唆しています。
背景
ナノワイヤー(NW)は、新興および将来の技術の有望なビルディングブロックを構成すると考えられているため、過去10年以内に注目を集めています。それらの技術的用途は、電界効果トランジスタや光デバイスから太陽電池に至るまで多様です[1、2]。 NWの幅広い適用性は、高アスペクト比、超低消費電力、InAsの場合、金属接点との界面にショットキー障壁がないなどの優れた特性に基づいています[3,4,5]。 。後者は、InAsが表面蓄積層を示し、オーム接触を可能にするという事実によるものです[6]。物理学の観点から、InAs NWは、優れた特性、つまり、高い電子移動度[7]、低い有効質量[8]、大きなg因子[9]、および強力なラシュバスピン軌道相互作用[10、11]を備えています。このため、それらは量子情報関連の研究に関する重要な要素になりました[5、12、13、14]。
InAs NWは通常、金の液滴を触媒として使用する気液固(VLS)成長法によって成長します。 Auの使用には、少なくとも2つの欠点があります。一方では、意図しない不純物としてNWに組み込まれ、材料特性を低下させます[2、15、16]。他方では、NW電界効果トランジスタ(FET)[17]などのすでに実証されている重要なアプリケーションの統合です。シリコンベースの技術では、トンネルFET [18]、光検出器[19]などは使用できません。したがって、以前に開発された蒸気-固体(VS)モードでの触媒を使用しない成長が、この通信内で適用されました[20]。バルクIII-V材料の安定相である立方閃亜鉛鉱(ZB)相の一部である六方晶閃亜鉛鉱(WZ)相もナノワイヤに存在します。 ZB-WZの多型、および回転双晶や積層欠陥などの他の欠陥が一般的に報告されています。相純粋で、積層欠陥がほとんどないInAs NWは、Au支援VLS成長[21、22]によって取得できますが、触媒フリーVS法[23、24、25]を使用しません。これらの欠陥は、輸送[26、27]および光学特性[28]に悪影響を及ぼします。
減少した電荷輸送を打ち消す1つの方法は、ドーピングの使用、すなわち、追加の担体の組み込みである。ただし、III-V化合物半導体層に使用される確立されたドーピング方法は、ワイヤ構造に単純に移行することはできません。ナノワイヤは、異なる結晶配向と表面再構成を備えた軸方向および半径方向の成長ファセットを持ち、ドーパントの取り込みに影響を与えると考えられる高度に異方性の成長をもたらします。状況は、関与するファセットの異なる成長モード、蒸気-液体-固体(VLS)およびVS [29、30]および特有の結晶相ポリタイプ[31]によって複雑になります。これらすべての特定の特性により、軸方向と半径方向の両方で不均一なドーパント分布が生じます[29、32、33]。 IV族元素Siは、MBEで成長させたIII-V薄膜のn型ドーパントとして一般的に使用されてきました。ただし、Siは両性挙動を示すことが知られています。つまり、Si原子は、基板の配向と成長条件に応じて、陽イオン格子サイトのドナーまたは陰イオン格子サイトのアクセプターとして組み込むことができます[34、35]。この挙動は、成長、成長メカニズム、および成長温度に関与するファセットの異なる結晶配向と相関しているナノワイヤでも観察されました[29、36、37]。一方、VI族元素Teは、両性挙動のリスクを示さないエピ層[38]で非常に効果的なn型ドーパントです。さらに、Teには他にもいくつかの利点があります。III-V材料システムで一般的に使用される他のn型ドーパントと比較してイオン化エネルギーが低く、より高いドーピングレベルの達成につながる可能性があります[39]。他の第6族元素、すなわち、突然の界面に重要なSおよびSeと比較して、拡散係数が低く[40]、メモリー効果が弱い[41]。 Teの排他的なn型ドーパントの挙動は、Au触媒[42]および自己触媒GaAsナノワイヤで報告されており、高濃度の高ドーピング濃度になる可能性があるだけでなく、ワイヤの形態や結晶構造への影響も示しています[43、44]。 。
この通信では、InAs NWでのTeドーピングを調査し、ドーピングがNW形態に与える影響と、Teの存在下でのVS成長内でのZBとWZ構造の切り替えに関する情報を提供します。走査型電子顕微鏡(SEM)に基づく調査では、NW形態に対するTeの強い影響が明らかになりました。高分解能透過型電子顕微鏡(HR-TEM)[45]およびX線回折(XRD)測定は、ZB /(WZ + ZB)比の変化を証明するのに役立ち、電気的2点測定はTeドーピングレベルを上げる。
メソッド/実験
InAs NWは、n型Si(111)基板上に異物触媒を使用せずにVSモードで成長させました。
基板の準備
成長の前に、基板はHFとDI-水を使用して洗浄されました。 45秒間の連続過酸化水素処理により、ピンホールを含む数オングストロームの厚さのSiO2膜が形成されます。これは、北西成長の核生成中心として機能します[20]。酸化後、基板はすぐにロードロックに移され、200°Cで45分間加熱されました。これに続いて、準備チャンバー内で脱気ステップを行い、サンプルを400°Cでさらに45分間加熱しました。
InAsナノワイヤーの成長
NWは、Omicron Pro 100分子線エピタキシー(MBE)チャンバー内で、基板温度475°Cで1:20時間成長しました。 0.1μmh -1 の成長率 北西の成長に使用されました。ヒ素はAsクラッカーセルを介して供給され、As4ビーム当量(BEP)は2.3×10 –5 の値に調整されました。 Torrおよび3.3×10 –5 トル。最初のサンプルシリーズ(シリーズA)は、他のすべてのパラメータを一定に保ちながら、2番目の成長シリーズ(シリーズB)と比較して高い分圧で成長しました(表1を参照)。テルルは、化学量論的GaTeを使用して成長中に供給されました。ホール測定を介してTeドープGaAs層で実施された校正に基づいて、エフュージョンセルの動作温度を401°Cから562°Cの間で変化させました。 GaTeセルの温度401°C、447°C、500°C、および561°Cは、約1×10 15 のキャリア濃度に対応します。 cm -3 、4×10 16 cm -3 、5×10 17 cm -3 、および6×10 19 cm -3 それぞれ、キャリブレーションに使用されるGaAs(100)層で。
<図>デバイス処理
2点接触を処理するために、NWは200nmのSiO2で覆われた事前にパターン化されたSi基板上に機械的に転写されました。連絡手順の概略図は、追加ファイル1:図S1に記載されています。金属蒸着の前に、ワイヤは、接触形状が定義された50 K(AR-P639.04)、50 K、および950 K(AR-P679.04)PMMAレジストの3層システムによってスピンコーティングされました。電子ビームリソグラフィーを介して。現像後、接触領域は希釈された3.5%多硫化アンモニウム(H 2 )によって不動態化されました。 O:(NH4) 2 S 3 、34:1)60°Cで30分。 100nmのチタンと40nmの金で構成される電極は、電子ビーム蒸発器を介して堆積されました。
SEM、TEM、XRD、および電気的測定によって調査されたサンプルの完全なリストを表1に示します。ここで、文字A、B、およびCは、それぞれ異なる分圧で成長したサンプルシリーズを示しています。等しい条件下で。 0°CのGaTe温度は、クローズドセルシャッターに対応します。
結果と考察
形態学
ワイヤの形態に対するTeドーピングの影響を調査するために、SEMイメージングを使用しました。結果を図1に示します。グラフ上のすべてのデータポイントは、少なくとも40本のワイヤーの平均を表し、エラーバーはそれらの標準偏差を表しています。

ナノワイヤの形態。ナノワイヤは、さまざまなGaTeセル温度での長さと直径を意味します。 a シリーズAは、約3.3×10 –5 の分圧で成長しました。 トル。 b シリーズBは、2.3×10 –5 の分圧で成長しました。 トル。破線は目の目安です。挿入図に示されているSEM顕微鏡写真は、成長中に形成された結晶子に囲まれたドープされていないInAsNWを示しています。スケールバーはそれぞれ300nmと120nmです
図1aは、約3.3×10 -5 の分圧で成長したワイヤシリーズAの形態を示しています。 トル。 GaTeセルの温度は0°Cから561°Cの範囲でした。エラーバーを考慮に入れると、セル温度が500°Cになるまで、北西の直径と長さの明確な傾向は観察されません。ただし、561°Cでは、Teの供給は明らかに有害であり、直径が大幅に増加し、北西の長さが減少します。図1bに示されている成長シリーズBは、2.3×10 -5 の比較的低いAs圧力で成長しました。 トル。挿入図は、成長したサンプルの例示的なSEM側面図を示しており、基板表面にInAsNWとクラスターを示しています。シリーズAおよびBのその他のSEM画像は、追加ファイル1:図S2に示されています。ここでは、0°Cから462°CまでのGaTeセルの温度範囲を調査しました。セル温度401°CでシリーズBの成長中にTeを添加すると、長さの減少が観察されます。同じ温度間隔でのシリーズAとBの測定値を比較すると、特にNWの長さの減少は、比較的低いAs圧力(シリーズB)でより明確であることが観察されます。ただし、同じ全体的な傾向、つまり、両方のシリーズでNWの長さの減少が観察され、シリーズAで直径の増加が観察されます。
Siドーピングは、成長方法(MBEまたは有機金属気相成長法(MOVPE))とは関係なく、InAsとGaAsの直径の増加と長さの減少を同様にもたらします[46、47]。 MBEによって成長させた無触媒GaAsNWのTeドーピングでも同じ寸法変化が観察されました[44]。使用される材料システム、すなわち、IV族(InAs / Si、GaAs / Si)またはVI族材料(GaAs / Te、InAs / Te)をドープしたIIIV材料とは無関係に、形態に関して同じ全体的な傾向が観察されるようです。
Teは、ホストの格子原子に対してかなり大きな共有結合半径を示すため、界面活性剤として機能します[48、49]。したがって、観察された挙動は、Teによって引き起こされたIn原子の拡散係数の低下に起因している可能性があります。これは次に、In吸着原子が成長を制御する北西先端に向かう途中で妨げられるため、放射状成長の増加と長さの減少を引き起こす可能性があります[46]。図1a(シリーズA)と図1b(シリーズB)を比較すると、As圧力が、Teの添加によってワイヤの形態がどのように影響を受けるかに影響を与えることがわかります。この発見は、As圧力をある程度増加させることにより、InAsワイヤの半径方向および軸方向の寸法に対するTeの影響の減少を打ち消すことができる可能性があることを示唆しています。
結晶構造
結晶構造に対するTeドーパントの影響をTEMとXRDを使用して調査しました。 Caroffらによって使用された分類を採用する。 [49]、結晶スタッキングシーケンスは、スタッキングシーケンスが原子の正確に4つの二重層に従っている場合、ZB(図2aを参照)またはWZ(図2dを参照)セグメントに割り当てられました。これは、... ABCA ...がZBセグメントとしてカウントされ、…ABAB…がWZセグメントとしてカウントされたことを意味します。これを図2b、eに示します。ここでは、すべての文字が原子の二重層を表しています。図2c、fに示すように、一部のワイヤセクションは、結晶シーケンス内の欠落または過剰な層で構成されるスタッキングフォールト(SF)によって中断されます。まれにしか観察されませんが、回転双晶は一部のセグメントにも存在します(ここには示されていません)。
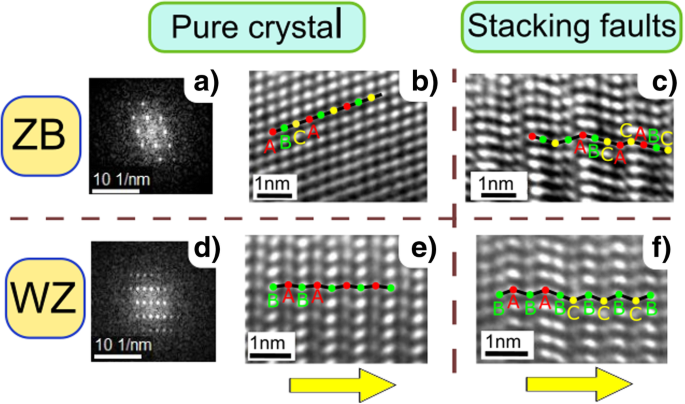
結晶構造分析。 InAs NWのHR-TEM画像。積層欠陥がある場合とない場合の、ZBおよびWZ結晶構造を示しています。黄色の矢印は[111]の成長方向を示しています。色付きの点と黒い線は、目がスタッキング特性をたどるためのガイダンスです。 a 欠陥のないZBのFFT回折パターン。 b 、 c ZB構造。 d 欠陥のないWZおよび e のFFT回折パターン – f WZ構造
結晶切片は、原子の4つの二重層からなる1つの完全なシーケンスが観察された場合にのみ、ZBまたはWZセグメントとして識別されました。残りのセクションは、SFまたは回転双子に起因していました。
説明された特性に従って評価された3つの異なるドーピングレベルでの結晶構造を図3に示します。異なるWZおよびZB領域が強調表示されています。ただし、分析では、個々のセグメントのみがカウントされました。 NW結晶構造に対するTeドーピングの影響を定量化するために、各ドーピングレベルの10 NWからのセグメントの全長約150nmを分析し、平均しました(図3b–dを参照)。 ZB /(WZ + ZB)セグメント比は、単一のZBおよびWZセグメントの数を数えることによって決定されました。 0°C、447°C、500°CのサンプルB1、B3、C1、A4をそれぞれ分析しました(図4を参照)。 GaTeセルの温度を上げると、ZB /(WZ + ZB)セグメント比が向上することがわかります。この傾向を図4に示します。最初の2つのデータポイント(0°Cと447°C)を比較すると、比率の向上は、ドープされていないものからドープされていないものへのWZセグメントの増加と比較してZBセグメントの増加が強いためです。最低ドーピング温度(挿入図図4を参照)。両方の構造タイプが強化され、SFの数が減少します。ただし、3点目は傾向が異なります。最高のドーピングレベルと最低のドーピングレベル(500°Cと447°C)を比較すると、SFの数がSFの数である間、WZセグメントの数が減少し、ZBセグメントの数がほぼ一定に保たれていることがわかります(挿入図4を参照)。増加します。これにより、比率が上がります。それでも、ZBセクションはドープされていない場合と比較して促進されます。最後に、調査結果は、Teドーピングが実際にZB /(WZ + ZB)セグメント比を高めることを示しています。ただし、Teの取り込みによってZBセグメントの形成が厳密に促進されるかどうかは、あいまいなままです。
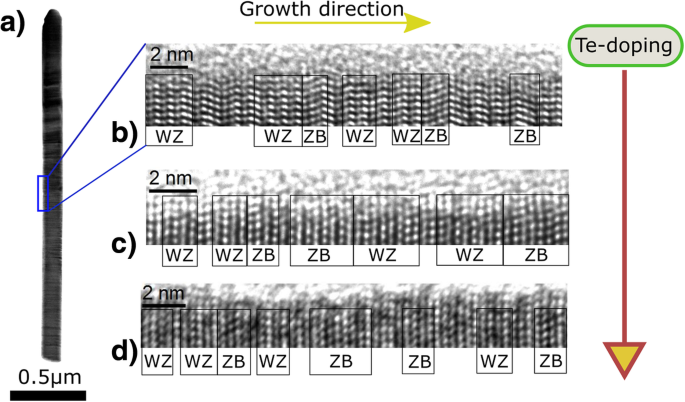
結晶構造に対するTeドーピングの影響。ドープされていないInAsNWとTeドープされたInAsNWの結晶構造を示すTEM画像。 a InAsNWの側面図。 b – d InAs NW結晶構造のHR-TEM画像(画像は時計回りに90°回転)。 WZおよびZBエリアにはラベルが付けられています。次のサンプルとGaTeセル温度が選択されました: b B1(As 4 -BEP =2.3×10 −5 Torr)、ドープされていない、すなわち0°C。 c B3(As 4 -BEP =2.3×10 −5 Torr)、447°C。 d C1(As 4 -BEP =3.0×10 -5 Torr)、500°C

ZBセグメントとWZセグメントの比率。 GaTeセルの温度に応じた、ZBセグメントの数とWZまたはZBとして識別されるセグメントの総数の比率。最初の2つの測定では、B1とB3が分析されています。 500°Cでは、ワイヤーC1とA4の結果は、同様のAs-BEPで成長したときにマージされました。挿入図の棒グラフは、指定されたセル温度で北西に存在するすべてのWZおよびZBセグメントの累積長をそれぞれ示しています
TEMによる観察を補完するために、XRD測定が実行されました。立方(220)反射と六角形[10,11,12,13,14,15]反射に焦点を当てたφスキャンを実施しました。これらの反射神経は、それぞれZBおよびWZ構造に明確に起因する可能性があります。 I を抽出するために許可されたそれぞれの強度の測定 ZB /(私 ZB + 私 WZ )強度比。図5aに示されているφスキャンは、各GaTeセルドーピング温度でのZBおよびWZピークの相対強度を決定するのに役立ちました。 ZB反射の場合、立方格子が3回対称になるだけであっても、6つのピークが発生します。これらのピークをZB構造の対称双晶に割り当てます。 WZスキャンで発生する6回対称のピークは、六角形の結晶構造に特徴的であり、私たちの期待に一致します。ここで、InAs表面微結晶の信号強度(図1の挿入図を参照)は、NW信号[50]よりも2桁小さいと想定されているため、無視できます。対応する強度比 I ZB /(私 ZB + 私 WZ )は図5b(シリーズAの色付きの三角形)にプロットされています。 I の増加を示しています ZB /(私 ZB + 私 WZ )GaTeセル温度の上昇に伴う強度比。シリーズAでは401°C後に明らかになります。この結果は、TEM分析からすでに得られた観察結果と一致しています。与えられた強度比は実際のZB / WZ比率を表すのではなく、定性的な結果を構成することに注意してください。これは、明示的に考慮されていない構造因子に応じて、異なる反射が異なる強度であるという事実によるものです。ただし、データポイント間の比較は引き続き有効です。上記のシリーズAよりも低いAs圧力で成長させたシリーズBについても、同じ反射に敏感な測定を行いました。図5b(黒い点)に示されている結果は、Aシリーズと同様の傾向、つまり、セル温度が高くなるとZB /(WZ + ZB)強度比が増加することを示しています。ただし、結晶構造に対するTe原子の影響は、より高いAs圧力と比較してそれほど明確ではなく、明確な増加は462°Cでのみ観察されます。シリーズBは、最高のGeTeセル温度である462°CでXRDのZB /(WZ + ZB)強度比の向上のみを示していますが、シリーズAは447°Cおよび500°Cのセル温度で明らかに増加を示しています。この観察結果は、As原子がTe原子の取り込みを促進し、それが結晶構造の変化につながることを示唆しています。したがって、ZB /(WZ + ZB)比へのより強い影響は、それぞれのより高いAs圧力で観察されます。図5bの447°Cでの強度比の低下は、サンプルB3のNW密度が平均を上回っていたため、シャドウイング効果が原因である可能性がありますが、これはまだ完全には理解されていません。

格子構造のX線分析。 a InAs NWA1〜A4でのX線測定によって得られたφスキャン。 b 結果の I ZB /(私 WZ + 私 ZB )強度比対GaTeセル温度。三角形のデータポイントは、( a )に示されている測定値から抽出されます。 )サンプルA1〜A4の場合。黒い点は、サンプルB1〜B4のデータポイントを示しています
上に示したTEMの結果から、Te供給下で成長したNWは、ドープされていない場合と比較して、ZBおよびWZセグメントの数が増加し、SFが少ないと結論付けられます。さらに、XRD測定は、ZB /(WZ + ZB)強度比がTeドーピングレベルの増加(高温で)とともに増加することを示しています。これは、TEM測定と定性的に一致しています。 Si(InAs / Si [30]、GaAs / Si)、C(GaAs / C)、Be(GaAs / Be)などのIII-V材料のドーピングに使用される一般的な元素とは対照的に、Teは明らかに結晶構造に影響を与えます。北西の。観察されたZB形成の促進は、表面エネルギーの変化に起因する可能性があり、ZB核形成のエネルギー障壁を低下させます。これは、Au触媒によるVLS成長が使用された亜鉛ドープInPナノワイヤ[51]でも同様に観察されました。ただし、根本的なメカニズムを明らかにするには、さらなる研究が必要です。
電気的測定
σ=A・R・L -1 で定義される導電率 wは、Ti / Au接点を使用した2点測定から抽出されました。ここで、Aは A のワイヤーの六角形の断面です。 =3√3 d 2 NW / 8ここで、 d NW は最大直径、 R 抵抗、およびLwは電気接点間の距離です。 L w および d NW SEMイメージングを介してすべてのワイヤについて個別に測定されています。ドープされていないInAsNWとドープされたInAsNWの例示的なI–V特性を図6a–dに示します。グラフは、InAsの表面蓄積層による予想されるオーム挙動を示しています[6、52]。ドーピングレベルに依存する導電率は、I–V測定とNW形状に基づいて決定されました。結果として生じる導電率とGaTeセル温度の依存関係を図6eに示します。各温度で、シリーズAについて少なくとも20 NWを調べました。ドープされていないワイヤとドープされたワイヤを比較すると、最高のドーピングレベルで約1桁の平均導電率の増加が観察されます。 500°CのGaTeセル温度で、約80 S / cmの平均導電率が決定されました(0°Cの約8 S / cmと比較して)。より高いドーピングレベルでの導電率の広がりは非常に明確ですが、我々の観察によれば、Teの取り込みは確かに強い影響を及ぼし、平均して導電率の増加につながります。 XRDと導電率測定の比較は、401°C未満では、結晶構造と輸送特性に対するTeの影響がわずかな役割しか果たしていないことを示唆しています。上記のInAsNWの導電率の大きな変動は、同様に文献で報告されています[53]。予想通り、北西の直径または接触間隔の変化に関して、導電率の傾向は観察されませんでした[26]。したがって、エラーの原因として異なるアスペクト比を除外します。導電率の大きな変動の原因となる3つの主な理由を特定します。(i)多硫化アンモニウムを使用した接触不動態化法は、不均一な接触品質につながる可能性があります。 (ii)ワイヤ表面は不動態化されておらず、表面状態は、水と酸素を介したワイヤ側ファセットのダングリングボンドの不均一な飽和によって影響を受ける可能性があり、最終的に不均一な表面酸化を引き起こします。これは、輸送特性に大きな影響を及ぼし、大きなエラーにつながります[54]。これらの不均一な表面状態を防ぐ1つの方法は、Al 2 のその場堆積による不動態化です。 O 3 [53、55]。 (iii)Siドーピング[26]で観察されたように、北西に沿った不均一なドーピングも、各ワイヤの中央に接点を配置することによってそれを排除しようとしましたが、大きなデータ拡散を引き起こす可能性があります。最後に、北西の長さ(図1を参照)と密度の変動は、シャドウイング効果を引き起こし、サンプル全体に均一なTeの取り込みを妨げる可能性があります。ただし、観察された大きな変動の原因を特定するには、より体系的な調査が必要です。さらに、比較的低いAs圧力で成長したシリーズBのNWの導電率測定を実施しました。ここでは、GaTeセルの温度ごとに少なくとも6本のワイヤが測定されました。図6eに示されている結果は、シリーズAについて上で説明したものと同様の動作を示しています。InAsNWの導電率は、GaTeセルの温度が高くなると増加します。ただし、より高いAs圧力で成長したシリーズAと比較すると、効果はそれほど明確ではありません。図6eの401°Cと447°Cでの両方のシリーズの導電率を比較すると、シリーズAの値はBの値の約2倍であることがわかります。上記のXRDの結果(図5を参照) )は、シリーズAの結晶構造がシリーズBよりもTeの取り込みの影響を強く受けることを示しています。両方の結果の組み合わせは、導電率の上昇が結晶構造の変化、つまりZB /(WZ +の増加)に関連していることを示しています。 ZB)強度比。文献から、WZが優勢なWZからZBが優勢な方向へのInAs NW結晶構造の変化が、導電性を高めることが知られています[50、53、56]。 InAs 1 − x のTEM調査に基づく Sb x NW、Sourribes etal。 NW ZBフラクションが20%から80%に増加すると、導電率が1.5増加することが報告されています[50]。 TEMの結果(図4を参照)は、ZB /(WZ + ZB)比が32%(ドープされていないNW)から43%(ドープされた最大NW)に上昇し、平均導電率値が約10倍に増加していることを示しています。比較すると、結晶構造の変化だけが導電率の向上の理由ではないことが示唆されています。結晶構造の変化はキャリア輸送に影響を与えますが、観察された効果はおそらく同様に、ドナーとして作用するTeによって誘発されたキャリア密度の増加によるものです。
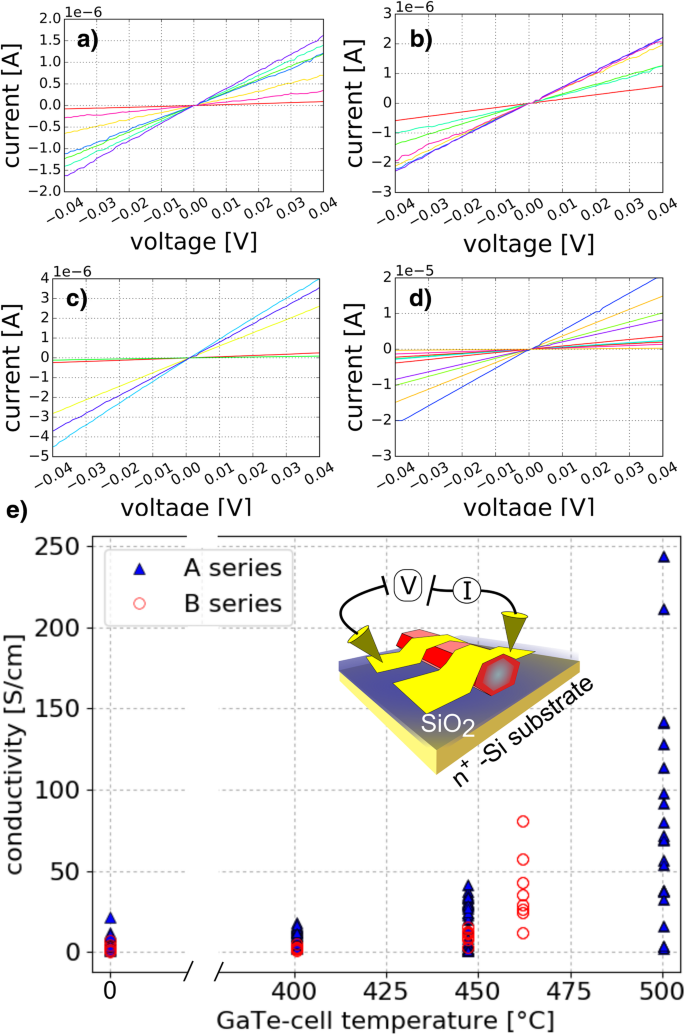
電気的特性。 a – d 2点接点を介して測定された0°C、401°C、447°C、および500°C(シリーズA)のGaTeセル温度でのInAs NWの例示的なI–V測定。 e A(高As-BEP)およびB(低As-BEP)シリーズのGaTeセル温度に依存してTeドープInAsNWの導電率値を決定しました。挿入図は、電気測定構成の概略図を示しています
結論
要約すると、我々は、気固成長法を介して、Si(111)基板上にTeドープ触媒フリーInAsNWを成長させました。 TeはGaTeセルによって提供され、セル温度を調整することにより、さまざまなドーピングレベルでTeドープInAsNWの成長を可能にしました。異なるAs-BEPで成長した2つのサンプルシリーズは、SEM、TEM、XRD、および電気的測定によって特徴づけられました。 TeがNW形態を変化させ、半径方向の成長率が増加し、軸方向の成長率が減少するという全体的な傾向につながることを示しました。影響は、比較的低い分圧でより強くなります。 TEMおよびXRD測定により、NW結晶構造はTeの添加によって影響を受け、両方の成長系列でZB /(WZ + ZB)比が増加することが明らかになりました。比較的高いAs-BEPで成長したNW結晶構造への影響は、低いAs-BEPで成長したNWで観察されたものよりも強化されました。電気的2点測定は、Te供給下で成長したワイヤの平均導電率の増加を示しました。これは、異なるAs圧力で成長した2つの成長シリーズで観察されました。 2つのサンプルシリーズを比較すると、InAs NWの結晶および電気的特性は、より高いAs圧力でのTe添加によってより強く影響を受けることがわかりました。この結果は、平均導電率の改善が結晶構造の変化、つまりZB /(WZ + ZB)比の増加に強く関係していることを示しています。強化された輸送特性は、ドナーとして機能する組み込まれた第6族元素Teと、結晶構造の変化の両方に起因すると考えられます。この作業は、SFによる輸送特性の劣化に対抗するために非常に興味深いNWドーピングのオプションを拡張するための重要な貢献を構成します。
略語
- As:
-
ヒ素
- BEP:
-
ビーム当量
- C:
-
カーボン
- GaAs:
-
ガリウムヒ素
- GaTe:
-
テルル化ガリウム
- HR-TEM:
-
高分解能透過型電子顕微鏡
- InAs:
-
ヒ化インジウム
- MBE:
-
分子線エピタキシー
- MOVPE:
-
有機金属気相エピタキシー
- NW:
-
ナノワイヤー
- SEM:
-
走査型電子顕微鏡
- SF:
-
スタッキング障害
- Si:
-
シリコン
- Te:
-
テルル
- VS:
-
蒸気固体
- WZ:
-
ウルツ鉱
- XRD:
-
X線回折
- ZB:
-
閃亜鉛鉱
ナノマテリアル



