微量のガリウムの導入によるInPからGaPナノワイヤへの熱力学制御の鋭い変換
要約
オプトエレクトロニクスおよび電子アプリケーション向けの低コストで高品質のIII–Vナノワイヤを成長させることは、長期にわたる研究の追求です。それでも、化学蒸着法を使用したIII–Vナノワイヤの制御された合成は課題であり、理論のガイダンスが不足しています。ここでは、真空化学蒸着法を使用して、高密度で大面積のInPおよびGaPナノワイヤの成長を示します。酸化物の形成を回避し、InPナノワイヤの結晶純度を高めるには、高い成長温度が必要であることが明らかになりました。反応器に少量のGaを導入すると、3成分のInGaPナノワイヤの代わりにGaPナノワイヤが形成されます。状態図の計算(CALPHAD)アプローチ内の熱力学的計算は、この新しい成長現象を説明するために適用されます。凝固プロセスの組成と駆動力の計算は、GaPの核形成がはるかに大きな駆動力を示すため、触媒中のGaのわずか1 at。%でナノワイヤ形成をInPからGaPに調整するのに十分であることを示しています。 III–Vナノワイヤ成長研究と組み合わせた熱力学的研究は、ナノワイヤ成長を導くための優れた例を提供します。
はじめに
ナノワイヤは、ひずみ緩和、ヘテロ接合形成、および結晶相工学において利点を示し、したがって過去10年間で急速に発展しています[1,2,3,4]。 III-V半導体ナノワイヤは、その優れた光学的および電子的特性のおかげで、両方のアプリケーション分野(光起電[5]、光検出器[6、7]、フォトダイオード[8]、電子デバイス[9]など)で広く使用されています。および基礎科学研究[10]。ボトムアップナノワイヤ製造では、有機金属化学蒸着(MOCVD)[11、12]および分子線エピタキシー(MBE)[13]技術が、高品質のナノワイヤを合成するために広く適用されています。たとえば、純粋なウルツ鉱[14]と閃亜鉛鉱双晶超格子InPナノワイヤ[15、16]の両方が実証され、テラヘルツ検出[17]およびレイジングアプリケーション[18]に適用されています。しかし、これらの高品質のナノワイヤーは高コストで製造されています。代わりに、安価な化学蒸着(CVD)法を使用すると、III–Vナノワイヤの製造コストを大幅に削減し、光電気化学分野などの応用分野を拡大することができます[19]。さらに、CVDはその実現可能性のおかげで成長探査において利点を持っています[20]。 III-Pおよびそれらの三元InGaPナノワイヤは、適切なバンドギャップ、低毒性、および低表面再結合速度[14]のおかげで、バイオセンサー[21]、レーザー[22]、および光触媒[23]アプリケーションでの可能性を示しています。 Hui etal。 [24]は、高い移動度(〜350 cm 2 )を備えたInPナノワイヤのCVD成長を実証しました。 V -1 s -1 )MOCVDおよびMBE技術によって成長したナノワイヤに匹敵します。 CVD法によって製造されたInPナノワイヤを使用して、Zheng等。 [25]強誘電性ポリマーのサイドゲート単一InPNW光検出器を製造し、この強誘電性材料によって生成される局所電場によって暗電流が大幅に抑制される超高感度光検出を示しています。 GaPは、バンドギャップが2.26 eVで屈折率が高い半導体であるため、緑黄色領域の発光ダイオード[26]やフォトニクスアプリケーション[27]に適しています。さらに、GaPの適切なバンドギャップにより、光触媒の分野でも有用になります[23、28]。しかし、それでも、GaPとその3成分InGaPナノワイヤのCVD成長の報告は非常に限られています。 GaPナノワイヤは、主に物理蒸着法[18、20、29、30]によって製造されました。三元InGaPナノワイヤは、MOCVD [31、32]、MBE [33]、および液相合成法[23]によって実証されました。詳細な成長、および金属シードGaPおよびInGaPナノワイヤの成長の基礎については、さらに調査する必要があります。熱力学は、ナノワイヤの成長に影響を与える重要な要素です。 CALPHADは、バルク材料の相平衡と熱力学的特性を計算するための強力で確立された方法です[34]。この半経験的熱力学的計算方法は、核形成中の熱力学的特性を計算できるため、ナノワイヤの成長を促進します。 CALPHAD法は、In–Sbシステムのナノフェーズ図を計算するために適用され[35]、GaAsおよびInAsナノワイヤのAuシード成長[36]と、InGaAsナノワイヤの組成分析[37]を理解します。それでも、III-Vナノワイヤの成長を導くためにCALPHAD法を完全に適用するために行われるべき多くの作業があります。たとえば、AuシードのInGaPナノワイヤの成長挙動を説明するためのCALPHAD分析は実行されていません。
この作業では、前駆体としてInP粉末と金属Gaを使用して、真空条件下でCVD反応器内に高密度のInPおよびGaPナノワイヤを成長させます。この方法は、広い温度範囲でナノワイヤを製造するのに効果的であることが実証されています。 InPナノワイヤの成長を最適化した後、純粋なGaを反応器に導入することにより、GaPナノワイヤの成長をさらに調査します。三元InGaPナノワイヤを形成する代わりに、Gaの入力重量や成長温度に関係なく、ほぼ純粋なGaPナノワイヤが形成されます。さらなる組成決定と熱力学的計算は、ナノワイヤの組成が動力学ではなく熱力学によって制御されることを示しています。 Au液滴中の少量のGaは、ナノワイヤの成長をInPからGaPに調整することができ、観察されたナノワイヤの成長挙動をよく説明しています。この作業は、III-Vナノワイヤの成長のための低コストで効果的な方法を提供し、適用された状態図分析方法は、III-Vナノワイヤの成長を理解するのに役立ちます。
メソッド
InPおよびGaPナノワイヤーの準備
InPおよびGaPナノワイヤは、図1aに示すように、真空条件下で自作のCVDシステムで成長させました。高度に精製されたGa(99.999%、Innochem)およびInP粉末(99.99%、Aladdin)を固体資源として使用し、2つの分離されたクォートチューブに分離しました。石英管の内径は8mm、長さは180mmです。電子ビーム蒸着を使用して、約2 nmの厚さのAu膜をSi(111)基板上に堆積させました。これらの石英管は、Auで堆積されたSi(111)基板とともに、別の大きな石英管の内部にロードされ(図1aに示すように)、真空シール機(Partulab MRVS-1002)でシールされました。チューブ全体の圧力は〜3.0×10 –3 Pa。次に、2温度ゾーンの炉でサンプルの成長を行いました。最初のゾーンの温度とInP粉末の重量は、すべてのサンプルでそれぞれ720°Cと20mgで一定に保たれました。 InPナノワイヤの成長では、Ga粉末は導入されず、2番目の成長温度ゾーンは400〜550°Cで変化しました。 InPナノワイヤの成長を最適化した後、Ga電力(0〜5 mg)を追加して、520〜630°Cの温度範囲でInGaPナノワイヤを成長させました。温度依存性の成長中、Gaの重量は3mgに固定されました。温度ゾーンを目標温度まで上げ、温度を60分間維持してから、冷却します。

InPナノワイヤの成長研究。 a InPとGaPの両方のナノワイヤ成長の実験装置の概略図。 b で成長したInPナノワイヤのSEM画像 400°C、 c 450°C、 d 480°C、 e 520°Cおよび f 550°C。 g 異なる温度で調製されたナノワイヤの直径分布。 h ラマンと i 異なる温度で成長したナノワイヤのPL比較
ナノワイヤの特性評価
成長後、ナノワイヤの形態と構造を、300 kV(Titan G2 60-300)で動作する走査型電子顕微鏡(SEM)と透過型電子顕微鏡(TEM)によって調査しました。成長したままのナノワイヤの結晶構造は、X線回折(MiniFle×600)によって調査されました。詳細な組成測定には、SEMとTEMの両方に装備されたエネルギー分散型スペクトル(EDS)を適用しました。 Thermo-Calcソフトウェアを使用して、熱力学計算を実行しました。 InPおよびGaPナノワイヤの光学特性は、市販のレニショーシステム(inVia)でマイクロラマンおよびフォトルミネッセンス(PL)によって調べられました。つまり、ナノワイヤは、緑色レーザー(532 nm)を介して対物レンズ(100×)を介して励起されました。
結果と考察
InPナノワイヤー
成長後、400〜520°Cのすべての調査された成長温度範囲で、光学顕微鏡下で高密度のInPナノワイヤを観察できました。図1b–gの詳細な形態特性は、CVDによって成長した他のナノワイヤと同様に、Si(111)基板上に非垂直でランダムに分布したInPナノワイヤを示しています[20]。一般に、すべてのナノワイヤは10 µmを超え、ほぼテーパーのない形態をしています。これは、MBE [38]またはMOCVD [39]によるIII-Vナノワイヤの成長速度よりもはるかに長いです。挿入図の拡大SEM画像は、単一のナノワイヤの形態を示しています。成長の最前線でAu液滴が観察され、InPナノワイヤの成長がよく知られている蒸気-液体-固体(VLS)成長メカニズムによって制御されていることを示しています[11]傾斜および湾曲したナノワイヤに加えて、面内InPナノワイヤも基板上で観察されます(図1の挿入図を参照)。形態の変化にもかかわらず、成長温度はナノワイヤの直径に影響を与えるようです。低い成長温度(400°C)では、ナノワイヤは比較的細く、平均直径は121nmです。成長温度の上昇に伴い、ナノワイヤの直径は単調に増加しますが、より無秩序に分布します。たとえば、550°Cでは、直径が210〜290 nmのナノワイヤが観察され、シリコン基板上のナノワイヤの分布は均一ではありません。
図1hと比較して、ラマン散乱とPL技術を使用して、成長したままのInPナノワイヤの結晶品質と光学特性をすばやくテストしました。 〜302 cm -1 に2つのピーク および341cm -1 InPの縦光学(LO)およびトラバース光学(TO)フォノンモードに対応するすべてのサンプルで観察されます[40]。これは、製造されたすべてのナノワイヤが実際にInPであることを示唆しています。ただし、図1iの対応するPLデータは非常に紛らわしいものです。 400〜480°Cで成長したナノワイヤの場合、PLスペクトルは、〜775nm〜811nmの範囲で強く幅広い発光ピークを示します。放出された光子エネルギーは、ウルツ鉱(WZ)(872 nm)または亜鉛ブレンド(ZB)(922 nm)InPナノワイヤーのバンドギャップよりもはるかに大きく、純粋なInPからの放出ではないことを示しています。約886nmの凹面は、光学システムのシステムバグが原因です。温度が520°Cを超えると、900 nm付近に強い発光ピークが観察されます。これは、多結晶InPナノワイヤーからの発光によるものです[40]。これらの研究は、InPナノワイヤの最適な成長温度が〜520°Cであり、高い光学品質を備えたInPナノワイヤの均一な分布につながることを示唆しています。
観察されたPLスペクトルの違いを明確にするために、図2と比較して、480°Cと520°Cで成長したサンプルのX線光電子分光法(XPS)テストを同じテスト条件で実行しました。両方のサンプルで、XPSスペクトルは特徴的なピークを示しています。 In-3 d から およびP-2 p 。さらに、O-1 s およびC-1 s 関連するピークも記録されました。 In-3 d のスロースキャン結果 480°Cで成長したサンプルのピーク(図2cを参照)は、443.5、442.3、および444.4 eVの3つのピークにデコンボリューションできます。これらは、InP、In 2 に起因します。 O 3、 およびInPO 4 それぞれ[41、42]。相対強度に基づくと、上記の化合物の重量比は、それぞれ31.0%、48.7%、20.3%です。強いP-2 p 132 eVのピーク(図2bを参照)は、InPO 4 の存在をさらに確認します。 。比較すると、520°Cで成長したサンプルの場合、In-3 d のピーク強度 、P-2 p 、およびO-1 s 、InPO 4 を表します 、In 2 O 3 、InPの相対強度が向上する一方で、大幅に抑制されます。これらの比較は、より高い成長温度が酸化物形成を抑制し、InPの純度を高めることができることを示しています。より低い成長温度では、InPナノワイヤでの酸化物形成は無視できず、PL発光は酸化インジウムによって支配されるため、In 2 によって引き起こされる幅広い発光ピークを示します。 O 3 欠陥状態[43、44]。代わりに、より高い成長温度でのInPナノワイヤの純度の向上は、InP半導体からの特徴的なピークにつながります。また、これらの実験は、成長条件自体に加えて、実験プロセスは、密封されたチューブに酸素が導入されないように注意する必要があることを示しています。たとえば、酸素含有量を避けるために、真空はさらに高くする必要があります。さらに、シーリングプロセス中は、酸化の可能性を回避するためにInP粉末を冷却する必要があります。

480°Cと520°Cの温度で成長したInPナノワイヤ表面のXPS比較。 a 調査スペクトル、 b の高解像度XPSスペクトル P-2 p 、 c In-3 d 、 d O-1 s
InPナノワイヤの成長を研究した後、Gaパワー(3 mg)を反応器に導入して、3成分のInGaPナノワイヤを成長させました。 Gaを添加すると、520〜630°Cの温度範囲で高密度のナノワイヤが形成されます。基板も黄色に変わります。ナノワイヤの平均直径は90nmから253nmに増加し、580°C後に再び減少します(図3aを参照)。図3bと比較して、さまざまな条件で成長したナノワイヤの結晶と組成を最初にXRDで調べます。使用したSi(111)基板は、28.43°に1つのメインピークしか示していません。 550°Cで成長したInPナノワイヤの場合、33.08°、43.61°、51.71°、58.93°、および63.52°に追加のピークが観察され、(200)、(220)、(311)、(222)、( 400)ZBInPの平面[45]。 InGaPナノワイヤの場合、調査したすべての条件(温度依存またはGa重量依存)で成長したナノワイヤのXRDスペクトルは非常に類似しており、ピーク位置はほぼ同じで、ピークは32.64°、46.93°、55.80°、および58.93°です。 。これらのピークは、ZB GaPの(200)、(220)、(311)、および(222)面を表しています[46]。 InPとGa粉末の入力重量比は、In 0.44 の公称組成を表していますが Ga 0.56 P、XRDデータは、予想される3成分のInGaPナノワイヤーではなく、GaPナノワイヤーの成長が成功したことを示しています。ナノワイヤの成長をInPからGaPに完全に変換できるのは、少量のGa粉末だけなので、これは非常に興味深いことです。この現象を正確に調査するために、エネルギー分散型X線分光法(EDX)分析のためにこれらのナノワイヤをSi基板に転写します。 3.0 mgのGa粉末を使用して550°Cで成長させたナノワイヤの典型的なSEM画像と対応するEDXスペクトルを図3c、dに示します。 EDXスペクトルは、GaとPからの優勢なピークのみを示し、Inの非常に弱いピークのみを示します。さらに、このナノワイヤに沿ったEDX分析は、同じ組成分布を示しています。この結論は、測定されたすべてのナノワイヤに当てはまります。これらのEDXスペクトルは、成長したままのナノワイヤが主にGaPであるというXRDの結果とよく一致しています。

InGaPナノワイヤーの合成。 a 特徴的なSEM画像が埋め込まれた、さまざまな成長温度(550〜630°C)でのInGaPナノワイヤの直径分布。 b 異なる成長条件でのInP(赤い曲線)およびInGaP(青い曲線)ナノワイヤのXRDスペクトル。 Si(111)基板のXRDスペクトルは、参照として挿入図に示されています。 SEM( c )および対応するEDSスペクトル( d )550°Cで成長させたInGaPナノワイヤの。ガリウム粉末の重量は3.0mg
成長の基本をさらに明らかにするために、InPおよびGaPナノワイヤのTEM分析を実行し、図4に示します。通常、メインのInPおよびGaPナノワイヤは、ZB構造[47、48]で[111]方向に沿って成長し、上記のXRD分析。特に、InPナノワイヤは双晶超格子のような構造を示し(図4aを参照)、これはMOCVDを介して高温で成長したInPTSLナノワイヤに似ています[16]。周期的な双晶面の距離は35〜21 nmの間でわずかに変動し、成長方向に沿って、特にAu液滴の近くで減少するようです。比較すると、高密度の平面欠陥がGaPナノワイヤに見られます。 Au液滴に近い高分解能TEM(HRTEM)画像(図4e、fを参照)は、液滴が主にAuIn 2 で構成されていることを示しています。 ZBフェーズ[49]。さらに、AuIn 2 とGaPナノワイヤーは同じ結晶方位を示します。したがって、AuIn 2 凝固プロセス中に、GaPナノワイヤ上に相がエピタキシャル成長します。 InPナノワイヤ上のAu液滴は同じ明るさのコントラストを示し、単相を示唆しています。ちなみに、AuIn 2 の凝固後は、少量のAuリッチ層が形成されているようです。 図4gの輝度コントラストと追加ファイル1の図S1のEDXマッピングに基づいています。図4hのEDX分析の比較により、GaPナノワイヤの形成が確認され、Inピークはほとんど観察されません。ただし、インジウムは触媒の主要元素です。 InとAuの相対比は、InPとGaPの両方のナノワイヤで同じです。図4eのHRTEM分析に基づくと、触媒相は主にAuIn 2 です。 。 Gaの導入は、In含有量を減少させないが、触媒中のGaのわずかな濃度をもたらすだけである。ただし、Gaの含有量は、液滴からナノワイヤへのInの核形成を阻害するのに十分な高さであるため、GaPナノワイヤのみを形成します。 InPおよびGaPナノワイヤの大きな触媒形状の違いは、局所的な表面張力の違いによって引き起こされます[50]。これらのEDX観察は、なぜ触媒中のはるかに高いIn含有量がInリッチInGaPナノワイヤーの形成をもたらさないのかという疑問を提起します。
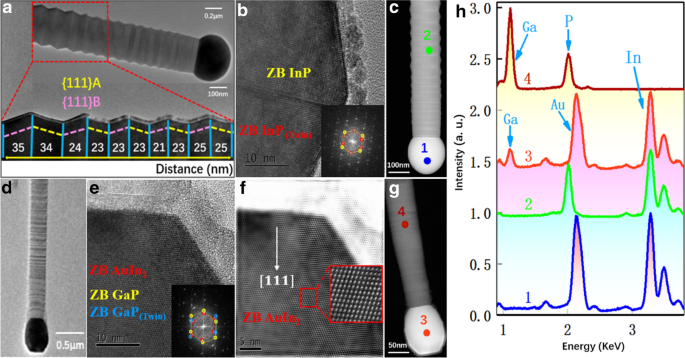
InPおよびGaPナノワイヤの構造および組成分析。 a 、 b InPナノワイヤのHRTEM画像。ZB双晶超格子構造を示しています。 d 、 e GaPナノワイヤのTEM画像。 f AuIn 2 の形成を示すAu液滴の高速フーリエ変換画像 段階。同じInP( c )の高角度環状暗視野(HAADF)画像 )およびGaP( g )ナノワイヤー。 h ( c のポイント1〜4のEDXスペクトル 、 g )。 EDX強度は正規化され、可視性のためにシフトされます
この組成の不一致を理解するために、2つのAu–Ga–InおよびGa–In–P熱力学データベースを組み合わせてAu–Ga–In–P四元系で熱力学計算を実行しました[51、52]。疑似二元状態図(図5aを参照)によると、三元InGaP化合物には混和性ギャップが存在するため、InGaPナノワイヤの組成調整が困難になります。熱計算ソフトウェアを使用して、過飽和Au液滴からのInGaPの凝固を計算し、Auシードナノワイヤの成長をシミュレートします。実験によると、触媒の温度とインジウムの組成範囲は、それぞれ793〜873 Kと50〜80 at。%です。液滴にGaを添加したときのInGaPの計算された組成を図5bに示します。熱力学的に、Ga含有量が1 at。%を超えると、ナノワイヤの核形成はInPからGaPに変化します。 InGaPナノワイヤは、Ga含有量が1 at。%未満の場合にのみ形成できますが、この条件は私たちの実験ではほとんど達成できません。さらに、この傾向は、触媒中の成長温度およびインジウム含有量とはほとんど無関係です。これらの計算は、さまざまな成長条件でのGaPナノワイヤの形成をよく説明しています。また、それは私たちのシステムでのInGaPナノワイヤの成長が平衡状態に近いことを示唆しています。さらなる駆動力(∆ μ )図5cの分析は、このような急激な合成変換を説明しています。 InPを形成するための駆動力は、Au液滴のインジウム含有量と成長温度の変化によってわずかに変化します。代わりに、触媒に少量のGaを加えると、駆動力が急激に変化します。液滴中のガリウム含有量がインジウムの10分の1を超えている場合でも、駆動力が大幅に増加すると、InPではなくGaPが形成されます。これは、熱力学的に、GaPがInPよりもはるかに安定しているためです。熱力学的計算によると、InGaPナノワイヤの成長は困難です。したがって、成長条件をダイナミクス制御領域にプッシュして、三元ナノワイヤを形成することをお勧めします[5]。別のアプローチは、選択領域エピタキシーアプローチ内でInGaPナノワイヤを成長させることです[32]。それ以外の場合は、Au触媒を別の可能な金属に置き換えるか、触媒なしでナノワイヤを成長させる必要があります[32]。さらに、図5dで、自己シードしたInGaPナノワイヤの状況を計算しました。 InPナノワイヤ形成の推進力は、Au液滴と比較して強化されています。しかし、それでも、GaPを形成する原動力はInPよりもはるかに大きく、この方法によるInGaPナノワイヤの自己触媒成長は、組成制御を実現するのが依然として難しいことを示唆しています。

核形成プロセスの熱力学的分析。 a 疑似バイナリInP-GaP状態図。計算済み( b )In x のコンテンツ Ga 0.5- x P 0.5 ギブズのエネルギー変化( c )Au液滴中のGa含有量の関数として。 d インシード条件下でのInGaPナノワイヤ形成の組成とギブズエネルギー分析
上記の実験的観察とCALPHAD計算は、熱力学がIII–Vナノワイヤの成長を決定する上で不可欠な要素であることを示唆しています。その結果、有効な熱力学的データベース、特にナノサイズ効果を含むデータベースを構築し、CALPHADアプローチの原理を使用することで、組成や結晶構造を含むがこれらに限定されないIII–Vナノワイヤーの成長を導く重要な熱力学的情報を提供できます。
結論
結論として、真空CVD法を使用して、高密度で大面積にInPおよびGaPナノワイヤを成長させることに成功しました。 PLおよびXPS分析により、In 2 の形成が確認されました。 O 3 より低い成長温度で、〜775〜811nmの範囲で幅広い発光ピークをもたらしました。温度を上げると、酸化物の形成を防ぎ、InPナノワイヤの純度を高めることができます。その結果、高温で成長したInPナノワイヤは、室温で強い発光ピークを持つZB双晶超格子構造を形成します。さらに、さまざまな特性評価手法によって確認されたように、リアクターに少量のGaを追加することにより、InPからGaPナノワイヤーへの急激な遷移を観察しました。テストされたすべての成長温度とGa / InP粉末の比率により、GaPナノワイヤが形成されます。詳細なEDX研究では、Au触媒には高いインジウム含有量が含まれていますが、ナノワイヤには含まれていないことが明らかになっています。四次熱力学データベース(Au–In–Ga–P)を組み合わせて、凝固プロセスを計算します。計算によると、GaPの核形成駆動力が急激に増加するため、Au触媒中の1 at。%Gaだけで、ナノワイヤの成長をInPからGaPに転送するのに十分です。計算はまた、この現象が広い成長条件範囲で有効であり、自己核形成InGaPナノワイヤ成長でも有効であることを示しており、観察された成長の基本を十分に説明しています。したがって、CALPHAD法を使用した熱力学的計算は、III–Vナノワイヤの成長を導くのに役立つと考えています。
データと資料の可用性
著者は、この研究の結果を裏付けるデータが記事内で利用可能であることを宣言します。
略語
- CALPHAD:
-
状態図の計算
- MOCVD:
-
有機金属化学蒸着
- MBE:
-
分子線エピタキシー
- CVD:
-
化学蒸着
- SEM:
-
走査型電子顕微鏡
- TEM:
-
透過型電子顕微鏡
- EDS:
-
エネルギー分散型スペクトル
- PL:
-
フォトルミネッセンス
- VLS:
-
蒸気-液体-固体
- LO:
-
縦光学
- TO:
-
トラバースオプティカル
- ZB:
-
ジンクブレンデ
- WZ:
-
ウルツ鉱
- XPS:
-
X線光電子分光法
- EDX:
-
エネルギー分散型X線分光法
- HRTEM:
-
高分解能透過型電子顕微鏡
ナノマテリアル
- ANDROID SMARTPHONEから制御されるRASPBERRYPI WIFI ROBOT
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- 将来の情報技術のためのリン化ガリウムの利用
- 有機金属化学蒸着によるInAsステム上での垂直GaSbナノワイヤの自己触媒成長
- ナノテクノロジー:invivoイメージングシステムから制御されたドラッグデリバリーまで
- 低温での急速熱アニーリングプロセスによる成長の制御高均一性セレン化インジウム(In2Se3)ナノワイヤ
- 最大の太陽エネルギー収穫のためのInPナノワイヤの効率的かつ効果的な設計
- 水熱反応によりレモンジュースから製造された蛍光炭素量子ドットの材料と光学特性
- 成長ドーピング法による二重発光および色調整可能なMnドープInP / ZnS量子ドット
- InGaAs / InPコアシェルナノワイヤの自己シードMOCVD成長と劇的に増強されたフォトルミネッセンス
- 小さな希土類フッ化物ナノ粒子は、電気極性相互作用を介して腫瘍細胞の成長を活性化します



