フィーチャーサイズを縮小し、エッチングストッパー層構造をクリーンにしたa-IGZOTFTの信頼性向上
要約
拡散Cu + の効果 アモルファスインジウム-ガリウム-亜鉛-酸化物(a-IGZO)薄膜トランジスタ(TFT)の微細構造と、クリーンエッチングストッパー(CL-ES)プロセスおよびバックチャネルエッチング(BCE)プロセス中の性能を調査および比較します。 。 TOF-SIMSで検証されたクリーンなコンポーネントで形成されたCL-ES層は、a-IGZO層をS / Dエッチャントから保護し、Cu + を防ぐことができます。 拡散。アクセプターのような欠陥の数を減らし、TFTの信頼性を向上させるのに役立ちます。製造されたCL-ES構造のTFTは、優れた出力安定性を備えています(最終的な I ds / initial I ds =82.2%)BCE構造のTFT(53.5%)と比較して、初期SS値(0.09 V / dec vs 0.46 V / dec)と最終SS値(0.16 V / dec vs 0.24)が優れているためです。 V / dec)高電流ストレス(HCS)評価後。特に、しきい値電圧の変動には大きな差があり(CL-ESTFTでは3.5V、BCETFTでは7.2V)、CL-ES構造のTFTはBCE構造のTFTよりも信頼性が高いことを意味します。 TFT。したがって、CL-ESプロセスは、半導体業界におけるa-IGZO技術の広範な適用を促進することが期待されています。
背景
最近、ディスプレイ製品は、広い領域と高解像度だけでなく、見た目に美しいエクステリアデザインも強調しています[1,2,3]。このデザインを強調するための重要な機能の1つとして、狭いベゼルが採用されています[4]。これを実現するには、ディスプレイを駆動する主回路をパネルに統合することが不可欠です。アレイ上のゲートドライブIC(GOA)は、比較的単純で一般的に使用される方法であり、ゲート信号が次々にパネルに入り、 V オン 毎回順番に移動します。 GOAには、コストの削減(G-ICコストの排除、G-ICボンディングプロセスの削除、ガラス基板の使用率の向上など)や美的効果(狭いベゼルまたはボーダレスデバイス)など、複数の利点があります[5]。ただし、個々のピクセルTFTとは異なり、GOA TFTは、より高い出力電流とより長い定時運航を実現するために、より厳しい信頼性条件を必要とします。高解像度製品に対する最近の市場の需要の高まりに伴い、GOAパフォーマンスの信頼性の向上が緊急かつ必要になっています[6]。
アモルファスインジウム-ガリウム-亜鉛-酸化物(a-IGZO)は、飽和電子移動度が高い(5〜10 cm 2 )ため、ディスプレイ業界で広く使用されています。 / V s)および低オフ電流(<1 pA)[7、8]。バックチャネルエッチング(BCE)技術は、業界でTFTの製造に一般的に使用されています[9、10]。 BCE構造のa-IGZOTFTは、個々のピクセルTFTに対して十分な特性を持ち、GOATFTのサイズを縮小します。ただし、一部の主要なTFT特性、特に出力電流の安定性は、主にBCEプロセスの2つの機能[14]により、GOA TFTに必要な高電流ストレス(HCS)環境を満たすことができません[11、12、13]。 1つ目は、a-IGZOフィルム(a-IGZO TFTのバックチャネル)の表面が、従来HNO 3 で構成されていたS / Dエッチャントにさらされていることです。 、H 3 PO 4 、およびCH 3 COOH、エッチング速度が速く、a-IGZOフィルムでは制御できません[15]。穏やかなH 2 O 2 S / D電極(Cu金属)のエッチングには、安定したエッチングとa-IGZO膜へのダメージが少ないベースのエッチャントを使用できますが、a-IGZO膜の表面への損傷は避けられません[16]。第二に、S / D金属(Mo / Cu / Mo)がa-IGZOフィルムと直接接触すると、TFTバックチャネルが汚染される可能性があります[17]。幸いなことに、クリーンエッチングストッパー(CL-ES)プロセスを使用すると、複雑でコストがかからず、汚染が最小限に抑えられ、大面積ディスプレイの均一性と安定性が向上したa-IGZOベースのTFTを製造できます[18]。 CL-ES構造のTFTは改善された性能を示しますが、エッチャントがa-IGZOフィルムとどのように反応するか、およびCu + がどのように反応するかという問題があります。 a-IGZOフィルムへの拡散は微細構造に影響を与え、デバイスの性能は不明なままです。
本研究では、多層a-IGZO / Mo / Cu / MoのバッチエッチングによるCL-ESプロセスにより、フィーチャーサイズを縮小し、バックチャネル構造をクリーンにしたa-IGZOGOATFTを作製しました。さらに、エッチャントとCu + の影響 CL-ES構造のa-IGZOGOA TFTデバイスの微細構造と性能に関する拡散を研究し、BCE構造のa-IGZO GOATFTデバイスと比較します。さらに重要なことに、CL-ESデバイスのエッチングストッパー層は、Cu + と同様にS / Dエッチャント保護層として機能します。 拡散バリア層は、欠陥の量を減らし、高電流ストレスの信頼性、SS値、高電流ストレス、しきい値電圧の変動などの信頼性を向上させるのに役立ちます。したがって、この作業は、改善されたという直接的な証拠と洞察に満ちたデモンストレーションを提供しますCL-ES構造のTFTの性能は、CL-ES構造とクリーンなコンポーネントと高い相関関係があり、CL-ESプロセスが満足のいく性能を備えたディスプレイの大量生産のための効率的なルートである可能性があることを確認しています。
実験方法
a-IGZO GOATFTの製造
CL-ES構造のa-IGZOTFTデバイスは、以前の研究[15]で報告されているように、修正された5ステップのCL-ESプロセス(図1)を介して製造されました。まず、ゲート電極をMo / Cu金属で形成し、ゲート絶縁体を340°CでPECVDを使用してSiNx / SiOx(3000Å/1000Å)二重層で堆積しました。次に、300Åのa-IGZO膜を、15%の酸素分圧で室温でDCマグネトロン反応性スパッタリングを使用して堆積させました。 1000Åのエッチングストッパー層(SiOx、ESL)は、240°CでPECVDを使用して堆積され、CF 4 によって反応的にエッチングされました。 エッチングマスクとしてBCEプロセスのアクティブフォトリソグラフィマスクを使用した、パターニング用のプラズマ。このステップでは、ESレイヤーパターンの下のa-IGZOフィルムをCF 4 への露出から保護しました。 プラズマは、ES層パターンで保護されていない残りのa-IGZOフィルムもエッチングされませんでしたが、導電性フィルムに変換されました。第三に、ソース-ドレイン(S / D)電極(Mo / Cu / Mo三重層)をスパッタ蒸着し、H 2 を使用してエッチングしました。 O 2 0.2 wt%のフッ化物添加剤を含むエッチャント。S/ DフォトリソグラフィーマスクとES層パターンがエッチングマスクとして機能します。第四に、3000Åのパッシベーション層が堆積されました。その後のプロセスは、一般的なTFTLCDバックプレーン製造のプロセスと同様でした。

a-IGZO GOA TFT
の製造工程比較のために、BCE構造のa-IGZO TFTデバイスは、従来のBCEプロセスと同じBCEマスクを使用して製造されました。
特性評価
サンプルの形態、微細構造、および組成は、SEM(Camscan Mx2600FE)、X線光電子分光法(XPS、PHI Quantera II)、および飛行時間型二次イオン質量分析(IONTOF、TOF-SIMS 5)を使用して特徴付けられました。 。電気測定は、半導体特性アナライザー(Keysight 4082A)を使用して、暗い環境および60°Cで実行されました。簡単にするために、HCSの信頼性は V で1000秒以上評価されました。 gs 25Vおよび V ds 評価中、 I を測定することにより、GOATFTの状態を監視しました。 ds 1秒間隔の電流、および I の傾向 ds 電流を分析しました。 私 d -V g 転送特性も100秒間隔で監視されました。
結果と考察
CL-ESプロセスで製造されたTFTチャネルとゲート、ドレイン、およびソースコンポーネントを含むGOA TFTデバイスを図2に示します。各TFT特性を正確に測定するために、すべてのTFTをレーザーを使用して切断しました。独立するため、ゲート、ソース、およびドレインは他のTFTとノードを共有できません。図2の赤い線で示されているように、このTFTは、電気測定の便宜のために、チャネル幅と長さがそれぞれ120μmと10μmのマルチチャネルと分離されたGOA構造設計を備えています。このTFTは、各チャネルを統合するフローティング金属片(チャネルの中央に配置)を配置することにより、個々のTFTチャネルに平均レベルの電流が流れるようにも設計されています。 HCSの信頼性評価の前に、他の周辺TFTからの対象のTFTの電気的干渉を評価することにより、分離された動作の信頼性を最初に確認します。この場合、 I オフ 分離されたGOATFTのノイズ電流は3pAと測定され(図2の挿入曲線)、近くにある他のGOA構成デバイスからの電気的干渉がないことを確認しています。
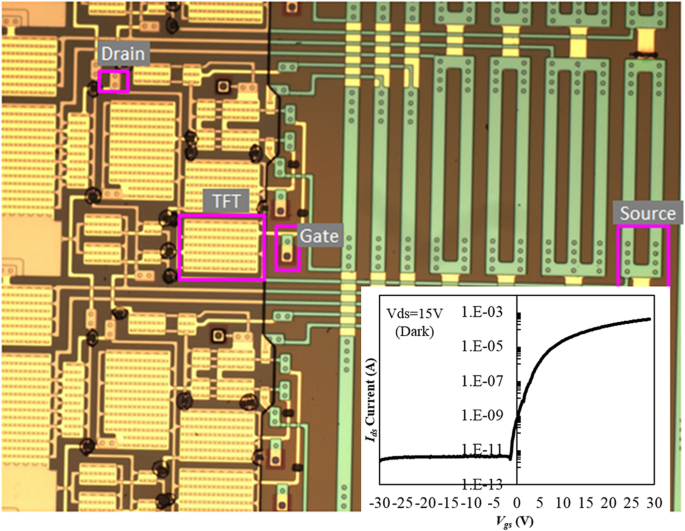
GOA回路から電気的に分離されたGOATFTの写真(挿入: I オフ 対象のTFTと他の周辺TFT間のノイズ電流)
CL-ES構造のTFTとBCE構造のTFTのいくつかのフィーチャサイズが測定され、比較されます。 CL-ES構造のTFT(図3a)の場合、幅と長さはそれぞれ4μmと6μmであり、図3bのBCE構造のa-IGZOTFTと同様です。一般に、BCEプロセスは、フィーチャサイズが小さいため、酸化物TFTの製造に適しています。したがって、得られたCL-ES構造のTFTは、BCE構造のTFTと同じくらい、特徴サイズが小さく、積分度が高くなっています。さらに、CL-ES構造のTFTの断面サイズはBCE構造のTFTの断面サイズと同様ですが(図3c、d)、CL-ES構造のTFTは、観察されない明確なES層を示しています。 BCETFTで。 CL-ESプロセスは主にESパターンを形成しますが、多層a-IGZO / Mo / Cu / Moのバッチエッチングプロセスは、BCEプロセスと同様のアクティブパターンとソース-ドレイン電極のマスクを使用して実行できます。したがって、ESパターンを除いて、CL-ESプロセスで使用されるフォトリソグラフィマスクの数はBCEプロセスの場合と同じです。このCL-ESプロセスは、従来のESLプロセスのマスク数の増加を回避でき、フィーチャーサイズが縮小されているため、大量生産に経済的に実行可能です。さらに、ハーフトーン露光を使用せずに、TFT LCD業界で従来使用されていたプロセス簡素化手順により、プロセスの複雑さと製造コストの両方が削減されます。
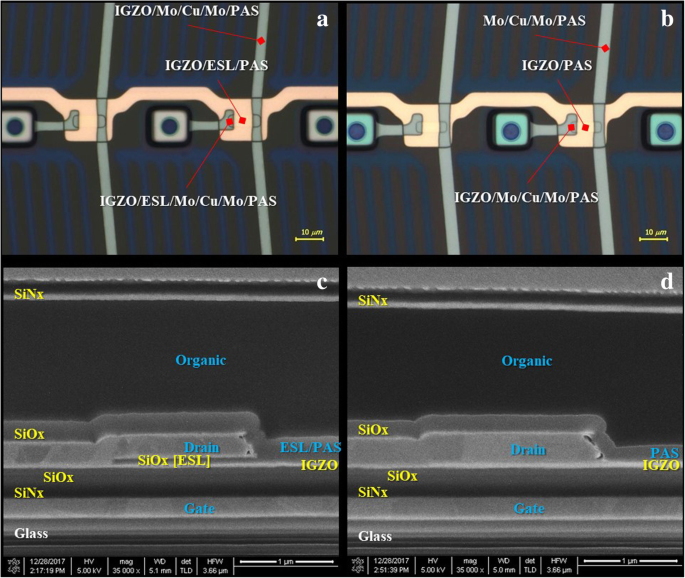
a-IGZO TFTのSEM画像: a CL-ES構造のTFT上面図、 b BCE構造のTFT上面図、 c CL-ES構造のTFT断面図、および d BCE構造のTFT断面図
BCE製造プロセス中のBCE構造TFTの表面欠陥をさらに観察するために、アニーリング前(サンプル1)、アニーリング後(サンプル2)、およびH2への曝露後のa-IGZOフィルムの表面組成 O 2 Cuエッチャント(サンプル3)はXPSを介して調査されます。 a-IGZOフィルムの完全にスキャンされたスペクトル(図4a–c)では、BCE製造プロセス中に、In、Ga、Zn、O、およびC元素のピークが存在します。図4dに示すように、BCE構造のTFTは、アニーリング前(サンプル1)と330°Cで1時間のアニーリング後(サンプル2)にa-IGZOフィルムの組成に大きな変化は見られませんが、大きな変化は湿った化学物質への暴露後に観察された(サンプル3)。特に、酸素との結合エネルギーが比較的低い亜鉛は、サンプル1で4.82%、サンプル2で5.42%でしたが、サンプル3では3.16%に減少しました。インジウムの組成のばらつきは最小限です。さまざまなプロセス、およびInに対するZnの相対的な変化率は非常に大きく、サンプル1、2、および3でそれぞれ44.1%、46.0%、および27.6%です。これは、酸素との強い結合親和性を持つガリウムでも同様です。言い換えれば、ウェットエッチングプロセス中に、ZnおよびGaの実質的な損失を含む望ましくない欠陥が、酸化物半導体の露出した裏面に発生した。この現象の理由は、酸素への結合エネルギーの違いと、a-IGZOフィルムの分子構造の違いに関連している可能性があります[19]。

a-IGZO薄膜の表面組成のXPS分析 a アニーリングの前に、 b アニーリング後、および c H 2 への暴露後 O 2 BCEプロセス中のCuエッチャント。 d 上記のプロセスに対応する原子の割合
酸性エッチャントに対するa-IGZOフィルムの耐薬品性は非常に弱いことはよく知られています[20]。特に、a-IGZOの分子構造を決定すると考えられているZnの急激な損失は、a-IGZO膜の表面構造の弱体化を引き起こします。さらに、酸素との強い結合エネルギーを介してキャリア生成を抑制するGaの還元は、酸素空孔を発生させる可能性を高める可能性があります[Vo] [21]。したがって、BCE構造のGOA TFTは、比較的穏やかなH 2 であっても、TFTバックチャネルへのエッチングによる損傷を回避できません。 O 2 ベースのCuエッチャント。
ES層の保護を確認するために、BCEおよびCL-ES(クリーンエッチングストッパー)プロセスで調製されたサンプルのTOF-SIMSを使用して、a-IGZO TFTチャネル領域の組成を調べます(図5)。 Cu + 以降 a-IGZOフィルムはアクセプター型の欠陥を生成し、電子をトラップする可能性があるため、電気的安定性を高めるためにa-IGZOTFTチャネルをクリーンにする必要があります。観察されたように、Cu + BCEサンプルで検出されたピークはCL-ESサンプルの20倍です。また、Cu + の検出領域 Zn + の検出領域と重なっています およびGa + かなりの程度(図5a)。これらの結果は、BCE構造のTFTのa-IGZO膜がCu + で汚染されていることを示しています。 TFTバックチャネル領域のa-IGZO膜がCu金属と直接接触するためです。 CL-ES構造のTFT(図5b)の場合、Cu + ES領域でのみ検出され、a-IGZOTFTチャネル領域とCu金属との直接接触が回避されていることを示しています。驚いたことに、かなりの量のZn + ESLに表示されます。拡散したZn + これは、ESL堆積中のより高い前処理プラズマ条件と圧力条件によって引き起こされます。したがって、CL-ES構造のTFTのES層は、a-IGZO膜の表面の損傷や汚染を回避することにより、電気的安定性を向上させるために不可欠です。

a を介して製造されたa-IGZOTFTのチャネル領域のTOF-SIMS分析 BCEと b CL-ESプロセス
CL-ESおよびBCE構造のGOAa-IGZO TFTの高電流ストレス(HCS)評価を図6aに示します。同じフィーチャサイズの場合、最初の I ds CL-ES構造のTFTの電流は429μAであり、BCE構造のTFTの電流(343μA)よりも高くなっています。 1000秒間のHCS評価後、 I ds CL-ES構造のTFTの電流は352μAで、初期値の約82.2%です。対照的に、 I ds BCE構造のTFTの残留電流は183μAに減少し、初期値の53.5%しか維持していません。さらに、外挿によって評価されるように(図6b)、 I ds CL-ES構造のTFTの残留電流は302.6μAと予想され、10,000秒後に初期値の70.5%を維持します。 BCE構造のTFTの場合、 I ds 残留電流は111.7μAまで急激に減少し、初期値の33.7%しか維持しません。したがって、同じ出力特性の下で、CL-ESプロセスを介して製造されたGOA TFTの統合度は、BCEプロセスの統合度と比較して最大271%向上する可能性があります。
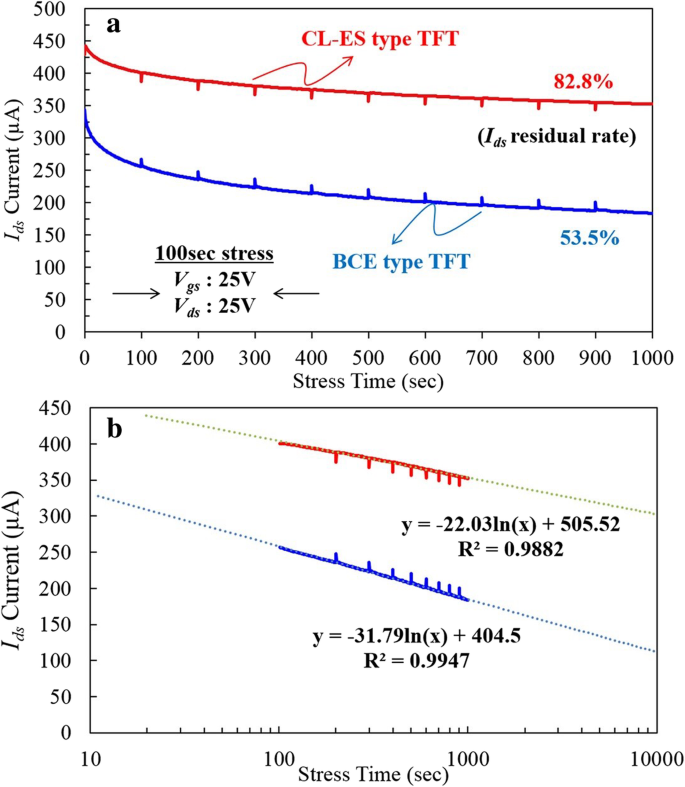
a 1000sおよび b の実験データ CL-ESおよびBCE構造のGOATFTの長期HCS評価のための外挿
さらに、 I - V HCS信頼性評価中のCL-ESおよびBCE構造のGOATFTの両方の伝達特性も測定されます(図7および表1)。 CL-ES構造のTFT(図7a)の場合、しきい値電圧は、最初のHCS評価(25°C)では0.0 V、HCS評価後は60°Cで1000秒で3.5Vです。さらに、しきい値電圧は、全体の変化(ΔV)とともに正の方向に連続的にシフトします。 th )の3.5V。サブスレッショルドスイング(SS)値は0.09から0.16 V / decにわずかに増加します。 BCE構造のTFTの場合、しきい値電圧ははるかに高く、25°Cで4.0 Vであり、60°Cで1000秒間のHCS評価後に11.2Vに増加します。これらの高いしきい値電圧の考えられる理由は、Cu + の拡散です。 BCEプロセスのウェットエッチングプロセス中にa-IGZOフィルムに注入されます。 Cu + a-IGZO膜のアクセプター型欠陥サイトとして機能し、高密度のCu + 多数の電子をトラップできます。トラップされた電子は、遮蔽されたクーロンポテンシャルを生成し、その結果、過渡しきい値電圧シフト現象が発生します。一般に、ゲート絶縁体のバルクと、a-IGZO膜のバルク内に新しく形成された欠陥サイトは、TFTのSS値を増加させる可能性があります[11]。これらの結果は、 I の減少を明確に説明しています。 ds BCE構造のTFTの残留電流。ただし、BCE構造のTFTのSS値は、0.46から0.24 V / decに減少する傾向を示しています。このSS値の低下は、a-IGZO界面付近に電子が蓄積した結果、ゲート絶縁体が最初に存在したアクセプター型トラップサイトの高レベルを急速に満たす可能性があります。さらに、トラップサイトはHCSによって生成されるよりも速く満たされるため、トラップされる電子の数は時間の経過とともに徐々に減少します。これは、しきい値電圧の正のシフト動作と一致します。

私 - V a のHCS評価中に測定された伝達特性 CL-ESと b BCE構造のGOATFT。 c の動作 しきい値電圧と d 1000秒と V の間隔でのサブスレッショルドスイング ds =15 V. I の初期測定値 d -V d e の出力特性 CL-ES-および f V を備えたBCE構造のGOATFT gs =0、5、10、15、および20 V
CL-ESの特性の均一性については、ESLがCu + からのアクティブなバックチャネル保護を提供するためです。 汚染とエッチャントの損傷により、その結果はBCEの結果と比較して安定しています。さらに、出力曲線の特性はBCEの違いを示さず、CL-ESの生成と安定性を約束できることに注意してください(表2、図7e、f)。
<図>図7cおよびdは、サブスレッショルドスイングとスレッショルド電圧の動作の結果とHCS評価の進行状況を示しています。一般に、CL-ES構造のTFTで見られるように、GOA TFTのサブスレッショルドスイング値は徐々に増加します(図7d)。ただし、BCE構造のTFTは異常な動作を示し、サブスレッショルドスイング値は最初は増加し、その後HCS評価中に減少します。 BCE構造のTFTのSS値は、基板温度が25から60°Cに上昇すると、0.46°から0.55°V / decに上昇します。同時に、しきい値電圧は4.0から2.9 Vに負にシフトします(図7c)。この異常現象は、H 2 によるa-IGZOフィルム表面の損傷に起因します。 O 2 フッ化物を添加したエッチャント。前述のように、a-IGZO膜の表面損傷は、Zn、Ga、および酸素原子の欠如を意味し、酸素空孔を含む多数の欠陥サイトを形成します。これらの欠陥部位は、最小伝導帯に近い浅いドナーのような状態として活性であり、熱励起が可能であり、伝導帯の電子源として作用し、a-の劣化をもたらすと考えられている。 IGZOTFTの特性。上記の結果に基づくと、小さなアクセプターのような状態と浅いドナーのような状態として機能する酸素欠乏を伴うCL-ES構造のTFTは、BCE構造のTFTよりもはるかに優れた構造です。
結論
結論として、CL-ES構造のGOA TFTは、デバイスのフィーチャサイズが小さく、エッチングストッパー層がきれいであるため、デバイスのパフォーマンスと安定性を大幅に向上できることを示しています。提案されたCL-ES構造のTFT製造プロセスにより、TFTバックチャネルの損傷と汚染が最小限に抑えられます。さらに、BCE構造のGOA TFTと同程度の統合により、CL-ES構造のTFTプロセスは、美的設計と製造コスト効率の目標を達成できます。 CL-ES構造のGOATFTは、BCE構造のGOA TFTと比較して優れた電気的性能を示します。これには、はるかに高い残留イオン電流(〜187%)、はるかに低い初期SS値(0.09 V / dec)、およびしきい値電圧の変動がはるかに小さい(3.5 V)。これは、はるかに高い統合性と信頼性を備えたGOA設計の可能性を意味します。強化された性能と安定性は、CL-ES構造のTFTが、簡素化されたプロセスとクリーンなエッチングストッパー層により、酸素欠乏によって引き起こされるドナーのような欠陥とCu +によって引き起こされるアクセプターのような欠陥をうまく克服することを示唆しています。 BCEプロセス中の拡散。したがって、CL-ES構造のTFTのa-IGZOチャネル領域のきれいな表面組成は、高信頼性、高解像度、ナローベゼルディスプレイを備えたa-IGZOTFTバックプレーンの製造にとって重要です。
略語
- TFT:
-
薄膜トランジスタ
- GOA:
-
アレイ上のゲートドライブIC
- a-IGZO:
-
アモルファスインジウム-ガリウム-亜鉛-酸化物
- LCD:
-
液晶ディスプレイ
- PEVCD:
-
プラズマ化学気相成長法
- ESL:
-
エッチングストッパー層
- BCE:
-
バックチャネルエッチング
- HCS:
-
高電流ストレス
- SiOx:
-
酸化ケイ素
- SiNx:
-
窒化ケイ素
- SS:
-
サブスレッショルドスイング
ナノマテリアル
- Bluetoothメッシュを使用した設計:ノードと機能タイプ
- MCUは、パフォーマンス、接続性、セキュリティが強化されています
- 機械学習で信頼性を高め、メンテナンスの成果を向上させる
- 構造体とクラスの違い:C++ の例で説明
- スパイラル型アンテナによるマイクロブリッジ構造のTHzマイクロボロメータの周波数変調と吸収改善
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- エッチングストッパーナノレイヤーを介したクリーンなインターフェースプロセスを使用したa-IGZOTFTデバイスのパフォーマンスの向上
- アルゴンプラズマ処理によるZnOの挿入による金属とn-Ge間の接触抵抗の低減
- 強化されたデュアルゲートと部分的なP埋め込み層を備えた超低比オン抵抗横方向二重拡散金属酸化物半導体トランジスタ
- メチレンブルーの吸着特性が著しく向上した階層構造カオリナイトナノスフェア
- IBM:EAMによる信頼性と安全性の積極的な確保



