チャープ超格子電子減速層を備えたAlGaNベースの深紫外線発光ダイオードの性能の向上
要約
AlGaNベースの深紫外線(DUV)発光ダイオード(LED)は、電子のオーバーフローと不十分な正孔注入の影響を受けます。この論文では、超格子電子減速層(SEDL)を備えた新しいDUV LED構造を提案して、活性領域に注入された電子を減速し、放射再結合を改善します。 DUV LEDの性能に対するいくつかのチャープSEDLの影響は、実験的および数値的に研究されています。 DUV LEDは、有機金属化学蒸着(MOCVD)によって成長し、762×762μm 2 に製造されています。 チップ、275nmで単一ピーク発光を示します。 3.43%の外部量子効率と6.4Vの動作電圧が40mAの順方向電流で測定され、ウォールプラグ効率が上昇するAl含有量チャープSEDLを備えたDUV LEDの2.41%であることを示しています。この改善の原因となるメカニズムは、理論的シミュレーションによって調査されます。 Al含有量が上昇するチャープSEDLを備えたDUVLEDの寿命は、キャリア注入の促進により、L50で10,000時間以上と測定されています。
はじめに
近年、UVB(320 nm–280 nm)とUVC(280 nm–100 nm)に起因するスペクトルを持つAlGaNベースの深紫外線(DUV)発光ダイオード(LED)は、その用途のために大きな注目を集めています。植物の照明、光線療法、水の浄化、および空気と表面の滅菌[1,2,3,4,5,6]。ただし、最先端のAlGaNベースのDUV LEDの光出力(LOP)は、発光波長が短くなるにつれて大幅に低下します[7、8]。これらのDUVLEDは、内部量子効率(IQE)、光抽出効率(LEE)、およびキャリア注入効率(CIE)が低いという欠点があります[9、10、11、12、13]。一般に、IQEの不足は、高密度の欠陥と貫通転位によって引き起こされますが、LEEの不足は、AlGaN材料の分極と不透明なp-GaN接触層による吸収によるものです[14、15、16、17、18]。さらに、電子オーバーフローがCIEの低下の主な理由です。これは、不十分な正孔密度と、AlGaN材料の電子と正孔の移動度が著しく不均衡であるためです[19、20]。
従来、電子オーバーフローを抑制するために、高Al含有量のp型AlGaN電子ブロッキング層(EBL)が使用されていました。しかし、EBLによって導入された価電子帯の障壁を介して活性領域に注入できる正孔はごくわずかであり、活性領域の障壁を越えてn型層の近くの量子井戸に輸送できる正孔はさらに少ないためです。 Mgドーパントの活性化効率と正孔の小さな移動度[21]。正孔障壁層、特別に設計された最後の障壁、EBL、および複数の量子井戸構造など、電子と正孔の注入を改善するためにさまざまな試みがなされてきました[22、23、24、25、26]。それにもかかわらず、DUVLEDの性能は大幅に改善されていません。
この研究では、超格子電子減速層(SEDL)を備えた新しいDUV LED構造を提案し、正孔注入を損なうことなく電子注入を減速し、電子オーバーフローを抑制します。いくつかのSEDLがDUVLEDの性能に及ぼす影響を実験的および数値的に研究しました。 DUV LEDは、有機金属化学蒸着(MOCVD)によって成長し、762×762μm 2 に製造されています。 チップ、275nmで単一ピーク発光を示します。 3.43%の外部量子効率(EQE)と6.4Vの動作電圧が40mAの順方向電流で測定され、ウォールプラグ効率が上昇するAl含有量チャープSEDLを備えたDUV LEDの2.41%であることを示しています。上昇するAl含有量のチャープSEDLを備えたDUVLEDの寿命は、L50で10,000hを超えると測定されています。さらに、性能向上のメカニズムを理論シミュレーションにより調査します。チャープされたSEDLは、電子と正孔の活性領域への注入を平衡化できることが確認されています。これにより、n型層の近くの最初の数個の量子井戸での放射再結合が促進されます。
メソッドと実験セクション
MOCVDによるエピタキシー
AlGaNベースのDUVLEDヘテロ構造は、垂直コールドウォールMOCVDシステムを使用して成長させました。構造全体のエピタキシーには、トリメチルアルミニウム(TMA)、トリメチルガリウム(TMG)、およびアンモニア(NH 3 )は、それぞれAl、Ga、およびNソースとして使用されました。 H 2 キャリアガスとして使用されました。図1aは、チャープされたSEDLを備えたDUVLED構造の概略図を示しています。成長は、2.7μmの厚さのAlNで開始され、成長モードの変更のために最初のAlN勾配中間層を使用した成長方法[27]を使用し、次に3μmの厚さのSiドープAl 0.6 Ga 0.4 N n型接触層。このn型層の電子濃度と移動度は、4.5×10 18 と測定されます。 cm -3 と52cm 2 / Vは、それぞれホールシステムによるものです。その後に、厚さ40nmのドープされていないSEDLが続きます。図1b–e。は、従来のDUVLEDとSEDLを備えた3つの提案されたDUVLEDのバンド構造を示しており、それぞれサンプルA、B、C、およびDと名付けられています。図1cに示すように、サンプルBには、20周期の均一なAl 0.65 の均一なSEDLがあります。 Ga 0.35 N / Al 0.5 Ga 0.5 N超格子。サンプルCおよびDのチャープSEDLは、異なる高Al含有層(0.7、0.65、0.6、および0.55)を持つ4セットの5周期超格子で構成されていますが、低Al含有層のAl組成は次のとおりです。 0.5になるように一定に保たれました。サンプルCの場合、高Al含有層のAl組成は下から上に向かって徐々に上昇しています。これは、図1 dおよびeに示すように、サンプルDの場合とは逆です。 SEDLの各層の厚さは着実に1nmに設定されています。 DUV LEDのアクティブ領域は、Al 0.6 で構成されています。 Ga 0.4 電流拡散用のN:Siクラッド層と、それに続く14nmの厚さのAl 0.57 を使用した5周期の多重量子井戸 Ga 0.43 N個のバリアと2nmの厚さのAl 0.45 Ga 0.55 Nウェル。次に、Al 0.7 Ga 0.3 N:Mg EBLとGaN:Mgp型コンタクト層を順番に成長させました。 p-GaNの正孔濃度と移動度は3.6×10 17 と測定されています。 cm -3 と15cm 2 / Vは、それぞれホールシステムによるものです。
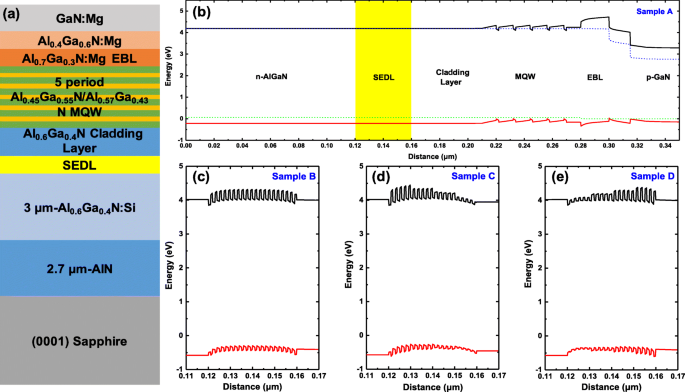
SEDLを使用した場合と使用しない場合のDUVLEDの設計構造のシミュレーション。 a チャープSEDLを備えたDUVLED構造の概略図。 n型AlGaN層とAlGaN電流拡散クラッド層の間に異なるAl組成の20周期SEDLを挿入します。 b 従来のサンプルの全バンド構造( a )SEDLなし。強調表示された領域は、SEDLが挿入される指定領域を示しています。 c サンプルのSEDLのバンド構造( b )、これは20周期の均質なAl0.5Ga0.5N /Al0.65Ga0.35N超格子です。 SEDLの各層は1nmです。 d サンプルのSEDLのバンド構造( c )、これは、異なる高Al含有量層、すなわち0.7、0.65、0.6、および0.55を持つ5周期減少Al含有量SEDL超格子の4セットです。 e サンプルのSEDLのバンド構造( d )、これは、異なる高Al含有層、すなわち0.55、0.6、0.65、および0.7を備えた5周期の上昇Al含有SEDL超格子の4セットです
デバイス製造
MOCVDの成長に続いて、DUVLEDは標準的な処理技術で製造されました。最初に、正方形と指の形状のメサ構造が、SiをドープしたAl 0.6 の上部から150nm下までドライエッチングすることによって形成されました。 Ga 0.4 N n型接触層、続いてエッチング損傷を修復するために900°Cのアニーリング。次に、Ti / Al / Ni / Au n接触金属スタックを堆積し、窒素雰囲気中で850°Cでアニールしました。続いて、ITO膜を蒸着し、p-contactを使用するために250°Cでアニールした後、厚い電極蒸着、パッシベーション層の蒸着、パッド蒸着、および762×762μm 2 へのステルスダイシングを行いました。 チップ。
シミュレーション
DUV LEDの性能向上のメカニズムを明らかにするために、この構造のバンド図、光学特性、およびキャリア輸送特性を、シュレディンガー方程式、ポアソン方程式、キャリア輸送方程式、および電流連続方程式を自己無撞着に解くことによってシミュレートしました。 Crosslight APSYS(半導体デバイスの高度な物理モデル)プログラム[28]。 Shockley-Read-Hall(SRH)再結合時間は、SRHの寿命がドーピングレベルに依存するため、p型挿入層を除くすべての層で1.5nsに設定されています[29]。内部損失は2000m -1 です。 [30]。お辞儀パラメータ b は1eVであり、バンドオフセット比はAlGaN材料では0.7 /0.3であると想定されています[31]。オージェ再結合係数は1×10 -30 に設定されています cm 6 / sは実験に適合します[32]。このシミュレーションでは、Fiorentini et al。によって提案された方法に基づいて、自発分極と圧電分極による組み込み界面電荷が計算されます。 [33]。さらに、欠陥によるスクリーニングを考慮して、表面電荷密度は計算値の40%であると想定されます[34]。
結果と考察
4つのサンプルが同一のAlNおよびn型AlGaNテンプレートを持っているため、サンプルA、B、C、およびDの結晶品質を高分解能X線回折(HR-XRD)によって測定しました。表1に示すように、両方のレイヤーの対称(002)平面と非対称(102)平面に沿ったX線ロッキングカーブ(XRC)が実行されました。結果は、4つのサンプルのXRC半値全幅(FWHM)と貫通転位密度(TDD)がほぼ同じであることを示しており、結晶品質がデバイスの性能向上の主な理由ではないことを示しています。さらに、AlGaN層の貫通転位密度(TDD)は、混合結晶特性、界面欠陥、およびSiドーピング不純物に起因するAlN層の貫通転位密度よりも高いことがわかりました[35]。バンらの研究によると。 IQEとTDDの相関関係については、この作業のすべてのサンプルのIQEは約30〜40%です[36]。
<図>新しい構造の成長が成功したことを確認するために、図2に示すように、代表的なサンプルBの断面明視野走査透過電子顕微鏡(BF-STEM)測定を実行しました。TDDが図2aの2.7μmの厚さのAlNの成長プロセス全体で減少します。図2bは、SEDLの各期間で、良好な周期性とほぼ1nmの厚さの層を示しています。さらに、異なる界面を持つ複数の量子井戸の5つの周期が図2cで認識されており、そのうちの障壁は14 nm、井戸は約2.1nmです。

典型的なサンプルBの形態特性評価。 a AlNテンプレートの断面STEM画像。 b SEDLの20周期の領域での断面STEM画像。 c アクティブ領域の断面STEM画像
デバイスの性能を調査するために、DUV LEDのチップをAlNセラミック基板に共晶接合して、加熱効果を最小限に抑えました。その後、基板をはんだペーストで六角形のアルミニウム板に取り付けた。次に、直径30cmの積分球を備えたATA-1000光電分析システムを使用して、電気的および光学的測定を行いました[37]。図3aは、光出力電力(LOP)と注入電流の変化を示しています。 Al含有量SEDLが上昇するサンプルDのLOPは、40mAで6.17mW、100mAで14.99mW、360mAで44.975mWであり、SEDLを使用しない従来のサンプルAの3倍です。これは、SEDLが電子オーバーフロー抑制と正孔注入に有益であることを示しています。一方、高バイアスで動作している場合、4つのサンプルでわずかなLOP飽和が観察されます。これは、加熱効果とオージェ再結合に関連しています[38]。注入電流に対するEQEを図3bに示します。最大EQEはサンプルDの40mAで3.43%ですが、EQEのピークはサンプルAでわずか1.17%です。一方、Al含有量SEDLが上昇するサンプルDのLOPとEQEは、均一でAl含有量SEDLの低下。これは、サンプルDでより効率的な放射再結合を示しています。すべてのサンプルで測定された電流-電圧特性を図3cに示します。 SEDLを組み込むと、高Al組成のSEDLの抵抗率が増加するため、動作電圧がサンプルAの40mAでの5.13VからサンプルBの40mAでの7.09Vに増加することがわかります。また、サンプルCとDの方がサンプルBよりも動作電圧が低いことがわかります。単層サンプルの構造設計と透過率測定によると、サンプルCとバリアの平均Al組成はD SEDLは62.5%ですが、サンプルBのSEDLは65%です。より高いAl含有量は、より低いドーピング効率およびより高い抵抗につながり、その結果、動作電圧が増加する。サンプルDの電圧は40mAで6.4Vであり、最大ウォールプラグ効率(WPE)は2.41%になります。 10mAでのエレクトロルミネッセンススペクトルを図3dに示します。 4つのサンプルのピーク放出はすべて275nm付近であり、ピーク強度の傾向はLOPと同じです。これは、昇順のAl含有量チャープSEDLがDUVLEDデバイスのパフォーマンスの向上に利用できることも示しています。
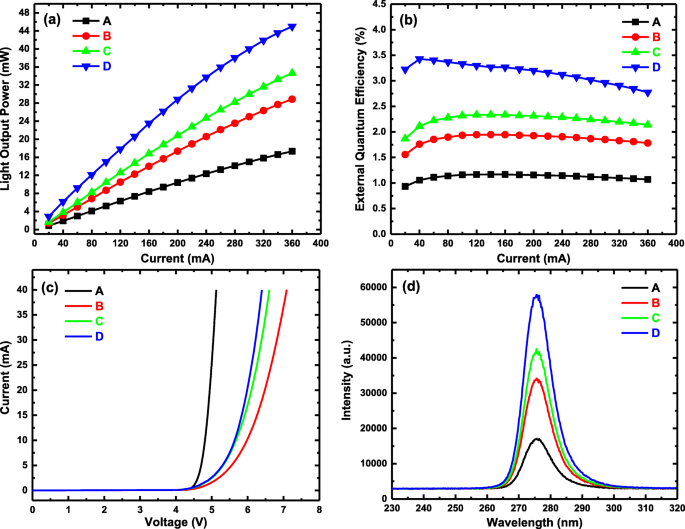
室温での異なるSEDLのサンプルの電気的および光学的特性。 a CWバイアス下でのLOPの注入電流への依存性。 b CWバイアス下での注入電流へのEQEの依存性。 c 注入電流の動作電圧への依存性。 d 10 mAの注入電流でのすべてのサンプルのELスペクトル、そのピーク放出は約275 nm
この改善の原因となるメカニズムを明らかにするために、APSYSプログラムによって理論シミュレーションを実行し、その結果を図4に示します。200mAでのアクティブ領域付近の電子電流密度と正孔電流密度の分布を図4に計算します。 4aおよびb。 SEDLを使用したサンプルの電子注入電流密度はSEDLを使用しないサンプルAの電子注入電流密度よりもわずかに低いことがわかりましたが、正孔注入電流の状況は逆であり、SEDLが電子をn型から減速できることを示しています。 AlGaN電子注入層とそれに応じて正孔注入を促進します。すべてのサンプルの放射再結合率は、図4cで計算されました。異なるSEDLを組み込むと、n型層の近くの量子井戸での放射再結合率が明らかに増加します。一方、サンプルAからサンプルDにかけて、5つの量子井戸の放射再結合率は徐々に均一になりつつあります。これは、Al含有量が上昇するチャープSEDLを使用したサンプルDとほぼ同じです。これはさらに、SEDLが電子キャリアと正孔キャリアの活性領域への注入を平衡化し、その間にn型層の近くの最初のいくつかの量子井戸で放射再結合を促進できることを示しています。その結果、4つのサンプルのIQEがシミュレートされ、図4dにプロットされました。サンプルDのIQEが最も高く、これは図4bのEQEと一致しています。さらに、SEDLを使用したサンプルの効率低下は明らかに改善されています。全注入電流範囲で、効率低下はサンプルA、B、C、およびDでそれぞれ70.33%、59.79%、48.93%、および36.26%であり、これは効率低下=(IQE maxとして定義されます) − IQE 250 mA )/ IQE max 。効率の低下は、一般に、電子の漏れと不十分な正孔注入によって引き起こされると考えられています[39]。効率の低下の改善は、SEDLが活性領域へのキャリア輸送のバランスを取り、量子井戸での放射再結合を促進し、最終的にデバイスの性能を向上させることができることを明らかにしています。

理論的なシミュレーションと分析。 a 200mAの注入電流でのアクティブ領域の電子電流密度。 b 200mAの注入電流でのアクティブ領域の正孔電流密度。 c 200mAの注入電流での複数の量子井戸における放射再結合率。 d 計算されたIQEの注入電流への依存性
デバイスの寿命は、20mAおよび室温で測定されました。各サンプルについて、結果の精度を確保するために、10個のチップがランダムに選択され、さまざまなストレス時間でのそれらの相対LOPの平均が図5に示されています。示されているように、サンプルAと比較して、サンプルの寿命SEDLで明らかに拡張されます。 LEDデバイスの劣化は、欠陥の蓄積、オーム伝導チャネル、およびキャリア注入の不足に部分的に関連しています[40]。寿命の改善は、SEDLが電子と正孔の輸送のバランスを取り、活性領域へのキャリア注入を促進できることをさらに検証します。さらに、上昇するAl含有量のチャープSEDLを使用したサンプルDの平均動作寿命は、L50で10,000 hを超えており、実際のアプリケーションに適しています。

20mAおよび室温でのすべてのサンプルのエージング時間の関数としての相対LOP。相対LOPが50%未満になると、エージングが停止します。黒、赤、緑、青の曲線はサンプルを表します a 、 b 、 c 、および d 、 それぞれ。昇順のAl含有量チャープSEDLを使用したサンプルDの寿命は、L50で10,000h以上です
結論
チャープされた超格子電子減速層がDUVLEDに及ぼす影響を、実験的および数値的に調査します。結果は、チャープされたSEDLがアクティブ領域への電子と正孔の注入を平衡化できることを示しています。これにより、n型層の近くの最初の数個の量子井戸での放射再結合が促進されます。放射再結合の増加は、DUVLEDデバイスの性能の向上にさらにつながります。 AlGaNベースのDUVLEDは、762×762μm 2 に製造されています。 チップ、275nmで単一ピーク発光を示します。 3.43%の外部量子効率と6.4Vの動作電圧が40mAの順方向電流で測定され、ウォールプラグ効率が上昇するAl含有量チャープSEDLを備えたDUV LEDの2.41%であることを示しています。 Al含有量が上昇するチャープSEDLを備えたDUVLEDの寿命は、キャリア注入の促進により、L50で10,000hを超えると測定されています。レーザーリフトオフ、表面粗面化、反射電極、およびカプセル化を導入することにより、さらなる改善が期待できます。一般に、チャープSEDLを備えた設計のDUV LEDは、十分な電気的特性、良好な光学性能、および望ましい信頼性を示し、高効率の浄水と表面滅菌に有望です。
データと資料の可用性
原稿のすべてのデータと資料が利用可能です。
略語
- APSYS:
-
半導体デバイスの高度な物理モデル
- BF-STEM:
-
明視野走査透過電子顕微鏡法
- CIE:
-
キャリア注入効率
- DUV:
-
深紫外線
- EBL:
-
電子遮断層
- EQE:
-
外部量子効率
- FWHM:
-
半値全幅
- HR-XRD:
-
高解像度X線回折
- IQE:
-
内部量子効率
- LED:
-
発光ダイオード
- LEE:
-
光抽出効率
- LOP:
-
光出力電力
- MOCVD:
-
有機金属化学蒸着
- SEDL:
-
超格子電子減速層
- SRH:
-
Shockley-Read-Hall
- TDD:
-
貫通転位密度
- TMA:
-
トリメチルアルミニウム
- TMG:
-
トリメチルガリウム
- WPE:
-
ウォールプラグの効率
- XRC:
-
X線ロッキングカーブ
ナノマテリアル
- 電子増倍管の発光層の設計
- 4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
- リチウムイオン電池の電気化学的性能が向上したLiNi0.8Co0.15Al0.05O2 /カーボンナノチューブの機械的複合材料
- 高性能シリコン/有機ハイブリッド太陽電池用の溶媒処理を備えた高導電性PEDOT:PSS透明正孔輸送層
- CdSe QD / LiF電子輸送層を備えた高効率の逆ペロブスカイト太陽電池
- 光触媒性能が向上した新規Bi4Ti3O12 / Ag3PO4ヘテロ接合光触媒
- 高いMgドーピング効率のために特別に設計された超格子p型電子ブロッキング層を備えたほぼ効率の低いAlGaNベースの紫外線発光ダイオード
- PEDOT:PSSを正孔輸送層として処理する高極性アルコール溶媒を使用した高輝度ペロブスカイト発光ダイオード
- 効果的な光吸収が強化されたピン接合ナノコーンアレイ太陽電池の光起電力性能
- AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
- 異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響



