両極WSe2電界効果トランジスタの電気的および光電子的特性に及ぼす容易なpドーピングの影響
要約
アンビポーラWSe 2 の電気的および光電子的特性を調査しました 周囲での熱アニーリング中の容易なpドーピングプロセスによる電界効果トランジスタ(FET)。このアニーリングにより、酸素分子はWSe 2 に正常にドープされました。 より高いp型導電率と正のゲート電圧方向への伝達曲線のシフトを保証する表面。さらに、両極WSe 2 の光スイッチング応答特性が大幅に改善されました FETは、周囲でのアニーリングによって実現されました。電気的および光電子的特性の変化の原因を調査するために、X線光電子、ラマン、およびフォトルミネッセンス分光法による分析を実施しました。これらの分析から、WO 3 周囲でのアニーリングによって形成された層は、両極WSe 2 にpドーピングを導入しました FET、およびWO 3 に起因する障害 / WSe 2 インターフェースは非放射再結合サイトとして機能し、光スイッチング応答時間特性を大幅に改善しました。
背景
二次元(2D)材料は、次世代エレクトロニクスおよびオプトエレクトロニクスデバイスの有望な候補としてかなりの関心を集めています[1、2]。グラフェンは最もよく研究されている2D材料の1つですが、固有のバンドギャップがなく、幅広い用途が制限されています。一方、MoS 2 などの2D遷移金属ジカルコゲナイド(TMD) 、MoSe 2 、WS 2 、およびWSe 2 は、固有のバンドギャップ特性、優れたキャリア移動度、および高いオン/オフ比により、電界効果トランジスタ(FET)のチャネル材料として使用できるという点で有利です[2、3]。したがって、TMDは、トランジスタ[4,5,6]、センサー[7,8,9,10]、論理回路[11]、メモリデバイス[12]、電界放出デバイス[12]などのさまざまなデバイスで広く使用されています。 13]、および光検出器[14、15]。特に、WSe 2 に基づくFET 高いキャリア移動度、優れた光応答特性、優れた機械的柔軟性、耐久性などの優れた両極特性を実証しています[16、17、18]。それにもかかわらず、WSe 2 のドーピング さまざまな電子アプリケーションに不可欠な電界効果移動度または接触特性をさらに改善するために必要です[16、19]。ドーピングのための多くのアプローチの中で、WO 3 を形成するための周囲での熱アニーリング WSe 2 のレイヤー 表面は、効率的で効率的なp型ドーピングプロセスであることが実証されています[20、21、22]。たとえば、Liu etal。熱アニーリングされたWSe 2 追加の物質を使用せずに周囲でフィルムをp型にドープし、正孔移動度を83 cm 2 に改善しました。 V -1 s -1 六方晶窒化ホウ素基板を採用した[20]。ただし、WSe 2 の光学的および光電子的特性に関する徹底的な研究 WO 3 でドープ フォトトランジスタ、フォトダイオード、発光ダイオードなどのオプトエレクトロニクスアプリケーションに適しています[17、18、23、24]。
この作業では、両極WSe 2 の電気的、光学的、および光電子的特性を調査しました。 周囲での熱アニーリング前後のFET。酸化層(WO 3 )WSe 2 で形成 アニーリング中の表面は、両極WSe 2 にpドーピングを導入することに成功しました。 FET、伝達曲線が正のゲート電圧方向にシフトします。興味深いことに、光照射をオフにした後もコンダクタンスが保持される現象である長期的な光伝導性は、アニーリング後に消失しました。さらに、X線光電子分光法(XPS)、フォトルミネッセンス(PL)分光法、ラマン分光法などのさまざまな実験を行い、両極WSe 2 FET。
メソッド
WSe 2 フレークは、バルクWSe 2 からマイクロメカニカル剥離法によって調製されました。 結晶、および270nmの厚さのSiO 2 高濃度にドープされたp ++ Siウェーハ上の層(抵抗率〜5×10 -3 FETデバイスのバックゲートとして使用されたΩcm)。 WSe 2 の厚さ フレークは、原子間力顕微鏡(NX 10 AFM、Park Systems)を使用して測定しました。電極パターンを作成するために、4000 rpmで電子レジスト層としてポリ(メチルメタクリレート)(PMMA)495K(アニソール中11%の濃度)をスピンコーティングしました。スピンコーティング後、サンプルをホットプレート上で180°Cで90秒間ベークしました。電子ビームリソグラフィー装置(JSM-6510、JEOL)を使用して電極パターンを設計し、メチルイソブチルケトン/イソプロピルアルコール(1:3)溶液を使用して120秒間パターンを作成しました。最後に、電子ビーム蒸発器(KVE-2004L、Korea Vacuum Tech)を使用して、チタン金属(30 nmの厚さ)電極を堆積しました。
周囲温度での熱アニーリングは、特定の温度でホットプレート上で実行されました。真空中での熱アニーリングは、4.5×10 -4 でラピッドサーマルアニーリングシステム(KVR-4000、Korea Vacuum Tech)を使用して実行されました。 Torrおよび200°Cで1時間。
フォトルミネッセンスおよびラマン分光測定は、532 nmの入射レーザー波長で共焦点イメージングシステム(XperRamn 200、Nanobase)を使用して実行されました。 X線光電子分光測定は、電子エネルギー分析器(AXIS SUPRA、Kratos)を使用して実施された。デバイスの電気的特性は、プローブステーション(JANIS、ST-500)と半導体パラメータアナライザー(Keithley 4200-SCS)を使用して測定されました。デバイスの光応答は、レーザー(MDE4070V)照明下で測定されました。
結果と考察
図1aは、WSe 2 の光学画像を示しています。 フレークと製造されたWSe 2 FET。 WSe 2 フレークはバルクWSe 2 から機械的に剥離されました 結晶であり、270nmの厚さのSiO 2 に転写されます。 FETのバックゲートとして使用された高濃度にドープされたp ++ Siウェーハの表面。ソース電極とドレイン電極として使用されるチタン金属パターンは、WSe 2 に堆積されました。 水面。詳細なデバイス製造プロセスは、追加ファイル1:図S1で説明されています。製造された両極WSe 2 の概略図 FETを図1bに示します。 WSe 2 のすべての電気的および光スイッチング特性 FETは真空中で測定されました(〜3.5×10 -3 Torr)空気中の酸素と水分子が、WSe 2 の特性に影響を与える可能性があるため FET。たとえば、半導体タイプのWSe 2 FETは、空気にさらされることでn型からp型に変化する可能性があります[25]。 WSe 2 の原子間力顕微鏡(AFM)画像 フレークは、地形断面プロファイルとともに図1cに表示されます。 WSe 2 の測定された厚さ 青い線を横切るフレークは〜1.2 nm(図1cの挿入グラフ)であることがわかり、二重層WSe 2 に対応します。 (単層WSe 2 の厚さ は〜0.7 nm)[16]。図1dは、WSe 2 のラマンスペクトルを示しています。 2つの明確なピークを示しています(520 cm -1 のピーク Si基板に割り当てられます)。 245 cm -1 のラマンピーク 面内に対応します(E 1 2g モード)または面外(A 1g モード)WSe 2 の振動 、および308 cm -1 のラマンピーク B 1 に対応 2g 多層WSe 2 でのみ表示されるモード 追加の層間相互作用による[26]。この発見により、WSe 2 の品質が保証されます。 これらの実験で使用されたフレーク。 E 1 2g およびA 1g WSe 2 のピーク それらはほとんど縮退しているので、この研究ではラマン分光装置によって区別することができませんでした[27]。図1eは、伝達曲線(ソース-ドレイン電流対ゲート電圧; I )を示しています。 DS - V GS 両極WSe 2 の曲線) FET。 WSe 2 のこのような両極輸送挙動 FETはWSe 2 の数によるものです FETの主要なキャリアタイプを決定できる層(二重層)[28、29]。
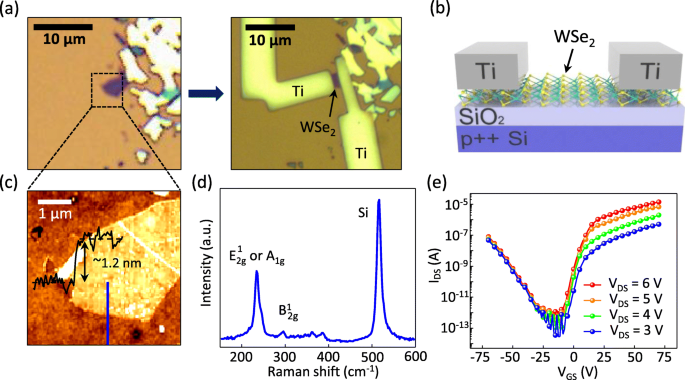
a WSe 2 の光学画像 フレーク(左)と製造されたWSe 2 FET(右)。 b 製造されたWSe 2 の概略図 Ti接点を備えたFET。 c AFM画像と d WSe 2 のラマンスペクトル 。 e 私 DS - V GS 両極WSe 2 の曲線 FET
図2aは、 I を示しています。 DS - V GS WSe 2 の曲線 200°Cで1時間の周囲での熱アニーリングの前後のFET。出力曲線(ソース-ドレイン電流対ソース-ドレイン電圧; I DS - V DS 同じWSe 2 の曲線) アニーリング前後のFETは、追加ファイル1:図S2に示されています。ここでいくつかの点に注意してください。まず、多数キャリアのタイプが変化する電圧( V n ↔ p )周囲でのアニーリング後、-15Vから-5Vにシフトしました(図2aの緑色の矢印で表されています)。次に、 I DS V で大幅に増加 GS ここで、多数キャリアはホールです( V GS < V n ↔ p )および V で減少 GS ここで、多数キャリアは電子です( V GS > V n ↔ p )アニーリング後(図2aの青い矢印で表されています)。この動作は、WO 3 に起因します。 WSe 2 にpドーピングを導入するアニーリングによって形成された層 FET [20]。第三に、アニーリング後、正孔移動度は0.13から1.3 cm 2 に増加しました。 V -1 s -1 、および電子移動度が5.5から0.69 cm 2 に減少しました。 V -1 s -1 。式μを使用しました =(d I DS / d V GS )×[ L /( WC i V DS )]キャリア移動度を計算します。ここで、 L (〜1.5μm)はチャネル長、 W (〜2.8μm)はチャネル幅であり、 C i =ε 0 ε r / d =1.3×10 −4 F m −2 WSe 2 間の静電容量です 単位面積あたりのp ++ Siウェーハ。ここで、ε r (〜3.9)はSiO 2 の誘電率です および d (270 nm)は、SiO 2 の厚さです。 層。アニーリング後の電気的特性のこれらの変化は、 I を示す等高線図でより明確に観察できます。 DS V の関数として GS および V DS 周囲でのアニーリングの前(上のパネル)と後(下のパネル)(図2b)。これらの等高線図は、多くの I に基づいて作成されました。 DS - V GS V で測定された曲線 GS 範囲は− 70〜70 V、1.25 Vステップ、 V DS 0.25 Vステップで3〜6Vの範囲。等高線図の青い領域は、正の V に向かってシフトしました GS アニーリング後の方向。このシフトは、図2aの緑色の矢印で示されている伝達曲線のシフトと一致しています。正と負の V での色の変化 GS (図2b)アニーリング後は、WSe 2 のチャネル電流の変化を示します。 FET(図2a)。その他のWSe 2 FETも、周囲でのアニーリング後に電気的特性に同じ変化を示しました(追加ファイル1:追加ファイルの図S3およびS4を参照)。また、WSe 2 のアニーリングによる電気的特性の変化 真空中のFET(〜4.5×10 -4 200°Cで1時間のTorr)を調べました(図2c、d)。周囲でアニールされたFETの結果とは対照的に、 I DS 両方の V で増加 GS V の条件 GS > V n ↔ p および V GS < V n ↔ p 。増加した I DS 真空中でのアニーリングによって得られるのは、改良されたWSe 2 によるものです。 -WO 3 を形成せずにTi接点 [30]。比較結果から、周囲でのアニーリング時に酸素分子との相互作用によりpドーピングが導入されたことが予想されます。電気的特性の変化の原因については、後でXPSデータを分析することで詳しく説明します。
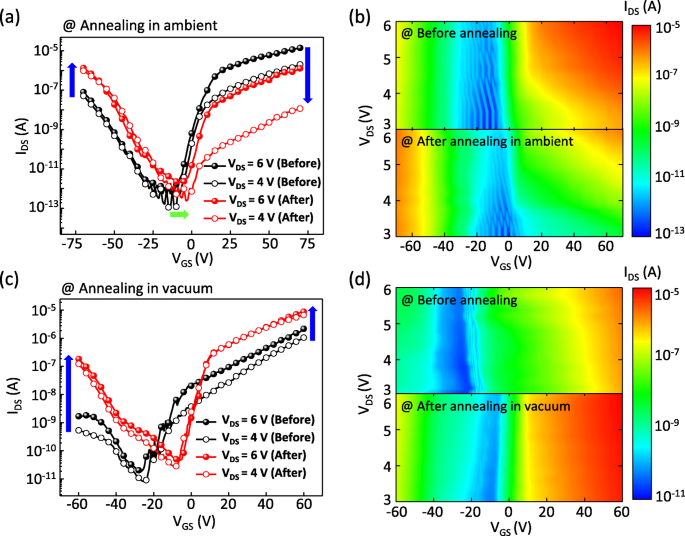
a 、 c 私 DS - V GS WSe 2 の半対数スケールの曲線 アニーリング前および200°Cで1時間のアニーリング後のFET。 b 、 d I の等高線図 DS V の関数として GS および V DS アニーリング前(上のパネル)および200°Cで1時間のアニーリング後(下のパネル)
次に、WSe 2 の光スイッチング特性を測定しました。 周囲での熱アニーリング前後のFET(図3a、b)。このFETの電気的特性は、追加ファイル1:図S3に示されています。レーザーはWSe 2 に照射されました FETであり、ソース-ドレイン電流が飽和したように見えるときにオフになりました。フォトスイッチング実験は固定された V で実行されたことに注意してください GS =0 V、 V DS =10 V、レーザー波長405 nm、レーザー出力密度11 mW / cm 2 。図3a、bは、それぞれ周囲でのアニーリング前後の光スイッチング特性を示しています。この研究では、立ち上がり時定数(τ 上昇 )は、光電流(暗所と照射下で測定された電流の差、つまり I )に必要な時間として定義されます。 ph =私 irra – 私 暗い )最大値の10%から90%に変更し、減衰時間(τ 崩壊 )は、光電流が1 / e に減少する時間です。 その初期値の。図3a、bの紫色の領域は、レーザー照射下の時間を示しています。 WSe 2 のフォトスイッチング応答時間の劇的な変化を観察しました 熱アニーリング後のFET。両方のτ 上昇 およびτ 崩壊 92.2秒と57.6秒からそれぞれ0.15秒と0.33秒未満に減少しました(それぞれ610倍と170倍以上の減少に対応します)。 τに注意してください 上昇 およびτ 崩壊 アニーリング後は、機器の制限により正確に測定できませんでした。光スイッチング応答時間の変化がWSe 2 の酸化の影響によるものであることを確認するには レイヤーについて、WSe 2 のフォトスイッチング動作を比較しました 真空中での熱アニーリング前後のFET(〜4.5×10 -4 Torr)200°Cで1時間(図3c、d)。周囲でアニールされたFETの光スイッチング応答時間の劇的な減少とは対照的に、τの比較的小さな変化 上昇 (148〜131秒)およびτ 崩壊 (166〜102秒)真空中でアニールされたサンプルで観察されました。この結果は、WSe 2 の酸化を意味します。 周囲でのアニーリングによる表面は、高速光スイッチング応答の主な起源です。周囲でのアニーリングによって光スイッチング挙動が改善される理由は、WSe 2 間の格子不整合です。 およびWO 3 構造は、WSe 2 のバンドギャップにトラップと組換え部位を提供します 、光生成キャリアの再結合プロセスを促進することができます。

アンビポーラWSe 2 のフォトスイッチング応答 FET a 、 c アニーリングの前後 b 周囲温度200°Cで1時間 d それぞれ真空中で。すべてのデータは V で測定されました GS =0Vおよび V DS =10 V
さらに、レーザーをオフにした後の長期的な光スイッチング特性の起源をさらに調査するために、いくつかの V での光スイッチング特性 GS 調査した(図4)。このFETの電気的特性は、追加ファイル1:図S4に示されています。適用された V GS =5 V、 V GS =− 15 V、および V GS =− 90Vは V の範囲に対応します GS > V n ↔ p 、 V GS 〜 V n ↔ p 、および V GS < V n ↔ p 、それぞれ。 注目すべき点は、光スイッチング応答が V の範囲に強く依存していることです。 GS 焼きなましされたかどうか。 V が減少するにつれて GS アニーリング前の場合は5〜− 90 Vで、 V で長持ちする光伝導性(図4で点線の円でマーク)が消えます。 GS =− 15 V(図4c)そして V で再び現れた GS =− 90V(図4e)。この V GS 依存する光スイッチング特性は、主に、適用された V によって変化した電荷キャリアダイナミクスによるものです。 GS [31]。適用された V に応じて GS フェルミ準位の位置に影響を与える(E F )、照射をオフにした後に注入されたキャリアの量を決定することができます(追加ファイル1:図S5)[31]。これらの複雑な V を説明するためのバンド図を提案しました GS 照射のオンとオフを切り替えたときの光スイッチング特性の詳細に依存します(追加ファイル1のセクション4を参照)。

a Wと b WSe 2 のXPSスペクトルのSeピーク 250°Cで1時間および5時間の周囲でのアニーリングの前後。 c WSe 2 の構造変化の概略図 周囲での熱アニーリングによって引き起こされる
図4a、bは、 V でフォトスイッチング特性が向上したことを示しています。 GS =5 V( V GS > V n ↔ p )図3の結果と一致する熱アニーリングによる。この挙動は、WSe 2 間の誘導された再結合部位で促進された再結合プロセスによっても説明できます。 およびWO 3 インターフェース。 PLの結果は、WO 3 に非放射再結合サイトが存在することを示しています。 / WSe 2 、これについては後で説明します。 V で GS =− 15 V( V GS 〜 V n ↔ p )、非常に高速な光スイッチング特性のため、熱アニーリング後の明確な変化を観察することはできませんでした(図4c、d)。この急速な光スイッチングの振る舞いは、E F の位置に起因します。 WSe 2 の途中 照射をオフにした後の追加電荷注入を抑制するバンドギャップ(詳細については、追加ファイル1のセクション4を参照してください)。 V の場合 GS =− 90 V(図4e、f)、τ 崩壊 およびτ 長い アニーリング後の電流はアニーリング前の電流よりもはるかに高かったが(20倍以上)、それぞれ維持および短縮された。重要なことに、光トランジスタの光誘起電流と減衰時定数の間にはトレードオフがあります。これは、トラップされた光生成少数キャリアが追加の電界を生成し、それによってチャネル電流が増加し、照射後も継続的な電荷注入が必要になるためです。オフになっています[32、33]。この点で、τの保存 崩壊 短縮されたτ 長い 図4e、fに示すように、光誘起電流が大幅に増加しているにもかかわらず、周囲でのアニーリングによって光スイッチング特性が改善されていることを意味します。 τについて 上昇 、E F の場所 pドーピングによって価電子帯に移動します。これにより、光生成された正孔が占有できる正孔トラップサイトが減少するため、非電荷の中性が強くなります(追加ファイル1:図S6a)。非電荷の中性が強いため、照射下では、電荷の中性を満たすためにより多くの電荷が注入されます。また、光生成されたキャリアは、チャネルを通過する際に自由キャリアでより多くの散乱を受けて光電流に寄与するため、τ 上昇 時間が長くなる可能性があります。そのため、τ 上昇 V で長くなります GS =図4e、fに示すように、熱アニーリング後の− 90V(詳細については、追加ファイル1のセクション4を参照してください)。
図5a、bは、WSe 2 の元素組成の変化を調査するためのXPS分析を示しています。 周囲での熱アニーリングによる。 200°Cで1時間のアニーリングは、図1および2に示すように、電気的特性と光スイッチング特性の両方を変更するのに十分でした。 2と3では、これらのアニーリング温度と時間は、WSe 2 の元素組成の変化を観察するのに十分ではありませんでした。 。したがって、機械的に剥離されたWSe 2 図5a、bに示すように、フレークはXPS分析のために周囲で1時間および5時間250°Cでアニーリングされました。 2つのタングステンピークの強度(W 6+ とラベル付けされている)に注意する必要があります。 図5a)では、35.5eVと37.8eVの結合エネルギーで、アニーリング時間の増加とともに徐々に増加しましたが、セレンピークの強度に変化は見られませんでした。 W 6+ のタングステンピーク 熱アニーリングによって生成されたものは、WO 3 の形成を示しています WSe 2 の反応による アニーリング中に空気中の酸素で[20、34]。一方、Se 2 などの酸化セレンの形成 O 3 、目立たなかった(図5b)。図5cは、WSe 2 の前後の微視的構造の概略図を示しています。 アニーリングによる酸化、およびそれらはWSe 2 の実際の幾何学的構造に基づいて描画されます およびキュービックWO 3 (W-Se結合長は2.53Å、Se-Se結合長は3.34Å、W-O結合長は1.93Å)[20、35、36]。 WSe 2 以降 WO 3 は六角形の構造ですが、 立方体構造のWSe 2 -WO 3 構造は、図5c [20]に示すように、キルト化された面内ヘテロ接合です。したがって、周囲でのアニーリング後に変化した電気的特性の原因(図2a、b)は、WO 3 の形成によって説明できます。 。形成されたWO 3 WSe 2 の仕事関数の違いにより、アクセプターとして機能できます。 (〜4.4eV)およびWO 3 (〜6.7eV) I の増加を引き起こします DS 負の V GS リージョン( V GS < V n ↔ p )および減少した I DS 正の V GS リージョン( V GS > V n ↔ p )[20、37、38]。私たちの結果と同様に、WO 3 WSe 2 に堆積または埋め込まれているレイヤー シートはWSe 2 にpドーピングを導入しました FET [20,21,22]。

a WSe 2 のラマンスペクトル 周囲温度で200°Cで60分(黒線)、350°Cで60分(赤線)、500°Cで5分(青線)のアニーリング後。挿入画像は、それぞれ500°Cでのアニーリング前後の光学画像に対応しています。スケールバー=15μm。 b 500°Cでアニーリングした後のラマンマッピング画像は、712 cm -1 のバンドと統合されています および806cm -1 、 それぞれ。スケールバー=10μm。 c WSe 2 の光バンドギャップ 前、250°Cで30分間、および60分間の周囲でのアニーリング後。挿入画像は、単層WSe 2 の光学画像です。 スケールバー=10μmのフレーク(サンプル1としてラベル付け)。 d 10μmのスケールバーを使用した最大PL強度および対応するPLマッピング画像
WO 3 の形成による光学的影響を調査するために、ラマンおよびPL分光実験を実施しました。 。図6aは、WSe 2 のラマンスペクトルを示しています。 周囲温度で200°Cで60分(黒線)、350°Cで60分(赤線)、500°Cで5分(青線)のアニーリング後。 712 cm -1 付近の新しいピークの出現 および806cm -1 WO 3 のラマンピークに非常に近い500°Cでのアニーリングによる (709 cm -1 および810cm -1 )[39]、WO 3 の形成をサポート WSe 2 のレイヤー 水面。挿入画像は、500°Cで5分間のアニーリング前後の光学画像です。 712 cm -1 のバンドと統合されたラマンマッピング画像 および806cm -1 図6bは、均一なWO 3 を示しています。 WSe 2 でのフォーメーション 表面。

a WSe 2 のラマンスペクトル 周囲温度で200°Cで60分(黒線)、350°Cで60分(赤線)、500°Cで5分(青線)のアニーリング後。挿入画像は、それぞれ500°Cでのアニーリング前後の光学画像に対応しています。スケールバー=15μm。 b 500°Cでアニーリングした後のラマンマッピング画像は、712 cm -1 のバンドと統合されています および806cm -1 、 それぞれ。スケールバー=10μm。 c WSe 2 の光バンドギャップ 前、250°Cで30分間、および60分間の周囲でのアニーリング後。挿入画像は、単層WSe 2 の光学画像です。 スケールバー=10μmのフレーク(サンプル1としてラベル付け)。 d 10μmのスケールバーを使用した最大PL強度および対応するPLマッピング画像
PL分光分析は、2つの異なる単分子層WSe 2 に対して実施されました。 図6cに示すフレーク(サンプル1およびサンプル2のラベルが付いています)。図6cの挿入図は、サンプル1の光学画像に対応しています。各WSe 2 フレークは、周囲温度で250°Cで30分と60分間アニーリングされました。他の単分子層WSe 2 の光学およびPLマッピング画像 フレーク(サンプル2のラベルが付いている)は、追加ファイル1:図S7に記載されています。アニーリング時間が長くなると、WSe 2 の光学バンドギャップが増加します。 広くなりました。光学バンドギャップは、バンドギャップから発生する共鳴蛍光に対応するため、PLスペクトルの最大強度の光子エネルギーから抽出されました。サンプル1の光学バンドギャップは、単分子層WSe 2 のバンドギャップに対応するアニーリング前に〜1.60eVと測定されました。 [27]、60分間のアニーリング後、バンドギャップ値は〜1.61eVに変化しました。光バンドギャップの増加(〜10 meV)はわずかですが、この現象はWSe 2 の形成によって説明できます。 -WO 3 面内ヘテロ接合と誘電体遮蔽効果。 WO 3 以降 WSe 2 と比較して2.75eVの大きなバンドギャップがあります (単分子層の場合は1.60 eV)[40]、単分子層WSe 2 の光学バンドギャップ フレークは、周囲でのアニーリングによって増加しました。さらに、WO 3 の形成 WSe 2 で WO 3 の誘電率が大きいため、より強力な誘電遮蔽効果を生成できます。 (〜90)WSe 2 と比較 (〜22)[41、42]。その結果、より強い誘電体遮蔽効果により、励起子結合エネルギーが減少し、熱アニーリング中の光学バンドギャップがわずかに増加します[43]。
興味深いことに、PL強度の観点からは、図6dに示すように、アニーリング時間が長くなるにつれて明らかに減少しました。単分子層WSe 2 のPL消光挙動 アニーリング時間が長くなるにつれて、ピーク領域のPL強度を統合するPLマッピング画像で簡単に観察できます(図6dの挿入図)。同様の現象がMoS 2 でも観察されました。 酸素プラズマで処理[44]。これらの結果は次のように説明できます。 WO 3 以降 間接バンドギャップ[40]、WSe 2 のバンド構造を持っています 間接バンドギャップのあるものに部分的に変更される可能性があり、これによりPL強度が低下します。さらに、WSe 2 間の格子不整合 およびWO 3 構造は、WSe 2 のバンドギャップにトラップと組換え部位を提供します WSe 2 の電気的および光学的特性に影響を与える可能性があります 。たとえば、無秩序、欠陥、および硫黄の空孔は、MoS 2 に浅いまたは深いトラップサイトを生成する可能性があります 層、再結合プロセスを生じさせる[31、45]。したがって、アニーリング時間が長くなると、WSe 2 の格子不整合に起因する無秩序と欠陥が発生します。 -WO 3 構造により、非放射(Shockley-Read-Hall)再結合[45]が発生し、PL強度が低下します。まとめると、XPS、ラマン、およびPL分光法の実験結果は、WO 3 の形成を示しています。 WSe 2 で 周囲でのアニーリングによる表面、およびそれらは2D材料の酸化に関する最近の研究とよく一致しています[20、46]。さらに、PL分光法の分析から、WO 3 によって誘導される非放射再結合サイトがサポートされました。 層は、再結合プロセスを促進することにより、光スイッチング特性の改善に貢献する可能性があります。
結論
要約すると、両極WSe 2 を作成しました FETと、周囲での熱アニーリング前後の電気的特性と光スイッチング応答を研究しました。 WSe 2 FETはp型方式で正常にドープされ、光スイッチング応答は周囲熱アニーリング後にかなり速くなりました。 XPS、Raman、およびPLの調査では、WO 3 WSe 2 上に形成されたレイヤー 表面は、pドーピング層と非放射再結合サイトの役割を果たして、より高速な光スイッチング動作を促進できます。この研究は、両極WSe 2 の電気的および光電子的特性への影響についてのより深い理解を提供します。 周囲での熱アニーリングによる簡単なpドーピングプロセスによるFET。
データと資料の可用性
すべてのデータは制限なしで完全に利用可能です。
略語
- 2D:
-
二次元;
- AFM:
-
原子間力顕微鏡
- FET:
-
電界効果トランジスタ;
- PL:
-
フォトルミネッセンス;
- TMD:
-
遷移金属ジカルコゲナイド;
- XPS:
-
X線光電子分光法;
ナノマテリアル
- チタンの特性と用途
- トランジスタ、接合型電界効果(JFET)
- 接合電界効果トランジスタ
- 4H-SiCPiNダイオードの特性に及ぼす紫外線照射の影響
- 小さなセレンナノ結晶とナノロッドの容易な合成と光学的性質
- 低抵抗Auオーミックコンタクトを備えた多層SnSeナノフレーク電界効果トランジスタ
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 色素増感太陽電池の光学的および電気的特性に及ぼすTiO2中の金ナノ粒子分布の影響
- TIPS-ペンタセンベースの有機電界効果トランジスタの移動度と形態に及ぼすその場アニーリング処理の影響
- ITO / PtRh:PtRh薄膜熱電対の調製と熱電特性



