グラフェン-MoTe2ファンデルワールスヘテロ構造におけるひずみおよび電場制御可能なショットキー障壁と接触タイプ
要約
本質的に不動態化された表面を備えた2次元(2D)遷移金属ジカルコゲナイドは、金属電極との接触によって性能が大きく影響を受ける超薄型オプトエレクトロニクスデバイスの有望な候補です。ここでは、第一原理計算を使用して、2D MoTe 2 の電子的および界面特性を構築および調査します。 それらを最大限に活用することにより、グラフェン電極と接触します。得られた結果は、グラフェンとMoTe 2 の電子特性を明らかにしています。 ファンデルワールス層間相互作用が弱いため、層はヘテロ構造でよく保存され、フェルミ準位はMoTe 2 の伝導帯の最小値に向かって移動します。 したがって、 n を形成する層 インターフェイスでSchottkycontactと入力します。さらに興味深いことに、グラフェンのショットキー障壁の高さと接触タイプ-MoTe 2 ヘテロ構造は、二軸ひずみと外部電場によって効果的に調整できます。これにより、ヘテロ構造を n から変換できます。 p にSchottkycontactと入力します 1つまたはオーミック接触に入力します。この作業は、接触タイプを調整するためのより深い洞察と、高性能MoTe 2 を設計するための効果的な戦略を提供します。 ベースのショットキー電子ナノデバイス。
はじめに
二次元(2D)層状結晶は、グラフェンの発見以来、その新しい物理的特性とさまざまな分野での潜在的な用途により、ますます関心を集めています[1]。ハーフ整数量子ホール効果[2]、クライントンネリング[3]、超伝導[4]などの型破りな機能と性能が、さまざまな2D材料で発見されています。ただし、グラフェンの場合、フェルミ準位の近くにバンドギャップがないディラックコーンタイプのバンド構造は、トランジスタへの直接の適用を妨げます。これは、他の2D材料[5,6,7,8,9,10,11,12,13,14]からの代替材料の探索を刺激し、その中で層状遷移金属ジカルコゲナイド(TMD)が大きな注目を集めています。 。 TMDのバンドギャップは約0.8eVから2.0eVまで調整でき、従来の半導体のバンドギャップに匹敵するため、TMDはオプトエレクトロニクスアプリケーションに特に適しています。グラファイトと同様に、ほとんどのTMDは層状構造の材料であり、層間にファンデルワールス(vdW)相互作用があるため、数層または単層に剥離できます[15、16]。 TMDは厚さに依存する特性を持ち、バルクから数層または単分子層に変更されると、間接直接バンドギャップ遷移[16、17]を受けることがわかります。単層TMDには、H相やT相(またはT '相)などのいくつかの構造がありますが、H相は通常半導体特性を示します。
TMDのメンバーとして、バルクMoTe 2 六角形(2H、半導体)相[18]、単斜晶(1 T '、金属)相[19]、八面体(T d )の3つの興味深い相が含まれています。 、タイプIIワイル半金属)相[20、21]、2H相が最も安定な相です。 2H相MoTe 2 バルクの場合は約1.0eVの間接バンドギャップがあり、単分子層の場合は約1.1 eVの直接バンドギャップがあります[22、23]。 -赤外線光検出器。便宜上、次のテキストでは、2H-MoTe 2 単にMoTe 2 と呼ばれます 。他のTMDと比較して、MoTe 2 導電率が低く[24]、ゼーベック係数が高く[24]、検知能力が優れている[18、25]など、多くの利点があります。 MoTe 2 の利点を組み合わせる とグラフェン、グラフェンとMoTe 2 によって一種のヘテロ構造を製造 デバイスアプリケーションの場合を検討できます。実際、最近、2D層状構造材料に基づく垂直ヘテロ構造は、孤立したコンポーネントの表面にダングリングボンドがなく、弱いため、関心が高まっています[26、27、28、29、30、31、32、33]。フェミレベルのピン留め。グラフェン-TMDベースの垂直ヘテロ構造の場合、実験により、単純なTMDと比較して、優れた高いオンオフ比、高い光応答、低い暗電流、および優れた量子効率が確認されています[34、35、36、37、38]。ベースのタイプ。報告されているグラフェン-TMDベースの垂直ヘテロ構造のほとんどは、MoS 2 などの他のTMDで構築されています。 、いくつかの実験では、グラフェン-MoTe 2 MoTe 2 のユニークな電子的および光学的特性によるヘテロ構造[39,40,41,42,43] 。グラフェン-MoTe 2 のオンオフ比が報告された[39] 垂直ヘテロ構造は〜(0.5 − 1)×10 −5 と同じくらい高い 、および写真の応答性は20 mAW -1 に達する可能性があります 、これはグラフェンの対応する値に匹敵します-MoS 2 端末。後で、グラフェンに基づく-MoTe 2 -グラフェン垂直vdWヘテロ構造、近赤外光検出器は、高い光応答性、高い外部量子効率、迅速な応答および回復プロセスを含む優れた性能を備え、外部のソース-ドレイン電源がない状態で製造されました[40、42]。他の層状半導体光検出器。次に、グラフェン-MoTe 2 適切なV字型両極特性を示すvdW垂直トランジスタ[41]が報告されました。したがって、グラフェン-MoTe 2 ヘテロ構造は、応答性が高く、高速で、柔軟性のあるオプトエレクトロニクスナノデバイスの有望な候補です。この意味で、グラフェン-MoTe 2 の理論的調査を実施することが不可欠です。 まだ報告されていない垂直ヘテロ構造。
金属-半導体ヘテロ構造の場合、ヘテロ構造の整流特性の有無を決定するため、接触タイプ(ショットキー接触またはオーミック接触)を考慮する必要があります。ショットキー接触の場合、ショットキーバリア高さ(SBH)は、対応するデバイスの動作に重要な役割を果たし[44]、徹底的に調査されています。実際のデバイスアプリケーションで高性能を実現するには、SBHを調整できることが望ましいでしょう。 SBHを変調するために多くの戦略が提案されており、その中で外部電界と二軸ひずみを適用することが最も一般的な方法です。
この論文では、第一原理計算、電子構造、およびグラフェン-MoTe 2 のSBHの外部電界とひずみ依存性に基づいています。 ヘテロ構造が調査されています。計算結果は、グラフェンとMoTe 2 の電子特性を示しています。 単分子層は、ヘテロ構造として垂直に積み重ねられた後、非常によく保存されます。ヘテロ構造のショットキー障壁は、 p 間で変更できます。 タイプして n 外部電界またはひずみを適用してタイプします。外部電界またはひずみが十分に強い場合、ヘテロ構造はオーミック接触に達することもあります。
計算方法
第一原理計算は、密度汎関数理論(DFT)に基づくVienna Ab-initio Simulation Package(VASP)[45,46,47]を使用して実行されました。プロジェクター増強波(PAW)[48]擬ポテンシャルを適用してイオン-電子相互作用をモデル化し、Perdew-Burke-Ernzerhof(PBE)一般化勾配近似(GGA)[49]を使用して電子交換相関を処理しました。すべての計算で、vdW相互作用項を表すGrimmeのDFT-D2 [50]法が採用され、平面波カットオフエネルギーは600eVに設定されています。収束しきい値は10 -6 に設定されています エネルギーの場合はeV、力の場合は0.01 eV /Å。ブリュアンゾーン k -ポイントメッシュは、Monkhost-Packスキーム内で9×9×1に設定されます。 z に沿った25Åの真空空間 隣接するレイヤー間の相互作用を避けるために方向が採用されます。 2H-MoTe 2 のバンド構造に対するスピン軌道相互作用の効果が明らかになった は非常に弱い[51]、すべての計算はスピン軌道相互作用を考慮していません。
グラフェン-MoTe 2 ヘテロ構造はグラフェンとMoTe 2 で構成されています 垂直方向に沿って2つの2D材料を積み重ねることによる単分子層。グラフェンとMoTe 2 の両方 六角形の格子を採用し、それらの格子定数はそれぞれ2.46Å[52]と3.52Å[53]です。したがって、格子不整合は以前の基準である5%よりも低くなります。グラフェンとMoTe 2 の構造によると 単分子層では、ここでは3つの典型的なスタッキングモードが考慮されます。HS-1、HS-2、およびHS-3です。これらは図1に示されています。HS-1スタッキングモードの場合、1つのTe原子がグラフェン格子; HS-2の場合、1つのTe原子がグラフェン格子の1つのC原子サイトの下にあります。 HS-3の場合、1つのTe原子がグラフェン格子の別の非等価C原子サイトの下にあります。

グラフェンの3つの典型的なスタッキングモードの上面図と側面図-MoTe 2 ヘテロ構造:( a )HS-1、( b )HS-2、( c )HS-3。灰色、ピンク、緑色のボールは、それぞれ炭素原子、モリブデン原子、テルル原子を表しています
SBHのひずみ依存性を調べると、グラフェンのジグザグ方向とアームチェア方向にそれぞれ均等にひずみが加えられます。
結果と考察
MoTe 2 の格子結晶構造 グラフェンの単分子層と3つの典型的なスタッキングモード(HS-1、HS-2、およびHS-3)-MoTe 2 ヘテロ構造はすべて完全に最適化されています。 3つの典型的なスタッキングモードで得られた結合エネルギーはすべてほぼ同じ、つまり-0.85 eVですが、3つのモードの平衡層間距離はすべて3.53Åにほぼ等しくなっています。したがって、HS-1グラフェン-MoTe 2 のみに焦点を当てます。 以下の説明ではヘテロ構造であり、以下のテキストでは簡単にするために「HS-1」を省略しています。 MoTe 2 の最適化されたジオメトリ構造 単分子層とグラフェン-MoTe 2 ヘテロ構造を図2に示します。明らかに、MoTe 2 単分子層は六角形の格子を採用し、最適化された格子定数は3.52Åであり、これは実験結果と一致しています[53、54]。 MoTe 2 のバンド構造からはっきりとわかります。 図3に示すように、単分子層はMoTe 2 単分子層はバンドギャップが1.14eVの半導体であり、これも実験結果と一致しています[22、23]。グラフェンとMoTe 2 の場合 単分子層はヘテロ構造として垂直に積み重ねられ、平衡層間距離は3.53Åであり、これはSb-MoTe 2 の値に匹敵します。 ヘテロ構造(約3.94Å)[55]。図2から、MoTe 2 の形状構造もわかります。 グラフェンの層とグラフェン層-MoTe 2 ヘテロ構造は、MoTe 2 の元の構造とほぼ同じです。 単分子層とグラフェン。これは、これら2つの層の間の相互作用が弱いことを示しています。平衡構造の結合エネルギー-0.85eVはSb-MoTe 2 の結合エネルギーよりも低い ヘテロ構造(約-0.37 eV)[55]であるため、ヘテロ構造はエネルギー的に安定しています。 2つの層間の平衡距離と結合エネルギーはどちらも、グラフェン水素化リンカーバイド[56]、グラフェン-AsSb [29]、グラフェン-SMoSe、グラフェン-SeMoS [30]などの典型的なvdWグラフェンベースのヘテロ構造の平衡距離に匹敵します。 、およびグラフェン-フォスフォレン[57]、MoTe 2 間の相互作用を示します グラフェンは弱いvdWタイプです。

( a の最適化された構造の上面図と側面図 )MoTe 2 単層および( b )グラフェン-MoTe 2 ヘテロ構造。灰色、ピンク、緑色のボールは、それぞれ炭素原子、モリブデン原子、テルル原子を表しています。青い平行四辺形は2Dユニットセルを示します
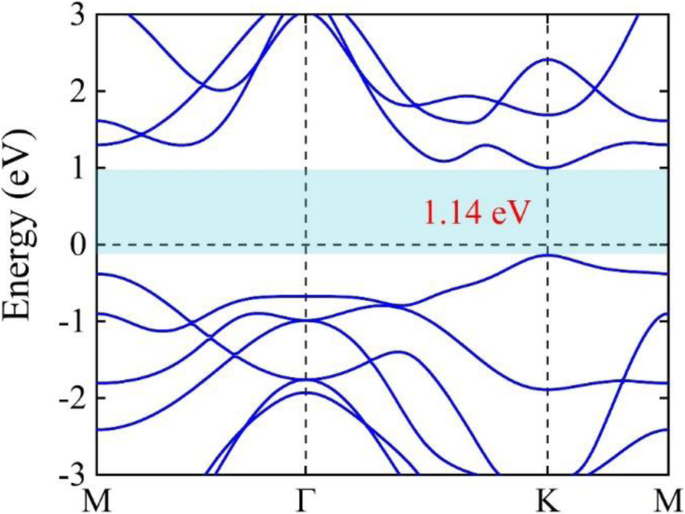
MoTe 2 の電子バンド構造 単層。水色の領域は、価電子帯と伝導帯の間のバンドギャップを表します
実際、グラフェンとMoTe 2 の場合、電荷の再分配と移動は必然的に発生します。 単分子層は積み重ねられてヘテロ構造を形成します。グラフェンの3D電荷密度の違い-MoTe 2 Δρとして定義されるヘテロ構造 =ρ H − ρ G − ρ MT が計算されました。ここで、ρ H 、ρ G 、およびρ MT は、ヘテロ構造、孤立したグラフェン、およびMoTe 2 の電荷密度です。 それぞれ単層。結果を図4aに示します。ここで、青と濃いピンクの領域は、それぞれ電荷の蓄積と枯渇を表しています。明らかに、青い領域はMoTe 2 のすぐ下にあります 層。これは、電子がMoTe 2 の周りに蓄積することを示します。 層;グラフェン層は濃いピンク色の領域に囲まれていますが、これはグラフェン層の周りに穴が蓄積していることを意味します。電荷移動の性質をより明確に見るために、平面平均〈∆ ρ 〉、これは3D電荷密度差Δρの平均値として定義されます。 z の平面内 =定数グラフェン層に平行なものは、図4aに青い線で示されています。ここで、負の値と正の値は、それぞれ電子の枯渇と蓄積を表しています。この結果は、一部の電子がグラフェン層からMoTe 2 に移動することを確認しています。 層、および〈 ∆ρ に振動があります 〉グラフェンとMoTe 2 の両方で 層。電子局在関数(ELF)も図4bにプロットされており、グラフェン層の近くのTe原子の周りのELFの形状が、反対側のTe原子の周りの形状と明らかに異なっていることがわかります。ヘテロ構造における層間vdW相互作用の存在。

a グラフェン-MoTe 2 内の位置の関数としての3D電荷密度差と平均電荷密度差(青い線) z に沿ったヘテロ構造 方向。ここで、青と濃いピンクの領域は、それぞれ電子の蓄積と不足を示します。水平の破線は、グラフェン層とMoTe 2 の間の中央の位置を示しています。 層。 b グラフェンの電子局在関数-MoTe 2 等値が0.7のヘテロ構造
多くの物理的特性は、バンド構造と状態密度(DOS)、および計算されたグラフェンのバンド構造とDOS-MoTe 2 によって決定されます。 ヘテロ構造を図5に示します。ここでは、フェルミ準位がゼロに設定されています。フェルミ準位の周りのグラフェン層のディラックコーンはまだよく保存されています。ただし、約10.6meVのバンドギャップが開きます。つまり、ヘテロ構造には小さいが目立つ層間結合があります。 MoTe 2 によって提供されたバンド 層は、MoTe 2 の半導体特性を示しています 直接バンドギャップのある層は保持されます。 MoTe 2 のバンドギャップ ヘテロ構造の層は0.85eVであり、孤立したMoTe 2 の1.14eVの結果と比較して変化しています。 単層。図5の顕著な特徴の1つは、バンド構造が孤立した層のバンドの単純な合計と見なすことができることです。グラフェン層とMoTe 2 の間の相互作用は驚くべきことではありません。 層はヘテロ構造の各成分のバンド構造の特性を変更するには不十分であるため、バンド構造に対する層間相互作用の影響は非常に弱いです。これはさらに、vdWの相互作用がMoTe 2 間で支配的であることを示しています。 ヘテロ構造の層とグラフェン層、したがって固有の重要な特性を保持します。
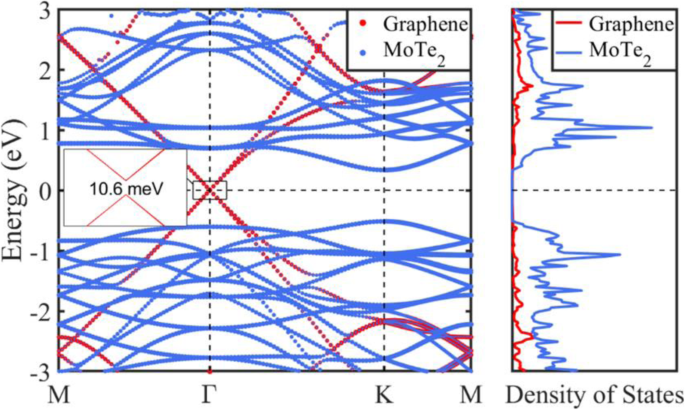
グラフェン層とMoTe 2 のバンド構造と部分状態密度 グラフェンの層-MoTe 2 ヘテロ構造
ヘテロ構造の接触特性は、デバイスアプリケーションにとって重要です。グラフェン-MoTe 2 ヘテロ接合ベースのトランジスタが設計されており、概略図を図6aに示します。ここで、MoTe 2 単分子層はチャネル材料として使用され、グラフェンはソース電極またはドレイン電極とゲート電極の両方として使用されます。金属と半導体の仕事関数の違いにより、界面にバンドベンディングがあり、これはフェルミ準位の違い(Δ E )で推定できます。 F )、Δ E で定義 F = W G − MT − W MT 、ここで W G − MT および W MT ヘテロ構造と対応するMoTe 2 の仕事関数です。 それぞれ単層。計算された W G − MT および W MT 図6bに示すように、はそれぞれ4.36eVと4.84eVです。結果は実験値と一致しています[39]。その結果、バンドの曲がり(Δ E F )はヘテロ構造で約0.48 eVであり、これはグラフェン水素化炭化リンヘテロ構造の結果に匹敵します[56]。
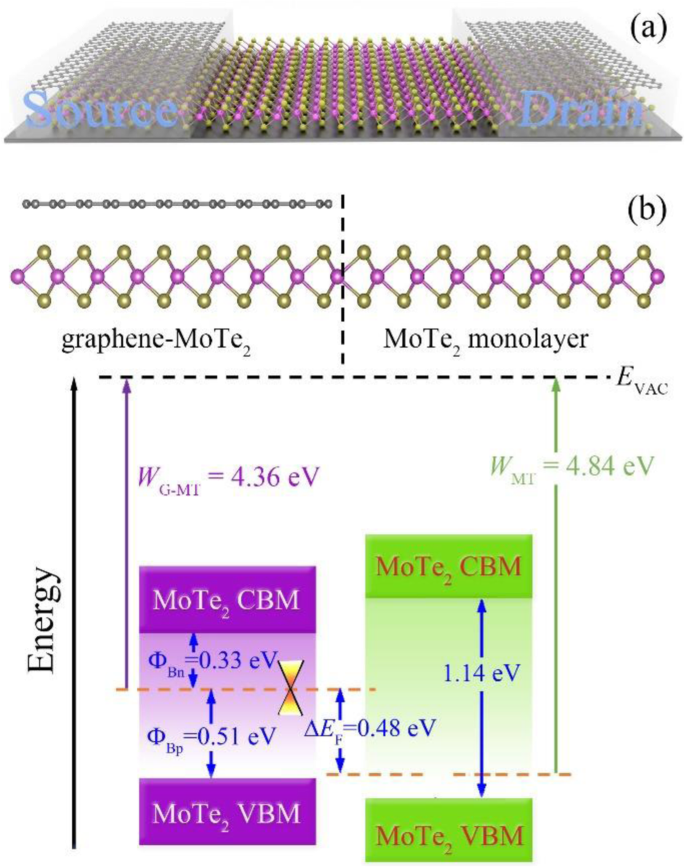
a グラフェンの概略図-MoTe 2 ヘテロ構造ベースのトランジスタ。 b グラフェンのバンドアラインメント-MoTe 2 真空準位に関するヘテロ構造。赤い円錐は、ヘテロ構造内のグラフェン層のディラック点の位置を表します。 CBMとVBMは、それぞれ伝導帯の最小値と価電子帯の最大値を表します。 W G-MT および W MT グラフェンの仕事関数です-MoTe 2 ヘテロ構造とMoTe 2 それぞれ単層
金属-半導体ヘテロ構造の最も重要な接触特性の1つは、垂直界面(グラフェン層とMoTe 2 の間)のショットキー障壁です。 層)、これはヘテロ構造の界面を横切る電流の流れを決定し、したがって対応するデバイスの性能に重要な役割を果たします。一般に、ヘテロ構造の半導体の種類に応じて、SBHは n に分けられます。 タイプして p それぞれタイプします。 n タイプSBH(Φ Bn )は、半導体の伝導帯最小値(CBM)間のエネルギー差( E )として定義されます。 C )および金属のフェルミ準位( E F )、つまりΦ Bn = E C − E F 。 p タイプSBH(Φ Bp )は、金属のフェルミ準位と半導体の価電子帯最大値(VBM)の間のエネルギー差として定義されます( E V )、つまりΦ Bp = E F − E V 。グラフェンのSBH結果-MoTe 2 ヘテロ構造を図6bに示します。電荷移動により、フェルミ準位はMoTe 2 の価電子帯側から移動します。 MoTe 2 の伝導帯側への単分子層 ヘテロ構造の層。これは、ヘテロ構造のSBHが n であることを示します。 インターフェイスで約0.33eVの値で入力します。つまり、ヘテロ構造の電荷伝導は主に電子を介して行われます。
ヘテロ構造ベースのトランジスタの性能を改善するには、SBHを調整することが望ましいでしょう。 SBHは、外部電界と面内ひずみを印加することで調整できることが実証されています[29、30、58]。異なる外部電場下でのヘテロ構造のバンド構造の一連の計算が行われ、その結果が図7に示されています。ここで、正の外部電場の方向はMoTe 2 > グラフェン層への層、負の値は反対方向に沿っています。ショットキー接触領域では、Φ Bn Φは電界とほぼ上向きの線形関係を示します Bp 逆の動作をします。これらの結果は、正および負の電場により、フェルミ準位がMoTe 2 のVBMおよびCBMにシフトできることを示唆しています。 それぞれ、ヘテロ構造の層。負の電界の下で、Φ Bn Φよりも小さい Bp 常に、ショットキー障壁が n であることを示しています タイプ。正の電界がゼロより少し大きい場合、Φ Bn Φより大きくなり始めます Bp 、これはショットキー障壁が n から変更されたことを意味します p と入力します グラフェンで入力-MoTe 2 インターフェース。明らかにバンドギャップ(Φの合計にほぼ等しい) Bn およびΦ Bp )MoTe 2 の 層は外部電場の下でほぼ一定のままです。これは、外部電場が元の電子特性にほとんど影響を与えないことを意味します。これは次のように理解できます。外部電界によってCBMやVBMなどの価電子のエネルギー固有値が変化する可能性がありますが、それらの相対値は変化しないため、バンドギャップは一定に保たれます。言い換えれば、外部電場はバンドの曲がりを除いてバンド構造を変えることができなかった。図7からも明らかなように、正の電界が1.0 V / nmを超えるとSBHが負になります。これは、グラフェンからの電子がMoTe 2 に注入されることを意味します。 バリアなしで、MoTe 2 金属伝導性を備えているため、ショットキーからオーミックへの接触遷移を実現します。強度が1.0V / nmを超える場合の負の電界の場合、ヘテロ構造をオーミック接触に調整することもできます。これらすべての結果は、外部電界の印加が、グラフェン-MoTe 2 のSBHと接触タイプを調整するための効果的な戦略であることを示しています。 ヘテロ構造。

グラフェンのショットキー障壁の高さ-MoTe 2 外部電界の関数としてのヘテロ構造。青と赤の領域は、ショットキーの連絡先を p として示します。 タイプして n それぞれタイプします。灰色の領域はオーミック接触領域を示しています
面内二軸ひずみの関数としてのSBHも計算され、結果が図8に表示されます。二軸ひずみを適用する場合、 z ユニットセルのサイズを変更した後、他の原子の位置は固定されたままで、Te原子の座標は緩和されます。ひずみは、 n 間のヘテロ構造のSBHも調整できることが示されています。 タイプして p ヘテロ構造を入力して駆動し、オーミック接触に近づけます。 SBHのひずみ依存性の振る舞いは、電界依存性の振る舞いとは大きく異なります。状況ははるかに複雑になります。広いひずみ範囲の場合、Φ Bn Φよりも小さい Bp 、狭い引張ひずみ範囲内のみΦ Bp Φよりも小さく維持します Bn 。つまり、 n のひずみ範囲 -タイプSBH(ひずみは約-10〜4%)は、 p よりもはるかに幅が広いです。 タイプ(約4〜7%)。引張ひずみが7%に達し、圧縮ひずみが10%に達すると、ヘテロ構造のオーミック接触も現れます。 MoTe 2 のバンドギャップは注目に値します。 ヘテロ構造の層は、ショットキー接触領域のひずみの変化に伴って大きく変化します。これは、電界の場合の結果とは大きく異なります。格子に歪みが生じると、格子は平衡状態から外れ、バンド構造が変化します。実際、バンドギャップの値だけでなく、バンドギャップのタイプ(直接または間接)もひずみによって変化します。小さなひずみの場合、MoTe 2 層は直接バンドギャップのままですが、大きなひずみの場合は間接バンドギャップに変わります。ここで、実際のトランジスタの場合、ショットキーからオーミックへの接触遷移を実現するための実際の条件は、実際の状況によって計算結果と多少異なる場合があることに注意してください。

グラフェンのショットキー障壁の高さ-MoTe 2 ひずみの関数としてのヘテロ構造。青と赤の領域は、ショットキーの連絡先を p として示します。 タイプして n それぞれタイプします。灰色の領域はオーミック接触領域を示しています
上記の結果は、外部電場と面内二軸ひずみの両方を適用することが、SBHとグラフェン-MoTe 2 の接触のタイプを制御するための効果的な方法であることを示唆しています。 ヘテロ構造。これは、2DvdWヘテロ構造ベースの電界効果トランジスタの設計に不可欠です。さらに、グラフェン-MoTe 2 ヘテロ構造は、ナノエレクトロニクスおよびオプトエレクトロニクスデバイスの調整可能なショットキーダイオードに適用できます。
結論
要約すると、グラフェンのバンド構造-MoTe 2 異なる電場と二軸ひずみの下でのヘテロ構造は、第一原理計算に基づいて体系的に調査されてきました。グラフェンとMoTe 2 の電子構造 垂直方向に沿って積み重ねられた後、よく保存されます。これは、ヘテロ構造の層間相互作用がvdWタイプに属することを示唆しています。ただし、フェルミ準位はMoTe 2 のCBMに向かって移動します。 ヘテロ構造の形成後の層、つまりショットキー接点は n 0.33 eVSBHで入力します。 SBHとヘテロ構造界面の接点のタイプは、外部電界またはひずみを加えることによって効果的に変調できます。電界が印加されると、ショットキー接触領域で n タイプSBHは、電界とほぼ上向きの線形関係を示し、 p タイプSBHは逆の動作をします。ヘテロ構造は、正と負の両方の側で1.0 V / nmを超える電界のオーミック接触に調整できます。二軸ひずみを加える場合は、電界の場合よりも状況が複雑になります。 n のひずみ範囲 タイプSBHは、 p のタイプよりもはるかに幅が広いです。 タイプ。引張ひずみが7%に達するか、圧縮ひずみが10%に達すると、オーミック接触も現れます。すべての結果は、電界またはひずみを印加することが、SBHの制御、およびヘテロ構造の接触のタイプ、さらにはシステムをオーミック接触に駆動するための優れた方法であることを示しています。これらの機能は、高性能のナノエレクトロニクスおよびオプトエレクトロニクスデバイスを設計するために非常に重要です。
データと資料の可用性
この記事の結論を裏付けるデータセットは記事に含まれており、データと資料に関する詳細情報は、対応する著者に宛てた意欲的な要求の下で、利害関係者が利用できるようにすることができます。
略語
- 2D:
-
二次元
- TMD:
-
遷移金属ジカルコゲニド
- vdW:
-
ファンデルワールス
- SBH:
-
ショットキーバリアの高さ
- DFT:
-
密度汎関数理論
- PAW:
-
プロジェクター拡張波
- PBE:
-
Perdew-Burke-Ernzerhof
- GGA:
-
一般化された勾配近似
- DOS:
-
状態密度
- CBM:
-
伝導帯の最小値
- VBM:
-
価電子帯の最大値
ナノマテリアル
- モリブデン線の種類と用途
- 電界と静電容量
- 磁場とインダクタンス
- ラジオの原理
- Arduinoセンサー–タイプとアプリケーション
- パイプカップリングの種類と用途
- 垂直電場によるML-GaSの電子的および光学的異方性特性の変調
- MnХFe3−XО4スピネルの構造的および磁気的特性に及ぼす接触非平衡プラズマの影響
- 非対称コンタクトフォームを備えた多層MoTe2フォトトランジスタからの顕著な光起電力応答
- ハーフメタリック合金の電界調整不揮発性磁性Co2FeAl / Pb(Mg1 / 3Nb2 / 3)O3-PbTiO3ヘテロ構造
- アルゴンプラズマ処理によるZnOの挿入による金属とn-Ge間の接触抵抗の低減



