InGaN / GaNマイクロ発光ダイオードの表面再結合を低減するための代替戦略—電流拡散を管理するための量子障壁の薄化
要約
表面積対体積比が高いため、InGaNベースのマイクロ発光ダイオード(μLED)は、側壁の欠陥によって引き起こされる表面再結合の影響を強く受けます。さらに、チップサイズが小さくなると、それに応じて電流拡散が強化されるため、キャリア注入と外部量子効率(EQE)がさらに制限されます。この作業では、電流拡散効果を管理することにより、側壁欠陥での非放射再結合率を低減することを提案します。そのために、量子バリアの厚さを薄くすることで垂直抵抗を適切に減らし、電流が側壁の欠陥に水平方向に広がるのを減らします。結果として、表面の非放射再結合の方法で消費されるキャリアははるかに少なくなります。私たちの計算結果は、抑制された表面の非放射再結合が正孔注入効率をより良く支持できることを示しています。また、Si基板上に成長するμLEDを製造し、測定結果は数値計算と一致しているため、適切に薄い量子バリアを備えた提案されたμLEDのEQEは、電流拡散効果が少なく、減少するため、向上させることができます。表面の非放射再結合。
はじめに
高輝度、低消費電力、長い動作寿命という特徴的な特性により[1]、III族窒化物ベースの発光ダイオード(LED)は幅広い研究関心を集めています[2、3]。これまでのところ、大型のInGaN / GaN青色LEDの飛躍的な進歩が見られ、商品化されており[3]、ソリッドステート照明や大型パネルディスプレイに応用されています。ただし、従来のInGaN / GaN LEDは変調帯域幅が小さいため、可視光通信(VLC)などには適していません[4、5、6]。一方、チップサイズが大きいため、携帯電話のディスプレイやウェアラブル時計のディスプレイなどのピクセル容量が低くなります。そのため、現段階では、チップサイズが100μm未満のInGaN / GaNマイクロLED(μLED)が注目されています。前述の利点にもかかわらず、高精度の物質移動[7,8,9]やサイズに依存する効率[10]など、μLEDのさらなる開発のために解決すべき多くの問題がまだ残っています。サイズに依存する効率は、メサを作る際のドライエッチングによって引き起こされる表面損傷から生じ、したがって、多数の欠陥が生成され、非放射性の表面再結合を引き起こす。さまざまなタイプの光電子デバイスの場合、結晶品質と電荷輸送は、光電子特性に影響を与えるよりも重要なパラメータの1つであることに注意してください[11、12、13、14、15、16]。 μLEDに特有のことですが、欠陥領域での表面再結合は、μLEDの内部量子効率(IQE)を大幅に低下させる可能性があります[17]。最近、Kou etal。さらに、チップサイズが小さくなると、欠陥によってホールがトラップされやすくなり、チップサイズが小さくなるとμLEDのホール注入能力がさらに悪化する可能性があることがわかります[18]。したがって、側壁の欠陥密度を減らすことが重要です。側壁欠陥を不動態化するための非常に便利な方法は、誘電体不動態化層を堆積することです[19]。これは、プラズマ化学気相成長法(PECVD)または原子層堆積法(ALD)を使用して実行できます。誘電体パッシベーション層は、成長した層の品質がさらに優れているため、ALD技術を使用することで側壁の欠陥をよりよく消滅させることができることが示されています[20]。次に、パッシベーション層を熱アニーリングすることにより、側壁の欠陥数をさらに減らすことができます[21]。これは、6μm×6μmμLEDでもEQEが向上していることを示しています。よく知られているように、横方向の抵抗率が低下するためにチップサイズが減少し続けると、電流の広がりはさらに良くなる可能性があります[22]。したがって、垂直抵抗率を下げて電流をメサ内に閉じ込めることを提案します。これにより、キャリアが側壁の欠陥から離れ、表面の非放射再結合が抑制されます。
したがって、目標を達成するために、エネルギー障壁と垂直抵抗を管理するために量子障壁の厚さを薄くすることを提案します。私たちの数値計算は、電流をより横方向にメサに閉じ込めることができることを示しています。これにより、表面の非放射再結合による正孔消費が減少します。以前のレポート[18]によると、表面の非放射再結合の減少は、正孔注入を容易にするのにも役立ちます。さらに、薄くなった量子障壁は、複数の量子井戸(MQW)全体の正孔分布を均一化します。実験結果は、量子バリアの厚さが減少したμLEDのEQEが改善されることを示しています。
調査方法と物理モデル
表面再結合の抑制、正孔注入の促進、およびInGaN-μLEDのEQEの改善における提案された構造の有効性を証明するために、さまざまなμLEDのセットが設計され、有機金属を使用して[111]配向Si基板上に成長します。化学蒸着(MOCVD)システム[23、24]。すべてのデバイスには、電子濃度が5×10 18 の厚さ4μmのn-GaN層があります。 cm -3 。次に、4ペアのIn 0.18 Ga 0.82 N / GaN MQWは、光子を生成するために使用されます。構造情報を表1に示します。次に、26nmの厚さのp-Al 0.15 Ga 0.85 N層はp型電子ブロッキング層(p-EBL)として機能し、正孔濃度レベルは3×10 17 cm -3 次に、p-EBLの、100 nmの厚さのp-GaN層でキャップされ、正孔濃度は3×10 17 cm -3 。最後に、両方のμLEDサンプルは20nmのp-GaN層で覆われています。調査したすべてのInGaNベースの青色μLEDのチップ寸法は10×10μm 2 です。 。 200nmのITOを電流拡散層として利用し、500°Cの温度で120秒間アニールして、p-GaN層とオーミック接触を形成します。次に、Ti / Al / Ni / Au /合金が電流拡散層に同時に堆積され、n-GaN層がそれぞれp電極とn電極として機能します。
<図>デバイスの物理を詳細なレベルで明らかにするために、調査対象のデバイスはAPSYS [25、26]を使用して計算されます。これにより、ドリフト拡散方程式、シュレディンガー方程式、ポアソン方程式を自己無撞着に解くことができます。フリップチップデバイスの光抽出効率は88.1%に設定されています[27]。 InGaN / GaNMQWの伝導帯と価電子帯のエネルギーバンドオフセット比は70:30に設定されています[28]。非放射再結合によるキャリア損失も、再結合係数が1×10 -30 のオージェ再結合を含む計算で考慮されます。 cm 6 s -1 キャリア寿命が100nsのShockley-Read-Hall(SRH)再結合[29]。 μLEDでは、メサ表面で発生する非放射再結合を無視することはできません。表面再結合を正確にモデル化するために、電子と正孔のトラップレベルは伝導帯より0.24 eV低く設定されています(つまり、E c − 0.24 eV)および価電子帯より0.46 eV上(つまり、E v + 0.46 eV)、それぞれ。 3.4×10 -17 のキャプチャ断面積 cm 2 トラップ密度は1×10 13 cm -3 電子トラップ用に設定されています[30]。 2.1×10 -15 のキャプチャ断面積 cm 2 トラップ密度は1.6×10 13 cm -3 穴[31]に設定されています。他のパラメータは他の場所で見つけることができます[32]。
結果と考察
量子障壁が薄くなると、より好ましい正孔注入が得られることはよく知られています[33]。ただし、薄い量子バリアがμLEDのメサ内に電流を制限するのに役立つかどうかは明らかではありません。この点に対処するために、ここにμLEDA、B、およびCがあり、表1に従って、量子バリアの厚さがそれぞれ6 nm、9 nm、および12nmに設定されています。キャリア分布に対する表面再結合の影響を排除するために[18]、調査対象のμLEDのメサ周辺にトラップは考慮されていません。図1は、μLEDA、B、およびCのそれぞれの注入電流密度レベルに関して計算されたEQEと光パワーを示しています。図1に示すように、量子バリアの厚さが薄くなると、EQEと光パワーの両方が増加し、μLEDA、B、およびCのEQE値は40 A /で28.8%、24.0%、および22.2%になります。 cm 2 。
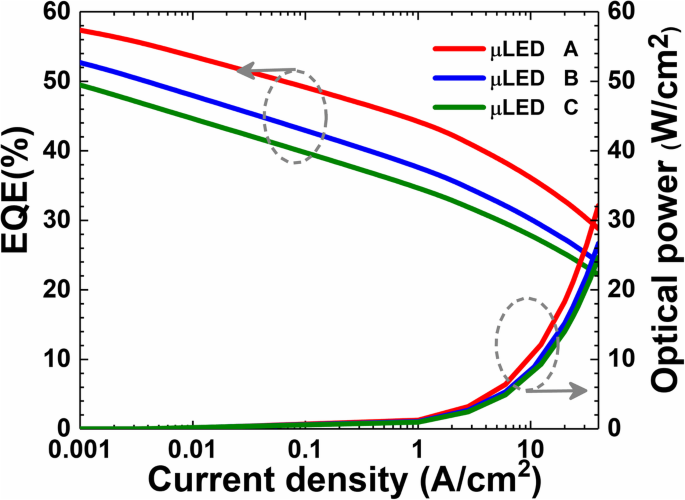
μLEDA、B、およびCのそれぞれの注入電流密度に関して計算されたEQEおよび光パワー密度
図2は、電流密度40 A / cm 2 でのμLEDA、B、およびCのMQW領域の正孔濃度プロファイルを示しています。 。量子障壁の厚さが減少すると、量子井戸の正孔濃度が増加することがわかります。一方、4つの量子井戸の正孔分布の空間的均一性も改善できます。したがって、ここでのμLEDの結果は、大型LEDの結果と一致しており、適切に薄い量子バリアが正孔輸送を促進する可能性があります[33]。すでに述べたように、薄い量子バリアを採用すると、電流がメサエッジに広がることが少なくなります。次に、図3aのp-EBLに最も近い最初の量子井戸の横方向の正孔分布を示します。正孔濃度は、p電極から離れた横方向の位置とともに減少することがわかります。次に、穴の垂下レベルを計算します。これは、p left として定義されます。 -p 右 / p 左 。ここで、p 左 およびp right は、それぞれ左メサエッジと右メサエッジでの正孔濃度として表されます。ドループレベルは、μLEDA、B、およびCでそれぞれ10.7%、10.3%、および9.8%です。より良い説明のために、図3bに示されている横方向の正孔濃度を正規化します。また、量子障壁が薄くなるにつれて垂下レベルが増加することも示しています。
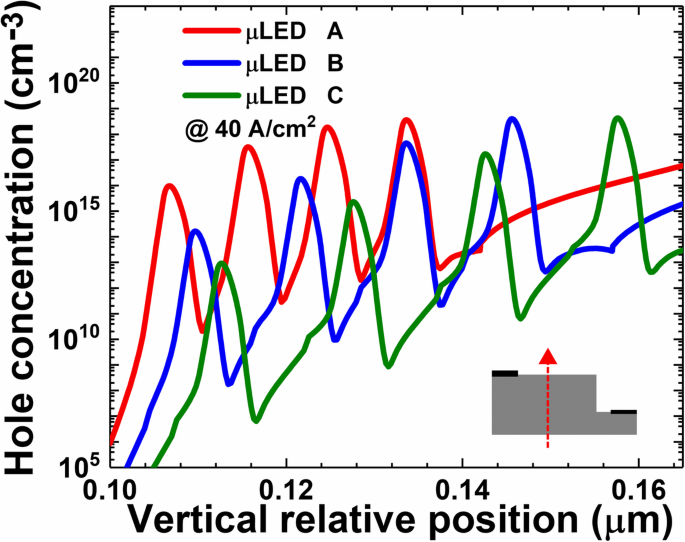
μLEDA、B、およびCのMQW領域で数値的に計算された正孔濃度プロファイル。データは40 A / cm 2 の電流密度で計算されます。 。挿入図は、日付プロファイルがキャプチャされる位置を示しています
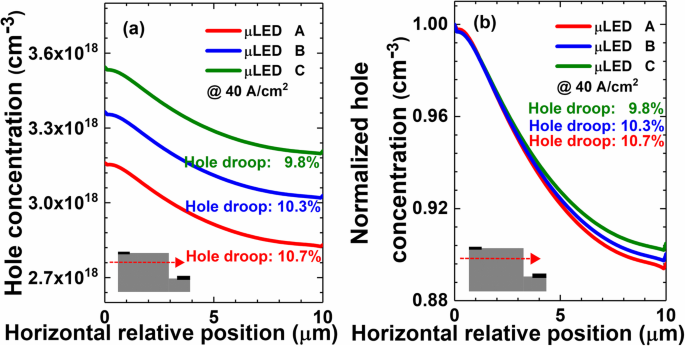
( a )数値的に計算された正孔濃度プロファイル、および( b )それぞれμLEDA、B、Cのp-EBLに近い最初の量子井戸の正規化された正孔濃度プロファイル。挿入図は、穴の濃度プロファイルがキャプチャされる位置を示しています。データは、40 A / cm 2 の電流密度で計算されます。
次に、μLEDA、B、およびCのエネルギーバンド図を図4a–cに示します。これは、量子障壁の厚さが減少すると、すべての量子障壁の価電子帯障壁の高さが減少することを示しています。バランスバンドバリアの高さを低くすると、MQW領域を横切る正孔輸送がより容易になります。これは、図2と一致します。一方、量子バリアを薄くすると、それに応じて垂直抵抗率が低くなります。 Cheらによる報告によると。 [34]、垂直方向の抵抗が減少すると、電流がメサエッジから離れる傾向があるように、横方向の電流の広がりを抑制することができます。この推測は、図3aおよびbを参照したときにも証明されます。
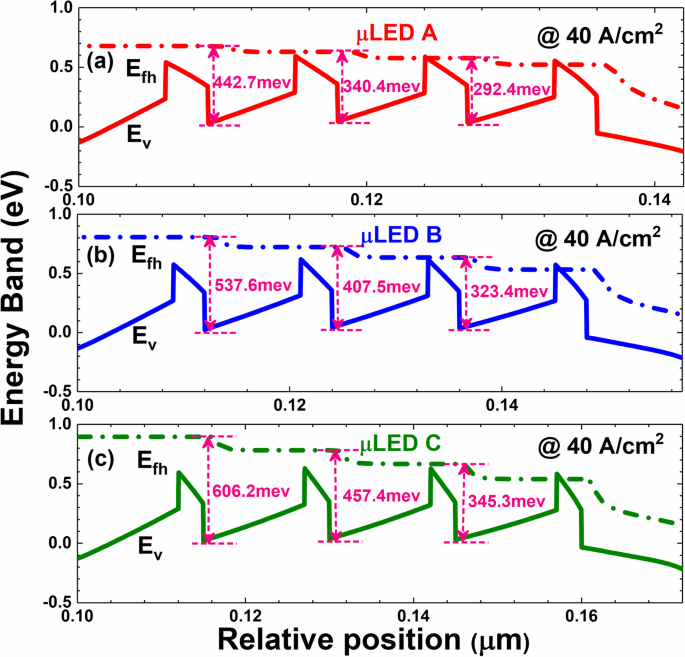
μLEDのエネルギーバンド図( a )A、( b )B、および( c )C。E v 、およびE fh 穴のバランスバンドと擬フェルミ準位をそれぞれ示します。 40 A / cm 2 の電流密度で計算されたデータケア
前述のように、電流拡散は量子障壁を厚くすることによって強化され、キャリア再結合プロセスに確実に影響を与えます。次に、メサのエッジでのSRH再結合と放射再結合の比率を示します(図5を参照)。比率は、\({R} _ {\ mathrm {SRH}} / {R} _ {\ mathrm {rad}} ={\ int} _0 ^ {{\ mathrm {t}} _ {\ mathrmを使用して計算されます{M} \ mathrm {QW}}} {R} _ {\ mathrm {SRH}}(x)\ times \ mathrm {dx} / {\ int} _0 ^ {{\ mathrm {t}} _ {{{ } _ {\ mathrm {M}}} _ {\ mathrm {QW}}}} {R} _ {\ mathrm {rad}}(x)\ times \ mathrm {dx} \)、ここで R SRH (x)はSRH再結合率 R を表します rad (x)は放射再結合率を示し、t MQW MQW領域の合計の厚さです。図5は、 R の比率を示しています。 SRH / R rad 量子バリアの厚さが増すにつれて、メサのエッジの両方が減少します。これは、理想的なμLEDアーキテクチャの電流拡散効果を改善することで放射再結合率を高めることができることを意味します。これは、チップサイズが大幅に縮小されているため、μLEDが優れた電流拡散を実現できることを意味します[21、22]。図5の表面再結合についてはまだ考慮していません。したがって、現実的なμLEDのはるかに優れた電流拡散効果は、表面の欠陥を考慮してモデル化できるキャリア放射再結合を犠牲にする可能性があると推測できます。その後、詳細な議論が行われます。
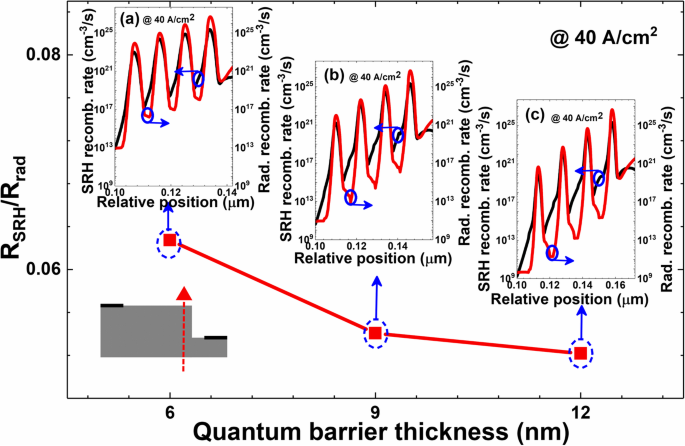
μLEDA、B、およびCの統合SRH再結合(SRH)率と統合放射再結合率の比率。挿入図( a )、( b )、および( c )は、それぞれμLEDA、B、およびCのメサエッジでのSRH再結合(SRH)率と放射再結合率のプロファイルです。データは、40 A / cm 2 の電流密度で計算されます。
薄い量子バリアを備えたMQWを使用することで表面の再結合を低減
量子バリアの厚さが異なるμLEDの正孔注入に対する表面再結合の影響を調べるために、μLEDI、II、およびIIIをさらに設計します。 μLEDI、II、およびIIIのMQWの構造情報は、μLEDI、II、およびIIIの表面欠陥が考慮されることを除いて、それぞれμLEDA、B、およびCの構造情報と同じです(表1を参照)。 μLEDI、II、およびIIIの欠陥領域の幅は、エッチングされたメサエッジから0.5μmに設定されていること。
電流密度の関数として数値的に計算されたEQEと光パワーを図6に示します。図6は、表面の非放射再結合を考慮すると、光強度を大幅に低下させることができることを示しています。したがって、これはさらに、μLEDの表面非放射再結合を無視できないことを確認します[10、17、18]。一方、図1の観察結果とよく一致して、量子バリアの厚さが減少すると、EQEと光パワーも向上します。たとえば、量子バリアが最も薄いμLEDIのEQEと光パワーが最大になります。 μLEDIおよびIIIについて実験的に測定されたEQEを図6aの挿入図に示します。これは、数値計算結果と同じ傾向を示しています。さらに、μLEDIおよびIIIの正規化されたエレクトロルミネッセンス(EL)スペクトルをそれぞれ測定し、図6bおよびcに示します。テストしたすべてのμLEDのピーク発光波長は約450nmです。測定されたELは当社のモデルで再現できます。これは、使用した物理パラメータが正しく設定されていることを示しています。たとえば、発光波長を決定するMQWの偏光レベルとInN組成が適切に設定されています。
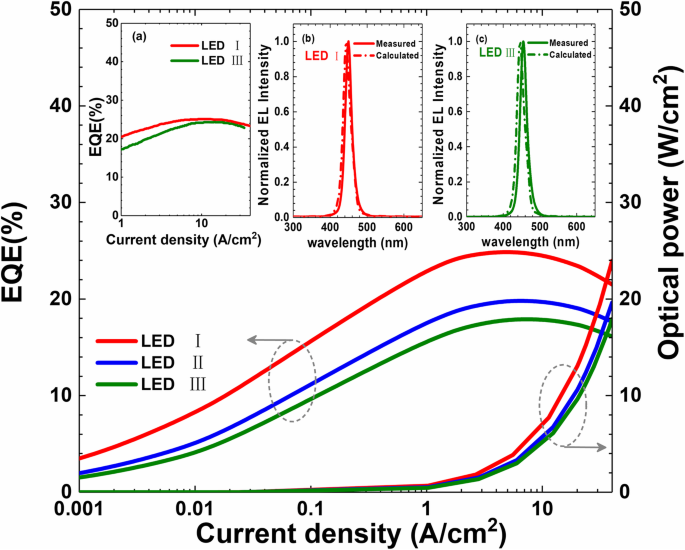
μLEDI、II、IIIのそれぞれの注入電流密度に関して計算されたEQEと光パワー密度。 ( a の挿入図 )は、それぞれμLEDIおよびIIIについて実験的に測定されたEQEを示しています。 ( b の挿入図 )および( c )μLEDIおよびIIIの測定および数値計算されたELスペクトルを示します。挿入図のデータ( b )および( c )は、40 A ∕ cm 2 の電流密度で収集されます
μLEDI、II、およびIIIの正孔注入効率に対する側壁欠陥の影響を明らかにするために、正孔濃度を図7に示します。図7aの正孔濃度は、デバイス[図7aの挿入図の赤い矢印で示されている]。図7bは、デバイスの欠陥領域の正孔濃度を示しています[図7bの挿入図の赤い矢印で示されています]。図7aおよびbが示すように、欠陥のない領域と側壁領域の両方で、量子バリアの厚さが薄くなると、MQWを通過する正孔の輸送が促進されます。ここでの結果は図2と一致しています。図7aとbをさらに比較すると、欠陥のある側壁領域での正孔注入効率は、欠陥のない領域よりも明らかに低いことがわかります。ここでの観察は、Kouらとよく一致しています。 [18]、これはさらに、量子バリアの厚さを適切に減らすことによって、欠陥のある側壁への電流の広がりを少なくすることが本質的に必要であることを示しています(図3aおよびbを参照)。

MQW領域で数値的に計算された正孔濃度プロファイル( a )中央に( b )それぞれμLEDI、II、IIIのメサの端にあります。データは、40 A / cm 2 の電流密度で計算されます。 。挿入図は、穴濃度プロファイルがキャプチャされる位置を示しています
次に、図5で行ったように分析を繰り返します。その値は、図8に示されています。 R の比率がわかります。 SRH / R rad 量子障壁が厚くなると、メサエッジで増加します。これは、表面の非放射再結合率が大幅に向上したことによるものです。私たちが提案したように、厚い量子障壁は、電流がメサエッジに到達し、表面の非放射再結合を引き起こすことを可能にします。その結果、挿入図a–cは、表面の非放射再結合がメサエッジで非常に強くなることも示しています。側壁での非放射再結合率は、放射再結合率をも圧倒します。

μLEDI、II、およびIIIの統合SRH再結合(SRH)率と統合放射再結合率の比率。挿入図( a )、( b )、および( c )は、それぞれμLEDI、II、およびIIIのメサエッジでのSRH再結合(SRH)率と放射再結合率のプロファイルです。データは、40 A / cm 2 の電流密度で計算されます。
結論
要約すると、InGaNベースのμLEDの正孔注入と電流拡散に対するさまざまな量子バリアの厚さの影響を数値的に調査して実証しました。結果は、量子障壁の厚さを薄くすることによって、メサ領域内のより良い電流閉じ込めを可能にすることができることを示しています。それに対応して、電流の広がりはメサエッジから離れるようにうまく管理することができ、それにより表面の非放射再結合が抑制されます。数値的にも実験的にも、適切に薄い量子バリアを備えたInGaNベースのμLEDの外部量子効率の向上を観察します。提案されたアプローチは、高性能μLEDの開発を制限するボトルネックを取り除くために有望であると信じています。さらに、この研究で紹介するデバイスの物理学は、InGaNベースのμLEDの理解を深めます。
データと資料の可用性
現在の作業のデータと分析は、合理的な要求に応じて対応する著者から入手できます。
略語
- μLED:
-
マイクロ発光ダイオード
- EQE:
-
外部量子効率
- LED:
-
発光ダイオード
- InGaN:
-
窒化インジウムガリウム
- GaN:
-
窒化ガリウム
- VLC:
-
可視光通信
- IQE:
-
内部量子効率
- PECVD:
-
プラズマ化学気相成長法
- ALD:
-
原子層堆積
- MQW:
-
複数の量子井戸
- MOCVD:
-
有機金属化学蒸着
- p-EBL:
-
p型電子ブロッキング層
- APSYS:
-
半導体デバイスの高度な物理モデル
- SRH:
-
Shockley-Read-Hall
ナノマテリアル
- Skype for Businessのコストを削減するために、これらの実装の課題に取り組みます
- Fe3 +の高感度測定のためのMXene量子ドットの蛍光を制御するN、N-ジメチルホルムアミド
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- シリコン基板上のInGaN / GaN多重量子井戸におけるひずみ制御再結合
- AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
- InGaAs / GaAs表面量子ドットのフォトルミネッセンス特性に及ぼす温度と励起強度の相互作用効果
- フォトルミネッセンスによって研究されたInGaN / GaN量子井戸における2種類の局在化状態間のキャリア再分布
- GaNテラヘルツ量子カスケードレーザーの性能に対する界面粗さ散乱の主な影響
- トラック運転手が道路上のストレスを管理するためのヒント
- AC 電流の最も一般的な用途は?



