サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
要約
赤外線(IR)反射分光法は、Siドープ多層n + を研究するために適用されます / n 0 / n + -GaNテンプレート/サファイア基板を備えたGaNバッファ上に成長したGaN構造。フォトエッチング、SEM、およびSIMS法による調査対象の構造の分析では、SiとOのドーピングレベルに大幅な違いがあり、エピタキシャルGaNバッファとテンプレートの間に位置する追加の層の存在が示されました。実験的な反射スペクトルのシミュレーションは、広い周波数範囲で実行されました。 2×2転送マトリックス法を使用し、追加の層を分析に含めることで、IR反射スペクトルのモデリングにより、実験スペクトルの最適なフィッティングを取得できることが示されます。これにより、良好なGaN層の厚さが評価されます。 SEMおよびSIMSデータとの合意。各GaN層のプラズモン-LO-フォノン結合モードのスペクトル依存性は、アクセプター状態による補償効果に起因する、Siドーピング不純物の誘電体のスペクトル依存性から得られます。
背景
近年、III族窒化物材料、特にGaNに高い関心が寄せられています[1、2]。成長技術の飛躍的進歩により、エピタキシャルGaN膜は、青色および紫外線発光ダイオード(LED)[3]、レーザー[4]、マイクロエレクトロニクスデバイスなどのオプトエレクトロニクスデバイスで幅広い用途が見出されています。例えば、高出力および高周波電界効果トランジスタ[5、6]。フリーキャリアの濃度と移動度は、アプリケーションでのデバイスのパフォーマンスを決定する重要なパラメータです。多層GaNベースのデバイス構造における自由キャリアの濃度と移動度のホール測定は、各測定層に取り付けられたオーミック接触と専用の測定手順を必要とする、簡単で時間のかかる技術的タスクではありません。
フーリエ変換赤外(IR)反射分光法とラマン分光法は、非接触で非破壊的な方法であり、フォノンの振動だけでなく、キャリア特性の特性評価も可能です[7]。しかし、共焦点マイクロラマン分光法の既知の問題は、光の屈折による深さの空間分解能の低下です[8]。それは参考文献に示されていました。 [6]励起波長488.0nmの多層GaN構造の深さスキャンでは、深さ分解能は約1.8μmであり、横方向分解能は約210nmです。 IR分光法は、干渉効果と広いスペクトル範囲での屈折率の分散の影響による層の厚さに対する感度が高いため、この問題を克服します。
薄いGaN膜のIR反射スペクトルは、1973年にA.S.によって調査されました。ベイカー[9]が、そのようなフィルムの空間的不均一性と全体的な低い構造品質は、得られた結果の実際の適用を著しく制限しました。それにもかかわらず、GaNの薄膜における光学フォノンと自由キャリアの吸収のパラメータを決定する可能性が実証されました。縦光フォノンの詳細な研究 – バルクGaNのプラズモン結合(LOPC)モードは、Perlin etalによって実行されました。 [10]ラマン分光法を使用し、Shubertらによる。 [11] IRエリプソメトリーを使用します。立方晶およびウルツ鉱型GaN膜の光学特性に対するさまざまな基板の影響も詳細に研究されています[12、13]。ネイティブGaN基板がないことを考慮すると、GaN膜のエピタキシャル成長にサファイア基板を使用することは、高温で動作するデバイスでの活用に最適であることが示されました。六角形サファイアのIR反射分光法の研究[14]は、複雑なスペクトルを示しました。その形状は、偏光と入射角に強く依存します。これにより、サファイア基板上に成長したGaN薄膜のフォノンモードのスペクトル特性と自由キャリアの特性の測定と決定が非常に複雑になります。
したがって、スペクトル分析アルゴリズムの適切な選択と誘電関数の形式は、多層GaN-on-sapphire構造のIR反射スペクトルの分析にとって非常に重要です[15、16、17]。この論文は、不均一な深さとドーピングプロファイルを持つ平面GaNベースの多層構造の分析のためのIR反射分光法と2×2転送マトリックス法の適用の可能性を示しています。これは実際には異なるタイプの半導体III窒化物である可能性があります。発光および整流ダイオード、ガンダイオード、高電子移動度トランジスタ(HEMT)などの垂直設計のベースのデバイス構造。
メソッド
実験的
調査したn + / n 0 / n + -GaN構造は、Al 2 上のMOCVDGaNテンプレート上で成長しました。 O 3 (0001)N 2 を使用したプラズマ支援分子線エピタキシーによる800°Cの温度での基板 0.5sccmの流量と350WのRFプラズマパワー(図1)。これにより、成長率は〜0.27 ML s -1 になります。 。まず、厚さ0.3μmのGaNバッファをMOCVDGaNテンプレート上に成長させました。厚さ0.8μmのSiドープGaN層の後に、厚さ1.75μmのアンドープGaN層と厚さ0.4μmのSiドープGaN層が続きました(図1)。 n + の公称Siドーピング濃度 -GaN層は〜10 19 cm -3 。
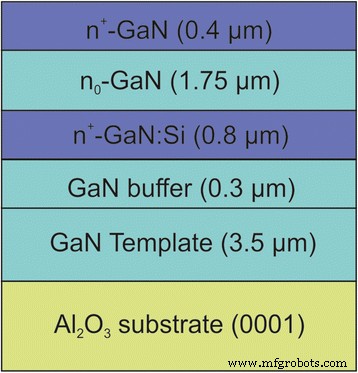
調査したn + の概略図 / n 0 / n + -GaNテンプレート/(0001)サファイア基板上に成長したGaN構造
キャリア濃度の異なる領域を調べるために、調査した構造の劈開されたエッジを、K 2 を使用した無電解構成でのフォトエッチング法によって調べました。 S 2 O 8 –KOH水溶液(KSO-Dエッチングシステム)[18]。この方法では、表面プロファイリングを使用してエッチング速度を測定することにより、異なるキャリア濃度の領域を明らかにし、相対的なキャリア濃度の違いを視覚化することができます[19、20]。調査したサンプルの断面を3分間フォトエッチングしました。その後、走査型電子顕微鏡(SEM)によってサンプルを検査しました。
サンプルの二次イオン質量分析(SIMS)研究は、セシウム(Cs + )を使用してCAMECAIMS6Fシステムで実行されました。 )不純物濃度のプロファイルを見つけるために、電流を400nAに維持した一次ビーム。ラスターのサイズは約50×50μm 2 でした 、および二次イオンは、直径30μmの中央領域から収集されました。 H、C、O、およびSiの場合、濃度はそれぞれH–、O–、C–、Si–種から導き出され、マトリックス信号Ga–が参照として使用されました。
300〜4000 cm -1 のスペクトル範囲での赤外線反射分光測定 スペクトル分解能1cm -1 Globarソースと重水素化硫酸トリグリシン(DLaTGS)検出器を備えたBruker Vertex 70 V FTIR分光計を使用して、室温で実施しました。入射角は11°でした。 S -偏光スペクトルは、KRS-5偏光子を使用して測定しました。金の鏡の反射スペクトルを基準として使用しました。
光学分析モデルの説明
層/基板システムの反射率は、2×2転送マトリックス法[17、21]を使用して計算されました。この方法では、任意の数の層を含めることができ、フィルム内の干渉効果が自動的に考慮されます。等方性層状システムの2×2転送行列法により、 s の独立した計算が可能になります。 -および p -実験室座標のz軸とc軸が整列している均質な2軸または1軸の等方性スラブで構成される層状システムの場合の偏光反射および透過スペクトル。この場合、2×2層状システム伝達行列は次のビューで表すことができます[21]:
$$ {\ left(\ begin {array} {c} \ hfill {E} _0 ^ {+} \ hfill \\ {} \ hfill {E} _0 ^ {-} \ hfill \ end {array} \ right) } _ {s / p} =\ frac {1} {t_ {0,1} ^ {s / p}} \ left(\ begin {array} {cc} \ hfill 1 \ hfill&\ hfill- {r} _ {1,0} ^ {s / p} \ hfill \\ {} \ hfill {r} _ {1,0} ^ {s / p} \ hfill&\ hfill 1 \ hfill \ end {array} \ right ){\ displaystyle \ prod_ {l =1} ^ N {T} _ {l / \ left(l + 1 \ right)} ^ {s / p} {\ left(\ begin {array} {c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {array } \ right)} _ {s / p}} ={\ left(\ begin {array} {cc} \ hfill {T} _ {11} \ hfill&\ hfill {T} _ {12} \ hfill \\ {} \ hfill {T} _ {21} \ hfill&\ hfill {T} _ {22} \ hfill \ end {array} \ right)} _ {s / p} {\ left(\ begin {array} { c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {array} \ right)} _ {s / p}。 $$(1)出口媒体のフィールド振幅の上位インデックスのアスタリスクは、式(1)で使用されます。 (1) N のすぐ右側の電界成分の値を説明する / N +1インターフェース。
\(2 \ times 2 \ kern0.24em {T} _ {l、\ left(l + 1 \ right)} ^ {s / p} \)伝達行列は、
ここで、\({r} _ {l、l + 1} ^ {s / p} \)および\({t} _ {l、l + 1} ^ {s / p} \)は、部分的な反射係数と透過係数を示します。 l /(l + 1)の場合 インターフェイス、\({\ delta} _l ^ {s / p} \)は位相シフトであり、 l-による伝播後に光に適用されます。 の第3層 -および p -偏光。
s の位相シフト -および p - l-を通過した後の偏光 この層は[17]:
として決定できます。 $$ {\ delta} _l ^ {s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _ {l、s / p} \ cos {\ theta} _ {l、 s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _l \ sqrt {1-{\ left(\ frac {1} {n_ {l、s / p}} \ sin \ theta \ right)} ^ 2}、$$(3)ここで n l the l- の複素屈折率 第3層、 d l l- の厚さです 第3層、およびθ は入射角です。
s の部分反射係数と透過係数 -および p -偏光は、フレネルの式を使用して計算できます。たとえば、 s の部分反射係数と透過係数 -分極の形式は次のとおりです[21]:
$$ \ begin {array} {l} {r} _ {l、l + 1} ^ s =\ frac {n_ {ls} \ cos {\ theta} _ {ls}-{n} _ {\ left( l + 1 \ right)s} \ cos {\ theta} _ {\ left(l + 1 \ right)s}} {n_ {ls} \ cos {\ theta} _ {ls}-{n} _ {\ left(l + 1 \ right)s} \ cos {\ theta} _ {\ left(l + 1 \ right)s}} \\ {} {t} _ {l、l + 1} ^ s =\ frac {2 {n} _ {ls} \ cos {\ theta} _ {ls}} {n_ {ls} \ cos {\ theta} _ {ls} + {n} _ {\ left(l + 1 \ right) s} \ cos {\ theta} _ {\ left(l + 1 \ right)s}} \ end {array} $$(4)したがって、多層スタックの複素反射率は、 N + 1 を部分反射係数と透過係数に置き換えることで取得できます。 式(4)のインターフェース(式(4)) (1)およびすべての N の位相シフト レイヤー(式(3)):
$$ {R} _ {s / p} ={\ left | {r} _ {0、N + 1} ^ {s / p} \ right |} ^ 2 ={\ left | \ frac {T_ {21 }} {T_ {11}} \ right |} ^ 2。 $$IR誘電関数モデル
屈折率は複素誘電関数εに依存します (ω )、次のように書くことができます:
$$ \ varepsilon \ left(\ omega \ right)={\ varepsilon} ^ {\ mathrm {lat}} \ left(\ omega \ right)+ {\ varepsilon} ^ {\ mathrm {fc}} \ left(\オメガ\ right)。 $$(5)最初の項は格子モード分散からの寄与に対応し、2番目の項は自由キャリア励起への寄与に対応します。
IR応答への格子モードの寄与ε lat (ω )フォノンエネルギーでℏω ローレンツ広がりを伴う因数分解モデルを使用して説明できます[22]:
$$ {\ varepsilon} ^ {\ mathrm {lat}} \ left(\ omega \ right)={\ varepsilon} _ {\ infty} {\ displaystyle \ prod_ {k =1} ^ M \ frac {\ omega_ { \ mathrm {LO} k} ^ 2-{\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {LO} k}} {\ omega _ {\ mathrm {TO} k} ^ 2-{\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {TO} k}}}、$$(6)ここで M s の赤外線アクティブ極性フォノンモードの数です。 -または p - c-への分極 軸; ω LOk およびω TOk 周波数(cm -1 ) k- の LOおよびTOフォノン。 γ LOk およびγ TOk それらの減衰定数(cm -1 )。 GaNの場合、パラメータω LOk およびω TOk E を説明する 1 (LO)、 A 1 (LO)および E 1 (TO)、および A 1 (TO)振動モード[23]。
フリーキャリア種の寄与ε fc (ω )誘電関数は、古典的なDrude近似[15]を使用して記述できます:
$$ {\ varepsilon} ^ {\ mathrm {fc}} \ left(\ omega \ right)=-{\ varepsilon} _ {\ infty} \ frac {\ omega_p ^ 2} {\ omega \ left(\ omega + i {\ gamma} _p \ right)}、$$(7)と
$$ {\ omega} _p ={\ left(\ frac {N {e} ^ 2} {\ varepsilon _ {\ infty} {\ varepsilon} _0 {m} ^ {\ ast}} \ right)} ^ {1 / 2} $$(8)$$ {\ gamma} _p =\ frac {e} {m ^ {\ ast} \ mu} $$(9)スクリーニングされたプラズマ周波数ω p (式(8))は自由キャリア濃度 N に依存します 、高周波誘電率ε ∞ 、および有効質量 m ∗ フリーキャリアの(ε 0 は真空誘電率であり、 e は電気的単一電荷です)。プラズモン減衰パラメータγ p 光キャリアの移動度μに依存します (式(9))[24]。
ω LO のパラメータ LOPCモードは、エネルギー損失関数の虚数部から決定できます— \(\ mathrm {I} \ mathrm {m} \ left(-\ frac {1} {\ varepsilon \ left(\ omega \ right)} \右)\)[7]、ここでε (ω )は、式(1)から得られる複素誘電関数です。 (5)。
結果と考察
SEM画像(図2)は、n + のフォトエッチングされた断面を示しています。 / n 0 / n + -GaNバッファ/ GaNテンプレート/サファイア基板上に成長したGaN構造。6つの異なる層がはっきりと見えます。これは、キャリア濃度とサファイア基板が異なる5つのGaN層です。 SEMによって測定された調査されたGaN構造の全体的な厚さは技術的なものと一致し、図1に従って観察されたGaN層は、暫定的に公称上部Siドープn + > 領域(レイヤー1)、ドープされていないn 0 領域(レイヤー2)、下部Siドープn + 領域(レイヤー3)、ドープされていないGaNバッファー(レイヤー4)、およびGaNテンプレート。
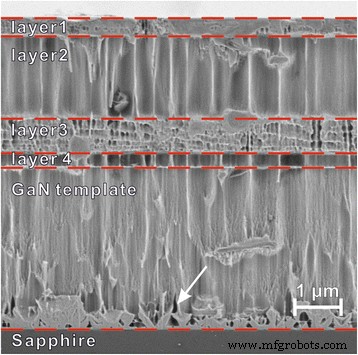
調査したn + の断面のSEM画像 / n 0 / n + -GaN構造。垂直線の不規則なパターンは、劈開中(つまり、フォトエッチング前)に形成され、Al 2 の研磨されていない劈開に特徴的です。 O 3 / GaNヘテロ構造。粗い錐体層(ピンホール )矢印で示されるサファイア/ GaNテンプレートで フォトエッチングで明らかになった
さらに、調査したサンプルの不純物/ドーピングレベルをより深く理解するために、SIMS測定を実行しました。得られたSIMSプロファイル(図3)は、GaN層の公称厚さおよび調査した多層構造の全体的な厚さと良好な相関関係があります。調べたすべての元素(H、C、O、Si)は、検出限界(3〜5×10 16 )を超えていました。 at / cm 3 )SIMSテクニックの。
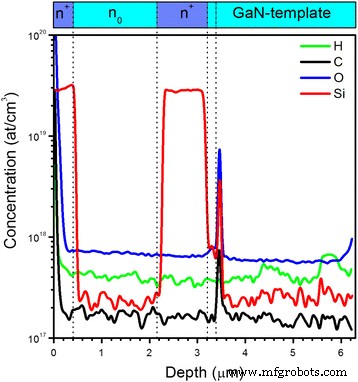
調査したn + の不純物元素プロファイル / n 0 / n + -サンプル表面からSIMSによって測定されたGaN構造
意図的なSiドーピングのプロファイルは、一般に、約2.8×10 19 の濃度の公称ドーピングプロファイルと一致します。 cm -3 ドープされた上部と下部のn + 領域と約2.3×10 17 cm -3 ドープされていないn 0 領域。ただし、SIMSデータからわかるように、Si濃度が1.1×10 19 の薄い(<50 nm)デルタ層もあります。 cm -3 GaNバッファとGaNテンプレートの間。 Siドープデルタ層には、2.4×10 19 の高濃度の意図しない酸素および炭素不純物も含まれていることに注意してください。 cm -3 および1.4×10 18 cm -3 、それに応じて。このデルタ層は、ホモエピタキシャル再成長界面に関連しています。これは通常、ローディングの技術プロセスまたは再成長の開始時に大気から吸収されたO、Si、およびC不純物によるGaNテンプレートの汚染から生じます[25、26]。
上記のように、SEM断面とSIMS分析により、GaN層の構造が得られます。これは、追加のGaN領域を励起することによって公称パラメーターとは異なりますが、全体の厚さは公称値と一致します。調査した構造のIR反射スペクトルに対する上記の追加のGaNデルタ層の影響を明らかにするために、実験スペクトルのシミュレーションは、公称技術パラメータであるSEM画像(図1)、およびSIMSによる7つの層。上記のモデルに基づいて計算されたスペクトルを図4に示します。

層数が異なるIR反射スペクトルのシミュレーション。調査したn + の実験スペクトル / n 0 / n + -GaN構造は実線で示されています 。 a Reststrahlen地域。 b 750 cm -1 を超える範囲の拡大スペクトル
図4からわかるように、SIMSプロファイルに基づいて、7層モデルは実験的なIR反射スペクトルの最良の近似を提供します。したがって、名目上の技術モデル(図1)と比較して、パラメーターが変更されたこのモデルを使用して、さらなるシミュレーションと分析が実行されます。これは、技術的なGaNバッファー層とGaNテンプレートの間の追加の層を説明します(図5)。
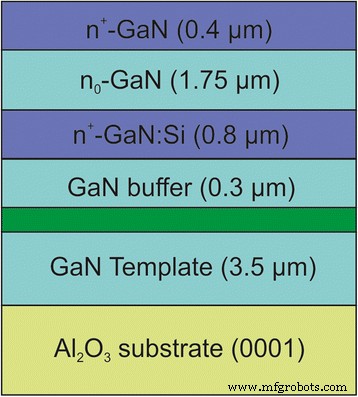
調査したn + のIR反射スペクトルをシミュレートするために使用される7層モデル / n 0 / n + -GaN構造。追加のレイヤー(緑 )は、GaNテンプレートと調査対象のGaN層の間の薄い界面層です
図6は、実験的および適合した理論上の s を示しています。 -11°の入射角での調査対象構造の偏光反射スペクトル。計算されたスペクトルは、上記のモデルに基づいています(図5)。 GaN層とサファイア基板の複素屈折率の分散は、式(1)を使用して決定されました。 (5)。サファイア基板は半無限と見なされ、基板内および研磨されていない裏面からの内部反射を無視することができました。スペクトルのレストストラレン領域で観察される複雑な構造は、重なり合うGaNとAl 2 の組み合わせによるものです。 O 3 干渉効果と一緒にreststrahlenバンド。これらのデータを計算されたスペクトルと比較すると、サンプルのさまざまな層の厚さ情報が得られるだけでなく、さまざまな材料の寄与という観点から、レストストラレン領域の複雑な構造を解釈するのにも役立ちます。

実験的(実線 )および最適な計算(一点鎖線 )n + のIR反射スペクトル / n 0 / n + -GaNテンプレート/ Al 2 上に成長したGaN構造 O 3 。 a Reststrahlen地域。 b 干渉領域
反射率データと計算されたスペクトルの比較からの層の厚さの決定は、2段階のプロセスです[27]。まず、レストストラレンバンドの上の透明な領域のフリンジ(ω> 1200cm -1 )は、多層構造の層への干渉効果によるものです。このようにして、すべての層の合計である、調査対象の構造の全体的な厚さを推定できます。
スタックの厚さがわかれば、計算されたスペクトルをスペクトルのレストストラレン領域の干渉効果に適合させることにより、各層の個々の厚さを決定できます。層の厚さは、以前に決定された全体の厚さを考慮に入れることによって変化させた。この制約の下で、1200 cm -1 を超える反射率 大きく変化することはありません。レストストラレン領域での干渉効果は、層の厚さが変化するにつれて干渉縞の位置がシフトするという事実に基づいて、TOおよびLO振動モードなどの他の機能と区別できます[28]。
reststrahlen領域での実験スペクトルの近似中に、次のモデルパラメータが変更されました。減衰パラメータγ LO およびγ TO E の場合 1 (LO)および E 1 (TO)フォノンモード;プラズマ周波数ω p ;プラズモン減衰パラメータγ p ;と層の厚さ。 E のみであることに注意してください。 1 対称フォノンは s でIRアクティブです -分極[9]。 E の初期周波数 1 (LO)および E 1 GaNおよびサファイア基板の(TO)フォノンは、IR反射率[29]およびラマン散乱[6、14]実験から取得されました。 GaNフォノン周波数の一般的な値はω TO です。 =560cm -1 およびω LO =740cm -1 。各層のフォノン周波数は、フィッティングプロセスで改良されました。エラーバーを使用して得られた最適なパラメータを表1に示します。フィッティングプロセスで得られた層の厚さは、SEMデータとよく一致していることに注意してください。
<図>図6aを参照すると、約450 cm -1 の反射率ピーク サファイア基板に起因する可能性があります。 500〜740 cm -1 の範囲で観察された特徴 これは、GaN層とサファイアレストストラレンバンドの重なり合う特徴の組み合わせによるものです。より詳細な分析のために、サファイア上のバルクGaNと6.78μmの厚さのGaN層のIR反射スペクトルを、調査対象の構造の全体の厚さに対応するGaNの厚さでシミュレートしました(図7)。 。図7からわかるように、500〜740 cm -1 の範囲のサファイアおよびバルクGaN上の6.78厚のGaN層の反射スペクトル 実験スペクトルに似ています。 〜511 cm -1 の小さな特徴 サファイア基板に関連付けられています。 〜736 cm -1 、 A に対応する弱いディップがあります 1 GaNテンプレートの(LO)モード。選択規則に従って、 A 1 (LO)モードは s では禁止されています -偏光IRスペクトル[9]。この禁止モードの登録の考えられる理由は、反射アクセサリの開口による偏光漏れと、GaN結晶構造の微小不均一性である可能性があります。具体的には、これは c の傾きが原因である可能性があります -膜の成長面に垂直な方向からのGaNの柱状ウルツ鉱構造の軸。このモードは、結果のスペクトルへの影響が弱いため、モデリングでは考慮されていません。 750〜1200 cm -1 の範囲の機能 オーバーラップするGaN:Siとサファイアのレストストラレンバンドと界面効果によるものです。 〜775 cm -1 での落下 GaN層とサファイアのレストストラレンバンドのエッジへの界面効果に関連しています。 〜825 cm -1 での広いディップ プラズモン-LO-フォノン結合モード(LPP + )の高周波分岐のオーバーラップに関連付けられています )n + の レイヤー。
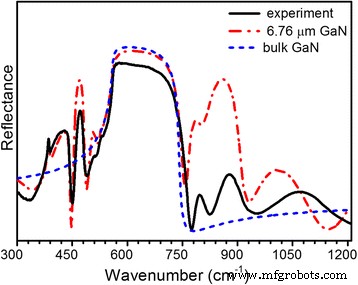
実験的(実線 )調査したn + のIR反射スペクトル / n 0 / n + -サファイア上の6.78μm厚のGaN層のGaN構造と計算された反射スペクトル(一点鎖線 )およびバルクGaN(破線 )
図8は、 E の推定のために、表1に示されている発振器パラメーターに従って各層のエネルギー損失関数の計算された虚数部を示しています。 1 -LOPCモード。ご覧のとおり、LOPCモードの高周波ブランチ(LPP + )キャリア濃度が10 17 未満の場合 cm -3 (n 0 レイヤーとテンプレート)は E とほぼ一致します 1 (LO)フォノンモード。 2×10 17 の範囲でのキャリア濃度の増加 –3×10 18 cm -3 (図5)は、LPP + の大幅な高周波シフトと広がりにつながります。 LOフォノンとプラズモン間の相互作用の増加と電荷キャリアの移動度の減少を示す分岐。 LPP + のこの動作 ブランチは、Z.F。によってサファイア上に成長させたSiドープGaN膜のIR反射率に関する実験データとよく一致しています。 Li etal。 [30]、およびバルクGaN [10]およびエピタキシャル層[31]のラマン測定。低周波LPP - この場合、LOPCのブランチを s として確実に定義することはできません。 -偏光IR反射スペクトルは、300 cm -1 未満の低周波数範囲では測定されませんでした。 。

最適なデータ分析から分析された各GaN層について得られた誘電関数の計算された虚数部
表2にリストされているキャリア濃度と移動度の値は、式(1)を使用して計算されました。 (8)および(9)電子有効質量m *が0.2m 0 [32]。計算されたキャリア濃度プロファイルは、SIMS測定によって得られたSi不純物濃度プロファイル(図3)と似ていますが、濃度Si不純物と比較して桁違いに低いキャリア濃度であることがわかります。キャリアとドーピング不純物の濃度のこのような不一致は、M。Bockowskietal。によって以前に観察されました。 [33]、そしてアクセプター状態による補償効果(おそらくガリウム空孔による)に関連しており、その形成エネルギーはn型ドーピングの増加とともに低下します[34]。 n + のキャリア濃度について言及する必要があります 〜10 18 のオーダーのレイヤー cm -3 LOPCモードの分析に基づく同様のGaN構造のラマン研究の結果とよく一致しています[6]。得られたキャリア移動度μのキャリア濃度による減少も、GaNでのホール実験[35]および理論的モデリング[36]とよく一致しています。
<図>高周波誘電率の値ε∞ 4.99〜5.35の範囲であることがわかりました(表1)。 ε∞の増加 ドープされたn + の場合 n 0 と比較したレイヤー 層は、α-GaNバンドギャップの赤方偏移に関連している可能性があります[37]。 ε∞の値に注意する必要があります 低導電性フィルムの場合のみ、比較的小さな誤差で測定できます。 ε∞の決定の精度 キャリア濃度とともに減少します。これは、ε∞という事実に関連しています。 誘電体モデル関数がここで研究されたものよりも短い波数に外挿されるとき、パラメータは「高周波」限界を説明します[11]。 300〜4000 cm -1 の広いスペクトル範囲 ε∞の決定における誤差を減らすために分析された およびn + のIR反射スペクトルのモデリングに関連するその他のパラメータ レイヤー。
結論
サファイア基板上に成長し、さまざまな濃度のSi不純物をドープしたGaN層からなる多層構造のIR反射スペクトルを測定し、詳細に分析しました。フォトエッチングされた断面のSEMによる調査された構造の分析は、GaN層の技術的パラメータとの良好な相関を示した。 SIMS分析では、ホモエピタキシャル再成長界面に関連する、SiおよびO不純物の含有量が高いGaNバッファー/ GaN-テンプレート界面の近くに薄いデルタ層が存在することも明らかになりました。分析に追加の層を含めることによる研究された多層構造のIR反射スペクトルのモデリングは、実験スペクトルの最良の適合を得ることを可能にした。得られたGaN層の厚さは、SEMおよびSIMSデータとよく一致しています。各GaN層の誘電率LOPCモードのスペクトル依存性から計算すると、LPP + の高周波シフトと広がりが示されました。 キャリア濃度の増加に伴って分岐します。各GaN層の電荷キャリアの濃度と移動度は、プラズモン周波数と減衰パラメータから計算されました。得られたキャリア濃度プロファイルはSIMSで得られたものと似ていますが、キャリア濃度の値がSiドーピング不純物の濃度よりも1桁小さく、欠陥アクセプター状態による補償効果に起因する可能性があります。したがって、IR反射分光法と2×2転送マトリックス法は、不均一なドーピングプロファイルを持つエピタキシャル多層GaN構造の分析にうまく使用でき、各GaN層の基本的な電子とフォノンのパラメータの決定を可能にすることが実証されています。 。
変更履歴
略語
- IR:
-
赤外線
- FTIR:
-
フーリエ変換赤外分光法
- SEM:
-
走査型電子顕微鏡
- SIMS:
-
二次イオン質量分析
- LOPC:
-
縦光フォノン – プラズモン結合
ナノマテリアル
- 遷移金属をドープしたカオリナイトナノクレイの構造と電子特性
- 角度分解X線光電子分光法によるAl2O3キャップGaN / AlGaN / GaNヘテロ構造の表面分極に関する調査
- ラウリル硫酸をドープしたポリアニリンとポリスチレンの新しいナノコンポジット
- 分子線エピタキシーによって成長したMoSe2のバンドギャップの温度依存性
- アニーリングによって酸化ケイ素膜上に成長したアモルファスシリコンナノワイヤ
- 多機能GaN / Feナノ粒子による内皮細胞の標的化
- グラフェン集積シリコンマイクロリング共振器のラマンマッピング分析
- 青色LEDの8周期In0.2Ga0.8N / GaN量子井戸のソフト閉じ込めポテンシャルを形成する成長シーケンスにおける量子障壁の最適なシリコンドーピング層
- MBEによりSi(111)上に成長させたナノウォールネットワーク、ナノカラム、コンパクト膜間のGaNの構造シフト
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解
- 収差補正HAADF-STEMによるエピタキシャルGaAsBi中のBi分布の分析



