原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
要約
HfO 2 / TiO 2 / HfO 2 三層構造の抵抗変化型メモリ(RRAM)デバイスは、原子層堆積(ALD)によって、PtおよびTiNでコーティングされたSi基板上にPt上部電極で製造されています。三層構造ユニットの抵抗スイッチング特性に及ぼすPtとTiNの下部電極の影響を調査した。 Pt / HfO 2 の両方 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 / TiNは、典型的なバイポーラ抵抗スイッチング動作を示します。両方のメモリーセルの低抵抗状態と高抵抗状態(LRSとHRS)での主な伝導メカニズムは、それぞれオーム挙動と空間電荷制限電流です。 PtおよびTiNの下部電極は、電鋳極性の優先度、高抵抗と低抵抗の比、および三層構造メモリーセルの動作電圧の分散に大きな影響を与えることが見出されている。対称Pt上部/下部電極を使用する場合と比較して、非対称Pt上部/ TiN下部電極を使用するRRAMセルは、-3.7 Vの小さい負の形成電圧、セット/リセット電圧の比較的狭い分布、および10の高抵抗と低抵抗の低い比率を示します。 2 。電極に依存する電鋳極性は、酸素との電極の化学的活性、アノードでの関連する反応、およびHfO 2 の三層構造における酸素空孔濃度の不均一な分布を考慮することによって解釈できます。 / TiO 2 / HfO 2 PtおよびTiNでコーティングされたSi。さらに、Pt / HfO 2 の場合 / TiO 2 / HfO 2 / TiNデバイス、酸素リザーバーとしてのTiN電極は、形成電圧を低減し、抵抗スイッチングパラメータの均一性を向上させる上で重要な役割を果たします。
背景
抵抗変化型メモリ(RRAM)は、次世代の不揮発性メモリのフラッシュメモリに取って代わる可能性があるため、大きな注目を集めています[1,2,3]。抵抗スイッチング(RS)現象は、遷移金属酸化物、固体電解質、および有機ポリマーで広く発見されています[4、5、6、7]。遷移金属酸化物に基づくRRAMデバイスは、その単純な構成と従来の相補型金属酸化物半導体(CMOS)製造との互換性のある処理のために広く研究されてきました[8、9、10]。酸素空孔移動のフィラメントモデルは、スイッチング挙動を解明するために使用されます[1,11]。遷移金属酸化物ベースのRRAMの単極および双極スイッチング特性の両方を定量化するために、統一された微視的原理が提案されています。これは、酸化物スイッチング層の局所的な酸素空孔の分布と相関しています[12、13]。
しかし、遷移金属酸化物を使用するメモリーセルは、低抵抗状態と高抵抗状態(LRSおよびHRS)の不安定な抵抗値、分散したセット電圧とリセット電圧などの抵抗スイッチングパラメータの不均一性に悩まされ、商用アプリケーションを妨げます。最近、3層構造の酸化物ベースのRRAMデバイスが、抵抗スイッチングパラメータの分散を改善することが実証されました。 Al 2 の構造を持つセル O 3 / HfO 2 / Al 2 O 3 セット電圧とリセット電圧の素晴らしい均一性、およびLRSとHRS間のスイッチングの優れた耐久性を示しました[14]。導電性フィラメントの結合または破壊は、Al 2 間の2つの界面層でより簡単に発生しました。 O 3 / IL / HfO 2 / IL / Al 2 O 3 。一方、TaO x の三層構造の単位 / TiO 2 / TaO x 1つのセレクターで良好なパフォーマンスを示しました-1つの抵抗アレイ。これは、TiO 2 のエネルギーバンドが原因でした。 フィルムは上下で対称的に曲がっていましたTaO x / TiO 2 いくつかのTa原子がTiO 2 に拡散するため、界面になり、クレステッド酸化物バリアとして修飾されます。 映画[15]。
さらに、特定の酸化物記憶媒体のRS動作は、電極材料によって大きく影響を受ける可能性があります[1、16、17]。しかし、界面酸化物形成の自由エネルギーと金属仕事関数に基づく既存のモデルは、結果を完全に説明するには不十分です。一方、三層構造のRRAMの電極依存RS現象に関する研究も現在かなり不足しています。
原子層堆積(ALD)は、前駆体蒸気を使用した連続的な自己制限および補完的な表面化学吸着反応に基づく新しいタイプの薄膜堆積技術であり、単純で正確な厚さ制御、大面積の均一性、および特に堆積のための優れた3次元適合性を備えていますナノ積層構造の[18、19]。
この作品では、HfO 2 / TiO 2 / HfO 2 三層構造のRRAMデバイスはSi / SiO 2 上に準備されています / Ti / PtおよびAlDによるPt上部電極を備えたSi / TiN基板。 HfO 2 のRS挙動に対するPtおよびTiNの下部電極の影響 / TiO 2 / HfO 2 デバイスは慎重に調査されています。関連する説明が提案されています。
メソッド
この実験では、市販のSi / SiO 2 を含む2つの異なる下部電極を使用しました。 / Ti / Ptおよび自家製Si / SiO 2 /錫。導電性TiNは、私たちの研究室でプラズマ強化原子層堆積(PEALD)によって堆積されました。
ALDは、商用のPicosun SUNALE TM で実行されました。 R-200アドバンストリアクター(フィンランド、ピコサン)。 P 抵抗率が1〜10ΩcmのタイプSi(100)ウェーハを出発基板として使用しました。天然酸化物を除去せずにSiウェーハを従来のRCA洗浄した後、室温のTiCl 4 を使用して、PEALDにより400°Cで下部電極として厚さ30nmのTiNをSi上に堆積させました。 およびNH 3 それぞれTiおよびN前駆体としてのプラズマガス。液体NH 3 NH 3 として選ばれました 室温でのプラズマ源。プラズマパワーとNH 3 ガス流量はそれぞれ2500Wと150sccmでした。
続いて、5 nm HfO 2 / 10 nm TiO 2 / 5 nm HfO 2 スタッキング構造は、Hf [N(C 2 H 5 )CH 3 ] 4 (TEMAH)、TiCl 4 、およびH 2 それぞれHf、Ti、およびO前駆体としてのO。1つの酸化物サイクルは0.1 s 金属源注入、4 s N 2 パージ、0.1 s H 2 O注入、および4 s N 2 パージ。 TEMAHは150°Cで蒸発させました。純粋なN 2 (99.999%)は、キャリアガスおよびパージガスとして使用されました。次に、Q150Tシステムを使用して、厚さ100nmのPt上部電極を直径150μmのシャドウマスクにDCスパッタリングしました。
純粋なHfO 2 のサイクルあたりの成長(GPC) またはTiO 2 Siについては、分光エリプソメーター(GES-5、Sopra)によって決定されました。フィルムと下部電極のトポグラフィーと表面粗さは、原子間力顕微鏡(AFM、Cypher、Asylum Research)によって分析されました。二乗平均平方根(RMS)の粗さの値は、1μm×1μmの領域から記録されました。スタック構造の組成と化学的状態は、単色Al K αを使用したX線光電子分光法(XPS、Thermo Fisher K-Alpha)によって調べられました。 光電子の励起のためのソース(hν=1486.6eV)。電荷効果は、C 1 s を設定することによって較正されました。 284.6eVでの光電子放出。 HfO 2 のXPS深度プロファイル / TiO 2 / HfO 2 PtおよびTiNでコーティングされたSiは、Arイオンエッチングによって得られた。 HfO 2 の電気的特性 / TiO 2 / HfO 2 三層構造のRRAMデバイスは、プローブステーション(CasCade Summit 12000 B-M)のKeithly4200半導体特性評価システムによって測定されました。製造されたデバイスユニットを設定プロセス中の大電流による損傷から保護するために、10mAの電流コンプライアンスが課されました。バイアス電圧は、PtまたはTiNの接地された下部電極を使用してPt上部電極に印加されました。
結果と考察
HfO 2 のRRAMデバイスの概略図 / TiO 2 / HfO 2 ALDによる三層構造を図1に示します。下部電極の表面形態と粗さ、およびHfO 2 の三層構造 / TiO 2 / HfO 2 PtおよびTiNでコーティングされたSiについて調べました。 Pt下部電極のRMS値は、PEALDから派生した0.87nmのTiNよりも0.39nm小さくなっています。したがって、HfO 2 のサンプル / TiO 2 / HfO 2 また、PtコーティングされたSiの表面は、1.3nmのTiNコーティングされたSiの表面よりも0.68nmのRMSで比較的滑らかな表面を示します。
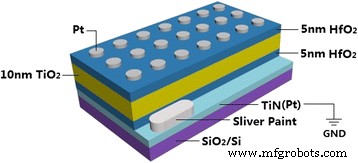
HfO 2 のRRAMデバイスの概略図 / TiO 2 / HfO 2 ALDによる三層構造
Pt / HfO 2 のDCI-V曲線 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 初期電鋳プロセスを含む/ TiNデバイスは、それぞれ図2a、bにプロットされており、典型的なバイポーラ抵抗スイッチング特性を示しています。ほとんどすべてのサンプルで、スイッチングテストの前に導電性フィラメントを形成するために、より大きな形成電圧が必要です。 Pt上部電極に正のバイアス電圧を印加すると、Pt / HfO 2 / TiO 2 / HfO 2 / Ptデバイスユニットは、図2aで+ 7Vの形成電圧を示しています。電圧掃引を継続すると、LRSからHRSへのユニットセルのリセット電圧-0.8 Vと、HRSからLRSへの設定電圧2.0Vが測定されます。高抵抗と低抵抗の対応する比率は約10 5 。電鋳と休止のプロセスは、それぞれ-11Vの負の電圧と+ 4Vの正の電圧を印加することによって完了することもできます。これは、正の成形電圧と負のリセット電圧よりもはるかに大きいものです。さらに、デバイスセルは、ネガティブフォーミングプロセス後の数サイクルだけLRSからHRSに切り替わり、その後、不可逆的な故障のためにHRSにリセットできません(ここには示されていません)。図2bでは、対称Pt上部電極と下部電極を使用した場合と比較して、非対称TiN下部電極とPt上部電極を備えた3層構造のRRAMデバイスは、約-3.7 Vの反対の低い形成電圧、-1.5Vの設定電圧を示しています。 、リセット電圧+1.5 V、高抵抗と低抵抗の比率が比較的小さい10 2 。正の電鋳電圧を印加した場合、Pt / HfO 2 ではRS現象は観測できません。 / TiO 2 / HfO 2 / TiNセルとデバイスは、+ 14 Vで恒久的に故障しますが、負の電圧でLRSからHRSに次のように効率的にリセットされることはありません(ここには示されていません)。
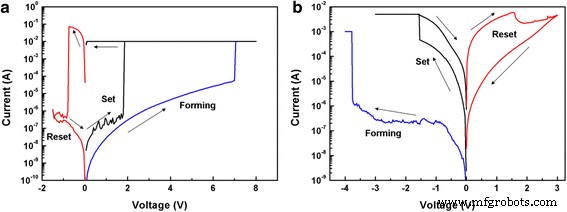
RRAMデバイスの典型的なバイポーラ抵抗スイッチング特性。 a Pt / HfO 2 / TiO 2 / HfO 2 / Pt。 b Pt / HfO 2 / TiO 2 / HfO 2 / TiN
対称Pt上部/下部電極と非対称TiN下部電極/ Pt上部電極を備えた3層構造のRRAMデバイスは、このような異なる電鋳極性の優先度を示します。化学的に不活性なPtまたは比較的活性なTiNの下部電極が重要な役割を果たしているようです。電極に依存する電鋳極性に関連する理由については、HfO 2 の3層構造のXPS深さプロファイルを検討した後で説明します。 / TiO 2 / HfO 2 PtおよびTiNでコーティングされたSi上。
高密度メモリアプリケーションでは、RSパラメータの均一性が非常に重要です。図3a、bは、Pt / HfO 2 の単一のデバイスユニットから測定されたセット電圧とリセット電圧の分布の統計結果をプロットしたものです。 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 それぞれ200回のテストの/ TiN。図3c、dは、Pt / HfO 2 のランダムに選択された10個のデバイスユニットのI–V曲線を記録しています。 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 それぞれ/ TiN。対称のPt上部電極と下部電極を備えた3層構造のRRAMデバイスユニットは、1.2〜2.8 Vの設定電圧と-0.5〜-1 Vのリセット電圧(図3a)および分散I-V曲線(図3a)に対して幅広い分布を示します。 3c)。一方、非対称のTiN下部電極とPt上部電極を備えたデバイスユニットは、-0.8〜-1.8 Vの設定電圧と1.3〜1.8 Vのリセット電圧の比較的集中した分布、I–V曲線での安定した再現性など、より優れたRS動作を示します。 (図3b、d)。同時に、PtコーティングされたSi上のものと比較して、TiNコーティングされたSi上の異なるデバイスユニットもRSパラメータの単分散を改善し、RRAMの実際のアプリケーションに有益です。

200回のテストで単一のデバイスユニットから測定されたセット電圧とリセット電圧の分布の統計結果。 a Pt / HfO 2 / TiO 2 / HfO 2 / Pt。 b Pt / HfO 2 / TiO 2 / HfO 2 /錫。ランダムに選択された10台のデバイスユニットのI–V曲線。 c Pt / HfO 2 / TiO 2 / HfO 2 / Pt。 d Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Pt / HfO 2 のデバイスユニットの耐久性と保持特性 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 / TiNは、それぞれ図4a〜dに示すように調べられています。 Pt / HfO 2 で / TiO 2 / HfO 2 / Pt、掃引電圧は、セットの場合は0〜3 V、リセットの場合は0〜-1.5Vで印加されました。 Pt / HfO 2 で / TiO 2 / HfO 2 / TiNの場合、掃引電圧は、セットの場合は0〜-2 V、リセットの場合は0〜2Vで印加されました。オンとオフの抵抗値は、室温で0.2Vを使用して読み取られました。保持テストは、0.2 Vの読み取り電圧で室温で測定されました。200回のプログラム/消去サイクルの後、Pt / HfO 2 / TiO 2 / HfO 2 / Ptデバイスユニットは、10 5 を超えるOFF / ON状態の比較的安定した抵抗比を示します。 (図4a);ただし、Pt / HfO 2 の耐久特性 / TiO 2 / HfO 2 / TiNメモリセルはPt / HfO 2 ほど良くないようです / TiO 2 / HfO 2 / Pt(図4b)。 Pt-TiN電極を備えたデバイスのオンおよびオフ状態はあまり安定しておらず、オフ/オン状態の抵抗比は約10 2 と小さくなっています。 スイッチングサイクルテスト中、特にLRSよりも大幅なHRS変動。参考文献の物理モデルに基づいています。 [12]、酸素空孔と界面O 2- の形成エネルギーを増加させることにより、耐久性が向上します。 額。もっともらしい説明を1つ推測します。以前の研究[14]では、ALD由来のAl 2 の優れたバイポーラ抵抗スイッチング特性 O 3 / HfO 2 / Al 2 O 3 非対称のTiN下部電極とPt上部電極を備えた三層構造が実証されており、最大10 3 のスイッチング耐久性が向上しています。 安定したON / OFF抵抗比でサイクルします。ここでは、HfO 2 を採用しました / TiO 2 / HfO 2 Al 2 の代わりに構成する O 3 / HfO 2 / Al 2 O 3 。 HfO 2 の金属イオン およびTiO 2 +4の同じ同一の化学原子価を持ち、3層HfO 2 の2つの界面層(IL)間の酸素空孔などの界面帯電欠陥が少なくなります。 / TiO 2 / HfO 2 。一方、Al 2 の金属イオン O 3 およびHfO 2 Al 3+ の化学的原子価が異なる およびHf 4+ 、Al 2 の2つのIL間の酸素空孔のより多くの界面帯電欠陥を生成します O 3 / HfO 2 / Al 2 O 3 。インターフェースO 2- Al 2 の間に2つのILを追加することによる量 O 3 / HfO 2 / Al 2 O 3 HfO 2 の間よりも高くする必要があります / TiO 2 / HfO 2 。また、Al 2 の貯蔵層における酸素空孔の形成エネルギー O 3 / HfO 2 / Al 2 O 3 また、HfO 2 よりも高い / TiO 2 / HfO 2 (酸素空孔の形成エネルギー7.08 eV(Al 2 O 3 )、6.53 eV(HfO 2 )、および4.35 eV(TiO 2 )[20、21])。これらの要因を考慮した後、Pt / HfO 2 のメモリセル / TiO 2 / HfO 2 / TiNは、Pt / Al 2 と比較して、耐久性の低下を示します O 3 / HfO 2 / Al 2 O 3 / TiN。

デバイスユニットの耐久性と保持特性。 a 、 c Pt / HfO 2 / TiO 2 / HfO 2 / Pt。 b 、 d Pt / HfO 2 / TiO 2 / HfO 2 / TiN。
Pt / HfO 2 の場合 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 / TiN、ON状態とOFF状態の抵抗レベルは、累積待機時間が10 4 になっても、明らかな変化はありません。 s図4c–dの室温で、外挿法に基づいて10年間にわたって両方のメモリセルの保持特性が優れていることを示しています。
Pt / HfO 2 / TiO 2 / HfO 2 / TiNデバイスは、Pt / HfO 2 よりもOFF / ON状態の抵抗比がはるかに低くなっています。 / TiO 2 / HfO 2 / Pt、これは仕事関数と導電率の下部電極の違いに起因する可能性があります。 PtおよびTiN下部電極の仕事関数は、それぞれ5.65および4.5eVです。したがって、TiNと基礎となるHfO 2 の間のインターフェースバリア Pt / HfO 2 では比較的低い / TiO 2 / HfO 2 / TiNデバイス。リセットプロセス中、電子がバリアを通過するために必要なエネルギーも小さくなります。したがって、Pt / HfO 2 / TiO 2 / HfO 2 / TiNは、OFF状態でPt / HfO 2 よりも低い抵抗値を示します。 / TiO 2 / HfO 2 それに応じて/ Pt。設定されたプロセス中に、導電チャネルの形成により、RRAMデバイスがHRSからLRSに変わります。 Pt下部電極はTiN下部電極よりも高い導電率を持っています。したがって、Pt / HfO 2 のON状態での抵抗値 / TiO 2 / HfO 2 / TiNはPt / HfO 2 よりも高い / TiO 2 / HfO 2 / Pt。その結果、Pt / HfO 2 / TiO 2 / HfO 2 / TiNデバイスは、オフ/オン状態の抵抗比が10 2 と小さくなっています。 。ただし、抵抗比は10 2 すでにRRAMアプリケーションの要件を満たしています。
抵抗スイッチング中の導電メカニズムを明確にするために、典型的なI–V曲線を二重対数スケールで再プロットします。図5a、bは、Pt / HfO 2 の電圧掃引領域のI–V曲線の線形フィッティングを示しています。 / TiO 2 / HfO 2 / PtおよびPt / HfO 2 / TiO 2 / HfO 2 / TiNデバイス。両方のメモリセルは、同様の導電メカニズムで動作します。デバイスをLRSに切り替えると、log(I)-log(V)の曲線は直線になり、傾きは1に近くなります(図5aでは0.94、図5bでは0.98)。これは、 LRSはオームの法則によって支配されています。酸素空孔移動のフィラメントモデルを使用して、スイッチング動作を説明できます。 HRSの場合、低電圧領域(絶対値<0.11 V)では、I–Vは、電流と電圧の線形関係を持つオームの法則によって支配されます(図5aの勾配1.05、図5bの勾配1.09)。高電圧領域(図5aでは6.8V>絶対値> 0.11 V、図5bでは1.85V>絶対値> 0.11 V)では、log(I)-log(V)線の傾きは約2であり、電流は、印加電圧のおよそ2乗に依存します(I / V 2 )。臨界電圧(図5aの絶対値6.8 V、図5bの1.85 V)では、急な電流上昇が突然現れ、非常に大きな傾きを示します。この結果は、HRSの3つの領域で構成され、基本的に、典型的なトラップ制御の空間電荷制限伝導(SCLC)注入[11]に従います。
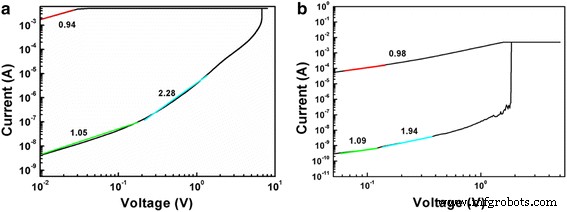
a の二重対数スケールでプロットされた典型的なI–V曲線 Pt / HfO 2 / TiO 2 / HfO 2 / Ptおよび b Pt / HfO 2 / TiO 2 / HfO 2 / TiN
HfO 2 の基礎となる抵抗スイッチングメカニズムをさらに理解するために / TiO 2 / HfO 2 PtコーティングおよびTiNコーティングされたSiで、対称および非対称の下部/上部電極を備えた3層構造でXPSナロースキャンと深度分析を実行しました。 XPSスペクトルは、スマートタイプのバックグラウンド減算後にガウス-ローレンツ(G-L)関数でフィッティングされました。
図6a〜dは、Hf 4 f のナロースキャンXPSスペクトルを示しています。 、Ti 2 p 、およびO 1 s HfO 2 のピーク およびTiO 2 TiNコーティングされたSi上の層。 Hf 4 f およびHfO 2 からのTi2pスペクトル およびTiO 2 レイヤーは、2つのグループピークにデコンボリューションできます。より強いHf4 f 5/2 およびHf4 f 7/2 1.7eVのスピン軌道相互作用を伴う18.4および16.7eVのピークは、Hf–O結合(Hf 4+ )に割り当てられます。 )HfO 2 から (図6a)。 17.6および14.8eVの低い結合エネルギーでのより弱いスピン軌道相互作用のピークは、Hf n の低化学原子価状態に起因する可能性があります。 + –o( n <4)、HfO 2 に酸素空孔が存在することを示します 層。 Hf n の計算されたパーセント濃度 + ( n <4)はHfイオンで約3.7%です。図6bでは、より強いダブレットはTi 2 p に対応します。 3/2および2 p Ti–Oボンディング(Ti 4+ )に属する458.8および464.5eVの1/2機能 )TiO 2 から 。弱いダブレットは456.1および462.0eVに位置し、Ti 3+ に割り当てられます。 –Oボンディング。 Ti 3+ の計算されたパーセンテージ濃度 Tiイオンで約21%です。これは、TiO 2 に酸素空孔が存在することを意味します。 レイヤー。
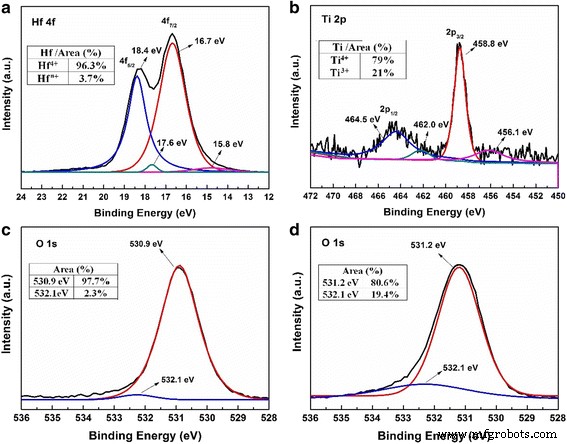
HfO 2 の三層構造からのナロースキャンXPSスペクトル / TiO 2 / HfO 2 TiNコーティングされたSi上。 a Hf 4f、 b Ti 2 p HfO 2 のピーク / TiO 2 / HfO 2。 O 1 s c のピーク HfO 2 および d TiO 2 レイヤー
O 1 s HfO 2 からのスペクトル およびTiO 2 図6c、dに示すように、レイヤーは2つのピークにデコンボリューションすることもできます。 O 1 s の比較的低い結合エネルギー 〜530.9および531.2 eVのピークは、TiO 2 のTi-OおよびHf-O結合に割り当てられます。 およびHfO 2 それぞれ、酸素空孔のない格子酸素に属する層。一方、O 1 s では532.1eVのわずかに高いエネルギー 図6c、dのスペクトルは、HfO 2 の酸素空孔付近の酸素原子によるものです。 およびTiO 2 文献レポートに基づくレイヤー[22、23、24、25]。酸化物層の相対的な酸素空孔濃度は、各ピークの面積比率を計算することで大まかに評価できます[22、23]。 HfO 2 の酸素空孔の計算されたパーセンテージ濃度 およびTiO 2 Hf n の結果と一致して、層はそれぞれ約2.3%と19.4%です。 + およびTi 3+ 。
図7a、bは、HfO 2 のXPS深度プロファイルを示しています。 / TiO 2 / HfO 2 それぞれArイオンエッチングによるPtおよびTiNコーティングSiのサンプル。 HfO 2 の三層構造 / TiO 2 / HfO 2 HfO 2 間の有意な界面拡散にもかかわらず、PtおよびTiNでコーティングされたSiの表面は容易に認識できます。 / TiO 2 およびHfO 2 / TiNが観測されました。通常、酸素空孔移動のフィラメントモデルは、遷移金属酸化物に基づくRRAMデバイスのRS動作を支配します[11]。ただし、単に酸素空孔含有量を増やすだけでは完全に効果的ではありません。酸素空孔フィラメントの分布を効果的に制御する方法は、RSの均一性を最終的に改善するための重要な問題です[20]。多くの研究により、通常、酸素空孔の不均一な分布がRSの動作に有益であることが示されています。これには、形成電圧の低下、スイッチングの安定性と耐久性の向上が含まれます[1、14、20、26、27、28、29]。貯蔵酸化物層における酸素空孔の初期の不均一な分布は、比較的高い酸素親和性(例えば、Ta、Ti、Al、またはTiN)を有する化学的に活性な電極の使用によって、または意図的に酸素空孔に富むものを導入することによってしばしば得られる。界面工学による界面層[1、17、30]。
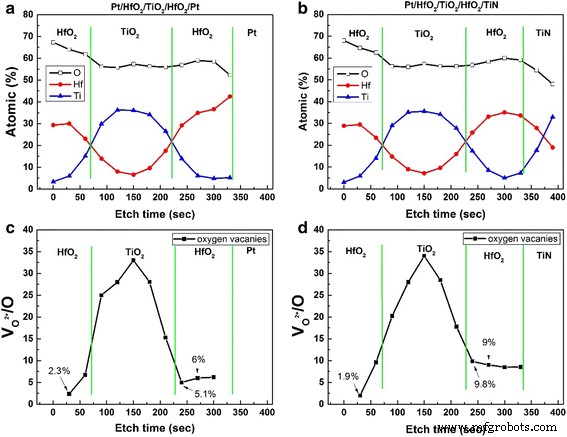
HfO 2 のXPS深度プロファイル / TiO 2 / HfO 2 ArイオンエッチングによるPtおよびTiNコーティングされたSiの場合。 a HfO 2 / TiO 2 / HfO 2 PtコーティングされたSi上。 b HfO 2 / TiO 2 / HfO 2 TiNコーティングされたSi上。酸素空孔濃度の深さ分布( V O 2+ / O)HfO 2 のXPSスペクトルから決定 / TiO 2 / HfO 2 PtおよびTiNでコーティングされたSi。 c HfO 2 / TiO 2 / HfO 2 PtコーティングされたSi上。 d HfO 2 / TiO 2 / HfO 2 TiNコーティングされたSi上
図7c、dは、HfO 2 の酸素空孔濃度の分布曲線を示しています。 / TiO 2 / HfO 2 上記の深さのXPSプロファイルに基づいて、PtおよびTiNでコーティングされたSiにそれぞれ基づいています。酸素空孔濃度は、上記の方法を使用して評価された。最高の酸素空孔濃度(〜34%)がTiO 2 に現れることがわかります。 中間層。もう1つの注目すべき機能は、基盤となるHfO 2 PtまたはTiN下部電極の近くの層は、上部HfO 2 よりも高い酸素空孔濃度を持っています レイヤー(〜2%)。さらに、基礎となるHfO 2 の酸素空孔濃度(〜9%) TiNコーティングされたSiの層は、PtコーティングされたSiの層よりも明らかに高い(〜6%)。
図8に、Pt / HfO 2 の電鋳とリセットの概略図を示します。 / TiO 2 / HfO 2 正および負のバイアス電圧での/ Pt。化学的に不活性なPt上部および下部電極の場合、バイアス極性に依存する電鋳現象はO 2 に関連しています。 電気還元の生成物としてアノードの酸化物層から放出されるガス。知られているように、電鋳プロセス中に、酸素空孔は高電界によって生成され、カソードに移動して、酸化物層に局所的な導電性フィラメント、すなわち、 O を形成します。 O → V O 2+ + O 2- 、 V O 2+ + 2 e − → V O [12](図8b、e)。同時に、O 2- イオンはアノードに向かってドリフトし、電荷を放出してO 2 を進化させます ガス、つまり O 2- →1/2 O 2 + 2 e − (図8b、e)。これにより、セルが物理的に変形したり、亀裂や穴が形成されたりする可能性があります[31]。 Pt上部電極に正の形成電圧を印加する場合、O 2 を仮定します。 上部HfO 2 の上に放出されたガス フィルムは、上部電極の端またはPt上部電極の小さなナノポアを通って簡単に逃げます(図8b)。これにより、弱い物理的変形が発生します。一方、基礎となるHfO 2 の比較的高い酸素空孔濃度を考慮すると (〜6%)上部HfO 2 よりも近くのPt下部電極 層(〜2.3%)(図7c)では、導電性フィラメントが容易に形成され、+ 7 Vのより小さな正の形成電圧につながります。-0.8Vの逆電圧では、逆反応によりフィラメントが破裂し、デバイスは簡単にHRS状態に戻すことができます(図8d)。

HfO 2 の電鋳と三層構造のリセットの概略図 / TiO 2 / HfO 2 対称的なPt上部および下部電極を備えています。 a – d 正の電圧で電鋳し、負の電圧でリセットします。 e – g 負の電圧で電鋳し、正の電圧でリセット
逆に、上部電極に負の形成電圧があると、下にあるHfO 2 の下に酸素ガスが形成されます。 層とPtの上に下部電極(図8e)。 O 2 解放がより困難になり、導電性フィラメントの形成が妨げられます。さらに、上部HfO 2 の酸素空孔濃度のため レイヤー(〜2.3%)は、基になるHfO 2 のレイヤーよりも低くなっています (〜6%)(図7c)、フィラメントを形成するには、-11Vのより高い負の形成電圧が必要です。より多くのO 2 基礎となるHfO 2 の下で特定の圧力まで蓄積します , it possibly erupts from the mechanically weakest part of the thin films, leading to the hole in oxide films or separation between oxide films and the bottom electrode induced by bubble cracking. Although the device can be reset to HRS at applied +4 V bias (Fig. 8g), the memory cell is degraded after several switching cycles. In our samples, a part of top electrode was blown off after the forming process. Similar electroforming polarity preference scenario has also been observed in Pt/TiO2−x /Pt bipolar RRAM cells with various physical deformation evidences of the junctions [31, 32].
Pt/HfO2 /TiO2 /HfO2 /TiN devices exhibit quite different electroforming polarity from Pt/HfO2 /TiO2 /HfO2 /Pt. The LRS caused by electroforming can be observed at both negative and positive bias voltage; however, the effective reset from LRS to HRS can be achieved only at positive bias voltage in Pt/HfO2 /TiO2 /HfO2 /TiN device. Similar electroforming preference with asymmetric Pt and TiN electrodes has been observed in some literatures with various storage oxide layers such as HfO2 [33, 34], TiO2 [35], ZrO x /HfO y bilayer [22], and Al2 O 3 /HfO2 /Al2 O 3 trilayer [14]. However, the related explanations are divergent or lacking.
After considering the TiN electrode’s chemical activity with oxygen [1, 30, 36] and the nondistribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 based on the XPS depth profiles (Fig. 7), a possible mechanism on electroforming polarity preference of Pt/HfO2 /TiO2 /HfO2 /TiN cells is proposed. Figure 9 shows the schematic diagrams of electroforming and reset of Pt/HfO2 /TiO2 /HfO2 /TiN at negative and positive bias voltages. The TiN bottom electrode plays a key role in the electroforming polarity. Kwak et al. reported that the relatively active TiN electrode would easily absorb oxygen ions from oxide films to form TiO x N1−x (TiON) interfacial layer [36]. The severe oxygen diffusion of underlying HfO2 layer into TiN bottom electrode has been confirmed in our sample by the XPS depth profile (Fig. 7b). For Pt/HfO2 /TiO2 /HfO2 /TiN device, the TiN electrode with high oxygen affinity [34, 36] produces a lot of oxygen vacancies in the underlying HfO2 layer near the TiN bottom electrode. The oxygen vacancies concentration of ~9% of underlying HfO2 layer is much higher than that of ~6% in the Pt/HfO2 /TiO2 /HfO2 /Pt device.
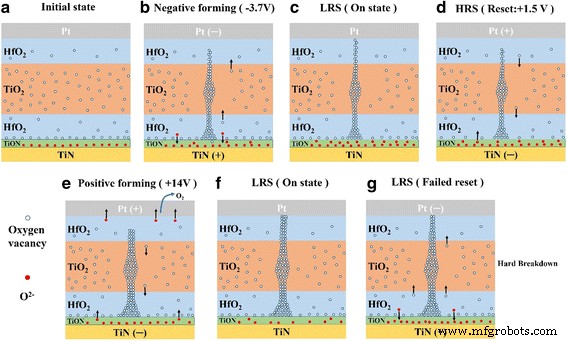
Schematic diagrams of electroforming and reset of trilayer-structure of HfO2 /TiO2 /HfO2 with asymmetric Pt top electrode and TiN bottom electrode. a – d Electroforming at negative voltage and reset at positive voltage. e –g Electroforming at positive voltage and reset at negative voltage
For chemically inert Pt top electrode and relatively active TiN bottom electrode, when applying negative forming voltage, O 2− ions drift towards the TiN anode and are absorbed to form TiO x N1−x layer (Fig. 9b), i.e., TiN + x O 2− →TiO x N 1−x + x 2e , avoiding the O2 release and possible damage to cells. The TiN electrode might act as a reservoir for oxygen ions drifting under an applied voltage [1, 36]. Simultaneously, due to the higher oxygen vacancy in the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%) than the upper HfO2 layer (~1.9%), the migration of the rich oxygen vacancies from the underlying HfO2 layer through TiO2 layer towards the the upper HfO2 layer, directly producing conductive oxygen vacancy filaments with a smaller forming voltage of −3.7 V (Fig. 9b). When performing reverse reset process at +1.5 V, the bottom electrode of TiN layer acting as oxygen reservoir supplies oxygen ions to react with oxygen vacancy, i.e., O 2− + V O 2+ →O O (lattice oxygen), which is beneficial to the reset operation from LRS to HRS with rupture of conductive filament (Fig. 9d). Above all, the oxygen reservoir effect of TiN bottom electrode contributes the forming voltage reduction as well as better set/reset voltage variation [1, 29, 36].
On the other hand, when imposing the positive forming voltage on top electrode Pt, the oxygen vacancies migrate from the upper HfO2 into the underlying HfO2 on TiN, accumulate in its vicinity, and develop into filaments. Owing to the lower oxygen concentration in the upper HfO2 (~1.9%) than the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%), this leads to further increase of the oxygen vacancy concentration in underlying HfO2 and intermediate TiO2 層。 In the same time, due to slight oxygen existence in PEALD-derived TiN films (about 10%), some oxygen ions in TiN drift into underlying HfO2 layer to form insulate lattice oxygen with nearby oxygen vacancy, preventing from the growth of conductive filaments (Fig. 9e). Finally, when the bias voltage attains +14 V, the coarsening conductive filaments in oxides is formed. However, when a negative voltage is applied on the device, the conductive filament in trilayer structure is too large to be ruptured (Fig. 9g). Therefore, the device cannot switch to HRS by applying a negative voltage, indicating that an irreversible hard breakdown occurs in Pt/HfO2 /TiO2 /HfO2 /TiN device.
Finally, on account of the fact that the inserted TiO2 layer stores more oxygen vacancies than HfO2 layer, the distribution of oxygen vacancies in trilayer structure is not uniform, especially in the two interfacial layers between HfO2 /IL/TiO2 /IL/HfO2 , which might affect the growth position, direction, and overlapping of conductive filaments. The linkage or rupture of the conductive filaments corresponds to the set process from HRS to LRS or the reset process from LRS to HRS, respectively, which more easily happens in two interfacial layers. Further, the shape and position of the conductive filaments in HfO2 and TiO2 layers change less in the set and reset processes.
結論
In summary, RRAM devices based on trilayer-structure of Pt/HfO2 /TiO2 /HfO2 /Pt and Pt/HfO2 /TiO2 /HfO2 /TiN have been prepared by ALD. Both memory cells show typical bipolar resistive switching characteristics, and Ohmic and SCLC dominant conduction mechanisms in LRS and HRS, respectively. It is found that the bottom electrodes of Pt and TiN have great influence on the electroforming polarity preference, the ratio of high and low resistances and dispersion of the operating voltage of trilayer-structure memory cells. Compared to with symmetric Pt top/bottom electrodes, the RRAM cells with asymmetric Pt top/TiN bottom electrodes show smaller negative forming voltage of −3.7 V, relatively narrow distribution of the set/reset operation voltages and lower ratio of high and low resistances of 10 2 。 The electrode-dependent electroforming polarity can be explained by considering electrodes’ chemical activity with oxygen, the related reactions at anode, and the nonuniform distribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 on Pt- and TiN-coated Si. Furthermore, the TiN electrode as oxygen reservoir plays an important role in forming voltage reduction and better dispersion of RS parameters for Pt/HfO2 /TiO2 /HfO2 /TiN devices. Considering the modulation effect of electrode and trilayer-structure on resistive switching performance, this work provides a new device design route for future RRAM applications.
ナノマテリアル
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 自己整流スイッチ特性を備えたTaO / HfOxおよびTaO / AlO xRRAMの保持モデル
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- 純粋なCMOSロジックプロセスによる自己抑制抵抗スイッチング負荷を備えたRRAM統合4TSRAM
- 色素増感太陽電池の光学的および電気的特性に及ぼすTiO2中の金ナノ粒子分布の影響
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- 抵抗変化型メモリのモデリングとシミュレーションに関する集合的研究
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性
- 二酸化炭素を使用したSiO2の低温プラズマ強化原子層堆積



