MoS2 / GaAsヘテロ接合における大きな横方向光起電力効果
要約
二硫化モリブデン(MoS 2 )ナノスケールの膜は、マグネトロンスパッタリング技術とMoS 2 を介してGaAs基板上に堆積されます。 / GaAsヘテロ接合が製造されます。製造されたMoS 2 の横方向光起電力効果(LPE) / GaAsヘテロ接合が調査されます。結果は、MoS 2 で大きなLPEが得られることを示しています。 / n -GaAsヘテロ接合。 LPEは、レーザー照明の位置に線形依存し、416.4 mV mm - というかなり高い感度を示します。 1 。この感度は、報告されている他のMoS 2 の値よりもはるかに大きくなっています。 ベースのデバイス。比較すると、MoS 2 のLPE / p -GaAsヘテロ接合ははるかに弱いです。 LPEのメカニズムは、MoS 2 のエネルギーバンドアラインメントを構築することによって明らかになります。 / GaAsヘテロ接合。優れたLPE特性により、MoS 2 高性能の位置敏感検出器のアプリケーションの候補として有望なGaAs半導体と組み合わせたフィルム。
背景
その優れた特性により、二硫化モリブデン(MoS 2 )は、次世代のマイクロエレクトロニクスデバイスやオプトエレクトロニクスデバイスを開発するための典型的な2次元材料の一種として研究されています[1,2,3,4,5]。グラフェンとは異なり、MoS 2 明らかなバンドギャップがあり、そのバンドギャップは層数の増加とともに減少します[6]。明らかなバンドギャップの存在により、MoS 2 の製造が可能になります。 オン/オフ比が10 8 を超えるトランジスタ 応答性の高い光検出器[7、8]。最近、MoS 2 GaAs、Si、GaNなどの他の半導体との組み合わせが大きな関心を集めています[9、10、11、12、13]。これらの設計されたヘテロ構造は、MoS 2 の実現可能な技術ルートを提供します。 実用的なオプトエレクトロニクスデバイスを開発するためのベースの材料。これらすべてのバルク半導体の中で、GaAsは〜1.42 eVの適切な直接バンドギャップと高い電子移動度(〜8000cm 2 )を持っています。 V -1 s -1 )。リンら。製造されたMoS 2 電力変換効率が9.03%を超える/ GaAs太陽電池[9]。さらに、Xu etal。 MoS 2 を報告しました 3.5×10 13 という非常に高い検出率を備えた/ GaAs自己駆動型光検出器 ジョーンズ[10]。以前のレポートでは、MoS 2 に関する研究 / GaAsヘテロ構造は、主に太陽電池と光検出器の分野での応用に焦点を合わせてきました。ただし、MoS 2 横方向光起電力効果(LPE)に基づく位置敏感検出器(PSD)としての/ GaAsはほとんど報告されていません。通常の縦方向の光起電力効果とは異なり、LPEは、界面の反転層での光子生成キャリアの横方向の拡散と再結合に起因します[14、15、16、17、18]。 LPE効果では、横方向の光起電力(LPV)を取得でき、デバイス表面のアクティブ領域上のレーザースポットの位置に比例して変化します。これらの特性により、LPEは高性能PSDの開発に非常に役立ち、ロボット工学、生物医学アプリケーション、プロセス制御、位置情報システムなどの分野で広く研究されてきました。
この作品では、MoS 2 n の表面にさまざまな厚さの薄膜が堆積します -/ p -マグネトロンスパッタリング技術によるGaAs基板。製造されたMoS 2 に大きなLPEが観察されます。 / n -GaAsヘテロ接合、感度は416.4 mV mm -1 に達しました 。我々の結果はさらに、LPEがGaAs基板のキャリアタイプとMoS 2 の厚さに明らかに依存していることを示しています。 映画。界面でのエネルギーバンドアライメントの構築を通じて、デバイス内のLPEへのメカニズムが提案されます。
メソッド
MoS 2 薄膜は、DCマグネトロンスパッタリング技術を使用して(100)配向のGaAs基板上に堆積されました。 MoS 2 粉末(純度、〜99%)を20.0MPaの圧力でディスクにコールドプレスしました。スパッタリング中のターゲットとして、製造されたままのディスク(Φ60.0mm×4.5mm)を使用した。 n- / p -GaAs基板をそれぞれ実験に使用しました。堆積の前に、基板はアルコール、アセトン、および脱イオン水によって順番に超音波洗浄されました。続いて、MoS 2 厚さの異なる薄膜( d MoS2 =〜10、30、50、90 nm)は、それぞれ400°Cの温度でGaAs基板上に成長しました。堆積中、使用圧力と出力はそれぞれ1.0Paと10.0Wに保たれました。参考までに、MoS 2 薄膜は、真性GaAs( i -GaAs)同じ条件下の基板。最後に、電極がMoS 2 に押し付けられたときに、直径0.5mmの約300μmのInパッド 映画。
MoS 2 フィルムは、励起波長488 nmのラマン分光法(HORIBA、HR800)を使用して特性評価されました。サンプルの表面を原子間力顕微鏡(AFM)でスキャンしました。 X線光電子分光法(XPS)は、単色AlKαX線源を備えたKratos AxisULTRA分光計によって実行されました。堆積速度は、断面走査型電子顕微鏡(SEM)からの厚さ(追加ファイル1:図S1)および堆積時間によって得られ、次いで、各膜厚は、堆積速度および各堆積時間によって決定された。透過スペクトルは島津UV-3150分光光度計で測定した。紫外光電子分光法(UPS)は、フィルター処理されていないHe-I(21.22 eV)ガス放電ランプを使用して実行されました。 LPVは、Keithley 2000電圧計と、波長650nmのレーザーを照明源とする3次元電気電動ステージを使用して測定しました。電流-電圧( I - V )曲線はKeithley 2400SourceMeterで測定されました。
結果と考察
図1は、MoS 2 のラマンスペクトルを示しています。 GaAs基板上のフィルム。 〜287.1cm -1 のGaAs基板のピークに加えて 、2つの特徴的なMoS 2 ラマンピークが見られます、A 1g 〜406.7cm -1 でのモード およびE 1 2g 〜378.9cm -1 でのモード 。右の2つの挿入図は、MoS 2 の原子振動の図を示しています。 。 A 1g モードは、面外方向に沿って逆位相で振動するS原子、およびE 1 に対応します。 2g モードは、結晶面に平行に逆位相で振動するS原子とMo原子に対応します。図に示すように、A 1g に対応するラマンピーク モードは、フィルムに対して優先的に励起されます。私たちの測定によると、A 1g の強度比 / E 1 2g 約2.1です。これらのラマン特性は、MoS 2 について報告されている他の結果と類似しています。 薄膜[19]。左の挿入図は、40 nm MoS 2 のAFMトポグラフィー画像を示しています。 GaAs基板上に成長した膜。この図から、フィルムの表面が密な円錐状の粒子で構成されていることがわかります。測定によると、フィルムの二乗平均平方根(RMS)粗さは約1.7 nmであり、粒子の平均サイズは直径約76.3nmです。表面上のこれらの粒子は、外光への表面反射を減少させ、製造されたデバイスの光吸収を高める可能性があります。

MoS 2 のラマンスペクトル GaAs上のフィルム。右の2つの挿入図は、E 1 の振動モードの概略図を示しています。 2g およびA 1g 、 それぞれ。原子のカラーコード:水色-緑、Mo;黄色、S。左の挿入図は、成長したままのMoS 2 の表面形態画像を示しています。 映画
図2は、MoS 2 のXPSスペクトルを示しています。 映画。図2aに示すように、229.3および232.5eVのピークはMo3d 5/2 に関連しています。 およびMo3d 3/2 それぞれ軌道。図2bに示すように、S 2p 3/2 およびS2p 1/2 二価硫化物イオンの軌道(S 2- )はそれぞれ162.2および163.3eVで観測されます。結果は、MoS 2 の報告値とよく一致しています。 クリスタル[17、18]。

MoS 2 のXPSスペクトル a の映画 Moと b それぞれS要素
図3aは、縦方向の I を示しています。 - V 製造されたMoS 2 の曲線 / n -GaAsヘテロ接合。直径約0.5mmの2つのIn電極をMoS 2 の表面に押し付けました。 それぞれ、GaAsのフィルムと裏面。挿入図は、縦方向の測定の回路図を示しています。順方向電圧は、上部のIn電極に印加される正のバイアス電圧として定義されます。図に示すように、製造されたMoS 2 / n -GaAsヘテロ接合は明らかな整流挙動を示します。整流比( I + / 私 − )±1.0Vで測定すると約520です。私たちの実験では、In / MoS 2 およびIn / GaAsはオーミック接触とその I に属します - V 曲線はほぼ線形です。したがって、整流 I - V ヘテロ接合の特徴は主にMoS 2 に由来します / GaAsコンタクト。図3bは、横方向の I を示しています。 - V 製造されたMoS 2 の曲線 / n -GaAsヘテロ接合。直径約0.5mmの2つのIn電極をMoS 2 の表面に押し付けました。 映画。上の挿入図は、横方向の測定の回路図を示しています。図から、 I - V 曲線は、電圧の増加に伴う電流のわずかな非線形増加を示しています。これは、MoS 2 の逆転層が / n -GaAs界面が形成されます[18]。下の挿入図は I を示しています - V 単一のMoS 2 の曲線 真性GaAs基板上のフィルム。図から、ほぼ線形の I - V 曲線が見られ、In / MoS 2 のオームの性質をさらに示しています。 コンタクト。 + 0.5Vの電圧で、単一のMoS 2 の電流 は約3.1×10 −2 μA、MoS 2 の値よりはるかに小さい / n -GaAs、約2.3μA。したがって、MoS 2 と比較して フィルム、MoS 2 の反転層 / n -GaAsインターフェースは、MoS 2 の横方向測定中に、キャリア輸送の抵抗率がはるかに低いパスを提供します。 / n -GaAsヘテロ接合。

a 縦方向の私 - V 製造されたMoS 2 の曲線 / n -GaAsヘテロ接合。挿入図は、縦方向の測定の回路図を示しています。 b 横方向の I - V 製造されたMoS 2 の曲線 / n -GaAsヘテロ接合。上の挿入図は、横方向の測定の回路図を示しています。下の挿入図は I を示しています - V MoS 2 の曲線 真性GaAs基板上の膜
図4aは、製造されたMoS 2 のLPEを測定するための回路図を示しています。 / GaAsヘテロ接合。 MoS 2 の表面に直径0.5mmの2つのIn電極を押し付けます。 LPEの測定を実行するフィルム。距離(2 L )電極間は〜1.0mmです。測定中、電極AとBは、それぞれケースレー2000電圧計の正と負のプローブに接続されました。図4bは、MoS 2 のLPE曲線を示しています。 / n -GaAsおよびMoS 2 / p -それぞれGaAsヘテロ接合。 MoS 2 の厚さ フィルムは〜30.0nmです。 MoS 2 の表面が フィルムは直径約0.1mmのレーザースポットで部分的に照射され、MoS 2 で大きなLPEを観察できます。 / n -GaAsヘテロ接合。図に示すように、レーザースポットがMoS 2 の電極AとBの間を移動するとき、LPEはレーザースポットの位置に対してほぼ線形の依存性を示します。 水面。この図から、LPVはレーザースポットの位置に依存していることがわかります。これは拡散理論[16]、
に適合させることができます。 $$ \ mathrm {LPV} ={K} _0 \ Big [\ exp \ left(-\ frac {\ left | Lx \ right |} {d} \ right)-\ exp \ left(-\ frac {\ left | L + x \ right |} {d} \ right)$$ここで K 0 、2 L 、 d 、および x 比例係数、2つの電極間の距離、キャリア拡散長、およびレーザースポット位置をそれぞれ表します。図の適切な結果は、MoS 2 のLPEを明確に示しています。 / n -GaAsヘテロ接合は、横方向の拡散流と、レーザー位置から離れた励起キャリアの再結合から生じます。図に示すように、光スポットが2つの電極間の中心にある場合、LPV値はゼロです。これは、キャリアの拡散対称性に起因する可能性があります。ライトの位置がA電極に近い場合、LPVは正であり、その逆も同様です。これは、MoS 2 のLPEが / n -GaAsヘテロ接合は、正孔型光励起キャリアによって引き起こされます。最大LPVは、レーザー照明が電極に最も近いときに得られます。私たちの測定によると、最大横方向光起電力(LPV max )は、MoS 2 の線形領域で約208.2mVです。 / n -GaAsヘテロ接合。比較すると、MoS 2 のLPV / p -GaAsヘテロ接合ははるかに小さく、そのLPV max 図に示すように、わずか7.3mVです。図から、MoS 2 のLPEであることがわかります。 / p -GaAsヘテロ接合は、電子型光励起キャリアによって決定されます。さらに、MoS 2 の非線形LPE特性 / p -GaAsヘテロ接合は、レーザースポットがA電極とB電極の間を移動するときの図からわかります。
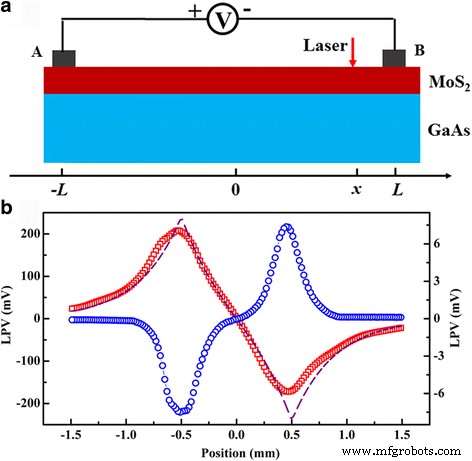
a LPEを測定するための回路図。 b MoS 2 のLPE曲線 / n -GaAsおよびMoS 2 / p -それぞれGaAsヘテロ接合
図5は、MoS 2 のLPE感度を示しています。 / n -レーザー出力と厚さ( d )の関数としてのGaAsヘテロ接合 MoS2 )MoS 2 の 映画。感度は S によって定義されます =LPV max / L 。明らかに、 S 最初はレーザー出力の増加に伴って大幅に増加しますが、出力がさらに増加するとゆっくりと飽和します。この飽和は、照射領域でのレーザー強度の増加に伴う光励起された正孔の再結合率の急速な増加によって引き起こされる可能性があります[20]。図に示すように、100.0μWの弱いレーザー照射下でも明らかなLPEと高感度が得られます。図から、感度のMoS 2 の厚さへの有意な依存性 映画を見ることができます。 d のとき MoS2 =〜10.0 nm、 S =165.4 mV mm -1 100.0μWのレーザー照射下。膜厚の増加に伴い、 S 徐々に増加します。 d のとき MoS2 =30.0 nm、 S 416.4 mV mm -1 に達する 。この感度は、報告されているMoS 2 よりもはるかに大きいです。 / Siデバイス[17、18]。 d の後 MoS2 > 30.0 nm、 S MoS 2 がさらに増加すると減少します 厚さ。 d のとき MoS2 =90.0 nm、 S = 283.3 mV mm -1 。したがって、最大のLPEと感度を得るには、MoS 2 の最適な厚さがあります。 製造されたMoS 2 のフィルム / n -GaAs、約30.0nm。

製造されたMoS 2 の正と負の感度の依存性 / n -それぞれレーザー出力でのGaAsヘテロ接合
図6aは、MoS 2 のUPSスペクトルを示しています。 Si基板上のフィルム。仕事関数( W )フィルムの)は、最高の結合エネルギーのカットオフと励起放射線の光子エネルギーの差から計算できます。図から、 W =5.24eVが得られます。距離(∆ E )価電子帯( E V )とフェルミ準位( E F )MoS 2 の 挿入図に示すように、フィルムは開始エネルギーから抽出できます。 ∆ E MoS 2 の場合 フィルムは約0.51eVです。 MoS 2 の透過率スペクトルのデータを使用 石英基板上のフィルム、(αhν ) 2 光子エネルギーhνの関数としてプロットされます 、ここで h プランク定数であり、ν は光子周波数です。 α は、αdによって計算される吸収係数です。 =ln(1 / T )[21]、ここで d および T はそれぞれフィルムの厚さと透過率です。バンドギャップ( E g )フィルムの)は、hνの線の切片から決定できます。 軸、 E g =1.54 eV、図6bに示すように。これらのエネルギーバンドパラメータに基づいて、 p -MoS 2 のタイプの動作 フィルムを決定することができ、それはホール測定によってさらに証明することができます。ホールの結果は、ホールタイプのキャリアの濃度と移動度が約3.8×10 15 であることを示しています。 cm -3 および11.2cm 2 V -1 s -1 それぞれ。

a MoS 2 のUPSスペクトル GaAs上のフィルム。フィルムのフェルミ準位と、フェルミ準位と伝導帯の上端との間の距離を示しています。 b (αhν ) 2 〜hν MoS 2 のUVスペクトルからの曲線 同じ堆積条件での石英基板上の膜
MoS 2 のLPEのメカニズムを明らかにするために / GaAsヘテロ接合、界面でのエネルギーバンド図は、図6の結果に基づいて作成されます。ここでは、 E g =1.42eVおよび E F = n の場合は4.17eV -GaAsはバンド構造を構築するために考慮されます[22]。 MoS 2 の場合 膜がGaAs基板上に堆積され、電子がGaAsからMoS 2 に流れます。 E が高いため、界面でのフィルム F GaAsの。フェルミ準位が等しく、MoS 2 になると、流動プロセスが停止します。 / GaAs p - n 図7aに示すように、接合部が製造されます。したがって、組み込みフィールド( E bi )はMoS 2 のインターフェースで形成されます / GaAsヘテロ接合。 E bi =[ E F ( n -GaAs)− E F (MoS 2 )] / e =1.07 Vであり、GaAsからMoS 2 を指します。 映画。したがって、非対称の縦方向の I - V 曲線を図3aに示します。強い E が存在するため bi 、界面付近に大量の正孔型キャリアが蓄積し、 n に反転層が形成されます。 -図7bに示すように、界面近くのGaAs基板。二次元ホールガス(2DHG)[23]と同様に、反転層は、ホールのシート濃度が高いため( p + )、高伝導の特徴を示す可能性があります。 )。図3bから、反転層の伝導がMoS 2 よりもはるかに大きいことがわかります。 映画。したがって、MoS 2 の同じ側にある2つの電極間の伝導 フィルムは、MoS 2 ではなく反転層によって支配されています 映画。接合部がレーザーによって部分的に照射されると、光が吸収され、MoS 2 の電子正孔対が形成されます。 図7cに示すように、膜とGaAsをそれぞれ誘導することができます。ただし、レーザーの厚さがはるかに大きく、バンドギャップが小さいため、ほとんどのレーザーはGaAs基板に吸収されると予想できます。レーザー照射下では、電子正孔対は照射領域でのみ励起され、 E によって空間的に分離されます。 bi 。 E の向きによる bi GaAsからMoS 2 を指す 、図7cに示すように、光励起された正孔は界面に向かって流れ、GaAsの反転層に入ります。反転層の光励起された正孔は、照射スポットから離れて2つの電極に横方向に拡散します。 2つの電極によって収集される励起された正孔の濃度は、照射スポットからの距離が異なると異なります。したがって、電極間に大きなLPVが形成され、ヘテロ接合でLPEが観察されます。これは、図3bのフィッティング結果、およびMoS2 / n のLPEと一致しています。 -GaAsヘテロ接合は、主にキャリア拡散に由来します。 MoS 2 の場合 フィルムは p に堆積されます -GaAs基板、 p - p 図7dに示すように、ヘテロ接合が形成されます。 E F ( p -GaAs)=5.32eVがバンド図で使用されています[22]。 E bi p の - p ヘテロ接合は0.08Vと計算でき、その方向はフィルムから基板に向いています。 E のため bi 、電子型キャリアがヘテロ接合の界面近くに蓄積され、反転層が形成されます。したがって、光励起された電子の拡散によって誘導されたLPEは、MoS 2 で取得されます。 / GaAs p - p 図4に示すように、ヘテロ接合。ただし、 V が弱いため、反転層に蓄積されたキャリアの濃度が低くなる可能性があります。 bi p でわずか0.08V - p p と比較したヘテロ接合 -MoS 2 / n -GaAs接合。これにより、反転層での光励起電子の輸送が困難になります。真剣に、ショットキー障壁は n の間に形成される可能性があります -タイプの反転レイヤーと p -MoS 2 図7eに示すように、フィルム。 p のこれらの特性 -MoS 2 / p -GaAs接合は、電極での光励起電子の収集を抑制します。その結果、LPEを大幅に削減できます。図4bに示すように、LPV max p の場合 - p ジャンクションはわずか7.3mVですが、 p では208.2mVに達します - n ジャンクション。

a MoS 2 のエネルギーバンドアラインメント / n -GaAsヘテロ接合、および b インターフェースでの電気的接触の対応する図。 c MoS 2 におけるLPEのメカニズム / n -GaAsヘテロ接合。 d MoS 2 のエネルギーバンドアラインメント / p -GaAsヘテロ接合、および e インターフェースでの電気的接触の対応する図
報告されているヘテロ接合タイプのPSDでは通常、キャップ層の厚さを変更することでLPEを調整できることがあります[20]。これは、フィルム内の光励起キャリアの再結合とビルトインフィールドの進化を考慮することでよく理解できます。 MoS 2 で / GaAs p - n 接合部では、厚いMoS 2 の長い輸送経路により、光子生成キャリアの再結合を強化できます。 それらが電極によって集められる前にフィルム。これにより、ヘテロ接合のLPEが減少します。逆に、フィルムが薄いと再結合が大幅に減少し、LPEが増加します。ただし、MoS 2 厚さが臨界値 E よりも小さい bi MoS 2 がさらに減少すると、界面で減少します。 厚さ[24]。これにより、光子によって生成された電子正孔対の分離が減少し、LPEが減少します。したがって、MoS 2 の最適な厚さがあります。 最高のLPE、約30nmを得るためのフィルム。
結論
要約すると、MoS 2 マグネトロンスパッタリング技術により、GaAs基板の表面に薄膜を堆積させた。製造されたMoS 2 で大きなLPEが得られました。 / n -GaAsヘテロ接合、およびレーザー照明の位置へのLPVの依存性は、良好な直線性を示しました。界面に強力なビルトインフィールドが形成されるため、MoS 2 / n -GaAsヘテロ接合は416.4mV mm -1 の高感度を示しました 、値はわずか7.3 mV mm -1 でしたが、 MoS 2 の場合 / p -GaAs。我々の結果はさらに、LPEがMoS 2 の厚さに明らかな依存性を示すことを示しました。 フィルムと約30.0nmがMoS 2 の最適な厚さでした 製造されたMoS 2 で最高のLPEを取得するためのフィルム / n -GaAsヘテロ接合。 MoS 2 のLPEのメカニズム / GaAsデバイスは、界面でのエネルギーバンド配列に基づいて解明されました。
略語
- ∆ E :
-
E 間の距離 V および E F
- d MoS2 :
-
MoSの厚さ 2 映画
- E bi :
-
ビルトインフィールド
- E C :
-
伝導帯レベル
- E F :
-
フェルミ準位
- E g :
-
エネルギーバンドギャップ
- E V :
-
価電子帯レベル
- I - V :
-
電流-電圧
- LPE:
-
横方向の光起電力効果
- LPV:
-
横方向の光起電力
- LPV max :
-
最大横光起電力
- MoS 2 :
-
二硫化モリブデン
- PSD:
-
位置感知検出器
- UPS:
-
紫外光電子分光法
- W :
-
仕事関数
ナノマテリアル
- GaSe / MoSe2ヘテロ接合デバイスの光起電力特性
- 電気触媒水素発生のための制御された厚さのMoS2
- 電気触媒作用のためのグラフェンナノシート上のMoS2ナノフレークの温度依存性結晶化
- リチウムイオン電池用の効率的なアノード材料としての数層のMoS2 /アセチレンブラック複合材料
- 多層MoS2フォトトランジスタのバイアス依存光応答性
- Pdナノ粒子の表面装飾による数層MoS2 / SiO2 / Siヘテロ接合の高度に強化されたH2センシング性能
- ペロブスカイト太陽電池の光起電力特性に及ぼすさまざまなCH3NH3PbI3形態の影響
- AlGaAs / GaAsヘテロ接合を使用したGaAsナノワイヤピン接合アレイ太陽電池の最適化
- 高速セレニル化アプローチによるSb2S3平面ヘテロ接合太陽電池の強化された光起電力特性
- 電荷移動ベースのバリア変調下でのMoS2非対称ガスセンサーのキャリア輸送特性
- GaAs / AlGaAs二次元電子ガスにおける外因性光誘起逆スピンホール効果の観測



