変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
要約
仮像(従来)InAs / GaAs量子ドット(QD)構造と比較した垂直変成InAs / InGaAsの光起電力に対するGaAs基板とその近くの層の双極効果を研究した。変成構造と仮像構造の両方が、分子線エピタキシー法によって成長し、成長した n のいずれかで下部接触を使用しました。 + -バッファまたはGaAs基板。 QD、濡れ層、およびバッファーに関連する機能は、両方のバッファー接触構造の光電スペクトルで識別されていますが、基板接触サンプルのスペクトルは、EL2欠陥中心に起因する追加の開始を示しました。基板に接触したサンプルは、双極光起電力を示しました。これは、QDに関連するコンポーネントと、基板関連の欠陥および最も深く成長した層を備えたそれらのクラッド層との間の競合の結果として発生することが示唆されました。緩衝液に接触した構造のスペクトルには、直接的な基質効果は見られませんでした。ただし、 n の顕著な悪影響 + -InAs / InGaAs構造では、光起電力および光伝導信号上のGaAsバッファ層が観察されました。得られた結果と実行された計算を分析することで、新しい効率的なフォトニックデバイスの開発に役立つ可能性のある変成QD構造の設計に関する洞察を提供することができました。
背景
過去20年間で、半導体ナノ構造を含む複合材料は、光感度、製造の容易さと低コスト、スペクトル調整可能性、および短寿命での高効率発光により、フォトニックアプリケーションで大きな用途が見出されています[1,2,3,4,5 ]。 In(Ga)As量子ドット(QD)ヘテロ構造は、赤外線に敏感なナノ構造の重要なクラスであり、レーザー[2、6]、単一光子源[7、8]などのさまざまなフォトニックデバイスで広く使用されています。光検出器[9,10,11,12,13]、および太陽電池[14,15,16]。このような感光性デバイスの光電特性を改善するために、多くの調査が行われてきました。たとえば、感光性範囲は、中間バンドギャップ[17、18]または複数の励起子生成[19、20]による励起によって拡張できるため、QDベースの太陽電池の電力変換効率は理論上単一の限界を超えることができます。 -バンドギャップ太陽電池[21]。ひずみ平衡[22]やミスフィット管理技術[23]、熱アニーリング[24]などの方法を使用して、これらの構造のひずみを低減し、動作範囲[25]を操作し、再結合中心として機能する可能性のあるひずみ関連の欠陥の抑制[26]。
ひずみを低減するための効率的な方法は、従来のGaAsではなくInGaAs変成バッファ(MB)の成長に基づいています。その結果、InAs / InGaAs QD構造は、過去10年間で多くの関心を集めてきました[27、28、29]。 InGaAs MB上でQDを成長させることにより、GaAsマトリックス内の従来のものと比較して形成プロセスとQD光学特性の本質的な違いを観察することができます[25、30、31、32、33]。たとえば、InGaAs閉じ込め層は、QDとバッファ間の格子不整合を低減し、QDの歪みを低減します。その結果、InAsのバンドギャップが減少し、発光波長の大幅な増加が観察されます[34]。 MBを閉じ込め材料として適用すると、その値を1.3および1.55μmの通信ウィンドウにシフトできます[28、29、35、36]。
同様に、変成InAs QD構造の光電特性を、変成赤外光検出器[11,12,13]や太陽電池[37,38,39]などの感光性デバイスの設計に適用する試みが期待されています。構造設計を開発するためにいくつかの研究が行われ[25、31、32、33]、光電特性を改善するために他の研究が行われた[39、40]。ヘテロ構造の歪みを減らすための調査が行われています[34、41]。これにより、太陽電池の光電流密度とスペクトル応答[39、40]、およびそのような構造の光電子放出効率が大幅に向上します[39、40]。 29、32、42]。
感光性デバイスの開発には、光電特性の詳細な研究が必要です。光起電力(PV)または光伝導率(PC)の研究は、光エネルギー、レベル間の遷移、キャリア輸送、およびデバイスの動作範囲の関数としての光応答を決定するための理想的なツールです[10、43、44]。ただし、過去数年間に変成InAs QDを備えた構造の光電特性に関するいくつかの研究が行われているにもかかわらず[37、38、39、43]、MBの影響とともに、光応答メカニズムの完全な側面は依然として不明です。ナノ構造の特性について。特に、InAs / InGaAs / GaAs QD構造の光電スペクトルに対するGaAs基板と関連する界面の影響については、詳細に検討されていません。基板の影響を回避するために多大な努力が払われていますが、光応答は、分子線エピタキシー(MBE)によって成長した基板と近くの層の両方の影響を受けます。したがって、適用される接触形状は、下層と基板を電気的に不活性に保つことですが、PVと光電流に対するそれらの顕著な悪影響が以前の調査で検出されました[43]。ごく最近、変成InAs / In 0.15 の光電特性を比較しました。 Ga 0.85 標準的なInAs / GaAs QDのものとのQD構造として、変成InAs / In 0.15 の光電流が Ga 0.85 ヘテロ構造はQD付近の欠陥に関連するレベルの影響を受けなかったため[45]。さらに、1.3μmの効率的なフォトニックデバイスは、活物質と同様のナノ構造で開発できると結論付けられています。
この作業では、変成In 0.15 のいずれかに埋め込まれたInAsQDを備えたヘテロ構造の光電特性の研究を続けます。 Ga 0.85 GaAs基板と近くのMBE層の効果に焦点を当てた従来のGaAsバッファとして。基板層とバッファ層の役割を明確に理解するために、(i)In 0.15 に下部接点がある構造を検討しました。 Ga 0.85 バッファ層として、または(ii)下部GaAs基板として(図1を参照)。したがって、下部接点の選択に応じて、電流は(i)QDとバッファ層のみ、および(ii)基板とMBE層との界面を含む完全な構造を流れました。結果と計算の分析により、変成QD構造上の光センサーの最適な設計への洞察を提供することができました。
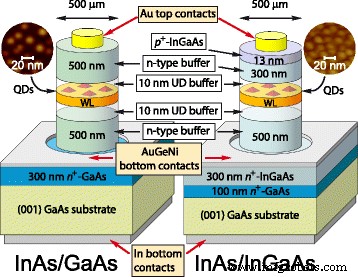
(オンラインカラー)変成InAs / In 0.15 の概略図 Ga 0.85 As / si -GaAs(右)およびInAs / GaAs / si -GaAs(左)QDサンプルを調査。キャップのない構造のAFM画像が表示されます
メソッド
構造は、(001)半絶縁( si )でMBEによって準備されました )GaAs基板。基板は n でした -タイプ、値は3×10 7 cm -3 残留キャリア濃度、500μmの厚さ、2×10 7 の抵抗率 Ω×cm。変成InAs / InGaAs QD構造は、(i)100 nm n で構成されます。 + -600°Cで成長したGaAsバッファ層、(ii)厚さ300 nm n + - 0.15 Ga 0.85 n のMBとして =5×10 18 cm -3 490°Cで成長、(iii)厚さ500 nm n - 0.15 Ga 0.85 n のMBとして =3×10 16 cm -3 490°Cで成長、(iv)20nmのドープされていないIn 0.15 に埋め込まれた自己組織化InAsQDの3.0単分子層(ML) Ga 0.85 460°Cで成長した層として、(v)300 nm n - 0.15 Ga 0.85 n の上部キャッピング層として =3×10 16 cm -3 490°Cで成長し、(vi)13 nm p + ドープされたIn 0.15 Ga 0.85 p のキャップとして =2×10 18 cm -3 490°Cで成長させました(図1)。 0.15 ML / sの成長速度で成長したQDを除いて、成長速度は1.0 ML / sでした。 QDを n から分離するには、ドープされていない層が必要です。 ドープされた領域、したがって非放射再結合中心の影響を低減し、QD発光効率を最大化します[30、46]。標準のInAs / GaAs QD構造は、(i)300 nm n で構成されます。 + - n のGaAsバッファ層 =5×10 18 cm -3 600°Cで成長、(ii)厚さ500 nm n - n を使用したGaAsMB =3×10 16 cm -3 600°Cで成長、(iii)460°Cで成長した20nmのドープされていないGaAs層に埋め込まれた3.0MLのInAsQD、および(iv)500 nm n - n のGaAs上部キャッピング層 =3×10 16 cm -3 600°Cで栽培。 0.15 ML / sの成長速度で成長したQDを除いて、成長速度は1.0 ML / sでした。
キャップのない構造の原子間力顕微鏡(AFM)画像を図1に示します。同様の構造のAFMデータの分析により、QDサイズの最も頻繁な値は20 nm(直径)および4.9 nm(高さ)であると推定されました。 QDおよび標準QDの21nm(直径)および5.0 nm(高さ)[30、31、45]。
光電測定では、500μmの円形のメサが構造物の下部バッファー n までエッチングされました。 + レイヤー;次に、直径400 µm、厚さ70nmのAu整流トップコンタクトをメサの上部に蒸着しました。下部のオーミック接触を取得するには n + -InGaAsおよび n + -GaAsバッファ層、それぞれ、Au 0.83 Ge 0.12 Ni 0.05 合金は、窒素雰囲気中で400°Cで1分間堆積されました。 GaAsバッファと si を流れる電流でも測定できるように、同じサンプルの他の部分の基板の底に厚いインジウムオーミック接触を作成しました。 -GaAs基板。連絡先のオーミシティは I によって確認されています - V 測定、基板への接触;電流-電圧特性は線形であることがわかりました(データは示していません)。
参考文献で提案されたアプローチに従う。 [47]そして他の作品[48、49]で使用されている、薄い p + -Au接点と n の間のInGaAs層 - n に金属を単純に堆積することで得られる構造であるため、ショットキー障壁の高さを高めるためにInGaAs層が使用されました。 -InGaAsは比較的低いショットキーバリア高さを示しました。したがって、薄い p の堆積 + -InGaAs層は、ショットキー障壁の高さをAu-GaAs接触の高さと同様に拡大し、変成構造とInAs / GaAs構造の両方の障壁プロファイルの類似性を維持します。
構造と接触の設計、およびIn 0.15 によって構成される両方の構造のエネルギープロファイルの理解 Ga 0.85 AsまたはGaAsMB、In(Ga)As QD、ドープされていないキャップ層、およびAu / AuGeNi接点では、Tibercadソフトウェアを使用して計算が実行されました[50]。バンドプロファイルは、ひずみ条件、InGaAs / GaAs界面領域の欠陥に関連するトラップの密度、接点近くの空乏層、および適切なショットキー障壁の高さを考慮して、ドリフト拡散近似でモデル化されました。変成QDバンドプロファイルの計算では、Refsですでに検証されているアプローチに従って、AFMデータからのサイズが考慮され、ひずみ効果が含まれています。 [42、51]。 QD量子レベルの計算はこの論文の範囲外であり、QDモデリングは以前に参考文献で実行されました。 [45]。ただし、この作業では、基板を含むヘテロ構造全体のバンドプロファイルを計算します。
垂直光電流およびPVスペクトルは、室温(RT)(300 K)および同じ光源強度(1.5 mW / cm 2 )での垂直入射励起ジオメトリを使用して、0.6〜1.8eVの範囲で測定されました。 )。光電流は、電流増幅器と直流技術[10、43、44、45]を使用して、1Vバイアスで測定されました。電流は、100kΩの直列負荷抵抗での電圧信号降下として測定されました(図5の挿入図を参照)。 532 nmで励起されたフォトルミネッセンス(PL)は、300 Kで測定されました。構造と方法に関するいくつかの情報は、参考文献に詳細に記載されています。 [45]。
結果と考察
A。光電特性評価
両方のInAs / In 0.15 のPVスペクトル Ga 0.85 AsおよびInAs / GaAsサンプルを図2に示します。MBE層のみに接触し、厚い n -InGaAs、または n -GaAsバッファ、スペクトルの特徴は他の場所で説明されています[45]。 InAs / In 0.15 のスペクトルしきい値 Ga 0.85 0.88 eVは、QDアンサンブルの基底状態の吸収に関連しています。これは、以前に測定されたRTでのPLスペクトルのQDバンドの開始に対応します[45](図2a)。変成QD発光スペクトルは0.94eVで広帯域を示し、これは1.3μm(0.95 eV)のテレコム範囲にありますが、QD PLは、以前の論文で指摘されているように、優れた効率を示しています[30、45、46、 52]。ピークが1.24eVでエッジが1.11eVのPVスペクトルの広帯域は、In 0.15 でのキャリア生成によるものです。 Ga 0.85 浅いレベルを通過する方法を含むMBおよび濡れ層(WL)として。 In 0.15 Ga 0.85 MBE成長層に対して計算されたバンドギャップは1.225eV [53]であり、WLPLは1.2eV [45]で観察されます。さらに、1.36 eVを超える大幅な急激な低下が観察されます。これは、参考文献に記載されている相互接触領域の外側にある高濃度にドープされたGaAsバッファ層の間接的な影響が原因である可能性があります。 [43]。バッファ層は、GaAsのバンド間吸収を赤方偏移させるMBE成長欠陥とドーピングセンターに起因する多数の浅いレベルとバンドの不均一性で満たされています[33、46、54、55]。従来のバッファー接触InAs / GaAsナノ構造の場合、図2bのPVスペクトルの1.05 eVでの開始は、PLスペクトルで確認されたように、QD基底状態に起因しますが、1.3eVでの鋭いステップはWLの遷移[56]。 1.39 eV以降の特徴は、明らかにドープされたGaAs上部バッファ層の吸収に関連しています。この効果のメカニズムについては、以下で詳しく説明します。

(オンラインカラー) a の室温PVスペクトル 変成InAs / In 0.15 Ga 0.85 Asおよび b InAs / GaAsQD構造; PVは、MBE層のみに接触して[45](黒い曲線)、半絶縁性の si を介して測定されました。 -GaAs基板(青)。 si で測定されたPVスペクトル -GaAs基板は、 a でそれぞれ1.68および1.44eV未満の電圧の符号によって反転します。 および b 。曲線の低エネルギー部分は挿入図に示されています。両方の構造について[45]の前に測定されたQDPLバンドは、QD基底状態のエネルギーポジショニング(赤)に対して表示されます
前述のように、InAs / In 0.15 でPV信号が1.36eVを超えると急激に低下します。 Ga 0.85 構造は n に関連しているため + -基板を覆うGaAs最下層。下部のAuGeNi接点の下の層が光応答に及ぼす影響を明らかにするために、基板背面のインジウム接点を使用して構造の光電特性を調べました。ユニポーラPVを可能にする以前のAuとAuGeNiの接触形状とは異なり、サンプルの上部と基板の背面に接触する構造では、バイポーラ信号が観察されています(図2)。 PVの符号は光子エネルギー軸に沿って変化することに注意する必要があります。図2では、InAs / In 0.15 Ga 0.85 それぞれAsおよびInAs / GaAsQD構造。ここで、MBE層への接触の場合のように、正の電位が上部のAu接点に印加され、負の電位が下部の接点に印加される場合、PVは正と見なされます。
上記のすべての光学遷移は、基板上部の接触形状の構造のPV信号に寄与します。ただし、基板を介してPVを測定する場合、変成構造および従来の構造の信号開始は約0.72eVで発生します。 0.72 eVでの開始は、 si にあるEL2欠陥中心からの遷移に起因します。 -GaAs基板およびGaAs伝導帯より0.75eV近くの関連する界面[57]、浅いレベルの欠陥を通過する可能性を考慮[46、54、55]。それらの位置とEL2PC開始赤方偏移に関連する側面は、他の場所で詳細に議論されています[10、45]。 InGaAsまたはGaAsバッファーに接触したサンプルのスペクトルでは、QD関連のバンドの下に信号が観察されなかったため(図2)、基板および関連する界面は、MBEで成長したヘテロ構造の特性に実質的な影響を及ぼさないと結論付けます。 。
サンプルでのPV信号の外観を理解するには、図3を参照してください。ここでは、成長方向に沿って計算されたバンドプロファイルを示しています。 Au接点とAuGeNi接点の間のPV起源の詳細な説明は、前の論文[45]に記載されています。要約すると、光励起された電子(正孔)は主に基板(表面)に向かってドリフトし、Au接点で正の電位、AuGeNi接点で負の電位を与えます。

(オンラインカラー)変成InAs / In 0.15 で計算されたバンドプロファイル Ga 0.85 As(上)および仮像InAs / GaAs(下)構造、PVメカニズムを説明します。 AuGeNi接点の下のより深い層のバンドベンディングは灰色で示されています。 PVスペクトルで観察された光学遷移は、垂直の矢印で示されています。太い矢印は、内部電界下での光学的に励起された電荷キャリアのドリフト方向を示しています(PV作成)。 E F フェルミエネルギーです。計算はTibercadソフトウェアを使用して実行されました[50]
電気的にアクティブな si を備えた構造からのバイポーラPVの説明 -GaAs基板の場合、図3で計算されたバンド構造を検討できます。前と同様に、QDとWLだけでなく、最上層で生成されたキャリアは、最上部に「+」、基板に「-」を与える可能性があります。半絶縁性基板のフェルミ準位は、 n のフェルミ準位よりもはるかに低い位置にあります。 ドープされたMBE層。したがって、バンドは n の近くで曲がっています + -GaAs /基板のインターフェースは、MBEで成長させた残りの構造のインターフェースと反対です(図3を参照)。したがって、 n の励起 + -GaAs層と基板(1.36 eV以上)は、QD、WL、およびバッファからの信号とは反対のPV信号を提供します。同じことが、GaAs基板のEL2欠陥(0.72 eV以上)、特に n のEL2のような欠陥からの励起にも当てはまります。 + -GaAs / GaAs歪み領域[46、57]。基質と n の寄与 + -総PV信号に対するGaAsは、基本的に上部MBE層の信号よりも強く、PVの負の信号は一般に低い励起エネルギーで観察されますが、InGaAs層とナノ構造の影響は、図のそれぞれのスペクトル曲線に谷として表示されます。 。2。これは、MBEバッファーに接触した構造のPV曲線上のQD、WL、およびバッファーのスペクトルバンドを、基板上に接触したサンプルのスペクトルの谷と比較することで明確にわかります。ただし、より高いエネルギーの場合、励起はサンプル表面の近くで吸収され、負の信号の主な発生源であるより深いMBE層と基板に到達しません。したがって、PV信号はより大きなエネルギーで正になります。したがって、電気的にアクティブな si の存在 -基板は、MBEで成長した上部層に関連するスペクトル成分と、基板に関連する欠陥および n との間の競合につながります。 + -GaAs吸収。
それ以外の場合、 p の最近の詳細な研究では、表面PV分光法によって1.35eVを超える同様の特徴が観察されています。 si に基づくドープされたInAs / GaAsQDおよびInAs / InGaAsドットインウェル構造 -GaAs基板[58]。私たちの場合とは異なり、PV振幅の急激な低下は、1.35eVの上下で生成されるさまざまな電荷キャリアによって説明されています。ただし、参照および現在の構造の大幅な違いと、適用された方法の詳細を考慮して、独自の結果の解釈に従います。
AuGeNi接点の下でのバンドの曲がりの概念に基づいて、図2aで観察された1.36eVを超えるバッファ接触した変成InAs / InGaAs構造でのPV信号の急激な低下を説明できます。このスペクトルの特徴は、基板と最も深いMBE n の影響によるものです。 + -GaAs層。実際、そこで生成された電子は、固有電界の下でAuGeNi接点に移動し、そこで追加の電界を引き起こします。これにより、InGaAs / GaAsヘテロ接合でのバンドベンディングによる障壁が明らかに低すぎて、電荷キャリアにとって本質的な障害にはなりません。これにより、PVに直接寄与する上層のバンドの曲がりが整列し、 n より上で光励起されたキャリアの供給が減少します。 + -GaAs層と、その結果としての総PV信号。
図2bでは、MBEバッファーに接触した仮像サンプルのスペクトルに、1.39 eV付近の小さな特徴が見られますが、同様のバンドベンディングを考慮すると、1.36 eVを超えると、変成構造のような信号の急激な低下が予想されます。 n の近く + -GaAs /基板界面。このような機能は、基板と n だけの属性ではありません。 + -ドープされたGaAs;このような遷移は、 p に基づくIn(Ga)As / GaAsQD構造で検出されました。 ドープされた[58]およびドープされていないGaAs [10、55]。これらの遷移は、明らかに、仮像構造の上部GaAs層でも発生し、PV信号に対する基板近くの層の悪影響を主に補償します。その結果、図2bのInAs / GaAsサンプルの黒い曲線では、同様のバイポーラにもかかわらず、より深いGaAs層に由来する変成岩の曲線の低下ではなく、基板近くの層の影響はごくわずかしか観察できません。 PV形成に基板が直接関与することで観察される効果。
MBEバッファに接触したInAs / GaAsサンプルのスペクトルの1.39eV以降の小さな特徴の理由は、変成InAs / InGaAsサンプルについて前述したものとは異なる可能性があります。私たちの意見では、これは、これらの光子エネルギーでPVにさらに効率的に寄与するQDとWLをシェーディングする上部MBE成長500nm厚のGaAsバッファの吸収端によって引き起こされる信号のわずかな低下によるものです。実際、QDとWLで生成された電子と正孔は異なる側に運ばれ、再結合の可能性がはるかに高いボリューム生成とは異なり、再結合を回避します。これが、QDとWLの単層からの光キャリアを効果的に検出する主な理由です。より高いエネルギーの光子は、表面近くの n に吸収されるバンド間です。 -GaAsバッファ層と電子がホールから離れてサンプルボリュームに逃げ、PVが1.4eVを超えると急激に上昇します。変成岩の場合とは異なり、バッファ接触したInAs / GaAs構造の1.36eVの特徴の提案された理由の正しさは、 n <に下部接触があるInAs / GaAs構造に基づく太陽電池の研究によって確認されています。 / i> + -GaAs基板[18、24、59]、つまり、接触から接触までサンプル全体で単調なバンドが曲がっています。それらのPVスペクトルは、基板へのMBE層の界面に関連する障壁がない同じ特徴を示しています。さらに、横方向の接触構造を持ち、固有磁場がないInGaAs / GaAs構造のPCスペクトルでは、同じスペクトル範囲で狭いディップが観察されました[10、55]。
構造の上層の固有電界のように方向付けられた1Vバイアスで得られた構造のPCスペクトル(上部の「-」と下部の接点の「+」)を図4に示します。 MBE層に接触する構造は、図2のPV構造と非常によく似ています。QD、WL、InGaAs、またはGaAsバッファ、および n のコンポーネント + -GaAs層は同じエネルギーで観察されます。 s i の下部接点のある構造について -GaAs基板、PCスペクトルには、EL2欠陥中心吸収に関連する0.72eV付近のしきい値があります。
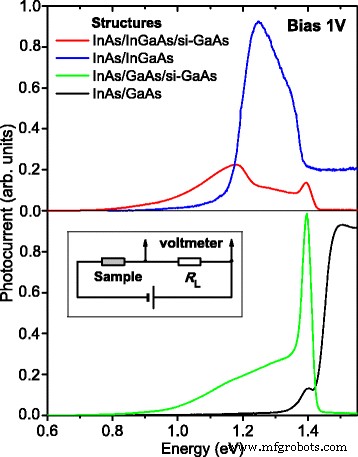
(オンラインカラー)変成InAs / In 0.15 の室温光電流スペクトル Ga 0.85 As / si -GaAsおよび従来のInAs / GaAs / si -GaAsQD構造。挿入図:PC測定用のサンプルを接続する電気スキーム
図4に示されているMBE層に接触している構造のPCスペクトルの特徴は、主に上記の図2のPVスペクトルの特徴に対応しています。 s i の下部接点のある構造について -EL2中心成分を備えたGaAs基板では、前述のように、MBE層での吸収からの信号とEL2関連レベルからの信号との間に競合があります。ただし、曲線の形状により、 n の上の層内で電荷キャリアが励起されていないと結論付けることができます。 + -GaAsはPCに参加します。これは、変成QD構造スペクトルに特に関係があります。明らかに、 si によって引き起こされる高いポテンシャル障壁(図3を参照)のために、電子は底に到達しません。 -基板。基板の抵抗が高すぎるため、印加バイアスの主な低下が基板上で発生するため、バリア低下は発生しません。
したがって、PVと光電流は基板関連の n によって悪影響を受けることに注意できます。 + -GaAs層:1.36 eVを超える吸収により、信号が大幅に減少します。 AuGeNi接点の下のバリアの主な原因は、 si です。 -フェルミ準位の位置がかなり低く、構造上部のバンドとは逆にバンドが曲がるGaAs基板。これは、このような接触形状でPVで観察される基板の唯一の効果であり、下部の接触と基板の間のかなり厚い(400 nm)中間層でも現れます。
B。基板-ヘテロ構造中間層設計ソリューション
実用的な観点から、 si を使用したInAs / InGaAs構造のこのような設計は結論付けることができます。 -GaAs基板は、特に比較的薄い n と一緒に使用すると、垂直感光性デバイスエンジニアリングには役立ちません。 + 接触構成が基板を流れる電流を排除する場合でも、ドープされたバッファ。 n に形成された空間電荷領域 + -GaAs /基板界面領域は、ここで励起された電荷キャリアを、図1および2のように変成構造で励起された電荷キャリアと反対に移動させます。 3と5aにより、反対のPV信号が生成され、サンプルの総量子効率が低下します。
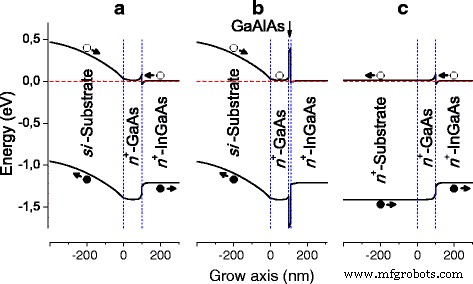
(オンラインカラー)In 0.15 付近の計算されたバンドプロファイル Ga 0.85 si 上に成長した変成構造のAs / GaAs界面 - n の基板 + - a のGaAs層の厚さ 100 nm(現在のサンプル)、 b 100nmおよび10nmの薄いGa 0.3 Al 0.7 バリア層として、および c 現在のような構造ですが、 n で成長しました + -100nmの厚さの n と同様にドープされた基板 + -上のGaAs層。計算はTibercadソフトウェアを使用して実行されました[50]
したがって、光吸収に基づくデバイスの場合、異なる構造設計を検討する必要があります。多くの研究グループが si を検討しているため、このような改善を提案する必要があると考えています。 -新規 p の基礎としてのGaAs基板 - n -QD赤外線光検出器[11、12、13]と太陽電池[15]の両方を入力します。
n の単純な肥厚 + -変成構造下のGaAsバッファはあまり良い考えではないようです。このようなバッファは、1.37 eVを超えるとより多くの励起量子を吸収し、その下の界面と基板をシャドウイングする可能性がありますが、上の800 nmのより狭いバンドギャップのInGaAs材料では負のバイポーラ効果を完全に抑制するには不十分であるため、その厚さは非常に厚くする必要があります。さらに、非常に厚い n + -GaAsバッファは、主に基板内にあり、MBE層との界面近くにあるEL2のような中心の悪影響を排除することはできません。それにもかかわらず、電荷キャリアの平均自由行程は限られているため、 n が厚くなります。 + -GaAs層は、上記のAuGeNiコンタクトに誘導された負の電界を弱める可能性があります。
図5bに示すように、基板から来る電子に対して薄いバリア層を成長させることで、より良い改善が得られる可能性があります。計算には、10nmの薄いアンドープGa 0.3 Al 0.7 バリア層として選択されています。 Such barrier could strongly confine the electrons excited in the substrate within the n + -GaAs layer. Similar high-ohmic layers grown by wide-bandgap materials as InAlAs, GaAlAs, and AlAs have been used in laser structures to avoid the charge carrier leakage from the active region of optoelectronic device [60]. However, for the case of GaAs-In0.15 Ga0.85 As based device, Ga0.3 Al0.7 As best matches due to the wide bandgap and small lattice mismatch between the epitaxial layer. Decreasing the carrier-induced field on the AuGeNi contact, it can suppress the negative effect of the substrate region on the photoresponse, especially in combination with increase in the n + -InGaAs layer thickness.
Yet, a more optimal design of the vertical structures seems to be in use of a monotonous gradient of doping, including an n + -doped GaAs substrate as it is proposed in Refs [14, 39, 40]. This design is the most efficient and at the same time simplest. If the substrate is doped similar to the capping n + -layer or heavier, this causes the band bending depicted in Fig. 5c. Furthermore, an essential advantage of such a substrate could manifest itself in solar cell design. A low-resistive substrate allows for utilization of the configuration with the “–” contact on the sample bottom [24, 38,39,40, 59], non-shadowing the MBE structure from the sunlight.
結論
We have shown that photoelectrical characterization evidences a critical influence of the deep levels on the photoelectrical properties of vertical metamorphic InAs/In0.15 Ga0.85 As and pseudomorphic (conventional) InAs/GaAs QD structures in the case of electrically active si -GaAs substrate. Both nanostructures manifest a bipolar PV caused by a competition of the components originated from the oppositely sloped band profiles near the GaAs substrate and bottom MBE n + -GaAs layer on one side and the rest of MBE-grown structure on the other side. An alternative contact configuration, which allows to avoid the current flow through the bottom layers, demonstrates the unipolar PV. The last configuration together with thick buffers on substrate strongly suppresses the influence of the photoactive deep levels originated from interfaces with the si -GaAs substrate on photoelectric properties of the nanostructures. However, a notable negative indirect effect of the substrate on the photovoltage and photocurrent signal from the InAs/InGaAs structure is observed when the excitation is absorbed in the substrate and near-substrate n + -GaAs MBE layer. Analyzing the obtained results and the performed calculations, we have been able to provide insights on the design of metamorphic QD structures, which can be useful for the development of novel efficient photonic devices.
略語
- AFM:
-
原子間力顕微鏡
- MB:
-
Metamorphic buffer
- MBE:
-
Molecular beam epitaxy
- ML:
-
Monolayer
- PC:
-
Photoconductivity
- PL:
-
フォトルミネッセンス
- PV:
-
Photovoltage
- QD:
-
Quantum dot
- R L :
-
Load resistance
- si :
-
Semi-insulating
- WL:
-
Wetting layer
ナノマテリアル
- 5Gデバイスの設計と開発:5Gのパフォーマンス範囲
- 効率的な光触媒水素生成のためのS、N共ドープグラフェン量子ドット/ TiO2複合材料
- スリーステートエレクトロクロミックデバイスのディップコーティングプロセスエンジニアリングと性能最適化
- マイクロピラーのInAs二重層量子ドットに基づく1.3μmの明るい単一光子源
- 自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
- 最大の太陽エネルギー収穫のためのInPナノワイヤの効率的かつ効果的な設計
- スーパーキャパシター用途の電極としてのグラフェン/ WO3およびグラフェン/ CeOx構造の評価
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- RFおよびマイクロ波設計のガイドライン
- RF PCB 設計における後退と解決策



