HfO2欠陥制御層を備えた単層カーボンナノチューブが支配的なミクロンワイドストライプパターンベースの強誘電体電界効果トランジスタ
要約
単層カーボンナノチューブ(SWCNT)を備えた強誘電性電界効果トランジスタ(FeFET)は、チャネル(Bi、Nd) 4 としてパターン化されたミクロン幅のストライプを支配しました。 Ti 3 O 12 絶縁体としてのフィルム、およびHfO 2 欠陥制御層としてのフィルムが開発され、製造された。準備されたSWCNT-FeFETは、大きなチャネルコンダクタンス、高いオン/オフ電流比、高いチャネルキャリア移動度、優れた疲労耐久性能、データ保持などの優れた特性を備えています。静電容量に相当する厚さにもかかわらず、HfO 2 のゲート絶縁体 欠陥制御層は、3.1×10 -9 の低いリーク電流密度を示します A / cm 2 ゲート電圧-3Vで。
背景
強誘電性電界効果トランジスタ(FeFET)は、その高速、単一デバイス構造、低消費電力、および非破壊読み出し動作により、不揮発性メモリデバイスおよび集積回路の有望な候補です[1,2,3]。 (Bi、Nd) 4 Ti 3 O 12 (BNT)は、安定した化学的性質と疲労耐久性能を備えた鉛フリーの強誘電体薄膜です。したがって、ゲート誘電体としてBNTを使用するFeFETは、しきい値電圧が小さくなり、チャネルコンダクタンスが大きくなります。カーボンナノチューブ(CNT)は、その高い導電性と大きなキャリア移動度のためにFeFETに広く適用されています[4、5、6、7]。理想的なCNTの表面にはダングリングボンドがないことはよく知られています。これにより、強誘電体膜とCNTの間に小さな界面反応が生じます[8、9]。ただし、実験でソース電極とドレイン電極の間で単一のCNT成長を達成することは非常に困難です。さらに、CNTナノワイヤネットワークFeFETのオン/オフ電流比は、CNTネットワークに金属ナノチューブが混在しているため一般的に低くなっています[7、10]。 Song etal。上記の問題を解決するために、FeFETのチャネル材料としてパターン化された多層CNTミクロン幅のストライプを使用することを提案しましたが、CNTFeFETの疲労耐久性能と物理的特性の保持は明確ではありません[9]。多層CNT(MWCNT)と比較すると、単層CNT(SWCNT)は、円筒形のチューブに形成されたシームレスに巻かれた単一のグラフェンシートです[11]。さらに、強誘電体薄膜の製造中に制御するのが難しいいくつかの欠陥(イオン不純物、酸素空孔、転位など)があります[12、13、14]。これらの欠陥の拡散は、オン/オフ電流比、疲労耐久性能、およびデータ保持に影響を与える可能性があります[15、16]。したがって、HfO 2 を移植します SWCNT-FeFETの層。これは、点欠陥の拡散をブロックするために使用され、BNTとSiの間の不適合を緩和し、BNT膜の転位密度を低減するためのバッファー層として使用できます。 SWCNT-FeFETの欠陥を制御し、オン/オフ電流比、疲労特性、およびデータ保持を大幅に改善できます。
この研究では、チャネル層として規則的で整列したミクロン幅のストライプパターンネットワークSWCNT、絶縁体としてBNTフィルム、およびHfO 2 を製造しました。 ボトムゲート型FeFETを作製するための欠陥制御層としてのフィルムであり、良好なオン/オフ電流比、疲労特性、およびデータ保持が期待されます。 SWCNT-FeFETの構造とその調製手順を図1a、bに示します。また、比較のためにMWCNT-FeFETも製作しました。
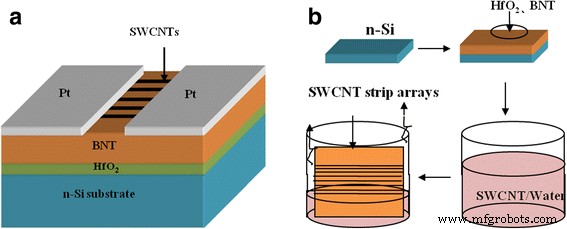
a ストライプパターンSWCNT-FeFETの構造図。 b ストライプパターンのSWCNT / BNT / HfO 2 のフローチャート -FeFETの製造
メソッド
FeFETデバイスでは、パターン化されたSWCNTミクロン幅のストライプがチャネルとして使用され、BNT薄膜がゲート誘電体HfO 2 として使用されます。 膜は欠陥制御層として使用され、高濃度にドープされたn型SiはFeFETの基板とバックゲート電極として同時に使用されます。 n型Siの抵抗率は0.0015Ωcmです。 HfO 2 は、波長248 nmのKrFエキシマレーザーを使用したパルスレーザー堆積(PLD)によってSi基板上に堆積され、その厚さは約20nmです。 BNT膜は、初期の研究[17]で説明されているように、PLDによってSi基板上に堆積され、その厚さは約300nmです。手付かずのアーク放電SWCNTは、成都有機化学研究所(中国科学アカデミー)から購入しました。長さと直径はそれぞれ10〜30μmと0.8〜1.1nmです。その純度は85%であり、これはSWCNTが支配的であることを意味します。 SWCNTは、蒸発誘起自己組織化を使用して製造されました。 SWCNT /水分散液の濃度は100mg / L、蒸発速度は9〜21μL / minの範囲で変化し、温度は80°Cでした。溶媒の蒸発温度を制御することにより、BNT / HfO 2 の固液-蒸気界面に明確な縞模様が形成されました。 / Si基板。次に、マスクプレートを使用したイオンビームスパッタリングによって、Ptソース/ドレイン電極をSWCNT / BNT上に堆積させた。金属製マスクプレートの総面積は1cm 2 、およびソースとドレインの領域は両方とも4.5 mm 2 。チャネル長( L )と幅( W )のFeFETはそれぞれ200μmと1500μmです。製造されたSWCNT-FeFETに続いて、500°Cで2時間のポストアニーリングにより、ソース/ドレイン電極とSWCNT間の接触が改善されます。報告されているように、CNTネットワークには金属ナノチューブと半導体ナノチューブの両方が含まれています。 CNTネットワークは大きなゲート電圧を印加することによって処理されました。金属SWCNTナノチューブはほぼアブレーションされ、半導体SWCNTナノチューブは負荷電流によって残りました[18]。比較するために、SWCNT / SiO 2 -FETは同じ方法と条件で製造されました。 MWCNTs / BNT-FETも、初期の研究[9]で説明されている方法で製造されました。 FeFETの特性は、Keithley4200パラメーターアナライザーを使用して測定しました。 FeFETのヒステリシスループと分極は、RT PrecisionWorkstation強誘電体アナライザを使用して測定されました。
結果と考察
図2は、ストライプパターン化されたSWCNTの典型的なSEM画像を示しています。図2aに、ミクロン幅の縞模様の規則的で整列したSWCNTを示します。隆起したストライプと明るいストライプはSWCNTストライプであり、図2bのストライプの拡大画像に示されているように、SWCNTが密に詰まっています。沈んだ灰色の縞模様は、むき出しのBNT / HfO 2 に対応します。 SWCNTミクロン幅のストライプ間のスペースにある/ Si基板。 SWCNT前駆体溶液の濃度は蒸発とともに増加し、傾斜した縞の幅はSWCNT /水液レベルの低下とともにわずかに増加します。 BNT / HfO 2 Si基板上のフィルムとBNTフィルムを図2c、dに示します。 BNT / HfO 2 の表面がわかります フィルムは多くの結晶粒と細孔で構成されており、BNTフィルムよりも粗さが大きいことを示しています。図2eは、 P を示しています - V BNTおよびBNT / HfO 2 のヒステリシスループ それぞれフィルム。 BNT / HfO 2 のヒステリシスループの分極 フィルムは同じ電圧のBNTフィルムよりも大きいです。 HfO 2 BNT / HfO 2 の電圧の一部を共有するレイヤー フィルムの場合、BNTフィルムはSi基板上に成長したBNTよりも優れた偏光値を示します。これは、HfO 2 で成長したBNT膜が原因です。 層は、Si基板上に直接成長させたBNT膜よりも拡散欠陥濃度が低くなっています。

a SWCNT / BNT / HfO 2 でパターン化されたSWCNTストライプのSEM顕微鏡写真 -FeFET。 b SWCNTのグリッド構造。 c BNT / HfO 2 の表面のSEM画像 映画。 d BNTフィルムの表面のSEM画像。 e BNTおよびBNT / HfO 2 のヒステリシスループ 映画
図3に、出力特性( I )を示します。 DS -V DS )SWCNT / BNT / HfO 2 の曲線 -FeFETおよびSWCNT / BNT-FeFET。 SWCNT / BNT / HfO 2 -FeFETおよびSWCNT / BNT-FeFETは典型的な p を示しています -チャネルトランジスタの特性と低ソース-ドレイン電圧での飽和ソース-ドレイン電流。それらのチャネル長( L )は200μmです。 SWCNTのミクロン幅のストライプパターンにより、SWCNT / BNT / HfO 2 の「オン」電流とチャネルコンダクタンス -FeFETとSWCNT / BNT-FeFETは両方とも3.8×10 -2 に達します A、3.6×10 −2 Aおよび9.5×10 -3 S、9×10 -3 V でのS GS =− 4Vおよび V DS =4V。ただし、SWCNT / BNT / HfO 2 -FeFETはSWCNT / BNT-FeFETよりも低いオフ状態電流を示し、SWCNT / BNT-FeFETは V で深刻なリーク電流現象を示します。 GS =0 V 。 これは、HfO 2 が原因です。 層は欠陥の拡散を効果的にブロックします。

SWCNT / BNT / HfO 2 の出力特性曲線 -FeFET(letf)およびSWCNT / BNT-FeFET(右)
伝達特性( I D - V G )SWCNT / BNT / HfO 2 の -FeFETおよびSWCNT / BNT- L を使用したFeFET =200μmおよび V DS =0.6Vを図4に示します。しきい値電圧( V th )SWCNT / BNT / HfO 2 の -FeFETおよびSWCNT / BNT-FeFETは V です th =0.2Vおよび V th =0.8 V( I の線形フィットによる) D ) 1/2 vs V GS 飽和領域で動作するトランジスタの曲線。チャネルモビリティ(μ 土 )は( I に基づいて計算されます DS ) 1/2 vs V GS 曲線と電界効果トランジスタの飽和領域式[19]、
$$ {I} _ {\ mathrm {DS}} =\ left(\ frac {\ varepsilon_0 {\ varepsilon} _r {\ mu} _ {\ mathrm {sat}} W} {t _ {\ mathrm {ins}} 2L} \ right){\ left({V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}} \ right)} ^ 2 for \ kern0.5em {V_ { \ mathrm {DS}}} ^ {{} ^ 3} {V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}}、$$ここで、ε r は比誘電率であり、 t ins BNTの厚さです。比誘電率(ε r )のBNTフィルムは350で、HP4156パラメータアナライザによって1MHzで測定されます。 μ 土 SWCNT / BNT / HfO 2 の -FeFETおよびSWCNT / BNT-FeFETは395および300cm 2 /Vs。図5は、 I を示しています DS – V GS 製造されたSWCNT / BNT / HfO 2 の対数伝達曲線 -FeFET、SWCNT / BNT-FeFET、およびSWCNT / SiO 2 / HfO 2 -ダブルスイープモードのFET。ゲート電圧掃引は V で実行されました DS 0.6Vおよび V GS − の範囲 7〜4 V、 − 6〜3 V、および − 4対1V。 I DS SWCNT / BNT / HfO 2 のオン/オフ比 -FeFET、SWCNT / BNT-FeFET、およびSWCNT / SiO 2 / HfO 2 -FETは2×10 5 、2×10 4 、および2.3×10 2 V で GS − の範囲 7〜4V。 I DS SWCNT / BNT / HfO 2 のオン/オフ比 -FeFETは、MWCNT / BNT-FeFET [9]およびSWCNT / BNT-FeFETよりも高くなっています。 HfO 2 欠陥制御層は、欠陥の拡散を効果的にブロックするSWCNT-FeFETに埋め込まれました。 I の場合 DS - V GS 特性として、BNTフィルムの強誘電分極反転により時計回りのヒステリシスループが得られ、SWCNT / BNT / HfO 2 のメモリウィンドウ(MW)幅が得られました。 -FeFETとSWCNT / BNT-FeFETは約4.2と4.1Vであり、チャネル層としてCNTネットワークを使用したCNT / PZT-FeFET(1.1 V)よりも大きくなっています[20]。 MWが大きいほど、このFeFETシステムの誘電体結合が良好であることを示しています。図4cから、得られたSWCNT / SiO 2 のウィンドウ幅を確認できます。 / HfO 2 -FETは約1Vですが、これは主にSWCNTの欠陥密度が原因です[21]。これらの結果は、強誘電体FeFETのメモリウィンドウヒステリシス(4.2 V)が、BNT分極とSWCNT欠陥の密度の両方によって引き起こされていることを示唆しています。
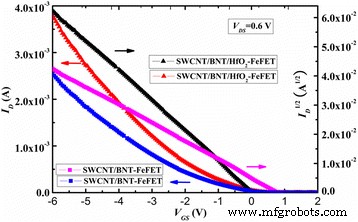
線形伝達特性曲線と適合した I DS 1/2 - V G V での曲線 DS =SWCNT / BNT / HfO 2 のストライプパターンの場合は0.6V -FeFETおよびSWCNT / BNT-FeFET

ストライプパターン化された a の対数伝達曲線 SWCNT / BNT / HfO 2 -FeFET、 b SWCNT / BNT-FeFET、および c SWCNT / SiO 2 / HfO 2 - V でのFET DS =0.6 V 。 矢印は反時計回りのヒステリシスループを示し、実線はメモリウィンドウの幅を示しています
図6aは、BNT / HfO 2 のリーク電流-電圧特性を示しています。 とBNTフィルム。ご覧のとおり、リーク電流は1.2×10 -9 です。 Aおよび1.5×10 -8 A for BNT / HfO 2 電圧が-3Vに達すると、それぞれおよびBNTフィルム。BNT/ HfO 2 の漏れ電流-電圧特性 とBNTフィルムは、 I をフィッティングすることによって比較のために研究されました - V データ。ショットキー接点の漏れ電流特性はLn( J )= b ( V + V bi * ) 1/4 [9、22、23]、およびBNT / HfO 2 の対応するプロット 図6bに、0〜3.8Vの電圧範囲のBNTフィルムを示します。内蔵電圧 V bi * と勾配 b 式のは、実験 I-V をフィッティングすることで得られます。 データ。計算された空間電荷密度 N eff 深いトラッピングセンターと酸素空孔からなる[22]は、約2.132×10 17 です。 cm -3 および1.438×10 19 cm -3 BNT / HfO 2 の場合 それぞれBNTフィルム。界面バリア高さの式[24]によれば、Si基板上に堆積されたBNT膜はn型半導体であることが示されています。これは、HfO 2 の効果と一致しています。 I のオフ電流を減らすことについて D - V G 図4a、bの曲線。これは、n型BNTが電子を生成するため、負の電圧でのオフ電流が増加するためです。 BNT膜の伝導はバルク制御メカニズムを示しており、これはさらに、n型BNTが主に伝導性の欠陥または不純物によって引き起こされることを意味します[9、22]。
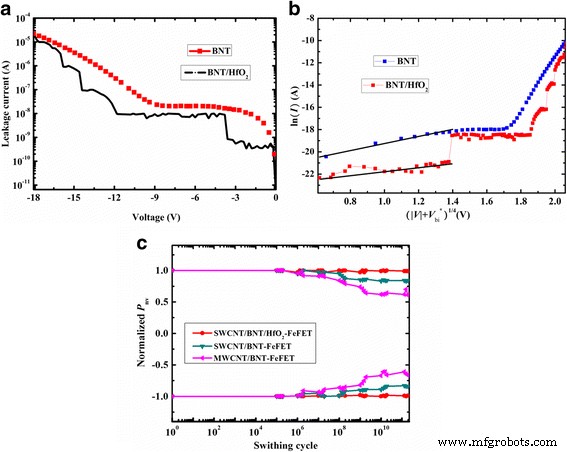
a BNT / HfO 2 の漏れ電流-電圧特性 とBNTフィルム。 b BNT / HfO 2 の漏れ電流-電圧特性のフィッティング曲線 とBNTフィルム。 c SWCNT / BNT / HfO 2 の疲労耐久性能 -FeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFET
図6cは、SWCNT / BNT / HfO 2 の疲労耐久性能を示しています。 -FeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFET、 V で100KHzのバイポーラパルス GS − の範囲 7〜4V。FeFETの疲労耐久性能は、切り替えサイクルを繰り返すと切り替え可能な分極が失われることで示されます。不揮発性分極の値( P nv )は、式 P によって得られます。 nv = P r * − P r ^ 次に、 P で正規化します nv / P r0 * [25]、ここで P r * はFeFETの2倍の残留分極、 P r ^ は次のパルス後の分極の喪失であり、 P r0 * はFeFETの2倍の初期残留分極です。正規化された P の部分的な損失 nv 10 11 以降 読み取り/書き込みスイッチングサイクルはFeFETで観察され、SWCNT / BNT / HfO 2 では約3、10、および25%です。 -それぞれ、FeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFET。 BNTが下部電極Si上で直接成長する場合、SWCNT / BNT-FeFETの疲労性能は、粒界を介したBNTとSi基板間の拡散のために非常に悪くなります[12、13、14]。これらの結果は、HfO 2 層はSi基板の拡散を効果的にブロックし、イオン不純物を低減するため、優れた疲労耐久性能が得られます。
NVRAMアプリケーションに対するFeFETのデバイスの信頼性を評価するために、データの保持を調べました。図7は、SWCNT / BNT / HfO 2 のソース-ドレイン電流保持曲線を示しています。 -室温でのFeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFET。 V の電圧パルス GS =− 4Vおよび V GS = V で1V DS =1 Vがゲート電極とソースドレイン電極に印加され、FeFETの電圧がそれぞれオフ状態またはオン状態に切り替わります。測定されたオン/オフ状態の電流比は、ほぼ3×10 4 です。 、7×10 3 、および6×10 2 SWCNT / BNT / HfO 2 の場合 -10 6 後のFeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFET s、それぞれ。 1×10 6 の保持時間の後、オン/オフ状態の電流比(3.2%)に大きな損失はありません。 ■SWCNT / BNT / HfO 2 の場合 -FeFET。曲線を10 8 に外挿する ■SWCNT / BNT / HfO 2 の場合 -FeFET、SWCNT / BNT-FeFET、およびMWCNT / BNT-FeFETの場合、オン/オフ状態の電流比はほぼ1.9×10 4 です。 、3×10 3 、および2×10 2 、 それぞれ。 SWCNT / BNT / HfO 2 のオン/オフ状態の比率 -FeFETはまだメモリの機能に対して十分に高く、現在のメモリデバイスの望ましい保持特性を示しています。保持はゲートリーク電流の影響を受けます[26、27]。長い保持時間は、HfO 2 を示します 欠陥制御層は、オフ状態電流とゲートリーク電流を効果的に低減し、オン/オフ電流比を安定させます。さらに、表1で強誘電体ベースのFETとさまざまなCNTを比較したところ、製造されたSWCNT / BNT / HfO 2 -この研究のFeFETは、高いオン/オフ電流比、優れた疲労耐久性能、およびデータ保持を提供できます。
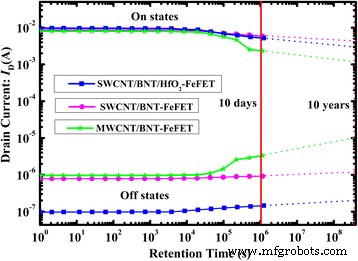
SWCNT / BNT / HfO 2 の保持特性 -室温でのFeFET、SWCNT / BNT-FeFETおよびMWCNT / BNT-FeFET
欠陥がデバイスの物理的特性にどのように影響するかをさらに理解するために、 P - E ヒステリシスループと I DS - V GS SWCNT / BNT / HfO 2 の曲線 -FeFETおよびSWCNT / BNT-FeFETは、以前のモデル[12、28]を使用して、欠陥によって引き起こされる非対称電荷を考慮してシミュレートされました。 P をシミュレートするために、欠陥によって引き起こされる非対称電荷が考慮されます - E ヒステリシスループと I DS - V GS BNTの曲線であり、対称電荷はBNT / HfO 2 のそれをシミュレートすると考えられます。 。シミュレーション結果を図8a、bに示します。これは、図8a、図8a、bの実験結果と類似しています。それぞれ2eと5a、b。シミュレーション結果は、HfO 2 を示しています 層は、欠陥によって引き起こされる強誘電体膜の非対称電荷を効果的に低減し、オフ状態電流をさらに増加させます。したがって、強誘電体薄膜の欠陥は、HfO 2 によって効果的に制御されていることが実証できます。 欠陥制御層。
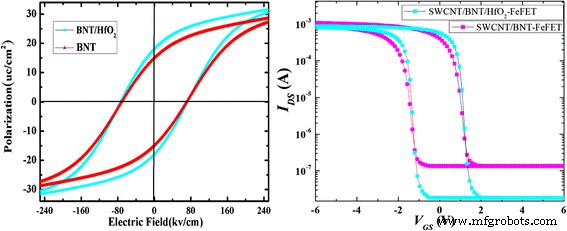
a のシミュレーション P - E BNTおよびBNT / HfO 2 のヒステリシスループ 映画と b 私 DS - V GS SWCNT / BNT / HfO 2 の曲線 -FeFETおよびSWCNT / BNT-FeFET
結論
要約すると、HfO 2 の効果 強誘電体薄膜の欠陥をHfO 2 > 欠陥制御層として。 HfO 2 の欠陥制御層が薄いため 、製造されたSWCNT / BNT / HfO 2 -FeFETは1.2×10 -9 の低いリーク電流を示します A電圧が− 3 Vに達すると、2×10 5 の大きなオン/オフ電流比 、 V th 0.2 V、およびμ 395 cm 2 /Vs。さらに、SWCNT / BNT / HfO 2 -FeFETは、薄いHfO 2 に起因する、優れた疲労耐久性能と優れたデータ保持を示しました。 欠陥制御層。ヒステリシスループ P - E および私 DS - V GS SWCNT / BNT / HfO 2 の曲線 -FeFETおよびSWCNT / BNT-FeFETをシミュレートして、欠陥がデバイスの物理的特性にどのように影響するかを理解しました。シミュレーション結果はさらに、SWCNT / BNT / HfO 2 で非対称電荷を低減できることを示しました。 -HfO 2 によるFeFET 欠陥を管理するため。
略語
- BNT:
-
(Bi、Nd) 4 Ti 3 O 12
- FeFET:
-
強誘電性電界効果トランジスタ
- MWCNT:
-
多層CNT
- PLD:
-
パルスレーザー堆積
- SWCNT:
-
単層カーボンナノチューブ
ナノマテリアル
- 最近の論文では、カーボンナノチューブのスケーラビリティ、統合のブレークスルーについて詳しく説明しています
- カーボンナノチューブヤーン、マッスル、透明シート
- 誘電体メタ表面を介した帯域幅の拡大による完全なテラヘルツ分極制御
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- 低抵抗Auオーミックコンタクトを備えた多層SnSeナノフレーク電界効果トランジスタ
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 超高密度の整列した単層カーボンナノチューブフィルムのための加熱増強誘電泳動
- スーパーキャパシターの電極材料としての階層的多孔質構造を持つ単分散カーボンナノスフェア
- ポロシメトリー特性評価によるニートおよび複合カーボンナノチューブ材料の設計
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- 垂直に整列した単層カーボンナノチューブの成長に及ぼすアルミナ支持層の強化された熱安定性の効果とナノ濾過膜におけるそれらの応用



