二酸化炭素を使用したSiO2の低温プラズマ強化原子層堆積
要約
この作業では、高品質のSiO 2 の成長の成功を報告します。 湿気/酸素に敏感な材料と互換性のある酸化剤を使用した低温プラズマ化学原子層堆積による膜。 SiO 2 フィルムは、CO 2 を使用して90°Cで成長させました。 プロセス前駆体としてのビス(第三級ブチルアミノ)シラン。 SiO 2 の成長、化学組成、密度、光学特性、および残留応力 フィルムが調査された。 SiO 2 サイクルあたりの飽和成長が〜1.15Å /サイクルのフィルムは、〜2.1 g / cm 3 の密度を示しました。 、632 nmの波長で〜1.46の屈折率、および〜30MPaの低い引張残留応力。さらに、フィルムは、〜2.4および〜0.17atのバルク濃度で低い不純物レベルを示しました。水素と窒素の場合はそれぞれ%ですが、炭素含有量は飛行時間型弾性反跳検出分析の測定限界を下回っています。これらの結果は、CO 2 は、プラズマ化学気相堆積プロセスに関連する湿気/酸素に敏感な材料の有望な酸化前駆体です。
背景
SiO 2 は、マイクロエレクトロニクス[1、2]、微小電気機械システム[3、4]、太陽光発電[5、6]、光学[7、8]などのアプリケーションに広く使用されている材料です。 SiO 2 薄膜は、熱酸化、プラズマ化学気相成長法(PECVD)、物理蒸着法(PVD)などのいくつかの方法で成長させることができます。原子層堆積法(ALD)は、正確な膜厚制御と高い均一性を組み合わせるという優れた利点を提供します。 、および適合性[9,10,11]。
さまざまなSi前駆体(クロロシランまたはアミノシラン)と酸化剤(H 2 )を使用した多くのALDプロセス O、H 2 O 2 、またはO 3 )、SiO 2 の成長のために開発されました 。これらのプロセスは通常、比較的高温(> 150°C)を必要とします[12、13、14、15、16]。有機材料、生物学的材料、高分子材料などの感熱材料と互換性のあるプロセスでは、触媒ALD [17、18、19]およびプラズマ化学気相堆積(PEALD)[9、20、21、22]が次のように使用されています。プロセス温度が100°C未満の効果的なソリューション。ただし、一般的に使用されるH 2 OとO 2 ベースの酸化剤は、湿気/酸素に敏感な材料の場合、材料の劣化につながる可能性があります。 H 2 との比較 OとO 2 、低温で、CO 2 化学的に反応しません。この場合、CO 2 を使用します 酸化剤として、不必要な酸化を回避することにより、湿気/酸素に敏感な材料の劣化を最小限に抑えることができます。さらに、CO 2 King [23]は、PEALD SiO 2 の成長のための実行可能な酸化剤であると報告しました。 SiH 4 を使用する場合のフィルム Si前駆体として。ただし、これらのPEALDプロセスの成長温度は250〜400°Cの範囲でしたが、高温に敏感な材料とは互換性がありません。
この作業では、CO 2 の開発について報告します。 SiO 2 のベースのPEALDプロセス 90°Cのフィルム。プロセスパラメータ(前駆体パルス/パージ時間およびプラズマパワー)への膜成長の依存性を調査します。また、フィルムの化学組成、構造的および光学的特性、および残留応力分析についても報告します。
メソッド
フィルムの準備
PEALD SiO 2 CO 2 を使用して、90°CでSi(100)およびサファイア基板上に膜を成長させました。 (99.5%、Air Products)プラズマを酸素源として、ビス(ターシャリーブチルアミノ)シラン(BTBAS)(97%、Strem Chemicals)をSi前駆体として[22]。プロセスは、容量結合された13.56 MHzの無線周波数(rf)で動作するソースを使用して、リモートプラズマシステムを備えたBeneq TFS200リアクターで実行されました。 N 2 (99.999%、AGA)は、600 sccmの反応器通過流量でキャリアおよびパージガスとして使用され、混合ガスはN 2 (200 sccm)およびCO 2 (75 sccm)がプラズマシステムを流れました。この研究で選択されたプラズマパワーは、プラズマシステムの安定性に基づいていました。 BTBASのソース温度は21°CおよびN 2 に設定されました。 ブースターはプリカーサーパルス中に適用されました。プロセスパラメータの詳細を表1に示します。PEALDプロセス中、反応器の圧力は約1hPaでした。
<図>フィルムの特性評価
PEALD SiO 2 の厚さ フィルムは、HeNeレーザーを使用したSENTECH SE400advエリプソメーターで、波長632.8 nm、入射角70°で測定されました。サイクルあたりの成長(GPC)は、得られた膜厚をALDサイクル数で割って計算しました。 GPCの偏差は、膜厚の不均一性に基づいていました。
化学組成は、グロー放電発光分光法(GDOES)、飛行時間弾性反跳検出分析(TOF-ERDA)、および減衰全反射フーリエ変換赤外分光法(ATR-FTIR)によって測定されました。 GDOES測定は、Horiba GD-Profiler 2で実行されました。直径4mmのアノードと、パルスモードで35WのRF電力が使用されました。元素強度は、参考文献に記載されているように、フィルムの厚さ全体にわたって積分された値として報告されました。 [22]。 TOF-ERDA測定では、5MVタンデム加速器から得られた40MeVエネルギーのBrイオンが測定されたサンプルに向けられました。検出角度は40°でした。 ATR-FTIR測定は、内部反射要素としてダイヤモンド結晶を備えたThermo Electron Corporation Nicolet 380ATR-FTIR分光計を使用して行われました。手順には、Si基板からのバックグラウンド収集とサンプルからのデータ収集が含まれていました。 2cm -1 800〜4000 cm -1 を超える解像度 波数範囲が使用されました。
X線反射率(XRR)分析は、フィリップスX’PertPro回折計でCu-K α1を使用して実行されました。 放射線。フィルム密度は、自社開発のフィッティングソフトウェアを使用して測定データから取得しました[24]。シリコン基板とPEALDSiO 2 の間の界面酸化物層 フィルムは、XRRフィッティングレイヤーモデルの一部としてシミュレートされました。 PerkinElmer Lambda 900分光計を使用して、PEALD SiO 2 の透過率スペクトル フィルムは、サファイア基板上での成長に続いて、360〜800nmの波長範囲で記録されました。屈折率( n )および吸光係数( k )透過率スペクトルからコーシーフィッティングで決定されました。良好なフィッティング精度を確保するために、この測定では、厚さ150nmのSiO 2 フィルムはサファイア基板上で成長しました。
厚さ50nmのPEALDSiO 2 の残留応力 フィルムは、ウェーハ曲率法[25]とストーニーの方程式[26]を使用して決定されました。 TOHO FLX-2320-Sツールを使用して、膜成長の前後にウェーハの曲率を測定しました。ウェーハは、120mmのスキャン長を使用して2軸スキャンされました。測定結果は、最大の測定の不確かさで提示されました[25]。
結果と考察
フィルムの成長
SiO 2 の依存性 BTBASパルスのフィルムGPCとパージ時間は、180 Wの固定プラズマ電力、CO 2 を使用した酸化ステップ中に調査されました。 プラズマ曝露時間は3秒、CO 2 2秒のプラズマパージ時間。図1aとbは、それぞれBTBASパルスとパージ時間の関数としてのGPC値を示しています。パルス時間依存性については、BTBASパージ時間を3秒に設定し、パージ時間依存性については、BTBASパルス時間を0.3秒に設定しました。図1aに示すように、最低のGPCは0.05秒のBTBASパルスで得られますが、0.1秒のパルス時間は約1.15Å/サイクルのGPCで自己制限的な成長に到達するのに十分であることがわかります。さらに、0.3秒の固定BTBASパルスを使用し、パージ時間を3秒から0.5秒に短縮した場合(図1b)、GPCの変化は観察されません。これは、BTBASの適用された短いパージ時間がCVDコンポーネントを防ぐのに十分であることを示しています。ただし、パージ時間の増加に伴い、膜厚の均一性が向上したことに注意してください。

PEALD SiO 2 のGPC BTBAS a の関数としてSi基板上に成長した膜 パルス時間と b パージ時間。印加プラズマパワーは180W
SiO 2 酸化ステップ中の成長は、固定BTBASパルスとそれぞれ0.3秒と3秒のパージ時間を使用して調査されました。図2aおよびbは、PEALD SiO 2 のGPCを示しています。 CO 2 の関数としてSiウェーハ上に成長した膜 それぞれプラズマ曝露とパージ時間。プラズマ曝露時間の影響の研究中に、50、180、および300Wのプラズマ出力が適用されました。一般的な観察として、90°Cでの飽和GPCと見なすことができる1.15Å/サイクルの最高のGPC値[27]が、すべてのプラズマ出力条件で観察されます。使用電力に関係なく、プラズマ曝露時間が1秒のプロセスの場合、1.15Å/サイクル未満のGPC値は、不完全な膜成長を示唆します。これは、1秒のプラズマ曝露時間が十分な量のOラジカルを生成するのに十分な長さではないことを示しています。完全な表面反応に必要なこれらのラジカルは、CO 2 から生じます。 血漿解離反応[28]。 50 Wのプラズマ出力の場合、GPCはCO 2 の増加とともに増加することがわかります。 6 sまでのプラズマ曝露時間。その後、GPCは1.15Å/サイクルの飽和値に達します。この値は、15秒までの露光時間の間一定のままです。ただし、より高い電力(180および300 W)で成長した膜の場合、1〜6秒のプラズマ曝露時間でGPCの逆V傾向が観察されます。以前に報告されたPEALDフィルムの成長段階[27]と、この作業で得られた1.15Å/サイクルの最高GPCによると、成長飽和は、プラズマ曝露時間3秒で180および300Wで達成されます。プラズマ曝露時間が6秒の場合、GPCの低下は、Al 2 のPEALDについて以前に報告したものと同様に、フィルムの緻密化の結果である可能性があります。 O 3 薄膜[27]。これらの2つの曲線(GPCのCO 2 への依存性を示す)に注意してください。 180および300Wのプラズマ曝露時間)は完全に重複しています。観察されたGPC曲線の重なりは、SiO 2 の成長を示唆しています。 180および300Wのフィルムには、高出力プラズマによって生成される同程度の量のイオンおよびラジカルフラックスに関連する可能性のある同一のメカニズムが含まれます[29]。ハイパワーの場合と比較して、SiO 2 の成長挙動 50 Wのプラズマパワーを使用する薄膜は、フィルムの緻密化が発生しないため、異なります。これは、50Wの低電力に起因する比較的低いイオンおよびラジカルフラックスが原因である可能性が最も高いです[29]。

PEALD SiO 2 のGPC CO 2 の関数としてSi基板上に成長した膜 プラズマ a 50、180、300 Wのさまざまなプラズマパワーでの曝露時間、および b 180Wのプラズマパワーでのパージ時間
CO 2 の効果 GPCでのプラズマパージ時間は図2bに示されています。 BTBASのパージ時間依存性の場合と同様に、CO 2 の場合、GPC値は一定のままであることがわかります。 パージ時間は0.5〜3秒の間で変化します。したがって、両方の前駆体に適用されたパージ時間は、SiO 2 のGPCにほとんど影響を与えないと結論付けることができます。 薄膜。これは、以前に報告されたSAM.24、BTBASの1種類のアミノシラン、およびO 2 を使用したPEALDプロセスとは異なります。 プラズマ[9]では、パージ時間が2秒より短いパージステップが膜の成長に大きな影響を与えることがわかりました。ここで、適用された前駆体パージ時間とGPCの間の独立性は、クロスフローを使用した反応チャンバー設計から部分的に利益を得る可能性のある残留前駆体と副生成物の効果的な除去に割り当てることができます。このような構成により、前駆体パルス間のガス交換時間が比較的短くなります。それにもかかわらず、前駆体の粘着性を排除することはできません。図2aに示す結果に基づいて、0.3 s / 3sのBTBASパルス/パージ時間とCO 2 を使用します。 プラズマ曝露/パージ時間は3s / 2 sで、飽和成長中の最高堆積速度は50 nm / hです。これは、高いプラズマパワーを適用し、0.1 s / 0.5sのBTBASパルス/パージ時間とCO 2 を使用することを意味します。 3 s / 0.5 sのプラズマ曝露/パージ時間、最大100 nm / hの堆積速度が達成可能です。
フィルムのプロパティ
SiO 2 の密度 フィルムはXRRによって研究され、結果は図3に示されています。測定されたサンプルは、180 Wのプラズマパワー、0.3 sのBTBASパルス時間、3のBTBASパージ時間でさまざまなプラズマ曝露時間を使用してSi基板上で成長しました。 s、およびCO 2 2秒のプラズマパージ時間。研究されたサンプルは、プラズマ曝露時間がそれぞれ1、3、および6秒の場合に「SiO1」、「SiO3」、および「SiO6」とラベル付けされます。値は測定誤差範囲内ですが、最低値と最高平均値はそれぞれ「SiO1」と「SiO6」で示され、プラズマ曝露時間の増加とともに膜密度がわずかに増加することを示唆しています。これは、180Wのプラズマパワーと6sの露光時間でのプロセス中のフィルム緻密化の仮説を支持します。飽和成長の場合、2.11 g / cm 3 の膜密度ですが O 2 の以前の研究で報告された値とよく一致しています ベースのPEALDSiO 2 成長温度が50〜300°Cの市販のALDリアクターを使用したフィルム[9、21、30]は、値(2.3 g / cm 3 )よりも低くなっています。 )PEALD SiO 2 を示したKingによって報告されました 改良型PECVDリアクターで400°Cで処理[23]。

SiO 2 の密度 プラズマ曝露時間1、3、および6秒で成長した膜
PEALD SiO 2 の化学組成 GDOESによって測定されました。測定値は組成深度プロファイリング用に較正されていないため、つまり元素依存の放出率は考慮されていないため、同じ元素の強度のみを異なるサンプル間で比較でき、異なる元素間の比較はできません。したがって、この場合、GDOES測定は、化学組成に関するかなり定性的な情報を提供します。検出された元素Si、O、H、N、Cを図4に示します。図に示すように、「SiO1」のHの強度は他のサンプルよりもわずかに低くなっていますが、誤差を考慮に入れています。マージン、Si、O、およびH含有量に対するプラズマ曝露時間の有意な影響は観察されません。この発見は、PEALD SiO 2 に関する以前の研究で報告されたプラズマパワー効果に類似しています。 BTBASとO 2 を使用して成長 プラズマ[22]。 N含有量の場合、「SiO1」と「SiO3」の強度はかなり一定ですが、「SiO6」の強度は低く測定されます。これは、膜の緻密化の際に、N不純物の除去がより効果的であることを示唆しています。サンプルの成長条件に関係なく、測定されたすべてのサンプルは、C含有量に対して同じ強度を示すことに注意してください。

SiO 2 の定性的な化学組成 GDOESによって測定された1、3、および6秒のプラズマ曝露時間で成長した膜。測定の精度は±15%であり、この作業では強度の元素間比較はできません(キャリブレーション係数は利用できません)
フィルムの化学組成のさらなる評価は、TOF-ERDAおよびATR-FTIR測定を使用して実行されました。飽和成長は通常ALDプロセスで対象とされることを考慮して、以下では、プラズマ出力180 W、BTBASパルス時間0.3秒、BTBASパージ時間3秒、COで成長したサンプルに焦点を当てて調査します。 2 プラズマ曝露時間は3秒、CO 2 2秒のプラズマパージ時間。 TOF-ERDAの深度プロファイルと元素組成を図5aに示します。膜の深さプロファイルに示されているOの下り勾配は、Si基板の影響によって引き起こされることに注意してください。これは、SiO 2 のTOF-ERDAの深さ分解能と相関関係があります。 / Siサンプル構造。元素組成分析では、基質効果が考慮されています。調査したサンプルは、バルク濃度が〜2.4および〜0.17atの低不純物レベルを示しています。水素と窒素の場合はそれぞれ%ですが、フィルム全体の総C濃度は、TOF-ERDAの測定限界を下回っています。深度プロファイルの情報に基づいて、炭素数は主にフィルム表面から収集されます。したがって、GDOES測定によって検出されて図4に示されているC含有量は、保管中またはテスト環境からのサンプル汚染が原因である可能性があると推測されます。バルクよりも表面のH濃度が高いことも注目に値します。さらに、フィルムは、Si / O比が約0.48で、わずかに酸素が豊富な組成を持っていることがわかります。この結果は、Dingemansらによって報告された結果と一致しています。 PEALD SiO 2 の場合 SAM.24とO 2 を使用して成長 100〜300°Cの温度範囲のプラズマ[9]。この酸素が豊富な組成は、フィルムに残った残留–OH種の寄与が原因である可能性が最も高いです。
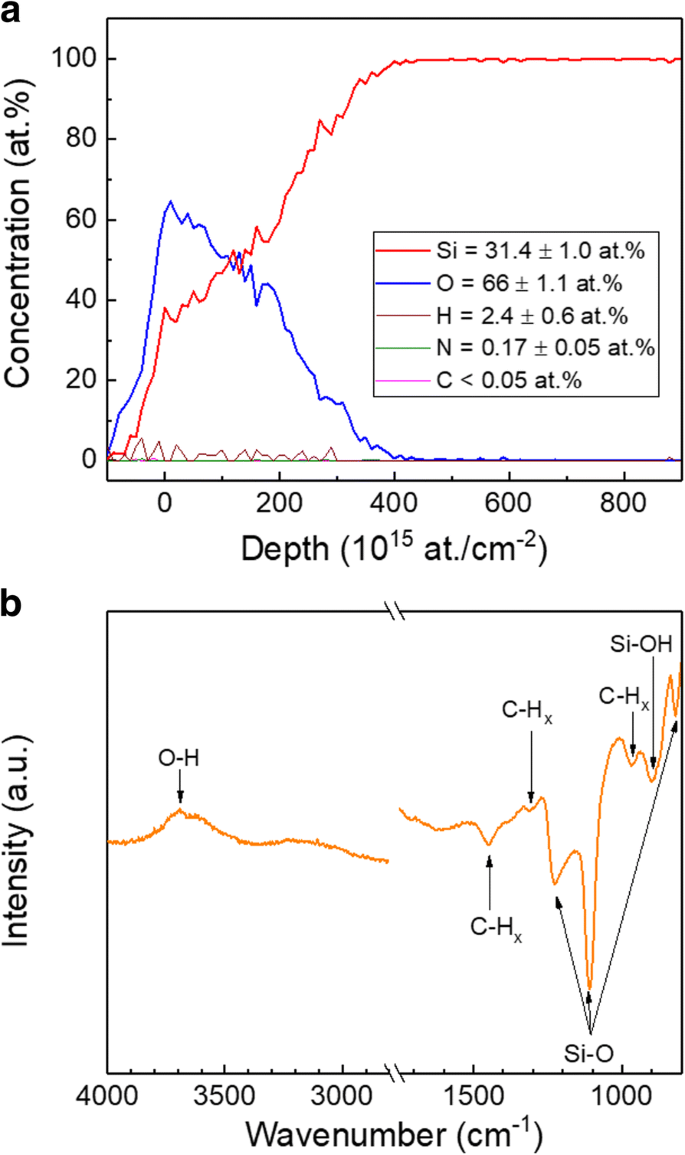
a TOF-ERDA深度プロファイルと b SiO 2 のATR-FTIR透過スペクトル 映画。目標とする膜厚は50nmでした
図5bは、同じサンプルで測定されたATR-FTIRスペクトルを示しています。 3200〜3800 cm -1 にあるブロードバンド機能 領域は、Si–OHと水のO-Hストレッチに割り当てることができますが、前者の可能性は低くなります[14、31]。 Si–OHストレッチ[31]にも典型的な別のバンドが、〜900 cm -1 に見られます。 。上記のTOF-ERDAの結果と一致する–OH基の存在は、– NH の燃焼を伴う燃焼のような反応を意味します。 t Bu 配位子と–OH基の形成が、酸化ステップを支配します。同様のメカニズムが、Al 2 の成長中に発生することが以前に報告されています。 O 3 トリメチルアルミニウムとO 2 から プラズマ[32]およびSiO 2 SAM.24およびO 2 から プラズマ[9]。 –OH基に加えて、Si-O-Si結合の伸縮が1108および1226 cm -1 付近で検出されます。 [14、33]結合の曲がりは、約820 cm -1 で見られます。 [34、35]。文献値[14、34、35]と比較して、この作業でのSi-O-Si伸縮周波数は比較的高いことに注意してください。これは、膜の残留応力の影響を受ける可能性のあるSi-O結合長の変化が原因である可能性があります。十太郎佐賀ほか圧縮応力が高いほど、Si-O-Si伸縮周波数は低くなると報告されています[36]。 〜970、1301、および1450 cm -1 のバンド CH 3 に割り当てられます ロッキング、CH 3 対称変形、およびCH 2 それぞれはさみ[14]。 C-H表面グループの発見は、TOF-ERDAの結果と一致しており、おそらく表面汚染が原因です。
図5のデータと、以前に文献[37]で報告された結果に基づくと、最初のALD半サイクル中のプロセス表面反応は次のように考えることができます。
$$ \ mathrm {Si}-{\ mathrm {OH}} ^ {\ ast} + {\ mathrm {H}} _ 2 \ mathrm {Si} {\ left [{NH} ^ t Bu \ right]} _ 2 \ to \ mathrm {Si}-\ mathrm {O}-{\ mathrm {SiH}} _ 2 {{\ left [{NH} ^ t Bu \ right]} _ {2-x}} ^ {\ ast} + { xH} _2 {N} ^ t Bu $$(1)ここで、表面種はアスタリスク(*)で示されます。前半反応では、1つだけ( x =1)または両方( x =2)- NH t Bu 配位子は表面の–OH基と反応して t を形成します -ブチルアミン分子。
Oラジカルは、CO 2 中に生成される主な活性種です。 プラズマ解離反応[28]であり、その結果、酸化反応を支配します。したがって、後半のサイクルでは、提案されている燃焼のような反応[9]は次のとおりです。
$$ {\ mathrm {SiH}} _ 2 {{\ left [{NH} ^ t Bu \ right]} _ {2-x}} ^ {\ ast} + \ mathrm {O} \ to \ mathrm {Si} -{\ mathrm {OH}} ^ {\ ast} + {\ mathrm {H}} _ 2 \ mathrm {O} + {\ mathrm {CO}} _ 2 + \ mathrm {N}-\ mathrm {taining} \ \ mathrm {種} $$(2)実際の反応生成物の不確実性のために、提案された表面反応は意図的にバランスが取れていません。この反応を完全に決定できるようにするには、副産物ガス分析など、膜成長中のその場分析が必要になります。
SiO 2 の光学特性 サファイア基板上に成長した膜は、分光分析によって研究されました。図6aは、波長の関数として測定された透過率と、曲線のコーシーフィッティングを示しています。透過率スペクトルからシミュレートされた屈折率分散を図6bに示します。フィッティングから、波長632 nm、屈折率1.456、ゼロ k 値が得られました。この屈折率の値は、低温PEALD SiO 2 について以前に報告された値とよく一致しています。 [9、21]、高温プロセスで報告された値と比較して比較的低い[23]。実際、成長温度は、成長した膜の–OH濃度に影響を与え、したがってそれらの屈折率に影響を与えることが知られています[38]。さらに、得られたゼロ k 値は、フィルムの低炭素含有量と一致しています。 k 間の同様の相関関係 値とC濃度は、Putkonen etal。によって以前に報告されました。 SiO 2 の場合 ALDによって成長した薄膜[21]。
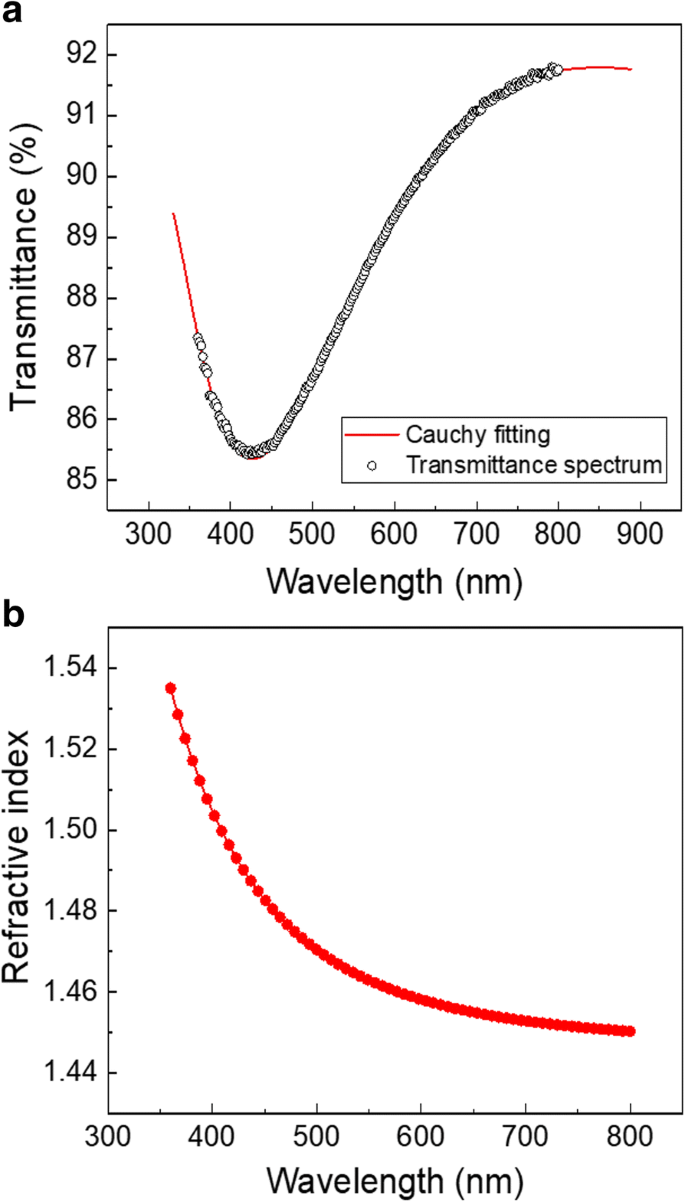
a 透過率スペクトルとコーシーフィッティングおよび b SiO 2 の屈折率分散 プラズマパワー180W、BTBASパルス時間0.3秒、BTBASパージ時間3秒、CO 2 のサファイア基板上に成長した膜 プラズマ曝露時間は3秒、CO 2 2秒のプラズマパージ時間。目標膜厚は150nmでした
ALDフィルムの残留応力は、熱応力と固有応力の寄与で構成されます。熱応力は、フィルムと基板の間の熱膨張の違いから生じます。固有応力は、前駆体、成長温度、およびALD法に応じて、膜の成長中に発生する内部応力として定義されます[30、39]。図7は、SiO 2 の残留応力を示しています。 成長温度の関数としてのフィルム。最高の応力値である150MPa(圧縮)[23]は、400°Cで成長したサンプルから得られました。ただし、この作業では、90°Cで30±10MPaの低い引張応力が得られます。 Putkonen etal。およびShestaevaetal。 SiO 2 の明確な依存性を示した 成長温度に対する膜応力[21、30]:温度が高いほど、圧縮応力が高くなります。熱応力の寄与は、高温で大きくなります。彼らはまた、低温PEALD SiO 2 のほぼ「ゼロ」の残留応力値を報告しました。 映画[21、30]。ここおよび文献で報告されている残留応力値を考慮すると、「ゼロ」に近い応力は、熱応力ではなく固有応力の結果である可能性が最も高いです。 PEALD SiO 2 の固有応力 フィルムは、プラズマ効果によって引き起こされる可能性があります。ただし、ガス流量、プロセス圧力、使用済み前駆体などの他の要因を除外することはできません[40]。

SiO 2 の残留応力 成長温度の関数としてのフィルム。私たちのサンプルは、180 Wのプラズマパワー、0.3 sのBTBASパルス時間、3 sのBTBASパージ時間、CO 2 で成長しました。 プラズマ曝露時間は3秒、CO 2 2秒のプラズマパージ時間。参考文献には、Putkonen etal。が含まれます。 [21]、Shestaeva等。 [30]、そしてキング[23]。サンプルの目標膜厚は50nmでした
結論
この作品は、CO 2 の可能性を示しています 低温PEALDSiO 2 を成長させるための酸化剤として 湿気/酸素に敏感な材料について。 SiO 2 不純物レベルが低く、引張残留応力が低い膜は、CO 2 を使用したPEALDによって90°Cで成長しました。 および前駆体としてのBTBAS。フィルムは、〜1.15Å /サイクルの飽和GPCと〜2.1 g / cm 3 の密度を示しました。 。この研究はまた、約4秒の非常に短いALDサイクル時間で膜の飽和成長に到達する可能性を示しています。これは、高スループット、したがって産業用アプリケーションにとって非常に望ましいことです。
略語
- ALD:
-
原子層堆積
- ATR-FTIR:
-
減衰全反射フーリエ変換赤外分光法
- BTBAS:
-
ビス(第三級ブチルアミノ)シラン
- GDOES:
-
グロー放電発光分光法
- GPC:
-
サイクルあたりの成長
- PEALD:
-
プラズマ強化原子層堆積
- PECVD:
-
プラズマ化学気相成長法
- PVD:
-
物理蒸着
- rf:
-
無線周波数
- TOF-ERDA:
-
飛行時間型弾性反跳検出分析
- XRR:
-
X線反射率
ナノマテリアル
- 原子スケールで画像化された海洋炭素
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- スタックカップカーボンナノファイバーの原子および電子構造を明らかにする
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- オーミック接触を形成するためのp-GaNへのAlドープZnOの2段階堆積
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- 固体二酸化炭素センサー
- 顕微鏡を使用した層の厚さの測定



