InAlAs中間層によるGaAsSbでキャップされたInAs量子ドットの光学特性の変更
要約
この作業では、複合In 0.15 でキャップされたInAs量子ドット(QD)の光学特性を調査します。 Al 0.85 As / GaAs 0.85 Sb 0.15 77 Kでの高分解能X線回折(HRXRD)およびフォトルミネッセンス(PL)分光法によるひずみ低減層(SRL)。ThinIn 0.15 Al 0.85 厚さ t のレイヤーとして =20Å、40Å、および60ÅがQDと60Åの厚さのGaAs 0.85 の間に挿入されました。 Sb 0.15 層。 GaAs 0.85 で観察されたタイプIIエミッション Sb 0.15 キャップされたInAsQDは、In 0.15 の挿入によって抑制されました。 Al 0.85 中間層として。さらに、発光波長は t の間ブルーシフトされました =20Åおよび t の赤方偏移 それぞれ、閉じ込めポテンシャルの増加とひずみの増加に起因する≥40Å。基底状態と励起状態のエネルギー分離は増加し、 t で106meVに達します。 GaAsSbSRLのみでキャップされたQDの64meVと比較して=60Å。さらに、In 0.15 の使用 Al 0.85 層が大幅に狭くなるにつれて、40Åおよび60Åの厚さのIn 0.15 のサンプルでは、QDスペクトル線幅が52から35meVに大幅に狭くなります。 Al 0.85 中間層として。
背景
過去数十年で、Stranski-Krastanov技術を使用して合成された自己組織化量子ドット(QD)が大きな注目を集めてきました。それらの光学的および電子的特性は、オプトエレクトロニクスデバイスでの潜在的な用途のために集中的に調査されてきました[1]。広く研究されているInAs / GaAs QDシステムは、活物質としてさまざまなオプトエレクトロニクスデバイスに採用されています。これらのナノ構造の成長中に、QDのサイズと形状に大きな変化がキャッピングプロセス中に発生します。このプロセスは非常に複雑であり、混合、分離、またはひずみが強化された拡散が含まれます[2]。純粋なGaAsキャッピング層を使用すると、QD放射が1300nm未満に制限されます。この問題を軽減するために、(Ga、In)(As、Sb、N)で作られたひずみ低減層が使用されています[2、3、4、5、6、7]。特に、三元GaAsSbは、Sb含有量を変更することによって[8、9]、Cバンドを超えて発光波長を拡張する能力によってタイプIまたはタイプIIに調整できるため、特に注目されています。 [10]。ただし、GaAsSbをひずみ低減層(SRL)として使用した場合、基本状態と励起状態のエネルギー差は60〜75meVに制限されます[11]。このエネルギー分離は、キャリアがQDから熱的に逃げるのを防ぎません。長いキャリア寿命を必要とするアプリケーションでは、InAs QDとGaAsSbの間に薄いバリアを挿入すると、QDとGaAsSb量子井戸(QW)の間のキャリア分離が増加するため、有益です。一例として、GaAs中間層が使用され、太陽電池の電力効率が23%向上しました[12]。 InAlAs層の使用は、放射再結合のタイプを設計するために興味深い場合があります。タイプII遷移の場合、InAlAsを挿入すると、キャリア寿命が長くなり[13]、基本状態と最初の励起状態の間のエネルギー分離が長くなります[14、15、16]。さらに、InAs QDとGaAsSbの間にInAlAs層を挿入すると、Inの偏析が減少し、InAsQDとGaAsSbSRLの間のInおよびGa原子の混合が抑制され、QDひずみがさらに減少することが期待されます[17]。 InAlAs / InGaAs複合SRLは、InAs QDをキャップするために使用されており、長波長発光と、104meVもの基本状態と励起状態の間の良好なエネルギー分離をもたらします[16、18]。
この論文では、In 0.15 を使用した場合の効果に関する最初の調査を報告します。 Al 0.85 InAs / GaAsの光学特性の中間層として 0.85 Sb 0.15 フォトルミネッセンス(PL)分光法による量子ドット。特に、発光波長の変化、発光の種類、スペクトル線幅、および基本状態と最初の励起状態の間のエネルギー分離が詳細に研究されました。
メソッド
本研究で調査したサンプルは、Veeco Gen20A分子線エピタキシーシステムのエピレディクォーター2インチp型GaAs(001)基板上で成長させました。バルブ付きクラッカーを使用してAs 2 を生成しました およびSb 2 二量体。 590°CでGaAsバッファ層を成長させた後、基板温度を約485°Cに下げて、公称2.5MLの厚さのInAs量子ドットを成長させました。 As 2 の下で少し休止した後 フラックス、複合In 0.15 Al 0.85 As / GaAsSb SRLを堆積させた直後に、同じ温度で厚さ5 nmのGaAsを成長させた後、成長温度を570°Cに上げて38nmのGaAsバリア層を成長させました。 GaAsSbの厚さは60Åに固定され、In 0.15 の厚さは Al 0.85 20から60Åまで変化しました。厚さ60ÅのGaAsSbSRLは、As 2 を使用して実現されました。 / Sb 2 参照サンプルのX線回折測定によって決定された15%のSb含有量を与えるフラックス比。 0.5ML / sの固定Ga成長速度がすべての層に使用されました。 In 0.15 のA、B、C、およびDとして示される4つのサンプルが成長しました。 Al 0.85 厚さとして t それぞれ0Å、20Å、40Å、60Åに設定されました。 Krijn [19]が使用した手順に基づいて、[20]のパラメーターを使用して、伝導帯と価電子帯の相対位置が推定され、成長した構造の概略図とそれに対応する帯図が図1に示されています。
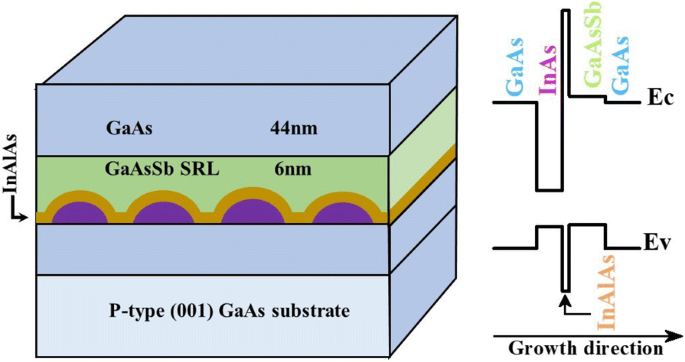
成長した構造の概略図と、複合In 0.15 でキャップされたInAsQDの対応するエネルギーバンド図 Al 0.85 / GaAs 0.85 として Sb 0.15 。 In 0.15 Al 0.85 厚さとして t =0Å、20Å、40Å、および60Å(サンプルA、B、C、およびDの場合)
サンプルの結晶品質は、分析用X線回折計を使用した高解像度X線回折(HRXRD)によって特徴づけられました。成長したサンプルの光学特性は、Vertex 80フーリエ変換赤外装置(Bruker Optics GmbH)に接続されたPLモジュールを使用し、熱電冷却された高利得InGaAs検出器を使用して77KでのPL分光法によって評価されました[21]。サンプルは、CW 532nmの固体レーザー光源で励起されました。
結果と考察
成長したサンプルの結晶品質は、004原子面からの回折パターンを記録することによるロッキングカーブスキャンを使用したHRXRDによって特徴づけられました。図2aは、InAlAsの厚さがそれぞれ0、20、40、60Åに対応するサンプルA、B、C、Dで得られた回折パターンを示しています。 InAs / InAlAs / GaAsSbに起因する明確な衛星ピークが観察され、成長したサンプルの良好な結晶品質を示しています。シミュレートされたX線ロッキングカーブは、実験データと一緒に図2aに含まれています。参照サンプルAで得られた平均Sb含有量は13%で、GaAsSbの厚さは66Åです。これらの値をサンプルB、C、およびDで使用して、In含有量とInAlAs中間層の厚さを求めました。シミュレーションでは、サンプルB、C、Dで平均In含有量が13.5%、InAlAs中間層の厚さがそれぞれ22Å、44Å、65Åであり、公称厚さに近いことが示されました。
>
a 高解像度ω / 2 θ サンプルA、B、C、およびDをスキャンします。 b 77Kおよび100mW励起で得られたサンプルAのPLスペクトル。 c 77KでのサンプルAの電力依存PL。 d P ex に対する最初の2つの光学遷移に対応するエネルギーピーク 1/3 77 K
参照サンプルAの光学特性は、最初に電力依存PL技術を使用して77Kで調査されました。図2bは、100mWの励起パワーのPLスペクトルを示しています。 PLスペクトルは、1004 meV、1068 meV、および1113 meVを中心とする3つのガウスピークに適合させることができます。これは、基本的な励起光学遷移として識別できます。基本状態と最初の励起状態の半値全幅(FWHM)は、それぞれ52と58meVです。観測された最初の2つの光学遷移の起源を理解するために、励起パワーを1から100 mWまで変化させ、図2cに示すように対応するPLスペクトルを取得しました。図2dに示すように、各励起パワーについて、最初の2つのピークのエネルギーがマルチガウス関数フィッティングを使用して抽出され、励起パワーの立方根の関数としてプロットされました。基本遷移のエネルギーは、タイプII遷移と一致する励起パワーの減少とともに減少します。これは、放出がQD(E0 QD )の基本電子状態にある電子の再結合の結果であることを示しています。 )およびGaAsSb QW(H0 QW )。 InAs / GaAsSbタイプIIバンドアラインメントの場合、QDとGaAsSb SRLにそれぞれ電子と正孔が局在すると、主に成長方向に沿った電界に起因するバンドベンディング効果が発生します[22]。タイプIIの遷移エネルギーは、Jin et al。によって示されているように、励起パワーの3番目の根に比例して増加すると予想されます。 [22]。同様に、最初の励起状態遷移のエネルギーは、励起パワーの減少とともに減少します。この遷移は、QD(E1 QD )の最初の電子励起状態での電子の再結合の結果である可能性があります。 )およびGaAsSb QW内の穴(H0 QW )GaAsSb QWの状態密度は、QDの状態密度よりもはるかに大きいためです。最初の2つの光学遷移を図3aに示します。また、基本励起状態と最初の励起状態の間のエネルギー分離ΔEは、励起電力が減少しても64 meVでほぼ一定のままであり、これは、電荷の蓄積によって生じる電界が成長方向に垂直であることの証拠です[22]。つまり、GaAsSbの正孔はQDの上に局在しています。 GaAsSbのSb含有量は13%であり、タイプIからタイプIIへの遷移が発生する組成に近いため、サンプルAではタイプIIの発光が予想されます[23、24]。考慮されるSb含有量については、QDとGaAsSb QWの間に小さな原子価帯オフセットが存在し、GaAsSb QWの正孔の局在化と、それに続くタイプIIの放出に有利に働くはずです[25、26]。
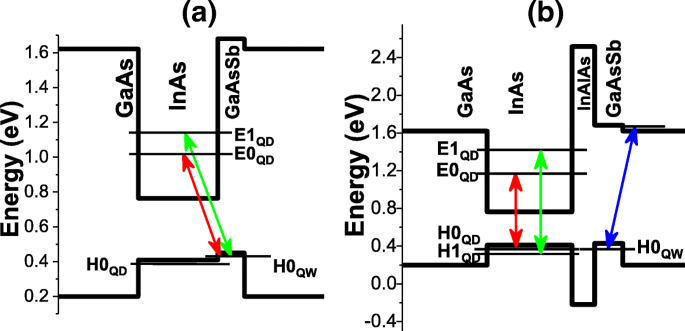
サンプルAのバンドプロファイル( a )およびサンプルB、C、およびD( b )対応する再結合チャネルを使用
図4aは、In 0.15 が異なるサンプルに対応するPL発光を示しています。 Al 0.85 励起パワーが1〜100mWの厚さ。 In 0.15 を含むすべてのサンプルについて、3つの主要なピークを特定できます。 Al 0.85 中間層として。参照サンプルAに対するさまざまな放射チャネルのエネルギーピーク位置の変化に注目します。100mWの励起パワーで、基本遷移のエネルギー、FWHM、およびエネルギー分離ΔEが抽出され、サンプルと比較されました。 A.抽出された値は図4bに報告されています。

a InAs / In 0.15 の電力依存PL Al 0.85 77KでのAs / GaAsSb量子ドット。 b 対応するピークエネルギー、FWHM、およびΔEとInAlAsの厚さおよび c サンプルB、C、およびDの励起パワーの立方根の関数としての光遷移チャネルのピークエネルギーの変化
サンプルAの基底状態遷移は、1004 meVで発生し、FWHMは52 meV、エネルギー分離ΔEは64meVです。 20ÅのIn 0.15 を挿入します Al 0.85 As(サンプルB)は、基底状態遷移の青方偏移を52meV誘導します。青方偏移は、ほぼ同じ成長温度で成長したQDに複合InAlAs / InGaAsを使用したときに観察されたものと一致しています[27]。サンプルBのInAsQDの基底状態遷移エネルギーの青方偏移は、閉じ込めポテンシャルの増加に起因します[15]。電子と正孔の障壁が増加すると、電子と正孔のエネルギー準位の分離が増加し、観測された発光ブルーシフトにつながるはずです。 InAsをGaAsでキャッピングすると、Inの偏析とIn-Gaの混合の結果としてQDの高さが低下することはよく知られています[28]。 GaAsキャッピング層にSbを導入すると、歪み駆動のIn-Ga混合を抑制することでQD分解が減少します[29]。 InAlAs中間層の挿入は、Al吸着原子の不活性に起因するIn偏析とIn-Ga混合をさらに抑制することが期待されます。実際、Jun etal。 [17]は、STEMを使用して、キャッピング層としてInAlAs / InGaAsの組み合わせ層を使用すると、Inの偏析、およびInAs QDのキャッピングプロセス中の成長方向に沿ったIn–Gaの混合が強く抑制され、ナノ構造の高さとキャッピング後のInAs量子ドットのより高いIn濃度。 QDの低い成長温度、つまり485°Cを考慮すると、Al吸着原子の不活性の結果として、QDとInAlAs中間層の間のインジウムの偏析と界面の混合は重要ではないと予想されます。
FWHMとΔEはそれぞれ39meVと92meVに減少および増加します。 In 0.15 の厚さをさらに増やす Al 0.85 40Åと60Å(それぞれサンプルCとD)に関しては、発光波長の赤方偏移が発生します。この赤方偏移は、複合InAlAs / GaAsSb SRLの総厚がInAlAsの厚さの増加とともに増加するため、InAsQDのひずみの変化によって引き起こされる可能性があります[30]。これにより、量子ドットの構造寸法が変化し、電子と正孔のエネルギーレベルが変化する可能性があります。サンプルCとD(それぞれ40Åと60Å)の場合、ひずみ効果が閉じ込めポテンシャル効果を支配しているようです。サンプルDでは、それぞれ35meVの最低FWHMと35meVおよび106meVの最高エネルギー分離ΔEが得られました。大きなΔEは、より厚いInAlAs層の使用と、おそらくQD高さの増加によって引き起こされます[31、32]。エネルギー分離は、複合InAlAs / InGaAs SRLを使用した場合に得られるものと同等です(104 meV)[16、33]。 FWHMの減少は、In 0.15 間の混合の減少という観点から理解できます。 Al 0.85 AsとQD、したがってQD分布の保存。抽出されたパラメータは表1にまとめられています。
<図>サンプルBおよびCのPL強度は、サンプルAと比較して増加しました。ただし、サンプルDではPL強度の大幅な低下が観察されました。つまり、サンプルCと比較して5分の1の低下が見られました。PL強度の低下は、GaAsSb層からQDへのキャリア注入の減少に起因します。実際、照明中に多数のキャリアが光生成され、In 0.15 が挿入されます。 Al 0.85 中間層がキャリアのバリアを作成し、QDへの注入を制限する可能性があるため。キャリアはトンネリングプロセスを介してQDに移動する可能性があり、PL強度はIn 0.15 が薄いサンプルの方が高くなります。 Al 0.85 障壁として[34]。サンプルDは、60ÅIn 0.15 をトンネリングするときに最低のPL強度を示しました。 Al 0.85 Asは大幅に減少し、これは、図4aに示すようにGaAsSbQWのPL発光が増加していることからも明らかです。トンネリングプロセスの削減は、GaAsSb QWでの電子と正孔の放射再結合を有利にし、強化します。
図4aに示すサンプルB、C、およびDの77 Kでの電力依存PLからの主な観測は、サンプルAで観測されたものとは対照的に、励起電力の増加に伴う最初の2つのピークの固定エネルギー位置です。は、電子と正孔の両方がQD内に局在するタイプI発光の特性です。最初の2つの発光ピークは、QD(E0 QD )の基本状態と最初の励起状態での電子と正孔の再結合に起因します。 -H0 QD およびE1 QD -H1 QD )。 3番目のピークは、GaAs内の電子とGaAsSbQWに局在する正孔の再結合に起因するタイプIIの発光に起因すると考えられます。実際、この遷移に対応するエネルギーは、タイプII遷移に特徴的な図4aおよび図4cに示すように、励起パワーの増加とともに増加します。さらに、その強度はIn 0.15 の増加とともに増加することがわかります。 Al 0.85 層の厚さとして。これは、より厚いIn 0.15 としての基本遷移のPL強度の減少と一致しています。 Al 0.85 層として、GaAsSbからQDへのキャリアトンネリングを減らし、それぞれGaAsとGaAsSbにある電子と正孔の再結合から得られるタイプII発光を優先します。サンプルB、C、およびDの再結合チャネルの概略図を図3bに示します。タイプIIの放出の抑制は次のように理解することができます。 20ÅのIn 0.15 の挿入 Al 0.85 層がQDとGaAsSbQWの間の搬送波分離を増加させると、その結果、電子と正孔の波動関数の重なりが減少します。さらに、GaAsSb含有量のSb含有量がタイプI-タイプIIクロスオーバーであるIn 0.15 に近いという事実 Al 0.85 中間層はQWに閉じ込められたレベルをもたらすため(H0 QW )QDの最初の量子化レベルより下(H0 QD )図3bに示すように、QWで捕捉された正孔は、InAlAs層を通り抜けて、タイプIIの放出の可能性が低くなる可能性があります。より厚いIn 0.15 の場合 Al 0.85 中間層(40Åおよび60Å)として、トンネリングはさらに減少しますが、電子と正孔の波動関数の重なりは大幅に減少し、GaAsの電子とGaAsSbの正孔の再結合を促進します[13]。 InAs / GaAsSb QDの光学遷移は、短寿命または長寿命を必要とするアプリケーションのタイプに合わせて調整できます。私たちの研究では、GaAsSbのSb含有量を13%と考えました。これは、タイプIからタイプIIへの遷移に近いものです。 InAlAs中間層の挿入により、タイプIIの発光が抑制され、基本状態と最初の励起状態の間のエネルギー分離が増加しました。これは、短いキャリア寿命を必要とするアプリケーションに適しています。本研究は、長いキャリア寿命を必要とするアプリケーションに合わせて調整することもできます。実際、GaAsSb層でより高いSb含有量を使用することと、InAlAs中間層を挿入することの組み合わせにより、キャリア寿命を大幅に延ばしながら、薄いInAlAs中間層のタイプII発光を維持することが期待されます。同時に、基本状態と最初の励起状態の間のエネルギー分離が増加すると、キャリアの熱逃げが減少します。
結論
複合In 0.15 でキャップされたInAsQD Al 0.85 As / GaAs 0.85 Sb 0.15 In 0.15 が変化するSRL Al 0.85 厚さが成長し、特徴付けられるにつれて。私たちの分析は、In 0.15 の挿入を示しています Al 0.85 As層は、InAs / GaAs 0.85 から得られる観測されたタイプII発光を抑制します。 Sb 0.15 QD。さらに、発光波長は t の間ブルーシフトされます =20Åおよび t の赤方偏移 それぞれ、閉じ込めポテンシャルの増加とひずみの増加に起因する≥40Å。厚さ60ÅのIn 0.15 のサンプルでは、106meVの大きなエネルギー分離ΔEが得られました。 Al 0.85 中間層として。さらに、In 0.15 の導入 Al 0.85 中間層が52meVからFWHMを大幅に減少させると、最小35meVに達します。
略語
- FWHM:
-
半値全幅
- HRXRD:
-
高解像度X線回折
- PL:
-
フォトルミネッセンス
- QD:
-
量子ドット
- QW:
-
量子井戸
- SRL:
-
ひずみ低減層
ナノマテリアル
- 構造的および光学的性質を改善するためのH2 / NH3混合ガス中のGaNベースの多重量子井戸の原子転位
- Fe3 +の高感度測定のためのMXene量子ドットの蛍光を制御するN、N-ジメチルホルムアミド
- 自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
- Al2O3 / ZnOナノラミネートの形態的、光学的、および電気的特性に及ぼす二重層の厚さの影響
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- 水溶性硫化アンチモン量子ドットの合成とそれらの光電特性
- グラフェン/ Ag3PO4量子ドット複合材料の簡単なワンステップソノケミカル合成と光触媒特性
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- 水熱反応によりレモンジュースから製造された蛍光炭素量子ドットの材料と光学特性
- 赤外領域におけるAlドープZnO膜の光学的性質とそれらの吸収への応用



