高いオン/オフ比と極性切り替え可能な光伝導性を備えたSnSe2電界効果トランジスタ
要約
SnSe 2 電界効果トランジスタは、剥離した数層のSnSe 2 に基づいて製造されました。 フレーク、およびその電気的および光電的特性が詳細に調査されています。脱イオン(DI)水の滴の助けを借りて、SnSe 2 FETは最大10 4 のオン/オフ比を実現できます SnSe 2 にとってこれまで非常に困難であった1Vバイアス内 キャリア密度が非常に高いため(10 18 / cm 3 )。さらに、サブスレッショルドスイングとモビリティの両方が〜62 mV / decadeと〜127 cm 2 に改善されています。 V -1 s -1 300 Kで、これは液体誘電体ゲートによる効率的なスクリーニングの結果です。興味深いことに、SnSe 2 FETは、ゲートバイアスに依存する光伝導性を示します。この場合、キャリア濃度と照明下での移動度の競合が、光伝導性の極性を決定する上で重要な役割を果たします。
はじめに
量子閉じ込め効果により、2次元(2D)原子層状材料(ALM)は、3Dバルク対応物とは非常に異なる動作をし、いくつかのユニークで魅力的な電子的、光学的、化学的、磁気的、および熱的特性を示します[1]。 2D ALMは、単一原子または数層の厚さの限界で、基本的な物理的および化学的研究のための魅力的なプラットフォームを提供します。さらに、ALMは他のデバイスと柔軟に統合でき、既存の材料の範囲を超えて新しい機能を開発するためのより大きな余地または自由を提供します。過去10年間で、2D ALMは広く調査され、センサー、エネルギー、環境などの分野での潜在的なアプリケーションが見つかりました[2、3]。
最近、IV-VIグループの重要なメンバーとして、二セレン化スズ(SnSe 2 )多くの注目を集めています。 SnSe 2 六角形のCdI 2 があります 空間群\(\ mathrm {p} \ overline {3} \ mathrm {m} 1 \)[4]を持つ六角形にパックされたSe原子の2つの層によってSn原子が挟まれているタイプの結晶構造。遷移金属ジカルコゲナイド(TMD)とは異なり、SnSe 2 MoS 2 のMoまたはWのd電子とは異なり、構造結合に関与するSnの外側のp電子に起因する、バルクから単分子層までの厚さ範囲全体で間接バンドギャップ特性を備えたより狭いバンドギャップを持ちます。 またはWS 2 [5]。 SnSe 2 熱電、相変化メモリ、リチウムイオン電池、およびさまざまな電子論理デバイスで優れた特性を持つことが調査されています[4、6、7、8、9]。特に、SnSe 2 電子親和力が高い(5.2 eV)ため、トンネル電界効果トランジスタ(FET)の製造に特別な用途があります[9、10、11]。パンら。機械的に剥離されたSnS 2 − x に基づいて体系的に調査されたFET Se x セレン含有量が変化する結晶[12]。彼らは、ドレイン-ソース電流( I d )Seの含有量が x に達した状態で完全にオフにすることはできません =1.2以上。後でSu等。 SnSe 2 を製造しました 300 Kで高い駆動電流(160μA/μm)を備えたMOSFETで、「オフ」状態がない場合と同じ結果になります[13]。 SnSe 2 の「オフ」状態を取得するのが難しい主な理由 FETデバイスは超高電子密度(10 18 cm -3 バルクSnSe 2 、10 16 と比較 cm -3 MoS 2 で )[14、15]。したがって、SnSe 2 におけるキャリアの輸送の効果的な変調 FETはやりがいのある仕事です。バオら I を正常にオフにしました d そして、10 4 のオン/オフ比を取得しました HfO 2 を使用する場合は室温で ポリマー電解質のトップキャッピング層と組み合わせたバックゲートとして。ただし、SnSe 2 のパフォーマンス Li + によって引き起こされる不可逆的な構造転移のため、数回の掃引に耐えることができません SnSe 2 の中間層へのインターカレーション [16]。 Guo etal。 10 5 のより高い電流オン/オフ比を達成しました SnSe 2 を薄くすることにより、しきい値電圧が− 100Vになります。 6.6nmまでフレーク[17]。ただし、作業温度は78 Kに過ぎず、実用上不便です。 FET内のキャリアの輸送の変調を強化する別の方法は、HfO 2 などのhigh-k誘電体層をトップゲートとして堆積することです。 およびAl 2 O 3 [18、19]。ただし、堆積温度が高いと、SnSe 2 の特性が変化します。 層を作り、さらにデバイスのパフォーマンスを低下させます。固体高分子電解質ゲートを使用してキャリア密度を調整することは、電解質と半導体の間の界面に形成される電気二重層(EDL)を非常に効率的に制御できるため、魅力的な方法です[20、21、22]。しかし、イオンの移動プロセスが遅い場合は、それに合わせて低バイアスの掃引速度が必要です。したがって、SnSe 2 のキャリアを変調するためのシンプルで効率的かつ実用的な方法 非常に要求が厳しいです。
この作業では、溶液のトップゲートとして一滴の脱イオン(DI)水のみを使用し、300 Kでチャネル電流を正常にオフにしました。さらに、オン/オフ比は、小さなゲート電圧で制御されて約4次に達する可能性があります。 1 V未満の。さらに驚くべきことに、SnSe 2 デバイスは、バイアスに依存する興味深い負および正の光伝導性を示し、可能な動作メカニズムが分析されています。
実験
SnSe 2 フレークは、機械的剥離によって高品質のバルク結晶から得られました。次に、100nmのSiO 2 で覆われたSiウェーハに転写しました。 。詳細な剥離と転写方法は、Huangの論文[23]に記載されています。転写後、光学顕微鏡を使用して選択したフレークを特定し、原子間力顕微鏡によって正確な厚さを測定しました。 SnSe 2 FETは標準的なフォトリソグラフィーによって製造されました。 Ti / Au(5/50 nm)接触は、熱蒸発器によって堆積され、続いて高真空(10 -5 )で200°Cでその場アニーリングされました。 Pa)金属接触を改善する。 DIウォータートップゲートFETの場合、追加のポリマー層(ポリメチルメタクリレート(PMMA)タイプ950 A5)をデバイスに堆積し(3000 rpmでスピンコーティング、厚さ〜400 nm)、180°Cで2分間ベークし、水滴とデバイスチャネル間の接触のためにウィンドウを開くために、UVフォトリソグラフィーによってパターン化されています。
電気的特性評価は、4プローブステーション(Signatone)のKeithleyソースメーター2634Bによって実行されました。波長532nmのレーザーダイオードを出力密度1mW / mm 2 の光源として使用しました。 SnSe 2 の光電性能を調べる FET。時間応答は、オシロスコープMDO3000によって記録されました。
光学顕微鏡(CCDカメラ付きXTZ-2030JX)を使用して光学画像を取得した。ラマンスペクトルは、ラマン顕微鏡を介してレニショーで室温で532nmのレーザー励起を使用して実行されました。 AFMの特性評価は、Bruker Multimode8の顕微鏡で行いました。
結果と考察
図1aに、SnSe 2 の概略図を示します。 FETデバイス。接点はPMMA(タイプ950 A5)の層で覆われており、ピペットから滴下されたDI水滴で構成されるトップゲートから電気的に絶縁されています。デバイスは、トップゲート電圧( V )でゲートすることができます。 tg )DI水滴と接触している電極またはバックゲート電圧( V )によって適用されます bg )SiO 2 を介して適用 サポート。 SnSe 2 の光学画像 パターン化された電極を備えたフレークを図1bに示します。ソースとドレインのギャップは約2μmです。ラマン分光法を使用して、SnSe 2 の特性を調べました。 図1cに示すように、材料。指紋は187cm -1 でピークになります および112cm -1 面外 A に対応します 1g モードと面内 E g それぞれ、他の人の報告とよく一致するモード。ただし、SnSe 2 の厚さを決定することは困難です。 ラマンピークの位置から。 MoS 2 とは異なり 、ラマンピーク位置の厚さ依存特性は明確ではありません[24、25、26]。そこで、原子間力顕微鏡(AFM)を採用してフレークの厚さを直接測定しました。図1dに示すように、SnSe 2 の厚さ フレークは約34nmです。
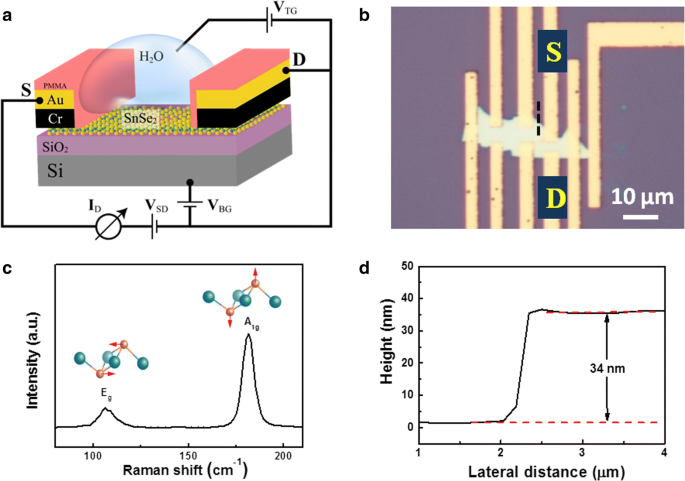
SnSe 2 のイラスト フォトトランジスタデバイスとSnSe 2 に関するいくつかの基本的な特性 フレーク。 a SnSe 2 の概略図 電界効果トランジスタデバイス。 b SnSe 2 の光学画像 SとDがそれぞれ調査中のソース電極とドレイン電極を示すフレーク。 c SnSe 2 のラマンスペクトル フレーク。 d 黒い点線から抽出した高さプロファイル(図1bに示す) )AFM測定で
暗所で測定されたさまざまなバックゲート電圧下でのFETデバイスの出力曲線を図2aに示します。 I の線形および対称関係 d -V ds Ti / Au電極とSnSe 2 間のオーミック接触を示します チャネル。図2aから、SnSe 2 の導電率の変調効果がわかりました。 バックゲート電圧によるものはごくわずかです。 I の比率 d ゲート電圧30と-30Vの間は V でわずか1.15です ds 50mVの。現在の I d バックゲート電圧で-30Vは V で〜1.47μAと同じくらい大きい ds 5 mVであり、バックゲート電圧ではオフにできませんでした。大きなゲート電圧を100Vまで上げても、SnSe 2 の超高キャリア密度によるゲート電位のスクリーニングの結果として、チャネルはオフ状態になりませんでした。 、これは以前のパンとスーの作品で報告されています[12、13]。半導体理論によれば、空乏幅 W を大まかに見積もることができます。 \(W ={\ left(\ frac {2 {\ varepsilon} _r {\ varepsilon} _0 {\ varphi} _s} {e {N} _Dによって決定される金属-絶縁体-半導体(MIS)構造の} \ right)} ^ {1/2} \)、ここでφ s は表面電位、 N D ドナー不純物濃度、およびε 0 およびε r それぞれ真空と比誘電率。 φを取る s 、ε r 、 N D 1 V、9.97、および1×10 18 / cm 3 控えめな計算として方程式に、空乏幅 W は約22nmで、SnSe 2 の厚さよりもはるかに小さいです。 フレーク(34 nm)。したがって、バックゲート変調による電子の枯渇がないことは簡単に理解できます。
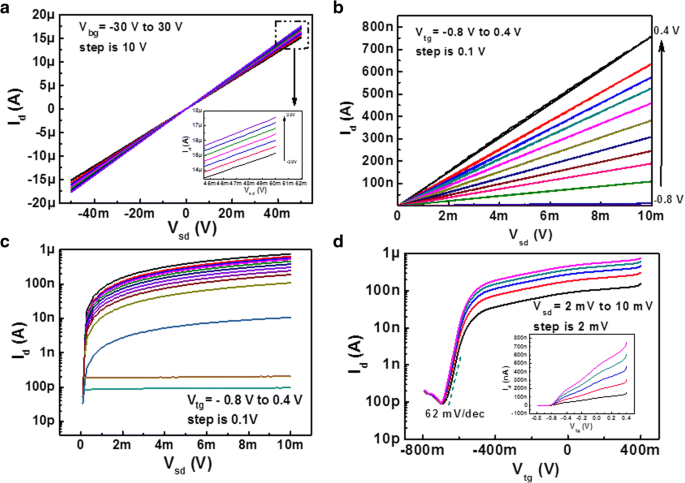
SnSe 2 の出力および転送特性 暗闇で測定されたFET。 私 d 対 V sd SnSe 2 の特徴 異なるバックゲート電圧 V でゲートされたFET bg ( a )、さまざまなトップゲート電圧 V tg 線形スケールで( b )、および異なる V tg 片対数スケール( c )。 私 d 対 V tg SnSe 2 の特徴 V のFET sd 片対数スケールで描かれた2mVのステップで2mVから10mVの範囲で、挿入図は I の線形スケールのプロットです。 d -V tg 特性( d )
対照的に、トップゲートとしてDI水を使用する場合、 I d -V ds 図2bに示すように、曲線は小さなゲートバイアスでも効率的な変調を示します。 0.4 Vと− 0.8Vのゲート電圧間の電流比は10 3 を超えています 、片対数スケールで描かれた図2cからより明確に見られます。 SnSe 2 に関する伝達曲線 トップゲートを備えたFETを図2dに示します。これは、典型的なn型導電性の振る舞いを示しています。電圧は、10 mV / sのスキャン速度で負の方向から正の方向にスキャンします。イオン液体または固体電解質の電気二重層(EDL)は高い静電容量を備えており、2Dおよび層状材料で非常に効率的な電荷結合を実現するために使用できます。ただし、サイズと質量が大きいイオンのために電荷移動プロセスが遅い場合は、ゲートとチャネルの界面で平衡を維持するために低バイアスのスキャンレートが必要です。対照的に、誘電体層としてDI水を使用する場合、H + およびOH − イオンはサイズと質量が小さく、水は粘度が低くなります。したがって、水-半導体界面の二重層を介したDI水ゲーティングは、はるかに高い電圧掃引速度をサポートし、イオン液体ゲーティングまたは固体電解質ゲーティングよりも高速に応答します。挿入図は、 I の線形スケールプロットです。 d -V tg 特性。特に、トップゲートとしてのDI水は、SnSe 2 の相互コンダクタンス特性を大幅に向上させます。 FET。 V として tg −0.8から0.4Vまで変化します、 I d 9.5×10 -11 からの変更 〜7.6×10 −7 オン/オフ電流比が〜10 4 のA 。伝達特性から計算されたサブスレッショルドスイングは〜62 mV / decadeです。これらの値は、層状金属カルコゲニドFETデバイスの実用的な低電圧動作に十分です。モビリティμ 次の式を使用して計算できます。\(\ mu =\ frac {d {I} _d} {d {V} _g} \ cdotp \ frac {L} {W {C} _ {H2O} {V} _ { sd}} \)、ここで L および W チャネルの長さと幅です( L = 2μm、 W =5μm)、および C H2O は、単位面積あたりのDIウォーターゲート容量です。ここで、 C の静電容量 H2O 348 nF / cm 2 と測定されました 、詳細な計算は補足資料に添付されています(追加ファイル1:図S1aおよびb)。得られた電子移動度は127cm 2 / Vs、これは他の数層の2Dマテリアルと比較して非常に優れています。誘電体層としてDI水を使用したトップゲートによって実現された大幅に改善された変調効果は、Huangの研究[27]でこれまでに報告されています。彼らはSnS 2 にDIウォーターゲートを適用しました 、MoS 2 、およびBPフレークであり、高いオン/オフ比、理想的なサブスレッショルドスイング、および優れた機動性を実現しました。彼らは、これらの改善がフレークを周囲の吸着物から完全に保護し、高 k による界面状態の不動態化に起因すると考えました。 誘電体(ε r (H2O) =80)。 DI水によって提供される不動態化および遮蔽効果は、HfO 2 などの他の従来の高誘電性材料によるものと同様です。 またはAl 2 O 3 [18、19]。さらに、DI水とSnSe 2 の間の効果的な結合 フレークのエッジを通過することは、厚いフレークでも高いオン/オフ比を達成する上で重要な役割を果たしているようです。 SiO 2 との比較 バックゲーティング、DIウォーターゲーティングは電界距離を効果的に短縮できるため(数100nmから1nm未満)、しきい値ゲート電圧も数十ボルトから1V未満に減少しました。図の挿入画像から。 2d、約 V でのわずかな電流ジャンプ tg =0.4 Vは、Huangの研究[27]で報告されている、電位窓が狭いためにDI水の電気分解が原因である可能性があります。
SnSe 2 の時間依存光電応答 バックゲーティングまたはトップゲーティングによって制御されるFETを図3に示します。興味深いことに、SnSe 2 FETは、バックゲートからSiO 2 を介したゲートに関係なく、負のゲートで正の光電流を示し、正のゲートで負の光電流を示します。 またはトップゲートからDI水を介して。図3aから、負のバックゲート電圧の増加に伴って光電流の大きさが増加することがわかります。バックゲート電圧が− 80 Vの場合、相対的な光伝導率(Δσ/σとして定義) 0 、ここでσ 0 は暗伝導率であり、Δσ σの違いです およびσ 0 )は5%です。 DI水をトップゲートとして使用すると、図3bに示すのと同様の法則が得られます。トップゲート電圧を− 0.4 Vに設定すると、相対光伝導率は6%に達する可能性があります。ただし、2種類のゲーティング間の応答時間はかなり異なることが簡単にわかります。 SiO 2 によるバックゲーティング用 誘電体として、立ち上がりエッジの応答時間は約30秒です。誘電体としてDI水を使用するトップゲーティングの場合、応答時間はわずか1.7秒です。ここでは、10〜90%の立ち上がり時間(または10〜90%の立ち下がり時間)が応答時間として定義されています。 DIウォーターゲーティングによる応答速度の高速化は、キャリアの移動度の向上(127 cm 2 )に関連しているはずです。 / Vs)不純物または吸着物の散乱を効果的にスクリーニングするため。興味深いことに、ゲート電圧が正の場合、SnSe 2 フィルムは、図3cおよびdに示すように、負の光伝導率(NPC)を示します。ゲートに依存する双極光伝導性は、ゲートとソースの間のリーク電流によって誘導されないことを強調しておく必要があります。 I の漏れ電流を測定しました g 追加ファイル1:図S2に示すように、正または負のゲートバイアスを適用する場合。 私のサイン g V の方向に従います gs ドレインからソースへの光電流の符号とは正反対です( I d )。さらに、 I の大きさ g I よりはるかに小さい d 、その影響は無視できます。 SnSe 2 のNPCで H 2 のFET 誘電体としてのOには、正の光伝導(PPC)とは異なる2つの特徴があります。 1つは、正の V での相対的な光伝導ゲーティングの絶対値です。 tg (〜20%)は、負の V でのゲーティングよりも著しく大きい tg (6%)。もう1つはSnSe 2 FETは、正の V ではるかに長い応答時間(〜30 s)を示します tg 負の V の場合よりも tg (1.7秒)。

SnSe 2 の光応答の時間依存性 V でバイアスされたFET sd =5mV異なる負のバックゲーティング電圧 V で印加した場合 bg ( a )、負のトップゲート電圧 V tg ( b )、正のバックゲーティング電圧 V bg ( c )、および正のトップゲート電圧 V tg ( d )
負の光伝導(NPC)現象は、カーボンナノチューブ、InAsナノワイヤー、ZnSeナノワイヤーなどのいくつかの半導体ナノ構造で報告されています[28,29,30] 。 酸素分子の吸着と光脱着は通常、NPC効果の原因であることが示唆されています。ただし、そのような説明は、SnSe 2 には適用されません。 酸素脱着はより高い電子濃度と導電率につながるだけなので、システム。 SnSe 2 におけるNPCの効果とNPCとPPCの共存を理解するために 、 I を測定しました d -V tg SnSe 2 の曲線 図4に示すように、照明下のFET。明確な比較のために、暗所での伝達曲線も追加されています。デバイスがバイポーラ光伝導性を示し、ゲート電圧によって切り替えることができることがわかります。照明下および暗所で測定された伝達曲線は、ゲート電圧0 Vでほぼ交差します。したがって、デバイスは、マイナスゲートバイアスで正の光伝導率を示し、プラスゲートバイアスで負の光伝導率を示します。これは結果と一致しています。よく知られているように、導電率σ σとして決定されます =neμ 、ここで n 、 e 、およびμ それぞれ、キャリア濃度、電子電荷、および移動度です。したがって、導電率はキャリア濃度と移動度の積によって決まります。光の下での伝達曲線では、相互コンダクタンスの変化 g m ゼロゲート電圧の両端は、移動度の変化を意味します。伝達曲線から、表1および2に示すように、照明と暗闇の移動度を計算できます。SnSe 2 の移動度 暗闇の中で約70cm 2 / Vs、照明下の移動度には2つの値があります:約60 cm 2 マイナスゲートバイアスおよび〜4 cm 2 での/ Vs プラスゲートバイアスでの/ Vs。負の V tg 、明暗状態の移動度はほぼ同じですが、光励起下のキャリア濃度は暗状態のそれよりも大きくなります。したがって、デバイスは正の光伝導性を示します。正の V tg 、移動度は、負の V の場合よりも1桁以上小さくなります。 tg 、および移動度の減少は、キャリア濃度の増加を上回り、光伝導性の進化を支配します。したがって、正の光伝導体の代わりに正味の負の光伝導体が発生します。
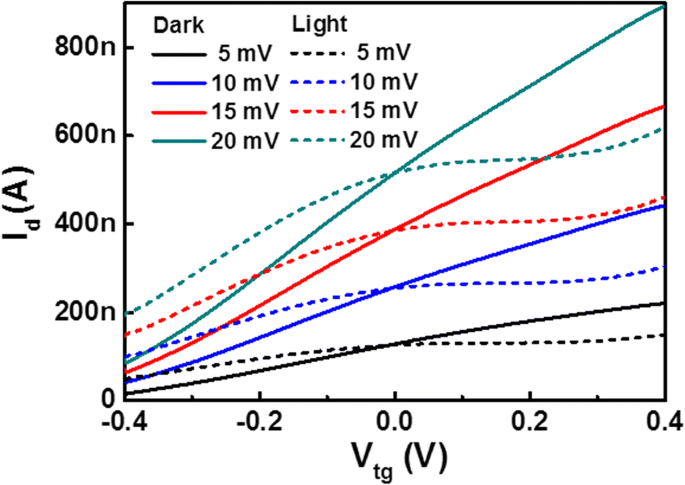
私 d -V tg SnSe 2 の特徴 照明下および暗所でのFET
Pai-Chun Wei etal。小さなバンドギャップでNPC効果を発見し、InN膜を縮退させ、荷電再結合中心からの激しい散乱によって引き起こされる移動度の低下に起因しました[31]。これはSnSe 2 に適用される可能性があります。 システム。しかし、ゲートバイアスが負から正の電圧にスキャンするときに移動度が低下する理由は明らかではありません。この現象は、いくつかのギャップ内の状態に起因すると考えられます。ギャップ内の状態は、Seの空孔などのいくつかのポイントの欠陥によって引き起こされる可能性があります。照明下では、ギャップ内は E より下の状態になります f いくつかの光生成された穴をトラップし、正に帯電した散乱中心になります。 V を使用 tg 負のバイアスから正のバイアスにスキャンすると、ギャップ内の状態が E を下回ります。 f 帯電した散乱中心になり、移動度の低下につながります。 NPCのメカニズムを完全に理解するには、さらなる作業が必要です。
結論
要約すると、SnSe 2 電界効果トランジスタ(FET)は、SnSe 2 に基づいて製造されています。 単結晶から剥離したフレーク。上部の誘電体ゲートとして一滴の水を使用して、〜10 4 の高い電流除去率でデバイスの電源を切ることに成功しました。 。 SiO 2 との比較 誘電体ゲートであるDI水は、SnSe 2 の輸送挙動を大幅に改善できます。 〜62 mV / decadeの理想的なサブスレッショルドスイングと〜127 cm 2 の優れた電子移動度を備えたFET V -1 s -1 300 Kで。特に、SnSe 2 トップゲートバイアスが−0.4から+0.4 Vまでスキャンすると、FETはバイポーラ光伝導性を示します。極性はゲート電圧の符号によって切り替えることができます。負のゲートバイアスでは、正の光伝導率はキャリア濃度の増加によって支配されます。正のバイアスでは、負の光伝導性は移動度の急激な低下によって引き起こされます。キャリア濃度と移動度の間の競争は、光伝導性の進化を決定します。この作業で提示された簡単なソリューションゲート方法では、SnSe 2 FETは優れた電気特性を示し、同時に興味深い極性切り替え可能な光伝導性を示します。これにより、高性能オプトエレクトロニクスデバイスの新しい変調方法が開かれます。
略語
- 2D:
-
二次元
- AFM:
-
原子間力顕微鏡
- ALM:
-
原子的に層状の材料
- DI:
-
脱イオン
- FET:
-
電界効果トランジスタ
- MIS:
-
金属-絶縁体-半導体
- NPC:
-
負の光伝導率
- PMMA:
-
ポリメチルメタクリレート
- PPC:
-
正の光伝導性
- TMD:
-
遷移金属ジカルコゲナイド
ナノマテリアル
- デジタル(ON / OFF)ホール効果デバイス:スイッチとラッチ
- データモジュール:高輝度でeasyTouch機能を備えた大型オープンフレームモニター
- 低抵抗Auオーミックコンタクトを備えた多層SnSeナノフレーク電界効果トランジスタ
- RGOと3次元グラフェンネットワークが高性能でTIMを共同修正
- 高度に圧縮耐性のあるスーパーキャパシタ電極としての超弾性と高静電容量を備えたグラフェン/ポリアニリンエアロゲル
- 強化されたデュアルゲートと部分的なP埋め込み層を備えた超低比オン抵抗横方向二重拡散金属酸化物半導体トランジスタ
- 高PSRRのナノスケール低電力抵抗なし電圧リファレンス
- アモルファスSiパッシベーションを備えた高移動度GepMOSFET:表面配向の影響
- リチウムイオン電池用のカーボンナノチューブとグラフェンで修飾されたFeF3・0.33H2Oの高性能カソード材料
- 太陽照射下での電荷分離と高い光触媒活性を強化するための部分的な表面改質を備えたZnO多孔質ナノシート
- 2DEGチャネルとパターン化基板を備えた新しいGaNナノピラー垂直電界効果トランジスタ(FET)のバリガの性能指数(BFOM)強化について



