原子層堆積によって製造されたRuベースのRRAMデバイスにおける負の微分抵抗効果
要約
この作業では、原子層が堆積したAlO y を備えたRuベースのRRAMデバイス / HfO x 機能層を作製し、研究した。電圧設定プロセス中に負性微分抵抗(NDR)の動作が観察され、その物理的起源が調査されました。抵抗スイッチングの物理的理解に基づいて、測定されたNDR動作は、部分的に単極のリセット効果に関連していると考えられます。これは、酸素空孔とRuO 2 インターフェイス層。測定された電気的特性とX線光電子分光法(XPS)の結果により、物理的な解釈が検証されました。
はじめに
最も有望な新しい不揮発性メモリの1つとして、抵抗変化型メモリ(RRAM)は、材料の最適化、パフォーマンスの向上、およびデバイスの統合に関して広く研究されてきました[1,2,3,4]。シンプルなセル構造、高速動作速度、低消費電力、比類のない小型化の可能性などの重要な利点により[5]、RRAMは脳に触発されたニューロモルフィックコンピューティングおよび再構成可能なブール論理に広く適用されています[6,7,8,9 、10]であり、ストレージクラスメモリ(SCM)アプリケーションの大きな可能性も示しています[11]。ただし、デバイスとシステムの国際ロードマップ2017(https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf)に示されているように、スケーラビリティ、デバイスの信頼性、プロセスの互換性などの課題は依然として妨げられています。 RRAMの開発。したがって、優れた性能を備えたCMOS互換のRRAMデバイスの構築は、RRAMセルの1T1R構造に基づくアプリケーションにとって非常に重要です[12、13、14]。以前の研究[15]によると、RuベースのRRAMデバイスはPtベースのデバイスと比較して大きな可能性を示していますが、電圧設定プロセス中に負性微分抵抗(NDR)が実証されました。抵抗スイッチングを伴うNDR現象は、他のRRAM構造で調査されています。これは主に、注入された金属ナノ粒子によって引き起こされる深く局在化した状態間の電子キャリアのトラップ/デトラップ[16、17]、または接合部の再インストールを引き起こす欠陥の蓄積によるものです。 [18]。大電流下でのRuベースのRRAMセルでのNDRの出現はまだ懸案ですが、この作業では、原子層堆積(ALD)技術によって製造されたRuベースのRRAMデバイスの電気的性能を評価しました。 X線光電子分光法(XPS)の特性評価とさまざまな刺激による電気的測定に基づいて、RuベースのRRAMのNDR現象は、酸素空孔導電性フィラメントモデルのフレームワークで説明できます。
メソッド
デバイス構造と製造されたRRAMアレイの概略図を、それぞれ図1a、bに示します。 Ru / AlO y / HfO x / TiN RRAMデバイスは、熱酸化された300 nm SiO 2 上に製造されました。 基板。 Ru金属ターゲットを使用するDCマグネトロンスパッタリング(オングストロームエンジニアリングNEXDEP)によって、80nmのRu薄膜が、底部電極として20nmのTi接着層上に堆積された。 SiO 2 プラズマ化学気相成長法(PECVD)によって成長したものは、電極を分離してビアを形成するための誘電体として機能します。次に、2 nm AlO y の抵抗層 および3nm HfO x 原子層堆積システム(PICOSUN R200)により、300°Cでトリメチルアルミニウム(TMA)とテトラキス[エチルメチルアミノ]ハフニウム(TEMAH)前駆体を使用して堆積されました。その後、80 nmのTiNをTiターゲットを使用して反応性スパッタリングし、エッチングして上部電極パターンを形成しました。電気的接触のために下部電極を露出させるために、別のドライエッチングも実行されました。
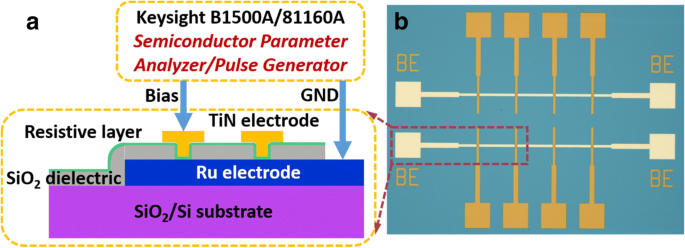
a Ruベースのデバイスの概略図。 b 製造されたRRAMアレイ
元素分析は、上部電極のない新鮮なサンプルを使用して、X線光電子分光法(XPS)システム(Thermo Scientific ESCALAB 250Xi)によって実行されました。測定前に、Cの影響を排除するために、測定前にArプラズマで表面洗浄を行いました。キャリブレーションにはAl2pのピーク位置を使用しました。電気的測定は、半導体デバイスアナライザ(Agilent B1500A)およびパルス機能任意ジェネレータ(Agilent 81160A)によって室温で実行されました。
結果と考察
RuベースのRRAMデバイスの典型的なIV特性を図2aに示します。電鋳後、正の電圧(2.5 V)をセットプロセスに印加して、セルを高抵抗状態(HRS)から低抵抗状態(LRS)に切り替え、コンプライアンス電流を1 mAにして、導電中の永久的な故障を防ぎました。フィラメント(CF)の形成。セット遷移後、負の電圧(− 2.3 V)を使用して、デバイスをLRSからHRSに切り替え、電流を徐々に減らしました。デバイスごとの抵抗変動を評価するために、10個のRuベースのRRAMセルを任意に選択しました。図2bに示すように、統計結果は、10 3 より大きい抵抗ウィンドウでHRSとLRSの優れた均一性を示しています。 、これはNVMベースのロジックアプリケーションの有望な候補となる可能性があります。以前に報告されたPtベースのデバイス[2]と比較して、NDR現象がセットプロセス中に観察されたことは注目に値します。この現象では、制限された電圧スケールで電圧の増加(セットフェーズ1)に伴って電流が減少し、その後増加します。コンプライアンス電流に合わせて(セットフェーズ2)。

a DC特性。 b 10個のRuベースのRRAMデバイスのHRS / LRS統計分布
RuベースのRRAMデバイスのサイクルごとの変動性も、サイクルの均一性を研究するためにパルスモードで調査されました。セット(2.4 V、15 ns)およびパルス(− 3 V、100 ns)のパルスは、各パルスの後に0.1Vの読み取り電圧でデバイスをLRSとHRSの間で切り替えるために使用されます。図3aに示すように、1000サイクルのデバイスは、標準偏差が379Ωで3×10 5 の一様分布を持っています。 LRSおよびHRSのΩ。これにより、100を超える安定したメモリウィンドウが得られます。10 6 の後でも、耐久性の低下は発生しません。 以前に参考文献で報告されたスイッチングサイクル。 [15]。さらに、このデバイスは、図3bに示すように、優れた保持特性も示します。 LRSとHRSの両方の抵抗は、10 5 を超える一定値を維持します s120°Cで故障なし。

a 1000耐久サイクル。 b Ru / AlO y の高温保持挙動 / HfO x / TiNRRAMデバイス
NDR現象を調査するために、 I–V 曲線は、電圧掃引モードと電流掃引モードの両方で測定されました。図4aは、ランダムに選択された5つの新しいRRAMセルの形成プロセスを示しています。電流は徐々に増加し、その後突然剥離し、CFの形成を示しますが、NDRは観察されませんでした。電鋳後、図4bに示すように、電流の変化を観察するために、同じセルでさまざまな掃引モードでのセット操作が実行されます。電流駆動セットの場合、電圧が急激に低下すると電流がゆっくりと増加し、HRSからLRSへの抵抗の遷移を示します。この動作は、電圧によって駆動される特性とは異なります。これは、CF全体での刺激によって誘発されるジュール熱の違いが原因である可能性があります。さらに、NDR領域の中間抵抗状態を調査するために、異なるバイアス下での連続したセット/リセット操作が実行されました。図4cに示すように、設定プロセス中に1 Vの適切な停止電圧を印加して、谷の底で掃引を終了しました。電圧を除去した後、不揮発性の抵抗状態が得られ、これは単極抵抗スイッチング動作を示した。したがって、このNDR現象は、暫定的に、設定プロセス中のCFの2回目のリセットに起因します。
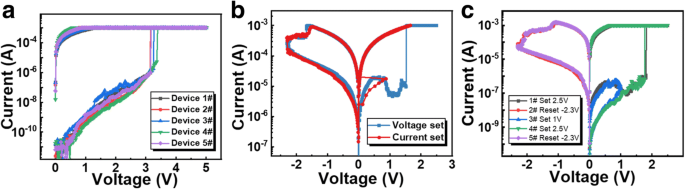
a 5つのRuベースのRRAMデバイスの電圧形成。 b 同じRRAMセル内の電圧駆動型と電流駆動型のセットプロセス。 c 電流谷の底に停止電圧がある不完全なセットプロセス
RuO 2 の特性だけでなく、さまざまなモードやデバイス製造プロセスでの測定と組み合わせる 、図5に示すように、NDR現象の物理的起源が提案されました。以前の研究[19、20]は、電子が枯渇した酸素空孔( V )の生成と再結合を示唆していました。 o )および酸素イオン(O 2- )異なる電気極性の下で、従来のHfO x の原因となります ベースのバイポーラRRAMデバイス。これは、セットフェーズ2およびリセットプロセスに似ています。ただし、従来の硬化プロセスとは異なり、CFの2回目の破裂は、Ru電極とCFを切断して、NDRにつながります。一般に、酸素原子は V に解離します o およびO 2- O 2- のドリフトを伴う電場下 V を残して、上部電極に o 電子伝達に使用されるCFを形成します。しかし、電場によって引き起こされるジュール熱のために、形成されたRuO 2 界面層は〜600°Cでゆっくりと分解し、O 2- を放出します これは、電子が枯渇した V と再結合する可能性があります o ( V o 2+ )Ru電極の近く(セットフェーズ1)[21]、結果として電流が減少します。このプロセスは、部分的なユニポーラリセットプロセスと見なすこともできます。電圧がさらに上昇すると、TEとBEの間のCFは、 V の蓄積によって再構築されます。 o セットフェーズ2に示すように、RRAMセルはLRSに切り替わります。リセット中、2つのプロセスが同時に発生します:(1)O 2- TiN電極から放出されたものは、正に帯電した V と急速に再結合します。 o キャプチャセクションが強化されているため、(2)O 2- BEに向かってドリフトすると、Ruと反応し、RuO 2 を再形成します。 局所ジュール加熱による界面層[22]。この状態で、RRAMセルはHRSに切り替わります。

RuベースのRRAMにおける抵抗スイッチングの物理的プロセス。 a NDR効果(セットフェーズ1)。 b 一般的なSET(セットフェーズ2)プロセス。 c デバイスのリセットプロセス
RuO 2 のXPS分析 デバイス製造プロセス中に形成されたインターフェース層も、NDR効果の提案された説明をサポートします。図6aは、O 1s、Ru 3d、Al 2p、およびHf4fコアレベルを含むサンプルのXPSフルスペクトルを示しています。他のマークされていないピークはすべて、異なる電子軌道を持つこれらの元素に対応しています。図6bのフィッティング曲線は実験データと完全に一致し、Ru 3d 5/2 に対応する4つのピークに分割されています。 (Ruの場合は280.01 eV、RuO 2の場合は280.75eV )およびRu 3d 3/2 (Ruの場合は284.3 eV、RuO 2の場合は285.26eV )コアレベル、RuとRuO 2 の共存を示します 薄膜で[23]。 Ru 3d 5/2 の強度が低い ピークは、形成されたRuO 2 を示します 予想通り、インターフェース層は非常に薄いです。

a のXPSスペクトル Ru / AlO y / HfO x 薄膜と b Ru3dコアレベル。 RuO 2 RuとAlO y の間の薄膜 ALDプロセス中のフォーム[18]
結論
この研究では、CMOS互換のRu / AlO y / HfO x / TiNRRAMデバイスが製造されました。優れたスイッチング性能は、均一なデバイス間抵抗と大きな抵抗ウィンドウ、および優れた高温保持特性によって達成されました。電気的測定とXPS分析に基づいて、セットプロセスでのNDR現象は、RuO 2 から放出された酸素空孔と酸素イオンの再結合によって説明できます。 電気的に誘発されたジュール熱による界面層。
略語
- ALD:
-
原子層堆積
- CF:
-
導電性フィラメント
- HRS:
-
高抵抗状態
- LRS:
-
低抵抗状態
- NDR:
-
負性微分抵抗
- PECVD:
-
プラズマ化学気相成長法
- RRAM:
-
抵抗変化型メモリ
- SCM:
-
ストレージクラスのメモリ
- XPS:
-
X線光電子分光法
ナノマテリアル
- 表皮効果とは何ですか?
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 超微細チタニア核形成に対する硫酸陰イオンの効果
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- Ge / Siチャネル形成とデバイス性能に及ぼすエッチング変動の影響
- エレクトロスピニングされたPUナノファイバーの機械的性質に及ぼす温度の影響
- 二酸化炭素を使用したSiO2の低温プラズマ強化原子層堆積



