水素に富むAl2O3誘電体を使用することにより、サーマルバジェットが非常に低い高性能a-InGaZnO薄膜トランジスタ
要約
アモルファスIn-Ga-Zn-O(a-IGZO)薄膜トランジスタ(TFT)の電気的特性を、O 2 を使用して比較します。 プラズマ強化原子層堆積Al 2 O 3 異なる温度での誘電体。高性能a-IGZOTFTは、Al 2 で成功裏に実証されています O 3 室温で堆積した誘電体で、19.5 cm 2 の高い電界効果移動度を示します。 V − 1 s − 1 、160 mV / decの小さなサブスレッショルドスイング、0.1 Vの低いスレッショルド電圧、4.5×10 8 の大きなオン/オフ電流比 、および優れた負および正のゲートバイアス安定性。これは、水素が豊富なAl 2 に起因します。 O 3 より高い堆積温度と比較して室温で誘電体が堆積されるため、a-IGZO / Al 2 の界面状態が効率的に不動態化されます。 O 3 IGZOのスパッタリング中の水素ドーピングが強化されたため、追加の電子を生成することにより、酸素空孔とa-IGZOチャネルの導電率が向上します。高性能a-IGZOTFTのこのような非常に低い熱収支は、フレキシブル電子アプリケーションにとって非常に魅力的です。
背景
アモルファスIn-Ga-Zn-O(a-IGZO)ベースの薄膜トランジスタ(TFT)は、移動度が高く、均一性が高く、可視光の透明度が高く、プロセス温度が低いため、過去10年間で大きな注目を集めています[1 2,3]。これらのメリットにより、透明ディスプレイ、フレキシブルデバイス、ウェアラブル電子機器などの次世代電子機器のアプリケーションの有望な候補となっています。特に、フレキシブルエレクトロニクスの用途では、TFTは一般に熱安定性の低いポリマー基板上に製造されます。したがって、a-IGZOTFT製造のサーマルバジェットを削減する必要があります。この目的のために、多くの研究者は、スパッタリング[4,5,6]、溶液プロセス[7,8,9]、電子ビーム蒸着[10]、および陽極酸化[11]。ただし、これらの誘電体膜は、高密度のトラップと強い誘電体/ a-IGZO界面散乱に悩まされることが多く、その結果、電界効果移動度が制限され、サブスレッショルドスイングが大きくなり、オン/オフ電流比が小さくなります[4,5,6 、7,8,9,10,11]。
一方、原子層堆積(ALD)は有望な技術であり、高品質の膜、膜厚の正確な制御、広い領域での良好な均一性、および低いプロセス温度を提供できます[12、13、14]。 Zheng etal。 [15]は、ALD SiO 2 を使用したa-IGZOTFTを報告しました。 誘電体は、ポストアニーリングを必要とせずに優れた電気的性能を示しました。ただし、SiO 2 のALDには、250°Cの高い基板温度が必要です。 フィルム[15]は、ほとんどの柔軟なプラスチック基板のガラス転移温度よりも高くなっています。興味深いことに、Al 2 のALDが報告されています O 3 フィルムは室温(RT)でも実現できます[16、17]。一方、Al 2 O 3 RTで堆積された膜には、大量の水素(H)不純物が含まれています[17]。ただし、私たちの知る限りでは、上記のHリッチAl 2 O 3 フィルムは、a-IGZOTFTのゲート絶縁体として利用されたことはありません。したがって、RT ALD Al 2 を使用してa-IGZOTFTを探索することが望ましいです。 O 3 ゲート絶縁体。
この手紙では、高性能a-IGZOTFTが室温で堆積されたAl 2 で正常に製造されました。 O 3 ゲート誘電体。 a-IGZOTFTの特性をさまざまなAl 2 と比較することにより O 3 さまざまな温度で堆積されたゲート絶縁体、根本的なメカニズムに対処しました。
メソッド
高濃度にドープされたp型シリコンウェーハ(<0.0015Ωcm)は、標準のRCAプロセスで洗浄され、ゲート電極として機能しました。 40ナノメートルのAl 2 O 3 フィルムは、トリメチルアルミニウム(TMA)とO 2 を使用して商用ALDシステム(Picsun Ltd.)に堆積されました。 それぞれ、前駆体および反応物としてのプラズマ。 1つの成長サイクルは、0.1秒のTMAパルス、10秒のN 2 で構成されていました。 パージ、8秒O 2 プラズマパルス、および10秒N 2 パージ。 TMAは、安定した蒸気圧とドーズ量のために18°Cに維持され、O 2 ガス流量は2500Wのプラズマ発生器出力で150sccmに固定されました。その後、40 nmのa-IGZO膜が、原子比In:Ga:Zn:O =1のIGZOセラミックターゲットを使用したRFスパッタリングによって堆積されました。 :1:1:4。スパッタリング中、使用圧力とArおよびO 2 ガス流量はそれぞれ0.88Paと48および2sccmに固定されました。活性領域は、フォトリソグラフィーおよびウェットエッチングによって形成された。その後、電子ビーム蒸着とリフトオフ法により、30 nm Ti / 70 nmAu二重層のソース/ドレイン電極を作成しました。これらのデバイスには、これ以上のアニーリングプロセスは適用されませんでした。
a-IGZO TFTの電気的特性は、室温のダークボックス内で半導体デバイスアナライザ(Agilent Tech B1500A)を使用して特性評価されました。デバイスの安定性は、それぞれ正および負のゲートバイアス応力下で測定されました。元素の深さプロファイルと化学組成は、それぞれ二次イオン質量分析(SIMS)とX線光電子分光法(XPS)によって測定されました。
結果と考察
図1aは、Al 2 の誘電率を比較しています。 O 3 周波数の関数としてさまざまな温度で堆積された膜(つまり、10Hzから10 5 Hz)。堆積温度が100°Cから150°Cに上昇すると、膜は誘電率の段階的な低下を示します。同様の傾向は、堆積温度がRTから150°Cに変化するという以前の文献でも報告されています[18、19]。これは、RT Al 2 が原因です。 O 3 フィルムには、OH基の形で最高濃度の水素(H)が含まれています。したがって、対応する誘電率は、電場内でより多くのOH基が回転するために向上します[20]。 10 Hzの測定周波数に関して、RT、100°C、および150°CのAl 2 の抽出された誘電率 O 3 フィルムはそれぞれ8.6、7.9、7.4に等しく、電界効果移動度(μ)の抽出に使用されます。 FE )および界面トラップ密度( D それ )製造されたTFTデバイスの。図1bは、さまざまなAl 2 のリーク電流特性を示しています。 O 3 映画。 RT Al 2 O 3 フィルムは2.38×10 − 8 の小さなリーク電流密度を示します A / cm 2 2 MV / cmおよび5.3MV / cmの破壊電界で。さらに、破壊電界は、堆積温度が100℃から150℃に上昇するにつれて徐々に増加します。
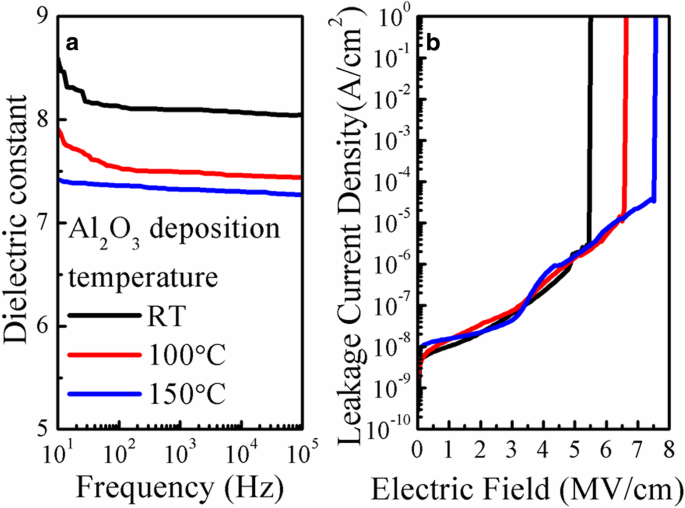
Al 2 の電気的特性 O 3 異なる温度で堆積した膜。 a 誘電率対周波数。 b 漏れ電流密度と電界の関係
図2は、Al 2 が異なるa-IGZOTFTの一般的な伝達曲線を示しています。 O 3 ゲート絶縁体。 RT Al 2 O 3 TFTは、高いμなどの最高のパフォーマンスを発揮します FE 19.5 cm 2 V − 1 s − 1 、160 mV / decの小さなサブスレッショルドスイング(SS)、小さなスレッショルド電圧( V T )0.1 V、オン/オフ電流比が大きい( I オン/オフ )4.5×10 8 。ただし、Al 2 を使用したa-IGZOTFT O 3 100°Cと150°Cの両方で堆積されたゲート絶縁体は、性能がはるかに劣ります。つまり、オン電流が減少します(10 − 7 および3×10 − 9 A)劣化したSS。 D それ Al 2 のインターフェースで O 3 / a-IGZOは、次の式[21]に基づいて計算できます。
$$ {D} _ {\ mathrm {it}} =\ left(\ frac {\ mathrm {SS} \ times \ lg e} {kT / q} -1 \ right)\ frac {C_ {ox}} { q ^ 2} $$(1)ここで e 、 k 、 T 、および q オイラー数、ボルツマン定数、絶対温度、および単位電子電荷をそれぞれ表します。 C ox は、単位面積あたりのゲート誘電容量です。 RT Al 2 の場合 O 3 TFT、 D それ 1.1×10 12 に等しい eV − 1 cm − 2 、これは、Al 2 を備えたTFTの場合よりも1倍または2倍以上低くなっています。 O 3 100および150°Cで堆積されたゲート絶縁体。

ALD Al 2 を使用したa-IGZOTFTの伝達曲線 O 3 抽出されたデバイスパラメータとともにさまざまな温度で堆積されたゲート絶縁体
デバイスのゲートバイアス安定性は、負および正の電圧を印加することによってさらに測定されました。図3は、 V を示しています T 異なるTFTのバイアスストレス時間の関数としてのシフト。負のゲートバイアスストレス(NGBS)に関しては、RT Al 2 O 3 TFTはごくわずかな V を示します T − 10 Vで40分間応力を加えた後の− 0.04Vのシフト。ただし、高温のAl 2 O 3 ゲート絶縁体は、より大きな V を生成します T 特に150°Cでシフトします。 RT Al 2 に対するこのような高いNGBS安定性 O 3 低濃度の酸素空孔( V )に起因する必要があります O )a-IGZOチャンネル[22]。正のゲートバイアスストレス(PGBS)に関しては、RT Al 2 O 3 TFTは V を示します T 1.47 Vのシフト。これは、100および150°CのAl 2 のシフト(8.8Vおよび12.1V)よりもはるかに小さいです。 O 3 TFT。さらに、図4に示すように、デバイスのパフォーマンスに対する保存時間の影響を調査しました。バックチャネルはパッシベーション層で覆われていませんが、デバイスはキャビネット(20%RH)に保管された後も優れたパフォーマンスを維持します。 30°Cで60日間;その間、μに有意な変動はありません FE とSSが観察されます。これは、RT Al 2 を示します O 3 パッシベーション層のないTFTは、現在の環境で保存時間に依存した安定性が良好です。

V T Al 2 を備えたTFTの場合、NGBS =− 10VおよびPGBS =10Vでのバイアスストレス時間の関数としてのシフト O 3 異なる温度で堆積した絶縁体

RT Al 2 の時間依存安定性 O 3 30°Cでキャビネット(20%RH)に保管された後のTFT。 a 伝達曲線。 b モビリティとサブスレッショルドスイング
表1は、RT Al 2 のパフォーマンスを比較しています。 O 3 他のレポートとTFT。私たちのデバイスはゼロに近い V を示していることがわかります T 、小さいSS、大きい I オン/オフ 同等のモビリティの場合[4、23]。 Ta 2 を使用していますが O 5 ゲート絶縁体は61.5cm 2 のより高い移動度を得ることができます V − 1 s − 1 、SSと I の両方 オン/オフ 著しく劣化する[10]。一言で言えば、私たちのRT Al 2 O 3 TFTは、100および150°CのAl 2 と比較して、優れた総合性能を備えています。 O 3 TFT。 Al 2 の堆積ステップを除いて、すべての処理ステップは同一であるため O 3 、電気的性能のこのような大きな違いは、Al 2 に起因するはずです。 O 3 ゲート絶縁体。
<図>根底にあるメカニズムを理解するために、a-IGZO / Al 2 の要素の深度プロファイル O 3 積み重ねられたフィルムはSMISによって分析されました。図5aは、IGZO / Al 2 のスタックの深さに対するH濃度の依存性を示しています。 O 3 、ここでAl 2 O 3 フィルムはそれぞれRTと150°Cで堆積されました。比較のために、裸のSi基板上に堆積されたIGZO膜も分析されました。裸のSi上に堆積されたIGZO膜には、〜3×10 21 のH濃度が含まれています。 cm − 3 、スパッタリングシステムの残留ガスに由来し、H 2 を吸収します。 / H 2 Si表面のO分子。 Al 2 に蒸着された両方のIGZOフィルム O 3 膜には、裸のSi基板よりも高いH濃度が含まれています。これは、H濃度の増加は、基礎となるAl 2 でのH不純物の放出に起因するはずであることを示しています。 O 3 IGZOのスパッタリング中のフィルム。さらに、RT Al 2 の上のIGZOフィルムのH濃度が観察されます。 O 3 膜は、界面近くの領域の150°Cのものよりも高く、界面状態のより効率的な不動態化を提供できます。したがって、これにより、RT Al 2 のSSおよびPGBSの安定性が向上します。 O 3 界面キャリアトラップを低減することによるTFT。さらに、IGZO / Al 2 の界面付近のa-IGZO膜のO1sXPSスペクトル O 3 図5bに示すように、分析されました。適合したピークは、530.2±0.1 eV、530.9±0.1 eV、および531.6±0.1 eVにあり、O 2- に対応します。 金属(O1)と結合したイオン、 V O (O2)、およびOH基(O3)、それぞれ[13、24]。裸のSiの上のa-IGZO層のO2の割合は26.3%です。ただし、150°CおよびRT Al 2 の場合は12.3%および6.8%に減少します。 O 3 それぞれ、基礎となるフィルム。これは、 V が多いことを示しています O IGZOチャネルでは、下にあるAl 2 に由来する追加のH不純物によって効果的に不動態化できます。 O 3 フィルム、特にRT Al 2 O 3 より高いH濃度のフィルム。 V O とHは両方ともa-IGZOフィルムに存在し、それらが結合して、Hが V でトラップされる安定した状態を形成することができます。 O ( V O H)、および結果の V O Hは浅いレベルのドナーです[25、26、27]。したがって、RT Al 2 の上のIGZOチャネルへの強化されたHドーピング O 3 追加の電子を提供することにより、チャネルの導電率を向上させます。さらに、小さな V T RT Al 2 のNGBSの下でシフト O 3 TFTは、 V の効果的なHパッシベーションにも起因する可能性があります。 O [28]。文献で報告されているように、NGBS下でのTFTの不安定性は、中性の V のイオン化に起因します。 O ( V O → V O 2+ + 2e − )[17、29]。さらに、RT Al 2 上のa-IGZOフィルムのO3パーセンテージ O 3 は6.9%で、150°CのAl 2 よりも高くなっています。 O 3 それぞれ(5.3%)と裸のSi(4.6%)。 OH基は反応O 2- に由来する可能性があります + H→OH − + e − IGZO膜の蒸着中[30]。したがって、RT Al 2 の上のIGZOチャネルへの強化されたHドーピング O 3 フィルムはより多くのOH基を生成し、チャネルの導電率の向上にも貢献します。

a Al 2 の水素濃度のSIMSプロファイル O 3 RTおよび150°Cで堆積。 b RT Al 2 に堆積したIGZOチャネルの高分解能O1sXPSスペクトル O 3 、150°CAl 2 O 3 、および裸のSi
結論
高性能a-IGZOTFTは、HリッチAl 2 を使用して、RTの非常に低いサーマルバジェットの下で正常に製造されました。 O 3 O 2 によって作成されたゲート誘電体 プラズマ強化ALD。これは、Al 2 O 3 RTで堆積された誘電体には、高温で堆積されたものよりも多くの水素不純物が含まれています。このように、IGZOのスパッタリング中に放出されたH不純物は、より多くの電子を生成し、a-IGZO / Al 2 の界面状態を効率的に不動態化しました。 O 3 および V O a-IGZOチャンネルで。
略語
- a-IGZO:
-
アモルファスIn-Ga-Zn-O
- ALD:
-
原子層堆積
- D それ :
-
界面トラップ密度
- H:
-
水素
- I オン/オフ :
-
オン/オフ電流比
- NGBS:
-
負のゲートバイアスストレス
- PGBS:
-
正のゲートバイアスストレス
- RT:
-
室温
- SIMS:
-
二次イオン質量分析
- SS:
-
サブスレッショルドスイング
- TFT:
-
薄膜トランジスタ
- V O :
-
酸素空孔
- V O H:
-
酸素空孔に閉じ込められた水素
- V T :
-
しきい値電圧
- XPS:
-
X線光電子分光法
- μ FE :
-
電界効果移動度
ナノマテリアル
- 高性能材料を使用した3D印刷器具
- アートワークでのエポキシ樹脂の使用
- 誘電体メタ表面を介した帯域幅の拡大による完全なテラヘルツ分極制御
- 低抵抗Auオーミックコンタクトを備えた多層SnSeナノフレーク電界効果トランジスタ
- 超長銅ナノワイヤーによるシリコーン複合材料の優れた熱伝導率の向上
- トルエン中の塩を含むABCトリブロック共重合体を使用した秩序あるナノパターンの製造
- 電気抵抗率の低いUV硬化インクジェット印刷された銀ゲート電極
- RGOと3次元グラフェンネットワークが高性能でTIMを共同修正
- 薄膜トランジスタ用の酸化インジウムナノフィルムの原子層堆積
- エッチングストッパーナノレイヤーを介したクリーンなインターフェースプロセスを使用したa-IGZOTFTデバイスのパフォーマンスの向上
- 溶液処理されたナノ結晶p型CuAlO2薄膜トランジスタの調製と特性評価



