MoS2単分子層に対する紫外線オゾン処理の効果:化学蒸着された多結晶薄膜と機械的に剥離された単結晶フレークの比較
要約
多結晶化学蒸着と機械的に剥離された単結晶MoS 2 の間の異なる酸化挙動を報告します 紫外線オゾン処理による単分子層。紫外線オゾン処理時間が0分から5分に増加すると、両方のMoS 2 のフォトルミネッセンス発光とラマンモード 消失し、酸化による構造劣化を示唆している。吸光度とX線光電子分光法による分析は、MoO 3 の形成を示唆しました。 両方のMoS 2 紫外線オゾン処理後。さらに、紫外線オゾン処理により、化学蒸着されたMoS 2 に酸素空孔、オキシ硫化モリブデン、または硫酸モリブデンが形成された可能性があります。 。紫外線オゾン処理後の電気抵抗の測定は、化学蒸着されたMoS 2 の変換を示唆しました。 ドープされたMoO 3 に および機械的に剥離されたMoS 2 無視できるほどドープされたMoO 3 。これらの結果は、単分子層MoS 2 の結晶化度を示しています。 紫外線オゾン処理の効果に強く影響し、MoS 2 のデバイス統合に重要な影響を与える可能性があります およびその他の2次元半導体。
はじめに
MoS 2 などの遷移金属ジカルコゲナイド(TMD)には大きな関心が寄せられています。 、トランジスタ、オプトエレクトロニクスデバイス、ヘテロ接合構造、センサー、電極触媒など、さまざまなデバイスアプリケーションに魅力的な可能性を提供するためです[1、2]。単層TMDに直接バンドギャップが存在するため、これらの2次元半導体はオプトエレクトロニクスデバイスに特に有望です[3、4]。ただし、フォトトランジスタなどのTMDベースのオプトエレクトロニクスデバイスを製造するための重要な課題には、高 k の堆積が含まれます。 TMD上の誘電体とTMDのドーピング。 TMDの表面にはダングリングボンドがないため、高い k を堆積させるのは困難です。 TMD上の誘電体[5]。さらに、シリコンなどのバルク半導体に使用される置換ドーピングは、単層TMDの2次元構造と特性を変更するため、TMDのドーピングも困難です[6]。
これらの困難を克服するために、O 2 によるTMDの表面機能化 プラズマ[7、8]または紫外線オゾン(UV-O 3 )[9,10,11]が提案されています。これらの方法はMoS 2 の表面を機能化することができますが 表面酸化により、それらは単分子層MoS 2 の構造と特性に同時に影響を与える可能性があります [12、13、14、15、16]。たとえば、O 2 による酸化 プラズマまたはUV-O 3 処理により、単分子層MoS 2 のラマン振動モードとフォトルミネッセンス(PL)発光が変化しました [12、16]。ただし、ほとんどの研究はマイクロメートルスケールの単層MoS 2 に基づいていたため バルク単結晶からの機械的剥離によって得られたフレークは、大面積単層MoS 2 との相互作用についてはほとんど知られていません。 通常は多結晶である薄膜。多結晶単分子層MoS 2 の粒界 UV-O 3 との反応性を高めることができます 単結晶よりも酸化挙動が異なります。したがって、この研究では、UV-O 3 の効果を調査します。 MoS 2 での治療 多結晶化学蒸着(CVD)薄膜と機械的に剥離した単結晶フレークの酸化挙動を直接比較することによる単分子層。両方のMoS 2 のPLおよびラマンスペクトルを体系的に調査します。 UV-O 3 の異なる持続時間の単分子層 暴露。また、両方のMoS 2 の酸化挙動を調査します。 UV-O 3 中の単分子層 X線光電子分光法(XPS)による処理。さらに、元の状態とUV-O 3 の電気抵抗を測定します。 処理されたMoS 2 UV-O 3 の効果を理解するための単分子層 MoS 2 での治療 単層。
メソッド
単層MoS 2 薄膜は(0001)配向サファイア基板上に堆積されました(〜1.5×1cm 2 )2ゾーン管状炉でのCVDによる。 MoO 3 (99.98%、Sigma-Aldrich)およびS(99.98%、Sigma-Aldrich)粉末を2つの別々のAl 2 O 3 ボートは前駆体として使用されました。 MoO 3 粉末(14 mg)をゾーン1(750°C)の上流に配置し、S粉末(1.4 g)を炉の上流入口に配置しました。基板はゾーン2(700°C)の下流に配置されました。 MoO 3 粉末を15°Cmin -1 の速度で加熱しました 基板は38°C分 -1 で加熱されました 。 30分の堆積後、炉をゆっくりと室温まで冷却した。堆積中、100sccmのArフローと約0.5Torrの圧力が維持されました。単層MoS 2 フレークは、バルクMoS 2 から金を介した剥離法[17]によって得られました。 結晶(2D半導体)および熱成長したSiO 2 を備えた高濃度ドープSi基板上に転写 (300 nm)。図1は、両方のMoS 2 の概略構造を示しています。 基板上の単分子層。単分子層MoS 2 の厚さ 原子間力顕微鏡(AFM、Park Systems XE-100)を使用して測定しました。バルクMoS 2 の結晶化度 結晶とCVDMoS 2 薄膜は、X線回折(XRD、Cu-Kα放射線を使用したBruker D8 Discover)および透過型電子顕微鏡(TEM、300kVでFEITitan 80–300)によってそれぞれ調査されました。
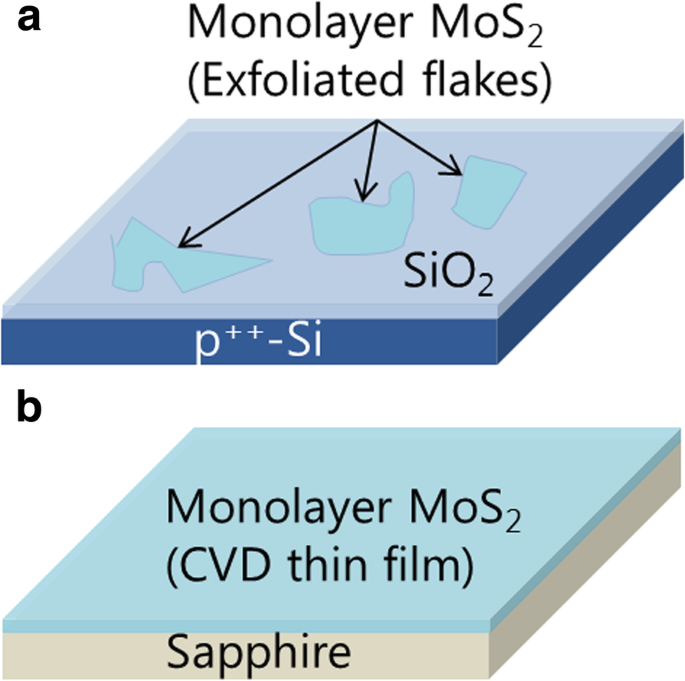
MoS 2 の概略構造 単層: a SiO 2 上の機械的に剥離したフレーク / Si基板と b サファイア基板上のCVD薄膜
MoS 2 単層はUV-O 3 にさらされました (SEN LIGHTS PL16–110、185 nm、および254 nm)58 mW cm -2 の放射照度で0〜5分間 。吸光度は、UV-可視分光法(PerkinElmer Lambda 35)によって測定されました。ラマン/ PL分光法(Horiba Jobin-Yvon LabRam Aramis)は、元の状態とUV-O 3 で測定されました。 処理されたMoS 2 532nmのレーザーと0.5mWのビームパワーを備えた単分子層。 XPS(Thermo Scientific K-Alpha)は、単色のAl K αを使用して実行されました。 X線源(hν =1486.7eV)、離陸角度45°、通過エネルギー40 eV、スポットサイズ直径400μm。すべてのサンプルで、C1sとO1sが観察されたのは、XPS分析のために超高真空チャンバーにロードされる前に大気にさらされたためと考えられます。 XPSスペクトルの電荷補正基準として、偶発的な炭素(284.8eVのC1s)を使用しました。エネルギー分解能は、Ag 3d 5/2 の半値全幅を使用して測定した0.7eVです。 ピーク。 MoS 2 サンプルは、XPS機器に持ち込まれる間、大気にさらされました。その場でのXPS分析はより正確な情報を提供することができましたが、この作業では利用できませんでした。ピークデコンボリューションとバックグラウンドサブトラクションには、Thermo Scientific Avantage DataSystemソフトウェアを使用しました。 XPSスペクトルを適合させるためにガウス関数が使用されました。
MoS 2 の電気抵抗を測定するには 単分子層、Au接点(100×100μm 2 、70 nmの厚さ)がMoS 2 の上に堆積されました 電子ビーム蒸発による。次に、Au層の上にスピンコーティングされたフォトレジストを従来のフォトリソグラフィーによってパターン化して、その後のエッチングのための開口領域を形成した。王水でのウェットエッチングによって開口部のAuを除去した後、残っているフォトレジストをアセトンで除去しました。次に、デバイスを管状炉(100 sccmArおよび10sccm H 2 )内で200°Cで2時間アニールしました。 )フォトレジストの残留物を除去し、接触抵抗を低減します。電気抵抗は電流-電圧( I )で計算されました – V )大気環境での測定(Keithley 4200-SCS)。
結果と考察
AFM測定に加えて、PLおよびラマンスペクトルを測定して、MoS 2 の形成を確認します。 単層。直接バンドギャップがあるため、MoS 2 単分子層は、〜1.88 eVでのPL発光を可能にします[3、4]。さらに、2つの特徴的なラマンA 1g 間の周波数差 およびE 1 2g MoS 2 のモード 単層は20cm未満です -1 [18]。図3では、元のMoS 2 のPL放出 〜1.88 eVは、両方のMoS 2 単層です。図4では、元のMoS 2 19.6〜19.9 cm -1 の周波数差を示します 単層MoS 2 を意味します 。 XRDおよびTEM分析は、バルクMoS 2 の単結晶の性質を示しました。 単分子層MoS 2 の結晶と多結晶性 薄膜(追加ファイル1:図S1)。単分子層MoS 2 の粒径 薄膜は〜10nmです[19]。
UV-O 3 後 治療、MoS 2 単分子層は色が変わり、透明になります。図2a、bでは、剥離したフレークとCVD薄膜の両方が5分間のUV-O 3 後に透明になります。 処理。 MoS 2 の吸光度スペクトル 図2cの薄膜は、UV-O 3 後の違いを明確に示しています。 処理。 (剥離したMoS 2 の吸光度 フレークのサイズが小さすぎるため、UV-可視分光法ではフレークを測定できませんでした。)元のMoS 2 薄膜は、励起子遷移(AおよびB)[3、4]、5分間のUV-O 3 による吸光度のピークを示します。 処理されたMoS 2 薄膜は、同じ波長範囲で吸光度のピークをまったく示しません。薄黄緑色のMoS 2 薄膜は、5分間のUV-O 3 後に可視光に対して透明になります 処理では、元の単分子層MoS 2 のエネルギーバンドギャップが予想されます。 (〜1.88 eV)UV-O 3 の後に広くなる 治療(> 〜3 eV)。これは、MoO 3 のワイドバンドギャップとよく一致しているためです。 (> 2.7 eV)[20]、透明なUV-O 3 処理されたMoS 2 MoO 3 の形成を示唆している 5分のUV-O 3 後 治療。
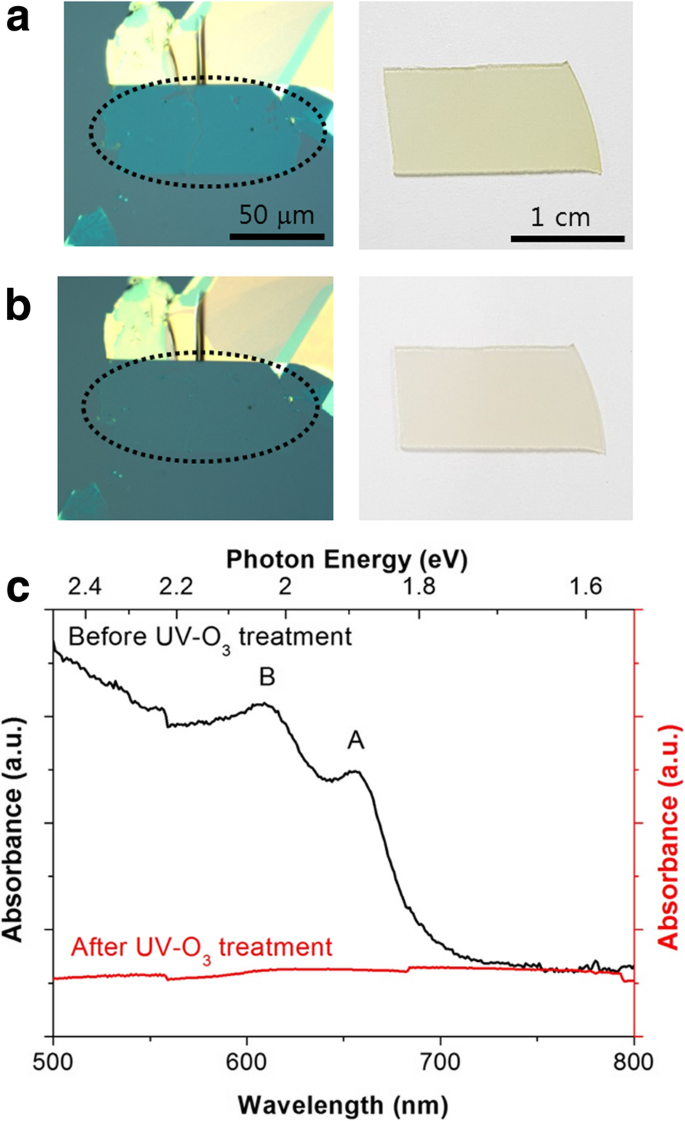
MoS 2 の機械的に剥離したフレークとCVD薄膜 単層 a 前と b 5分のUV-O 3 後 処理(点線の領域は単層を示します)、 c 5分間のUV-O 3 前後のCVD薄膜の吸光度 治療
次に、UV-O 3 の効果を調査します。 MoS 2 のPL放出の処理 単層。図3は、CVD MoS 2 のPLスペクトルを示しています。 薄膜と剥離したMoS 2 UV-O 3 後の単結晶フレーク それぞれ0、1、3、5分間の曝露。 PL発光の強度はUV-O 3 で大幅に減少します 処理時間、そして最終的にはPLは5分間処理されたMoS 2 で完全にクエンチされます 単層。これらの結果は、UV-O 3 の後に非放射再結合を可能にする酸化物または欠陥の形成を示唆しています。 処理。 MoS 2 として 単分子層はUV-O 3 の後に透明になります 処理、ワイドバンドギャップ半導体MoO 3 の形成 合理的に期待されます。自然のままのMoS 2 のPL放出のエネルギー 剥離フレークの場合は1.88eV、CVDフィルムの場合は1.86eVです。このわずかな違いは、基板がラマンおよびPL発光に強く影響する可能性があるため、おそらく下にある基板の影響によるものです[21]。 CVD単分子層のPL発光ピークの幅が広いことは、欠陥密度が高いことを示しています。興味深いことに、単結晶MoS 2 では、PL発光ピークのさらなる負のシフトが観察されます。 UV-O 3 後のCVD薄膜(〜10 meV)よりもフレーク(〜50 meV) 処理。 PL発光の負のシフトは、MoS 2 のトリオン結合エネルギー(10〜40 meV)に匹敵するため [22]、これは、酸化誘起ドーピングによって形成されたトリオン(電子または正孔を受け入れる中性励起子)の濃度が異なるためである可能性があります[23、24]。 (この作品では、単結晶MoS 2 フレークはCVDMoS 2 よりも導電性が高い 、単結晶MoS 2 のドーピングレベルが高いことを示唆しています 。)単結晶MoS 2 のより高いドーピングレベル フレークは高濃度のトリオンを可能にし、その再結合がそれらのPL放出を支配します。対照的に、CVD MoS 2 の低ドーピングレベル 薄膜はトリオンの低濃度を可能にします。したがって、それらのPL放出は、中性励起子の再結合によって支配されます。ただし、PL放出の負のシフトは、下にある基質または菌株の影響にも関連している可能性があるため、将来的にはより体系的な調査が必要です。

MoS 2 のPLスペクトル 単層 a SiO 2 上の機械的に剥離したフレーク / Si基板と b UV-O 3 後のサファイア基板上のCVD薄膜 0、1、3、5分間の治療
次に、UV-O 3 による構造劣化を調査します。 処理では、MoS 2 のラマンスペクトルを測定します UV-O 3 後の単分子層 それぞれ0、1、3、5分間の治療(図4)。両方のE 1 の強度 2g およびA 1g 治療時間が長くなると、モードは減少します。 E 1 間の周波数差が 2g およびA 1g モードは、UV-O 3 の0〜5分間変更されません。 治療時間では、2つのラマンモードは5分間の治療後にほぼ完全に消失し、深刻な構造の歪みと劣化を示唆しています。 AFM分析は、UV-O 3 後の表面粗さの増加を示しています 処理(追加ファイル1:図S2)。これはMoS 2 の酸化と一致しています。 [23]。

MoS 2 のラマンスペクトル 単層 a SiO 2 上の機械的に剥離したフレーク / Si基板と b UV-O 3 後のサファイア基板上のCVD薄膜 0、1、3、5分間の治療
MoS 2 の構造劣化をさらに調査する UV-O 3 による単分子層 処理では、MoS 2 のXPSスペクトルを測定します 。 XPSのビームサイズは単層MoSのサイズよりもはるかに大きいため 2 フレーク、単結晶MoS 2 のXPSスペクトル フレークは、大面積のMoS 2 から取得されます。 単結晶(サイズは約1 cm、厚さは約100μm)。図5は、バルク単結晶およびCVD MoS 2 のMo3dおよびS2p領域のXPSスペクトルを示しています。 それぞれ薄膜。 Mo 4+ の存在 -元のMoSの状態 2 Mo 3d 3/2 の結合エネルギーから観察できます。 およびMo3d 5/2 軌道。 UV-O 3 後 露出、Mo 6+ の強度 -235.9 eVの状態は、UV-O 3 でさらに増加します Mo-O結合とMoO 3 の形成の拡大を示す処理時間 。 Mo 3d領域では、図5aとbの間に4つの明確な違いがあります。 (1)図5bでは、Mo 6+ -元のMoS 2 で235.9eVの状態 薄膜は、CVDプロセス中またはプロセス後に形成された残留酸化物が原因である可能性があります。 (2)Mo 4+ の強度 そしてS2のピークはCVDMoS 2 で減少します UV-O 3 が長い薄膜 暴露。ただし、Mo 4+ の強度 S2のピークはUV-O 3 では変化しません 大きなMoSでの治療時間 2 XPSはMo 4+ を検出できるため単結晶 MoS 2 からのS2のピーク 酸化された上面の下。 (3)単結晶MoS 2 、Mo 4+ の結合エネルギー -状態は、CVD MoS 2 よりもさらに正のシフトを示します。 より高いn型ドーピングを示唆する薄膜[25]。 MoS 2 の酸化後のピークシフト この作品の(0.41〜1.09 eV)は、文献の作品(0.6〜1.1 eV)に匹敵します[23、24]。 (同様の正のシフトを引き起こす可能性のある帯電効果を防ぐために、XPS測定中にフラッドガンを使用しました。)(4)CVD MoS 2 薄膜、Mo 5+ のピーク -状態はUV-O 3 でも表示されます おそらく酸素空孔の形成を示唆する治療[26]またはオキシ硫化モリブデンMoO x S y [27]。これらの結果は、Mo 4+ の酸化によって理解できます。 -MoS 2 の状態 より高い酸化状態(Mo 5+ およびMo 6+ )UV-O 3 を使用 暴露。これは、多結晶多層MoS 2 でのXPSの結果とも一致しています。 O 2 以降の薄膜 プラズマまたはUV-O 3 治療[26、28、29]。

MoS 2 のXPSスペクトル a バルク単結晶と b UV-O 3 後のサファイア基板上のCVD薄膜 0、1、3、5分間の治療
S 2p領域では、S 2- の存在 -状態はS2p 1/2 の結合エネルギーから観察できます。 およびS2p 3/2 手付かずのMoS 2 の軌道 。 S 2- の結合エネルギー -単結晶MoS 2 の状態 CVD MoS 2 よりもさらに正のシフトを示します より高いn型ドーピングを示唆する薄膜[25]。 S-O結合はUV-O 3 で〜165eVで観察されますが 処理された単結晶MoS 2 、CVD薄膜の検出限界を下回っています。代わりに、硫黄酸化状態の新しいダブレットピークが、UV-O 3 後のCVD薄膜のより高い結合エネルギー(〜169 eV)で現れます。 3分間の治療。この新しいダブレットは、酸化硫黄S 6+ のS2pピークに対応します。 、おそらくさまざまな硫酸モリブデンMo(SO 4 ) x [28]。 S 2- の強度が ダブレットはUV-O 3 が長くなると減少し続けます 露出、S 6+ の強度 ダブレットは、5分間のUV-O 3 後にさらに増加します 治療、S 2- のさらなる変換を示唆 より高い酸化状態(S 6+ )酸化による。同様にMo 4+ ピーク、S 2- の強度 ピークはUV-O 3 では変化しません 大きなMoSでの治療時間 2 単結晶。 S 6+ の存在 -O 2 の後の状態 プラズマまたはUV-O 3 治療は文献で一貫性がありません。その存在は多結晶多層MoS 2 で報告されました O 2 以降の薄膜 プラズマ治療[28]。ただし、他の多結晶多層MoS 2 では観察されませんでした。 O 2 後の薄膜[26、29]または単結晶[9、16、30] プラズマまたはUV-O 3 処理。この不一致は、MoS 2 の用量依存性と時間依存性に関連している可能性があります。 酸化[30]、将来これを明らかにするために、より体系的な調査が必要です。
XPSの動作の違いは、単結晶とCVD薄膜の組成と結晶化度の違いに関連している可能性があります。 Mo:Sの組成はバルク単結晶で1:1.97、CVD薄膜で1:1.5であり、CVD薄膜中のS空孔の濃度が高いことを示唆しています。 S空孔の濃度が高いことと、CVD薄膜に粒界が存在することにより、単結晶よりも酸素に対する反応性が高くなる可能性があります。
MoS 2 の酸化をさらに理解する UV-O 3 による単分子層 処理では、元の状態とUV-O 3 の電気抵抗を測定します 処理されたMoS 2 単層。電気抵抗にはサンプルごとのばらつきがあるため、電気抵抗の相対比( R )を使用します。 後 / R 前 )、ここで R 後 および R 前 UV-O 3 の前後の電気抵抗です それぞれ治療。図6は、 R を示しています 後 / R 前 UV-O 3 の関数として 治療時間。 R 後 / R 前 剥離したMoS 2 単結晶フレークは、処理時間が長くなると大幅に増加します。 R 後 / R 前 CVD MoS 2 の 薄膜は処理時間が長くなると減少します。これらの結果は、MoO 3 UV-O 3 によって形成されます CVD MoS 2 の治療 薄膜はMoS 2 よりも高いドーピングレベルを持っています 単結晶フレーク。これは、酸素空孔、MoO x の存在の可能性を示唆するXPS分析によってサポートされています。 S y 、またはMo(SO 4 ) x CVD MoS 2 単層。これは、単結晶MoS 2 でのより高いドーピングと矛盾しているようです。 図5aで提案されています。ただし、図5aはバルク単結晶に基づいているため、上部の単分子層の正確な情報が提供されない可能性を排除することはできません。したがって、バルクMoS 2 の表面酸化 単結晶は、MoS 2 にのみドーピングを提供する可能性があります 下にある単結晶、上面領域を無視できるほどドープされたMoO 3 に変換 。これらの結果と一致して、単分子層MoS 2 の場合、電気抵抗も増加しました。 単結晶フレークはO 2 によって酸化されました プラズマ[12]。単結晶MoS 2 として 粒界がないと、多結晶MoS 2 よりも酸化に対して耐性があります。 、酸化誘起ドーピングの効果は、多結晶MoS 2 でより強くなる可能性があります 単結晶MoS 2 より 。ただし、将来この違いを理解するには、さらに調査が必要です。

MoS 2 の電気抵抗の比率 UV-O 3 の関数としての単分子層 治療時間( R 後 :UV-O 3 後の電気抵抗 治療、 R 前 :UV-O 3 前の電気抵抗 治療)
結論
要約すると、UV-O 3 の効果を調査しました 多結晶CVD薄膜および単層MoS 2 の単結晶フレークの処理 。単層MoS 2 UV-O 3 後に透明になります ワイドバンドギャップ半導体MoO 3 の形成を示唆する処理 。 UV-O 3 として 処理時間が長くなると、PLおよびラマンスペクトルの強度が大幅に低下し、酸化物または欠陥の形成が示唆されます。両方のMoS 2 、XPS分析はMo-O結合とMoO 3 の形成を示しました 。ただし、CVDではMoS 2 薄膜、Mo 4+ の変換 -およびS 2- -Mo 5+ への状態 -およびS 6+ -状態は、UV-O 3 の後にも観察されました。 治療、酸素空孔の存在の可能性を示唆、MoO x S y 、またはMo(SO 4 ) x 。単結晶MoS 2 の電気抵抗として 単分子層は、UV-O 3 が長くなると大幅に増加しました 処理時間、単結晶MoS 2 の酸化 MoO 3 に ドーピングはごくわずかであるようです。対照的に、CVD MoS 2 の電気抵抗 単分子層はUV-O 3 が長くなると減少しました 治療時間、CVD MoS 2 の酸化を示唆 MoO 3 に ドーピングを提供します。これらの結果は、UV-O 3 の効果に対する結晶化度の重要な影響を示しています。 MoS 2 での治療 単分子層。2次元ナノ材料に基づくヘテロ接合構造の製造に興味深い影響を与える可能性があります。
データと資料の可用性
すべてのデータと資料は、合理的な要求に応じて提供される場合があります。
略語
- CVD:
-
化学蒸着
- I-V:
-
電流-電圧
- R 後 :
-
紫外線オゾン処理後に測定された抵抗
- R Before :
-
紫外線オゾン処理前に測定された抵抗
- TMD:
-
遷移金属ジカルコゲニド
- UV-O 3 :
-
紫外線オゾン
- XPS:
-
X線光電子分光法
ナノマテリアル
- 電気触媒水素発生のための制御された厚さのMoS2
- TIPS-ペンタセンベースの有機電界効果トランジスタの移動度と形態に及ぼすその場アニーリング処理の影響
- 剥離したテルルを含む単一原子鎖に向けて
- MoS2 / GaAsヘテロ接合における大きな横方向光起電力効果
- 多層MoS2フォトトランジスタのバイアス依存光応答性
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- クルクミンの処理効果を持つPEGコーティングされたCoFe2O4ナノ粒子の毒性
- チタニアナノチューブの熱伝導率に及ぼす形態と結晶構造の影響
- 廃水処理におけるナノ材料とナノテクノロジーの役割:計量書誌学的分析
- リチウムおよびナトリウムイオン電池の安定した性能の陰極としてのアモルファス酸化バナジウム薄膜



