HfOx薄膜に分散したAg濃度がスレッショルドスイッチングに及ぼす影響
要約
スニークパス電流(隣接するメモリセルを通過する電流)は、メモリスタメモリセルで構成されるクロスバーアレイに固有の避けられない問題です。この深刻な問題は、セレクタデバイスを各メモリスタセルに直列に接続することで軽減できます。さまざまなタイプのセレクターデバイスの概念の中で、拡散セレクターはその優れた性能のためにかなりの注目を集めています。このセレクターは、固体電解質の電極またはドーパントとして機能するAgやCuなどの活性金属のダイナミクスを使用した揮発性しきい値スイッチング(TS)を備えています。この研究では、AgをドープしたHfO x に基づく拡散セレクター 共スパッタリングシステムを使用して製造されます。 HfO x のAg濃度として 層が変化し、異なる電気的特性が観察され、それによってTS特性が観察されます。 TS特性のための電鋳(EF)プロセスの必要性は、HfO x の適切なAg濃度によって決定されます。 層。 EFプロセスのこの違いは、TS特性のパラメータに大きな影響を与える可能性があります。したがって、拡散セレクターが優れたセレクターデバイスの動作を実現し、最終的にデバイスのパフォーマンスを低下させる可能性のあるEFプロセスを回避するには、最適化されたドーピング条件が必要です。
はじめに
メモリスタとしても知られる抵抗スイッチングメモリは、次世代の不揮発性メモリの有望な候補として、何十年にもわたって広く研究されてきました。最近、メモリスタデバイスは、脳に触発されたコンピューティングのためのイオン移動に基づくスイッチングメカニズムに似た人工シナプスおよびニューロンに適用されています[1,2,3]。高速スイッチング速度(<1 ns)、極端なスケーラビリティ(<2 nm)、かなり良好な耐久性(最大10 11 プログラミング/消去サイクル)、および3次元スタッキング構造は、これまでのところ、個々の記憶システムで証明されています[4、5、6]。さらに、大きなクロスバーアレイ(CBA)を構築することで画像処理とパターン認識を可能にすることができます[1、3、7、8]。
ただし、CBA構造には、隣接するメモリスタメモリセルを流れるスニークパス電流が、選択されたセルまたは半分選択されたセルでの書き込み/読み取り操作を妨害するという固有の問題があります[9、10、11]。スニークパス電流とハーフセレクトの問題を抑制するために、2端子セレクタデバイスを各メモリセルに直列に接続できます。非線形電流-電圧( I )を備えたセレクターデバイスには多くの種類があります - V )ショットキーダイオード、金属-絶縁体転移(MIT)、オボニックスレッショルドスイッチ(OTS)、トンネルバリアセレクター、拡散セレクター(拡散メモリスタとも呼ばれる)などの特性が導入されています[9、10、11、12、13、14 、15]。その中でも、誘電体内の金属種(AgまたはCu)の拡散ダイナミクスに基づく拡散セレクターは、その単純な構造と非常に高い非線形性などの優れた性能により、大きな関心を集めています[14、15、16、17、18、 19、20、21、22]。拡散セレクターは、金属フィラメントの形成と自己破壊に基づく揮発性しきい値スイッチ(TS)を備えています。これまでに、さまざまな拡散セレクタシステムとその動的特性が報告されています。ただし、基礎となる操作メカニズムを理解することは依然として困難です。さらに、優れたTS性能を実現するには、拡散金属種の濃度と分布を確立する必要があります。これらは、電気伝導と遷移特性に大きな影響を与える可能性があるためです。
ここでは、Pt / AgをドープしたHfO x を作製しました。 拡散セレクターとしての/ Ptスタック。AgとHfO x それぞれ、拡散性の金属ドーパントおよび誘電体材料として機能します。 TS特性に適した条件を関連付けるために、さまざまなドーピング濃度でのデバイスの電気的特性を調べました。電鋳が必要(EFが必要)および電鋳が不要(EFが不要)のTS特性は、拡散セレクターのドーパント濃度によって決定されました。電鋳(EF)プロセスとそれに続くTS特性の違いを説明するために、拡散セレクターデバイスの構造的および化学的分析を行いました。私たちの研究は、拡散セレクターのTS特性に対するドーパント濃度の影響を示唆し、その性能を改善する方向性を提供します。
メソッド
図1aは、AgとHfO 2 を備えた同時スパッタリングシステムを示しています。 目標。基板上の4つの位置に0.5cm離れたデバイスを作製しました。位置はHfO 2 の近くでした 図1aに示すように、デバイス1、2、3、4(D1、D2、D3、D4)の順序でターゲットを設定します。 AgをドープしたHfO x すべてのデバイスのスイッチング層がPt / Ti / SiO 2 に堆積されました Agの場合は10W、HfO 2 の場合は150Wのスパッタリングパワーでの同時スパッタリングによる/ Si基板 、 それぞれ。堆積プロセスの前に、真空チャンバーのベース圧力を最大5×10 6 まで排気しました。 。スイッチング層は、Arプラズマを維持するために20 sccmのArフローの下で室温で基板を回転させることなく5分間堆積されました。プロセス圧力は10mTorrでした。その後、上部のPt電極は、電子ビーム蒸着を介して直径200μmのシャドウマスクを使用して、堆積されたままのスイッチング層上に堆積された。図1bとcは、それぞれ、製造されたデバイスの断面画像と概略設計を示しています。
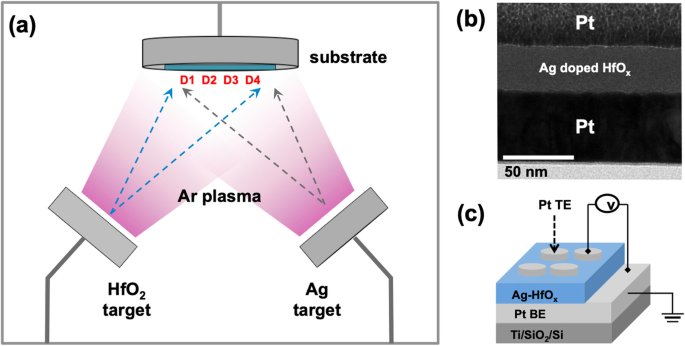
a 共スパッタリングシステムの概略図。 b 作製したデバイスの断面TEM画像。 c 電気測定システムを備えたデバイスの概略図
同時スパッタリングによって堆積されたスイッチング層の厚さは、エリプソメーター(FS-1、Film-Sense、USA)を使用して測定された。ラザフォード後方散乱分光法(RBS; 6SDH-2、NEC、米国)および蛍光X線分析(XRF; ARL、サーモフィッシャーサイエンティフィック、米国)を実施して、AgドープHfO x 層。デバイスの電気的特性を評価するために、半導体パラメーターアナライザー(SPA; HP-4155A、Agilent、USA)を室温で使用しました。すべての測定は、図1cに示すように、下部電極を接地した状態で上部電極にバイアスをかけることによって実行されました。デバイスの表面は、電界放出走査型電子顕微鏡(FE-SEM; JSM-6700F、JEOL、日本)および原子間力顕微鏡(AFM; XE-100、パークシステム、韓国)を使用して分析されました。デバイスの断面サンプルは、集束イオンビーム(FIB; Quanta 3D FEG、FEI、オランダ)プロセスを使用して準備され、高分解能透過型電子顕微鏡(HR-TEM:JEM-2100F、JEOL、日本)を使用して観察されました。 )。化学組成は、エネルギー分散型X線分光法(EDS)を使用して分析されました。
結果と考察
4つのAgドープHfO x を同時に製造しました 単一プロセス中の拡散セレクター用のデバイス。堆積プロセス中、電気的特性に対するドーピング濃度の影響を確認するために、基板を回転させなかった。表1は、それぞれD1、D2、D3、およびD4の厚さ、Ag:Hfカチオン比、および二乗平均平方根(RMS)粗さを示しています。スイッチング層のAg組成は、XRF分析から得られたAgとHfの量を使用してカチオン比として表されました。示されているように、各デバイスは異なる厚さとAg濃度を持っています。 HfO 2 からの距離が長くなると ターゲットでは、酸化物層のAg組成が増加する一方で、スイッチング層の厚さが減少しました。 Ag濃度を上げると、RMS粗さの値がわずかに増加します(AFM画像は追加ファイル1:図S1に示されています)。
<図>直流(DC)-電圧( I - V )すべてのデバイスから測定された特性を図2a〜dに示します。 D1(35.3 nm、7%Ag)は最初は高絶縁状態であり、厚いスイッチング層にもかかわらず導電性フィラメントを生成するにはAg濃度が不十分であったため、DC測定中にしきい値スイッチングは観察されませんでした(図1a)。対照的に、D2(27.3 nm、16%Ag)は、元の状態での電鋳(EF)プロセスに続いて、高抵抗状態(HRS)から低抵抗状態(LRS)に切り替わるしきい値を示し、動作可能なデバイスを生成しました。図1bに示すように。 EFプロセス中に、電流が低レベルから増加してコンプライアンス電流( I )に到達しました cc )− 4.3 Vの電圧で。その後、D2は、両方のバイアス極性で形成電圧よりも低い動作電圧でTS動作を継続的に示しました。同様に、D3(24 nm、39%Ag)は、典型的な双方向TS動作を示しました。ただし、D3の元の状態ではEFプロセスは必要ありませんでした。言い換えると、D3はEFフリーのTS動作を示します。対照的に、D4(18.8 nm、58 Ag%)は、おそらく薄いHfO x 内のAgパーコレーションのために、最初は高導電性状態でした。 高いAg濃度が与えられた層。

製造されたデバイスの電気的特性。 a I-V D1(高絶縁状態)の曲線。 b I-V D2の曲線で、EFプロセスとその後のTSの動作を示しています。 c I-V D3の曲線、EFプロセスなしのTSの動作を示しています。 d I-V D4(導通状態)の曲線
表面形態と粒子サイズは、Ag濃度の増加とともに変化しました。前述のように、Ag濃度の増加に伴い、表1に示すようにRMS粗さの値が増加しました。粒子サイズもSEMを使用して評価されました(追加ファイル1:図S2)。 Ag濃度が増加するにつれて、粒子サイズの増加が観察された。ただし、TS特性が異なるD2とD3の場合、表面粗さと結晶粒径の差は非常に小さかった。それにもかかわらず、EFプロセスとそれに続くTS特性に関して、それらの電気的特性にはかなりの違いがありました。そこで、D2とD3のTS特性を次のようにさらに比較しました。
図3aおよびbは、DC測定を介してD2およびD3で観察された再現可能なTSの動作を示しています。比較のため、負バイアスでのTS特性のみを図に示します。両方のデバイスは、最初、検出限界以下の-0.1VでいくつかのpA電流レベルを示しました。 D2でのTSの動作は、EFプロセス後、〜− 3.5 Vの形成電圧で、コンプライアンス電流( I cc )ハードブレークダウンを防ぐために、デバイスには5μAを設定しました。 EFプロセスの後、デバイスは図3aに示すような典型的なTS動作を示しました。印加電圧がしきい値電圧( V )を超えたとき th )〜− 1.1 Vの場合、電流は突然 I に達しました cc 5μAの;デバイスはオフ状態からオン状態に切り替わりました。ただし、印加電圧がホールド電圧( V )未満に低下すると、デバイスのオン状態はオフ状態に回復しました。 ホールド )。デバイスはオフ状態に戻りましたが、EF前のデバイスよりも高いオフ電流が観測されました。
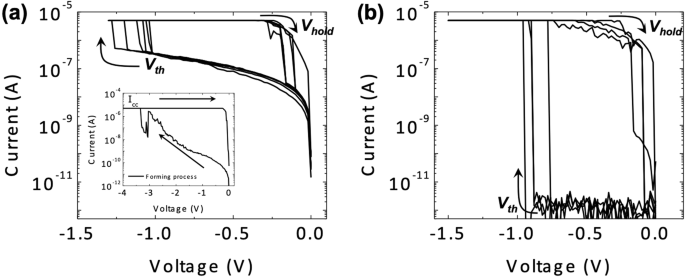
D2とD3のTS特性の比較。 a EFプロセスに続いてオフ電流が増加したTSの動作。挿入図は、デポジットされたままのデバイスでのEFプロセスを示しています。 b EFプロセスが低いオフ電流と高い NL を維持しない場合のTSの動作
D3も、図3bに示すように典型的なTS特性を示しました。ただし、元の状態のデバイスでTS動作を誘発するために、EFプロセスは必要ありませんでした。電流は I に達しました cc V で5μA th オン状態である〜− 0.8 Vの値であり、 V で自発的に初期オフ状態に戻ります。 th 〜− 0.2V未満。後続のD3 I - V ループは最初の I と似ていました - V ループします。さらに、デバイスは、D2のそれと比較して低い動作電圧で一貫して低いオフ電流を示しました。さらに、D3のオフ状態の電流密度は依然としてD2の電流密度よりも低いままでした。差は約10 5 でした A / cm 2 。その結果、HfO x のAg濃度の違いが確認されました。 レイヤーがEFプロセスの必要性を判断し、TSの特性が劇的に変化しました。
1つのセレクターと1つの抵抗メモリ(1S1R)を実現するには、セレクターはリーク電流を抑制するために低いオフ電流と、抵抗メモリのリセット電流に対応する高いオン電流を必要とします[21、22]。そのような私を満たすために - V 非線形特性、非線形性を確認しました( NL )と選択性( S )当社のデバイスと、セレクターとしてのパフォーマンスを評価するために以前に報告されたTSセレクターのデバイス[14、18、21、22、23]。ここでは、 NL を定義します および S 式を使用します。 (1)と(2)は、それぞれ次のとおりです。
$$ NL =\ frac {I_ {V _ {\ mathrm {th}}}} {I _ {\ frac {1} {2} {V} _ {\ mathrm {th}}}} $$(1)$$ S =\ frac {I _ {\ mathrm {ON}}} {I _ {\ mathrm {OFF}}} $$(2)NL V での電流の比率として定義されます th および V の半分 th 。クロスバー配列のハーフバイアススキームでは、 V th V の半分の間にターゲティングセルに適用されます th 隣接する半分選択されたセルに適用されます。したがって、 NL プログラム/読み取り操作中にクロスバーアレイが誤動作するのを防ぐために重要です。対照的に、 S V でのON状態とOFF状態の電流の比率です。 th 、TSベースのセレクターのパフォーマンスを表します。どちらの定義も、セレクターデバイスのパフォーマンスの比較に広く使用されています。したがって、大きな NL および S スニークパス電流を効果的に抑制するには、1S1R動作に値が必要です。
NL を含むさまざまなスイッチングパラメータ および S 私たちのデバイスと文献のTSセレクターを表2に示します。D2の場合、OFF電流が増加すると、 NL が大幅に減少します。 および S 。対照的に、D3 OFF電流は十分に低く、10 6 を超えます。 NL および S 買収されました。ただし、D2とD3は、低い I でのみTS特性を示すことができました。 cc (<10μA)TSがより高い I でメモリスイッチングに移行したため cc 。 Agフィラメントを使用するほとんどのTSセレクターデバイスは、 I で不揮発性メモリスイッチングの遷移を受けることはよく知られています。 cc 10–100μAを超える[23,24,25,26]。 私のとき cc が10〜100μAより高い場合、より低い I で形成された細くて不安定なフィラメントと比較して、自発的に破裂しにくい堅牢で安定した金属フィラメントが形成されます。 cc [26、27]。したがって、多層構造(Ag / TaO x / TaO y / TaO x / Ag)および誘電体にテンプレート化されたAgナノドットは、より高い I で信頼性の高いTS特性を取得することが提案されています。 cc [21、22]。
<図>HfO x 内のAg原子のサイズと分布を観察する 層、HR-TEMおよびEDS元素分析はD2およびD3で実行されました。図4aおよびb(cおよびd)は、D2(D3)の断面HR-TEM画像を示しています。 HR-TEM画像によると、Agの原子サイズはHfO x に均一に分散している可能性があります。 マトリックス。両方のデバイスで、数ナノメートルのサイズの識別可能なAg粒子またはAgクラスターは観察されませんでした。さらに、HfO x 図4bおよびdの挿入図に示すように、アモルファス相は高速フーリエ変換(FFT)画像によって確認されました。ただし、ラインプロファイルのAg信号は、HfO x にAgが存在することを示しています。 層。したがって、HfO x のAgは 原子スケールで配布されます。 Agナノフィラメントを含むスイッチング領域を調査する必要があります。ただし、TSの特性は不安定であるため、将来的にその場でのTEM観察を試みる必要があります。
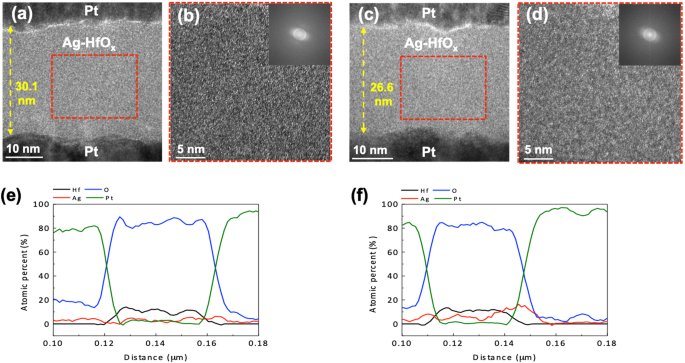
微細構造および組成分析。 a D2のTEM断面画像。 b D2の拡大TEM画像。挿入図は対応するFFT画像です。 c D3のTEM断面画像。 d D3の拡大TEM画像。挿入図は対応するFFT画像です。 e のEDSエレメンタルラインプロファイル D2と f D3
図5aおよびbに示すように、デバイスのTS動作に対して次のメカニズムを提案します。製造されたままのAgドープHfO x スイッチング層は、HfO x に均一に分布したAg原子を持っています 。ただし、D2のAg濃度が低いため、Ag原子間の距離は比較的長いと予想されます。図5aは、製造されたままのD2からのEFプロセスを示しています。電界が元の状態でデバイスに印加されると、HfO x のAg原子 Ag + に酸化することができます イオンとそれらはフィールド方向に沿って移動します。酸化されたAg + イオンはもう一方のPt電極で再びAg原子に還元され、そこでAg伝導フィラメントが連続的に成長します。フィラメントが2つの電極間に接続されると、デバイスはオフ状態からオン状態に切り替わります。 D2のEFプロセス中に、高電界のために、より大きなAgクラスターが形成される可能性があります。文献[14、15]のその場TEM観察から、そのような大きな電場は直径数ナノメートルのAgナノ粒子を形成するのに十分であることがわかった。印加された電界が除去された後、原子スケールのAgがHfO x に拡散します。 マトリックス。デバイスがオフ状態に戻ったことを示します。ただし、十分に拡散できない大きなAgクラスターは、導電性パスに留まります。したがって、この残留Agクラスターは、後続のオフ状態でより大きなオフ電流につながります。対照的に、図5bに示すように製造されたままのD3の場合、D3は低電界で動作するため、Agクラスターを形成せずにAgフィラメントが形成されます。これは、デバイスが低オフ電流を維持できることを意味します。同様に、印加された電界が除去されると、Agフィラメントの自発的破裂により、デバイスはオフ状態に戻ります。これは、フィラメントとマトリックス間の界面エネルギーを最小化するトムソン-ギブス効果によって説明できます[15、18 、28]。その結果、双方向のTS特性は、再現可能なAg原子/イオン拡散ダイナミクスによって実現できます。
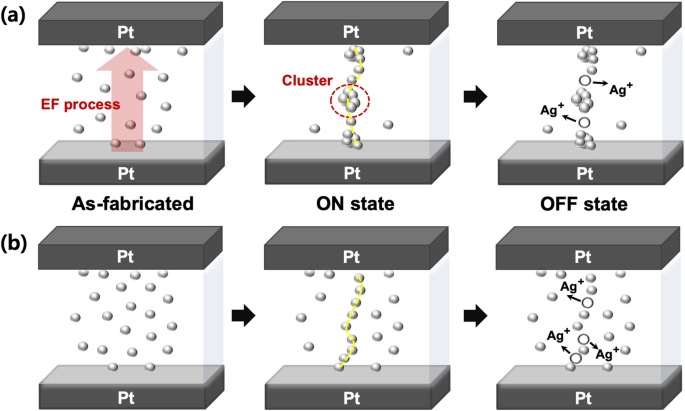
AgドープHfOxデバイスにおけるTSの提案されたメカニズム。 a でのTS動作の最初のAgフィラメント形成/破壊 EF-必要(D2)および b EFフリー(D3)デバイス
EFプロセス中の違いを説明するために、次の式を提案します。 (3)および(4):
$$ D ={D} _0 \ mathit {\ exp} \ left(-\ frac {E _ {\ mathrm {mo}}} {kT} \ right)$$(3)ここで D は拡散係数、 D 0 は前指数因子、 E mo はゼロバイアスでの移行障壁、 k はボルツマン定数であり、 T は局所的な絶対温度です。 HfO x 内でAgフィラメントを形成するには 層では、Agイオンは、負にバイアスされた電極に向かって移動するために、移動障壁を克服する必要があります。外部バイアスが印加されると、電界によって移動障壁 E が低下する可能性があります。 m 、次のように電界方向に沿ったイオン移動につながります:
$$ {E} _ {\ mathrm {m}} ={E} _ {\ mathrm {m} \ mathrm {o}}-\ frac {e \ bullet {V} _ {\ mathrm {bias}}} { Z _ {\ mathrm {box}}} \ bullet \ Delta z $$(4)電子電荷 e 、バイアス電圧 V バイアス 、HfO x 層の厚さ Z ボックス 、および z でのAgホッピング距離 方向 ∆z 。実際、Agイオンは、ゼロバイアスの下ですべての方向にホップできます。ただし、 z に沿ったホッピングを検討しました Agイオンが主に電界方向に沿ってホップする高電界下でデバイスをオン状態にすることができるため、EFプロセスの方向。 E を見積もるには m 、Agホッピング距離( ∆z )を計算しました )Ag濃度と膜厚の実験結果から、D2で0.67 nm、D3で0.45nmとして。ゼロバイアスでの移行障壁、 E mo =3.02 eV、文献[29]から使用されました。 Agフィラメントの最初の形成では、D2に〜1.6 MV / cmの電界が必要であり、移動障壁が0.11eV低下しました。対照的に、D3の最初のスイッチングには〜0.4 MV / cmの電界が必要であり、移行障壁が0.04eV低下しました。したがって、Agの拡散は、D2に比べてホッピング距離が短くAg濃度が高いため、バリアの減少が少ないにもかかわらず、D3でAgフィラメントを形成するのに十分です。ただし、D2のホッピング距離が比較的長いため、Agフィラメントを形成するのに十分な拡散を行うには、より大きなバリアの削減が必要でした。フィラメントが形成されたら、電圧を停止することによって自発的に破裂する必要があります。ただし、Agフィラメントは初期分布に完全に拡散できなかったため、ホッピング距離 ∆z 製造されたままのD2のそれから減少します。したがって、この結果により、後続のしきい値切り替えで電界が減少しました(〜0.4 MV / cm)。膜厚は I に大きく影響することに注意してください。 - V デバイスの特性。したがって、厚さが同じでAg濃度が異なるデバイスでEFプロセスを確認しました。同様に、デバイスは、Ag濃度の増加に伴い、EFが必要な特性からEFが不要な特性への移行を示しました。したがって、Ag濃度は、有効な内部電界を制御することにより、本質的にEFプロセスに影響を与えることが実証されました。つまり、Ag濃度を調整し、HfO x のホッピング距離を調整します。 NL が大きいEFフリーTS特性には、レイヤーが必要です。 および S 値。
結論
AgドープHfO x に基づく拡散セレクターデバイス 薄膜を作製し、そのTS特性を評価した。電気的特性に対するAg濃度の影響を理解するために、さまざまなAg濃度のデバイスを評価しました。デバイス内のTSの動作は、HfO x 内の原子的に分散したAg原子からのAgフィラメントの形成/自己破壊によって説明できます。 。 Ag濃度がEFプロセスに影響を与えてそのような金属フィラメントを形成する可能性があることが確認された。 Ag濃度が低いデバイスでは、TS動作に先行するEFプロセスが必要でしたが、Ag濃度が高いデバイスではEFフリーのTS動作が証明されました。さらに、EFフリーデバイスは、非線形性とオフ電流の点で、EFが必要なデバイスよりも優れたTSパフォーマンスを示しました。したがって、EFプロセスに起因する性能の低下を防ぐために、EFフリーの拡散セレクターデバイスを取得するには、適切なドーパント濃度と分布制御が必要です。
データと資料の可用性
すべてのデータは制限なしで完全に利用可能です。
略語
- CBA:
-
クロスバーアレイ
- EF:
-
電鋳
- HRS:
-
高抵抗状態
- LRS:
-
低抵抗状態
- NL :
-
非線形性
- S :
-
選択性
- TS:
-
しきい値の切り替え
ナノマテリアル
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- BaTiO3 / Nb:SrTiO3エピタキシャルヘテロ接合における強誘電場効果による非対称抵抗スイッチング効果
- 微細構造の制御による有機-無機ペロブスカイトCH3NH3PbI3の薄膜のインピーダンス分析
- 丸い形の金ナノ粒子:シロイヌナズナの根の成長に対する粒子サイズと濃度の影響
- ペロブスカイト太陽電池の光起電力特性に及ぼすさまざまなCH3NH3PbI3形態の影響
- セレクタおよびメモリとしてのV / SiOx / AlOy / p ++ Siデバイスの二重機能
- 不揮発性メモリのスイッチング特性に及ぼす二分子膜CeO2-x / ZnOおよびZnO / CeO2-xヘテロ構造と電鋳極性の影響
- InP / ZnS量子ドット膜の光学特性に及ぼすポストサーマルアニーリングの影響
- リチウムおよびナトリウムイオン電池の安定した性能の陰極としてのアモルファス酸化バナジウム薄膜
- c軸配向エピタキシャルBaドープBiCuSeO薄膜の熱電性能の向上



