金属支援化学エッチングによって形成された高濃度にドープされた多孔質Si層を備えたシリコン基板の形成と評価
要約
多孔質シリコン(Si)は熱伝導率の低い材料であり、熱電デバイスの可能性が高くなります。ただし、多孔質Siの出力性能が低いと、導電率が低いため、熱電性能の向上が妨げられます。多孔質Siと金属間の非線形接触による大きな接触抵抗は、導電率が低下する理由の1つです。この論文では、 p -および n タイプの多孔質Siは、金属支援化学エッチングによってSi基板上に形成された。接触抵抗を減らすには、 p -および n 不純物元素を p にドープするために、ドーパントのタイプスピンが採用されています。 -および n それぞれ、タイプの多孔質Si表面。ドープされていない多孔質サンプルを含むSi基板と比較して、オーミック接触が得られ、ドープされた p の電気伝導率が得られます。 -および n タイプの多孔質Siは、それぞれ1160および1390 S / mに改善できます。 Si基板と比較して、ドープされた p の特殊な接触抵抗 -および n タイプの多孔質Si層は1.35および1.16mΩ/ cm 2 に減少します それぞれ、キャリア濃度を上げることによって。ただし、キャリア濃度の増加は、 p のゼーベック係数の低下を引き起こします。 -および n 多孔質Siサンプルをそれぞれ491および480μV/ KにドープしたタイプのSi基板。力率は、熱電材料のゼーベック係数と電気伝導率に関連しており、出力性能を評価する重要な要素の1つです。したがって、ドープされた多孔質Siサンプルを含むSi基板のゼーベック係数値は減少しますが、ドープされた多孔質Si層は、導電率の向上により、ドープされていないサンプルと比較して力率を改善でき、熱電アプリケーションの開発を容易にします。
はじめに
現在、無駄な熱を電気エネルギーに変換できる熱電エネルギー変換は、エネルギー利用効率を高めてエネルギー不足の圧力を緩和する重要な技術とされています[1]。特に、将来の情報通信社会では、さまざまなセンサーアプリケーションが強く求められています[2、3]。高効率でコンパクトな熱電デバイスを実現するために、熱電材料に基づく微細加工技術が研究されてきました[4、5、6]。熱電材料の熱電性能は、性能指数 ZT によって評価されます。 =бS 2 T /к 、ここでб は電気伝導率、 S ゼーベック係数、 T 絶対温度、およびк 熱伝導率[7]。力率、бS 2 は、材料の最大生成電力出力であるため、その出力性能を推定するために使用されます。
Bi 2 などの一般的な熱電材料 Te 3 およびSb 2 Te 3 、希少で有毒な物質が含まれているため、大規模な生産が困難です。 Siは豊富で、半導体産業で広く使用されているため、熱電デバイスに適用する代替候補の1つと見なされています[8]。ただし、Siは熱伝導率が高く(〜150 W / mK)、 ZT が低いため、理想的な熱電材料ではありません。 値(0.006)[9]。最近、ナノ構造のSiは、熱伝導率を1.6 W / mKに低下させ、 ZT を改善することが証明されました。 300Kで0.6に値します[10]。最近、Siナノワイヤをベースにした熱電発電機の製造に成功しました[11、12]。ただし、Siナノワイヤアレイは ZT と強く関連している均一な直径と滑らかな表面を保証するのが難しいため、これらの熱電発電機の性能はまだ低いです。 値。
Siナノ構造の1つである多孔質Siは、理論的および実験的研究から熱電材料の候補の1つと見なされています[13、14、15]。ただし、多孔質Siの出力性能が不十分な場合、導電率が低いため、熱電デバイスの開発が制限されます。多くの研究により、金属と多孔質Siの間の電気的接触は、金属と多孔質Siの間の位置エネルギー障壁のために非線形の振る舞いを示すことがわかりました[16、17]。その理由は、多孔質Siの大きな表面状態と表面トラップ効果により、多孔質Siの表面のキャリア濃度が低下するためです[18]。界面の電気抵抗から大きな寄生損失が発生するため、熱電発電機の製造には課題があります[19]。さらに、このバリアの増加により、多孔質Siの見かけの電気伝導率がバルクSiの電気伝導率と比較して数桁減少し、力率が低くなります[20]。
スピンオンドーパント(SOD)を使用した不純物ドーピングは、Si表面のキャリア濃度を上げることで導電率を上げるための表面改質方法の1つです。イオン注入とは異なり、SODによる不純物のドーピングは損傷プロセスが少ない[21]。いくつかの研究は、SODによってドープされたSiナノワイヤが高い電気伝導率を示すことを示しています[22、23]。 Boor etal。電気化学的方法によって形成された多孔質Si膜の電気伝導率は、SODをドープした後に向上させることができることを発見しました[24]。ただし、SODをドープした多孔質Siの電気的接触特性は、これまでの研究では調査されておらず、熱電デバイスの重要なパラメータです。さらに、多孔質Si層を備えたSi基板の出力性能に対するSODドーピングの影響の調査はまれです。電気化学的方法とは異なり、多孔質Siを形成するために金属支援化学エッチング(MACE)を使用しました。 MACEは、ウェットエッチング技術を使用したシンプルで大量生産可能な方法であり、Siナノワイヤや多孔質Siなどの多様なナノ構造を合成できます[25、26、27]。さらに、他の方法よりも速いエッチング速度で真っ直ぐなナノポアを形成することができます。
この研究では、 p -および n 多孔質Si層を備えたタイプのSi基板がMACEによって形成され、ゼーベック係数、電気伝導率、および電気的接触が、さまざまなタイプのSODがドープされた多孔質Si層で評価されました。まず、 p のゼーベック係数 -および n- MACEによって形成されたタイプの多孔質Siを調査し、SODをドープした層のキャリア濃度を評価して、ドーピング効果を検証しました。次に、電流-電圧特性を使用して、多孔質Si層をドープしたSi基板の導電率と接触特性を測定しました。さらに、金属とドープされた多孔質シリコン層との間の電気的接触を、特別な接触抵抗の観点から評価した。最後に、 p の力率 -および n ドープされた多孔質Si層を備えたタイプのSi基板が評価され、ドープされていないサンプルと比較されました。
メソッド
(100)指向の p -タイプ(10.0mΩ-cm)および n -タイプ(10.0mΩ-cm)サイズが2×2cm 2 のSi基板 アセトン、エタノール、脱イオン水、ピラニア溶液(H 2 )で順次洗浄しました。 SO 4 :H 2 O 2 2:1の体積比で)。次に、 p -および n 以下のように、MACEプロセスによりSi基板上にタイプの多孔質Si層を形成した。まず、Si基板を0.14 MHFと5×10 –4 の混合物に浸しました。 M AgNO 3 室温で7分間の溶液。この手順では、図1に示すように、直径80〜180 nmのAgナノ粒子をSi表面に堆積させました。次に、Agナノ粒子を堆積させたSi基板を、25mlの49%HF溶液、10 mlの35%H 2 O 2 溶液、および室温で5:2:1の体積比の5mlの脱イオン水。エッチング反応は、電気的な局所陽極酸化および酸化物除去プロセスで進行します。 Agナノ粒子は、局所的な陽極酸化によって界面のSi表面を即座に酸化し、酸化物は溶液中のHFによってエッチングされます。エッチングが進むにつれて、Agナノ粒子はさらにエッチングするためにSiに浸透します。したがって、多孔質Si層が形成される。 p の多孔質形成率が報告されています -タイプSiは n よりも低速です -タイプSi [28]。多孔質Siの厚さはエッチング時間によって制御されます。私たちの実験では、 p のエッチング時間 -タイプSiは2分40秒に選択されていますが、 n -タイプSiを2分間処理して、約20μmの多孔質Si膜を取得します。最後に、Si基板を10%硝酸で洗浄して、Agナノ粒子を除去した後、脱イオン水で洗浄しました。多孔質Si層の気孔率は次のように定義されます
$$ {\ rm {Porosity}} =\ frac {{m_ {1} --m_ {2}}} {pv} $$(1)ここで m 1 は初期サンプルの質量、 m 2 は、多孔質Si層の形成後のサンプルの質量 p、v は、元のエッチングされた単結晶Si層の密度と体積です。多孔質Si膜の形態は、電界放出型走査電子顕微鏡(FE-SEM)によって観察されました。
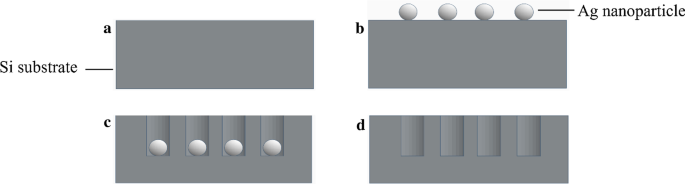
金属支援化学エッチングを使用した多孔質Si層形成プロセスを備えたSi基板。 a 洗浄したSi基板。 b Agナノ粒子の堆積。 c HF溶液によるエッチング。 d 銀ナノ粒子の除去
図2a、bは、 p の断面画像を示しています。 -および n MACEによって形成されたタイプの多孔質Si膜。 p の厚さ -および n タイプの多孔質Si膜は約20μmで、エッチング時間によって調整されます。 p の平均細孔径 -および n タイプの多孔質Si膜はそれぞれ130nmと125nmであり、 p の多孔度 -および n タイプの多孔質Si膜はそれぞれ35%と31%です。
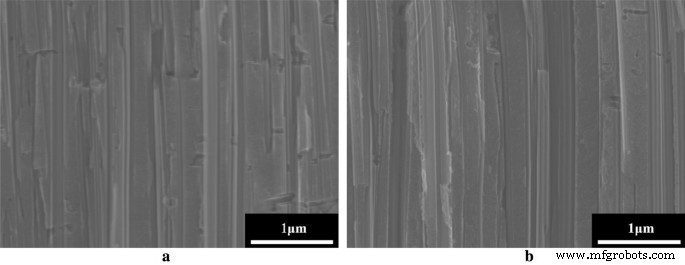
a の多孔質Si層の微細構造 p -タイプと b n -タイプ
ホウ素またはリンの不純物を多孔質Si層にドープして、 p を形成しました。 -タイプまたは n それぞれ、SOD(Filmtronics Inc. USA)を使用したタイプのSi層。 SODは、3000rpmで30秒間のスピンコーティングによって表面にコーティングされました。次に、サンプルを110°Cで15分間ベークして、SODフィルムを硬化させました。その後、サンプルを石英管炉に入れ、N 2 で1100°Cで3時間アニールしました。 ドーパント原子を多孔質Siに拡散させる環境。最後に、サンプルをHF溶液に浸して、SiO 2 を除去しました。 表面をきれいにします。多孔質Si層へのドーピング効果を検証するために、ドープされていない多孔質Si層とドープされた多孔質Si層のキャリア濃度をホール効果測定システムで測定しました[17]。
図3aに示すように、室温でのサンプルのクロスプレーンゼーベック係数を測定するために、多孔質Si膜とSi基板の裏側に2つの金属電極パターンを別々に形成しました。 Siウェーハの半分の領域に多孔質Si層を形成し、深掘り反応性イオンエッチング(RIE)を使用して、Siの残りの部分を深さ30μmでエッチングしました。次に、厚さ1μmのSiO 2 フィルムは、テトラエトキシシラン化学蒸着(TEOS-CVD)によって表面に堆積され、周囲雰囲気への熱損失を低減しました。 2つの1×1mm 2 正方形の接触窓がSiO 2 上に形成されました 映画。その後、2つの1×2mm 2 -長方形の厚さ300nmのTi-Au電極は、コンタクトパッド用の電子ビーム蒸着によって形成されました。最後に、2つの市販のペルチェ素子をSi基板と接触させて、面内方向に沿った温度勾配を作成しました。気温 T 1 および T 2 2つの電極で熱電対と温度差Δ T によって測定されました 得られました。発生電圧Δ V 電位計で測定しました。サンプルのゼーベック係数は、次の式から得られました。
$$ S =-\ frac {\ Delta V} {{\ Delta T}} $$(2)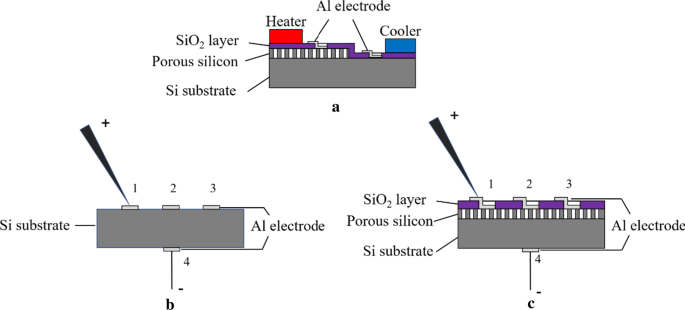
a ゼーベック係数測定用の装置の図。電気伝導率と特殊接触抵抗測定用のデバイスの図: b Si基板; c 多孔質Si層を備えたSi基板
現在の( I )–電圧( V ) p の特性を測定しました -タイプバルクSi、 n 図3b、cに示すように、タイプのバルクSi、および横方向と縦方向の測定構成を使用したドープ/アンドープ多孔質Si。サイズが0.6×0.6mm 2 の厚さ200nmのAl電極3個(「1」、「2」、「3」) 図3bに示すように、バルクSiサンプルの上面に形成され、裏面にもAl電極(「4」)が形成されました。電気的接触を作るために、銀ペーストを使用して銅線を電極「4」に接着した。 Al電極「12」、「23」、「13」間の中心間距離は、それぞれ0.2、0.3、0.56cmでした。バルクSiサンプルを450℃で30分間アニールして、AlとSiのオーミック接触を確認しました。特殊な接触抵抗を測定するために、3つの電極間の横方向の抵抗を高感度プローブを使用して測定しました。バルクSi基板の垂直電気伝導率を測定するために、Al電極「2」〜「4」間の電気コンダクタンスを測定しました。ドーピングの有無にかかわらず、多孔質Siサンプルの電気的特性を測定するには、厚さ2μmのSiO 2 電気プローブによる多孔質Si層への機械的損傷を回避するために、テトラエチルオルトシリケートCVD(TEOS-CVD)によって多孔質Si膜上に層が堆積されました。 3つの0.6×0.6mm 2 SiO 2 窓は、SiO 2 をエッチングすることによって形成されました。 電気的接触をするために緩衝されたHFを部分的に使用する層。次に、3つの1.0×0.6mm 2 Al電極はSiO 2 上に形成されました SiO 2 と一緒に層 図3cに示すように、ウィンドウ。したがって、プローブは拡張されたAl電極と物理的に接触して、多孔質Si膜に電気的に接触することができます。
結果と考察
図4は、ドープされた多孔質Siサンプルとドープされていない多孔質Siサンプルを使用したSi基板で発生した電圧と温度の差を示しています。さまざまなサンプルの計算されたゼーベック係数値を表1に示しました。バルクpおよびn型Siのゼーベック係数はそれぞれ450および485μV/ Kであり、 p のゼーベック係数は および n ドープされていない多孔質Siサンプルを含むタイプのSi基板は、それぞれ696および650μV/ Kの高い値を示します。ゼーベック係数の違いのこの理由は、エネルギーフィルタリング効果と表面散乱効果によるものです[29、30、31]。ドーピングプロセス後、 p のゼーベック係数 および n ドープされた多孔質Siサンプルを含むタイプSi基板は、ドープされた多孔質Si層のキャリア濃度が増加するため、491および480μV/ Kに減少します。ただし、ドープされた多孔質Siサンプル全体の場合、ドープされた多孔質Si層は薄く、多孔質Si層の残りの部分はまだドープされていません。したがって、ドープされた多孔質Si層のキャリア濃度はバルクSiのキャリア濃度よりも高くなりますが、ドープされた多孔質Siサンプル全体(ドープされた多孔質Si層+ドープされていない多孔質Si層)のゼーベック係数はバルクSiサンプルのゼーベック係数に近くなります。
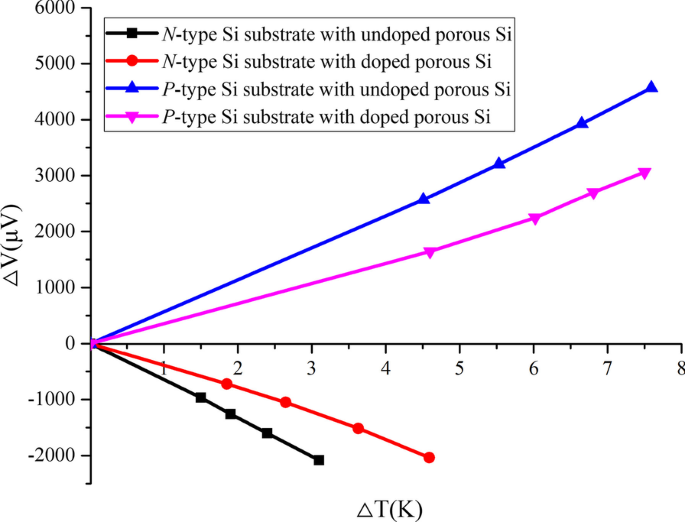
ドープおよびアンドープのn型およびp型多孔質Si層を備えたSi基板上に生成された電圧対温度差
一般に、ゼーベック係数は電荷拡散部分 S で構成されます。 d フォノンドラッグ部分 S ph 。すべてのサンプルが高濃度にドープされているため(〜10 18 )そして測定は室温で行われます、 S ph 値は S よりはるかに小さい d 、結果として S ≈ S d [32]。したがって、ゼーベック係数はフェローとして表示することもできます[33]、
$$ S =\ frac {{8 \ pi ^ {2} k _ {{\ rm {B}}} ^ {2} T}} {{3qh ^ {2}}} m ^ {*} \ left({ \ frac {\ pi} {3n}} \ right)^ {2} $$(3)ここで k B ボルツマン定数、 h プランク定数、 T は絶対温度、 m *は州の有効質量、 q は電子の電荷であり、 n はキャリア濃度です。したがって、キャリア濃度 n ゼーベック係数の値を決定する重要な要素です。
キャリア濃度とゼーベック係数の関係をよりよく理解するために、 p のキャリア濃度 および n タイプドープおよび非ドープの多孔質Si層はホール測定によって測定されました。 p のキャリア濃度 および n タイプのドープされていない多孔質Si層は1.3×10 18 であることがわかります および1.35×10 18 cm -3 、それぞれ、 p のキャリア濃度 -および n タイプドープ多孔質Si層は4.6×10 19 に増加します および2.3×10 19 cm -3 SODドーピング後。参考までに、<i> p のキャリア濃度 -および n タイプのSi基板は2.3×10 19 です。 および9.0×10 18 cm -3 、 それぞれ。ドープされた多孔質Si層によって引き起こされるキャリア濃度の増加により、ドープされた多孔質Siサンプルを含むSi基板のゼーベック係数は減少します。
図5aは、 I を示しています。 – V p の曲線 -および n -ウェーハの厚さ方向に沿ってバルクSi層をタイプします。 p の総抵抗 -および n タイプのバルクSi層は1.12および0.65Ωですが、 p の推定内部抵抗は -および n -タイプのバルクSiは両方ともわずか0.08Ωです。したがって、 p の総抵抗 -および n タイプのバルクSi層は、主に接触抵抗によって決まります。 p 以降 -および n タイプのバルクSi基板は両方とも高濃度にドープされています(〜10 19 )、AlパッドとSi基板間の電気的接触はオーミック接触になります。ただし、私 – V p の特徴 -および n 図5bに示すように、ドープされていない多孔質Si層を備えたタイプのSi基板は、非線形曲線を示します。この場合、 I の勾配からこれらのサンプルの電気伝導率を定義しました。 – V 1 Vの特定の電圧で曲線を描きます。この非線形動作の理由の1つは、ナノ構造で表面積対体積比が増加し、ドープされていない多孔質Si層の表面に多数の表面エネルギー状態が形成されるため、非線形性が生じることです。量子閉じ込め効果によって引き起こされます[34]。バルクSiとは異なり、電子はAl多孔質Si界面を移動するためにより多くのエネルギーを必要とするため、接触抵抗が増加し、総導電率が低下します。さらに、準安定水素化表面や自然酸化物などの他の要因が多孔質Siの電気的特性に影響を及ぼし、これも導電率の大幅な低下に寄与する可能性があります[35、36]。 SODドーピング後、 p のオーミック接触が得られます。 -および n 線形 I として、多孔質SiをドープしたタイプのSi基板 – V 曲線を図5aに示し、 p の電気伝導度を示します。 表1に示すように、多孔質Si層がドープされたタイプおよびnタイプのSi基板は、それぞれ150から1160および385から1390 S / mに増加します。導電率の増加は、主に接触抵抗の減少に起因します。 SODドーピングは主に多孔質Siの表面に影響を与えます。 SODドーピング後、 p を薄くします。 + または n + p 上に多孔質Si層が形成されます -および n それぞれ、タイプの多孔質Si層であり、キャリア濃度は約10 19 に達する可能性があります。 cm -3 。したがって、電子は、ポテンシャル障壁に関係なく、Alとドープされた多孔質Siの間の界面を通り抜けることができます[37]。
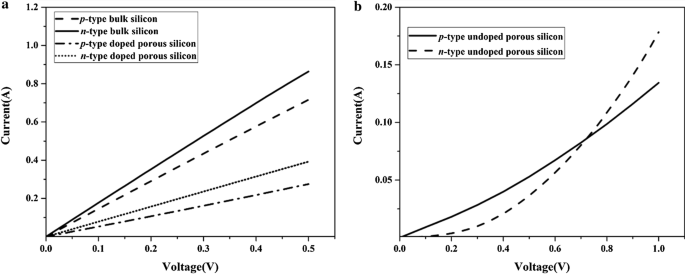
評価された I – V 試験片の特性。 a p -および n 多孔質SiをドープしたタイプのバルクSiおよびSi基板。 b p -および n ドープされていない多孔質Siを含むタイプのSi基板
試験片の電気的特性を評価するために、単位面積あたりの接触抵抗として定義される伝送線測定(TLM)理論に基づいて比接触抵抗を評価します[38]。 TLM理論では、総抵抗 R によって計算できます
$$ R =2R _ {{\ rm {c}}} + \ frac {{p_ {i}}} {A} L $$(4)ここで R c は接触抵抗、 p i サンプルの内部抵抗率、 L 2つの電極間のギャップ、および A 断面積。比接触抵抗 p c p として定義できます c = R c × A 。したがって、式。 4は面積 A を掛けることで変換できます に、
$$ RA =2p_ {c} + p_ {i} L $$(5)値 L の場合 0に近づいています、 R 接触抵抗の2倍になります。したがって、 p c RA 間の関係から推定できます (総抵抗に断面積を掛けたもの)および L 、図6に示すように。したがって、比接触抵抗 p c L での外挿値の半分から取得できます =0。 I 以降 – V 曲線は非線形であり、ドープされていない多孔質Siの比接触抵抗は測定できません。 p の計算された比接触抵抗 -および n -タイプドープされた多孔質Siは1.35および1.16mΩ-cm 2 、それぞれ、 p -および n -タイプバルクSiは1.88および1.25mΩ-cm 2 、 それぞれ。この結果は、 p -および n タイプをドープした多孔質Siは、 p よりも比接触抵抗が低かった。 -および n -バルクSiと入力します。したがって、ドープされていない多孔質Siを含むSi基板と比較して、ドープされた多孔質Siと金属の間の接触抵抗が低いのは、ドープされた多孔質Siを含むSi基板の導電率の向上に起因します。

L 間の関係 および RA 。 a p 多孔質SiをドープしたタイプのバルクSiおよびSi基板。 b n 多孔質SiをドープしたタイプのバルクSiおよびSi基板
表1に、 p の力率を示します。 -および n -ドープされていない多孔質Si層とドープされた多孔質Si層を備えたタイプのバルクSiおよびSi基板。 p のゼーベック係数は -および n -多孔質Siを含むタイプSi基板は、両方ともSODドーピングによって減少し、力率は4倍に増加して280μW/(m K 2 ) p の場合 -2倍に増加して320μW/(mK 2 ) n の場合 -電気伝導率の大幅な増加によるタイプ。以前の研究では、ドープされていない多孔質Siを含むSi基板のZT値は、ゼーベック係数が高く(670μV/ K)、熱伝導率が低い(3.8 W / mK)ため、元のバルクSiのZT値の7.3倍に増加する可能性があります[20]。 。ただし、ドープされていない多孔質Siを使用したSi基板のZT値のさらなる最適化は、比較的低い導電率によって妨げられます。熱伝導率は、平均自由行程が100 nmを超えるフォノンによって主に支配されるため、SiをドープしてもSiを維持できます。したがって、熱伝導率は、主に多孔質Siを使用したナノ構造化によって低下します[39]。さらに、最高の ZT キャリア濃度が10 19 の場合、材料の値は室温で0.1を超える可能性があります。 および10 21 cm -3 ボルツマン輸送方程式[40]に基づいています。したがって、推定された ZT ドープされた多孔質Siを含むSi基板の値は、SODドーピングによって約0.1に改善できます。これは、ドープされていない多孔質Siを含むSi基板の値(0.02)の5倍です。結果として、SODドーピングによって多孔質SiをドープしたSi基板は、その熱電性能を改善すると結論付けられます。
結論
多孔質Siは高濃度にドープされた p で合成されました -および n 金属支援化学エッチング(MACE)を使用したタイプのバルクSi。 p の電気的特性を改善するために、スピンオンドーパント(SOD)を使用した表面ドーピングが使用されました。 -および n -タイプの多孔質Si。 p と比較して -および n ドープされていない多孔質Si(696および650μV/ K)を備えたタイプのSi基板、 p のゼーベック係数 -および n ドープされた多孔質Si層のキャリア濃度が増加するため、ドープされた多孔質Siを含むタイプのSi基板は491および480μV/ Kに減少します。 p のキャリア濃度との比較 -および n タイプバルクSi(2.25×10 19 および9.03×10 18 cm -3 )、 p のキャリア濃度 -および n タイプのドープされていない多孔質Siは1.3×10 18 に減少します および1.35×10 18 cm -3 p のキャリア濃度は、量子閉じ込め効果と大きな表面積によるものです。 -および n タイプドープ多孔質Siは4.6×10 19 に増加します および2.29×10 19 cm -3 SODドーピング後。ただし、SODは薄い多孔質Si膜のドープにのみ使用できます。 p との比較 -および n タイプのドープされていない多孔質Si、 p -および n タイプドープ多孔質Siは、接触抵抗の減少により、導電率を150から1160および385から1390 S / mに増加させました。さらに、オーミック接触は p で取得できます。 -および n タイプドープ多孔質Si。多孔質SiとAl間の特殊接触抵抗は1.35と1.16mΩ-cm 2 に減少します。 、キャリア濃度の増加により、バルクSiとAl間の接触抵抗よりも低くなります。ゼーベック係数は減少しますが、 p の力率 -および n 多孔質SiをドープしたタイプのSi基板は、280および320μW/(m・K 2 に増加します。 )、それぞれ、電気伝導率の向上による。したがって、SODドーピング後にMACEによって形成された多孔質Siを含むSi基板は、導電率を高め、熱電用途に使用されることが期待される多孔質Siの熱電性能を向上させることができます。
データと資料の可用性
現在の研究中に使用および/または分析されたデータセットは、合理的な要求に応じて対応する著者から入手できます。
略語
- Si:
-
シリコン
- MACE:
-
金属支援化学エッチング
- SOD:
-
ドーパントのスピン
- FE-SEM:
-
電界放出型走査電子顕微鏡
- RIE:
-
深掘り反応性イオンエッチング
- TEOS-CVD:
-
テトラエトキシシラン化学蒸着
- TLM:
-
伝送線路の測定
ナノマテリアル
- ST:ITおよびIoTアプリケーション向けのすぐに使用できるソフトウェアを備えたセキュアエレメント評価キット
- ナイロン6、66およびPOMと競合するポリケトンベースの化合物
- 金属支援化学エッチング中の多孔質シリコンナノワイヤの形態進化とエッチング速度論の解明
- ns-Laserによって調製されたブラックシリコン上に酸素をドープしたナノ結晶の電子状態と可視発光
- 金属支援化学エッチングによって製造されたAuキャップGaAsナノピラーアレイ
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 圧力センサーおよび調整可能な感度を備えたガスセンサーとしての多層多孔質ポリアニリン複合材料の容易な製造
- 反射防止および超疎水性用途のための金属塩-ポリマーナノコンポジットフィルムの相分離によって形成された表面ナノ構造
- ナノ粒子の毒性の物理的および化学的性質への依存性
- GeSiSnナノアイランドと歪み層を備えた半導体膜の形態、構造、および光学特性
- LSPカップリングの波長と強度に対する基板の影響



