有機金属化学蒸着によるInAsステム上での垂直GaSbナノワイヤの自己触媒成長
要約
Si(111)基板上に有機金属化学蒸着(MOCVD)を使用して、InAsステム上に高品質のGaSbナノワイヤを最初に自己触媒的に成長させたことを報告します。垂直InAs / GaSbヘテロ構造ナノワイヤの成長を実現するために、トリメチルガリウム(TMGa)とトリメチルアンチモン(TMSb)の2段階の流量が使用されます。まず、比較的低いTMGaおよびTMSbの流量を使用して、細いInAsステム上のGa液滴を保持します。次に、TMGaとTMSbの流量を増やして、軸方向の成長速度を高めます。より高い成長温度でのGaSbの半径方向の成長速度が遅いため、500°Cで成長したGaSbナノワイヤは、520°Cで成長したものよりも大きな直径を示します。ただし、軸方向の成長に関しては、ギブス・トムソン効果と成長温度の上昇に伴う液滴過飽和の減少により、500°Cで成長したGaSbナノワイヤーは520°Cで成長したものよりも長くなります。詳細な透過型電子顕微鏡(TEM)分析により、GaSbナノワイヤーが完全な閃亜鉛鉱(ZB)結晶構造を持っていることが明らかになりました。ここで紹介する成長方法は、他のアンチモン化物ナノワイヤーの成長に適している可能性があり、アキシャルInAs / GaSbヘテロ構造ナノワイヤーは、新しいナノワイヤーベースのデバイスの製造や基本的な量子物理学の研究に使用できる可能性があります。
背景
III-V半導体ナノワイヤは、その独自の電子的、光学的、および幾何学的特性により、次世代のナノスケールの電子的、光学的、および量子デバイスの有望な候補として認識されています[1,2,3]。 III-V半導体材料の中で、狭い直接バンドギャップ、小さなキャリア有効質量、最高のキャリア移動度などの独自の利点により、III-アンチモニドは中波長および長波長赤外線の製造に使用できる可能性があります。光検出器[4]、低電力高速トランジスタ[5,6,7]、および基本的な量子物理学の研究[8,9,10]。ただし、原子量が大きいため、元素Sbの揮発性が低く、III-アンチモン化合物の融点が低く、アンチモンベースのナノワイヤの成長を実現することは非常に困難です[11]。
特に、非常に重要なp型アンチモン化物ナノワイヤであると考えられているGaSbナノワイヤは、主にAu触媒の助けを借りて成長してきました[12、13、14、15、16]。ただし、Auの導入により、Siバンドギャップに不要な深層再結合中心が形成され、III–Vナノワイヤの電子的および光学的特性が低下する可能性があります[17、18]。したがって、外来触媒なしでGaSbナノワイヤを成長させることが非常に望ましい。さらに、垂直アンチモン化物ナノワイヤの成長では、基板上での直接核形成は非常に困難です。核形成の問題を回避するために、垂直GaSbナノワイヤの成長を支援するために、常に別の材料の短いステムが最初に成長します。最近、GaAsステム上でのGaSbナノワイヤの自己触媒成長は、分子線エピタキシー(MBE)[19]によって実現されましたが、私たちの知る限り、高品質のGaSbナノワイヤの成長に関する報告はありません。有機金属化学蒸着(MOCVD)技術に基づく外来触媒の使用。ここでは、Si(111)基板上でMOCVDを使用したInAsステムの助けを借りて、GaSbナノワイヤの自己触媒成長を紹介します。一方では、自己触媒メカニズムによるInAsナノワイヤステム上でのGaSbナノワイヤの成長は、陰イオンと陽イオンの両方がInAsステムから上部GaSbに変化するため、困難です。一方、0.6%の低い格子不整合と、InAsとGaSbの間のユニークなタイプIIの壊れたバンド配列により、InAsステム上でのGaSbナノワイヤの成長により、InAs / GaSbアキシャルヘテロ構造ナノワイヤが形成されます。トンネリングベースのデバイス[7、14、20、21]、高速相補型金属酸化膜半導体(CMOS)トランジスタ[22、23]、電子正孔ハイブリダイゼーションの研究[9]、励起子など、多くのアプリケーションおよびスピン物理学の研究[24]。
この記事では、成長条件を注意深く制御することにより、側壁が滑らかな高品質のGaSbナノワイヤを実現しました。垂直InAs / GaSbヘテロ構造ナノワイヤの成長を実現するために、トリメチルガリウム(TMGa)とトリメチルアンチモン(TMSb)の比較的低い流量を最初に使用して、InAsステム上のGa液滴を保存しました。次に、TMGaとTMSbの流量を増やして、GaSbナノワイヤの軸方向の成長を促進しました。より高い成長温度でのGaSbの半径方向の成長速度が遅いため、500°Cで成長したGaSbナノワイヤは、520°Cで成長したものよりも直径が大きくなります。さらに、ギブス・トムソン効果と成長温度の上昇に伴う液滴過飽和の減少により、500°Cで成長したGaSbナノワイヤーは、520°Cで成長したものよりも直径と長さの両方が大きくなります。詳細な透過型電子顕微鏡(TEM)分析により、InAsステムの結晶構造は、ウルツ鉱(WZ)と亜鉛ブレンド(ZB)構造のポリタイプで構成されているのに対し、軸方向に成長したGaSbナノワイヤーは完全に遊離した純粋なZB結晶構造を持っていることがわかります。平面欠陥の。
メソッド
Nanowire Growth
InAs / GaSbヘテロ構造ナノワイヤは、密結合シャワーヘッドMOCVDシステム(AIXTRON Ltd、ドイツ)によって、133mbarのチャンバー圧力で成長しました。トリメチルインジウム(TMIn)とTMGaをグループIIIの前駆体として使用し、アルシン(AsH 3 )およびTMSbをグループV前駆体として使用しました。超高純度水素(H 2 )をキャリアガスとして使用し、H 2 の総流量 12slmでした。ナノワイヤはSi(111)基板上に成長しました。成長の前に、基板はアニーリングのために635°Cに加熱され、次にAsH 3 の下で400°Cに冷却されました。 (111)Bのような表面を形成するフラックス[25]。 InAsの茎は、TMInとAsH 3 を使用して、545°Cで45秒間成長させました。 1.0×10 -6 の流量 mol / minおよび2.0×10 -4 それぞれmol / min。その後、ソースフラックスがTMInとAsH 3 から切り替えられました。 TMGaとTMSbに変換し、GaSbナノワイヤの軸方向成長のために基板を特定の温度に冷却しました。最後に、TMSbを保護剤として使用して、サンプルを室温まで冷却しました。
特性評価方法
ナノワイヤーの形態は、走査型電子顕微鏡(SEM)(Nova Nano SEM 650)によって特徴づけられ、TEM(JEM2010F TEM; 200 kV)とX線エネルギー分散型分光法(EDS)を組み合わせて結晶構造を調査しました。それぞれ元素組成分布。 TEM観察では、成長したままのナノワイヤをサンプルから炭素膜でコーティングされた銅グリッドに機械的に転写しました。ラマン測定は、励起源として532 nmの波長のレーザー(Jobin-Yvon HR Evolutionラマンシステム)を使用して、室温で後方散乱ジオメトリで実行されました。サンプルは、約1μmのスポットサイズで0.36mWのレーザー出力で励起されました。
結果と考察
図1は、InAsステム上でのGaSbナノワイヤの軸方向成長と、ナノワイヤの成長のためのソース-供給シーケンスの概略図を示しています。ナノワイヤは自己触媒メカニズムを介して成長し、TMInとAsH 3 からのフラックスを切り替えた後、触媒液滴はInからGaに徐々に変化します。 TMGaとTMSbに。ステムナノワイヤーと比較して、GaSbナノワイヤーは常にはるかに太い直径を持っています。これは、Ga触媒液滴のサイズがIn液滴のサイズよりもはるかに大きいことを意味します。次に、細いInAsステム上の液滴によるGa吸着原子の過度の急速な収集は、液滴の滑り落ちを引き起こす可能性があります(追加ファイル1:図S1に示されているように)。図1に示すように、触媒液滴がInAsからGaSbへの移行段階でGa吸着原子を収集するのに十分な時間を確保するために、最初に比較的低い流量のTMGaとTMSbを使用してInAsステム上のGa液滴を保護しました。最初のステップでは、TMGaとTMSbの流量は0.35×10 -6 でした。 mol / minおよび2.0×10 -6 mol / min、これは約5.7のV / III比に対応し、成長プロセスは15分のままでした(図1の領域2)。その後、軸方向の成長速度を上げるために、TMGaとTMSbの流量を0.7×10 -6 に増やしました。 mol / minおよび4.0×10 -6 GaSbナノワイヤのその後の成長(V / III比を一定に保つ)のそれぞれのmol / min。 2段階のTMGaおよびTMSb流量を使用することにより、InAsステム上でのGaSbナノワイヤーの垂直成長を実現することに成功しました。特に明記しない限り、低流量のGaSbナノワイヤの成長時間は変わらないことを考慮すると、次の段落で説明するGaSbナノワイヤの成長時間は、高流量のGaSb成長の成長時間と同じです(図1の領域3)。 。
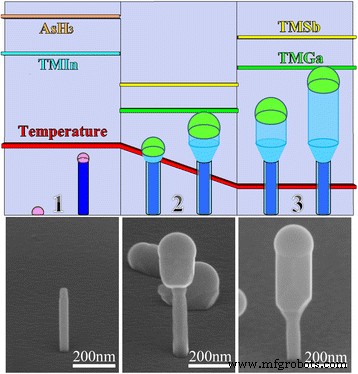
InAsステム上でのGaSbナノワイヤの軸方向成長の図と、ナノワイヤの成長のためのソース-供給シーケンス。ここで紹介するGaSbナノワイヤは520°Cで成長しました
480、500、520、および545°Cのさまざまな温度でInAsステム上に成長したGaSbナノワイヤの典型的なSEM画像をそれぞれ図2a〜dに示します(GaSb成長前のInAsステムは追加ファイル1に示されています。図S2)。 GaSbの成長時間は10分です。 GaSbの成長挙動は、成長温度に非常に敏感であることが観察されています。明らかに、480°Cでは、軸方向の成長の代わりに、GaSbはInAsステムの周りまたは平面方向に沿って放射状に成長する傾向があります(図2a)。 InAsコア上でのGaSbシェルの放射状成長と、アンチモン化物ナノワイヤの平面成長に関する詳細は、他の場所で報告されています[26、27、28]。ただし、GaSbの成長温度が500または520°Cに上昇すると状況が変化し、GaSbナノワイヤの軸方向の成長が自立型InAsステムで実現されます(図2b、c)。ナノワイヤの先端にあるGa液滴は、GaSbナノワイヤの自己触媒による気液固(VLS)成長メカニズムを示しています。上部GaSbセグメントの直径は一般にInAsセグメントの直径よりも厚く、InAs / GaSb界面でのGaSbセグメントの幅の増加は、GaSbの初期成長段階でGa触媒液滴のサイズが徐々に増加することを示しています。さらに、図2cのはるかに細いステムセグメントは、成長温度が500から520°Cに上昇するにつれて、GaSbの半径方向の成長が徐々に減少したことを意味している可能性があります。しかし、温度をさらに545°Cに上げると、GaSbナノワイヤは平面または傾斜方向に沿って成長しているように見えます。さらに、ほとんどのInAsステムが消失し、残りのInAsステムの直径が非常に薄くなっています(図2dの赤い円でマークされており、追加ファイル1:図S3にさらに多くのSEM画像が示されています)。 InAsステムは、545°Cの高い成長温度で深刻に分解され、成長プロセス中にGaSbナノワイヤが落下する結果になると推測されます。したがって、InAsナノワイヤステム上でGaSbナノワイヤを垂直方向に成長させるには、GaSbナノワイヤの成長温度を注意深く制御する必要があります。

InAs上で成長したGaSbナノワイヤの80°傾斜SEM画像は a にあります 480°C、 b 500°C、 c 520°C、および d 545°Cで20分間。 InAsナノワイヤステムの成長条件は一定に保たれました。 インセット b で および c 高倍率のSEM画像を表示します。 赤い円 d で 残りのInAsステムをマークします
図3は、図2b、cに示すGaSbセグメントの直径と長さの統計的分布を示しています。ここで、GaSbの成長温度はそれぞれ500°Cと520°Cです。明らかに、同じ温度で成長したGaSbナノワイヤーのサイズ分布(図3の赤または青の点)は、太いナノワイヤーが長くなる傾向があることを示しています。この現象は、MBEによるGaAsPナノワイヤのGa触媒成長[29]、化学ビームエピタキシー(CBE)によるInAs / InSbヘテロ構造ナノワイヤのAu触媒成長[30]およびMOCVDによるInGaSbナノワイヤ[31]でも報告されています。 ]。その理由は主に、有効な過飽和度が低いことに起因しています(Δμ )小さな触媒液滴で。 VLS成長メカニズムの場合、過飽和Δμ は、触媒液滴とナノワイヤのIII-Vペアあたりの化学ポテンシャルの変化であり、ナノワイヤの成長の主な推進力です。自己触媒成長プロセス中、ナノワイヤはグループIIIが豊富な環境で成長し、触媒液滴に組み込まれたグループV原子の濃度が効果的な過飽和を支配します。 GaSbナノワイヤの自己触媒成長の場合、効果的な過飽和Δμ Ga触媒液滴に組み込まれたSb原子の濃度によって支配されます。したがって、有効な過飽和Δμ [32、33]
として表示できます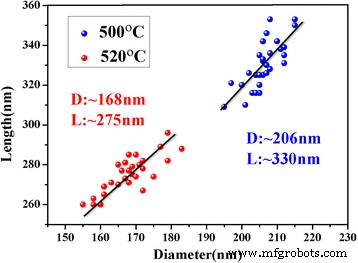
500および520°Cで成長したGaSbナノワイヤーの直径と長さの統計データ
。
$$ \ varDelta \ mu ={k} _ {\ mathrm {B}} T \ ln \ left({x} _ {\ mathrm {Sb}} / {x} _ {\ mathrm {Sb}、\ mathrm { eq}} \ right)$$(1)ここで k B はボルツマン定数、 T は絶対温度です。 x Sb および x Sb、eq は、それぞれ、ナノワイヤ成長プロセス中およびGaSbナノワイヤ結晶と平衡状態にあるGa触媒液滴中のSbの原子分率です。さらに、結晶成長の古典的な理論に基づいて、ナノワイヤの軸方向成長速度( v )は[34]と表すことができます。
$$ v \ sim {\ left(\ varDelta \ mu / {k} _ {\ mathrm {B}} T \ right)} ^ 2 $$(2)明らかに、ナノワイヤの成長速度は、Sb濃度 x に強く依存しています。 Sb Ga液滴で。ギブス・トムソン効果のため、触媒液滴中のSbの蒸気圧は、直径が減少するにつれて大幅に増加する可能性があります[35、36]。次に、液滴が小さいほど、Ga触媒粒子からSb原子をより簡単に脱着できるため、Sb濃度が低くなります( x Sb )より小さなGa触媒液滴で。結果として、小さな液滴の有効な過飽和は大きな液滴のそれよりも低く、それによって自己触媒成長メカニズムによるGaSbナノワイヤの軸方向成長速度を低下させます。
さらに、500°Cと520°Cで成長したGaSbナノワイヤーのサイズ分布を比較すると、500°Cで成長したGaSbナノワイヤー(図3の青い点、平均直径と長さは約206と約330 nm)が観察されます。 520°Cで成長したGaSbナノワイヤーよりも大きな直径と長さの両方(図3の赤い点;平均直径と長さは約168および約275 nm)。 520°Cで成長したより細いナノワイヤは、より高い成長温度でのGaSbの半径方向の成長速度が遅いことに起因する可能性があります。ただし、ギブス・トムソン効果以外の軸方向成長の場合、成長温度の上昇により、液滴の過飽和が減少し、GaSbナノワイヤの軸方向成長速度がさらに低下する可能性があります[29、37]。したがって、500°Cで成長したGaSbナノワイヤは、520°Cで成長したGaSbナノワイヤよりも直径と長さの両方が大きくなります。
ステムナノワイヤの支援から生じる利点をさらに判断するために、図4に示すように、Si基板上と短いInAsステム上で直接成長したGaSbナノワイヤを比較しました。図4a、bに示すGaSbナノワイヤを成長させました。図4cに示されているGaSbナノワイヤは520°Cで成長しましたが、500°Cで成長しました。明らかに、InAsナノワイヤステムは、垂直GaSbナノワイヤの成長を成功させる上で重要な役割を果たしています。図4aに示すように、Si(111)基板上に直接成長したGaSbナノワイヤは、平面方向に沿って成長することを好みます(追加ファイル1:図S4でより多くのSEM画像を利用できます)。基板上に核形成されると、Sb吸着原子の界面活性剤効果に関連し、事前に堆積されたGa液滴とSi基板表面の間の接触角を減少させる可能性があります[38、39]。一方、図4b、cに示すように、垂直GaSbナノワイヤは、短いInAsステムの助けを借りて実現されます。図4b、cでは、InAsナノワイヤステムの成長時間が20秒に短縮され(その結果、InAsナノワイヤの長さは一般に120 nm未満になります)、GaSbナノワイヤの成長時間は30分。すべてのGaSbナノワイヤは、目に見えるテーパーがなく、全長に沿って非常に滑らかな側壁を備えています。特に、InAsステムセグメントは上部GaSbナノワイヤとほぼ同じ直径を持っています(図4b、cの挿入図に示されているように)。これは、InAsステム周辺のGaSbの半径方向の成長速度が上部GaSbナノワイヤ周辺のそれよりも速いことを示しています。 。この違いは、基板表面から拡散した反応物吸着原子が細くて短いInAsナノワイヤの側壁の周りに集まる傾向があり、その結果、InAsステムの周りのGaSbの半径方向の成長速度が局所的に向上するという事実に関連している可能性があります。最後に、十分な成長時間で、成長したナノワイヤは成長方向に沿ってほぼ均一な直径を持ちます。 MOCVDによる短いInAsステムに基づくInSbナノワイヤの成長でも同じ挙動が観察されています[40]。

InAsステムなしで成長させたGaSbナノワイヤの80°傾斜SEM画像( a )、および短いInAsステム( b 、 c )。 a に示されているGaSbナノワイヤー および b c のGaSbナノワイヤを使用しながら、500°Cで成長させました。 520°Cで栽培されました。 インセット b で および c 高倍率のSEM画像を表示する
得られたナノワイヤの構造特性を調べるために、詳細なTEM測定を行った。図5aは、520°CでInAsステム上に成長した典型的なGaSbナノワイヤの明視野(BF)低解像度TEM画像を示しています(図2cを参照)。その後のGaSbナノワイヤの成長後、より細いInAsナノワイヤは粗い形態になります。これは、InAsの熱分解と、GaSbナノワイヤ成長プロセス中のGaSbの不規則な放射状成長に起因する可能性があります。図5b–eは、図5aの4つの赤い長方形でマークされた領域から取得された対応する高分解能TEM(HRTEM)画像を表しています。図5bのHRTEM顕微鏡写真および関連する高速フーリエ変換(FFT)パターンは、軸方向に成長したGaSbナノワイヤーが、アンチモン化物ナノワイヤーの成長で一般的に観察される平面欠陥のない純粋なZB結晶構造を持っていることを示しています。ただし、GaSbナノワイヤの上部および初期成長領域に存在する時折の平面欠陥(ツインプレーン(TP)およびスタッキングフォールト(SF))(図5c、d)は、最終的な冷却プロセスと、InAsから上部GaSbへの初期移行段階。さらに、残留As原子は、遷移領域での平面欠陥の形成にも役割を果たす可能性があります(以下のEDS分析に示されています)。対照的に、図5eに示すように、InAsステムの結晶構造は、成長方向に沿って多数の平面欠陥を持つWZおよびZB構造のポリタイプで構成されています。 WZ構造とZB構造が共存しているため、対応するFFTスポットは分割され、成長方向に沿ってわずかに伸びます(図5eの挿入図)。ナノワイヤの構造欠陥は、キャリア移動度の望ましくない阻害を引き起こし[41]、したがってInAs / GaSbヘテロ構造システムの輸送特性を低下させる可能性があることが示されています。最近、Sbを組み込むと、InAsナノワイヤの結晶品質が効果的に向上することが報告されており[42、43]、それにより、外来触媒を使用しないInAsナノワイヤの結晶相工学の可能性が大幅に高まります。
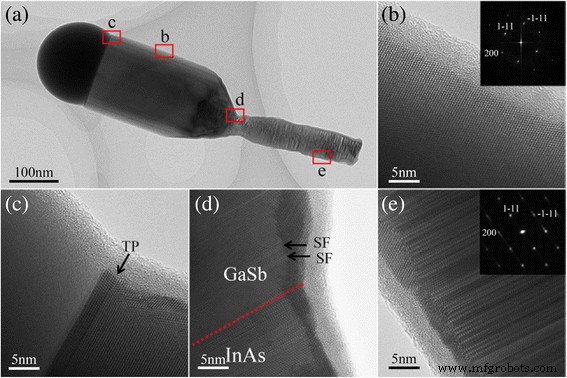
a 典型的なInAs / GaSbヘテロ構造ナノワイヤの低倍率TEM画像。 b – e 赤い長方形でマークされた領域から撮影された高分解能TEM(HRTEM)画像 in( a ) それぞれ。すべてのHRTEM画像は、〈110〉ゾーン軸から取得されます。 赤い破線 d で InAsステムと上部GaSbナノワイヤ間のインターフェースを示します。 挿入物 b で および e それぞれ、GaSbナノワイヤとInAsステムの対応する高速フーリエ変換(FFT)パターンです
図6a–fは、別のInAs / GaSbヘテロ構造ナノワイヤのTEM画像と対応するEDS分析を示しています。すべてのEDS測定では、In、As、SbのLα発光信号とGaのKα発光信号を使用します。EDSラインは軸方向に沿ってスキャンし(図6b)、ナノワイヤ組成の元素マッピングを行います(図6c–f)。液滴は主にGaと少量のInを含み、AsまたはSbはほとんど観察されないことを示しています。これは、GaSbナノワイヤの自己触媒成長メカニズムを直接確認します(スポット1の定量的EDSポイント分析からの原子パーセンテージ:Ga、それぞれ96.13%; In、3.8%; As、0; Sb、0.07%。2つのスポットでのポイント分析のEDSスペクトルは、追加ファイル1:図S5)に示されています。液滴中のこの弱いIn濃度は、主に、InAsからGaSbへの初期遷移段階でのIn原子のGa液滴への溶解に起因します。さらに、図6bのEDSラインスキャンによると、GaSbナノワイヤの成長はInAsステムで始まり、スポット2の元素組成分布のEDSポイント分析から始まります(Ga、48.86%; In、0.91%; 0.70%; Sb、49.53%)として、成長したGaSbセグメントのGa原子とSb原子の化学量論比は約1:1です。ただし、InAsセクションのGaおよびSbの比較的高い信号は、InAsステムの周りのGaSbの放射状の成長に起因し、界面付近のIn、As、Ga、およびSb信号の元素勾配は主に次の原因で発生する可能性があります。 TMInおよびAsH 3 の後の残りのInおよびAs フラックスは遮断されます。

a アキシャルInAs / GaSbヘテロ構造ナノワイヤの図と520°Cで成長したInAs / GaSbナノワイヤの低倍率TEM画像。 b 赤い線に沿ったEDS線スキャン ( a )。 c – f ( a のナノワイヤのEDS組成マップ )、Ga、Sb、In、およびAsの分布を示しています。 2つのスポット a で EDSポイント分析が実行された位置をマークします
成長したGaSbナノワイヤの光学特性を分析するために、ラマン測定を実行しました。図7は、GaSb(100)基板と短いInAsステム上に成長したGaSbナノワイヤのラマンスペクトルを示しています。バルクGaSbのスペクトルに約226.5および235.2cm -1 の2つの散乱ピークが観察されます。 (図7の赤い線)そして、それぞれGaSbの横方向光学(TO)および縦方向光学(LO)フォノンモードに起因します。 GaSbナノワイヤの場合、同様の2つのピークが約225.0および233.6 cm -1 にもはっきりと観察されました。 ラマンスペクトル(図7の青い線)で、得られたGaSbナノワイヤの高いフォトニクス品質を示しています。ラマン後方散乱測定では、TOフォノンモードは(100)方向で禁止されており、バルクGaSb(100)基板の小さなTOフォノンモードピークは、基板のわずかな方向のずれまたは不完全性に起因する可能性があります[44]。ただし、GaSbナノワイヤの場合、ナノワイヤは垂直(111)方向に沿って成長し、6つの{110}側壁があるため、ラマンスペクトルでTOフォノンモードとLOフォノンモードの両方を明確に観察できます。さらに、バルクGaSbと比較して、GaSbナノワイヤのTOおよびLOフォノンモードは弱いダウンシフトを示します。ラマン散乱測定では、量子閉じ込めと欠陥の両方がフォノンピークの周波数ダウンシフトを引き起こす可能性があります[45]。一方、成長したGaSbナノワイヤの直径が大きく、量子閉じ込め効果がほとんどないため、フォノン周波数のこの弱いダウンシフトは、GaSbナノワイヤの表面欠陥に関連している可能性があると推測されます。 TMGaとTMSbの2段階の流量により、外来触媒を使用せずにMOCVDによってInAsステム上に純粋なZBGaSbナノワイヤを垂直成長させることができました。成長温度や、2段階の成長プロセスにおけるTMGaとTMSbの流量のさまざまな組み合わせなどの成長パラメータをさらに最適化することで、より高いアスペクト比のGaSbナノワイヤが実現される可能性があります。

GaSb(100)基板のラマンスペクトル(赤い線 )およびGaSbナノワイヤー(青い線 )。 緑色の線 マルチピークのローレンツフィットの結果です
結論
要約すると、MOCVDによるInAsステム上でのGaSbナノワイヤの自己触媒成長を実証しました。垂直InAs / GaSbヘテロ構造ナノワイヤの成長を実現するために、最初に比較的低いTMGaおよびTMSb流量を使用して、InAsステム上のGa液滴を保持します。次に、TMGaとTMSbの流量を増やして、軸方向の成長速度を改善します。より高い成長温度でのGaSbの半径方向の成長速度が遅いため、500°Cで成長したGaSbナノワイヤは、520°Cで成長したものよりも直径が大きくなります。ただし、軸方向の成長では、ギブス・トムソン効果と成長温度の上昇に伴う液滴過飽和の減少により、500°Cで成長したGaSbナノワイヤーは520°Cで成長したものよりも長くなります。詳細なTEM測定により、InAsステムの結晶構造はWZ構造とZB構造の混合物であり、上部のGaSbナノワイヤーは完全なZB結晶相を持ち、ラマン分析は得られたGaSbナノワイヤーの高い光学品質を示しています。ここで紹介する成長方法は、他のアンチモン化物ベースのナノワイヤの成長に適している可能性があります。さらに、InAsステム上で成長したままのGaSbナノワイヤは、ナノワイヤベースのデバイスでのアプリケーションや量子物理学の研究に新しい可能性をもたらす可能性があります。
略語
- CMOS:
-
相補型金属酸化膜半導体
- EDS:
-
エネルギー分散型分光法
- FFT:
-
高速フーリエ変換
- LO:
-
縦光学
- MBE:
-
分子線エピタキシー
- MOCVD:
-
有機金属化学蒸着
- SEM:
-
走査型電子顕微鏡
- SF:
-
スタッキング障害
- TEM:
-
透過型電子顕微鏡
- TMGa:
-
トリメチルガリウム
- TMSb:
-
トリメチルアンチモン
- TO:
-
トランスバーサルオプティカル
- TP:
-
ツインプレーン
- VLS:
-
気液固
- ZB:
-
閃亜鉛鉱
ナノマテリアル
- 化学蒸着とは何ですか?
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 金属支援化学エッチング中の多孔質シリコンナノワイヤの形態進化とエッチング速度論の解明
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- 化学蒸着によって成長した大きな単一ドメインを備えた大面積WS2膜
- 低温での急速熱アニーリングプロセスによる成長の制御高均一性セレン化インジウム(In2Se3)ナノワイヤ
- パルス電位堆積技術によって電着されたテクスチャードFeナノワイヤアレイの一軸磁化性能
- 分子線エピタキシーによりGaAs基板上に成長させた中波および長波InAs / GaSb超格子の電気的性質
- InGaAs / InPコアシェルナノワイヤの自己シードMOCVD成長と劇的に増強されたフォトルミネッセンス
- 固体ソース2段階化学蒸着によって生成されたInGaAsナノワイヤの形成メカニズム



