超循環原子層堆積によるZnO膜のフェルミ準位調整
要約
熱ALDプロセスとその場O 2 を組み合わせた新しい超循環原子層堆積(ALD)プロセス この研究では、高度に調整可能な電気的特性を備えたZnO薄膜を堆積するためのプラズマ処理を紹介します。両方のO 2 スーパーサイクルのプラズマ時間と熱ALDサイクル数を調整して、外因性ドーピングなしで、膜の抵抗率とキャリア濃度を最大6桁まで微調整できます。水素欠陥の濃度は、ZnO膜の電気的特性を調整する上で主要な役割を果たすと考えられています。ケルビンプローブフォース顕微鏡の結果は、さまざまなZnO膜のフェルミ準位のシフトを明らかに示しており、キャリア濃度の変化とよく関連しています。ここで報告されているこの信頼性が高く堅牢な技術は、この方法を使用して、さまざまなアプリケーションで特性が制御されたZnO膜を製造できることを明確に示しています。
背景
将来の資料として定義されると 、酸化亜鉛(ZnO)は、その優れた光学的および電気的特性により、半世紀以上にわたって科学界の関心を集めてきました[1]。最近、透明導電性酸化物産業の急速な成長により、フラットパネルディスプレイ、タッチスクリーン、低放射率コーティング、薄膜太陽電池などの透明電極としての用途がさらに復活しました[2、3]。さらに、ZnOは、発光ダイオード、光検出器、パワーデバイスなどの電子デバイスに数多くの用途があります[4、5]。これらのさまざまなタイプのアプリケーションでは、さまざまな電気的パラメータを持つZnO膜が必要であり、一部のアプリケーションでは、さまざまな電気的特性を持つZnO膜の多層が必要です[6]。たとえば、完全に統合された透明な電子機器を実現するために、透明な抵抗変化型メモリ(TRRAM)を開発するために多くの努力が払われてきました[7、8]。最も有望な候補の1つとして、ZnOベースのTRRAMは、アクティブスイッチング層として高抵抗ZnO膜を使用しますが、透明電極として機能する高導電性ZnO膜が理想的に要求されます[8、9、10]。したがって、ZnO膜の抵抗率やキャリア濃度などの電気的特性を制御する機能が重要な要件です。ドーピングは通常、特性の変更が必要であり、ZnO膜の特性を変更するためにさまざまなドーパントが適用されている場合に使用されます[11、12、13]。ただし、ドーピングは常に複雑であり、二次相の形成につながる可能性があります[14]。したがって、単一の堆積プロセスによるドープされていないZnOの電気的特性の変調は有利な場合があります。
原子層堆積(ALD)は、ナノメートルスケールまでの膜厚の優れた制御と大きな基板上での均一性を備えた高品質のZnOを形成するための一般的な手法になりました[15、16]。 ZnOの成長温度は通常200°C未満であるため、ガラスやプラスチックなどのさまざまな基板と互換性があります。 ALD ZnOは通常、Zn前駆体としてジエチル亜鉛(DEZ)を使用し、酸素前駆体として水蒸気(熱)または酸素プラズマ(プラズマ強化)を使用して成長します。熱ALDプロセスでドープされていないZnO膜の特性を調整する主な方法は、成長温度を変更することです[17、18]。これにより、導電性の高い膜の堆積が可能になりますが、キャリア濃度が低いと高品質のZnO膜を得ることが困難になります。プラズマ強化ALDは、低キャリア濃度のZnOが必要な場合に使用するのが好ましい[19、20]。最近、単一のプラズマ強化ALDプロセスを使用してZnOを調整できることを報告しました。これにより、異なるO 2 を使用して、抵抗率とキャリア濃度を最大3次まで調整できます。 プラズマ時間[21]。ただし、O 2 が短い場合、プラズマ強化ALDは自己制限的ではない成長を遂げる可能性があります。 プラズマ時間は、必要なキャリア濃度を達成するために適用されます。これにより、大きな基板全体の均一性が低下する可能性があります。したがって、自己制限ウィンドウ内で調整可能なALDプロセスが望まれます。
ZnOの電気的特性を調整する機能は別として、これらの特性の決定も依然として困難です。ホール効果測定は、ZnO薄膜の電気的特性を測定する際に最も一般的な手法です。しかし、それは誤解されがちであり、ドーピングの実際の原因を明確に検出することは困難です[1]。ケルビンプローブフォース顕微鏡法(KPFM)は、半導体材料およびデバイスのナノスケールの構造的、動的、および電気的特性を特徴づけるために広く使用されている非破壊表面技術です[22、23]。接触電位差( V )を直接測定する CPD )、つまり、チップとサンプルの仕事関数の違いにより、バンドギャップ内のフェルミ準位の位置に影響を与えるため、材料のドーパントタイプ、キャリア濃度、および抵抗率についての洞察を得ることができます。ただし、ZnOの特性とKPFMの結果を相関させる研究はほとんど報告されておらず、私たちの知る限り、ALDで成長させたZnO膜に基づく研究はありません[24、25、26]。
この作業では、ドープされていないZnOの電気的特性を調整するための新しいスーパーサイクルALDプロセスを提案します。熱ALDプロセスとその場でのO 2 の組み合わせ プラズマ処理では、このプロセスにより、ZnO膜の抵抗率とキャリア濃度の幅広く洗練された調整が可能になります。さらに重要なことに、ZnO膜のフェルミ準位シフトはKPFMによって直接測定でき、ZnOの電気的特性を特徴づけるために使用できます。
メソッド
すべてのZnO薄膜は、ジエチル亜鉛(DEZ)前駆体を使用してOIPT FlexAlALDシステムで作成されました。 ALDプロセスの各スーパーサイクルは、 m で構成されます。 熱ALDプロセスのサイクル(DEZおよびH 2 O)と1つのO 2 図1aに示すプラズマステップ。熱ALDプロセス内で、DEZ蒸気は最初にチャンバーに導入され、次にアルゴンフローによってパージされ、H 2 続いてO蒸気を導入し、次にアルゴンをパージしました。 m の後 熱ALDプロセスのサイクル、O 2 プラズマステップは、その場でのプラズマ処理ステップとして追加されました。 O 2 プラズマステップは、O 2 を使用して設定されました 60 sccmの流量、300 WのRF電力、15mTorrの圧力。両方の熱ALD数( m )およびO 2 血漿時間( t 3 )は、ZnO膜の特性制御に使用されました。 ALDプロセスの1つの成長スーパーサイクルの具体的な詳細は、追加ファイル1:表S1に記載されています。すべてのZnO膜はSiO 2 上に堆積されました 190°Cの固定温度でコーティングされたSi基板(1cm×1cm)で、すべての膜厚は40nmと予測されました。

a 提案されたスーパーサイクルALDプロセスの1つの成長スーパーサイクルの図。 b O 2 の関数としてのZnO成長速度 熱サイクルが固定されたスーパーサイクルALDのプラズマ時間( m =1)およびプラズマ強化ALDプロセス。破線の曲線は目のガイドです。 c 熱処理サイクル m の関数としてのZnO成長速度と線形フィッティング 固定O 2 プラズマ時間( t 3 =1および8秒)
堆積したZnO膜の厚さと光学定数は、エリプソメトリー(VASE、J.A。Woollam Co. M-2000)によって測定され、Tauc-Lorentz(TL)モデルに適合しました。電気的特性は、0.5 Tの磁場下で室温でホール測定(Nanometrics HL5500PC)によって測定されました。すべての測定の前に、各銅プローブとサンプルの間で線形接触が得られるように特別な注意が払われました。 X線回折(XRD)パターンは、かすめ入射(θ)で収集されました。 1 =1°)9 kW Cu- K を備えたRigakuSmartlab回折計を使用 α ソース。 X線光電子分光法(XPS)データは、Al- K を備えたThermoScientificThetaプローブシステムを使用して取得されました。 α 放射線(光子エネルギー=1486.6 eV)。必要に応じて、イオンスパッタリングガンを使用して表面の汚染を除去しました。 Zn 2 p 、O 1 s 、およびC 1 s スペクトルが収集されました。すべてのデータはC1 s を参照していました 284.6eVの結合エネルギーが割り当てられたピーク。 KPFM測定は、65kHzの共振周波数を持つNanosensorATECPt-IrコーティングチップによってNanonicsCV2000で実行されました。表面汚染物質の影響を減らすために、サンプルを真空チャンバーから取り出した直後に測定を行いました。
結果と考察
提案されたスーパーサイクルALDプロセスは、 m で構成される1つのスーパーサイクルを使用して図1aに示されています。 熱ALDプロセスのサイクル(DEZおよびH 2 O)と1つのO 2 プラズマステップ(O 2 プラズマ)。詳細については、「メソッド」セクションを参照してください。図1bは、 m の場合のスーパーサイクルALDプロセスでのZnO成長速度を比較しています。 =1およびO 2 の関数としての従来のプラズマ強化ALDプロセス プラズマ時間。プラズマ強化ALDプロセス(赤)の成長速度は、O 2 に敏感であることがわかります。 それが約から増加するにつれてプラズマ。 1.4〜1.7Å /サイクル、プラズマ時間は2秒から4秒に変更されます。その後、それは約のレベルで飽和します。より長いプラズマ時間で1.7Å/サイクル。より短いO 2 での不飽和成長速度 血漿時間は、プロセス中の酸素欠乏に起因します。これは、高導電率のZnO膜を得るのに好ましい場合がありますが、自己制限的ではなく、基板全体の均一性が低下する可能性があります。一方、成長率は約2倍で安定していることがわかった。スーパーサイクルALDプロセス(黒)の1.69Å/スーパーサイクルであり、熱ALDプロセスのそれに近い( t 3 =0 s)適用されるプラズマ時間に関係なく。さらに、熱サイクルの増加 m 図1cに示すように、プラズマ時間が固定された1つのスーパーサイクルでは、成長速度が直線的に増加します。適合勾配は、O 2 が異なる両方の成長で1.67と計算されます。 プラズマ時間。これも熱ALDプロセスの成長速度に近い。これは、スーパーサイクルALDでのZnOの成長が、熱ALDプロセスとそれに続くO 2 によって支配されていることを示唆しています。 プラズマステップは単なる治療として機能します。
スーパーサイクルALDプロセス( m )によって成長したすべてのZnO膜 =1)六角形のウルツ鉱型構造で結晶化し、O 2 に関係なくピーク強度の同様の分布を示します。 図2aに示すように、血漿時間。ピーク(0 0 2)と(1 0 1)の間の理論強度比0.44(微結晶のランダムな配向についてJCPDS-34-1451から計算)と比較して、これらのフィルムはに沿って強い優先配向を示します。 c -軸は(0 0 2)と(1 0 1)のピーク強度比が2と5の間であり、フィルムの結晶品質が良好であることを示しています。 O 2 の増加に伴い、(0 0 2)から(1 0 1)のピーク比のわずかな増加が観察されます。 血漿時間(追加ファイル1:図S1に示されています)。これは、より長いプラズマにさらされたときに、より高度な優先配向を示唆します。同様の動作も報告されています[27、28]。しかし、私たちの仕事における強度比の変化は、他の仕事に比べてかなり些細なことであることを指摘する価値があります。これはさらに、高品質のZnO膜を製造するためのスーパーサイクルALDプロセスの安定性を示唆しています。平均粒径もシェラーの式[29]に基づいて推定され、約2倍であることがわかりました。 11 nm、これはZnOの粒子サイズがO 2 の影響をほとんど受けていないことを示しています。 プラズマ時間。同様のパターンは、さまざまな熱ALDサイクル( m )から成長したZnO膜でも観察されます。 )固定O 2 図2bに示すプラズマ時間(1秒)。
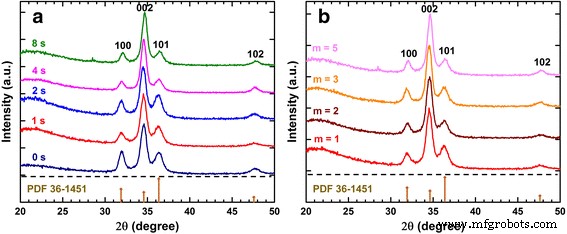
a を使用したスーパーサイクルALDプロセスによって成長したZnO膜のXRDパターン 異なるO 2 固定熱サイクル( m )でのプラズマ時間 =1)および b 固定されたO 2 によるさまざまな熱サイクル 血漿時間( t 3 =1秒)
結晶化度とは別に、超サイクルALD成長ZnO膜の光学特性も分光エリプソメトリー(SE)を使用して研究されました。光学定数( n および k )は、ZnO膜のフィッティングに一般的に使用されるTauc-Lorentzモデルによってエリプソメトリーの結果から抽出できます[28、30、31]。類似の結晶化度と同様に、異なるO 2 で堆積されたZnO膜の光学特性 追加ファイル1:図S2に示すように、プラズマ時間と熱サイクルも変更されません。これは、結晶化度の変化が常に光学特性の変化に関連しているという報告された研究と一致しています[28、32]。 ZnO膜の形態学的特性はAFMによって特徴づけられます。すべてのフィルムは同様に滑らかであり、平均粗さは約1〜2であることがわかりました。 0.3および0.8nm(追加ファイル1:図S3)。
スーパーサイクルALDプロセスによって成長したZnO膜の電気的特性は、ホール効果システムによって調査されます。すべての映画が n であることが判明しました タイプの半導体であり、抵抗率は約から増加します。 10 -3 〜10 3 O 2 の増加に伴うΩcm プラズマ時間と固定熱サイクル( m =1)図3aに示すように。これは、キャリア濃度が約1から減少することに関連しています。 10 21 〜10 15 cm -3 O 2 として 血漿時間は0秒から8秒に増加します(図3b)。逆に、すべてのZnO膜の電子移動度はかなり一貫していることがわかります(約3.0±1.0 cm 2 / V s)であり、血漿持続時間の影響を受けません。詳細な伝導メカニズムについては、以下のセクションで詳しく説明します。以前に報告したプラズマ強化ALDプロセス[21]と比較して、抵抗率調整の大きさは、スーパーサイクルALDプロセスで5桁以上にさらに改善されました。さらに、この提案されたALDプロセスは、熱サイクル( m )を変化させることにより、これらの電気的特性をより洗練された制御で提供します。 )O 2 を固定しながら1つのスーパーサイクルで 血漿時間( t 3 )。これは、 t の場合に特に便利です。 3 =1 s ALD機器の制限により、プラズマ時間をさらに短縮してもチューニングが達成できない場合。図3a、bの白抜きの点は、さまざまな熱サイクル( m )によって成長したZnO膜の抵抗率とキャリア濃度を表しています。 =2、3、5) t の場合 3 =1秒(エラーバーはドット内にあります)。熱サイクルが多いほど、キャリア濃度が高く、抵抗の少ない膜になることがわかります。これにより、10 -3 の範囲内で3つの抵抗率が追加されます。 〜10 1 Ωcm。
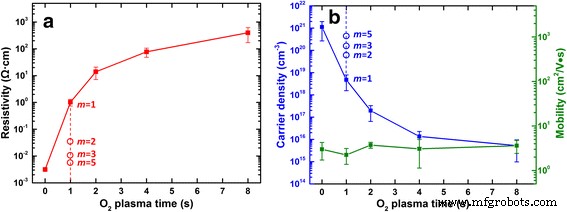
a 異なるO 2 から成長したZnO膜の電気抵抗率 固定熱サイクルのプラズマ時間 m (実線の点)および固定O 2 によるさまざまな熱サイクル スーパーサイクルALDプロセスによるプラズマ時間(白抜きの点)。 b 異なるO 2 から成長したZnO膜のキャリア濃度(青) 固定熱サイクル(実線の点)を使用したプラズマ時間と固定O 2 を使用したさまざまな熱サイクル 血漿時間(白抜きの点)。異なるO 2 から成長したZnO膜の移動度(緑) 固定熱サイクルでのプラズマ時間
KPFM測定は、抵抗率が変化するZnO膜のフェルミ準位の位置に関する洞察を得るために実行されました。接触電位差 V を測定します CPD 導電性チップとサンプルの間:
$$ {V} _ {\ mathrm {CPD}} =\ frac {\ phi _ {\ mathrm {tip}}-{\ phi} _ {\ mathrm {sample}}} {q} $$(1)ここで、 q は電荷ですが、 ϕ ヒント および ϕ サンプル それぞれチップとサンプルの仕事関数です。 2つの異なる材料が電気的に接触すると、フェルミ準位は電子電流の流れによって整列し、その結果、追加ファイル1:図S4に示すように、チップとサンプルの間に接触電位差が生じます。 KPFMの詳細な動作原理は、追加ファイル1に示されています。さまざまなO 2 からのスーパーサイクルALDプロセスによって成長したZnO膜の接触電位の違い 固定熱サイクル( m )でのプラズマ時間 =1)を図4に示します。各 V CPD 画像は均一で比較的滑らかに見え、平均 V にかなりの違いがあります CPD 値を観察できます(図4fに示されています)。チップ仕事関数 ϕ ヒント すべての測定で一定のままです。 V の実質的な違い CPD したがって、これは異なるZnO膜内のフェルミ準位シフトの結果です。約の合計シフト。 0.32 eVは、0秒と8秒のO 2 で成長したZnO膜の間で得られます。 ZnOバンドギャップと比較して有意なプラズマ時間(追加ファイル1:図S2cに示すように、SEに基づく約3.22 eVの結果がこの作業になります)。異なる熱サイクル( m )から成長したZnO膜の場合 =2、3、5)固定O 2 血漿時間( t 3 =1 s)、異なる V CPD 図4fに示すように、値も検出されました。これらのフィルムの2次元KPFM画像は、追加ファイル1:図S5にあります。これは、電子正孔バランスの変化が膜全体で発生し、ZnOキャリア濃度にかなりの影響を与える可能性があることを意味します。
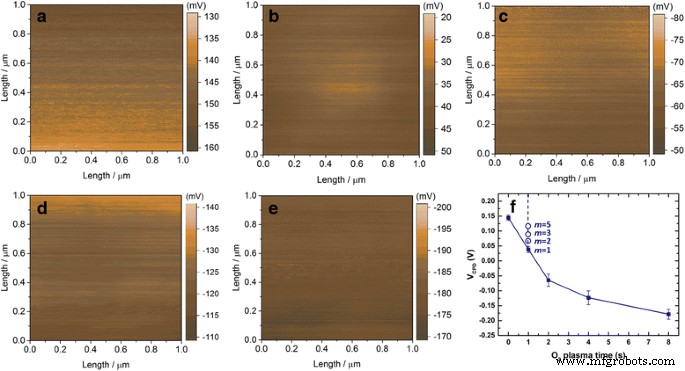
a – e 二次元接触電位差 V CPD O 2 を使用したスーパーサイクルALD成長ZnO膜の表面電位測定の画像 血漿時間( t 3 )0〜8秒で変化し、熱サイクルが固定されている( m =1)。 f 平均 V CPD O 2 が変化する値 プラズマ時間(実線の点)と熱サイクル(白抜きの点)
フェルミ準位とキャリア濃度の関係を調べるために、Maraglianoらによって提案された電子エネルギーモデルを採用します。接触電位差を相関させる V CPD 材料中のドーピング濃度[26]。有効ドナー濃度を仮定すると n D 固有のキャリア濃度よりも大幅に高い場合は、次のように記述できます。
$$ {n} _ {\ mathrm {D}} \ approx {N} _ {\ mathrm {C}} \ exp \ left(\ frac {q {V} _ {\ mathrm {C} \ mathrm {PD} }-{\ phi} _ {\ mathrm {tip}} + \ chi} {K_BT} \ right)$$(2)ここで N C は有効状態密度χです。 は半導体の電子親和力、 K B はボルツマン定数であり、 T は温度です。有効状態密度の値は N ですが、 C 、チップ仕事関数 ϕ ヒント 、および電子親和力χ 取得が困難な場合、これらの値はすべての測定で同じであるため、さまざまなZnO膜の相対的なキャリア濃度の差を計算できます。したがって、0秒のO 2 で成長した膜間のキャリア濃度比 特定のZnO膜までのプラズマ時間は、次のように表すことができます。
$$ \ frac {n_0} {n_x} =\ exp \ left(\ frac {V _ {\ mathrm {CPD} 0}-{V} _ {\ mathrm {CPD} x}} {K_BT / q} \ right) $$(3)n 0 および n x は、0および x で成長したZnO膜のキャリア濃度です。 sのO 2 それぞれプラズマ時間、および V CPD0 および V CPD x 対応する接触電位差です。計算されたキャリア濃度比は、O 2 の関数として図5にプロットされています。 プラズマ時間。濃度比は、O 2 が長くなるにつれて増加するように計算されます。 血漿時間(赤)。さらに重要なことに、増加傾向は、ホール効果測定結果(黒)から得られた値とよく一致しています。同様の傾向は、異なる熱サイクル( m )から成長したZnO膜でも観察されました。 =2、3、5)固定O 2 血漿時間( t 3 =1秒)。これは明らかに、ZnO膜のフェルミ準位のシフトがキャリア濃度レベルに直接関連していることを示唆しています。
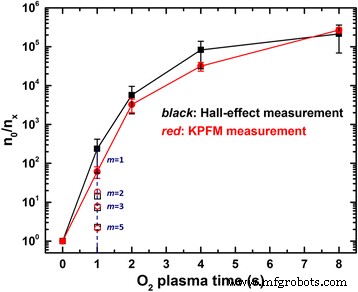
さまざまなO 2 で成長させたZnO膜間のキャリア濃度比のホール効果とKPFM測定結果 プラズマ時間(実線の点)と熱サイクル(白抜きの点)
X線光電子分光法(XPS)測定は、超サイクルALD成長ZnO膜の結合と化学状態を研究することにより、伝導メカニズムに光を当てるために実行されました。 O 1 s の化学状態 を図6に示します。ここでは、ガウスフィッティング後に2つのピークを識別できます。低いエネルギーピーク(A)は約530.3eVがO 2- であることが推奨されます 六角形のZn 2+ のウルツ鉱構造のイオン イオン[33、34、35]。約でより高い結合エネルギー成分の割り当て。 532.2(B)は、文献[33,34,35,36,37,38]について物議を醸しています。しかし、それはZnO膜のヒドロキシル基(すなわち、Zn–OH)[33、37、38、39]と関連していることが広く報告されています。したがって、暫定的にO B 図6で観察されたZn-OH結合のピーク。一方、酸素空孔に関連するピークは、約1に位置します。この作業では531.2eV [35]は観察されません。熱ALDプロセス( t )によって成長したZnO膜 3 =0 s)は支配的なO B を特徴付ける XPSスペクトルのピーク(図6a)。これは、この膜に水素関連の不純物が大量に存在することを意味します。この高レベルの欠陥は、自己ドーピングメカニズムとして機能し、高いキャリア濃度につながります。追加のO 2 プラズマステップ( t 3 )不純物を減らし、O B ピーク強度は、O 2 が長くなると減少します 血漿時間(図6f)。同様の傾向は、さまざまな熱サイクルから成長したZnO膜でも観察され、より多くの熱サイクルがO B の増加につながります。 図6fおよび追加ファイル1に示すピーク強度:図S6。

a – e XPSスペクトルとO1 s のガウスフィッティング O 2 を含む超サイクルALD成長ZnO膜の領域 血漿時間( t 3 )0〜8秒で変化し、熱サイクルが固定されている( m =1)。 f 水素関連のO B の割合 さまざまなO 2 で成長したZnO膜のピーク プラズマ時間(実線の点)と熱サイクル(白抜きの点)
固有の n の起源 ZnO膜のタイプの導電率はまだ物議を醸しています。従来の知識では、この導電率は固有の欠陥(つまり、酸素空孔とZn格子間原子)に起因するとされてきましたが[18、40、41、42、43、44]、最近の第一原理計算によって異議を唱えられています[45]。酸素空孔はまた、多くの研究が浅いドナーではなく深いドナーであり、 n で高い形成エネルギーを持っていることを示唆しているため、このような高濃度レベルに寄与する可能性は低いです。 -タイプのZnO(したがって、形成される可能性は低い)[41,42,43,44]。さらに、酸素空孔関連のO 1 s 図6に示すXPSデータでもピークは観察されません。Zn格子間原子は浅いドナーですが、形成エネルギーが高く、拡散が速いため、安定しにくいことが示唆されています[41]。 Zn 2 p のXPSスペクトル 3/2 さまざまなO 2 を備えた超サイクルALD成長ZnO膜の状態 プラズマ時間は図7に示されています。すべてのスペクトルは、約1に位置する同様のピークによって特徴付けられます。 Zn 2+ に起因する1021.5eV ZnOでの結合[6、34、46]。ただし、結合エネルギーがわずかに高いZn格子間成分[6、47]は、すべてのスペクトルで観察されるわけではありません。これは、ZnO膜の導電率に対するZn格子間原子の影響もこの研究で除外できることを示唆しています。

a – e XPSスペクトルとZn2 p のガウスフィッティング 3/2 O 2 を含む超サイクルALD成長ZnO膜の領域 血漿時間( t 3 )0〜8秒で変化し、熱サイクルが固定されている( m =1)
最近、水素関連の不純物/欠陥が n で役割を果たすことが提案されています。 ZnOのタイプの導電率[33、48]。 ZnOに水素結合が存在する証拠は、Janotti etal。によって実証されています。 [48]、そしてそれらの結合は高濃度で組み込まれ、浅いドナーとして振る舞うことができることが示唆されている[49,50,51]。実際、水素は、前駆体とH 2 の両方として、スーパーサイクルALDプロセスに存在します。 Oには水素が含まれており、熱ALDステップの半サイクルごとにZn-OH結合が生成されます。これは、ヒドロキシル基に関連するO 1 s の観察によっても裏付けられています。 XPSスペクトルのピーク(図6を参照)。 ZnO膜の抵抗率とキャリア密度は、図8のこのピークの比率に対してプロットされています。これらの水素不純物の比率が高いと、キャリア濃度が高くなり、抵抗率が低くなります。後続のO 2 各スーパーサイクル内のプラズマステップは、水素結合を効果的に除去することによってキャリア濃度を低減します。これは、キャリア濃度の低下と抵抗率の増加を伴います。 ALDプロセスとCVDプロセスの両方で同じ動作が報告されました[33、52]。
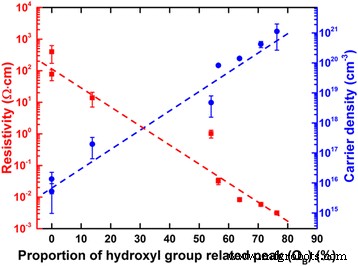
ヒドロキシル基に関連するO B の関数としての電気抵抗率とキャリア濃度 ピーク比率(破線は目のガイドです)
結論
ここでは、熱ALDプロセスとその場O 2 を組み合わせたスーパーサイクルALDプロセスを使用して、高度に調整可能な電気的特性を備えたドープされていないZnO膜の堆積を報告しました。 プラズマ治療。 O 2 を調整することにより、膜の抵抗率とキャリア濃度を5桁以上調整できました。 プラズマ時間。スーパーサイクルの熱ALDサイクル数を変えることで、特性の微調整も実現できます。これらの電気的特性の調整は、膜中の水素欠陥濃度の変化に関連していると考えられています。これは、ケルビンプローブフォース顕微鏡によって明らかにされたように、ZnO膜内のフェルミ準位のシフトを直接引き起こします。単純な電子エネルギーモデルを採用することにより、フェルミ準位シフトから計算されたキャリア濃度は、ホール効果測定結果との良好な一致を示しています。ここで報告されているこの信頼性が高く堅牢な技術は、この方法を使用して、さまざまなアプリケーションで特性が制御されたZnO膜を製造できることを明確に示しています。
略語
- ALD:
-
原子層堆積
- DEZ:
-
ジエチル亜鉛
- KPFM:
-
ケルビンプローブフォース顕微鏡
- XPS:
-
X線光電子分光法
- XRD:
-
X線回折
ナノマテリアル
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- オーミック接触を形成するためのp-GaNへのAlドープZnOの2段階堆積
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 赤外領域におけるAlドープZnO膜の光学的性質とそれらの吸収への応用
- ペロブスカイト太陽電池の光起電力特性に及ぼすさまざまなCH3NH3PbI3形態の影響
- 酸化亜鉛/多孔質陽極酸化アルミナ複合膜の調製とアンチバイオフィルム特性
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性



