薄膜トランジスタ用の酸化インジウムナノフィルムの原子層堆積
要約
In 2 の原子層堆積(ALD) O 3 ナノフィルムは、シクロペンタジエニルインジウム(InCp)と過酸化水素(H 2 )を使用して調査されました。 O 2 )前駆体として。 In 2 O 3 膜は160〜200°Cの比較的低温で優先的に堆積でき、1.4〜1.5Å /サイクルの安定した成長速度を示します。堆積された膜の表面粗さは、堆積温度とともに徐々に増加し、これは、より高い堆積温度での膜の結晶化の増強に起因する。堆積温度が150°Cから200°Cに上昇すると、光学バンドギャップ(E g )堆積した膜のは3.42から3.75eVに上昇します。さらに、堆積温度の上昇に伴い、堆積されたままの膜のInとOの原子比は、化学量論的なIn 2 の原子比に向かって徐々にシフトします。 O 3 、および炭素含有量も段階的に減少します。 200°Cの堆積温度では、堆積された膜は1:1.36のIn:O比を示し、炭素の取り込みはありません。さらに、高性能のIn 2 O 3 Al 2 の薄膜トランジスタ O 3 ゲート誘電体は、300°Cの空気中で適切な時間ポストアニーリングすることで実現され、7.8 cm 2 の電界効果移動度を示しています。 /V⋅s、サブスレッショルドスイング0.32 V / dec、オン/オフ電流比10 7 。これは、デバイスチャネル内の酸素空孔の不動態化に起因していました。
背景
酸化インジウム(In 2 O 3 )は透明な金属酸化物半導体であり、室温で約3.7 eVの広いバンドギャップ、可視光に対する高い透明性、および優れた化学的安定性を示します[1、2]。したがって、In 2 O 3 光起電デバイス、電気化学センサー、フラットパネルディスプレイなどのさまざまなアプリケーションについて調査されています[3,4,5]。これまで、In 2 を準備するために、いくつかの堆積技術が開発されてきました。 O 3 スパッタリング[6、7]、ゾルゲル[8、9]、および化学蒸着(CVD)[10、11]を含む薄膜。ただし、スパッタリングとゾルゲル法の手法は、通常、広い領域での均一性が低く、元素組成が不正確であるという問題があります。 CVD技術は一般に> 300°Cの比較的高い堆積温度を必要とします。これらの欠点により、均一なIn 2 を実現することが困難になります。 O 3 低い堆積温度で正確な厚さと組成制御を備えたフィルム。
近年、原子層堆積(ALD)は、優れたステップカバレッジ、原子スケールの厚さの制御性、優れた均一性、および比較的低い堆積温度を実現できる有望なアプローチとして登場しました。したがって、In 2 の成長 O 3 薄膜は、InCl 3 を含むさまざまな前駆体を使用したALDによって調査されています。 -H 2 O [12]、InCl 3 -H 2 O 2 [13]、InCp-O 3 [14]、InCp-O 2 -H 2 O [15]、およびIn(CH 3 ) 3 -H 2 O [16]。 InCl 3 の前駆体に関して -H 2 OおよびInCl 3 -H 2 O 2 、In 2 の堆積温度 O 3 フィルムは〜300–500°Cに上げる必要があります[13]。一方、InCl 3 十分なInCl 3 を得るには、コンテナを285°Cに加熱する必要があります。 蒸気[15]。さらに、腐食性HClの副産物は、ALD装置に損傷を与え、堆積したIn 2 をエッチングする可能性があります。 O 3 フィルム[17]、およびIn 2 の成長率 O 3 0.25〜0.40Å /サイクルと低いです。 TMIn-H 2 などの他の前駆体が OおよびTMIn-H 2 O 2 ALD In 2 に採用されました O 3 フィルムでは、比較的大きな成長速度(1.3〜2Å /サイクル)にもかかわらず、堆積温度は依然として高い(つまり、200〜450°C)[18]。
この作業では、InCpとH 2 O 2 ALD In 2 の前駆体として提案されました O 3 薄膜、したがってIn 2 O 3 薄膜は低温でうまく堆積し、満足のいく成長速度を示した。さらに、堆積された膜の物理的および化学的特性が特徴づけられた。さらに、In 2 O 3 ALD Al 2 を備えた薄膜トランジスタ(TFT) O 3 ゲート誘電体が製造されており、7.8 cm 2 の電界効果移動度などの優れた電気的性能を示しています。 V -1 s -1 、およびオン/オフ電流比10 7 など
実験的
Si(100)ウェーハは、標準のRadio Corporation of Americaプロセスを使用して洗浄され、初期基板として機能しました。 2 O 3 薄膜は、ALD装置(Wuxi MNT Micro Nanotech Co.、LTD、中国)を使用して、事前に洗浄されたSi(100)基板上に、InCp(Fornano Electronic Technology Co.、LTD、中国、不純物:99.999%)およびH 2 O 2 (30%水溶液)前駆体はそれぞれ130°Cと50°Cに維持されました。パージガスとして窒素ガスを使用した。 ALD In 2 の機能を実証する O 3 薄膜、In 2 O 3 ベースのチャネルTFTは、次のプロセスとして製造されました。まず、38 nm Al 2 O 3 ゲート誘電体膜は、トリメチルアルミニウムとH 2 を使用したALDにより、200°Cで事前に洗浄されたp型Si(100)基板(<0.0015Ω・cm)上に成長しました。 O、およびそのような低抵抗率のシリコン基板は、バックゲートとして機能した。次に、20 nm In 2 O 3 チャネル層はAl 2 上で成長しました O 3 160°Cでフィルム。 Ti / Au(30 nm / 70 nm)スタックのソース/ドレイン接点は、光リソグラフィー、電子ビーム蒸着、およびリフトオフプロセスによって順番に形成されました。最後に、製造されたデバイスは、空気中300°Cでさまざまな時間アニーリングされました。
In 2 の結晶化度、表面形態、元素組成、吸収係数、および厚さ O 3 フィルムは、X線回折(XRD)(Bruker D8 Discover)、原子間力顕微鏡(AFM)(Bruker Icon)、X線光電子分光法(XPS)(Kratos Axis Ultra DLD)、紫外可視分光法(UV- VIS)、およびエリプソメーター(Sopra GES-SE、フランス)。デバイスの電気的測定は、室温の周囲空気中でカスケードプローブステーションを備えた半導体パラメータアナライザ(B1500A、Agilent Technologies、日本)を使用して実行されました。
結果と考察
図1aは、In 2 の成長率を示しています。 O 3 基板温度の関数としてのフィルム。 160〜200°Cの範囲で〜1.46Å /サイクルの安定した成長速度が達成され、ALD In 2 の速い成長速度と明確な温度ウィンドウが明らかになります。 O 3 映画。基板温度を150°Cに下げるか210°Cに上げると、結果として生じる成長速度は大きくなりました[19、20]。前者は基板上のInCpの凝縮に起因し、後者は高温でのInCpの熱分解に起因します。さらに、堆積したIn 2 の進化 O 3 図1bに示すように、膜厚はALDサイクルの関数として評価されました。 In 2 であることは明らかです O 3 膜厚は堆積サイクルの数とともに直線的に増加し、非常に均一な成長を示します。

a ALD In 2 の成長率 O 3 基板温度の関数としてのSi基板上の膜、および b In 2 の依存性 O 3 160°CでのALDサイクル数の膜厚
In 2 の進化を観察する O 3 堆積温度によるフィルムテクスチャ、In 2 のXRDパターン O 3 異なる温度で堆積された膜を図2に示します。堆積温度が160°Cを超えない場合、回折ピークは観察できません。これは、堆積したIn 2 が O 3 低温のフィルムはアモルファスです。堆積温度が170°Cまで上昇すると、いくつかの回折ピークが現れ始めます。さらに、堆積温度が徐々に210°Cまで上昇すると、回折ピーク強度は劇的に増加します。これは通常、2θ=30.3°と35.4°のピークで示されます。これは、堆積したままのIn 2 の結晶化度と粒径を示しています。 O 3 膜は、堆積温度の上昇とともに徐々に強化されます。図3は、代表的なIn 2 の表面形態を示しています。 O 3 異なる温度で堆積した膜。堆積温度を上げると、膜表面はますます粗くなることがわかります。つまり、結果として得られる二乗平均平方根(RMS)粗さは、堆積温度を160から210°Cに上げると0.36から1.15nmに増加します。これは、In 2 の結晶化度に関連している必要があります O 3 映画。 160°Cの堆積温度に関して、堆積されたIn 2 O 3 フィルムはアモルファスで、非常に滑らかな表面を示します。堆積温度が180°Cに達すると、堆積された膜は多結晶になります。これは、図2に示すように、得られた膜には多くの結晶粒が含まれており、堆積温度の上昇に伴って結晶粒径が大きくなることを意味します。これは、膜表面のヒロックのサイズが観察されたこととよく一致しています。堆積温度を上げると徐々に増加するため、RMS値が増加します。
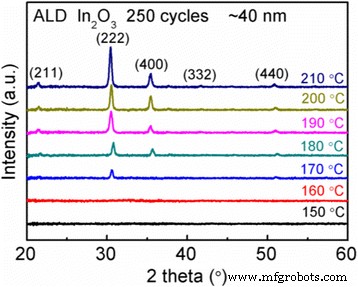
In 2 のX線回折パターン O 3 異なる温度で250サイクル堆積した膜

In 2 のAFM画像 O 3 異なる温度で堆積された膜: a 160°C、 b 180°C、 c 200°Cおよび d 210°C。堆積サイクルは、各フィルムで250に固定されました
図4は、In 2 の高分解能C1 s、In 3d、およびO1sXPSスペクトルを示しています。 O 3 異なる温度で堆積した膜。図4aに示すC1 s XPSスペクトルに関して、160°Cで堆積された膜は289.8 eVにピークを示し、これはC-Oに対応するはずです[21]。堆積温度を180°Cに上げると、ピークははるかに弱くなります。さらに、200°Cの堆積温度に関しては、C 1sのピークが消えます。したがって、堆積温度が高いほど、堆積されたIn 2 中のCの不純物が少ないことが示されます。 O 3 映画。図4bは、In 2 のIn3dXPSスペクトルを示しています。 O 3 In 3d 5/2 に関連する、444.7および452.3eVでのワンダブレットガウスピークを明確に示すフィルム および3d 5/2 In 2 のコアレベル O 3 [22、23]。 O1のXPSスペクトルを図4cに示します。各サンプルのO1 sスペクトルは、それぞれ529.8、531.0、および532.0eVにある3つのピークに十分に分離できることがわかります。これらのピークはO 2- に対応します 金属(O1)、酸素空孔(O2)、および–OH / CO(O3)とそれぞれ結合したイオン[24、25]。堆積温度が160から200°Cに上昇すると、O1の相対パーセンテージは76から92%に上昇します。 O2の相対的な割合は16%から4%に徐々に減少します。さらに、O3の相対的な割合も減少傾向を示しています。これらの結果は、より高い堆積温度が、堆積された膜中の酸素空孔の濃度、ならびにヒドロキシル基およびC-O結合を減少させるのに有益であることを示している。さらに、In 2 の元素組成 O 3 さまざまな温度で堆積された膜を表1に示します。興味深いことに、堆積された膜のIn / Oの原子比は、堆積温度の上昇とともに徐々に減少します。ただし、純粋なIn 2 の場合でも O 3 200°Cで堆積した膜の場合、In / Oの原子比(1:1.36)は、化学量論的In 2 の原子比(1:1.5)よりも大きくなります。 O 3 。これは、ALD In 2 O 3 フィルムは一般的に酸素空孔が豊富です。

高解像度 a C 1s、 b 3D、および c O 1 s In 2 のXPSスペクトル O 3 それぞれ160、180、および200°Cで堆積された膜。偶発的な表面汚染物質を除去するために、信号収集の前に、すべてのサンプルをその場でのArイオン衝撃で6分間エッチングしました
。図5aは、(αhν) 2 のバリエーションを示しています。 堆積したままのIn 2 の光子エネルギーの関数として O 3 異なる堆積温度でのフィルム。光学バンドギャップ(E g )In 2 の O 3 フィルムは、タウクの関係によって決定できます:αhν=A(hν-E g ) n [26]、ここでα は吸収係数、 A は定数、 h プランク定数ν は頻度であり、指数 n バンド遷移の性質を特徴づけます。ここでは、 n =1/2、In 2 であることを示します O 3 直接許容遷移を持つ半導体です。 E g 直線部分をαのエネルギーバイアスに外挿して抽出します。 =0。抽出された E g In 2 の場合 O 3 フィルムを図5bに示します。 E g 堆積温度を150から200°Cに上げると、3.42から3.75eVに増加します。増加した E g より高い堆積温度では、堆積された膜中の酸素空孔とC不純物の減少に起因する可能性があります。実際、他の研究者も、ZnOに多くの酸素空孔が存在すると、不純物状態がより非局在化し、価電子帯の端と重なり、バンドギャップが狭くなることを報告しました[27]。さらに、堆積温度の関数として徐々に増強された結晶化度は、In 2 の光学バンドギャップに影響を与える可能性があります。 O 3 映画。これは次のように説明できます。堆積温度が上昇すると、堆積したIn 2 の粒径が大きくなります。 O 3 図2に示すように、膜は増加します。これにより、膜の粒界密度が減少します。電子は粒界に閉じ込められやすいため、In 2 では自由電子の数が増えるはずです。 O 3 粒界の少ないフィルム[28、29]。したがって、このように電子濃度が高くなると、Burstein-Mossシフトによって光学バンドギャップが大きくなります[30]。

a (αhν) 2 のプロット 対In 2 の光子エネルギー O 3 異なる温度で堆積された膜; b 抽出されたバンドギャップの依存性(E g )のIn 2 O 3 堆積温度について
ALD In 2 の機能を実証する O 3 TFTのチャネルとして機能するフィルム、In 2 O 3 -原子層が堆積したAl 2 を備えたチャネルベースのTFT O 3 ゲート誘電体が製造された。図6aは、In 2 の転送特性を示しています。 O 3 TFT。製造されたままのデバイスは、電界効果トランジスタに典型的なスイッチ特性を示さず、ソースとドレインの間の導体のようなものであることがわかります。これは、In 2 に多くの酸素空孔が存在することに起因するはずです。 O 3 酸素空孔が自由電子を供給できるため、チャネル。したがって、In 2 の酸素空孔の濃度を下げるために O 3 チャネル、空気中でのポストアニーリングは300°Cで実行されました。 In 2 であることは明らかです O 3 TFTは、2時間のアニーリング後に典型的なスイッチング動作を示します。これは、空気中でのポストアニーリングによってデバイスのパフォーマンスが大幅に向上する可能性があることを示しています。さらに、アニーリング時間が10時間まで徐々に増加すると、しきい値電圧(V th )のTFTが正バイアスの方向にシフトし、サブスレッショルドスイング(SS)が少しずつ向上します。ただし、アニーリング時間が11時間に増加すると、デバイスのパフォーマンスが低下し始めます。水素は、製造プロセス中にフィルムに組み込まれ、チャネル内またはチャネルと誘電体の間の界面で–OH結合を形成することによって電子トラップとして機能する可能性があることに注意してください[31]。これらの電子トラップはおそらくSSの劣化をもたらします。空気中でアニーリングした後、OH結合はO 2 の取り込みによって減少しました 分子[32]。これにより、トラップ密度が低下し、デバイスのSSが向上する可能性があります。空気中での10時間のアニーリングに関しては、In 2 O 3 TFTは電界効果移動度(μ EF )7.8 cm 2 V -1 s -1 、V th -3.7 V、SS 0.32 V / dec、オン/オフ電流比(I on / I オフ )of 10 7 。対応する出力特性も図6bに示され、さまざまな正のゲート電圧の下での明確なピンチオフおよび電流飽和動作を示しています。さらに、出力曲線は n も示しています -タイプの拡張モード。比較のために、表2は、報告されたALD In 2 の特性をまとめたものです。 O 3 さまざまな研究グループのフィルムとTFT [33、34、35、36、37]。 In 2 O 3 フィルムは比較的低温で優れた成長速度を示し、製造されたデバイスも小さなSSを示します。ただし、デバイスの一般的なパフォーマンスはそれほど完璧ではなく、プロセスとデバイス構造の最適化によって改善される可能性があります。
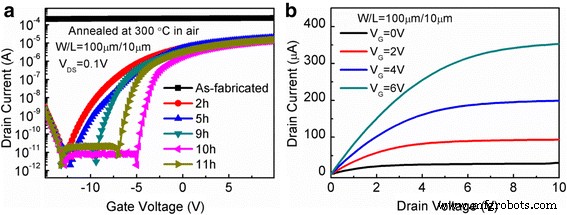
a In 2 の伝達特性 O 3 空気中300°Cで異なる時間アニールされたTFT。 b In 2 の出力特性 O 3 空気中300°Cで10時間アニールしたTFT
In 2 の組成に対する空気中でのポストアニーリングの影響をよく理解する O 3 チャネル、In 2 O 3 フィルムを300°Cでさまざまな時間アニーリングした後、XPSを使用して分析しました。表3に、さまざまなアニールされたフィルムの元素パーセンテージを示します。アニーリング時間が2時間から11時間に増加すると、In:Oの原子比は1:1.22から1:1.48に減少し、化学量論的In 2 の(1:1.5)に徐々に近づきます。 O 3 。これはさらに、空気中でのアニーリング時間を長くすると、In 2 の酸素空孔の密度が効果的に減少したことを確認します。 O 3 映画。したがって、In 2 のパフォーマンスが向上します。 O 3 TFTは主に、バルクチャネルおよび/またはチャネルと誘電体の間の界面に位置する可能性のある酸素空孔の不動態化に起因するはずです[25]。ただし、11時間のアニーリングで明らかになったように、過度のアニーリングはデバイスのパフォーマンスを低下させました。これは、In 2 の結晶化の変化に起因する可能性があります。 O 3 チャネル層、および空気中での余分なポストアニーリング中のTi電極の酸化の可能性。したがって、In 2 の良好な性能を達成するには、適切なアニーリング時間が必要です。 O 3 TFT。
<図>結論
In 2 の急速なALD成長 O 3 フィルムは、InCpとH 2 を使用して、比較的低温(160〜200°C)で実現されています。 O 2 1.46Å/サイクルの均一な成長速度を示す前駆体。堆積温度が上昇するにつれて、堆積された膜の結晶化は徐々に増強された。一方、堆積膜の酸素空孔と炭素不純物の両方も大幅に減少しました。したがって、これは E の増加につながりました g In 2 の O 3 。さらに、ALD In 2 O 3 チャネル層、ALD Al 2 を備えたTFT O 3 誘電体が製造された。空気中でのポストアニーリング時間が長くなるにつれて、In 2 の電気的性能 O 3 TFTは10時間のアニーリングまで明らかに改善されました。これは主に、バルクチャネルおよび/または空気中でのアニーリング後のチャネルと誘電体の間の界面にある酸素空孔の不動態化によるものです。 10時間のアニーリングに関して、デバイスは7.8 cm 2 の電界効果移動度などの優れた性能を示しました。 /V⋅s、サブスレッショルドスイング0.32 V / dec、オン/オフ電流比10 7 。 200°Cの堆積温度に関して、堆積された膜は、検出可能な炭素なしで1:1.36のIn:O比を示し、したがって、堆積されたままの膜に酸素空孔が存在することを明らかにします。
ナノマテリアル
- 10nmチップ用のエアスペーサー
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- フルアングルマイクロLED用の高反射薄膜最適化
- リチウムイオン電池用の金属酸化物アノードの電気化学的性能に及ぼす異なるバインダーの影響
- 超高感度グルコースセンシング用のメソポーラス酸化ニッケル(NiO)ナノペタル
- リチウムイオン電池用のパルスレーザー堆積によって調製されたナノ結晶Fe2O3膜アノード
- イプシロンに近いゼロに近いインジウムスズ酸化物に基づく偏光非感受性表面プラズモン偏光電気吸収変調器
- 潜在的な創傷治癒用途のためのエレクトロスピニングされたキトサン-ポリエチレンオキシド/フィブリノーゲンバイオコンポジットの開発
- 高性能スーパーキャパシター用のアニオン性界面活性剤/イオン液体挿入還元グラフェン酸化物
- 薄膜シリコン太陽電池用の両面ピラミッド格子を使用した効果的な光吸収
- 無線通信用の薄膜、高周波アンテナアレイ



