機械的に剥離したβ-Ga2O3薄膜上のMo / AuSchottky接触の実験的および理論的研究
要約
Mo /β-Ga 2 の逆電流放出メカニズムを研究しました O 3 298〜423 Kの温度依存電流-電圧(IV)特性によるショットキーバリアダイオード。電界による逆電流の変化は、ショットキー放射が、フレンケル-ポールではなく、逆バイアス下での主要なキャリア輸送メカニズムであることを示しています。トラップ支援放出モデル。さらに、Mo /β-Ga 2 で平均電界3MV / cmのフロリナート環境で、300Vの絶縁破壊電圧が得られました。 O 3 ショットキーバリアダイオード。電界分布に対する表面状態の影響も、TCADシミュレーションによって分析されました。負の表面電荷密度が増加すると、ピーク電界は単調に減少します。さらに、順方向バイアス下でのショットキー障壁の高さの不均一性についても議論されました。
背景
最近、超ワイドバンドギャップ半導体β-Ga 2 O 3 高い化学的安定性、4.8〜4.9 eVの大きな直接ワイドバンドギャップ、高い理論的破壊電界( E )などの優れた特性により、多くの関心を集めています。 BR )は8 MV / cmで、バリガの性能指数は3400と高く、これはSiCの約10倍、GaNの4倍です[1,2,3]。これらすべての特性と、高品質、大面積、費用効果の高いβ-Ga 2 の組み合わせ O 3 溶融成長技術によって成長した基板は、β-Ga 2 を作ります O 3 高電圧および高電力の電子機器アプリケーションに適した材料[4、5、6、7、8、9]。有望な電子デバイスとして、β-Ga 2 O 3 ショットキーバリアダイオード(SBD)は、Cu [8]、Pd [10]、Pt [5、6、11、12、13]、Au [10、14]、Ni [13、15]などのさまざまなアノード電極金属を使用して製造されました。 、16、17、18]、およびTiN [12]、および特定のオン抵抗 I などのその順方向および逆方向の電気的特性 on / 私 オフ 比率、バリア高さ、逆リーク電流、および絶縁破壊電圧を包括的に調査しました。不均一なショットキー障壁の高さと不飽和の逆バイアス電流がβ-Ga 2 で報告されました。 O 3 SBD [6、8、11、18、19]は、逆バイアス下でのキャリア輸送メカニズムについてはほとんど知られていないが、これは絶縁破壊電圧の向上に不可欠である。
さらに、Mo /β-Ga 2 の放出メカニズムを分析するために行われた調査はありません。 O 3 コンタクト。 β-Ga 2 にトラップや欠陥がある場合 O 3 基板では、リーク電流はフレンケル-ポール放出モデルと一致していることがわかります。逆電流は、金属-半導体界面近くのトラップ状態からの電子の放出です。そうでなければ、逆電流の主なプロセスは、ショットキー障壁を越える電子が逆電流をもたらすショットキー放出によって支配されます。 β-Ga 2 O 3 結晶には、[100]方向に沿って12.23Åの大きな格子定数という1つの固有の特性もあります。これにより、薄いベルトまたはナノメンブレンへの容易な劈開が可能になります[9、20]。そこで、この研究では、大規模なβ-Ga 2 を機械的に剥離しました。 O 3 低転位密度のバルク基板から、そして初めて、熱的に安定なモリブデン(Mo)が、β-Ga 2 を製造するためのアノード電極金属として選択されました。 O 3 垂直ショットキーバリアダイオード。逆バイアス下の電気伝導メカニズムは、298〜423 Kの温度範囲で議論されました。この作業は、β-Ga 2 の機能を改善するのに役立つキャリア輸送メカニズムへの洞察を提供します。 O 3 ベースのデバイス。
メソッド/実験
図1a、bに示すように、ショットキーバリアダイオードはβ-Ga 2 上に製造されました。 O 3 (100)Snをドープしたβ-Ga 2 から機械的に剥離した膜 O 3 基板、厚さ15 µm、電子濃度2×10 17 cm − 3 。図1d、eに示すように、半値全幅(FWHM)と二乗平均平方根(RMS)は、高分解能X線回折(HRXRD)と原子間力により、それぞれ51.9秒角と0.19nmと推定されました。力顕微鏡(AFM)測定。測定により、優れた結晶品質と滑らかな表面が確認されました。湿式化学洗浄後、Ti / Au(20 nm / 100 nm)金属スタックは、裏面にEビーム蒸着を使用して堆積され、続いて窒素雰囲気下で600°Cで60秒間の急速熱アニーリング(RTA)が行われました。オーミック接触を形成します。直径100μmの円形ショットキーアノード電極は、Mo / Au(40 nm / 100 nm)金属の蒸着とリフトオフプロセスによって前面に形成されました。図1cは、β-Ga 2 の概略断面の構造を示しています。 O 3 この作品のSBD。
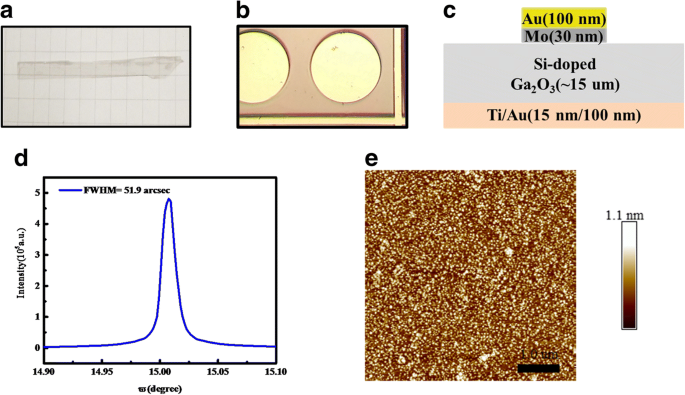
a Snをドープしたβ-Ga 2 O 3 厚さ300μmの基板。 b 前面に直径100μmのショットキーアノード電極を形成。 c β-Ga 2 の断面全体の回路図の構造 O 3 SBD。 d XRDロッキングカーブと e β-Ga 2 のAFM画像 O 3 (100)β-Ga 2 から機械的に剥離したドリフト層 O 3 基板
結果と考察
Au / Mo /β-Ga 2 の電流-電圧(I-V)特性 O 3 ショットキーバリアダイオードは、298〜423KのKeithley4200半導体特性評価システムを使用して調査されました。図2aに示すように、 I on / 私 オフ 比率は10 10 に近い 298 Kで、良好な整流動作を示します。 0.1〜0.7 Vの順方向バイアスの場合、半対数I-V曲線はほぼ直線的であり、強い温度依存性の動作を示します。順方向バイアスがさらに増加すると、IV曲線の直線性からの偏差はショットキーバリアダイオードの直列抵抗に起因し、印加電圧と電流の関係は\(I ={I} _s \ left \ {\ exp \ left [\ frac {q \ left(V- {IR} _s \ right)} {nkT} \ right] -1 \ right \} \)[21,22,23]、ここで V は印加電圧 R s 直列抵抗、 T 絶対温度、 k ボルツマン定数、 n 理想的な要素、および I s は逆飽和電流です。 n および私 s ln の傾きと切片から決定できます それぞれI-Vプロット。理想的なショットキーバリアダイオードの場合、理想係数 n 団結に等しいはずです。 n が高いほど 、熱放射(TE)モデルからの偏差が大きくなります。さらに、方程式\({\ phi} _b =\ frac {kT} {q} \ ln \ left [\ frac {AA ^ {\ ast} {T} ^ 2} {I_s} \ right] \ )[21,22,23]、 ϕ の値 b 図2bに示すように、さまざまな温度での測定も行われました。ここで、 ϕ b はバリアの高さ、 A はダイオード面積であり、 A * は有効なリチャード定数40.8A cm −2 K − 2 β-Ga 2 O 3 m の有効質量 * = 0.34 m 0 [5、24]。気温が298Kから423Kに上昇すると、 ϕ b n の間に増加します 減少し、電流輸送に寄与し、β-Ga 2 で以前に報告された純粋なTEモデルからのI-V特性の偏差につながる別の輸送メカニズムを示します O 3 ショットキーバリアダイオード[25]およびその他のワイドバンドギャップデバイス[26、27、28、29、30]。バリア高さの不均一性分析は、バリア高さのガウス分布で表すことができます。
$$ {\ phi} _b =\ overline {\ phi_ {b0}} \ left(T =0 \ right)-\ frac {q {\ sigma} _s ^ 2} {2 kT} $$(1)<図>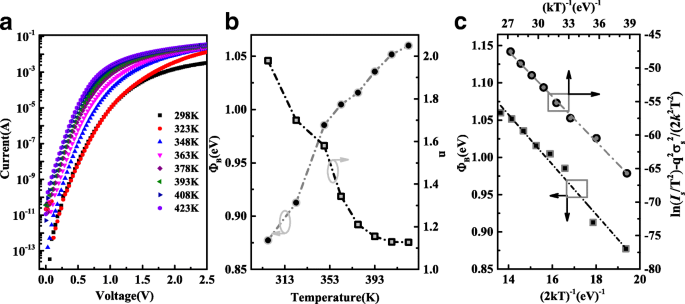
a Mo /β-Ga 2 の順方向I-V特性 O 3 さまざまな温度でのショットキーバリアダイオード。 b β-Ga 2 の理想係数とショットキー障壁高さの温度依存性 O 3 ショットキーバリアダイオード。 c ϕ のプロット ap 対q / 2 k Tおよび修正されたリチャードソンプロット対1 / k β-Ga 2 のT O 3 ショットキーバリアダイオード
平均バリア高さ\(\ overline {\ phi_ {b0}} \)と標準偏差σの値 s 図2cから、それぞれ1.55eVと0.186eVに抽出されます。さらに、バリアの高さの不均一性を考慮して、従来のリチャードソンプロットは次のように変更されます。
$$ \ ln \ left(\ frac {I _ {\ mathrm {s}}} {T ^ 2} \ right)-\ left(\ frac {q ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2} {2 {k} ^ 2 {T} ^ 2} \ right)=\ ln \ left({AA} ^ {\ ast} \ right)-\ frac {q \ overline {\ phi_ {b0}}} {kT} $$(2)図2cに示すように、変更された\(\ ln \ left({I} _ {\ mathrm {s}} / {T} ^ 2 \ right)-\ left({q} ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2/2 {k} ^ 2 {T} ^ 2 \ right)\)対1 / kT 直線です。曲線の切片は、 A を取得するために使用されます * 44.7 A cm −2 K −2 、これはβ-Ga 2 の理論値に非常に近い O 3 40.8 A cm −2 k −2 。したがって、β-Ga 2 の金属/半導体界面でのバリアの不均一性 O 3 SBDは、SBH上のバリアのガウス分布を使用したTEによって説明できます。
室温の逆ブレークダウン測定も、図3に示すように、Agilent B1505A高電圧半導体アナライザシステムを使用して実行しました。ブレークダウン電圧は260Vでしたが、サンプルを3M社製のFluorinert™に沈めた場合は300Vでした。これにより、高い逆バイアス下での空気の破壊を防ぐことができます。電界の分布を理解するために、図4a、bに示すように、ATLASソフトウェアを使用して数値シミュレーションを実行しました。半導体とアノードの界面から約1μmまでの距離が長くなると、電界は徐々に減少します。 x の位置 =4μm、平均電界は3 MV / cmで、図4cから計算されます。 y の位置での図4dにも示されています =1 nm、絶縁破壊電圧での最大電界は、ショットキー接点の端で約8 MV / cmであり、平均電界の約2.7倍です。 AJ Green et al [31]とK.Zeng et al [32]によって報告されたように、電極エッジのピーク電界と平均電界は、それぞれ5.3、3.8 MV / cmと6.1、4.4 MV / cmでした。およびMo / Ga 2 のピーク電場 O 3 ショットキーダイオードは比較的高いです。 β-Ga 2 O 3 機械的剥離によって得られたナノメンブレンには、多数のダングリングボンドと表面状態があり、電子を捕獲して、逆バイアス下でアノードからカソードへのキャリアを枯渇させます[33]。負の表面電荷を考慮に入れると、シミュレーション結果は、Schottky接点のエッジでの電界が、負の表面電荷密度が0.5×10 13 から増加するにつれて減少することを示しました。 cm −2 〜3×10 13 cm −2 、 それぞれ。特に負の表面電荷密度が3×10 13 の場合 cm −2 、Schottky接点の端のピーク電界は約5.2 MV / cmです。したがって、β-Ga 2 で逆ブレークダウン電圧300Vを達成できます。 O 3 N のナノメンブレン D =3×10 17 cm −2 エッジ終端構造なし。図4dに示すように、 X にインターフェース状態が存在するため -2 µm未満の位置では、電子がトラップされ、空乏領域が形成され、 Y に電界が発生します。 方向。界面状態の濃度が高くなると、 Y の電界が増加します。 X の電界は増加しますが、方向は増加します。 方向がゼロに近づきます。したがって、電界は X で増加します -2μm未満の位置。
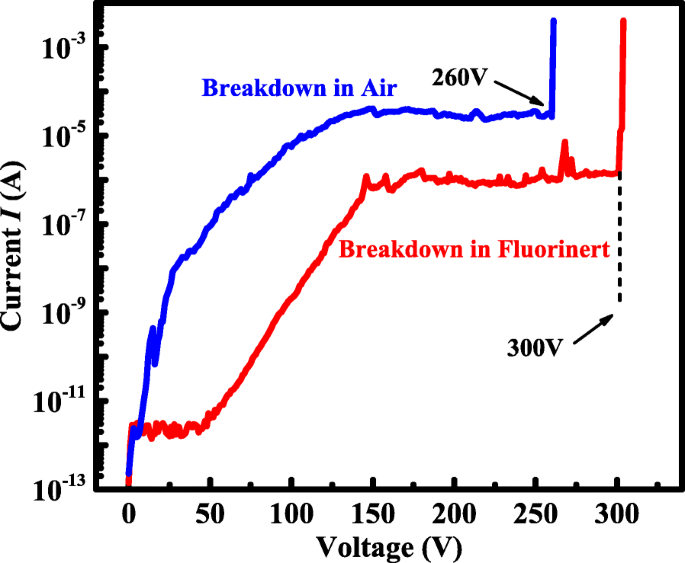
β-Ga 2 の逆I-V特性 O 3 フロリナートと空気でそれぞれ室温でサンプル

a − 300Vバイアス下でのショットキーバリアダイオードのオフ状態TCAD電界シミュレーション。 b 緑の破線のボックス内の選択された領域の電界シミュレーション。 y に沿った可能性 x の軸 =4μmは( c に存在します )、および異なる有効な負の表面電荷密度で減少したショットキー接点のエッジの電界は、( d )に存在します。 )
一方、逆バイアスの場合 V re 増加すると、漏れ電流 I re | V は飽和するのではなく、増加します |> 3k B T / q 、図5aに示すように、これはTE理論と矛盾しています。したがって、電場増強熱電子放出は、 I の依存性を議論するために考慮されました。 re V re 、 プール-フレンケル放出とショットキー放出を含む[34、35]。プール-フレンケル放出では、電子はトラップ状態と I を介して金属から半導体に輸送されます。 re によって与えられます
$$ {I} _ {re} \ propto E \ exp \ left(\ frac {q} {kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right)$$(3 )。ショットキー発光では、電子は金属/半導体の障壁を乗り越えて電流と I を形成するのに十分なエネルギーを獲得します。 re
で表現できます $$ {I} _ {re} \ propto {T} ^ 2 \ exp \ left(\ frac {q} {2 kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right )$$(4)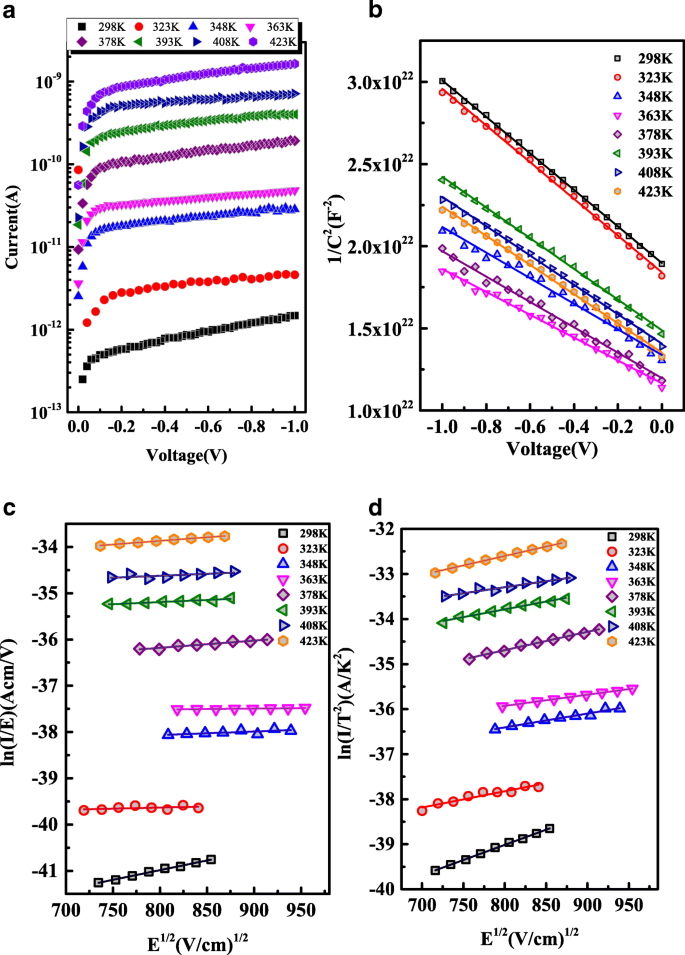
a Mo /β-Ga 2 の逆I-V特性 O 3 異なる温度でのショットキーバリアダイオード。 b 1 / C 2 の温度依存性 Mo /β-Ga 2 の特性 O 3 ショットキーバリアダイオード。 Mo /β-Ga 2 の電場依存性解析 O 3 異なるメカニズムとのショットキー接触。 c プール-フレンケルメカニズム( I / E )対 E 1/2 および d ショットキーメカニズム ln (私 / T 2 )対 E 1/2
ここで、ε s はβ-Ga 2 の誘電率です O 3 (〜10ε 0 )および E は印加電界であり、\(E \ kern0.5em =\ kern0.5em \ sqrt {\ frac {2 {qN} _D} {\ varepsilon_S} \ left(V + {V} _ {bi}-\ frac {k_BT} {q} \ right)} \)、 N D はβ-Ga 2 のドナー密度です O 3 、および V bi 組み込みの可能性です。図5bに示すように、 N D および V bi 逆二乗静電容量(1 / C )の傾きと切片から抽出できます 2 )対 V re 次の式を使用してプロットします
$$ \ frac {1} {C ^ 2} =\ frac {2 \ left({V} _ {\ mathrm {bi}}-kT / qV \ right)} {q {\ varepsilon} _s {A} ^ 2 {N} _D} $$(5)ln の曲線の場合 ( I / T 2 )対 E 1/2 は線形であり、ショットキー放出メカニズムが支配的です。そして、 ln のプロットが (私 / E )対 E 1/2 ライナーである場合、プール-フレンケル放出が逆電流輸送を支配します。図5c、dは、 ln のプロットを示しています。 (私 / E )および ln (私 / T 2 )対 E 1/2 、 それぞれ。曲線の両方のセットは線形であり、プール-フレンケル放射だけでなくショットキー放射も存在することを示しています。支配的なキャリア輸送メカニズムを明確にするために、曲線の傾き、または放出係数は[34,35,36]として表すことができます。
$$ S =\ frac {q} {nkT} \ sqrt {\ frac {q} {\ pi \ varepsilon}} $$(6)ここで n =1はプール-フレンケル排出量( S ) PF )および n ショットキー放出の場合は=2( S S )。 S の実験値 S として示されます m-PF および S m-S それぞれ図5c、dの曲線の傾きによって与えられるプール-フレンケルおよびショットキー放出の場合。実験値と理論値の比率 N PF (= S m-PF / S PF )および N S (= S m-S / S S )、を図6に示します。 N の値が S N よりも1に近い PF 、逆電流はショットキー放射によって支配されます。

プール-フレンケル放出の相対係数プロット N PF (= S m-PF / S PF )およびショットキーエミッション N S (= S m-S / S S )対温度
結論
(100)β-Ga 2 上に作製されたMo / Auショットキーバリアダイオードの電気的特性を調査しました。 O 3 Snをドープしたβ-Ga 2 から機械的に剥離した膜 O 3 基板。 TEモデルに基づいて、抽出された ϕ b および n 温度の上昇とともにそれぞれ増加および減少します。不均一なバリア高さのガウス分布を仮定することにより、平均バリア高さ1.55eVと標準偏差0.186eVが得られました。 最後に、 ln によると (私 / T 2 )および ln (私 / E )対 E 1/2 プロット、パラメータ N S ショットキー放出の割合は1に近く、ショットキー放出が逆電流の主要な輸送メカニズムであることを示しています。フロリナートのサンプルでの300Vの絶縁破壊電圧は、平均電界が3 MV / cmのMo / Auショットキーバリアダイオードで得られ、β-Ga 2 の大きな可能性を示しています。 O 3 パワーエレクトロニクスアプリケーション用。
略語
- I-V:
-
電流-電圧
- Mo:
-
モリブデン
- RTA:
-
ラピッドサーマルアニーリング
- SBD:
-
ショットキーバリアダイオード
- TE:
-
熱電子放出
ナノマテリアル
- 異なる回転角のエンクロージャー内のTiO2-水ナノ流体の安定性と自然対流に関する実験的研究
- MnХFe3−XО4スピネルの構造的および磁気的特性に及ぼす接触非平衡プラズマの影響
- らせん状溝管内のTiO2-水ナノ流体の流れと熱伝達特性に関する実験的研究
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 腫瘍の光検出および治療のための5-アミノレブリン酸-スクアレンナノアセンブリ:invitro研究
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- ITO / PtRh:PtRh薄膜熱電対の調製と熱電特性
- 二層/三層ブロードバンドSiO2反射防止膜の断面形態に関するTEMおよびSTEM研究
- InGaAs / InAlAsSAGCMアバランシェフォトダイオードに関する理論的研究
- 低エネルギー照射に対するSi、Ge、およびSi / Ge超格子の放射応答の理論的シミュレーション
- 機械的に剥離したグラファイト上でのGaNエピタキシャル層の成長メカニズムの理解



