構造内の現在の整流:ReSe2の両側のReSe2 / Au接点
要約
二次元材料のショットキー効果は、ナノスケールの電気機器にとって重要です。 ReSe 2 フレークは、AuシンクとAuナノフィルムの間に浮遊するように移動します。このデバイスは当初、ReSe 2 の輸送特性を測定するように設計されています。 フレーク。ただし、273〜340 Kの実験では、整流挙動が観察されます。整流係数は約10です。微細構造と元素組成を体系的に分析します。 ReSe 2 フレークとAu膜は、45°の傾斜ビューでの走査型電子顕微鏡画像からSi基板と接触していることがわかります。 ReSe 2 / SiおよびSi / Au接点は、p-nヘテロ接合およびショットキー接点です。両方の接点が非対称であると、整流動作が発生します。熱電子放出理論に基づく予測は、実験データとよく一致しています。
はじめに
電流が印加電圧の方向によって変化する金属-半導体接点の整流挙動は、ショットキーバリアダイオード、電界効果トランジスタ(FET)、および金属-酸化物-半導体FETで広く使用されています。ショットキーは、そのような界面の半導体側の空乏層による挙動を説明しました[1]。金属と半導体の電子仕事関数の違いは、ショットキー効果と呼ばれる整流挙動につながります[2]。金属と二次元(2D)半導体材料との接触は、金属がn型2D半導体材料よりも高い電子仕事関数、またはp型2D半導体よりも低い電子仕事関数を持っている場合のショットキー接触です。金属/ 2D材料のショットキー効果は、マイクロフォトディテクタ、マイクロFET、ガスセンサー、およびフォトトランジスタに優れた用途があります[3]。 2D材料の中で、遷移金属ジカルコゲナイド(TMD)は、かなりのバンドギャップを持ち[3]、厚さが単分子層に減少するにつれてバンドギャップが間接から直接に遷移するため、大きな注目を集めています[4]。バンドギャップにより、TMDを多くのアプリケーション(FETや太陽電池など)に使用できるようになります[3]。 TMDは熱電分野でも使用でき[5]、広く注目されています[6,7,8,9]。 MoS 2 などのTMDのプロパティとアプリケーションを調査するために、多くの実験が行われました。 、MoSe 2 、WSe 2 、およびWS 2 。 Lopez-Sanchez etal。 [10] MoS 2 で超高感度単層フォトトランジスタを作成 。 Britnell etal。 [11] WS 2 を作成しました /グラフェンヘテロ構造と光起電力デバイスでのそのアプリケーションを示した。 WSe 2 、両極半導体として、発光ダイオードを製造するために二重静電ゲートで制御されました[12、13]。 TMDの中で、ReSe 2 ReSe 2 であるため、他のグループVITMDとは異なります。 d に余分な電子を持つグループVIITMDに属します 強い面内異方性につながる軌道[14]。いくつかの研究では、ReSe 2 の電気的特性が調査されています。 その特別なバンド構造のため。現在の整流は、ReSe 2 で調査されます / WS 2 p-nヘテロ接合[15]およびReSe 2 / MoS 2 p-nヘテロ接合[16]。 FETは、ReSe 2 のような金属/半導体接点の電気的特性を調査するために作られています。 / metalまたはReS 2 / metal [17,18,19]。
この手紙では、ReSe 2 フレークは、AuシンクとAuナノリボン電極の間に吊るされています。このデバイスは元々、ReSe 2 の熱伝導率と電気伝導率を測定するように設計されています。 フレーク。測定は、340 K、310 K、280 K、および273Kで実行されました。
メソッド
まず、Au電極を備えたSi基板を作製しました。厚さ400μmのドープされていないSi基板が酸化され、厚さ180nmのSiO 2 が形成されました。 最初の洗浄後の層、および320nmの厚さの電子ビームレジストがSiO 2 上に堆積された スピンコーティングによる表面。 Auは、物理蒸着によって堆積され、電子ビームリソグラフィーによって調製されたパターンで、Auナノ電極およびAuナノフィルムを製造した。サンプルをフォトレジスト現像液に入れることにより、電子ビームレジストがエッチングされ、Au電極とフィルムが残された。最後に、SiO 2 層は緩衝フッ化水素酸によってエッチングされ、Auナノフィルムの下のSi層はCF 4 によってエッチングされます。 プラズマを使用して、Si基板から約6μm上にある浮遊ナノフィルムを製造します。
ReSe 2 フレークは、銅基板上で化学蒸着によって合成されました。 ReSe 2 フレークをAu電極に移して、Au-ReSe 2 を製造しました。 -Auは、ReSe 2 である濡れ移動法を使用して接触します。 銅基板を備えたナノリボンをポリメチルメタクリレート(PMMA)でコーティングし、エッチング液に浮かせて銅基板をエッチングしました。銅基板を剥がした後、PPMAコーティングされたReSe 2 フレークは、固定小数点転送プラットフォームによって、Auナノ電極を備えたSi基板上に正確に移動しました。次に、PMMAをレーザーで切断し、PMMAでコーティングされたReSe 2 フレークは、AuナノフィルムとAuナノ電極の間に浮遊するように着地しました。最後に、サンプルを水酸化カリウム溶液浴に3時間浸すことにより、PMMAを除去しました。作製したAu電極の走査型電子顕微鏡(SEM)画像-ReSe 2 フレーク-Auナノリボン(Au-ReSe 2 -Au)基板に対する垂直方向の接合部を図1aに示します。 ReSe 2 フレークはセクションBでAuナノリボンと接触し、セクションCでAu電極と接触していました。図1bに、デバイスの概略図を示します。
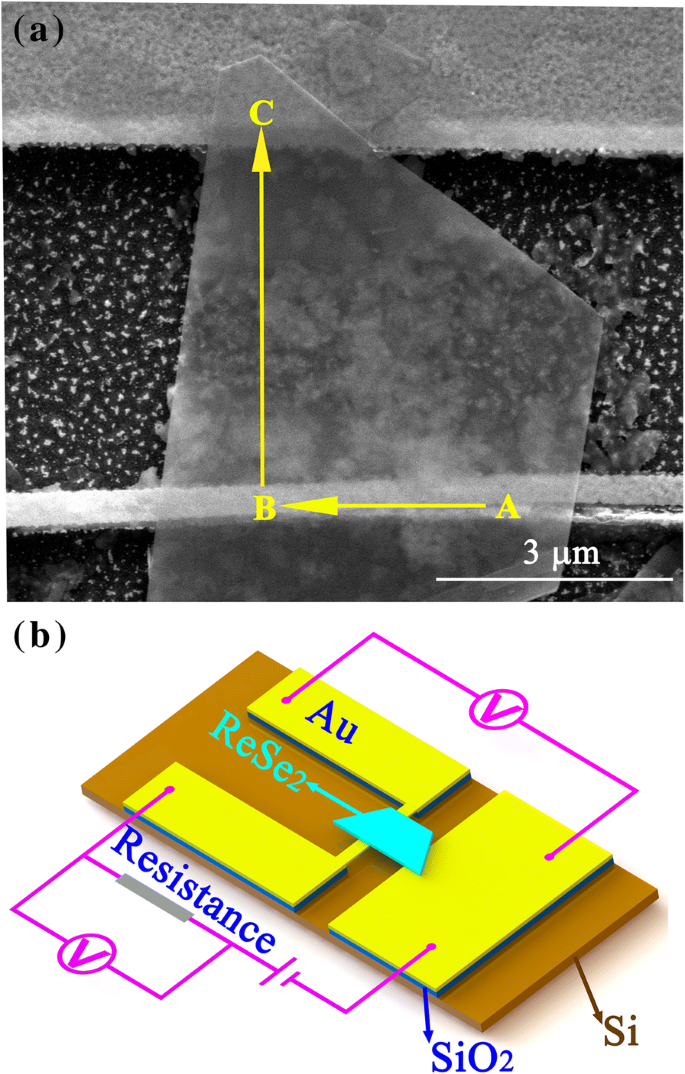
a 基板と正の電流方向および b を垂直に見たデバイスのSEM画像 測定器の概略図
A-B-Cに沿った方向は正、またはその逆として定義され、直流が適用されました。電圧、 V 、Au-ReSe 2 全体 -Auジャンクションは、高精度デジタルマルチメータ(Keitheley 2002、8.5桁)で測定されましたが、現在の I は、直列の基準抵抗の両端の電圧を測定することによって決定されました。 私 - V ReSe 2 の曲線 順方向電圧と逆方向電圧の/ Au接合は、物性測定システム(量子設計)でさまざまな温度で測定されました。
結果と考察
図2は、測定された I を示しています。 - V 273 K、280 K、310 K、および340Kでの曲線。 I の重要な非対称性 - V 測定されたすべての温度で曲線が観察され、異常な整流挙動を示しています。 277 mVおよび− 277 mVの電流を使用して、各温度での電流整流比を計算します。整流比は約10です。電流は、特定の電圧の温度とともに増加します。
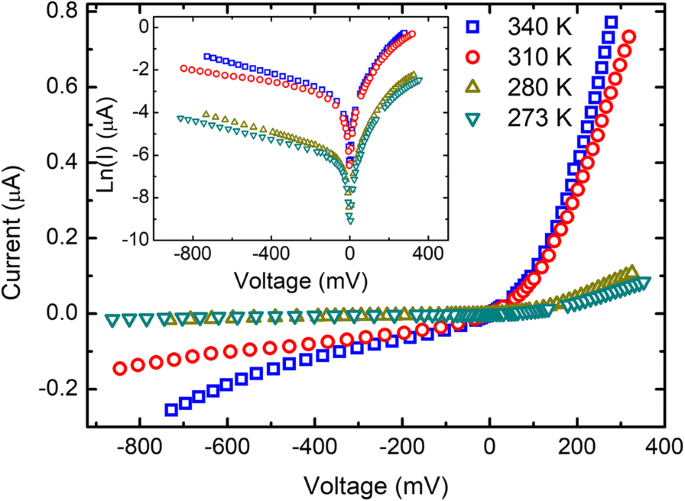
273 K、280 K、310 K、および340KでのAu-ReSe2-Au接合の電流-電圧特性
異常な整流の原因となるメカニズムを調べるために、ReSe 2 の微細構造 フレークは、原子間力顕微鏡[(AFM)、Cypher、Oxford Instruments]およびラマン分光計(Jovin Yvon T64000、励起波長532 nm)によって検出されました。 ReSe 2 のAFM画像 フレークを図3a〜cに示します。白い線に沿った断面の高さプロファイルに基づいて、決定された平均厚さは28nmです。信号強度の高い最大13本の予想される線で構成されるラマンスペクトルを図3dに示します。これは、Wolverson etalによって検出されたスペクトルとよく一致しています。 [4]そして現在のReSe 2 の三斜晶系結晶構造を明らかにする フレーク。

a 、 b 、および c ReSe2のAFM画像と厚さ、および d ReSe2のラマンスペクトルと結晶構造
図4は、ReSe 2 のSEM画像です。 45°の傾斜ビューのフレークは、ReSe 2 フレークとAuナノフィルムはSi基板と接触しています。 ReSe 2 -Au接触は、以前の研究[20]でオーミック接触が示されていますが、これはこの実験での整流動作の原因ではありません。回路はAu-ReSe 2 で構成されています -AuとAu-ReSe 2 -Si-Auジャンクション。図5に回路の概略図を示します。 Si-AuコンタクトはSchottkyコンタクト[21]に示されています。
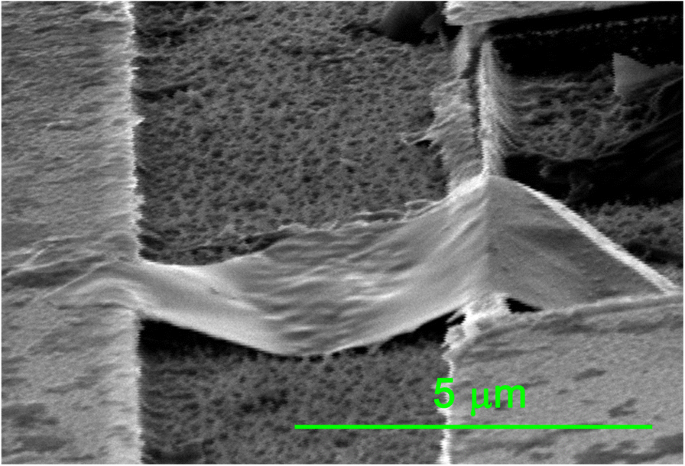
ReSe 2 のSEM画像 45°の傾斜ビューでのフレークとAuナノフィルム
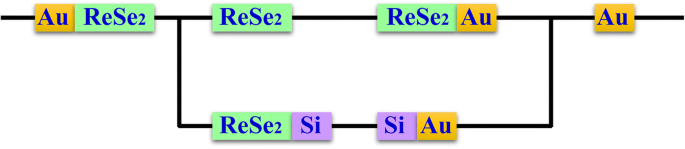
回路の概略図
図6は、エネルギー分散型分光法(EDS)のデータを示しています。 ReSe 2 のマップ合計スペクトル はセクション1と2で取得されます。平均的な化学式はReSe 1.67 です。 ReSe 2 よりもReの比率が高い そして、ReSe 2 を与えます フレークp型半導体の特性。したがって、ReSe 2 -Si接触はp-nヘテロ接合であり、整流動作を示します。両方の整流接点が非対称であると、整流動作が発生します。
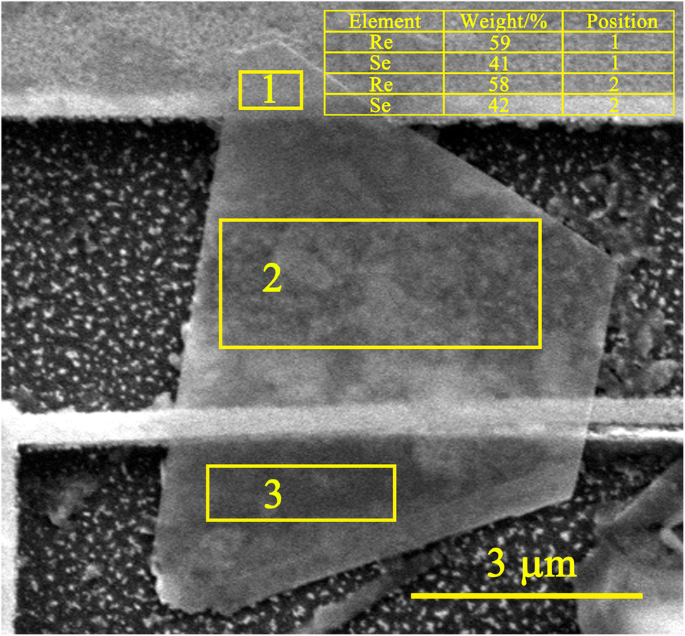
ReSe 2 のEDSデータ 画像の右上隅にあります。ボックス1と2は、2つの測定されたセクションを表します
電流は、ショットキー接点とp-nヘテロ接合の両方で次の式によって決定できます[22、23]:
$$ I ={I} _0 {e} ^ {qV / nkT} \ left(1- {e} ^ {-qV / kT} \ right)$$(1)$$ {I} _0 ={AA} ^ {\ ast} {T} ^ 2 {e} ^ {-q {\ Phi} _B / kT} $$(2)ここで私 0 は飽和電流、 q は電荷、 k はボルツマン定数、 V 接合部に印加される電圧 A 接触領域、 A * は有効なリチャードソン定数です、Ф B は見かけのバリアの高さであり、 T は測定温度です。温度依存の理想係数 n 連絡先が理想的なショットキー連絡先から逸脱するレベルを表します。
式に基づく計算。 (1)は、整流動作の分析を調べるために作成されます。 ReSe 2 の電流 -Si連絡先、 I 1 、およびSi-Au接触、 I 2 、は次のように表されます:
$$ {I} _1 ={I} _ {01} {e} ^ {qV / {n} _1 kT} \ left(1- {e} ^ {-qV / kT} \ right)、$$(3 )$$ {I} _2 ={I} _ {02} {e} ^ {-qV / {n} _2 kT} \ left({e} ^ {qV / kT} -1 \ right)。 $$(4)図7は、数値結果が実験データとよく一致していることを示しています。数値パラメータを表1に示します。ReSe 2 の逆飽和電流 -ReSe 2 の接触面積が大きいため、Si接触はSi-Au接触よりも大きくなります。 -Si接点は、図4に示すようにはるかに大きくなります。両方の接点の逆飽和電流は温度とともに増加し、両方の接点の導電率が式(1)に示すように整流動作を示すことを示しています。 (2)。

I の比較 - V 実験結果と計算された曲線
ReSe 2 の理想的な要素 -接触条件や結晶構造が異なるため、Si接触はSi-Au接触よりも大きくなります。図4は、エッチング液が原因でSi基板の表面が粗くなり、ReSe 2 になることを示しています。 -Si接触が不均一。不均一な接触は大きな理想係数につながります[24、25]。粗い表面はまた、大きな理想係数をもたらす多数のトラップ状態を生成します[26]。さらに、連絡先の種類が異なれば、理想的な要素も異なります。 ReSe 2 -Si接触はp-nヘテロ接合であり、ReSe 2 とSiの結晶構造は異なり、ReSe 2 の三斜晶系です。 Siの面心立方。格子不整合は常にエッジ転位を引き起こし[27]、高密度のトラップ状態を生成し[26]、ReSe 2 -Si接点は理想的な接点から外れており、理想係数が大きくなっています[27]。 Si-Auは金属半導体接点であり、Siの結晶構造は理想係数にほとんど影響を与えません。両方の接点の理想係数は、温度によってほとんど変化しません。それは式で説明することができます。 (5)Khurelbaatarらによって報告された。 [28]、
$$ n =\ frac {q} {kT} \ frac {dV} {d \ lnI}。 $$(5)式(5)は、理想係数が温度に反比例することを示しています。理想係数は、低温でのみ温度とともに大幅に低下し、温度が300 Kを超えるとゆっくりと変化します[28、29]。ただし、表1に示すように、逆飽和電流は、理想係数とは異なる温度で大幅に増加します。それは式で説明することができます。 (2)。式によると。 (2)、 T であるため、逆飽和電流は温度とともに増加します。 2 およびexp(− q Φ B / kT )温度とともに増加します。 exp(− q Φ B / kT )および−qΦ B / kT、exp(− q Φ B / kT )温度とともに大幅に増加します。 Zhu et al [30]による調査に基づいて、 q Φ B 273Kと295Kでの実験におけるAu / Si接触の割合は、それぞれ0.77eVと0.79eVです。計算結果は、295Kでの逆飽和電流が273Kでの逆飽和電流の6倍であることを示しており、逆飽和電流が温度とともに大幅に増加する理由を説明しています。
結論
結論として、整流挙動は、ReSe 2 が存在する接点で観察されます。 異なる温度でAu基板とAuナノフィルムを横切って浮遊するフレーク。吊り下げられたReSe 2 のSEM画像 45°の傾斜ビューのフレークは、ReSe 2 フレークとAuナノフィルムはSi基板と接触しており、EDSマップは元素組成ReSe 1.67 を示しています。 。 ReSe 2 間の接触 フレークとSi基板が整流挙動の原因です。 ReSe 2 -SiおよびSi-Au接点は両方とも別の回路を形成する整流接点であり、両方の接点の非対称性により、見かけの整流動作が発生します。ショットキー電流方程式に基づく計算結果は、Si-Auショットキー接触とReSe 2 を考慮したものです。 -Sip-nヘテロ接合は実験結果とよく一致しています。
略語
- 2D:
-
二次元
- AFM:
-
原子間力顕微鏡
- EDS:
-
エネルギー分散型分光法
- FET:
-
電界効果トランジスタ
- PMMA:
-
ポリメチルメタクリレート
- SEM:
-
走査型電子顕微鏡
- TMD:
-
遷移金属ジカルコゲナイド
ナノマテリアル



