MoS2 / HfO2界面でのバンドアラインメントにおける窒化の調査
要約
数層MoS 2 間のバンドアラインメントに対する窒化処理の効果 およびHfO 2 X線光電子分光法によって調査されました。 MoS 2 の価電子帯(伝導帯)オフセット / HfO 2 窒化処理ありとなしで、それぞれ2.09±0.1(2.41±0.1)と2.34±0.1(2.16±0.1)eVであると決定されました。調整可能なバンドアライメントは、HfO 2 のMo-N結合の形成と表面バンドの曲がりに起因する可能性があります。 窒化によって引き起こされます。 MoS 2 のエネルギーバンド工学に関するこの研究 / HfO 2 ヘテロ接合を他のhigh-k誘電体に拡張して、2次元材料と統合し、電子デバイスを設計および最適化することもできます。
背景
現在、層状遷移金属ジカルコゲナイド(TMDC)は、現代のエレクトロニクスおよびオプトエレクトロニクスでの潜在的な用途に対する魅力的な特性により、大きな関心を呼んでいます[1、2]。特に、二硫化モリブデン(MoS 2 )は、7 nmテクノロジーノードを超えてスケーリングを継続するための有望なチャネル材料としてかなりの注目を集めています[3、4]。構造的には、MoS 2 結晶は、1つの六角形に配置されたMo平面で構成され、2つの六角形に配置されたS平面に挟まれています。三角形のプリズム配列は、共有結合したS-Mo-Sユニットを介して形成されました[5、6]。 MoS 2 単層(SL)MoS 2 の直接バンドギャップ(1.8 eV)とは異なる、層に依存するバンドギャップを持っています。 バルクMoS 2 の間接バンドギャップ(1.2 eV) [7]。バンドギャップがゼロのグラフェンとは異なり、バンドギャップの厚さに依存する変調は、MoS 2 の探索の動機となりました。 光学および電気デバイス[3、8]。 MoS 2 の物理学に基づく 、数層のMoS 2 の状態密度 単層MoS 2 の3倍です 、その結果、弾道限界で高い駆動電流が発生します[8]。このコンテキストでは、数層のMoS 2 SL MoS 2 よりもトランジスタアプリケーションに大きな利点をもたらす可能性があります [3]。
一方、従来の二酸化ケイ素誘電体をベースにした電子デバイスは、誘電率が低いため、物理的な限界に近づいています[9]。薄い等価酸化膜の厚さ(EOT)を得るには、high-k誘電体をMoS 2 と統合することが非常に重要です。 。これまで、多くのhigh-k誘電体がMoS 2 で調査されてきました。 、Al 2 を含む O 3 、ZrO 2 、HfO 2 、およびh-BN [10,11,12,13,14]。 DiStefano etal。数層のMoS 2 に対して3.3±0.2および1.4±0.2eVのそれぞれの伝導帯および価電子帯オフセットを取得しました。 アモルファスBNへの酸化物蒸着によって成長します[13]。タオら単分子層MoS 2 の伝導バンドオフセット(CBO)が報告されました / Al 2 O 3 (ZrO 2 )ヘテロ接合は3.56 eV(1.22 eV)であると推定され、価電子帯オフセット(VBO)は3.31 eV(2.76 eV)でした[15]。また、MoS 2 でのCBOは2.09±0.35eV、VBOは2.67±0.11eVです。 / HfO 2 インターフェイスはMcDonnellらによって報告されました。 [12]。これらのゲート誘電体の中で、HfO 2 誘電率が高く(k〜20)、poly-SiGe、TaNゲート、および多結晶シリコンゲートとの互換性があるため、最も有望な候補の1つと見なされていました[16]。ただし、HfO 2 熱安定性が低く、漏れ電流が大きく、酸化物トラップ密度が高く、界面トラップ密度などがあります[17]。これらの制限は、界面の窒化やフッ素化処理技術などの不動態化技術を検索するための広範な調査の動機となっています[18、19]。この研究では、数層のMoS 2 のエネルギーバンドアラインメントを研究しました。 HfO 2 で プラズマニトロ化の有無にかかわらず誘電体。表面ニトロ化の効果はX線光電子分光法(XPS)によって特徴づけられました。
メソッド
SiO 2 (280 nm)/ Siウェーハをアセトンとイソプロパノールで交互に10分ごとに超音波洗浄し、続いて脱イオン水でリンスし、N 2 ドライ。数層のMoS 2 膜はSiO 2 に堆積されました MoO 3 の前駆体を使用した化学蒸着(CVD)による/ Si基板 (0.08 mg、99%、Alfa Aesar)およびSパウダー(1 g、99%)[20、21]。成長手順の後、MoS 2 フィルムはHfO 2 に転送されます 図1aに示すように、ポリ(メチルメタクリレート)(PMMA)法による/ Si基板[22]。このプロセスでは、PMMAは最初にMoS 2 にスピンコーティングされました。 / SiO 2 支持層としての/ Siサンプル。次に、サンプルをKOH溶液に浸して、SiO 2 をエッチング除去しました。 、その後、MoS 2 PMMAを含むレイヤーは、ソリューションの上部に浮きます。最終的に、サンプルをHfO 2 に移した後、PMMA層をアセトンに溶解します。 / Si基板。 HfO 2 膜は、Hf [N(CH 3 )を使用して200°Cの温度で原子層堆積(ALD)によってシリコンウェーハ上に成長しました。 )(C 2 H 5 )] 4 [テトラキス(エチルメチルアミド)ハフニウム、TEMAH]およびH 2 前駆体としてのO蒸気[23、24]。プラズマ処理時間の最適化プロセス中に、SIMS測定による70秒の窒化処理後に窒素が酸化物に大幅に拡散し、酸化物の品質が大幅に低下することがわかりました。プラズマ処理時間は30秒ですが、SIMSの結果から酸化物表面に明らかなNピークは観察されませんでした。コントロールサンプルの場合、50秒N 2 プラズマ処理はHfO 2 で実施されました MoS 2 の前に3Paの圧力で/ Si基板 移行。プラズマ条件下では、結果として得られるN線量は約8.4×10 14 です。 原子/ cm 2 二次イオン質量分析(SIMS)の結果から推定。また、XPSデータに基づいて、窒素化後の窒素濃度は約1.5%と計算されました。 XPS測定用に4つのサンプル1〜4#を準備しました:1#数層MoS 2 SiO 2 上のフィルム / Si基板(数層MoS 2 )、2#厚さのHfO 2 Si基板上のフィルム(バルクHfO 2 )、3#転送されたMoS 2 成長したままのHfO 2 のフィルム / Si基板(成長したままのMoS 2 / HfO 2 ヘテロ接合)、および4#転送されたMoS 2 N 2 の映画 プラズマ処理されたHfO 2 / Si基板(窒化MoS 2 / HfO 2 ヘテロ接合)。
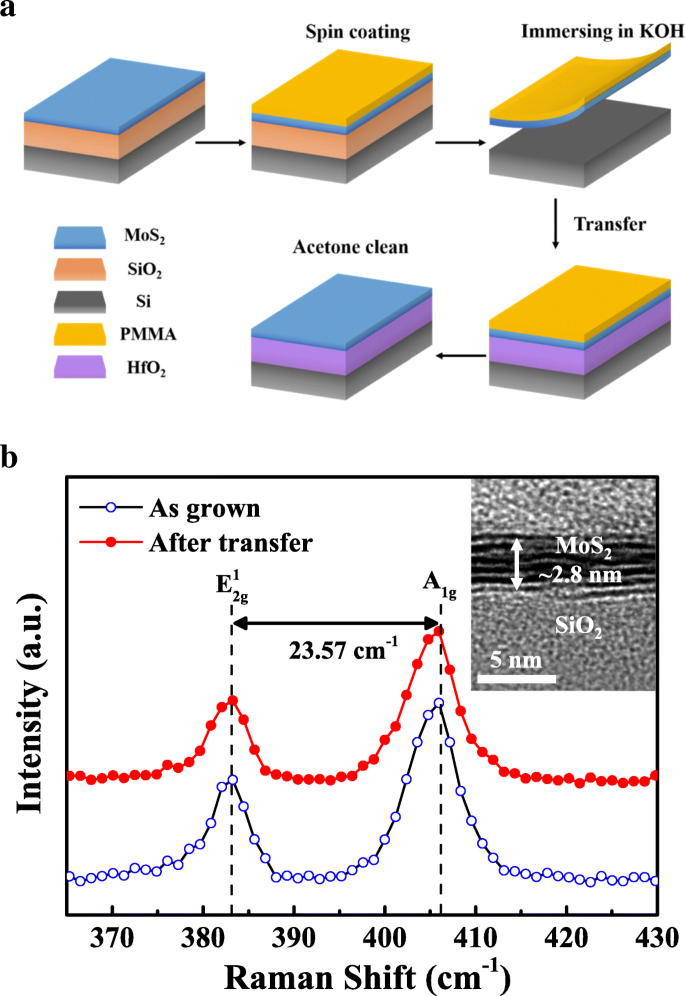
a MoS 2 のPMMA支援ウェットトランスファー法のプロセスフロー / ALD-HfO 2 ヘテロ接合の形成。 b 成長したままのMoS 2 のそれぞれのラマンスペクトル 映画。挿入図は、成長したままのMoS 2 の断面透過型電子顕微鏡画像です。 SiO 2 / Si基板
結果と考察
RENISHAW inViaラマン分光法を使用して、数層のMoS 2 のラマンスペクトルを特性評価しました。 図1bに示すように、転写手順の前後のフィルム。 382.86 cm -1 付近に2つのラマンピークが見られます。 および406.43cm -1 、面内(\({E} _ {2g} ^ 1 \))および面外( A )に対応します 1 g )モード、それぞれ[25、26]。 \({E} _ {2g} ^ 1 \)と A にはラマンシフトがほとんどないことがわかりました。 1 g 転送プロセス後のモード周波数。構造の変更が最小限であることを示します。周波数差( ∆k )\({E} _ {2g} ^ 1 \)と A の間 1 g モードは約23.57cm -1 であると推定されました 、MoS 2 の約4〜5層を指定 映画[27]。図1bの挿入図に示すように、MoS 2 の厚さ フィルムは、高分解能透過型電子顕微鏡(HRTEM)によって約2.8 nmであることが確認されました。これは、上記のラマンスペクトルと一致しています。さらに、転送されたMoS 2 のSIMS深度プロファイルを提示しました。 窒化されたHfO 2 上のフィルム / Si基板。 SIMS測定は、1keVのエネルギーのCs一次イオンビームを備えたPhysicalElectronics ADEPT 1010 SIMS機器で実行され、正イオンが収集され、電荷補償が実行されました。このSIMS測定では、窒素元素が定量化されましたが、他の元素(Mo、Hf、およびSi)は層マーカーとしてのみ意味され、定量化されていません。図2aに示すように、転送されたMoS 2 の深度プロファイル 窒化されたHfO 2 上のフィルム / Si基板は、Mo、N、Hf、およびSiで表される主成分の信号が深さに対してプロットされているSIMSによって決定されました。 NのHfO 2 への拡散 層が観察されました。これは、一次ビーム衝撃またはプラズマ処理中に下にある層へのN注入によって興味をそそられる可能性があります。また、表面汚染と表面効果、たとえば表面近くのN元素の異常な強度のために、表面層近くの深さプロファイルは通常複雑で無意味であることも注目に値します[28]。 HfO 2 付近のNプロファイルのより高い信号 / Si界面は、窒素がHfO 2 に拡散する傾向があるためと考えられます。 / Si界面、界面付近にNが蓄積する[29]。 HfO 2 のMoの尾 フィルムは主にSIMS測定における一次ビーム衝撃によって引き起こされる可能性があります[30]。図2bは、サンプル3#および4#のそれぞれのN 1sXPSスペクトルを示しています。両方のヘテロ接合の高強度ピークはMo3p 3/2 でした 一方、窒化ヘテロ接合では〜395.80 eVの低強度ピークが検出され、Mo-N結合の形成を示しています[31]。
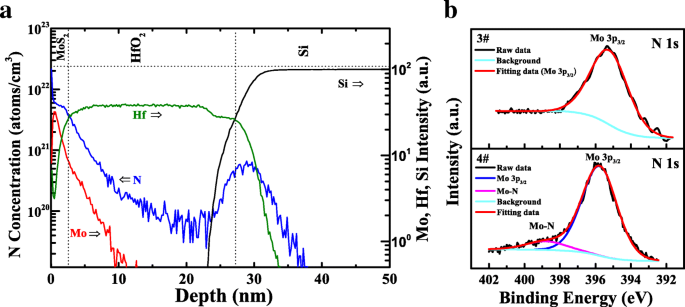
a 転送されたMoS 2 のSIMS深度プロファイル 窒化されたHfO 2 上のフィルム / Si基板。 b MoS 2 のN1sXPSスペクトル / HfO 2 それぞれ、窒化処理の有無によるヘテロ接合
数層のMoS 2 間のバンドアラインメントを取得するには およびHfO 2 窒化処理の有無にかかわらず、0.05 eVのステップでのXPS測定は、単色AlKαX線源(hν=1486.6 eV)を使用してVG ESCALAB220i-XLシステムで実行されました。一定通過エネルギーは20eVに設定されました。さらに、標準のC 1s(284.8 eV)が結合エネルギー(BE)のキャリブレーションに使用されました[32]。 MoS 2 のVBO値を評価するには / HfO 2 サンプル1〜4#には、ヘテロ接合、Mo3dおよびHf4fコアレベル(CL)がそれぞれ選択されました。図3aは、サンプル1#からのMo3dおよび価電子帯スペクトルのXPSナロースキャンを示しています[33]。したがって、Mo 3d 5/2 間の結合エネルギー差(BED) サンプル1#のコアレベルと価電子帯の最大値(VBM)は、228.49±0.1eVと計算されました。図3bは、Hf 4f 7/2 のCLを示しています。 サンプル2#のVBM。対応するBEDは14.10±0.1eVであると決定されました。図3cは、MoS 2 のMo3dおよびHf4fCLの測定されたXPSスペクトルを示しています。 / HfO 2 窒化処理あり/なしのヘテロ接合。 Mo 3d 5/2 CLは、サンプル3#の229.45±0.05 eVからサンプル4#の229.90±0.05eVにシフトしました。これは、MoS 2 に窒化界面層が導入されたためと考えられます。 / HfO 2 プラズマ処理後の界面により、上記のMo-N結合が生じます。 Mo-N結合が存在する場合、Mo要素とN要素の間の結果として生じる電荷移動は、測定されたMo 3d 5/2 に寄与しました。 CLシフト。さらに、Hf 4f 7/2 図3dに示すように、サンプル3#の17.40±0.05 eVのCLは、サンプル4#の17.60±0.05 eVのより高い結合エネルギーにシフトしましたが、O1sも0.20eVのより高いBEDへのシフトを示しました。これらのピークシフトは、HfO 2 で下向きのバンドベンディングを意味します 表面。これは、窒素プラズマがHfO 2 のドナーのような欠陥を誘発したと解釈できます。 [34]。クラウト法[35]に基づいて、VBO( ∆E V )値は次の式から計算できます:
$$ \ Delta {E} _V =\ left({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S }} _ 2}-{E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \ right)-\ left({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2}-{E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Hf } \ mathrm {O}} _ 2} \ right)-{\ Delta E} _ {\ mathrm {CL}} $$(1)ここで、\({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \)および\( {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \)は、Mo 3d 5/2 の結合エネルギーです。 MoS 2 のCLおよびVBM 、\({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \)および\( {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {HfO}} _ 2} \)は、Hf 4f 7/2 の結合エネルギーです。 ALD-HfO 2 のCLおよびVBM 、 ∆E CL =\({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2}-{E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \)は、Mo 3d 間のBEDを指します。 5/2 およびHf4f 7/2 ALD-HfO 2 のCL / MoS 2 ヘテロ接合。したがって、 ∆E V MoS 2 の ALD-HfO 2 で 窒化処理ありとなしで、それぞれ2.09±0.1と2.34±0.1eVと計算されました。

a Mo 3dCLのXPSスペクトルと数層MoS 2 の価電子帯 。 b Hf 4fCLのXPSスペクトルとバルクHfO 2 の価電子帯 。 c のXPSスペクトル Mo 3d、Hf 4f、および d 転送されたMoS 2 のO1s CL バルクHfO 2 のフィルム 窒化処理あり/なし
N 2 の影響を評価するには 伝導帯域オフセットのプラズマ処理(CBO、 ∆E C )ALD-HfO 2 間 および数層のMoS 2 、HfO 2 の5.9±0.1eVのバンドギャップ MoS 2 の場合は1.4±0.1eV ここではそれぞれ[7、36]が使用されました。したがって、CBOは次の式で求めることができます。
$$ {\ Delta E} _C ={E} _g ^ {{\ mathrm {HfO}} _ 2}-{E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2}-{\ Delta E } _V $$(2)ここで、\({E} _g ^ {{\ mathrm {HfO}} _ 2} \)と\({E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \)はHfOのバンドギャップです。 2 およびMoS 2 、 それぞれ。式によると。 (2)、 ∆E C MoS 2 の間 およびALD-HfO 2 窒化処理ありとなしで、それぞれ2.41±0.1と2.16±0.1eVと計算されました。対応するバンド図を図4に示します。驚くべきことに、これら2つのヘテロ接合のVBO値とCBO値の両方が優れた電子と正孔の閉じ込めを提供し、MoS 2 への適合性を保証します。 ベースのFET [37]。さらに、窒化されたヘテロ接合は、窒化されていないヘテロ接合と比較してCBOが高く、nチャネルFETアプリケーションに適しています。
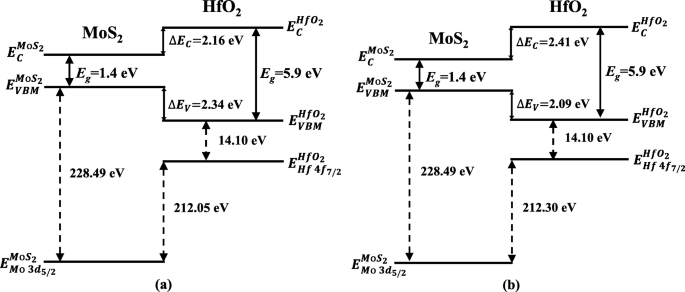
MoS 2 のバンド図 / HfO 2 ヘテロ接合 a 窒化処理なしおよび b 窒化処理あり
結論
結論として、XPS測定により、MoS 2 でのバンドアラインメントが明らかになりました。 / HfO 2 HfO 2 にニトロ化を導入することにより、インターフェースを変更できます。 MoS 2 を積み重ねる前の表面 映画。窒化されていないMoS 2 の場合、CBOおよびVBOは2.16±0.1および2.34±0.1eVであると決定されました。 / HfO 2 ヘテロ接合、一方、窒化されたMoS 2 の場合、CBOは2.41±0.1 eVまで変更され、VBOは2.09±0.1eVまで変更されました。 / HfO 2 それぞれヘテロ接合。界面に窒化界面層が導入され、Mo-N結合が形成されることがわかった。さらに、窒素プラズマはドナーのような欠陥を誘発し、HfO 2 の表面バンドの曲がりを引き起こす可能性があります 。このように、界面バンドアライメントエンジニアリングは、最新の電子機器の柔軟な設計と最適化に向けた有望なルートを提供します。
データと資料の可用性
この原稿の結論を裏付けるデータセットは、原稿に含まれています。
略語
- ALD:
-
原子層堆積
- BE:
-
結合エネルギー
- ベッド:
-
結合エネルギーの違い
- CBO:
-
伝導バンドオフセット
- CL:
-
コアレベル
- CVD:
-
化学蒸着
- FET:
-
電界効果トランジスタ
- HfO2:
-
酸化ハフニウム
- HRTEM:
-
高分解能透過型電子顕微鏡
- MoS 2 :
-
二硫化モリブデン
- PMMA:
-
ポリ(メタクリル酸メチル)
- SIMS:
-
二次イオン質量分析
- SL:
-
単層
- TEMAH:
-
テトラキス(エチルメチルアミド)ハフニウム
- TMDC:
-
遷移金属ジカルコゲナイド
- VBM:
-
価電子帯の最大値
- VBO:
-
ヴァランスバンドオフセット
- XPS:
-
X線光電子分光法
ナノマテリアル



