原子層に堆積したAZO /β-Ga2O3(\(\ overline {2} 01 \))ヘテロ接合のエネルギーバンドの調査
要約
ZnO /β-Ga 2 のバンドオフセットに対するAlドープ効果 O 3 界面はX線光電子分光法によって特徴づけられ、第一原理シミュレーションによって計算されます。伝導帯オフセットは1.39から1.67eVまで変化し、価電子帯オフセットは0.06から-0.42 eVまで減少し、0から10%まで変化するAlドーピング比に対してほぼ線形の依存性を示します。その結果、タイプIのバンド配列がZnO /β-Ga 2 の界面に形成されます。 O 3 ヘテロ接合とAZO /β-Ga 2 O 3 インターフェイスにはタイプIIのバンドアライメントがあります。これは、AlをZnOに組み込むと、AlとOの強い電子混合によりバンドギャップが開き、伝導帯と価電子帯のエッジが結果として低いレベルにシフトするためです。
背景
最近、酸化物半導体Ga 2 O 3 大きなバンドギャップ、高い飽和電子速度、高温耐性などの独自の特性により、幅広い関心を集めています[1]。 Ga 2 には5種類の異性体があります O 3 :α、β、γ、δ、およびε、ここでβ-Ga 2 O 3 より簡単に成長させることができ、広く研究されてきました[2]。特に、β-Ga 2 O 3 SiCやGaNなどの従来の第3世代半導体材料よりも大きな破壊電界を持っています[3]。 n型の導電特性は、Sn [4]またはSi [5]をドープすることで変調できます。したがって、β-Ga 2 O 3 ベースのデバイス[6、7]は、情報技術、省エネ、および排出削減の分野で幅広いアプリケーションの見通しがあります。ただし、β-Ga 2 O 3 ベースのデバイスには共通の制限があります:β-Ga 2 間の接触 O 3 ワイドバンドギャップと有限のキャリア濃度によって引き起こされる大きな障壁のため、ほとんどの金属はショットキーになる傾向があります。近年、ITO [8]やAZO [9]などの中間層をGa 2 の間に挿入する O 3 金属は、β-Ga 2 間のエネルギー障壁を減らすための有効な方法であることが示されています。 O 3 と金属。
抵抗率が低く、製造コストがITOよりも低いため、Alドープ酸化亜鉛(ZnO)が注目されています[10]。特に、高い熱安定性、高い移動度、およびキャリア濃度により、中間半導体層(ISL)の有望な候補となっています[11]。これまでのところ、AlドープZnO膜は、分子線エピタキシー(MBE)[12]、マグネトロンスパッタリング[13]、化学蒸着(CVD)[14]、および原子層堆積(ALD)[ 15]。特に、ALDは、自己制限化学吸着や自己制限連続反応などの自己制限表面反応により、大面積で優れた均一性を示し、サイクルあたりの成長速度を統一するナノ厚膜を作製する有名な方法です[16]。さらに、ALDは、成長サイクルの比率を変更することにより、界面の乱れを減らし、Alドーピング濃度をより正確に調整することができます。
伝導帯オフセット(CBO)が電子輸送のエネルギー障壁を決定するため、オーミック接触を形成するにはCBOを小さくすると効果的であることに注意してください。以前の研究[17]に基づいて、Alドーピング濃度を上げることにより、AlドープZnO膜は多結晶からアモルファスに変化し、そのバンドギャップも広がります。ただし、さまざまなAlドープZnO /β-Ga 2 のバンドオフセット O 3 ヘテロ接合は広く研究されていません。この研究では、異なるAlドーピング比のZnO膜をそれぞれβ-Ga 2 上に堆積させました。 O 3 ALDによる基質。結果は、VBOとCBOがAlドーピング比にほぼ線形に依存していることを示しています。
メソッド
基板はバルクβ-Ga 2 O 3 (\(\ overline {2} 01 \))そしてドーピング濃度は約3×10 18 / cm 3 。 Ga 2 のクリーニングプロセス O 3 基板は、アセトンとイソプロパノールで10分ごとに超音波洗浄され、3回繰り返されました。続いて、Ga 2 O 3 基板を脱イオン水ですすいだ。その後、AlドープZnO膜をGa 2 上に成長させました。 O 3 ALD(Wuxi MNT Micro Nanotech Co.、LTD、China)による基板。 3種類のサンプルを用意しました。まず、ドープされていないZnO膜を、Znの前駆体(C 2 )を使用してALDで成長させました。 H 5 ) 2 (DEZ)およびH 2 O at 200 o C.次に、トリメチルアルミニウム(TMA)とH 2 の1つのパルスを追加することにより、AlドープZnO膜を実行しました。 ODEZおよびH 2 の19サイクルごと 基板温度200 o でのパルス(5%Alドーピングと表示) ALD中のC。第三に、比率9:1のAlドープZnO膜(10%Alドーピングと表示)も準備しました。 ZnOとAl 2 の成長速度 O 3 それぞれ0.16および0.1nm /サイクルでした。すべての種類のフィルムには、2つの異なる厚さが含まれていました。つまり、厚膜と薄膜の場合、それぞれ40nmと10nmです。さらに、β-Ga 2 O 3 バルク材料を研究するために基板が使用された。 Ga 2 p 、Zn 2 p CL、および価電子帯の最大値(VBM)はX線分光法(XPS)(AXIS Ultra DLD、島津製作所)で測定され、XPSスペクトルの分解能のステップは0.05eVです。 ALDからXPSチャンバーへの転送プロセス中のサンプルの表面汚染を回避するために、XPS測定の前にArイオンエッチングを実行しました。充電効果により、XPSスペクトル、およびC 1 s のBEがシフトする可能性があることに注意してください。 問題を解決するために、ピークは284.8eVで校正されています。
結果と考察
AlドープZnO /β-Ga 2 の価電子帯オフセット(VBO) O 3 ヘテロ接合は、次の式で取得できます[18]:
$$ \ Delta {E} _V =\ left({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3}-{E} _ { \ mathrm {VBM}} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \ right)-\ left({E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm { AZO}}-{E} _ {\ mathrm {VBM}} ^ {\ mathrm {AZO}} \ right)-\ left({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga }} _ 2 {\ mathrm {O}} _ 3}-{E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm {AZO}} \ right)$$(1)
ここで、\({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \)は、Ga 2
続いて、 E に基づいて g および ∆E V 、AlドープZnO /β-Ga 2 のCBO O 3 インターフェイスは次の式で計算できます:
$$ \ Delta {E} _C ={E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3}-{E} _g ^ {\ mathrm {AZO}}-\ Delta {E } _V $$(2)ここで、\({E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \)はGa 2 のバンドギャップです。 O 3 \({E} _g ^ {\ mathrm {AZO}} \)は、AlをドープしたZnOのバンドギャップです。ドープされていない、5%のAlドープされたZnO、10%のAlドープされたZnO、およびβ-Ga 2 のバンドギャップ O 3 それぞれ3.20eV、3.25 eV、3.40 eV、4.65 eVです[17、19]。バンドギャップは、Alドーピング率が高くなると増加し、次のパートのシミュレーションとよく一致します。
図1は、バルクβ-Ga 2 のGaおよびZn元素CLとVBMを示しています。 O 3 、厚くドープされていない、および5%および10%のAlドープZnO膜。 VBMスペクトルから線形領域とフラットバンドゾーンをフィッティングすると、VBMを推定できます[20]。図2は、Ga 2 p を示しています。 およびZn2 p さまざまな薄いAlドープZnO /β-Ga 2 からのCL O 3 ヘテロ接合。 Ga 2 p のBEの違い およびZn2 p ドープされていない、5%のAlドープされたZnO /β-Ga 2 のCL O 3 、および10%AlドープZnO /β-Ga 2 O 3 それぞれ96.12eV、96.16 eV、95.94eVになります。次に、界面でのVBOは、ドープされていない5%AlドープZnO /β-Ga 2 の場合、1.39 eV、1.52 eV、および1.67eVであると決定されます。 O 3 、および10%AlドープZnO /β-Ga 2 O 3 それぞれサンプル。
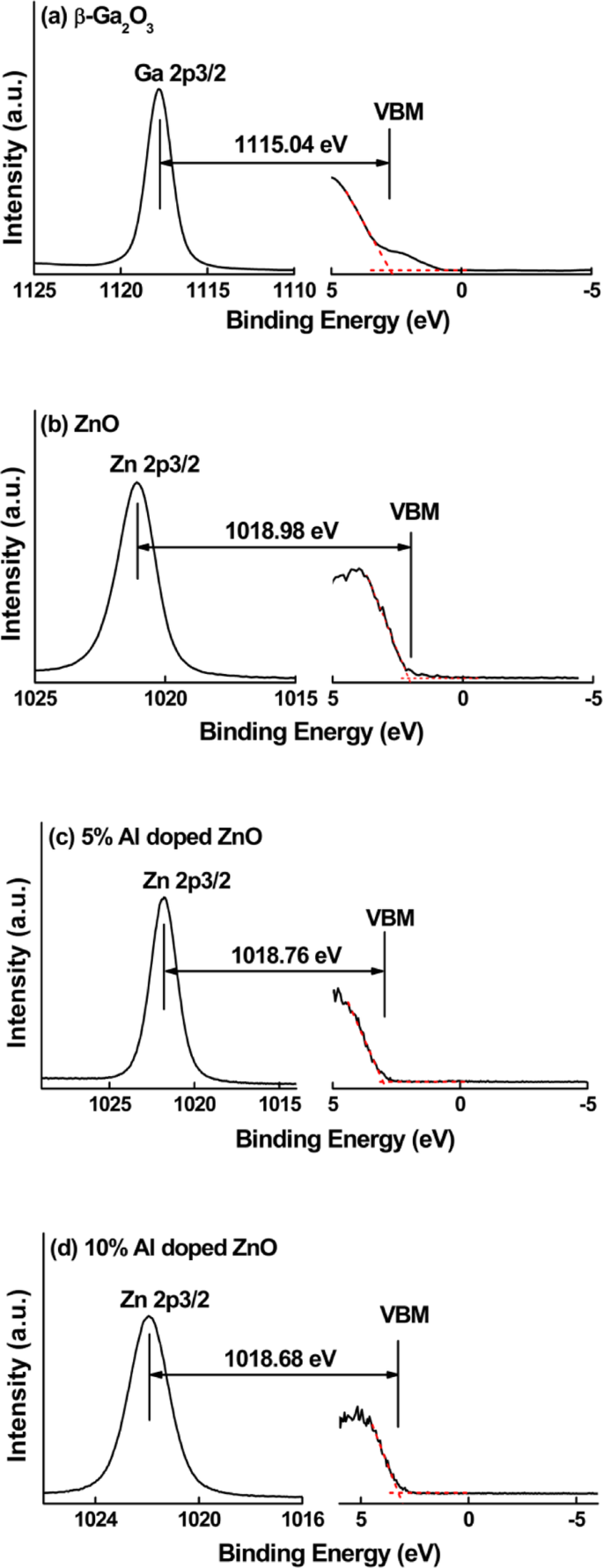
a のコアレベルと価電子帯の最大値(VBM)の高分解能XPSスペクトル Ga 2 p 裸のβ-Ga 2 からのコアレベルスペクトルとVBM O 3 、 b Zn 2 p 厚い純粋なZnO /β-Ga 2 からのコアレベルスペクトルとVBM O 3 、 c Zn 2 p 厚い5%AlドープZnO /β-Ga 2 からのコアレベルスペクトルとVBM O 3 、および d Zn 2 p 厚い10%AlドープZnO /β-Ga 2 からのコアレベルスペクトルとVBM O 3

Ga 2 p のコアレベルスペクトル およびZn2 p a の高分解能XPSスペクトルから得られた 薄いZnO /β-Ga 2 O 3 、 b 薄い5%AlドープZnO /β-Ga 2 O 3 、および c 薄い10%AlドープZnO /β-Ga 2 O 3
0%、5%、および10%のAlドープZnO /β-Ga 2 の系統的なバンドアラインメント O 3 ヘテロ接合は、図3に示すように、上記の式で計算されます。ドープされていないZnO /β-Ga 2 のバンドオフセット O 3 ヘテロ接合はタイプIに属します。5%と10%の両方のAlドープZnO /β-Ga 2 O 3 ヘテロ接合にはタイプIIのバンドオフセットがあります。図4は、AlをドープしたZnO /β-Ga 2 のバンド配列を示しています。 O 3 界面は、Alドーピング濃度と同様の線形関係を持っています。 CBOは1.39から1.67eVまで変化し、Alドープ濃度は0から10%に増加します。一方、VBOは0.06から-0.42 eVに減少し、Alドープ濃度は0から10%に上昇します。スパッタされたAZO /β-Ga 2 のCBOとVBOに注意してください。 O 3 それぞれ0.79eVと0.61eVです[9]。この作業では、伝導帯と価電子帯の両方が下方にシフトします。これは、堆積法によって導入された異なる組成比と結晶構造が原因である可能性があります。

a の概略バンドアライメント図 純粋なZnO /β-Ga 2 O 3 、 b 5%AlドープZnO /β-Ga 2 O 3 、および c 10%AlドープZnO /β-Ga 2 O 3

原子層に堆積したAZO /β-Ga 2 の伝導帯と価電子帯のオフセット O 3 異なるAlドーピング比で製造されたヘテロ接合
それ以外に、第一原理シミュレーションは、Vienna Ab-initio Simulation Package(VASP)[21,22,23,24]によって実行され、AlドープZnO / Ga 2の電子バンド構造とバンドアラインメントが調査されました。 O 3 ヘテロ接合。計算中、電子-イオン相互作用は超軟質疑似ポテンシャルによって処理され、波動関数とポテンシャルは平面波基底によって拡張されました[25]。さらに、Perdew、Burke、およびErnzerhof(PBE)によって提案された一般化勾配近似(GGA)が、交換相関エネルギーを記述するために実装されました[26]。シミュレーションを開始する前に、収束テストが実行されました。平面波ベースの450eVのカットオフエネルギーと、MonkhorstPackスキームを使用した3×3×3のk空間グリッドが十分に収束した結果をもたらすことが示されました。構造の最適化では、共役勾配法が使用され、0.01 eV /Å未満になるまで残留力が解放されました。さらに、半局所PBE近似に基づくハイブリッド密度関数が実装されました。過小評価されたバンドギャップを修正するために、PBE交換の35%が正確なものに置き換えられました[27]。 Alドーピングレベルの変化に伴うバンドエッジシフトを特定するために、平均静電ポテンシャル(AEP)が計算され、0 Vにスケーリングされた真空レベルに調整されました。その結果、VBMと伝導帯最小値(CBM)は次のように調整されました。バンド図に基づくAEP [28]。この作業では、スーパーセル内に16個のO原子と16個のZn原子を持つバルクZnOを使用しました。 Alドーピングを導入するために、スーパーセル内の1つまたは2つのZn原子がAl原子に置き換えられ、ドーピング濃度がそれぞれ3.21%と6.25%のAlドープ構造が作成されました。
図5a〜cは、それぞれ、ドープされていない、3.21%のAlドープされたZnO、および6.25%のAlドープされたZnO構造の計算されたバンド図を示しています。 ZnOが3.42eVのバンドギャップを持つ直接バンドギャップ半導体であり、CBMとVBMがブリルアンゾーンのΓ点に位置していたことを明確に示しています。これらの理論的シミュレーション結果は、実験値と非常によく一致しています[29]。 Alドーピングにより、フェルミ準位が伝導帯に上方にシフトし、純粋なZnOがn型半導体に変換されることがわかりました。一方、バンドギャップは、3.21%のAlドープZnOと6.25%のAlドープZnOでそれぞれ4.83eVと5.42eVに増加しました。ここでドープされたZnOのバンドギャップは、実験結果よりも高くなっています。ただし、これは、界面欠陥状態やその他の結晶欠陥を無視していることが原因である可能性があります。
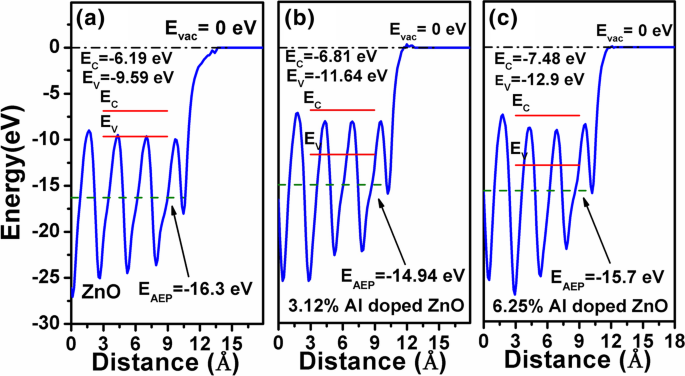
a の計算されたバンド図 ドープされていないZnO、 b 3.21%AlドープZnO、および c 6.25%のAlドープZnO構造。フェルミ準位は0eVに設定されました
図6a〜cは、真空レベルに対する、ドープされていない、3.21%のAlドープされたZnO、および6.25%のAlドープされたZnOのバンドアラインメントを示しています。材料の伝導帯については、Al元素とO元素の強い電子混合により、エネルギー準位がZnOの-6.19eVから3.21%AlドープZnOの-6.81eVに減少することがわかりました( Δ E =0.62 eV)、6.25%のAlドープZnO(ΔE)ではさらに-7.48eVに減少します。 =1.29 eV)。一方、バンドギャップが開いたため、価電子帯のエッジがZnOの-9.59eVから3.21%AlドープZnOの-11.64 eV(ΔE =2.05 eV)および-6.25%AlドープZnOの場合は-12.9 eV(ΔE =3.31 eV)。全体として、強いAlとOの電子混合に起因して、AlをZnOに組み込むとバンドギャップが開くことが理解できます。さらに、真空準位に合わせると、伝導帯と価電子帯の両方のエッジがより低いエネルギーレベルにシフトします。
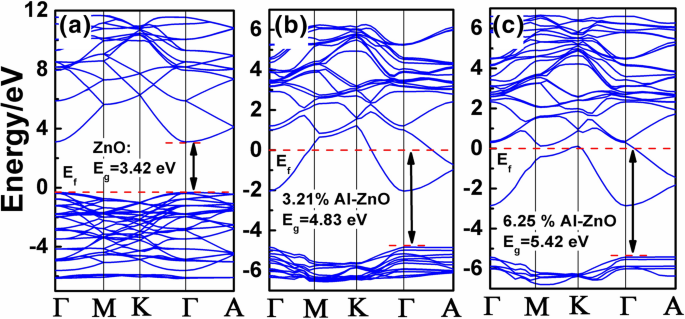
AZO /β-Ga 2 のバンドアラインメント O 3 a とのヘテロ接合 ドープされていない、 b 3.21%、および c 6.25%のAlドープZnO。真空レベルは0eVにスケーリングされました
結論
結論として、さまざまなAlドープZnO /β-Ga 2 のバンドアラインメント O 3 (\(\ overline {2} \)01)インターフェイスはXPSによって調査されました。タイプIのバンド配列がZnO /β-Ga 2 の界面に形成されます O 3 ヘテロ接合。 AZO /β-Ga 2 O 3 インターフェイスにはタイプIIのバンドアライメントがあります。 CBOは1.39から1.67eVまで変化し、VBOは0.06から-0.42 eVに減少し、Alドープ濃度は0から10%に上昇します。さらに、密度関数の計算は、AlがZnOに組み込まれると、強いAlとOの電子混合によりバンドオフセットが変化することを示しています。これらの結果は、純粋なZnOがバリアの高さを減らし、電子伝達を促進するための有効なISLであることを示唆しています。
データと資料の可用性
この原稿の結論を裏付けるデータセットは、原稿に含まれています。
略語
- AEP:
-
平均静電ポテンシャル
- ALD:
-
原子層堆積
- BE:
-
結合エネルギー
- CBM:
-
伝導帯の最小値
- CBO:
-
伝導バンドオフセット
- CL:
-
コアレベル
- CL:
-
コアレベル
- CVD:
-
化学蒸着
- DEZ:
-
Zn(C 2 H 5 ) 2
- Ga 2 O 3 :
-
酸化ガリウム
- GaN:
-
窒化ガリウム
- GGA:
-
一般化された勾配近似
- ISL:
-
中間半導体層
- PBE:
-
Perdew、Burke、Ernzerhof
- SiC:
-
炭化ケイ素
- TMA:
-
トリメチルアルミニウム
- VASP:
-
ウィーンabinitioシミュレーションパッケージ
- VBM:
-
価電子帯の最大値
- VBO:
-
ヴァランスバンドオフセット
- XPS:
-
X線分光法
- ZnO:
-
酸化亜鉛
ナノマテリアル
- 固体のバンド理論
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性
- 原子層に堆積したZnO /β-Ga2O3(\(\ overline {2} 01 \))ヘテロ接合でのエネルギーバンドの調査
- 二硫化モリブデンとZrO2ヘテロ接合のエネルギーバンドの調査
- 二酸化炭素を使用したSiO2の低温プラズマ強化原子層堆積
- 短期/長期シナプス可塑性を備えた原子層堆積Hf0.5Zr0.5O2ベースのフレキシブルメモリスタ



