テトラキス(エチルメチルアミノ)およびテトラキス(ジメチルアミノ)前駆体を用いた原子層堆積Hf0.5Zr0.5O2薄膜の強誘電性能に関する比較研究
要約
堆積した原子層の化学的、物理的、および電気的特性Hf 0.5 Zr 0.5 O 2 テトラキス(エチルメチルアミノ)(TEMA)とテトラキス(ジメチルアミノ)(TDMA)前駆体を使用した薄膜を比較します。有機金属前駆体の配位子は、残留C濃度、粒子サイズ、および結果として生じる強誘電特性に強く影響します。 Hf 0.5 のデポジット Zr 0.5 O 2 TDMA前駆体を含むフィルムは、C濃度が低くなり、粒子サイズがわずかに大きくなります。これらの発見は、より強誘電相が支配的な膜を成長させるのに有益であり、それはそのウェイクアップ効果を軽減する。 TDMA-Hf 0.5 のウェイクアップテストから Zr 0.5 O 2 2.8 MV / cmのサイクリングフィールドを備えたフィルムでは、ウェイクアップの悪影響は10 5 まで十分に抑制されました。 サイクル、約40μC/ cm 2 の適度に高い二重残留分極値 。このフィルムは、10 9 までの信頼性の高い切り替えも示しました。 ウェイクアップ効果を伴わずに、2.5 MV / cmのサイクリングフィールドでサイクリングしますが、典型的な疲労挙動を示します。
はじめに
原子層堆積Hf 1- x Zr x O 2 (HZO、 x 〜0.5)薄膜は、メモリおよびロジックアプリケーション用の半導体デバイスの分野で超薄強誘電体(FE)層として有力な候補となっています。これは、フルオライト構造のFE HZO膜を、10 nm未満でもスケールダウンでき、成熟原子層堆積(ALD)技術を利用して3次元ナノ構造上に均一に堆積できるためです。また、従来のペロブスカイト構造の強誘電体では実現が困難な従来のTiN電極[1、2]との互換性があります。過去数年間にALDベースの薄膜を使用したHZOフィルム処理とデバイス製造が大幅に改善されたにもかかわらず、いくつかの未解決の欠点があります。特に、フルオライト構造の強誘電体の信頼性は不確かです。現在、ウェイクアップ効果と限られた数の持久力が最も深刻な問題と考えられています[3]。一般に、分極-電場(P-E)曲線は元の状態で挟まれており、強制電場(E c )は空間的に不均一であり、いくつかのFEドメインが固定されています[4]。 E c より高い電界強度での電界サイクリング後 、より対称的で正方形のようなP–E曲線を実現できます。これは、ウェイクアップ効果として知られる現象です。場合によっては、このようなウェイクアッププロセスは10 4 になります。 –10 5 サイクル、これは約の典型的な耐久サイクルです。フラッシュメモリ、デバイスとシステムの操作を複雑にします[5]。耐久性の数が限られていることは、ワーキングメモリとして使用することを目的としている場合のもう1つの重要な問題です(耐久性> 10 15 必要とされている)。金属-強誘電体-金属コンデンサ構造の場合、報告される最大耐久性は10 11 未満です。 [6]、および強誘電性電界効果トランジスタの金属-強誘電体-半導体ゲートスタックの場合、耐久性は最大10 5 に制限されます。 回[3、7]。
ウェイクアップ効果のさまざまな起源が文献で示唆されました。提案されているメカニズムは、不純物、酸素空孔などの欠陥によるドメイン境界のピン止め、および元の状態の電極または半導体チャネルに隣接する界面での非強誘電相(立方晶または正方晶相)の存在です[5、8 、9,10]。ピニングサイトの濃度は、繰り返しの分極切り替え中に減少すると予想されます。また、電界サイクリングは、界面の正方晶または立方晶相をFE斜方晶相に変換します[5]。この研究は主に、ALDプロセス中に代替のHfおよびZr前駆体を採用することにより、HZOフィルムの電気的性能を改善するか、ウェイクアップ効果を排除することに焦点を当てました。これにより、不純物濃度、特に炭素不純物が低下する可能性があります。
有機金属前駆体を使用するALDプロセスの場合、成長した膜にC、N、Hなどの残留不純物を誘発することはほぼ避けられません。これらはおそらく有機配位子に由来します。キムら[11、12]は、HfO 2 の堆積温度を変えることによって そしてHZOフィルム、多形性および結果として生じる電気的性質を制御することができた。オージェ電子分光法(AES)から、ALD HZO薄膜のC濃度は、堆積温度の低下とともに増加しました。これは、不完全な配位子交換反応に起因する可能性があります[11、12]。また、横方向の粒子径は、C濃度の増加とともに減少しました。このようなフルオライト構造の膜における安定した単斜晶相ではなく、不安定または準安定相(正方晶、斜方晶、および立方晶)の形成は、粒子サイズ効果と密接に関連しています[13、14、15、16]。したがって、不純物濃度を制御することは、フィルムの電気的信頼性を高めるだけでなく、目的の相(FE斜方晶)を達成するために重要です。
FE HZO薄膜のALDの場合、最も頻繁に使用される有機金属HfおよびZr前駆体は、テトラキス[エチルメチルアミノ]ハフニウム(TEMAH)およびテトラキス[エチルメチルアミノ]ジルコニウム(TEMAZ)です[11、12、17]。これらの前駆体は、メチル基とエチル基の間の電荷移動を介した容易な配位子分解を目的として、有機金属化学蒸着用に開発されました[18、19、20]。しかし、このタイプの熱的に誘発された配位子分解とそれに続く有機配位子(の断片)の除去は、容易なALD反応を不利に妨害し、フィルムへの不純物(C、H、およびN)の取り込みをもたらします[11、17、18、 19,20]。
対照的に、テトラキス[ジメチルアミノ]ハフニウム(TDMAH)およびテトラキス[ジメチルアミノ]ジルコニウム(TDMAZ)前駆体は、FE HZO膜の堆積にも使用されており[21、22、23、24]、メチル基のみが含まれています。リガンド。したがって、熱分解の完全な抑制は保証できませんが、そのような悪影響は深刻ではない可能性があります。
この研究では、2つの異なる金属前駆体を使用してALDプロセスで成長させたHZO膜間の比較分析を行いました。 TEMAH / TEMAZおよびTDMAH / TDMAZ。後者のプロセスでは、フィルム内のC濃度が低くなり、HZOフィルムの電気的性能が大幅に向上しました。最適化されたスイッチングサイクリング条件下では、切り替え可能な分極が〜40μC / cm 2 のままである間、ウェイクアップ効果はほとんど達成されませんでした。 。
メソッド/実験
Hf 0.5 の準備 Zr 0.5 O 2 薄膜
この作業では、原子層に堆積したHf 0.5 の構造と電気的性能に対する有機金属前駆体の種類の影響を調べました。 Zr 0.5 O 2 薄膜。 HZO薄膜は、TDMAH(またはTEMAH)、TDMAZ(またはTEMAZ)、およびオゾン(190 g / m 3 を備えた直径4インチスケールの熱ALDリアクターを使用して堆積されました。 濃度)Hf前駆体、Zr前駆体、および酸素源としてそれぞれ。 TEMAH / TEMAZ前駆体を使用した最適化されたALDプロセスは、著者の以前の研究[5、9、11、12、13、14、15、16]と同じでした。 TDMAH / TDMAZ前駆体を含むHZO薄膜は、260°Cの基板温度で熱ALDによって調製されました。組成が最大の残留分極(P r )を示すことが報告されているため、電気的試験には50:50のHf:Zr比を選択しました。 )以前の研究の値[17、25、26]。 TDMAH / TDMAZ前駆体を含むHZO薄膜は、TiN / Ti / SiO 2 上にHfおよびZr前駆体のALDサイクル比が1:1で堆積されました。 / Si基板。 1つのALDサイクルは、ソース供給(2 s)-ソースパージ(20 s)-オゾン供給(3 s)-オゾンパージ(10 s)プロセスで構成されていました。 HZO膜の成長速度は1サイクルあたり0.13nmであり、10 nmの厚さのHZO薄膜は、実験用にTDMAH / TDMAZ前駆体によって調製されました。最適な条件は、ALDチャンバーの容量によって異なります。表1に、TEMAソースとTDMAソースの物理的特性の比較を示します。 TiN(50 nm)およびTi(5 nm)膜は、市販のスパッタリングツール(Endura、Applied Materials)を使用して、熱酸化されたp型Si基板上に5kWのスパッタリングパワーでスパッタリングを使用して堆積されました。堆積されたHZO膜は、堆積されたままの状態では部分的に結晶性またはアモルファスであるため、結晶化のためのその後のアニーリングは、N 2 で450°Cのラピッドサーマルプロセス(RTP)を使用して行われました。 雰囲気。
<図>Hf 0.5 の化学的/物理的特性の特性評価 Zr 0.5 O 2 薄膜
堆積したフィルムの結晶構造は、X線回折計(XRD、X’pert pro、Panalytical)を使用して、入射角0.5°のかすめ入射ジオメトリ内で分析しました。走査型電子顕微鏡(SEM、S-4800、日立)を使用してサンプルの微細構造を分析し、Gwyddionソフトウェア[29]を使用して分水界法により粒度分布を分析しました。堆積したHZOフィルムの化学組成は、蛍光X線(XRF、Quant'X、Thermo SCIENTIFIC)を使用して分析し、Cなどの不純物を含む化学組成の詳細な変動は、時間を使用して分析しました。飛行オージェ電子分光法(AES、PHI-700、ULVAC-PHI)。
Hf 0.5 の電気的特性の特性評価 Zr 0.5 O 2 薄膜
HZO膜の電気的特性を分析するために、92.6%-Ar / 7.4%-N 2 の下で、100Wの電力でスパッタリングプロセスを介して上部のTiN電極を反応的に堆積させました。 雰囲気。 TiN上部電極は、直径300μmの円形の穴を備えたシャドウマスクを使用してパターン化されました。 P–E特性は、強誘電体テスター(TFアナライザー2000、Aixacctシステム)を使用して、1kHzの測定周波数で分析されました。耐久性テストは、パルスジェネレータ(81110A、Agilent)と強誘電体テスター(TFアナライザ2000、Aixacctシステム)によって生成された、高さと幅がそれぞれ2.8〜3.8 MV / cmと10μsの長方形のバイポーラパルスを使用して実施されました。静電容量-電圧(C-V)特性は、インピーダンスアナライザー(4194A、ヒューレットパッカード)を使用して、周波数10kHz、高さ50mVの正弦波ACパルスとDCバイアスを組み合わせて測定しました。 HZOフィルムの誘電率は、測定された静電容量、光学顕微鏡で測定された電極面積、および分光エリプソメトリー(ESM-300、J。A。Woollam)を使用して測定された厚さから計算されました。電流密度-電界(J-E)特性は、半導体パラメーターアナライザー(4155B、ヒューレットパッカード)を使用して、1秒の遅延時間でDCバイアス下で分析されました。
結果と考察
図1aは、厚さ10nmのHf 0.5 のかすめ入射X線回折(GIXRD)パターンを示しています。 Zr 0.5 O 2 TDMAH / TDMAZ(TDMA-HZO、黒の曲線)およびTEMAH / TEMAZ(TEMA-HZO、赤の曲線)を使用して、入射角0.5°で堆積された薄膜。単斜晶、正方晶、斜方晶の各相の文献から引用した参照パターンが下部に追加されています。 TDMAフィルムとTEMAHZOフィルムの両方のGIXRDパターンから、単斜晶相からの回折ピークの強度はごくわずかであり、ピークの形状と強度に顕著な違いは確認できませんでした。したがって、TDMAとTEMA HZOの間の結晶構造に有意差は、GIXRDから実験的に確認されませんでした。

(a) TDMAH / TDMAZ(黒の曲線)およびTEMAH / TEMAZ(赤の曲線)を使用して堆積されたHZO薄膜のGIXRDパターン、単斜晶、正方晶、および斜方晶相の文献から取得した参照パターンが下部パネルに添付されています。 ( b) TDMA HZOフィルムと( c)の平面SEM画像 TEMA(赤;参考文献[15]から複製)、TDMA(黒)HZOの粒度分布。 ( d) 飛行時間型オージェ電子分光法を使用して分析されたTDMAHZO薄膜の深さプロファイル、および( e) HZOフィルム部分の拡大された低濃度領域。 TDMA(黒い一点鎖線)、TEMA(赤い一点鎖線、参考文献[12]から複製)、HZOの平均C濃度が示されています
横方向の粒子サイズを含む微細構造は、HZO薄膜のFE特性に強く影響する可能性のあるもう1つの重要な要素です[13、14、15、16、30]。したがって、TDMAおよびTEMA HZOフィルムの微細構造は、走査型電子顕微鏡(SEM)を使用して分析されました。図1bは、TDMAHZOフィルムの平面SEM画像を示しています。さまざまな以前の研究では、熱ALDを使用して堆積されたHZO薄膜は柱状の粒子構造を示し、垂直方向の粒子サイズが膜の厚さと同じくらい大きいことが示唆されました[1、5、11、31]。上記のソフトウェア[29]を使用して分析された横方向の粒子サイズの分布は、ガウス関数に適合しました。 TEMA HZO(赤い曲線)の粒度分布は以前の研究[15]から取得され、図1cにTDMA HZO(黒い曲線)の粒度分布とプロットされています。図1cに示すように、TDMA HZOの平均横方向粒子径(8.5 nm)はTEMA HZOの平均横方向粒子径(7.1 nm)よりも大きかった。これが、TDMAHZOのFEパフォーマンスが向上した主な理由である可能性があります。以前の報告によると、斜方晶および正方晶相などの準安定相の形成は速度論的起源によって駆動され、正方晶および正方晶相は小粒径領域で好ましい[13、16]。はるかに大きな粒子は単斜晶相を好み、小さな粒子サイズは正方晶相を好み、わずかに大きい粒子サイズは斜方晶相を好みます。回折パターンにおける2つの相(正方晶相と斜方晶相)のピーク位置のほぼ重なりは、2つのフィルムの主要な相の明確な識別を可能にしませんでした。ただし、SEMとそれに伴う粒子サイズ分析では、TDMAHZOフィルムはTEMAHZOフィルムと比較して斜方晶相の部分が高い可能性があることが示されました。
異なる粒子サイズは、2つのフィルムのC不純物濃度のレベルが異なる結果として発生している可能性があります。不純物の濃度は、HZO薄膜の微細構造とその結果生じる強誘電特性に強く影響する可能性があります[11、12、32]。したがって、TDMAおよびTEMA HZO薄膜の化学組成は、飛行時間型AESを使用して分析され、TDMA HZO内のHf、Zr、O、C、Ti、およびNなどのさまざまな原子の詳細な濃度が得られました。フィルムは、図1dにスパッタリング時間の関数としてプロットされました。図1eは、HZOフィルム部分の図1d(赤い破線のボックス)の拡大された低濃度領域を示しています。 TDMA HZOフィルム(黒い四角)の平均C濃度は〜2.4%であり、TEMA HZOフィルム(赤い三角形)[12]のそれ(〜3.9%)よりも〜38%小さく、AESデータは著者の以前の研究[12]。 Nを含む他のすべての濃度では、顕著な違いは見られませんでした。
Cho etal。 ALDプロセス中に形成された残留C不純物が粒子成長を遅らせ、最終的に堆積された膜の粒子サイズを小さくすることを示唆しました[32]。同様の傾向が強誘電性Hf 0.5 でも観察されました。 Zr 0.5 O 2 薄膜と純粋なHfO 2 キムらによる映画。堆積温度が280℃から200℃に低下したとき[11、12]。ユングら計算シミュレーションを使用して、正方晶相と単斜晶相の間の自由エネルギーの差が、HfO 2 のC濃度の増加とともに減少することを示しました。 、C不純物を含めると準安定正方晶相の安定性が向上することを示唆しています[33]。 Kuenneth etal。また、HfO 2 の自由エネルギー値に対するC濃度の影響も調べました。 。しかし、彼らは、C濃度の増加は、斜方晶相と単斜晶相の間の自由エネルギー差の減少をもたらさなかったと報告しました[34]。 Kuenneth et al。の研究では、置換型C欠陥が考慮されましたが、C不純物は一般にHfO 2 の侵入型欠陥として知られています。 [33、35]。したがって、理論計算では、C不純物が正方晶相と斜方晶相の間の自由エネルギー差を減少させる可能性があることを明確に明らかにしていませんでした。ただし、実験により、C不純物の増加により、ALDHZO薄膜の正方晶相の割合が増加する可能性があることが確認されています[11、12、33]。
TDMA HZOフィルムのC不純物濃度が低いのは、TDMAリガンドとTEMAリガンドの熱分解の性質が異なるためである可能性があります。 TEMAリガンドの最も外側の炭素原子は、熱的に解離する傾向があり、ALDプロセス中にフィルム表面に残ります[11、12]。これはTDMAリガンドの場合には当てはまらない可能性があります。
次のステップとして、強誘電特性に対するC濃度と結果として生じる微細構造の影響について説明します。図2aとbは、それぞれTDMAHZOフィルムとTEMAHZOフィルムを使用したMFMコンデンサのP–E曲線を示しています。これらは、元の状態と疲労状態で10 2 切り替えて測定したものです。 、10 3 、10 4 、および10 5 3.8 MV / cm-高さおよび10μs幅のバイポーラ矩形パルスを使用した時間。図2aおよびb(元の状態)のP–E曲線から、TEMA HZOコンデンサのP–E曲線(黒の曲線、図2b)は、TDMA HZOコンデンサ(黒)と比較して、元の状態でより強く挟まれています。曲線、図2a)。図2bは、TEMA HZOコンデンサの元のP–E曲線のこぶを明確に示していますが、TDMA HZOコンデンサの元のP–E曲線には当てはまりません。 P–E曲線のこぶは、スイッチング電流のピークの分割に起因します。これは、一般に、内部電界および/または強制電界の空間的不均一性に起因します。図2cは2P r の変化を示しています 疲労パルスの関数としてのTDMAおよびTEMAHZOコンデンサの値。 2P r 10 5 以降の値 元の2P r と比較した電気パルスの時間 TDMAコンデンサとTEMAHZOコンデンサの値は、それぞれ〜80%と〜69%です。これは、TEMAHZOフィルムがTDMAHZOフィルムと比較してより高いウェイクアップ動作を持っていることを示唆しています。

( a の分極-電場(P–E)曲線 )TDMA HZOおよび( b )TEMA HZO(参考文献[5]から転載)コンデンサは、10 2 でパルスされた元の状態と疲労状態で測定されました。 、10 3 、10 4 、および10 5 3.8 MV / cm-高さおよび10μs幅の双極矩形パルスでの時間。 ( c) 2P r の変更 疲労パルスの関数としてのTDMA(黒)およびTEMA(赤)HZOコンデンサの値。 ( d の誘電率-電界曲線 )TDMA HZOおよび( e )TEMA HZO(参考文献[5]から転載)コンデンサ。上部と下部のTiN電極は、元の状態と疲労状態で測定されています。 ( f) TDMA(黒)およびTEMA(赤)HZOコンデンサの疲労パルス数の増加に伴う誘電率値の変化
図2dとeは、誘電率-電界(ε r )を示しています。 -E)10 2 で切り替えられた元の状態と疲労状態で測定されたTDMAHZOおよびTEMAHZOコンデンサの曲線 、10 3 、10 4 、および10 5 3.8 MV / cm-高さおよび10μs幅のバイポーラ矩形パルスを使用した時間。 ε r TDMA HZOコンデンサの値は、すべてのテスト条件でTEMAHZOコンデンサの値よりも大幅に低くなっています。図2fは、ε r の変化を示しています。 TDMAおよびTEMAHZOコンデンサの疲労スイッチングサイクル数の増加に伴う値。 ε r 値は、ε r を平均することによって計算されました 図2dおよびeの最高および最低電界で測定された値。図1aのGIXRDパターンから、両方のフィルムの単斜晶相の割合はごくわずかでした。したがって、ε r の違い 値は、正方晶相と斜方晶相の比比または欠陥濃度によって決定される可能性があります。これにより、局所的な格子歪みによって平均誘電率が低下すると予想されます。 ε r 正方晶相の値(35–40)は、斜方晶相の値(25–30)よりも高かった。したがって、高いε r TEMA HZOコンデンサの値は、TDMAHZOコンデンサと比較して正方晶相の割合が高いことを示しています。疲労パルスの数が増えると、ε r 図2fに示すように、TEMAHZOコンデンサとTDMAHZOコンデンサの両方の値が減少します。 ε r の減少の大きさ 10 5 の間の値 TDMA HZOコンデンサの偏光スイッチングの倍数(26.8〜25.3)は、TEMA-HZOコンデンサの偏光スイッチング(32.2〜29.6)よりも約42%小さかった。これは、図2cに示すウェイクアップ動作と一致しています。
正方晶相の割合の違いと、結果として生じる異なるε r TDMAとTEMAHZO薄膜の値は、C濃度の違いから理解できます。キムらによると。 [12]、C濃度の増加は、斜方晶相の自由エネルギーと比較して正方晶相の自由エネルギーを減少させます(正方晶相は斜方晶相と比較してさらに有利です)。その結果、C濃度の増加に伴い、正方晶相の割合が増加すると予想されます。 TDMAHZOフィルムのC濃度はTEMAHZOフィルムよりも低いため、TDMAHZOフィルムの正方晶相の割合はTEMAHZOフィルムよりも低いと予想されます。図1cに示す粒子サイズの違いも、相対的な結晶相の割合で同じ傾向を示しています。 Materlikらによると。 [30]、正方晶相の自由表面エネルギー(2.5 J / m 2 )はそれよりも低い(2.9 J / m 2 )斜方晶相の。ただし、これらの自由表面エネルギーは、さまざまな厚さとZr濃度のHZO薄膜での実験的観察を説明するために推定されました。バトラら。 [36]は、さまざまな配向のさまざまな結晶相の自由表面エネルギーを計算し、正方晶相の自由表面エネルギーが斜方晶および単斜晶相の自由表面エネルギーよりも低いことを示しました。高角度の粒界エネルギーは自由表面エネルギーの約1/3であると一般に認められています[37]。したがって、正方晶相の粒界エネルギーは、斜方晶および単斜晶相と比較して最も低く、最小の結晶粒径で最も安定な相になります。これらは、平均粒径が大きいTDMA HZO膜と比較して、TEMA HZOの粒径が小さいほど、非強誘電性正方晶相の部分が多く含まれる傾向があるという考えと一致しています。したがって、実験的に観察されたC濃度と粒子サイズは、TDMAおよびTEMAHZO薄膜の異なる結晶構造と結果として生じる電気的特性を一貫してサポートします。
ウェイクアップ効果の背後にあるメカニズムを解明するために、界面容量(C i )を推定できるパルススイッチング測定 )電極近くの非強誘電体層に由来し、TDMAHZOおよびTEMAHZOコンデンサで実行されました[5]。図3aとbは、C i の変化を示しています。 、接触抵抗(R c )、およびE c TDMAHZOコンデンサとTEMAHZOコンデンサのそれぞれの疲労パルス数の増加に伴う値。詳細な測定方法と結果は、オンラインのサポート情報に含まれています。 TEMA HZOコンデンサのデータは、Kim et al。の以前の研究[5]から取得されたもので、C i 電界サイクリングの数が増えると、値は増加します[5]。手付かずの状態では、C i (37.6μF/ cm 2 )TDMAコンデンサの値がそれよりも高い(21.1μF/ cm 2 )TEMA HZOコンデンサの〜75%であり、TDMAHZOの非強誘電性界面層の厚さがTEMAHZOフィルムの厚さよりもはるかに薄いことを示唆しています。一方、E c の違い TDMAおよびTEMAHZOコンデンサの元の状態での値はわずか13%であり、TDMAおよびTEMA HZOコンデンサの元のP–E特性の違いの主な理由は、非強誘電性界面層の厚さが異なることであることを示唆しています。 R c 以降 値は、電気テスト設定の接触抵抗の影響を強く受けます。他の2つの要因と比較して重要性が低い場合があります。したがって、TDMAとTEMA HZOコンデンサの元の状態での異なるP–E特性は、Kim etalによって提案された以前のウェイクアップモデルに基づいて一貫して理解できます。 [5]。以前の研究によれば、TiN電極付近の酸素空孔濃度は、元の状態の膜バルク領域の酸素空孔濃度よりも高くなっています。ホフマンらによると。 [38]、酸素空孔濃度の増加は、斜方晶相の安定性と比較して正方晶相の安定性を高めます。耐久性試験での繰り返し分極スイッチング中に、界面正方晶相は、酸素空孔をフィルムのバルク領域に拡散させることにより、FE斜方晶相に変換するように見えました。印加された場はまた、界面の非FE相のFE相への相転移を誘発した。 TDMA-HZOコンデンサの界面層の厚さは、元の状態のTEMA-HZOコンデンサの厚さよりも薄いため、フィールドサイクリング中のウェイクアップ効果を軽減できます。
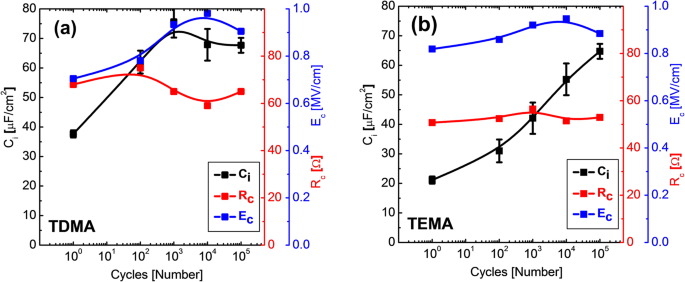
( a の変更 )TDMA HZOおよび( b )界面容量(C i のTEMAHZO(参考文献[5]から転載) )、接触抵抗(R c )、および強制フィールド(E c )疲労パルス数の増加に伴う値
また、疲労パルスの振幅は、フルオライト構造の強誘電体のウェイクアップ現象に強く影響する可能性のあるもう1つの重要な要因です[6、8]。したがって、TDMA HZOコンデンサのウェイクアップ効果は、2.8、3.1、3.5、および3.8 MV / cmのさまざまな振幅の疲労パルスを使用して調べられました。図4a、b、およびcは、それぞれ2.8、3.1、および3.5 MV / cmの疲労パルス高さでのウェイクアップテスト中に測定されたP–E曲線を示しています。 2P r の変更 ウェイクアップテスト中は図4dにまとめられています。図2aに示すウェイクアップテストの結果と同様に、P–E測定は、3.8 MV / cmの測定電界で、所定の電界振幅で一定回数のウェイクアップサイクルを行った後に実行されました。 P–Eヒステリシスの変化は、図4a–cに示すように、疲労パルスの振幅が減少するにつれて減少します。図4dは、2P r の変更の概要を示しています。 2.8、3.1、3.5、および3.8 MV / cm振幅疲労パルスを使用した耐久性テスト中の値。図4dに見られるように、2P r の大きさ 10 5 後に増加 フィールドサイクリングの時間は、0.41、5.18、9.93、および9.94μC/ cm 2 でした。 それぞれ〜1、〜13、〜26、および〜24%の変化に対応するさまざまな疲労場の振幅に対して。この結果は、2.8 MV / cmの振幅の疲労パルスが適用された場合、ウェイクアップ効果が無視できることを意味します。この場合、2P r は適度に高くなります。 値(〜40μC / cm 2 )まだ達成できる可能性があります。
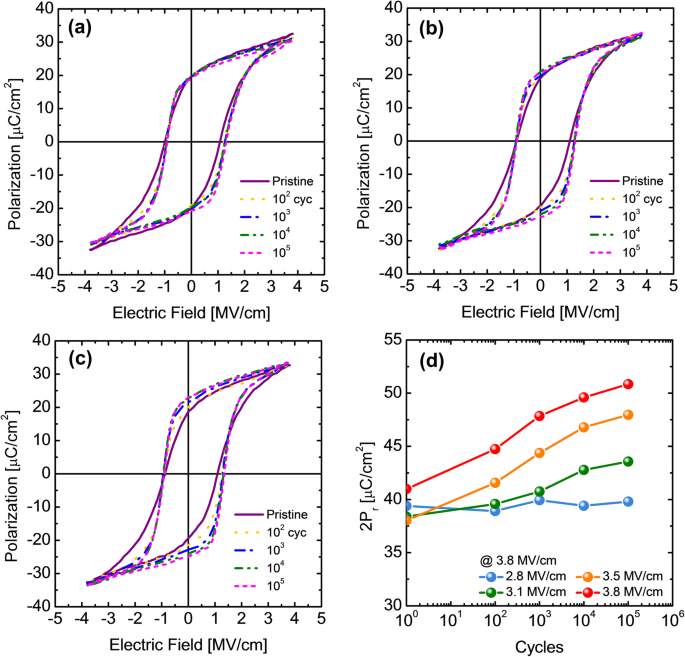
疲労パルス波高が( a )のウェイクアップテスト中に測定された分極-電界(P–E)曲線 )2.8、( b )3.1、および( c )3.5 MV / cm。 ( d) 2P r の変更 2.8、3.1、3.5、および3.8 MV / cmの耐久性テスト中の値-高疲労パルス
ウェイクアップ効果は、主に界面層で、酸素空孔のドリフトと、その結果生じる正方晶相から斜方晶相への相転移に強く関連しています[9、10]。酸素空孔のドリフトは、疲労パルスの振幅に強く影響されるはずであり、適切に低い疲労試験場の振幅(この場合は2.8 MV / cm)は、このような悪影響を大幅に軽減できます。達成可能な最大2P r 値は〜51μC / cm 2 から減少しました (3.8 MV / cmで)〜40μC / cm 2 (2.8 MV / cmで)、〜40μC / cm 2 強誘電体メモリデバイスとしては、依然としてかなり高い値です。 TEMA HZOフィルムの場合、ウェイクアップの問題を軽減するために同様の戦略を適用できますが、最初は2P r が低くなっています。 値(〜30μC / cm 2 )そのような方法の潜在的な問題である可能性があります。
C濃度の影響は、10 9 までの耐久性試験によってさらに明らかになりました。 P r の変動を示した図5aおよびbに示すように、サイクル TEMAおよびTDMAHZOフィルムの場合、それぞれ2.5および3.0 MV / cmのフィールド振幅の下で。どちらの場合も、P r 値は、サイクリングフィールドと同じ強度の最大電界を持つP–Eループによって推定されたため、推定されたP r 値は一般に、P–Eテストが3.8 MV / cmで実行された図4の値よりも小さくなります。図4のP–E試験の最大電界(3.8 MV / cm)を耐久性試験に使用した場合、フィルムは早期に破壊され、最大サイクル数までの耐久性試験が禁止されました。 2つの映画は、P r の進化において一貫した傾向を示しました。 vs. cycle behavior:TEMA HZO film kept increasing the Pr values, whereas the trend was much lower for the case of the TDMA HZO film. The TEMA HZO film showed unsteady Pr changes before break down at ~ 10 7 and ~ 10 9 cycles using 3.0 and 2.5 MV/cm field cycling, respectively. In contrast, the TDMA HZO film showed no indication of breakdown up to ~ 10 7 and ~ 10 9 cycles at 3.0 MV/cm and 2.5 MV/cm field cycling, and sudden breakdown was observed. The Pr value decreased slightly after ~ 10 7 under the cycling field strength of 2.5 MV/cm, which corresponds to the genuine fatigue behavior. Similar decay in the Pr performance with the switching cycles has been extensively reported for conventional perovskite ferroelectrics, which usually ascribed to the domain wall pinning by the increasing defect density [40, 41]. In the previous studies on the HZO-based ferroelectric thin films, such genuine fatigue behaviors have hardly been observed due to the involvement of significant wake-up and early breakdown, which was also the case in Fig. 5a. The data shown in Fig. 5b reveals that the HZO film may also suffer from the fatigue effect, known in the perovskite ferroelectric film, under the condition that the wake-up and early breakdown are appropriately addressed.
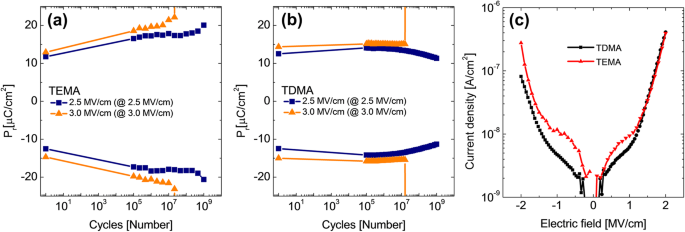
The results of endurance test of (a ) TEMA HZO (reproduced from Ref. 39) and (b ) TDMA HZO with the electric field cycling and pulse field amplitude of 2.5 and 3.0 MV/cm. The frequency of the rectangular double pulse for the endurance test was fixed at 100 kHz. (c) The current density–electric field curves of TDMA HZO (black) and TEMA HZO (red; reproduced from Ref. [39])
Figure 5c shows the comparison in the leakage current density performance of the two types of films. Due to the lower C concentration, TDMA HZO film had a lower leakage current than that of the TEMA HZO film at field strength <~ 1.5 MV/cm, where the trap-assisted tunneling may dominate. As a result of the leakage current improvement in TDMA HZO, the film did not show the breakdown up to 10 9 cycles, with relatively low field strength of 2.5 MV/cm.
However, in the higher field strength region, the difference becomes diminished, which may indicate that the high-field leakage current is more dominated by the interface Schottky barrier property, and such barrier property was less sensitive to the C concentration. Further research will be performed to more precisely identify the leakage current mechanism in subsequent work. The similar leakage currents in the high field region coincide with the no significant difference in the number of switching cycles before the breakdown at 3.0 MV/cm, shown in Fig. 5a and b.
結論
In conclusion, this work examined the influence of types of metal-organic precursors on the structure and electrical performances of the atomic layer-deposited Hf0.5 Zr0.5 O 2 薄膜。 The adopted Hf and Zr precursors have either TEMA or TDMA ligands, where the former is more prone to the thermal decomposition compared to the latter. The ALD process using the precursors with TDMA ligands resulted in a lower C impurity concentration (~2.4 atomic % vs. ~3.9 atomic %) in the HZO film, which induced a slightly larger grain size (~8.5 nm vs. ~7.1 nm). As the slightly larger grain size prefers to have the ferroelectric orthorhombic phase rather than the non-ferroelectric tetragonal phase, the TDMA HZO film outperformed the TEMA HZO film, especially for the wake-up performance. When the wake-up field cycle was 2.8 MV/cm, the TDMA HZO film showed almost no wake-up effect, while a high 2Pr value of ~40 μC/cm 2 could be achieved. This is significant merit over the severely waking-up property of the TEMA HZO film. The TDMA HZO film also contained a lower portion of the interfacial non-ferroelectric phase with the TiN electrodes, compared with the TEMA HZO film. Due to the lower C concentration, the TDMA HZO film showed a lower leakage current in the low field region (<~1.5 MV/cm), but the high-field leakage current behaviors were similar. As a result, the number of switching cycles before breakdown was similar when the cycling field was as high as 3.0 MV/cm (~10 7 cycles), but it could be extended over 10 9 cycles when the cycling field was lower (2.5 MV/cm) for the case of the TDMA HZO film. The TDMA HZO film revealed that the typical fatigue behavior, i.e., decreasing Pr value with the increasing switching cycles, could be observed after ~ 10 7 cycles at 2.5 MV/cm, which might be ascribed to the domain wall pinning by the accumulated defects, as for the conventional perovskite ferroelectric films.
データと資料の可用性
The datasets supporting the conclusions of this article are included within the article and its Additional file 1.
略語
- TEMA:
-
Tetrakis(ethylmethylamino)
- TDMA:
-
Tetrakis(dimethylamino)
- TEMAH:
-
Tetrakis[ethylmethylamino]hafnium
- TEMAZ:
-
Tetrakis[ethylmethylamino]zirconium
- TDMAH:
-
Tetrakis[dimethylamino]hafnium
- TEMAZ:
-
Tetrakis[dimethylamino]zirconium
- TDMA HZO:
-
Hf0.5 Zr0.5 O 2 thin films deposited using TDMAH/TDMAZ
- TEMA HZO:
-
Hf0.5 Zr0.5 O 2 thin films deposited using TEMAH/TEMAZ
- ALD:
-
原子層堆積
- AES:
-
Auger electron spectroscopy
- RTP:
-
Rapid thermal process
- XRD:
-
X線回折計
- GIXRD:
-
斜入射X線回折
- SEM:
-
走査型電子顕微鏡
- HZO:
-
Hf1-x Zrx O 2 , x~0.5
- FE:
-
Ferroelectric
- Pr :
-
Remanent polarization
- Ec :
-
強圧的場
- P–E:
-
Polarization–electric field
- C–V:
-
Capacitance–voltage
- J–E:
-
Current density–electric field
- Ci :
-
Interfacial capacitance
- Rc :
-
接触抵抗
ナノマテリアル
- スタックカップカーボンナノファイバーの原子および電子構造を明らかにする
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- ボロフェンの安定性とSTM画像に関する第一原理研究
- 界面層の設計によるZnO膜の表面形態と特性の調整
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- 水性電解質中の対称スーパーキャパシタとしてのカーボンナノファイバーと活性炭の研究:比較研究
- ITO / PtRh:PtRh薄膜熱電対の調製と熱電特性
- 二層/三層ブロードバンドSiO2反射防止膜の断面形態に関するTEMおよびSTEM研究
- 天然および合成ナノ材料の電気化学的、生物医学的、および熱的特性の比較研究
- PECVDによる低欠陥密度nc-Si:H薄膜の堆積のための便利で効果的な方法



