不揮発性メモリ用のアモルファス膜の酸素空孔双極子に起因する強誘電体のような動作
要約
従来の強誘電体デバイスは、スケーラビリティに欠けています。ドープされたHfO 2 薄膜はスケーリングの問題を解決するのに有望ですが、多結晶性による高いリーク電流と均一性の懸念が課題となっています。安定した強誘電体のような挙動は、最初に厚さ3.6nmのアモルファスAl 2 で示されます。 O 3 映画。アモルファスAl 2 O 3 デバイスは非常にスケーラブルであり、ナノメートルスケールのフィンピッチを備えたマルチゲート不揮発性電界効果トランジスタ(NVFET)を可能にします。また、プロセス温度が低く、周波数(〜GHz)が高く、メモリウィンドウが広く、耐久性が長いという利点もあり、VLSIシステムに大きな可能性を秘めています。切り替え可能な偏光( P )電圧変調された酸素空孔双極子によって誘導されることが提案されています。
背景
従来のペロブスカイト強誘電体(PZTなど)に基づく強誘電体ランダムアクセスメモリ(FeRAM)は、スケーリングやCMOS互換ではありませんが、市販の不揮発性メモリ(NVM)の1つです[1]。強誘電体は、ブタの大動脈壁[2]、Sb 2 など、さまざまな材料で広く観察されました。 S 3 ナノワイヤー[3]、GaFeO 3 フィルム[4]、ドープされたポリ-HfO 2 フィルム[5]、ナノ結晶ヒドロキシアパタイトフィルム[6]、およびLaAlO 3 -SrTiO 3 フィルム[7]。これらの材料の中で、ドープされたHfO 2 フィルムは、CMOSプロセスとの互換性があるため、NVMアプリケーションに特別な関心を集めています。しかし、多結晶構造は、ドープされたHfO 2 で強誘電性を生成するために避けられません。 、デバイスアプリケーションの障害を次のように克服しました。1)斜方晶相を形成するために必要な500°Cの熱収支に関して、ゲートラスト処理と互換性がありません[8]。 2)電力消費は、強誘電体の厚さの縮小に伴って指数関数的に増加する、粒界に沿った望ましくないリーク電流から引き起こされます。最近、理論的研究により、厚いポリHfO 2 の強誘電性が追加されることが提案されました。 (> 5 nm)は、酸素空孔によって生成された電気双極子のアセンブリにおける長距離相関から生じる可能性があります[9]。欠陥電荷トラップ/デトラップメカニズムは、5nmの厚さのアモルファスAl 2 で強誘電体のような挙動を示すことが観察されました。 O 3 ただし、トラップ/デトラップ周波数が非常に低い(たとえば、約500 Hz)マルチステートメモリの場合[10]。
この研究では、安定した強誘電体のような挙動が、厚さ3.6nmのアモルファスAl 2 で実証されています。 O 3 フィルム、切り替え可能な偏光( P )は、電圧変調された酸素空孔双極子によって誘導されることが提案されています。アモルファスAl 2 O 3 フィルムは、プロセス温度が低く、動作周波数が最大〜GHzであるという利点があり、ナノメートルスケールのフィンピッチを備えたマルチゲート不揮発性電界効果トランジスタ(NVFET)を可能にします。 Al 2 O 3 100 nsのパルス幅のプログラム/消去(P / E)電圧と10 6 を超えるNVFETメモリ P / Eサイクルの耐久性が実証されています。 P に対する電極と膜厚の影響 Al 2 で O 3 コンデンサも調査されます。アモルファス不揮発性デバイスは、VLSIメモリの有望な未来を示しています。
メソッド
アモルファスAl 2 O 3 膜は、原子層堆積(ALD)によってSi(001)、Ge(001)、およびTaN / Si基板上に成長しました。 TMAおよびH 2 AlとOの前駆体としてそれぞれO蒸気を使用した。堆積中、基板温度は300℃に維持された。 TaN / Ti、TaN、およびWを含むさまざまな上部金属電極がAl 2 に堆積されました。 O 3 反応性スパッタリングによる表面。異なる電極を備えたコンデンサは、リソグラフィーパターニングとドライエッチングによって製造されました。 350°Cで30秒間のラピッドサーマルアニーリング(RTA)を実行しました。 TaN / Al 2 を備えたNVFET O 3 ゲートスタックはGe(001)上に製造されました。ゲート形成後、ソース/ドレイン(S / D)領域がBF 2 によって注入されました。 + 1×10 15 の用量で cm -2 次に、20 keVのエネルギー、および20nmの厚さのニッケルS / D金属電極がリフトオフプロセスによって形成されました。図1aおよびbは、製造されたAl 2 の概略図を示しています。 O 3 コンデンサとpチャネルNVFET。電極とAl 2 の間に界面層(IL)があります O 3 映画。図1cおよびdは、TaN / Al 2 の高分解能透過型電子顕微鏡(HRTEM)画像を示しています。 O 3 / Geスタックと異なるアモルファスAl 2 O 3 厚さ( t AlO )350°CでのRTA後。
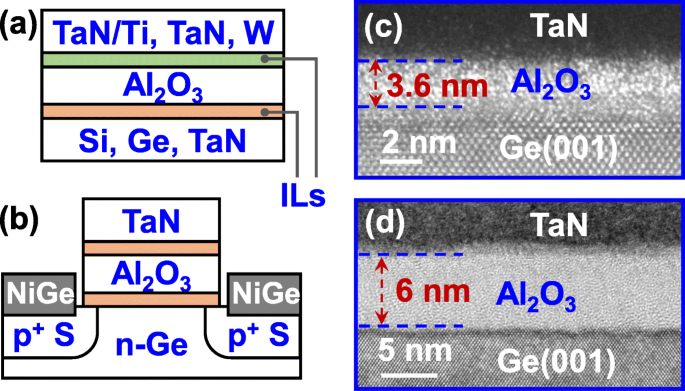
製造された a の概略図 Al 2 O 3 さまざまな電極と b を備えたコンデンサ Al 2 O 3 NVFET。 c および d 作製したTaN / Al 2 のHRTEM画像 O 3 / Geスタックが異なる t AlO 、アモルファスAl 2 を示しています O 3 350°CでのRTA後のフィルム
結果と考察
図2は、測定された P を示しています。 vs 。 電圧 V アモルファスAl 2 の特性 O 3 t が異なるコンデンサ AlO とさまざまな上部と下部の電極。測定周波数は1kHzです。図2a–cに示すように、3.6nmの t が固定されています。 AlO 、TaN / Al 2 O 3 / Geコンデンサはより高い飽和度を達成します P ( P 土 )TaN / TiおよびW上部電極を備えたデバイスと比較。強誘電体のような挙動は界面と強く相関しており、TaAlO x の形成が提案されています。 TaNとAl 2 の間のIL O 3 より多くの酸素空孔を生成し、より強力なスイッチングに貢献します P 、TiAlO x と比較して およびWAlO x IL。 P-V 図2dの曲線は、TaN / Al 2 O 3 / TaNコンデンサの P ははるかに高くなります 土 TaN / Al 2 との比較 O 3 / Ge、これはデュアルTaAlO x という事実に起因します ILは、より高い酸素空孔濃度を提供します。 P 土 Ge電極と比較して、Si下部電極(図2e)の場合よりも大幅に低くなっています。この結果は、Al 2 O 3 / Si界面の品質は、Ge基板に基づくデバイスの品質と比較して、優れています。つまり、酸素空孔が少なくなっています。図2fは、 P-V を示しています。 TaN / Al 2 の曲線 O 3 (6 nm)/ Geコンデンサ、より高い V c ほぼ同一の P 土 3.6nmのAl 2 を備えたデバイスからのものと比較して O 3 図2bのフィルム。閉じられていない P の理由に注意してください - V ループは、リークが実際に存在するためです。ゼロの電場での大きなオフセットは常に大きな電場で発生し、 V のより小さな掃引範囲で常に徐々に消えると報告されました。 [11、12]。
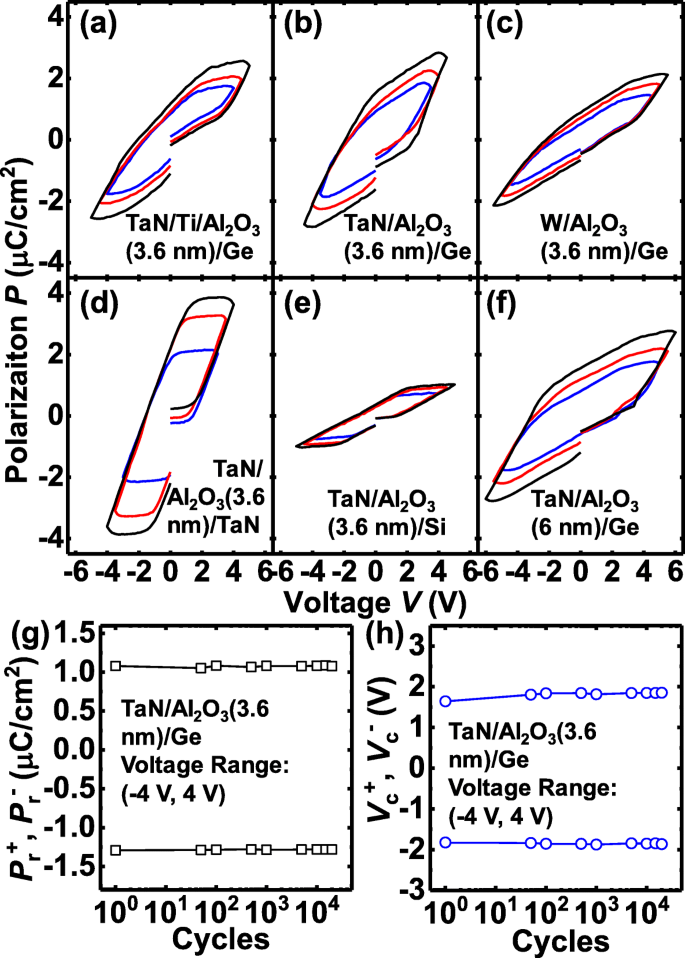
測定された P 対 V Al 2 の特徴 O 3 異なる電極を持つコンデンサ。 a 、 b 、および c P を表示 - V TaN / Ti / Al 2 の曲線 O 3 / Ge、TaN / Al 2 O 3 / Ge、およびW / Al 2 O 3 / Ge、それぞれ3.6 nm t AlO 。 d および e P であることを示す 土 Geの代わりに下部電極としてTaN(Si)を使用することにより、強化(低減)されます。 f TaN / Al 2 O 3 (6 nm)/ Geコンデンサの V は高くなります c および同様の P 土 b の厚さ3.6nmのデバイスと比較 。 g および h P の劣化がないことを示す耐久性測定 r および V c 10 4 以降に観測 TaN / Al 2 のスイープサイクル O 3 (3.6 nm)/ Geコンデンサ
図2gとhは、正と負のレムナント P の抽出された進化を示しています。 ( P r )そして強制的な V ( V c )それぞれ、10 4 を超える値 TaN / Al 2 のスイープサイクル O 3 / Geコンデンサ。目覚め、痕跡、または倦怠感の影響は観察されません。 V c デバイスの電圧は約1.8Vであり、 E Al 2 で O 3 フィルムは4〜6 MV / cmであり、ILでは8 MV / cmを超える可能性があり、これは酸素空孔を駆動するのに十分な高さです[13、14]。 P 土 デバイスの範囲は1〜5μC / cm 2 、3〜15×10 12 の範囲の妥当な酸素空孔濃度に対応 cm -2 プラス2の担当があると仮定します。
Al 2 の酸素空孔に関連する強誘電性のような挙動の根本的なメカニズム O 3 デバイスについて説明します。電圧駆動の酸素空孔の移動は、抵抗変化型メモリデバイスで広く実証されています[15、16]。図3に、切り替え可能な P の概略図を示します。 TaN / Al 2 で O 3 / Geは、電圧変調された酸素空孔と負電荷の分離によって発生し、電気双極子を形成します。可動酸素空孔は主にTaAlO x の形成から生じると推論するのは合理的です。 ILであり、初期状態では上部界面の近くにあります(図3a)。図3bとcは、正と負の P それぞれ、印加電圧下での酸素空孔と負電荷双極子の変調によって形成されます。 Al 2 のX線光電子スペクトル(XPS) O 3 / Geおよび(Ti、TaN、およびW)/ Al 2 O 3 / Geサンプルが測定され、図4)に示されています。すべての金属/ Al 2 O 3 / Geサンプルでは、金属とAl 2 の間に金属酸化物ILが形成されています。 O 3 、酸素イオンと空孔の貯蔵所であると提案されており、これは参考文献と一致しています。 [17]。
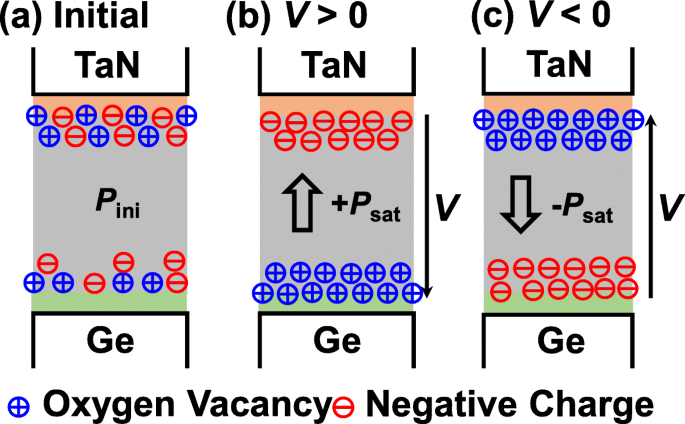
Al 2 における強誘電性のような挙動のメカニズムの概略図 O 3 コンデンサ。切り替え可能な P 双極子を形成するための酸素空孔と負電荷の移動によるものです

a のコアレベルXPSスペクトル Al 2 O 3 / Ge、 b TaN / Al 2 O 3 / Ge、 c Ti / Al 2 O 3 / Ge、および d W / Al 2 O 3 / Geサンプル
Al 2 の電気的性能を特徴づける O 3 NVMとしてのNVFET、プログラム(消去)動作は、ゲートに正(負)の電圧パルスを印加して、そのしきい値電圧( V )を上げる(下げる)ことによって実現されます。 TH )。図5aは、Al 2 の線形領域伝達特性を示しています。 O 3 最初の I に対するNVFETシフト DS - V GS パルス幅100nsの±4Vプログラム(消去)電圧で測定された曲線。ここでは、 V TH V として定義されます GS 100nA・W / Lで、MWは V の最大変化として定義されます。 TH 。 Al 2 O 3 NVFETは、アモルファスAl 2 ですが、0.44VのMWを取得します。 O 3 フィルムの P は小さい r 報告されたドープされたHfO 2 より 映画[5、8]。 Al 2 の最大10MHzの高い動作周波数に注意してください。 O 3 その切り替え可能な P を示すNVFETメモリ Al 2 で O 3 欠陥の電荷トラップ/デトラップではなく、電圧駆動の酸素空孔が移動して双極子を形成することに起因します。交互のプログラムと消去パルスがAl 2 に適用されました O 3 デバイスの耐久性をさらに調査するためのデバイス。図5bは、 V のプロットを示しています。 TH vs 。 P / Eサイクル数。これは、10 6 を超える大幅な劣化なしに安定したMWを維持できることを示しています。 3.6nmの厚さのAl 2 のP / Eサイクル O 3 NVFET。
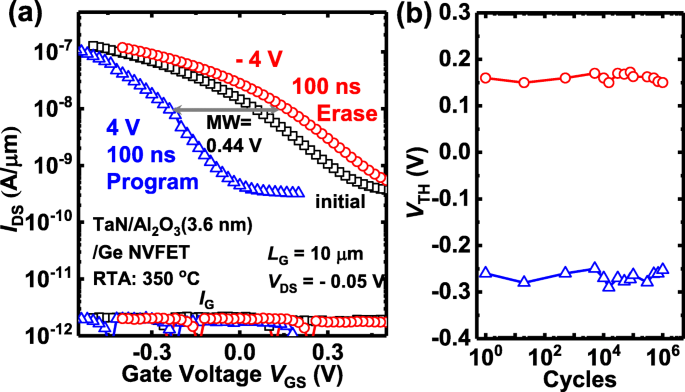
a 測定された I DS - V GS 厚さ3.6nmのAl 2 の曲線 O 3 初期および2つの偏光状態のNVFET。 0.44VのMWが得られます。 b 耐久性の測定は、10 6 以降はMWの低下が観察されないことを示しています P / Eサイクル
特に、アモルファスAl 2 で観察された強誘電体のような挙動 O 3 デバイスは、酸化ハフニウム(HfO 2 など)などのユニバーサルアモルファス酸化物に拡張できます。 )および酸化ジルコニウム(ZrO 2 。
結論
安定した強誘電体のような動作は、薄いアモルファスAl 2 を備えたコンデンサで最初に実現されます。 O 3 インシュレータ。切り替え可能な P アモルファスAl 2 O 3 コンデンサは P-V で示されます ループとNVFETテスト。強誘電体のような振る舞いは、界面の酸素空孔とイオンの双極子に起因すると提案されています。厚さ3.6nmのAl 2 O 3 NVFETは、0.44Vおよび10 6 を超えるMWを達成します。 100 ns P / E条件で±4Vでのサイクル耐久性。全体として、この作業により、アモルファス酸化物強誘電体デバイスの新しい世界が開かれました。これは、VLSIシステムで潜在的にナノスケールのフィンピッチを備えたマルチゲート(フィン型、ナノワイヤ、またはナノシート)NVFETに有望です。
データと資料の可用性
この記事の結論を裏付けるデータセットは、記事に含まれています。
略語
- Al 2 O 3 :
-
酸化アルミニウム
- ALD:
-
原子層堆積
- BF 2 + :
-
フッ化ホウ素イオン
- E c :
-
強制電界
- Ge:
-
ゲルマニウム
- GeO x :
-
酸化ゲルマニウム
- HRTEM:
-
高分解能透過型電子顕微鏡
- I DS :
-
電流を排出する
- MOSFET:
-
金属酸化物半導体電界効果トランジスタ
- MW:
-
メモリウィンドウ
- Ni:
-
ニッケル
- NVFET:
-
不揮発性電界効果トランジスタ
- P r :
-
残留分極
- P 土 :
-
飽和分極
- RTA:
-
リペイドサーマルアニーリング
- TaAlO x :
-
タンタル酸化アルミニウム
- t AlO :
-
酸化アルミニウムの厚さ
- TaN:
-
窒化タンタル
- V GS :
-
ゲート電圧
- V TH :
-
しきい値電圧
- XPS:
-
X線光電子スペクトル
ナノマテリアル



